低反射率多晶硅绒面的湿法制备研究*
张力典,沈鸿烈,2* ,岳之浩,王 威,蒋晔
(1.南京航空航天大学材料科学与技术学院,南京210016;2.南京航空航天大学纳米智能材料器件教育部重点实验室,南京210016)
随着光伏产业的发展,多晶硅太阳电池以其成本低等优点受到国内外研究人员的广泛关注,如何提高多晶硅太阳电池的转化效率一直是研究重点。减少晶硅太阳电池表面反射率是提高电池转化效率有效方法之一[1-4]。相比较机械刻槽[1],反应离子刻蚀[2]以及光刻技术[3]制备多晶硅绒面,酸腐蚀方法[5-6]工艺简单,制备成本低,成为工业制备多晶硅绒面的主要方法。
酸腐蚀法制备多晶硅绒面主要是利用HF/HNO3/H2O的混合溶液与硅片进行化学反应,从而获得表面形貌为蚯蚓状的多晶硅绒面。未经腐蚀的多晶硅表面反射率一般在30%以上,从1959年Robbins和Schwartz发现硝酸腐蚀硅表面形成的氧化膜可以在氢氟酸中溶解后[7],酸腐蚀多晶硅制绒技术一直在不断改进。主要从改变混合溶液成分以及改变实验方法入手,优化腐蚀条件,但效果并不是很理想。2008年,M.Ju等人采用蒸汽腐蚀法制备多晶硅绒面,在300 nm~1 100 nm波长范围内平均反射率为6.5%[8],但此方法过程相当繁琐,实际生产中很难采用。2011年,林育琼等人采用两步法对多晶硅进行腐蚀,在350 nm~1 050 nm波长范围内绒面平均反射率为24.8%[9]。2012年,钱勇等人采用HF/NaNO2/H2O腐蚀液腐蚀多晶硅片,在300 nm~1 100 nm波长范围内绒面平均反射率为24.8%[10]。工业中通常采用廉价的HF/HNO3/H2O腐蚀系统,但此系统制备的多晶硅片绒面反射率一直较高。2011年,Cheng Yuang-Tung等人用HF/HNO3/H2O的混合溶液制得的绒面在300 nm~900 nm波长范围内平均反射率为21.4%[11]。影响表面形貌的因素有很多,主要有混合酸的体积比[12],腐蚀液中缓冲剂的含量[13],腐蚀时间和反应温度[14]等,这些因素从各个方面影响着表面形貌。
本研究采用HF/HNO3/H2O混合溶液腐蚀多晶硅片,从HF与HNO3的体积比,腐蚀时间和腐蚀液中缓冲剂的体积比这3个因素展开研究,通过合理优化这3个因素,得到了具有更低反射率的多晶硅绒面。
1 实验
实验采用面积为2 cm×2 cm,厚度180 μm~200 μm,电阻率为0.5 Ω·cm ~1.5 Ω·cm 的多晶硅片。制绒采用HF(40 wt.%)与 HNO3(68 wt.%)的混合酸溶液,腐蚀液中加入去离子水作为缓冲剂。制绒前先在85℃下用20%的NaOH溶液去除硅片表面损伤层,再用10%的HF漂洗硅片表面去除硅片表面氧化物,最后用去离子水超声洗净。反应结束后先用稀释的碱液清洗,再用去离子水冲洗后吹干。由于制绒反应是放热反应,为了避免大量放热对反应的不利影响,实验中,我们用冰水浴控制温度,使整个实验中保持温度不变。通过调整HF与HNO3体积比,腐蚀时间以及缓冲剂在腐蚀液中的体积比来研究这3个因素对制绒的影响。
硅片反射率由日本岛津生产的UV-3600分光光度计测得,测试范围为300 nm~1 100 nm波长范围,硅片的表面形貌以及断面形貌由日本日立生产的HITACHI S-4700扫描电子显微镜测得。
2 实验结果与讨论
实验中我们采用固定变量法,分别研究了腐蚀时间、HF与HNO3的体积比以及腐蚀液中缓冲剂的含量对多晶硅绒面反射率的影响。
2.1 多晶Si绒面平均反射率与腐蚀时间的关系
我们固定 HF∶HNO3∶H2O 体积比为 5 ∶1 ∶2,得到的反射率与腐蚀时间的关系如图1。从图中可以发现:随着腐蚀时间的增加,绒面反射率先降低后升高,在腐蚀时间从1 min增加到3 min的过程中,绒面的反射率不断下降,但当腐蚀时间进一步增加到4 min后,绒面反射率升高。当腐蚀时间为3 min时,光波长范围在300 nm~900 nm下绒面的平均反射率为20.4%。测得的表面形貌以及断面形貌的图像如图2所示。
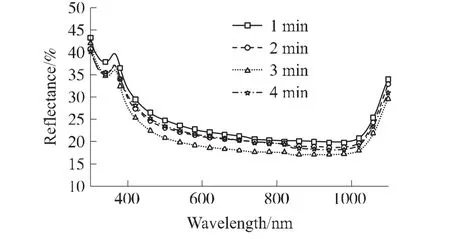
图1 不同时间腐蚀后的绒面反射率
图 2(a)、2(b)、2(c)、2(d)为别为反应 1 min、2 min、3 min和4 min的绒面SEM图像。从图2(a)中我们看到由于腐蚀时间较短,形成的腐蚀坑分布少,断面图像显示反应1 min后,腐蚀坑刚开始形成,腐蚀坑小而浅,反应2 min后腐蚀坑长大,如图2(b)所示,断面图像显示反应2 min后的腐蚀坑较反应1 min后有所长大,腐蚀坑的宽度及深度相对于图1(a)中有所增加,这些微小腐蚀坑零散地分布在绒面上,对降低绒面反射率贡献不大,绒面的反射率较高。随着腐蚀时间的增加,微裂纹开始慢慢扩展,裂纹首尾互相连接并不断长大,腐蚀坑也随之变宽,变深,变长。腐蚀3 min后,从图2(c)中我们可以观察到明显的腐蚀坑,从图2(c)的右上角断面图我们可以发现此时的腐蚀坑已接近半球形,这种半球形的腐蚀坑可以使入射光照射在绒面上尽可能多的在腐蚀坑内发生反射,从而提高了硅表面对光的吸收,降低了绒面反射率[10]。随着腐蚀时间进一步增加到4 min,硅片表面出现了过腐蚀的现象,这种现象的产生是由于随着反应的进行,相邻的半球形腐蚀坑发生合并,导致形成的腐蚀坑宽而浅,如图2(d)所示,从图2(d)的右上角断面图中可以看出腐蚀坑的宽度相对之前腐蚀3 min形成的腐蚀坑增加很多,这使得光在腐蚀坑内的反射次数减少,从而导致绒面反射率升高。
从示意图中可见,经过恰当的时间腐蚀硅片后,在硅片表面形成了较深的腐蚀坑,类似于图2(c)中的断面图的腐蚀坑,光线进入这种形貌的腐蚀坑后,可以在腐蚀坑内进行多次反射,从而提高了硅片表面对光的的吸收,降低了硅片表面的反射率。随着腐蚀时间的增加,腐蚀坑不断长大,相邻腐蚀坑发生合并形成浅而宽的腐蚀坑,类似于图2(d)中的断面图的腐蚀坑,光线进入这种形貌的腐蚀坑后,在表面的反射次数相对之前明显减少,从而导致硅片对光的吸收减少,反射率升高。所以合理控制腐蚀时间,可以得到陷光效果明显的表面形貌,对降低绒面反射率有重要意义。

图2 不同时间腐蚀后的多晶硅表面以及断面形貌图(右上角插图)

图3 腐蚀坑随腐蚀时间变化过程的示意图
2.2 多晶Si绒面平均反射率与腐蚀液中HF与HNO3的体积比的关系
众所周知,酸腐蚀过程包括HNO3和HF对硅片的共同作用,HNO3作为氧化剂首先氧化硅片使其表面形成SiO2,再由HF溶解掉表面的SiO2,最后形成绒面[12]。由于在富HNO3的情况下,HF含量过低导致Si被HNO3氧化后形成的SiO2不能充分溶解,从而制约了多晶硅的腐蚀。所以实验中我们采用富HF的溶液对多晶硅进行腐蚀。
从图4中我们看出,在腐蚀时间为3 min不变的情况下,在腐蚀液中HF∶HNO3∶H2O体积比从3∶1∶2到6∶1∶2不断变化的过程中,绒面反射率先降低后升高,在 HF∶HNO3∶H2O 体积比为 5 ∶1 ∶2时,绒面在300 nm~900 nm波长范围内的平均反射率最低,为20.4%。这是因为在 HF含量较低时,Si被HNO3氧化后形成的SiO2不能很快得到溶解,阻碍了硅片表面与腐蚀液的接触,从而制约了反应的进行。随着HF含量的不断增加,使得表现氧化形成的SiO2溶解速度不断提高,有利于硅片与腐蚀液的接触,腐蚀坑易于形成,因此反射率下降,但是随着HF含量不断增加,从而使HNO3含量相对减少,硅片表面的氧化反应不能充分进行,腐蚀坑的密度减少,反射率回升。同时由于HF含量过高导致表面氧化形成的SiO2溶解速率过快,不利于形成稳定的表面形貌。

图4 不同HF与HNO3体积比的腐蚀液腐蚀后的绒面反射率
图5(a)和5(b)分为不同 HF∶HNO3∶H2O 体积比下腐蚀时间为3 min时得到的表面形貌图像。图5(a)是在 HF∶HNO3∶H2O 体积比为 3 ∶1 ∶2的时候制备的多晶硅绒面,从图5(a)中可以发现由于HF含量偏低使得氧化形成的SiO2溶解速率较慢,阻碍了反应进行,导致绒面腐蚀坑纤细,使得绒面反射率偏高。随着HF含量的增加,在HF∶HNO3∶H2O体积比为5∶1∶2的时候制备的多晶硅绒面,此时绒面上腐蚀坑分布均匀(见图2(c)),反射率也最低,为20.4%(见表1)。进一步提高 HF含量,当 HF∶HNO3∶H2O 体积比为 6∶1∶2时,腐蚀后的多晶硅绒面如图5(b)所示,由于硅片表面腐蚀坑大小、深浅以及分布稀疏程度不同,导致绒面的不同区域对光线的反射强弱程度不同,从图像上反应就是不同区域颜色的深浅不同。在这种条件下,反射率又上升到20.9%(见表1),得不到最好的制绒效果。

图5 不同HF与HNO3体积比的腐蚀液腐蚀后的多晶硅表面形貌图
表1是在不同HF与HNO3的体积比以及腐蚀时间条件下,对多晶硅进行制绒得到的绒面在300 nm~900 nm波长范围内的平均反射率。

表1 不同腐蚀时间和不同HF与HNO3体积比下制得的多晶硅绒面的反射率
从表1中我们可以发现,制绒后的绒面反射率与腐蚀液中HF与HNO3体积比以及腐蚀时间有着密切关系,随着腐蚀时间的增加,绒面反射率先降低后升高,时间为3 min时效果最佳。随着 HF与HNO3体积比的增加,在腐蚀时间1 min~3 min条件下所有绒面反射率先降低后升高,HF与HNO3体积比为5∶1时反射率最低;腐蚀时间为4 min时反射率随HF与HNO3体积比的增加呈现无规律的变化,这是因为当腐蚀时间过长后,硅片表面发生过腐蚀,表面形貌发生了较大的变化,同时腐蚀液中的成分相对初始时也有所变化,导致测得的反射率跟理想情况下有所偏差。再者,在过腐蚀情况下得到的反射率变化情况对实际应用意义不大。
2.3 多晶Si绒面平均反射率与腐蚀液中缓冲剂含量的关系
为了研究腐蚀液中缓冲剂的含量对反应后绒面的影响,我们保持腐蚀液中HF∶HNO3体积比为5∶1以及腐蚀时间为3 min不变,改变腐蚀液中缓冲剂的含量进行实验。分别配制腐蚀液中HF∶HNO3∶H2O 体积比为5 ∶1 ∶1,5 ∶1 ∶2以及 5 ∶1 ∶3的三组腐蚀液对多晶硅片进行腐蚀。测得的绒面反射率如图6所示。

图6 不同缓冲剂体积比的腐蚀液腐蚀后的绒面反射率
图6反映了缓冲剂在腐蚀液中的含量对绒面反射率的影响,当腐蚀液中HF∶HNO3∶H2O体积比分别为5 ∶1 ∶1,5 ∶1 ∶2和5 ∶1 ∶3时,计算得出在300 nm ~900 nm波长范围内,绒面的平均反射率分别为28.8%,20.4%和24.4%。从反射率曲线可以看出,在缓冲剂在腐蚀液中含量不断增加的过程中,腐蚀后绒面的反射率先减小后增加。在HF∶HNO3∶H2O体积比为5∶1∶2时,绒面平均反射率最低。
图7中(a)和(b)是HF∶HNO3∶H2O体积比分别为5∶1∶1和 5 ∶1 ∶3,腐蚀 3 min 后的多晶硅绒面 SEM图像。图7(a)形貌形成的原因是由于腐蚀液中缓冲剂的含量过低,导致混合酸浓度太高,反应过于激烈,使得硅片腐蚀过快。我们发现在腐蚀过程中反应形成的气泡比之前实验条件下都要多,导致类似抛光的表面形貌,这种形貌与前述最佳腐蚀条件下形成的蚯蚓状腐蚀坑(见图2(c))有很大不同,测得的表面反射率很高。图7(b)是在腐蚀液中HF∶HNO3∶H2O体积比为5∶1∶3时腐蚀后得到的多晶硅表面形貌图,由于缓冲剂体积比过高导致反应速度很慢,反应过程中几乎看不见气泡生成,反应后与反应前的形貌没有显著区别,因此测得的绒面的反射率也较高。

图7 不同缓冲剂体积比的腐蚀液腐蚀后的多晶硅表面形貌图
3 总结
在利用由HF,HNO3和H2O组成的腐蚀液对多晶硅表面进行腐蚀时,HF与HNO3的体积比,腐蚀时间以及腐蚀液中缓冲剂的含量对制备出的绒面的反射率以及表面形貌有着重要的影响。腐蚀时间决定了腐蚀坑的大小以及深浅,腐蚀液中HF,HNO3和H2O三者的体积比决定了腐蚀坑的宽度以及分布密度。随着腐蚀时间的增加,绒面反射率先降低后升高,时间为3 min时腐蚀效果最佳。随着HF与HNO3体积比的增加,绒面反射率也是先降低后升高,HF与HNO3体积比为5∶1时反射率最低。当HF∶HNO3∶H2O 体积比为 5 ∶∶1 ∶2,腐蚀时间为 3 min时,制得的多晶硅表面腐蚀坑窄而深,增加了光在硅片表面的反射次数,从而增强了硅片对光的吸收,降低了反射率,绒面在300 nm~900 nm波长范围的平均反射率最低为20.4%。
[1]Zechner C,Fath P,Wlleke G,et al.Numerical Simulation Studies of Mechanically Textured High Efficiencysilicon Solar Cells[C]//Proceedings 14th EC PVSEC,1997:69-72.
[2]Inomata Y,Fukui K,Shirasawa K.Surface Texturing of Large Area Multicrystalline Silicon Solar Cells Using Reactive Ion Etching Method[J].Solar Energy Materials and Solar Cells,1997,48(1-4):237-242.
[3]Zhao J H,Wang A H,Campbell P,et al.A 19.8%Efficient Honeycomb Multicrystalline Silicon Solar Cell with Improved Light Trapping[J].IEEE Transactions on Electron Devices,1999,46(10):1978-1983.
[4]吕红杰,沈鸿烈,沈洲,等.太阳电池用单晶Si表面的织构化研究[J].电子器件,2011,34(5):498-502.
[5]Park S W,Kim D S,Lee S H.New Approach to Isotropic Texturing Techniques on Multicrystalline Silicon Wafers[J].Journal of Material Science Materials in Electronics,2001,12(11):619-622.
[6]Park S W,Kim J.Application of Acid Texturing to Multicrystalline Silicon Wafers[J].Journal of the Korean Physical Society,2003,43(3):423-426.
[7]Robbins H,Schwartz B.Chemical Etching of Silicon I[J].Journal of the Electrochemical Society,1959,106(6):505-508.
[8]Ju M,Gunasekaran M,Kim K,et al.A New Vapor Texturing Method for Multicrystalline Silicon Solar Cell Applications[J].Materials Science and Engineering B,2008,153(1-3):66-69.
[9]林育琼,冯仕猛,王坤霞,等.两步酸修饰的多晶硅绒面结构[J].材料科学与工程学报,2011,29(5):707-710.
[10]钱勇,冯仕猛.多晶硅表面陷阱坑形貌对表面光反射率的影响[J].光学学报,2012,32(2):0224001.
[11]Yuang-Tung C,Jyh-Jier H,Song-Yeu T,et al.Efficiency Improved by Acid Texturization for Multi-Crystaline Silicon Solar Cells[J].Solar Energy,2011,85(1):87-94.
[12]Gonzalez-Diaz B,Guerrero-Lemus R,Diaz-Herrera B,et al.Optimization of Roughness,Reflectance and Photoluminescence for Acid Textured Mc-Si Solar Cells Etched at Different HF/HNO3Concentrations[J].Materials Science and Engineering B,2009,159-160:295-298.
[13]Marstein E S,Solheim H J,Wright D N,et al.Acidic Texturing of Multicystalline Silicon Wafers[C]//Proceedings of the 31st IEEE Photovoltaic Specialists Conference.2005:1039-1042.
[14]肖文明,檀柏梅,刘玉岭,等.多晶Si太阳电池表面酸腐蚀制绒的研究[J].微纳电子技术,2009,46(10):627-631.

