电镀填盲孔薄面铜化技术研究
陈世金 徐 缓 邓宏喜(博敏电子股份有限公司,电子薄膜与集成器件国家重点实验室梅州研发中心,广东 梅州 514768 )李松松 何 为(电子科技大学电子与固体学院,四川 成都 610054)
电镀填盲孔薄面铜化技术研究
陈世金 徐 缓 邓宏喜
(博敏电子股份有限公司,电子薄膜与集成器件国家重点实验室梅州研发中心,广东 梅州 514768 )
李松松 何 为
(电子科技大学电子与固体学院,四川 成都 610054)

为满足印制电路精细线路的设计,对制作设备、材料和工艺技术等提出了更高的要求,尤其是HDI印制板的薄面铜化工艺技术,对精细线路的制作有着十分重要的意义。文章将就电镀填盲孔薄面铜化工艺技术进行相关试验研究,得出在确保盲孔凹陷度小于15μm的前提下,电镀添加剂最佳组分配比,该条件下电镀层的厚度最薄,从而满足精细线路的制作要求。
脉冲电镀;盲孔填铜;精细线路;凹陷度;添加剂
1 前言
在2015 CES(国际消费电子产品展)上,“中华酷联米”等国内高端智能手机制造商全面“出海”,早前已向欧亚市场发起强大进攻,现已经将火力对准了美国市场[1]。尽管有预测2015年中国智能手机面临增长放缓,但开拓海外市场仍有巨大的市场潜力,尤其是5G技术、移动技术、云计算和大数据等先进技术的不断开发,将会给电子信息产业带来更大的发展契机。高端印制电路板的应用将会越来越广泛,尤其是高阶、任意层HDI的设计将会越来越多,给印制电路制作技术带来巨大的挑战,如精细线路制作技术、电镀填盲孔技术、精准层间对位技术和板材涨缩控制技术等。
精细线路制作技术最关键是要保持蚀刻线路的薄型化,即所需要蚀刻的面铜厚度越薄越容易得到精细的线路。当前,高阶、任意层HDI等绝大多数都是采用电镀填盲孔的方式来实现层与层之间的堆叠互连(如图1),而要保证蚀刻前的薄面铜,就要从电镀填盲孔这里进行控制。当然,控制较薄面铜的前提是要保证盲孔填充率,因为过大的凹陷度可能会导致互连失效的出现。采用脉冲水平电镀填盲孔是能有效控制面铜厚度的,不过设备昂贵、制作成本高,并未能得到全面推广。本文针对电镀填盲孔的薄面铜化进行相关试验测试,寻求一种适合常规垂直连续电镀线(VCP)的制作工艺。

图1 叠孔填铜任意层互连HDI电路板
2 薄面铜化技术原理
我们知道,周期换向脉冲电镀(又称双向脉冲电镀)通过正反向脉冲时间、幅度的调整可改善镀层厚度分布均匀,同时反向脉冲有利于减薄扩散层的厚度,加快孔内铜层的沉积速率[2]。采用脉冲电镀方法来实现印制板薄面铜化对设备的要求很高,制作成本也让许多PCB厂家望而却步,要实现传统电镀设备的薄面铜化制作还需要做更多的研究。笔者采用不同电流参数组合[3][4]和对电镀添加剂的组分进行最佳配比试验,利用电镀填盲孔不同时期(初始期、爆发期、末期)持续时间及盲孔底部沉积铜速率的变化,在较短的时间里得到较好填充效果,而又利用电镀添加剂(加速剂、抑制剂、整平机)的各自作用机理进行有机、最佳配比,使孔内铜的沉积速率是线路面的数倍,从而实现薄面铜化。
3 试验部分
3.1 试验设计
本试验设计不同介质层厚度状与盲孔孔径的测试板,采用传统VCP制作,对电流参数和添加剂进行优化、配比等,看填充合格盲孔(凹陷度小于15 μm)后,其面铜厚度是否满足2 mil/2 mil线路的制作要求。测试板设计如图2所示。
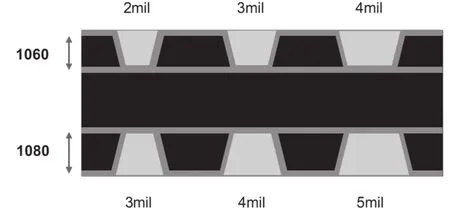
图2 测试板设计
测试板完成激光钻孔和化学沉铜后先进行闪镀(1.2 A/dm2、10 min),使盲孔内镀1 μm ~ 2 μm厚度的铜层,然后再在VCP上进行填孔电镀,最后取切片分析,观察填孔效果及面铜厚度等。具体流程如图3。

图3 试验工艺流程
在106pp面设计有2 mil、3 mil、4 mil三种不同的孔径,在1080pp面设计有3 mil、4 mil、5 mil三种不同孔径。2 mil/2 mil线路的制作要求面铜总厚度控制在22 μm以内,测试板底铜除去棕化、减铜和沉铜微蚀等影响,最后铜厚在3 μm左右(闪镀铜1 μm几乎不增加整体铜厚)。因此,可将镀铜厚度设计成“镀铜15 μm”和“镀铜18 μm”两种情况,看填孔效果是否符合要求。
3.2 试验材料及仪器
(1)试验材料:A公司双面覆铜板、106半固化片、1080半固化片;
B公司三组分电镀添加剂的填孔系列药水。
(2)C沉铜线、水平电镀线,D公司VCP线,金相显微镜、切片研磨机等。
3.3 试验参数
(1)填孔电镀溶液参数。如表1所示:

表1 填孔电镀溶液参数表

表2 试验电流参数表
(2)试验所用电镀参数。如表2所示。
3.4 试验结果
按照以上试验参数所得实验结果如下:
(1)镀铜15 μm的填充效果参见表3、表4。

表3 镀铜15μm 106pp面盲孔填充情况

表4 镀铜15μm 1080pp面盲孔填充情况
(2)镀铜18μm的填充效果参见表5、表6。
(3)两种镀铜厚度各面盲孔凹陷度及其切片情况,参见表7、表8。

表5 镀铜18μm 106pp面盲孔填充情况

表6 镀铜18μm 1080pp面盲孔填充情况

表7 镀铜15μm测试板两面盲孔凹陷度对比表
4 结论
(1)采用不同电流参数组合及对电镀添加剂各组分进行配比调整,可得到较薄的面铜(比常规方法的面铜要薄10 μm左右),且盲孔填充效果较好(dimple小于15 μm),满足2 mil/2 mil精细线路的制作要求。
(2)镀铜15 μm厚度时,不同介质层与孔径的盲孔填充凹陷度,除1080介质层5 mil孔径盲孔填充为10 μm 左右外,其余均为零。镀铜18 μm厚度时,不同介质层与孔径的盲孔填充凹陷度,除1080介质层5 mil孔径盲孔填充为5 μm 左右,其余均为零。
Study on thin surface copper technology in blind via filling plating
CHEN Shi-jin XU Huan DENG Hong-xi LI Song_song HE Wei
In order to meet the needs of fine lines PCB, it requests higher requirements to equipment, materials and technology. Especially the thin surface copper has significance for the production of fine lines in HDI process technology in PCB. In this paper relative experiment research of thin surface copper in blind via filling plating process was made. It draw a conclusion that by ensuring the blind via dimple less then 15μm, making the best ratio of the electroplating additive and under the conditions of the thinnest plating thickness, we can meet the requirements of the production of fine lines.
Pulse Plating; Blind Via Filling Plating; Fine Line; Dimple; Electroplating Additive
TN41
A
:1009-0096(2015)05-0044-03

