3D封装与硅通孔(TSV)技术
周 健 周绍华
(合肥工业大学,安徽 合肥 230009)
随着对具有更小外形的先进电子产品的需求不断增长,对优越性能和更低的总体成本的追求推动着半导体行业发展创新,涌现了一系列先进封装技术。相对于其他各类封装技术,3D封装技术具有良好的电学性能以及较高的可靠性,同时它能实现较高的封装密度,因此目前3D封装技术被广泛应用于各种高速电路以及小型化系统中。有很多种方式能实现芯片间的互连,一般来说,通常采用引线键合或者倒装芯片焊接将硅圆片集成在一起,如上图所示。目前,主流的三维封装一般利用硅通孔技术来实现。硅通孔技术通过在硅圆片上制作出一定布线排序的垂直互连孔,在孔中淀积通孔材料,实现不同芯片层之间的电互连,从而保证了芯片间具有较短的互连线,因此可以获得更好的电性能以及更小的信号延迟。
1 TSV简介
区别于传统的芯片封装技术,硅通孔技术在三维层面实现芯片间的电互连,封装密度大大提高,而垂直的互连线也改善了芯片间的信号传输速度,同时在硅通孔技术保证了对电路板空间的集约化利用,降低了芯片的功耗。另外,一些大型的IDM制造商如IBM和Intel都预测硅通孔技术是微电子制造行业最有前途的技术之一,并且已经开始着手商业化这一技术。TSV技术的发现得益于印刷电路板(PCB)多层化这一设计思路,它使得多芯片之间实现短垂直互连,取代在2D封装中的长引线互连,因而可以提高性能和减少时间延迟。同时采用硅通孔技术可以有效的降低功耗,另外由于硅通孔技术在三维层面对芯片进行整合,因此硅通孔技术可以有效的提高芯片的集成密度。目前,硅通孔技术的挑战主要来自于以下几个方面:通孔的刻蚀、通孔填充材料的选取、工艺流程、堆叠形式与键和方式的选取。如今,TSV技术已经被广泛应用于存储器、图像传感器、功率放大器等芯片中,虽然目前还未能大量商业化生产,但是随着技术的不断进步与完善,硅通孔技术必将会凭借其独特的优势引领微电子行业取得进一步的发展。
2 TSV技术展望
随着3D技术的不断发展以及通孔尺寸的缩小,叠层中的每一层芯片的厚度也会有所减少。而将硅片厚度减到5μm以下,电路的性能并不会因此而显著变坏。因此,未来对于微电子行业发展的限制并不是电学性能的限制,而是由于技术问题导致新技术无法实现或者无法商业化。可以预见在未来的十几年里传统器件将会到达其本身的物理极限,无法或者很难实现进一步的突破。而新型器件,比如碳纳米管、自旋电子器件等等在目前还只能在实验室中实现,无法大规模商业化使用。那么当前,在封装层面提高集成度显得尤为重要。所以在最近几年内硅通孔技术将会是微电子行业的热点话题,一些目前快速发展的实用芯片,如CMOS图像传感器、存储器和逻辑电路上存储器等等对于3D技术尤其是硅通孔的应用,使 3D技术不断发展与完善。另外,硅通孔技术还可以用于集成生产工艺不同的芯片,这称为“异质集成”。如手机的功率放大器一般使用GaAs工艺,而实际中,GaAs工艺使用较少,因此常常通过TSV集成将GaAs电路键合在CMOS电路上面,使之成为完整的电路。硅通孔技术的不足是当通电时,由于通孔产生的电磁噪声会对附近的MOS晶体管造成干扰,导致晶体管的特性发生改变,甚至无法正常工作。另外,由于温度变化通孔附近的电阻电容值发生改变,影响芯片的温度稳定性。“日本庆应大学研究开发的电磁耦合层叠芯片可以较好的解决这一问题,因此电磁耦合层叠芯片被认为是未来节电芯片的主要选择之一。”三维封装技术较之二维封装有着明显的优势,例如:更低的低功耗、更高的互连密度、更小的传播延迟等等。3D硅通孔技术通过将芯片制造与芯片封装技术融合在一起,提高了系统性能,在较低的成本下跟上了摩尔定律的预测。当然,目前3D封装仍然面临严峻的挑战,在可靠性、材料选取等等方面仍然制约着硅通孔技术的商业化进程,这有待进一步的研究。

图1
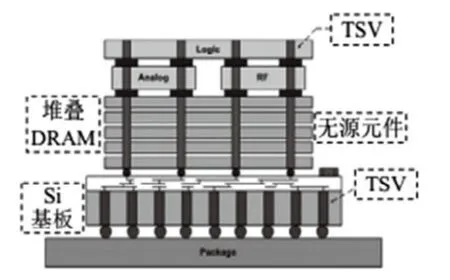
图2 使用硅基板和 TSV 的三维堆叠图

图3 采用 TSV 技术的堆叠器件
结语
总的来说,目前3D封装的硅通孔技术还处于高速发展时期,但是由于该技术具有更小的封装尺寸,更高的封装密度,以及具有适应半导体器件发展方向的高性能与低功耗种种优势,因此硅通孔技术具有广阔的前景以及成为微电子行业热门领域的潜质。
[1]邓小军,曹正州.应用于三维封装中的硅通孔技术[J].电子与封装,12(09):18-23.
[2]刘培生,黄金鑫,仝良玉,沈海军,施建根.硅通孔技术的发展与挑战[J].电子元件与材料,31(12):76-80.
[3]郎鹏,高志方,牛艳红.3D封装与硅通孔(TSV)工艺技术[J].电子工艺技术,30(06):323-326.
[4]侯珏,陈栋,肖斐.硅通孔互连技术的可靠性研究[J].制造工艺技术,36(09):684-688.

