Ni(W)Si/Si肖特基势垒二极管电学特性研究
石青宏,刘瑞庆,黄 伟
(1.深圳深爱半导体股份有限公司,广东 深圳 518116;2.中国电子科技集团公司第 58 研究所,江苏 无锡 214072)
Ni(W)Si/Si肖特基势垒二极管电学特性研究
石青宏1,刘瑞庆2,黄 伟2
(1.深圳深爱半导体股份有限公司,广东 深圳 518116;2.中国电子科技集团公司第 58 研究所,江苏 无锡 214072)
首次提出在 Ni中掺入夹层 W 的方法来提高 NiSi的热稳定性。具有此结构的薄膜,经600~800 ℃快速热退火后,薄层电阻保持较低值,小于 2 Ω/□。经 Raman 光谱分析表明,薄膜中只存在 NiSi相,而没有 NiSi2生成。Ni(W)Si的薄层电阻由低阻转变为高阻的温度在 800 ℃以上,比没有掺 W 的镍硅化物转变温度的上限提高了 100 ℃。Ni(W)Si/Si肖特基势垒二极管能够经受 650~800 ℃不同温度的快速热退火,肖特基接触特性良好,肖特基势垒高度为 0.65 eV,理想因子接近于 1。
Ni(W)Si;热稳定性;肖特基势垒二极管;XRD;Raman 光谱;卢瑟福背散射;快速热退火(RTA)
1 前言
难熔金属硅化物作为接触和局部互连材料有很多优点,例如接触电阻低、薄层电阻小、无电迁徙现象、能够实现自对准结构和能够承受高温热处理等,因而在深亚微米集成电路中硅化物技术被广泛应用。NiSi由于具有薄层电阻小、应力小、易形成浅结等优点,却没有 Ti硅化物的“桥连”现象和线宽效应,也没有CoSi2形成时耗硅多、应力大、漏电大的缺点,因而NiSi能够适应集成电路特征尺寸不断缩小的趋势,成为深亚微米集成电路中最有前景的硅化物之一。然而NiSi存在一个亟待解决的问题,即热稳定性差[1],大于650 ℃ RTA 退火后的 NiSi薄膜开始结团,750 ℃就能生成高阻的 NiSi2,这将增大薄膜电阻率,并引起器件的漏电流增大。目前在 Ni中掺入金属如 Pt、Pd[2]等方法来提高 NiSi的热稳定性,能够起到不同程度的作用。本文首次提出在 Ni中掺入 W 的方法来提高 NiSi的热稳定性,取得了良好效果。
2 实验
在掺 As,浓度为 1×1019cm-3,晶向 <111>,n 型硅衬底上生长一层厚为 9~10 μm 掺磷的外延层,外延层浓度 5×1015cm-3。常规清洗后将其放入 S-Gun 磁控反应溅射室内,在本底真空度达到 5.2×10-5Pa 时,再通入 Ar气后,分别溅射 15 nm Ni/2 nm W/15 nm Ni夹层结构。随后进行第一次快速热退火(RTA),温度为 600℃,时间 40 s,反应生成 Ni(W)Si薄膜。用 H2SO4和 H2O2煮 2 min,去除未反应的 Ni、W。最后在 600~950 ℃范围内对样品进行 40 s的第二次快速热退火。用四探针法测量 Ni/W/Si硅化物薄膜的薄层电阻,采用卢瑟福背散射(RBS)法分析金属 W 在其中的原子百分含量及其硅化物的厚度,并借助 Raman 光谱分析方法研究Ni/W 硅化物薄膜的相转变。使用 HP4156 半导体参数测试仪测量肖特基二极管的正反向特性。
3 结果和讨论
3.1 Ni(W)Si薄膜的薄层电阻
用四探针法测量经不同温度快速热退火后的Ni (W)Si薄膜的薄层电阻,结果如图1 所示。
由图1 可以看出,CapTi/Ni/Si结构经 600~700 ℃快速热退火后,该硅化物的薄层电阻为 3.0~3.2 Ω/□。当快速热退火温度升高到 750 ℃时,薄膜电阻就增大到 4.5 Ω/□,这个实验结果已被张慧等人报导[6]。而由夹层结构得到的 Ni(W)Si薄膜经受 600~800 ℃快速热退火后,薄层电阻比上述 NiSi的方块电阻要低,低阻值约为 2 Ω/□,此时硅片表面光亮,硅化物颗粒细密而且颗粒分布均匀;而当退火温度上升到 850 ℃时,虽然这时硅片表面仍然光亮,但硅化物表面开始粗糙不平且硅化物颗粒明显增大并出现结团的迹象,表明NiSi2开始形成。上述实验结果表明掺 W 的镍硅化物薄膜的热稳定性有了很大的改善,其薄层电阻由低阻转变为高阻的温度提高到 800 ℃以上。
3.2 Ni(W)Si薄膜的卢瑟福背散射(RBS)分析
为了较为准确地了解究竟有多少W参加了硅化反应,采用 RBS 确定在 Ni(W)Si薄膜中 W 金属的原子含量以及该硅化物厚度。其中 15 nm Ni/2 nm W/15 nm Ni/Si在 800 ℃快速热退火后的样品被用来进行 RBS分析。图2 给出了 RBS的实验结果:W 在金属中的原子含量为 7.3%,Ni(W)Si硅化物厚度约为 80 nm。

图2 15 nm Ni/2 nm W/15 nm Ni/(111)Si经 800℃快速热退火后的 RBS分析
3.3 Ni(W)Si薄膜的 Raman 光谱分析
用 Raman 光谱分析快速热退火后 NiSi和 Ni(W) Si薄膜中的物相组成。测试的样品是 30 nm Ni/Si分别经过 650 ℃、750 ℃、800 ℃快速热退火后的薄膜,和15 nm Ni/2 nm W/15 nm Ni/Si分别经历 650 ℃、800 ℃、850 ℃快速热退火后的样品。然后对它们形成的硅化物样品进行 Raman 光谱分析测试。Raman 光谱分析是在 Renishaw1000 谱线上进行的,使用的激光波长是633 nm。样品的 Raman 光谱如图3 所示。

图1 Cap Ti/Ni/Si和 Ni/W/Ni/Si形成的硅化物薄层电阻与快速热退火温度的关系曲线
对于 NiSi样品,图3(a)的拉曼光谱实验结果表明,对于 650 ℃、750 ℃快速热退火后的镍硅化物薄膜样品,在 215 cm-1和 195 cm-1左右位置附近都能够观测到有很强的 Raman 光谱峰,其中 215 cm-1处是 NiSi的峰[3,4]。而在 800 ℃形成的样品中,在 215 cm-1和195 cm-1位置附近并没有出现 NiSi的峰,相反在 290、380 位置上已经能够明显地看到有两个很强的高阻NiSi2峰,而这个现象在 650 ℃退火的样品中并没有发生,这说明硅化物已经完全转化成高阻 NiSi2。对于 Ni (W)Si样品而言,图3(b)的拉曼测试结果表明,经650 ℃和 800 ℃快速热退火后的镍硅化物薄膜样品,仍然在 215 cm-1和 195 cm-1位置发现 NiSi的存在,而且峰的强度很大;而 850 ℃快速热退火后的 Ni(W)Si薄膜,在上述两个位置并没有观测到 NiSi这两个峰,相反在 232 cm-1、297 cm-1、320 cm-1、402 cm-1左右出现了高阻 NiSi2峰。由此可见,650 ℃和 800 ℃退火生成的 Ni(W)Si硅化物只有 NiSi,而没有 NiSi2峰的存在,在 850 ℃退火生成的硅化物成分中,却已能探测到在该薄膜中存在着高阻 NiSi2。所以 Raman 光谱实验也证明了掺 W 能够延缓 NiSi2的形成,将形成 NiSi2的温度提高到了 800 ℃以上。

图3 (a)NiSi薄膜和(b)Ni(W)Si薄膜经不同温度快速热退火后的 Raman 光谱图
3.4 Ni(W)Si/Si肖特基势垒二极管电学特性
镍硅化物薄膜的热稳定性除了要考察薄层电阻的特性以外,它与硅接触的电学特性在器件和电路制造中也是非常重要的一个方面。采用的硅片材料为 n+型衬底,n 型外延,外延层厚度 9~10 μm,杂质浓度 5× 1015cm-3,晶向 <111>。器件面积为 210 μm×210 μm,结构为保护环结构肖特基势垒二极管。分别溅射夹层金属 15 nm Ni/1.5 nm W/15 nm Ni,在 600 ℃进行 60 s 第一次快速热退火,反应生成 Ni(W)Si并形成肖特基结。随后用选择腐蚀液去除未反应的 Ni、W。然后使其分别在 650 ℃、700 ℃、750 ℃、800 ℃四个温度下进行第二次快速热退火,退火时间 40 s。为考察 Ni(W)Si/Si肖特基二极管的电学特性,使用 HP4156B 半导体参数分析仪进行了正向和反向 I-V 特性的测试。图4 为具有保护环结构的 Ni(W)Si/Si肖特基二极管器件剖面图。

图4 具有保护环结构的 Ni(W)Si/Si肖特基二极管器件剖面图
图5 比较了 650 ℃、700 ℃、750 ℃、800 ℃四个温度下形成的 Ni(W)Si/Si肖特基二极管的 I-V 正向特性。
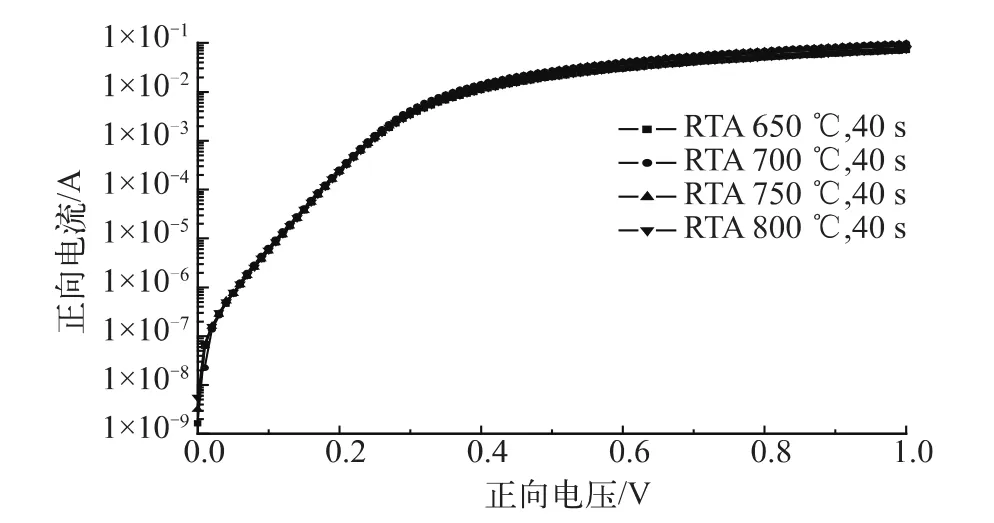
图5 不同温度快速热退火的 Ni(W)Si/Si肖特基势垒二极管正向 I-V 特性
由图5 可以求得 Ni(W)Si/Si肖特基势垒二极管的理想因子和势垒高度,结果如表1所示。
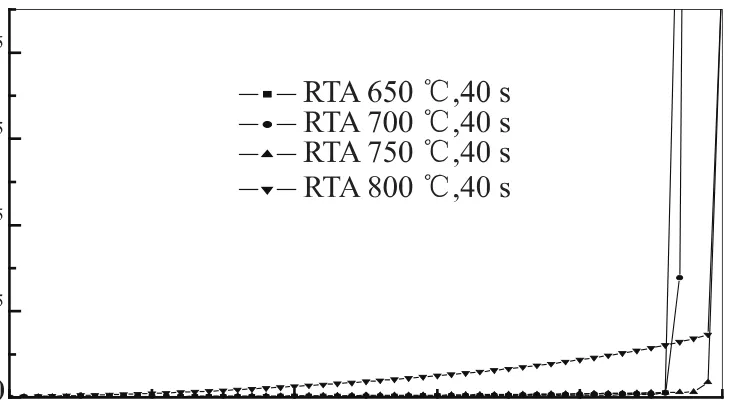
表1 经不同温度快速热退火的 Ni(W)Si/Si肖特基二极管的势垒高度和理想因子
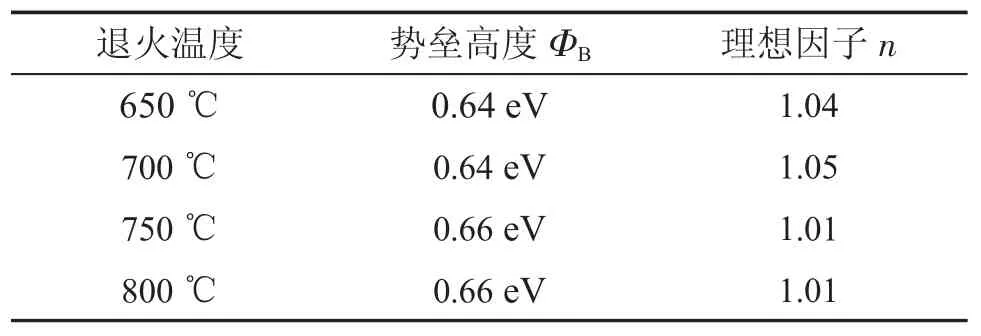
退火温度 势垒高度ΦB 理想因子n 6 5 0 ℃ 0 . 6 4 e V 1 . 0 4 7 0 0 ℃ 0 . 6 4 e V 1 . 0 5 7 5 0 ℃ 0 . 6 6 e V 1 . 0 1 8 0 0 ℃ 0 . 6 6 e V 1 . 0 1
可以看出,经 650~800 ℃等不同温度快速热退火的器件的势垒高度基本稳定在 0.65 eV 左右;理想因子在 1.00~1.04 之间。
图6 为 Ni(W)Si/Si肖特基势垒二极管经过 650~800 ℃快速热退火后的反向 I-V 特性。
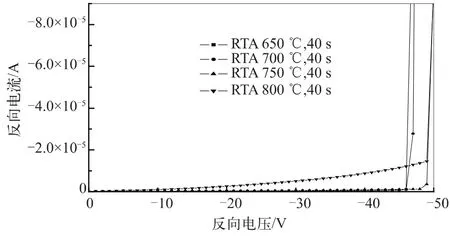
图6 不同温度快速热退火的 Ni(W)Si/Si肖特基势垒二极管反向 I-V 特性
从图6 中可以看到,器件经过 650℃、700℃、750℃退火后,击穿很硬,击穿电压在 45~49 V 左右,在击穿点漏电流的量级在 1 μA 左右;器件经过 800 ℃退火后反向击穿特性仍然较好,只是漏电流比 700 ℃、750 ℃退火的器件稍微大一点,在击穿点漏电流的量级在 30 μA 左右,击穿电压在 49 V 左右,击穿也较硬。究其原因,虽然 800 ℃退火后的 Ni(W)Si硅化物薄膜无高阻 NiSi2,但此刻低阻相 NiSi已开始结团,导致NiSi/Si肖特结界面变差,故反向击穿特性已开始褪化。而没有掺入 W 的 NiSi形成的 NiSi/Si肖特基结能够经受的最高退火温度为 650 ℃,超过这个温度则肖特基结的反向特性很差,漏电非常大,几乎没有结的特性。因此,在金属 Ni中掺入一定量的 W,对于所形成的镍硅化物热稳定性以及 Ni(W)Si/Si肖特基结的电学特性都有很大的改善作用。
4 结论
首次报导了在 NiSi薄膜中掺 W 能够使 Ni(W)Si薄膜的热稳定性提高。在 600~800 ℃温度范围内快速热退火后薄层电阻低,约为 2 Ω/□。Raman 光谱分析结果均表明,Ni/W/Ni/Si薄膜经 600~800 ℃快速热退火后,形成的 Ni(W)Si硅化物中只有 NiSi相而不存在NiSi2物相。因此掺 7.3%的 W 能够有效延缓 NiSi2的形成,使镍硅化物的薄层电阻由低阻转变为高阻的温度提高到 800 ℃以上,比没有掺 W 的镍硅化物的转变温度上限提高了 100 ℃。Ni(W)Si/Si肖特基势垒二极管能够经受 650~800 ℃不同温度的快速热退火,肖特基接触特性良好,肖特基势垒高度为 0.65 eV,理想因子接近于 1。因而 Ni(W)Si薄膜是一种性能良好的接触和局部互连材料。
致谢:
实验流片工作均在北京大学微电子研究院工艺实验室进行,谨对该工艺线上的技术人员和老师们的工作和指导表示衷心感谢。
[1]E G Colgan,J P Gambino,B Cunningham.Nickel silicide thermal stability on polycrystalline and single crystalline silicon[J].Material Chemistry and Physics,1996,46(2~3): 209-214.
[2]D Mangelinck,J Y Dai,J S Pan,S K Lahiri.Enhancement of thermalstability of NiSifilm on(100)Siand(111)Siby Pt addition[J].APPLIED PHYSICS LETTERS,1999,75(12).
[3]P S Lee,K L Pey,D Mangelinck,J Ding,D Z Chi and L Chan.New Salicidation Technology With Ni(Pt)Alloy for MOSFETs[J].IEEE ELECTRON DEVICES LETTERS, 2001,22(12):568-570.
[4]P S Lee,K L Pey,D Mangelinck,J Ding,D Z Chi and L Chan.Improved NiSi Salicide Process Using Presilicide N2+Implant for MOSFETs[J].IEEE ELECTRON DEVICES LETTERS,2000,21(12):566-568.

台湾稳懋砷化镓晶圆制造厂扩张产能 20%
台湾稳懋半导体是全球首座以六英寸晶圆生产砷化镓电路的专业晶圆代工服务厂。近期,稳懋完成了新一轮晶圆厂翻新扩张,对其第三家最新的晶圆厂(Fab C)配备最先进的净化间、工艺线和砷化镓微波集成电路(GaAs MMIC)生产设备,以及复合半导体外延生长、制造和光学检测设备。稳懋主要提供 HBT、pHEMT、集成 BiHEMT 方案和光学设备,用于功率放大器、WiFi、无线区域性网络基建和光学市场。产品线可满足 50 MHz到 150 GHz光波传输的广大应用。稳懋首席执行官表示,Fab C 的扩建还在持续进行,量产能力仍在不断提高,建设完毕后厂房面积达 65590 m2,产能是目前的2倍。 (编译 李星悦)
原 文 链 接 :http://www.semiconductor-today.com/news_ items/2017/may/win_110517.shtml
Studies of Electrical Properties of Ni(W)Si/Si Schottky Barrier Diode
SHIQinghong1,LIU Ruiqing2,HUANG Wei2
(1.Shenzhen SI Semiconductors Co.,Ltd.Shenzhen 518116,China;2.China Electronic Technology Group Corporation No.58 Research Institute,Wuxi214072,China)
In the paper,a noveltechnique ofadding a thin Winterlayerin the nickelfilm isatfirsttime proposed forbetterthermalstability ofnickelsilicide.After RTA temperature reaches about600~800 ℃,Ni(W)Sifilm exhibits low sheet resistances of less than 2 Ω/□.Raman spectral analysis shows that there exists only NiSi phase and no NiSi2phase in the Ni(W)Sifilm.The transformation temperature from low resistance phase to high resistance phase increases to 800 ℃ at least,100 ℃ higher than that of NiSi.The electrical properties of fabricated Ni(W)Si/Si Schottky Barrier Diode is satisfactory.The barrier height and the ideal factor of the devices are about0.65 eV and close to 1.Itfurther proves thatthe presence of Welementin Nickelsilicide is effective in promoting thermalstability and electricalproperties ofNickelmonosilicide.
Ni(W)Si;thermalstability;Schottky Barrier Diode;XRD;Raman spectralanalysis;RBS(Rutherford backscattering spectrometry);RTA(Rapid thermalannealing)
TN304
A
1681-1070 (2017)06-0041-04
石青宏(1973—),男,广东深圳人,1998 年毕业于电子科技大学微电子科学与技术专业,目前就职于深圳深爱半导体股份有限公司,主要从事半导体生产与管理工作;
刘瑞庆(1981—),男,山东高密人,2006 年毕业于南京理工大学电气工程及自动化专业,目前就职于中国电子科技集团公司第 58研究所,主要从事微电子预研工作。
2017-4-19

