高性能折叠I型栅无结场效应晶体管
高云翔,靳晓诗
(沈阳工业大学信息科学与工程学院,沈阳110870)
1 引 言
近年来,结合多栅极技术的无结场效应晶体管已经成为深纳米级硅基VLSI技术领域中最流行的半导体器件结构之一[1-2]。由于超薄硅膜SOI技术可以使栅极能够轻易控制沟道在完全耗尽状态下工作,因此器件制造不再需要PN结[3]。与常规的基于PN结的三栅极(TG)MOSFET类似,在关断状态下,三栅极无结(TG JL)FET的栅极电压反向偏置时会引起带间隧穿的增强,特别是在栅极角区域和栅极至漏极或源极的延长区,它极大地增加了由于带间隧穿所引起的泄漏电流,并在静态关断状态下导致了更高的功耗。
带间的隧穿几率与栅极角区域中最强的电场强度成比例。有很多种降低多栅无结场效应管在反向偏压下的电场强度的方法被提出,如栅极几何形状的优化[4-5]以及不同功函数和栅介质的多栅材料的应用[6-7]。实际上,对于纳米级短沟道器件来说,器件的开关特性如静态关断功耗、亚阈值摆幅和导通电流驱动能力之间存在权衡。纳米级器件设计的最终目标是通过器件结构优化在有限的给定芯片面积内实现最佳性能。为了实现优化的高性能器件,应该充分考虑栅极结构构造。因此,提出一种高开关特性的折叠I形栅极(FIG)无结场效应晶体管,以总共22nm的水平硅体长度(包括源极/漏极区域,栅极/沟道区域以及栅极/沟道区域与源极/漏极区域之间的空间)为例,通过Silvaco TCAD器件仿真对所提出的FIG JL FET的性能展开深入研究[8]。
2 折叠I型栅无结场效应晶体管结构
器件的整体结构如图1所示,由Silvaco TCAD仿真软件中的绘图工具绘制。图1(a)为折叠I型栅无结场效应晶体管的三维结构图;图1(b)和图1(c)分别为器件沿图1(a)的沿平面A和平面B切割的剖面图;图1(d)为图1(a)的俯视图。栅极结构的俯视图看起来像一个折叠的字母“I”,故此得名。I形的栅极结构增加了栅极对于沟道的作用面积,可以有效抑制由于沟道长度太短所引起的短沟道效应,减小泄漏电流。
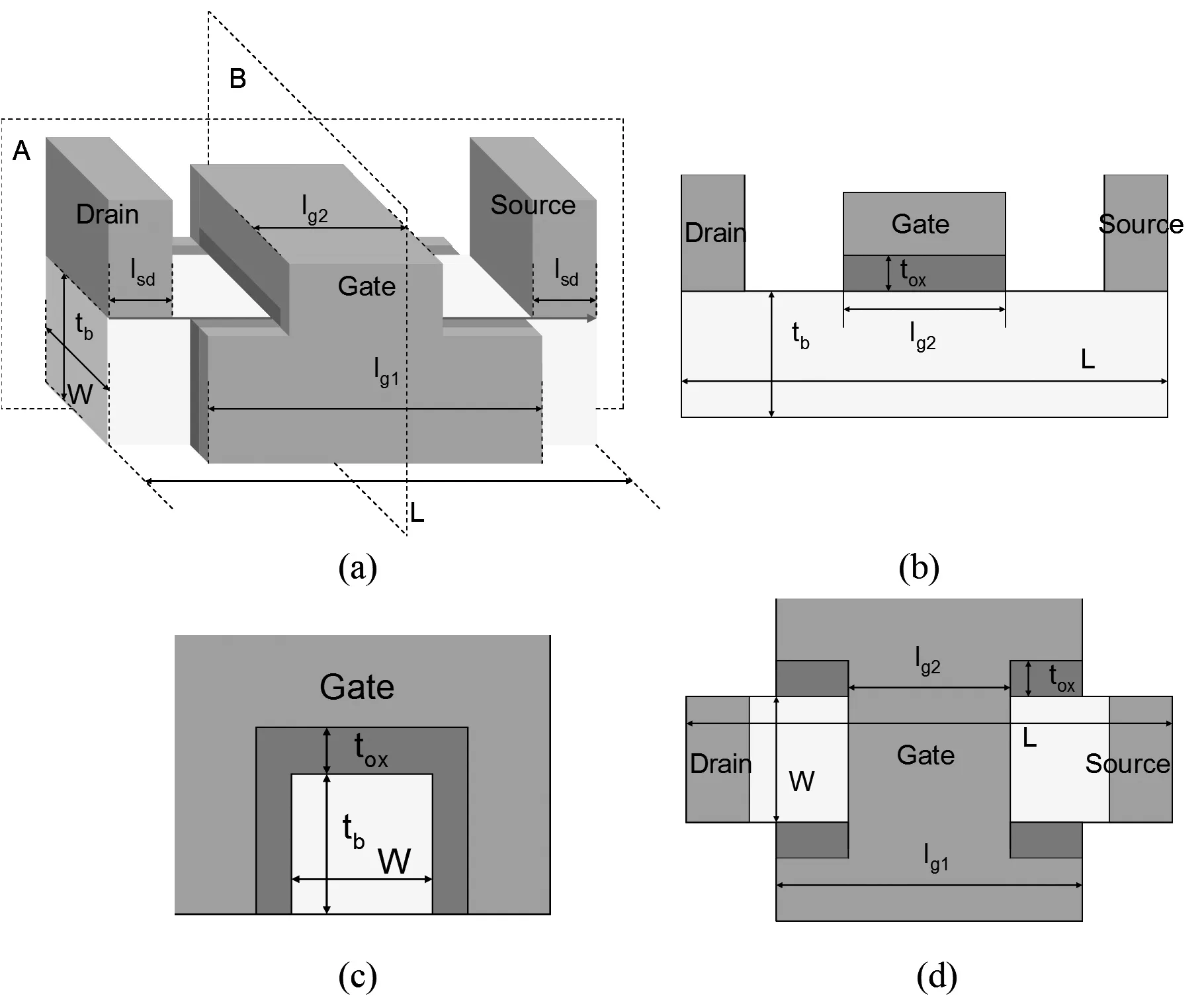
图1 折叠I型栅无结场效应晶体管器件结构图
图中,L为硅体长,tb为硅体厚,W为硅体宽,tox是栅极氧化层的厚度,lsd是源极/漏极的宽度,lg1是垂直部分的栅极长度,lg2是水平部分的栅极长度。下述仿真实验主要就是围绕这些参数展开的。
3 仿真与讨论
3.1 仿真设计
所用的仿真计算模型主要有Shockley-Read-Hall模型(srh),CVT 迁移率模型(cvt),俄歇复合模型(Auger),禁带宽度变窄模型(bgn)和标准带带隧穿模型(bbt.std)。在仿真过程中需要设定一些固定的参数,如图1中提到的W、tb、L、tox和lsd等,另外用ND表示硅体掺杂浓度,具体数值设置为:W=tb=6 nm,L=22nm,tox=1nm,lsd=2nm,ND=1×1018cm-3。通过TCAD器件仿真软件分析不同栅极长度所产生的影响。此FIG JL FET具体仿真参数设置如表1所示。

表1 FIG JL FET仿真参数
3.2 仿真分析
如图2(a)所示为折叠I型栅无结场效应晶体管的lg2从14nm至2nm变化时其对数曲线与线性曲线的IDS-VGS特性对比。图2(b)和图2(c)分别显示了在反向栅极偏置电压下的电场分布和在正向栅极偏置电压时从漏极到源极硅体和栅极氧化物之间的角接触面上的电子浓度。实际上,三栅无结场效应晶体管可以看作是lg2=lg1的一个特例。
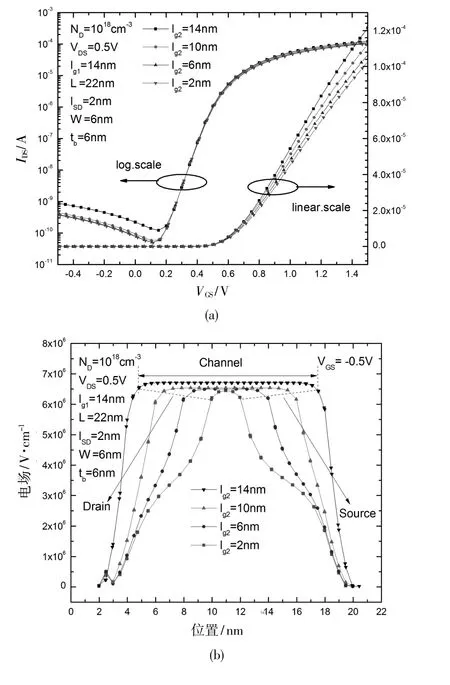

图2 仿真结果
从仿真结果图中可以看出,当lg2小于10nm时,关断状态下的泄露电流没有明显变化,然而,当lg2增加到14nm(栅极长度为14nm的三栅无结场效应晶体管)时,由于栅极角区域的长度不断增加以及漏极/源极电极和栅极电极之间的距离不断缩短,导致最强电场区域的扩大和增强。值得注意的是,折叠I形栅无结场效应晶体管的亚阈值摆幅不会随着lg2的缩短而改变。
如图2(b)所示,随着lg2的缩短,具有峰值电场强度的区域的宽度也随之缩短,这意味着具有足够高的用于带间隧穿电场强度的硅体的总体积通过缩短lg2而大大减小,与此相反,正向偏置电压下载流子浓度几乎不受缩短lg2的影响,如图2(c)所示。这也表明,与传统的双栅极结构相比,三栅极的优点是增强了栅极对于从源极到漏极方向中心部分的硅的控制能力,而不是靠近源极/漏极区域的部分。换句话说,所提出的折叠I型栅无结场效应晶体管结合了双栅无结场效应晶体管和三栅无结场效应晶体管的优点,它同时实现了如三栅结构一样更强的栅极控制能力和如双栅结构一样更小的栅极角效应。
3.3 优化改进
根据参考文献[2]、[3]中的优化方法,对折叠I形栅无结场效应晶体管做了进一步的优化调整。优化后的折叠I型栅无结场效应晶体管的三维结构如图3所示。当lg1=14nm,lg2=2nm时,改变栅极的垂直部分的长度,同时引进两个新的参数:tl定义为栅极上方垂直部分的边缘至低一层的垂直部分的边缘的长度,th定义为栅极的上方垂直部分的高度。首先,固定tl=6nm不变,改变th从0nm到6nm。实际上,当th=0nm时,相应的器件结构就是没有进行优化时的折叠I型栅无结场效应晶体管;当th和tl都为6nm时,相应的器件结构就是栅极厚度为2nm的三栅无结场效应晶体管。

图3 折叠I形栅无结FET优化结构图
图4所示为栅极长度为2nm的三栅无结隧穿场效应晶体管、栅极长度为14nm的双栅无结隧穿场效应晶体管和优化后的折叠I型栅无结场效应晶体管的IDS-VGS特性的线性曲线与对数曲线的对比。

图4 优化结构仿真结果
尽管不能同时得到最小的反向泄漏电流和最大的正向开启电流,但综合考虑73mV/dec的亚阈值摆幅和8×105的Ion-Ioff比等特性,相较于2nm栅极长度的三栅无结隧穿场效应晶体管 (SS=95mV/dec)和14nm栅极长度的双栅无结隧穿场效应晶体管 (SS=72mV/dec),折叠I型栅无结场效应晶体管已经通过优化得到了较大的改进。SS与14nm栅极长度的双栅无结隧穿场效应晶体管几乎相同,且反向泄漏电流水平在2nm的三栅无结隧穿场效应晶体管和栅极长度为14nm的双栅无结隧穿场效应晶体管之间,比栅极长度为14nm的双栅无结隧穿场效应晶体管低大约10倍。
4 结束语
对于这一新型的硅体长为22nm的折叠I形栅极无结场效应晶体管完成了在纳米尺寸下不同栅极长度所对应的IDS-VGS特性的仿真分析。可见反向泄漏电流与正向导通电流随着栅极长度增加而增大,但亚阈值摆幅不会随着栅极长度的变化而改变。通过栅极结构的优化,实现了折叠I型栅无结场效应晶体管电学性能的较大提升。与普通双栅无结场效应晶体管相比,该器件具有较高的正向导通电流和更低的亚阈值摆幅;与普通三栅无结场效应晶体管相比,其反向泄漏电流降低了约一个数量级,使它成为一种非常具有发展潜力的高性能器件。

