横向收集结构锗硅半导体雪崩探测器的设计研究
叶余杰,柯少颖,吴金镛,李 成,陈松岩
(厦门大学 物理科学与技术学院,福建 厦门 361005)
1 引 言
近些年来,由于光通信与量子通信的不断发展,近红外通信波段的弱光探测成为了研究热点。具有高内增益与外量子效率的半导体雪崩探测器(Avalanche Photodiode,APD)被认为是有希望实现低损耗,高效率的弱光探测的半导体探测器件,可广泛应用于光电通讯、生物检测、化学分析等各方面[1-6]。
近年来,关于Ⅲ~Ⅴ族半导体材料APD的研究已经取得了较大进展,例如InP/InGaAs[7-9]和InGaAs/InAlAs[10-11]APD等已经被广泛应用在近红外波段(主要是1 310 nm和1 550 nm波长)的探测中。然而,这些Ⅲ~Ⅴ族APD被较大的(指接近1)的空穴电子离化率比(k值)导致的较大过剩噪声所限制,很难进一步提升器件特性。锗材料制备的APD在近红外通信波段的探测能力也受到广泛关注[12-13],但是由于过大的暗电流以及接近1的空穴电子离化率比,使其无法作为倍增层材料。另一种IV族元素硅则具有很低的k值(<0.1),并且具有很好的暗电流以及倍增特性,使得硅被认为是一种很合适的倍增材料。但是硅材料不吸收近红外波段的光信号,纯硅APD探测器也无法满足通信需求。因此为了结合Ge、Si两种材料的优点,以Ge为吸收层,Si为倍增层制备的分离的吸收电荷倍增多层(Separate Absorption Charge Multiplication,SACM)结构成为了现在的研究热点,并被认为是有希望实现高效近红外弱光探测的器件。
传统的Ge/Si光电器件通常由外延生长的方法制备,尽管这种方法已经发展了很多年,但依然存在由Ge、Si材料间4.2%的晶格失配导致的外延Ge区域高穿透位错的问题[14-15]。从而使噪声较严重与暗电流特性较差。本课题组前期研究了一种有潜力的利用非晶锗(a-Ge)作为中间层实现Si/Si、Ge/Si低温键合的方法[16-18]。这种技术能够将高质量的体锗材料转移到硅衬底上,实现高性能硅基锗光电子器件的制备。
另外,传统的纵向SACM结构Ge/Si APD通常不能达到很高的带宽[19-21],这是由于在Ge吸收层中电场强度较低,导致载流子渡越时间较长,从而降低了3dB带宽。对于这一问题,减少Ge层厚度可以有效提升器件的频率响应特性,然而减少Ge层厚度会使整体电场上升,进而导致本征Ge吸收层中的电场过大,引起APD提前击穿。综上所述,现在的Ge/Si APD面临着要降低暗电流以及提高频率响应两个问题。
本文设计了一种新的基于无氧化层Ge/Si键合界面的横向吸收层结构。这种结构展现了一种特殊的电场分布,其包括横向电场(横向收集)与传统纵向电场(纵向雪崩)。通过添加间隙区域、调整掺杂浓度,边缘电场得到了很好的调控,并且提升了载流子的输运速度。优化后,得到了接近20 GHz的高3 dB带宽以及较低的暗电流。
2 结构设计与模拟参数
2.1 结构设计
图1(a)为本文设计的横向吸收结构锗硅APD。它主要由一块SOI与Ge材料键合制得。首先在N型掺杂的顶层Si层上离子注入形成一层100 nm左右的p型区作为电荷层,再与体Ge材料一起溅射2 nm厚度的a-Ge进行键合制得锗硅异质结结构,对Ge层利用smart-cut技术减薄后,进行光刻与刻蚀得到台面结构,最后通过离子注入形成高掺接触层得到器件结构。在仿真模拟中,将键合结构的晶体质量看作单晶体材料质量,设置为无穿透位错。本文也模拟了相同台面结构的纵向APD进行对比,其利用低高温两步法在Si衬底上外延生长Ge材料制备得到,因此模拟仿真时在Ge/Si界面处设置了100 nm的高位错低温Ge层(位错密度1016cm-3),其上为低缺陷的高质量Ge层(位错密度1012cm-3),如图1(b)所示。两者入光面积相同,输入光也相同,都为1 310 nm波长,-30 dBm(1 μW)总光功率。

图1 (a)横向吸收结构与(b)传统纵向SACM结构Ge/Si APD的结构示意图 Fig.1 Schematic diagrams of the (a)lateral-collection Ge/Si APD and (b)traditional vertical SACM Ge/Si APD
2.2 模拟参数
本文主要采用了TCAD Silvaco商用软件的atlas模块对APD器件性能进行仿真模拟,本工作中半导体光电特性方面的模拟主要基于对3个经典方程(泊松方程,连续性方程,以及输运方程)的运算。在本文模拟工作中,当需要计算温度依赖方程时,温度(T)统一被设定为300 K(室温)。响应度(R)被定义为I(g=1)/P,I代表光电流,g代表增益,P代表光功率。3 dB带宽被定义为10×log10(If/IM),If代表光电流作为响应频率的函数,IM代表最大光电流。Ge/Si APD的雪崩模拟基于Selberherr′s碰撞电离模型[22]。电子和空穴的离化率用以下方程表达:
an=ANexp[-(BN/E)BETAN] ,
(1)
ap=APexp[-(BP/E)BETAP] ,
(2)
式中,AN、AP是和晶格温度有关的参数,而BN、BP是和禁带宽度以及光声子平均自由程有关的参数,E是电场强度。对于硅材料,当E<4×105V/cm时,AN=7.03×105cm-1,AP=1.58×106cm-1,BN=1.231×106cm-1,BP=2.036×106cm-1。 当E≥4×105V/cm,AN=7.03×105cm-1,AP=6.71×105cm-1,BN=1.231×106cm-1,BP=1.693×106cm-1[22]。对于锗材料,AN=1.55×107cm-1,AP=1×107cm-1,BN=1.56×106cm-1,BP=1.28×106cm-1[22]。BETAN(βn)和BETAP(βp)都被设为1。硅材料中的电子和空穴饱和漂移速度被分别设置为1×107和7×106cm/s,锗材料中的电子和空穴饱和漂移速度被分别设置为7×106和6.3×106cm/s。[23]
3 模拟结果与讨论
3.1 Gap区域的添加
为了在横向收集结构Ge/Si APD中得到均匀分布的电场,并实现有效的近红外波段的吸收与雪崩倍增。需要考虑Si倍增层的掺杂浓度,在高掺n-Si与Ge/Si台面间的Gap区域以及Si倍增层的厚度。最初的设计结构参数和通常的纵向SACM结构类似,只是将高掺电子收集层横向设置并减少了Ge层厚度。其电场分布如图2(a)所示,可以发现电场主要分布在Ge台面区域的边缘,且最高强度已经超过了3×105V/cm,大大超过了Ge雪崩所需的电场强度,由图2(c)中的I-V曲线也可以看出,器件由于Ge层中电场过大出现了提前击穿的现象。这是由于将高掺n+-Si层横向设置后,原本纵向SACM结构中的电场平衡被打破,高掺n+-Si与Ge层更加接近,电场也主要由Ge层与n+-Si间形成的p-n结产生,然而,也由此产生了严重的边缘电场效应。
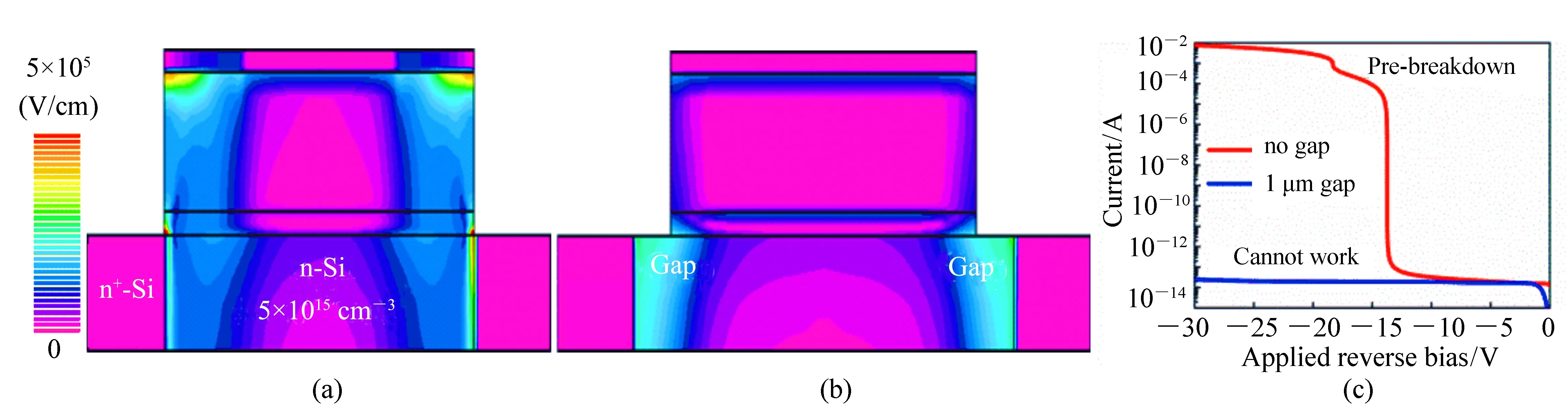
图2 30 V反向偏压下Ge/Si APD的电场分布图(线性坐标)。(a)最早设计的APD结构,其具有0.5 μm的Si层厚度,掺杂浓度为5×1015 cm-3。(b)在高掺Si层和台面间添加了1 μm Gap后的器件结构。(c)对应的I-V曲线 Fig.2 Electric fields of Ge/Si APDs at 30 V reverse bias in linear coordinates. (a)The original APD with 0.5 μm top Si layer(doping concentration of 5×1015 cm-3), (b)the optimized APD with a gap of 1 μm between the mesa and n+-Si layer, (c)I-V curves
为了改善最初设计中台面边缘严重的边缘电场效应,在台面与高掺n+-Si之间添加了一个gap区域,如图2(b)所示。可以看到,由于这个gap区域的加入,台面边缘的电场强度得到了极大的削弱。但电场分布依然局限在两侧,由于没能在Ge、Si层间形成均匀电场来引发有效的雪崩倍增,故不能正常工作。究其原因发现,这是由于Si倍增层是作为本征层模拟的,掺杂浓度只有5×1015cm-3,在p-Si电荷层与Si倍增层间的结效应非常弱,Si倍增层与n+-Si间的结效应也很弱,因此电场不能集中在Si倍增层区域。
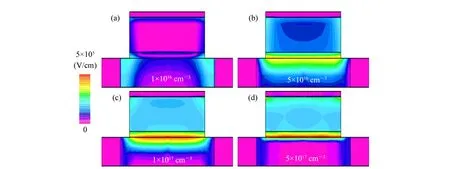
图3 30 V反向偏压下不同Si倍增层掺杂浓度的Ge/Si APD的电场分布图(线性坐标)。(a)1×1016 cm-3; (b)5×1016 cm-3; (c)1×1017 cm-3; (d)5×1017 cm-3 Fig.3 Electric fields (linear coordinate) of Ge/Si APDs with the doping concentrations of (a)1×1016 cm-3, (b)5×1016 cm-3, (c)1×1017 cm-3, and (d)5×1017 cm-3 at 30 V reverse bias
3.2 Si倍增层的掺杂浓度调整
根据上文的分析,尝试通过改变Si倍增层的掺杂浓度来调节APD中各结效应的影响。因此模拟了不同掺杂浓度的Si倍增层对电场分布的影响,如图3所示。可以发现,当掺杂浓度提升到1×1016cm-3时,由于纵向结效应的提升,电场分布有从两侧的gap区域向中间倍增层延伸的趋势。当掺杂浓度提高到5×1016cm-3时,电场不再主要分布于gap区域,而是在Ge层与Si层间均匀分布,类似传统的SACM结构中的电场分布。然而,当继续增加掺杂浓度到1×1017cm-3,Si层中的高电场分布区域减少,高场区延伸到Ge层中。最后,当掺杂浓度提高到5×1017cm-3时,电场几乎都集中在Ge层中。
不同掺杂浓度APD对应的I-V曲线如图4(a)所示。可见,随着掺杂浓度的提高,雪崩电压随之下降,这是由于Ge层中的电场强度提升,导致了Ge层中的载流子碰撞离化,形成提前雪崩。为了对比键合方法制备的器件与外延生长制备的器件性能,也模拟了低高温两步法键合制备的Ge/Si APD[24-25],发现相比于外延法生长制备的APD,由于穿透位错的降低,键合法能得到小得多的暗电流,有利于实现高效的近红外微光探测。

图4 (a)I-V曲线; (b)0 V偏压下的器件能带模拟图; (c)30 V偏压下的器件能带模拟图 Fig.4 (a)I-V curves, (b)energy band diagrams of devices at 0 V bias, and (c)at 30 V bias with different doping concentration of top Si layer
图4(b)展示了模拟得到的不同掺杂浓度下的APD能带图,可以观察到电荷层附近存在一个i-p--n-(Ge/Si/Si)双结结构。较低掺杂浓度的器件较高掺的器件展现出更高的导带势垒(~0.7 eV),Ge吸收层中的电子很难克服较大的势垒进入倍增层。另外,可以在图4(c)中看到,对于较低掺杂浓度的器件,即使偏压升高到30 V,势垒依然存在,因此中心区域无法得到高电场,只能被局限在台面边缘。图中也能观察到,一方面势垒高度随着掺杂浓度的提升而下降,这对于载流子输运是有利的;但另一方面Si倍增层中耗尽区的宽度也会随着掺杂浓度的提升而减小,这对于载流子的雪崩倍增是不利的,Si倍增层中需要形成一个足够大、足够强的电场才能使载流子通过碰撞离化过程倍增产生增益。除此之外,根据Ge/Si APD中的电场分布[19],Ge层中的电场也需要一个合适的范围(10~100 kV/cm),在保证载流子顺利输运的同时,避免发生碰撞离化而导致暗电流过高。最终,为了取得均匀分布的电场,将掺杂浓度设定为5×1016cm-3。
3.3 Si倍增层的尺寸影响
当确定了掺杂浓度对电场分布的影响后,再对倍增层的尺寸进行研究。图5展示了不同厚度Si层的APD的电场分布及其I-V曲线。可以看到,当Si层的厚度为300 nm时(图5(a)),Si倍增层的厚度太薄,无法达到完全耗尽所需的厚度,不能起到调节电场分布的作用,其I-V曲线也显示它不能正常工作。前文图3(b)中Si层厚度为500 nm,其电场分布的区域与强度相比于300 nm均有所优化,也实现了正常的雪崩倍增。当厚度继续提升到1 μm时(图5(b)),Ge层和Si层中的电场都变得更加均匀,呈现一种类SACM结构的电场分布,并且I-V曲线体现出的光响应度特性也有所提高。这表明倍增层厚度对于Ge/Si间结效应的增强与电场分布的调控有积极作用。但当厚度继续增加,大于1 μm时(图5(c)),电场分布和I-V曲线均未有明显变化。这是因为纵向和横向双结的作用区都主要集中在Ge/Si界面附近,Si倍增层中耗尽区之外的部分对器件功能影响较小。结合以上分析,将Si倍增层厚度设定为1 μm。

图5 不同厚度Si层电场分布示意图及其I-V曲线。(a)300 nm;(b)1 μm;(c)1.5 μm(d)I-V曲线 Fig.5 Electric fields(linear coordinate) of Ge/Si APDs with (a)300 nm, (b)1 μm, and (c)1.5 μm thick top Si layer and (d)corresponding I-V curves
另一个可能影响器件性能的倍增层尺寸参数就是gap区的宽度。如图6(a)所示,当gap区宽度为0 μm时,APD中显示出一种不均匀的电场分布,这是由于Ge台面靠近高掺N-Si区会导致APD提前击穿(这里没有给出I-V曲线)。直到gap区的宽度提高到1 μm时,该结构终于避免了提前击穿,类SACM结构的电场形成,变得可以实现正常雪崩。这表明需要一定的gap宽度从物理距离上削弱高掺N-Si与Ge台面的pn结效应。而随着gap宽度的增加,纵向电场分布几乎没有变化。这说明纵向电场分布与gap宽度变化是独立的。本文提取了不同gap区宽度的APD的横向电场,如图7(a)所示。可以看到,高场区在gap区达到1 μm时已经达到最大,再继续增大gap区域宽度,只是增加了低场区的范围,对载流子输运是不利的。图7(b)也表明了随着gap区宽度的提升,器件整体频率响应特性是下降的,1 μm时可以达到接近20 GHz的3 dB带宽,已经优于传统纵向结构的Ge/Si APD。

图6 不同宽度gap区电场分布示意图(对数坐标)。(a)0 μm;(b)1 μm;(c)2 μm;(d)5 μm Fig.6 Electric fields(logarithmic coordinates) of Ge/Si APDs with (a)0 μm, (b)1 μm, (c)2 μm, and (d)5 μm wide gap region

图7 不同宽度gap区的(a)横向电场分布和(b)对应的3 dB带宽 Fig.7 Lateral electric fields(a) and the related 3 dB-BW(b) of the APDs with different width of gaps
3.4 对器件3 dB带宽的分析
为了进一步分析设计的横向收集结构Ge/Si APD的高带宽特性。模拟计算得到了纵向SACM结构和该横向收集结构器件的主要载流子(电子)的速率分布,如图8(a)和8(d)所示。可以看出两种结构具有一定的相似性,高速区都集中在器件边缘,并且Si层的速率都高于Ge层。这是由电场分布以及不同材料的载流子迁移率共同决定的。

图8 纵向SACM结构APD的(a)电子速率;(b)电流方向(和电子输运方向相反)和(c)纵向电子速率分布;本文设计的横向吸收结构APD的(d)电子速率;(e)电流方向(和电子输运方向相反)和(f)纵向电子速率分布,插图中是横向速率分布 Fig.8 (a)-(c) The electron velocity(linear coordinates), direction of current flow(contrary to electrons transport) and vertical electron velocity curve in edge of SACM APD; (d)-(f)the electron velocity, direction of current flow and vertical electron velocity curve of proposed APD. Inset shows the lateral electron velocity
如上文所述,本文设计的基于键合技术制备的Ge/Si APD是横向收集载流子的。因此器件的频率响应特性需要重点考虑横向结构部分,比如gap区域。图8(d)就展现了器件中电子输运的速率分布,可以看到电子在连接本征Si倍增区和高掺Si收集区的gap区具有很大的速率。这会减少载流子在倍增层雪崩后到被收集的输运时间。这是由于改变参数后,p+-i-p--n-与n--n+双结的结效应有所提升,共同作用于gap区的结果。同时,图8(b)和8(e)通过展示器件中的电流密度矢量表明了两种器件中的电流方向与大小。这两幅图说明了载流子在该器件的Si层中是横向输运收集的,与传统SACM结构的纵向输运不同。更重要的是,可以看到在本文设计的APD中,载流子输运主要发生在台面边缘及两侧,而在SACM APD中则一般是在中间部分。这可以由独特的横向收集结构和边缘电场效应解释。由于n+-Si收集层设置在侧面即横向方向,而经过参数优化后载流子又会如同传统结构一样在Ge层中吸收后纵向输运到下方的Si层中雪崩倍增,载流子输运受到横向电场以及边缘电场的共同影响,路径集中在两侧,这极大地加速了载流子的输运过程。为了方便进一步讨论,本文提取出了两种不同结构的电子速率曲线,如图8(c)和8(f)所示。可以看到整体速率是横向结构高于纵向结构的。这是由于独特的收集结构导致输运路径在高速区。图8(f)中的插图展示了横向上的电子速率,可以发现在载流子输运集中的地方(gap区)具有很大的电子速率。这些结果表明了本文设计的横向吸收结构APD,其载流子输运路径和电场分布引起的高速区一致,比传统SACM结构具有更快的载流子输运速率,极大地减少了载流子输运时间,并提高了器件的3 dB带宽。
4 性能模拟与结果
在对设计的APD电场结构进行优化后,选择掺杂浓度为5×1016cm-3,厚度为1 μm的Si倍增层以及gap区域宽度为1 μm的器件进行测试。接下来选取了3组不同的Ge吸收层厚度(0.5 μm,0.6 μm,0.7 μm)来仿真测试器件性能,并验证器件在薄Ge吸收层下能否正常工作。
图9(a)展示了模拟得到的不同Ge吸收层厚度APD的I-V曲线,发现随着Ge吸收层厚度的增加,雪崩电压提升明显。这是由于Ge层中耗尽区域的增加导致相同偏压下整体电场强度的下降,需要更高的偏压才能满足Si倍增层所需的高电场。图9(b)展示了3 dB带宽特性的对比结果。可以明显看出,随着Ge吸收层厚度的增加,3 dB带宽不断减小。这是由于电子在Ge层中渡越时间增加。如表1所示,随着Ge吸收层厚度的增加,响应度也随之增大。为了实现高的3 dB带宽和响应,本文选择了0.6 μm的吸收层厚度,并模拟得到了19.6 GHz的3 dB带宽和0.7 A/W的响应度。同时对图1(b)所示的类似参数的纵向SACM结构进行了同样的模拟仿真,虽然在0.6 μm吸收层参数下取得了16.6 GHz的高带宽,但是由于吸收层厚度过薄,器件在雪崩后1 V内就击穿了,使得其无法正常工作。因此,对于传统纵向SACM结构的Ge/Si APD来说,很难简单地通过减少Ge吸收层厚度的方法来提高带宽。这是因为较强的纵向结效应容易导致Ge吸收层厚度降低,从而使Ge层中的电场强度过大,最终导致器件提前击穿。较好的SACM结构Ge/Si APD实验值由参考文献[24-25]给出,也列在表1中。
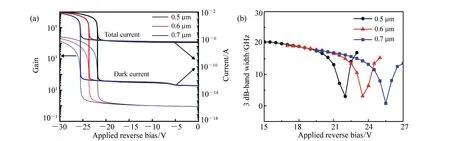
图9 不同Ge吸收层厚度(0.5 μm,0.6 μm,0.7 μm)模拟得到的(a)I-V曲线、增益和(b)3dB带宽 Fig.9 (a)I-V curves, gain and (b)3 dB-BW of devices with different Ge absorption layer thicknesses(0.5 μm, 0.6 μm, 0.7 μm) under an optical input power of -30 dBm at 1 310 nm

器件雪崩电压/V暗电流/A响应度/(A·W-1)3 dB带宽/GHz0.5 μm吸收层横向-21.8510-120.62220.4纵向在雪崩倍增前提前击穿,不能工作0.6 μm吸收层横向-23.6510-120.70119.6纵向-29.110-81.0516.60.7 μm吸收层横向-25.5510-120.77417.6纵向-30.110-81.213.3纵向APD[20]-2410-70.5513纵向APD[21]-2210-90.8513
5 结 论
本文设计并模拟优化了一种有潜力的、具有新结构的Ge/Si APD,将纵向的吸收-倍增和横向的载流子收集相结合。基于键合技术,高质量的体Ge和Si材料可以分别用于制备APD的吸收层和倍增层。研究发现Si倍增层的掺杂浓度对结效应具有显著影响,主导了纵向上类SACM结构电场的产生。在台面和高掺n+-Si间添加的gap区域有助于调控边缘电场效应。另外,Si倍增层的厚度也对器件性能具有一定影响,需要一定厚度才能保证完全耗尽。在经过结构优化后,最终仿真得到了具有0.7 A/W响应度,19.6 GHz 3 dB带宽以及10-12A暗电流的高性能Ge/Si APD器件。

