聚合物基电子封装材料的研究进展
刘佩东,胡晓丹,宋诗慧,钟奕宁,张海黔,常树全,张晓红
(南京航空航天大学材料科学与技术学院,南京 211106)
随着5G移动网络时代的到来,电子设备正逐步向着功率高,体型轻、薄、微小化的趋势发展。研究表明,电子元器件的使用寿命与温度有着密切联系,通常工作温度升高10 ~15℃,电子元器件的使用寿命就会缩短两倍[1]。高分子聚合物拥有廉价的成本和优良的绝缘性能,故被广泛用于电子封装领域。但大部分的高分子聚合物本征导热性能较差,热导率仅在0.1~0.5 W/(m·K)之间。一些特征线宽较窄的元器件工作时发热率可达150 W/cm2甚至更高,在高频工作时发热更加明显,普通的聚合物封装材料已无法满足微电子行业对散热的需求。因此开发高热导率、廉价的新一代电子封装材料对新型高性能电子元器件的开发具有重大意义。
在电子封装技术中,聚合物已成为主流的电子封装材料,这类聚合物材料应具备高散热性、高化学稳定性、高韧性以及低吸水性、低介电常数、低介电损耗性等性能。环氧树脂(EP)因其具有良好的粘附性、较低的介电常数、优异的电绝缘性能和低廉的价格等特点,常被用做电子封装基体材料。此外,以聚酰亚胺(PI)、聚二甲基硅氧烷(PDMS)、双马来酰亚胺树脂(BMI)、聚氨酯(PUR)、酚醛树脂(PF)、氰酸酯树脂(CE)等为基体的电子封装材料也在特殊的电子封装领域中得到广泛应用。
用于电子封装领域的聚合物材料按照制备工艺可大致分为本征型和填充型两大类。本征型是指聚合物在合成及成型加工过程中,通过改变其分子和链节的结构,达到提升材料导热性能的一种制备工艺。这种工艺可在保证材料优异的力学、电绝缘性能的同时,成百上千倍地提升材料的热导率。但该工艺较为复杂且成本较高,目前还未实现工业化应用[2]。填充型是指将聚合物作为基体材料,向其中添加高热导率的导热填料,从而起到增强导热性能的效果。填充型聚合物基复合材料因具有成本低、易加工等优点,是目前聚合物基电子封装材料制备最常用的工艺方法。
笔者介绍了聚合物基复合材料的分类及影响复合材料导热性能的因素,总结了提高聚合物基电子封装材料导热性能的途径,综述了国内外有关聚合物基电子封装材料的研究进展,并指出了未来该领域的研究重点。
1 聚合物的种类
聚合物种类的选择对电子封装材料的综合性能有着很大的影响。通常,用于电子封装领域的聚合物基体材料需要具备优良的电绝缘性、较高的热导率以及良好的力学性能等。图1为聚合物结构示意图[3],可见分子链规整排列的晶型结构区域和分子链随机纠缠的非晶型结构区域。聚合物的导热性能受其结构影响很大,分子链之间相互缠绕,声子散射程度增大导致高分子聚合物的热导率较低,常见的电子封装聚合物基体材料的导热系数见表1[4-6]。

图1 聚合物结构示意图[3

表1 常见电子封装聚合物的导热系数
1.1 EP
EP是一种常见的热固性树脂,具有优良的电绝缘性、抗氧化性、耐腐蚀性,并且价格低廉、易加工,是目前最主要的电子封装基体材料。但由于它自身结构的原因,EP固化后质脆、易产生裂纹,并且热导率较低,通常在0.17~0.23 W/(m·K)之间。为了保障元器件安全可靠的长时间工作,国内外学者对EP进行了大量的研究工作,使EP的热学及力学性能有了极大的提升[6-7]。
Ren等[8]通过在Al2O3表面沉积银纳米粒子(AgNPs),降低了EP的界面热阻,改善了EP材料的导热性能。当AgNPs质量分数为1.96 %时,复合材料的导热性能得到极大的提升,面外热导率为纯EP的1.43倍。Han等[9]以碳化硅(SiC)、氮化硼纳米片(BNNS)作为混杂填料添加到EP中,合成了EP/SiC/BNNSs复合材料,当填料质量分数为20%时,复合材料的热导率为纯EP的4.1倍,体积电阻率为2.32×1015Ω·cm,电击穿强度为22.1 kV/mm,表面电阻率为1.26×1015Ω,依然保持着优良的电绝缘性能。Wu等[10]将BNNS与AgNPs二元混合纳米填料加入到EP制备了EP/BNNS/AgNPs复合材料。AgNPs作为BNNS之间的“桥梁”有效地降低了填料间接触热阻,使复合材料的导热系数显著提高。当填料体积分数为25%时,复合材料的热导率为2.14 W/(m·K),较纯EP提高了近10倍。Liu等[11]将还原氧化石墨烯(rGO)包覆在Cu表面作为填料加入EP中,制备了EP/Cu@rGO复合材料。当填料质量分数为80%时,复合材料的热导率提高至7 W/(m·K),较纯EP提升了35倍。
EP难以自愈合和再加工的缺点限制了它在一些领域的应用,因此具有自修复能力的EP封装材料也是近些年来研究的一个热点。Yang等[12]制备了一种可回收、热导率高、可自愈合的EP/微米氮化硼 (mBN)复合材料,复合材料最高的热导率为1.058 W/(m·K),较纯EP材料提高了近4倍。当材料出现损伤时,复合材料可以通过酯交换反应实现有效的自我修复,且修复后拉伸强度能保持在原始复合材料的85%以上,表现出良好的自修复性能,为自修复电子封装领域带来了新的思路。
1.2 PI
PI是指主链上含有酰亚胺环的一类聚合物,通常是由二酐和二胺在有机溶剂中缩合得到的。它具有耐低高温、耐辐照、耐腐蚀、机械强度高、介电常数低等特点,是一种综合性能极佳的特种树脂,已被广泛应于电子封装领域和航空航天工业领域。
PI材料在微电子封装领域的应用已有近50年的历史,其主要应用有:芯片中α-粒子屏蔽膜、芯片钝化膜、电路层间介电绝缘膜、耐热硬质基板及柔性基板等[13]。由于PI自身的热导率较低,为了满足高导热性并且不降低材料综合性能的要求,需要添加一些绝缘高导热填料来提高PI的导热性能。Yang等[14]使用均苯四甲酸二酐(PMDA)、二氨基二苯醚(ODA)与六方氮化硼(h-BN)通过原位聚合的方法合成了PI/h-BN复合薄膜材料。通过扫描电子显微镜分析和水接触角测试结果显示,改性后的h-BN疏水性增加,促进了填料在PI基体中的分散性,使填料在基体中更容易形成导热通路,从而大大提升复合薄膜的导热性能。通过热力学表征结果可知,当h-BN的填充量质量分数为40%时,复合薄膜的导热系数为0.748 W/(m·K),较纯PI提升了近4.6倍,复合薄膜的热稳定性也有所提升。随着h-BN的加入,复合薄膜的体积电阻率虽有所下降,但仍保持良好的绝缘性能,因此可作为一种理想的电子封装材料。
PI作为一种综合性能优异的特种材料,在航空航天及辐射环境下的电子封装领域有着广阔的前景。但由于其韧性相对较差,限制了它的部分应用。因此,目前应用于电子封装领域的PI材料主要的研究重点是提高材料的韧性,开发具有低介电常数、介电损耗、高韧性、高热导率和高绝缘性的PI封装材料。
1.3 BMI
BMI 是一种高性能热固性树脂材料,具有与PI相似的耐高温特性,可在较宽的温度范围内保持较高的机械性能。由于BMI偶极损耗小,拥有优异的介电性能,因此被广泛应用于航空、航天、电子封装等领域[15]。Gao等[16]以h-BN和2,2′-二烯丙基双酚A (DBA)改性的4,4′-双马来酰亚胺二苯甲烷(BDM)树脂为材料,成功地制备出h-BN/DBA/BDM复合材料。材料拥有良好的绝缘性能、高热导率、低热膨胀系数和低介电损耗,是一种综合性能优异的新型复合材料。Tian等[17]通过构建氮化硼骨架(sBN)与BMI形成三维无磷的交联网络成功制备出一种具有高导热性能和阻燃性能的BMI/sBN新型树脂材料。当sBN的填充质量分数为12.53%时,复合材料的导热系数为1.53 W/(m·K),是纯BMI的9.4倍。在持续加热下sBN/BMI的燃烧强度较纯BMI明显减弱,且最大发烟密度降低了54.8%,综合性能得到了极大的提升。
由于BMI脆性较大,限制了其在电子封装领域的应用,因此需对材料进行增韧改性。增韧改性常用的方法有:共混改性法、共固改性法、扩链法、共聚法等。采用不同的方法引入柔性基团,降低BMI分子链的刚性和交联密度,最终达到增韧的目的[18]。丙烯基化合物共聚法是BMI增韧技术中最成熟的一种,陈宇飞等[19]使用3,3′-二烯丙基双酚A(BBA)、双酚A双烯丙基醚(BBE)作为活性稀释剂,聚醚砜(PES)和磺化聚醚醚酮(SPEEK)作为改性剂,与4,4’-二氨基二苯甲烷双马来酰亚胺(MBMI)多元共聚改性,并采用溶胶-凝胶法成功制备了MBMI/PES-SPEEK/Al2O3复合材料,材料的力学及耐热性能均得到了大幅的提升。
虽然目前已有诸多BMI增韧方法和技术,但仍然存在工艺复杂、耐热性能不足等缺点。因此研究新型增韧方法,制备高韧性的BMI复合材料仍然是该领域的研究重点。
1.4 PDMS
PDMS分子呈螺旋状结构,分子链上的甲基朝外排列并可自由旋转。作为一种有机硅树脂基体,这种独特的分子链结构使其具有优异的柔韧性、化学稳定性和热稳定性,同时它优良的绝缘性,是近年来柔性电子器件领域的理想封装材料[20]。
同大多数聚合物材料类似,由于PDMS自身的导热性能难以满足当前大部分器件的散热需求,因此需要通过添加导热填料来进行提升。Liu等[21]通过在PDMS基体中加入短碳纤维(SCF)和BN颗粒,采用旋涂法制备了一种柔性聚合物复合薄膜。当SCF与BN的填料量的质量分数分别为15%和20%时,复合薄膜的热导率为2.29 W/(m·K),较纯PDMS提升了近13倍。由于SCF具有优良的导电能力,加入基体后使得复合薄膜的体积电阻率及电击穿强度分别降至2.11×1014Ω·cm和12.5 kV/mm,但仍保持良好的绝缘性能,有望在柔性电子器件封装领域发挥重要的应用价值。
PDMS虽然具有上面提到的优势,但其断裂韧性较差,在有预裂纹情况下拉伸25%左右就会使材料发生破坏,这严重的影响了材料的可靠性。为了保证PDMS的力学性能与导热性能,Zhao等[22]向PDMS基体中加入石墨烯泡沫(GF)、碳纤维(CF)杂化填料,制备出PDMS/CF/GF复合材料。表征结果表明,当CF填充量质量分数为10 %时,复合材料的导热系数为0.55 W/(m·K),拉伸弹性模量和抗拉伸强度较纯PDMS分别提升了185%和63%,极大地优化了材料的导热性能及韧性,为开发高韧性高热导率柔性电子封装材料提供了新方法和新思路,使PDMS的应用领域更加宽广。
1.5 CE
CE是一种高性能的热固性树脂,具有低吸水率和良好的耐热性、耐湿性、阻燃性和优异的介电性能等,被视为微电子和航空航天领域最具应用前景的树脂基体。但较差的本征热导率限制了它在高性能电子封装材料领域的应用,因此通过添加绝缘高热导率填料来改善CE的热性能逐渐成为电子封装领域的研究重点。薛洁等[23]使用硅烷偶联剂KH560对SiO2和不同粒径的AlN进行处理,之后与CE共混成功制备出CE/AlN/SiO2复合材料。表征结果表明,不同粒径的AlN混合使用对复合材料导热性能的提升更加明显,当纳米AlN体积分数为3.35%时,复合材料的热导率最高。并且,由于SiO2的引入,复合材料的介电常数明显降低,进一步拓宽了其在电子封装领域的应用。胡明等[24]将纳米氧化铜(CuO)与CE和EP共混,制备了CE/CuO复合材料。表征结果表明,当纳米CuO的添加质量分数为10%时,复合材料的热导率为2.15 W/(m·K),弯曲强度和冲击强度分别提升了95.34%和62.24%。张有茶[25]将不同体积分数的h-BN作为导热填料分散在CE树脂基体中,固化后得到了CE/h-BN复合材料。当h-BN添加体积分数为18 %时复合材料的热导率提高至2.18 W/(m·K),是纯CE的19.8倍。频率为104Hz时复合材料的介电常数为2.3,介电损耗为0.075,此时复合材料的综合性能达到最佳。
CE是发展潜力巨大的新型电子封装材料基体,由于韧性不足限制了它的广泛应用。因此今后的研究工作应在增强CE复合材料导热性能时,还需注重材料韧性的提高,开发出性能综合性能更加优异的CE电子封装材料。
1.6 PF
PF是由酚类和醛类在一定条件下缩聚而成的树脂材料,具有低廉的价格、优良的力学性能、电绝缘性能和阻燃性等,在涂料、机械、电子电器领域得到了广泛应用。为了扩大PF在微电子封装领域的应用,王登武等[26]以镀银的碳纤维(Ag@CF)作为填料,与PF树脂搅拌混合成功制备出PF/Ag@CF复合材料。当填料填充质量分数为7%时,复合材料的热导率提高至1.25 W/(m·K),较纯PF提高了11.78倍。
由于PF分子空间位阻较大、链节旋转自由度小使得材料韧性较差。因此PF材料的增韧也是扩大材料应用领域的重要内容。通常提高PF材料韧性的方法主要分为添加外增韧剂、添加内增韧剂或添加增韧材料三种[27]。刘娟[28]通过加入PUR预聚体提高PF韧性,当PUR预聚体添加质量分数为5%时,PF力学性能较好,冲击强度和弯曲强度分别较未改性PF提高了67.1%和39.1%。
虽然目前国内外学者对PF材料增韧提出了许多手段,但增韧后复合材料仍具有固化脆性大、力学性能差等不足,因此今后相关研究应在注重增强材料韧性的同时,保证其优异的综合性能。
1.7 PUR
PUR是一种新兴的有机高分子材料,被誉为“第五大塑料”,因其卓越的力学性能常作为电子灌封材料被广泛使用。同其它树脂材料相同,PUR本征热导率较低,不能直接作为电子封装材料使用。因此,为了提高材料的导热性能,常与高热导率的填料进行复合。乔友健等[29]将改性后的纳米BN与rGO均匀分散至PUR预聚体中,经交联得到PUR/BN/rGO复合材料。当纳米BN与rGO的质量分数分别为10%和2%时,复合材料热导率为0.671 W/(m·K),较纯PUR提高了188%。与此同时,复合材料邵氏硬度提高了4.12%,磨损率降低了26.63%,材料的综合性能得到了进一步提升。赵瑾朝等[30]将二氧化硅包覆的多壁碳纳米管(SiO2@MWNT)作为杂化填料,通过溶胶-凝胶法制备了PUR/SiO2@MWNTs复合材料。当SiO2@MWNTs添加质量分数为1.0%时,复合材料的热导率提升至0.261 W/(m·K),较纯PUR提高了63.8%。SiO2包覆层不仅增强了MWNTs与PUR基体之间的相互作用,提高了填料在PUR中的分散性,还有效地阻断了电子流通。当杂化填料添加质量分数为1.0%时,复合材料的体积电阻率为9.6×1013Ω·cm,仍保持良好的绝缘性能。电子灌封材料还需具备良好的阻燃性,通常提高基体阻燃的方法有添加反应型阻燃剂和非活性阻燃剂两种方式[31]。杨再军等[32]使用球形Al2O3作为导热填料,加入液相阻燃剂后制备了一种性能优异的电子封装材料。复合材料热导率随着Al2O3添加量的增加不断提高,当添加质量分数达到67 %时,复合材料热导率为0.815W/(m·K),体积电阻率为4.3×10-13Ω·cm,阻燃等级达到UL94V—0级,综合性能达到最优。
热塑性聚氨酯(TPU)是一种性质介于橡胶与塑料之间的高分子材料,多用作橡胶的替代产品,是一种绿色环保材料。它具有加工性能好、力学、绝缘性优异等特点,被广泛应用于电子封装领域。为了满足电子封装领域更高的散热需求,李成磊等[33]将rGO作为导热填料通过原为聚合法制备了TPUR/rGO复合材料,表征结果表明,当rGO质量分数为1.0%时,复合材料性能最优,热导率为0.2242 W/(m·K),较纯TPU提高了近166%,拉伸强度提高41%以上。继续提高填料量会出现较为严重的团聚现象,且热导率不再提升。
PUR因其良好的综合性能备受研究者青睐,虽然近些年来通过添加填料的方式大幅提升了PUR材料的热导率,但对于如何改善填料在PUR基体中的分散问题还需研究人员继续拓展研究。
2 填料种类
填充型聚合物基复合材料导热性能的提升除了与基体自身的热导率有关,还与填料的种类、取向、表面处理以及复合材料的制备工艺等密切相关。
目前用于填充型聚合物基复合材料的常规填料主要分为氮化物和氧化物两大类,如BN、AlN、Si3N4、Al2O3、ZnO、MgO等。除了这两类常规填料以外,近年一些非常规导热粒子,如金刚石、石墨烯等,也逐渐进入人们视野。室温下常见填料的导热系数见表2。

表2 填料的导热系数[34]
2.1 BN
由于h-BN具有较高的本征热导率、优异的电绝缘性和较低的介电常数,使得它在填充型聚合物基复合材料中得到广泛应用。Gu等[35]通过混炼、热压工艺将h-BN与聚甲基乙烯基硅氧烷橡胶(MVQ)混合,制备了MVQ/h-BN复合材料。随着h-BN添加量的增加,复合材料热导率增大,当h-BN体积分数为40%时,复合材料的热导率提高到最大值,为1.11 W/(m·K),是纯MVQ材料的6倍。Liu等[36]以PI为基体,改性后的AlN和h-BN作为填料制备了两种复合薄膜材料。结果表明,当AlN的体积分数为9%时,PI/AlN复合材料的热导率为0.675 W/(m·K);当AlN与h-BN的体积分数分别为3%和6%时,PI/h-BN /AlN复合材料的热导率为0.771 W/(m·K)。复合薄膜热导率的升高可能是由于AlN与BN两种粒径不同的填料之间紧密填充,更有利于导热通路的形成。AlN与h-BN的体积分数为3%时,复合薄的拉伸强度损失较小,同时电击穿强度也提高到180 kV/mm,具有优良的导热性和绝缘性。
此外,h-BN还可通过剥离得到层数较少的BNNS,BNNS具有类石墨烯结构,又被称为“白色石墨烯”,拥有更高热导率、电绝缘性、热稳定性、低介电常数和介电损耗的BNNS引入聚合物基体中可使复合材料的综合性能大大提高[37]。Li等[38]将双面改性处理的BNNS作为填料加入到EP中,制备了EP/BNNS复合材料。通过材料表征结果可知,复合材料的热导率较纯EP提高了129%,介电常数也有所下降,材料仍保持优异的绝缘性能,是一种综合性能优异的电子封装材料。
BNNS高的比表面积可大大提高填料与聚合物基体的热接触面积,是制备高性能电子封装材料的重要填料。但BNNS的产率较低,因此研究如何提高剥离产率是该领域的研究重点。
2.2 AlN
AlN是一种共价化合物,晶体结构简单,晶格振荡谐和性高,较高的导热系数、低热膨胀系数和高电阻率使其成为电子封装材料中常见填料之一。Dai等[39]研究表明质量分数为1%的纳米AlN与EP形成的复合材料具有优异的电绝缘性和导热性。Chen等[40]以纳米AlN为导热填料制备了EP/AlN复合材料,当填料质量分数分别为0.5%,1%,2%时,复合材料的热导率较纯EP分别提升了37.2%,61.5%,65.7%。
但AlN较高的介电常数和较差的抗氧化性能限制了其在电子封装领域的应用,因此需要对AlN表面进行改性提高填料抗氧化性能和降低介电常数。张娜等[41]使用PF对AlN表面进行改性处理,当PF与AlN的质量比为1∶4时复合材料导热性能最佳。Zhou等[42]使用PI对AlN进行包覆得到Al@PI改性填料,之后与EP进行共混制备了EP/Al@PI复合材料。复合材料在质量分数为40%的填料填充下热导率提升至2.03 W/(m·K),较纯EP提升了10.6倍,极大地拓宽了其作为电子封装材料的应用。
2.3 Al2O3
Al2O3因低廉的价格和高导热、绝缘、高电阻率等性能在导热填料领域备受青睐,是电子封装领域使用最为广泛的陶瓷填料,其常见的形式是球形α-Al2O3。单一类型氧化铝填料与树脂基体复合时通常会出现界面粘结性不佳、分散性差等问题,不利于导热性能的提升且会影响材料的力学性能。周文英等[43]研究表明当填料添加量较高时,采用大粒径的Al2O3对复合材料导热性能改善更加明显;当填料添加量较低时,小粒径的Al2O3对复合材料导热性能的改善更加优异。施萍等[44]采用不同粒径的Al2O3作为导热填料制备了EP/Al2O3复合材料,当Al2O3体积分数为70%时,复合材料热导率为1.15 W/(m·K),且材料黏度适宜。邹德晓等[45]使用硅烷偶联剂对纳米微米级共混的Al2O3(micro@nano-Al2O3)进行改性处理,与EP体系进行混合成功制备出EP/micro@nano-Al2O3复合材料。相同填充量下,共混填料比单一粒径填料对复合材料的导热性能影响提升更加明显。当micro-Al2O3与nano-Al2O3的体积比为1∶5时,复合材料热导率达到最高值2.20 W/(m·K)。与此同时,复合材料仍保持优异的介电性能、热稳定性和绝缘性能。费川[46]等通过原位聚合法制备了PI/Al2O3复合材料,当Al2O3的质量分数为30%时,复合材料的导热性能得到了极大提升,导热系数提高至0.48 W/(m·K),较纯PI提高了2.4倍。
使用不同粒径Al2O3作为导热填料对复合材料的各项性能提升均有帮助,因此寻求更为合理的填充比是今后应持续关注的重点内容。
2.4 金刚石
纳米金刚石(ND)具有优异的化学稳定性、硬度、导热系数等,且由于其内部没有自由电子,因此也具有良好的电绝缘性能,同时大的比表面使其更易于进行表面修饰,从而提高它在基体中的分散性,近年得到了大量关注。图2为ND显微结构图[47],ND的热传导是通过晶格振动实现的,其特殊的结构可以使得声子的散射作用减小,从而提升其散热性能,使ND在高导热绝缘材料领域起着越来越重要的作用。由于ND价格昂贵产品成本过高,因此限制了其在导热填料方面的发展。
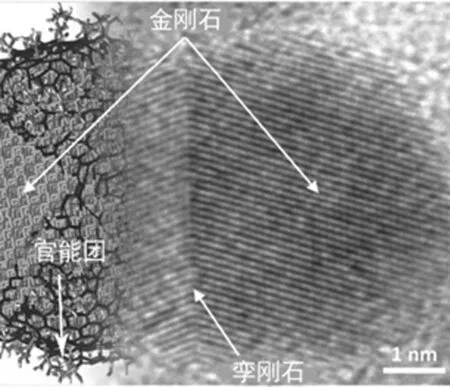
图2 纳米金刚石显微结构图
ND粒子可通过聚合物粘结剂使其之间直接接触,形成相互连接的散热网络。因此当使用ND作为填充型导热绝缘复合材料的填料时,可以使复合材料的热导率得到显著的提升[48]。为增强ND在聚合物中的分散性,孙明琪[49]通过共沉淀法将Fe2O3负载在金刚石表面,之后与硅凝胶共混,在外加磁场诱导下制备了具有定向排布结构的硅凝胶/金刚石复合材料。当金刚石的体积分数为14%时,复合材料的面外热导率为2.0 W/(m·K),较纯硅凝胶基体提升了437%。复合材料电阻率虽随着金刚石加入量的增加有所下降,但始终高于1011Ohmcm,具有良好的绝缘性能。 利用ND良好的电绝缘性能,将其与氧化石墨烯 (GO)、碳纳米管(CNT)等高热导率无机填料混合使用,在不影响绝缘性能的同时又能提高复合材料的导热性能。Zhao等[50]通过化学反应把ND颗粒包覆在CNT表面,制备出了碳纳米管-纳米金刚石 (CNT-ND)复合填料,并将其分散于EP内,得到了一种新型的导热绝缘复合材料。这种复合填料有效地增强了CNT-ND在EP中的分散度,同时ND与CNT之间彼此协同,强化了导热性能,在绝缘导热材料方向有着广阔的应用前景。
2.5 石墨烯
石墨烯是一种二维层状结构材料,单层厚度只有0.335 nm,是迄今为止材料界厚度最薄、强度最大、硬度最高、热导率最高的纳米材料,近些年成为最理想的导热材料及填料[51]。石墨烯较高的纵横比对复合材料的导热性能提升有极大的帮助,Chen等[52]研究了不同碳基填料负载对复合材料热导率的影响,结果表明,石墨烯在提高复合材料导热性能比其它碳基纳米填料更加显著。
由于石墨烯具有优良的导电能力,单独作为填料加入聚合物基体会大大降低材料的绝缘能力,因此石墨烯通常与其它电绝缘性能较好的填料杂化填充在基体中。这样既保证了聚合物材料的绝缘性能,又大幅提高了材料的导热能力。Guo等[53]使用BNNS和rGO作为杂化填料,在PI基体中组装形成微夹层结构,制备出了PI/BNNS/rGO复合材料。当杂化填料量体积分数为2.5%时,复合材料的热导率增加至1.49 W/(m·K),介电常数为579,材料依旧保持良好的绝缘性能。
目前石墨烯在使用中存在的最大问题是在聚合物基体中的分散性不高,导致复合材料不能发挥良好的性能,因此对石墨烯表面进行改性处理是未来研究的重要方向。
3 填料的表面处理
由于存在极性差异,大部分无机填料和有机聚合物基体之间难以相容,导致填料在加入聚合物基体后分散性较差,容易发生团聚,相界面处存在空隙及缺陷,从而增大了界面热阻,使复合材料的导热性能和部分力学性能降低,因此对填料表面的改性就显得尤为重要。
表面功能化是提高填充型复合材料填料与基体间界面结合改善其在基体中分散性的常用策略,主要分为共价官能化和非共价官能化两种。共价官能化改性是在填料的表面接枝一些极性基团,例如环氧基、羟基或羧基等,这些极性基团有助于填料与有机聚合物基体之间结合[54]。Li等[55]通过添加异氰尿酸三缩水甘油酯对GO进行接枝改性,制备了环氧基复合材料。当改性GO的质量分数为36.8%时,复合材料的热导率为1.091 W/(m·K),较纯酚醛环氧树脂提升了近25倍,改性后的GO对酚醛环氧树脂的导热性能及其它多种性能都有着积极的影响。非共价官能化改性是通是利用π-π键间的相互作用、静电相互作用、范德华力或氢键等物理作用,在填料表面包覆偶联剂或者其它高分子来实现填料的表面功能化,从而达到降低界面热阻的作用。Ye等[56]使用多面体低聚倍半硅氧烷的超支化聚乙烯共聚物(HBPE@POSS)对石墨烯进行剥离、功能化处理,借助共聚物与纳米片之间的CH-π非共价相互作用,使剥离出的石墨烯纳米片(GNPs)均匀地分散在PDMS基体中。当GNPs的填充质量分数为4.0%时,PDMS/GNPs纳米复合材料的导热系数达到0.93 W/(m·K),较纯PDMS高了约400%。
除了对填料表面功能化改性以外,对填料进行表面包覆也可以有效增加其在树脂中的分散性,同时为一些高热导率但电绝缘性差的填料的应用提供了思路。Shen等[57]使用二氧化硅包覆石墨烯纳米片(SiO2@GNPs)与PDMS基体结合,开发了一种新型的杂化纳米复合材料。PDMS/SiO2@GNP复合材料绝缘性能良好,热导率为0.497 W/(m·K),较纯PDMS提高了155%,且高于未使用二氧化硅包覆的PDMS/GNP复合材料。Li等[58]将被SiO2包覆的纳米铜作为填料,添加到EP中制备了EP/nano-Cu@SiO2复合材料。复合材料的热导率为2.9 W/(m·K),分别是纯EP和EP/SiO2复合材料的19倍和4.8倍,且电绝缘性能良好,应用于电子封装材料时显著提升了电子元器件的使用寿命。
填料在基体中的分散程度会直接影响到复合材料的各种性能,通过表面改性可以有效改善填料的分散性,因此新型高效的表面改性方法一直是填充型聚合物基复合材料研究的热点。
4 填料的填充方式
填料在基体中的取向性对复合材料的导热性能也有很大的影响。任何一种材料,无论它是极性还是非极性的,它都存在一定的介电性质,因此当处于外加电场、磁场中时会产生不同程度的极化。通过控制电、磁场使填料定向排布,可大大减少声子在该方向上的散射,从而提高复合材料的热导率。
王大鹏[59]利用外加电场制备了具有定向排布的EP/GO/ND复合材料,其热导率提升明显,最高为0.5 W/(m·K),较纯EP提高约150%。BN填料在外加电场的作用下,也可以有效地控制它的取向。Mi等[60]通过使用脉冲电压和外加电场,制备出具有良好取向性的EP/BN纳米复合材料,当频率为100 Hz时,纳米复合材料的热导率为0.588 W/(m·K),是普通EP/BN的2倍以上。Wu等[61]则是将GNPs与EP共混,之后放入交流电场使GNPs产生取向制备了EP/GNPs复合材料,当GNPs体积分数为1.08%时,复合材料热导率为0.45 W/(m·K),较纯EP提高了60%,而未取向的EP/GNPs复合材料热导率仅为0.412 W/(m·K)。
磁场诱导取向是指填料在磁场作用下在基体中形成的取向,相较于电场诱导,磁场诱导的应用相对较少。Chung等[62]在磁场诱导的作用下,将Al2O3-Fe3O4杂化粒子加入EP中制备了EP/Al2O3-Fe3O4复合材料中。通过表征发现填料在基体中呈线性有序排列,极大地提高了复合材料的导热性能,较随机分散填充的复合材料导热系数提高了240%以上。Kim等[63]利用外加磁场成功地将Fe3O4-BN杂化填料垂直定向分散在EP中,填料的含量影响了颗粒的分散和排列,当复合填料体积分数为30%时,复合材料的热导率从1.765 W/(m·K)提高到3.445 W/(m·K),是随机取向复合材料的1.96倍。
可以看出,填料具有取向性的复合材料导热性能要远远高于填料随机排布的复合材料,因此寻找高效、廉价、工艺简单的填料取向方法是填充型聚合物基复合材料未来研究的重要方向。
5 结语
从国内外近年的研究中可以看出,填充型聚合物基复合材料的性能主要受聚合物种类、填料类型、填料的表面改性和填充方式影响,其中最重要的是填料需在基体中形成连续的导热通路。随着集成电路技术的不断发展,高性能电子封装材料对散热提出了更高的需求,聚合物基封装材料还面临着诸多挑战,未来研究重点将会在以下几方面展开:
(1)研究如何在低填充量下获得综合性能优异的填充型聚合物基复合材料。
(2)研究新型的材料增韧方法,在保证材料力学强度和导热性能的同时进一步提升材料韧性。
(3)研究更贴近实际情况的导热理论模型,更加准确地预测复合材料的热导率。
(4)改善填料在聚合物基体中的定向有序性及分散性,开发新型的填料改性方法和复合材料制备工艺。

