光栅参数测量技术研究进展
刘洪兴,张 巍,巩 岩
(1.中国科学院长春光学精密机械与物理研究所,吉林长春130033;2.中国科学院研究生院,北京100039)
光栅参数测量技术研究进展
刘洪兴1,2,张 巍1,巩 岩1
(1.中国科学院长春光学精密机械与物理研究所,吉林长春130033;2.中国科学院研究生院,北京100039)
光栅参数测量技术是衡量光栅制作水平的重要标准。本文从直接测量法和间接测量法两个角度对现阶段较成熟的光栅参数测量技术进行了研究。重点介绍了原子力显微镜(AFM)测量法、扫描电子显微镜(SEM)测量法、激光衍射(LD)测量法以及散射测量术的测量原理和研究进展,指出了这些方法各自的优缺点和适用范围。AFM测量法和SEM测量法均可测得光栅的局部形貌信息,可用于检测光栅表面形貌缺陷;LD测量法和散射测量术反映的是激光照射区域的平均结果,其中LD测量法能得到光栅周期参数,而椭偏测量术能得到光栅周期以外的其他形貌参数。这些方法测得的光栅参数结果比较吻合,其中LD测量法不确定度最小,AFM次之,SEM最大。文章最后对未来光栅参数测量技术的发展方向进行了论述。
光栅;光栅参数测量;原子力显微镜;扫描电子显微镜;激光衍射仪;椭偏仪
1 引 言
与棱镜分光相比,光栅作为分光元件,具有色散本领高、体积小、重量轻的优点,是各种光谱仪器的核心元件,已广泛应用于航天遥感、石油化工、医药卫生、食品、生物、环保等国民经济和科学研究的各个领域中[1],如VCD、DVD光学头、各种激光器、航空遥感成像光谱仪、天文望远镜、光谱分析仪器、光栅干涉仪以及相位延迟器、各种玻片、光栅偏振器等。光栅的分类繁多,按照折射率的调制方式可分为浮雕光栅和体积位相全息光栅,浮雕光栅是通过均匀材料的表面轮廓周期性变化调制折射率,而体积位相光栅是靠光栅材料体内折射率周期变化衍射光。
随着光栅制造技术的不断发展,对光栅参数测量精度的要求越来越高。广义上讲,影响光栅衍射效率、分辨率、杂散光[2]等的所有内部因素都称为光栅参数,包括光栅常数、光栅层的复折射率、槽形等等。不同类型的光栅对各种光栅参数要求不同,亚波长结构光栅可近似看成具有等效折射率的各向异性材料薄膜,其位相大小取决于等效薄膜的厚度和折射率,因此对光栅折射率、槽深和槽形非常敏感;而周期尺寸较大的透射黑白光栅可采用标量衍射理论处理,其衍射效率主要取决于单缝衍射因子和缝间干涉因子,因此只需考虑单缝宽度、光栅常数和光栅面积[3]。测量光栅参数的方法有多种,本文将其分为两类:直接测量法和间接测量法,直接测量法主要是借助相关的仪器直接确定光栅参数;而间接测量法是先得到相关仪器的测量量而不是光栅参量,通过对测量量进行公式计算或者数据反演再得到光栅的各个参数。直接测量法一般包括:微型探针法[1]、原子力显微镜(Atomic Force Microscopy,AFM)测量法[4~6]和扫描电子显微镜(Scanning Electron Microscopy,SEM)测量法[5,7]等。直接测量法可以测量光栅形貌参数,其中探针法属于接触式测量,AFM测量法分为接触模式、非接触模式、点拍模式和侧向力模式;SEM测量法属于非接触式测量。间接测量法包括:激光衍射(Laser Diffraction,LD)测量法[4~6,8~10]、散射测量术(Scatterometry)[12~18]、分光计测量法[11]、透射光谱测量法[19,20]、衍射能量比测量法[21,22]、CCD 测量法[23]等。在众多光栅参数测量技术中,AFM测量法、SEM测量法、激光衍射测量法和散射测量术由于测量精度高和技术相对成熟而备受关注,本文将重点介绍此4种测量技术。
2 直接测量法

图1 原子力显微镜原理图Fig.1 Simplified schematic of AFM
2.1 原子力显微镜测量法
1986年,Binnig与斯坦福大学的Quate以及IBM苏黎士实验室的Gerber等人在扫描隧道显微镜(STM)基础上发明了原子力显微镜(AFM)。其原理如图1所示。把对微弱力特别敏感的悬梁臂一端固定,悬梁臂另一端有一探针,针尖的原子与样品表面的原子发生原子作用力,使悬梁臂发生形变,利用光学检测法或隧道电流检测法测出形变大小,从而得到原子作用力大小。通过反馈控制悬梁臂或样品上下运动使扫描时针尖原子与光栅表面原子的原子作用力恒定,实现光栅形貌参数测量[24]。
用原子力显微镜测量光栅表面的形貌,从而得到光栅周期,槽深和槽型等光栅参数,测量精度高,适用于反射光栅、黑白透射光栅等浮雕光栅的测量。目前商用 AFM的横向分辨率能达到0.2 nm,纵向分辨率能达到0.1 nm。AFM的横向分辨率很大程度由探针的纵横比以及尖端的曲率半径决定,如图2所示。侧壁陡直的光栅槽型对探针的纵横比要求很高,硅或者硅化合物探针针尖是锥形的,一般曲率半径为5~40 nm,如图3所示。由于探针有一定的宽度,因此在横向测量一个分子时会出现所谓的“加宽效应”,碳纳米管具有小的曲率半径(0.5~2 nm)、较高的纵横比和很高的柔软性,适合作为高分辨率AFM探针针尖,图4为碳纳米管针尖的扫描电子显微镜图,碳纳米管的长度约为450 nm。目前,文献[25]采用Veeco D3100型AFM分别测量侧壁角为72°和74°的闪耀光栅,得到了很好的结果。原子力显微镜测量速度比较慢,并且受仪器本身结构的影响,其扫描范围也有一定的限制,如瑞士Nanosurf公司Nanite AFM扫描范围为110 μm×110 μm。

图2 针尖与AFM测量横向分辨率的关系Fig.2 Relationship of lateral resolution and tip
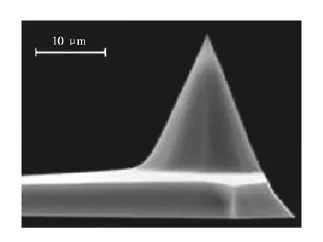
图3 硅AFM扫描探针Fig.3 Si AFM scanning probe

图4 碳纳米管针尖Fig.4 Carbon nanotube tip
2.2 扫描电子显微镜测量法
1942年,剑桥大学的马伦制成世界第一台SEM。SEM的工作原理是依据电子与物质的相互作用来研究样品形貌,即用极狭窄的电子束去扫描样品,通过电子束与样品的相互作用产生各种效应,发射出二次电子、俄歇电子、特征X射线和连续谱X射线、背散射电子、透射电子,以及在可见、紫外、红外光区域产生的电磁辐射,通过研究各种效应(主要是二次电子成像)来获取被测样品的各种物理、化学性质的信息,如形貌、组成、晶体结构、电子结构和内部电场或磁场等等。SEM测量光栅原理图如图5所示。采用扫描电子显微镜正常模式(Top-down Mode)测得光栅形貌图像,经过分析处理即可得到光栅常数、槽型等信息[5,7];另外可以采用横截面模式(Cross-section Mode)测量一维光栅与栅线方向垂直的横截面,得到一维光栅完整的槽型信息[7],但是将光栅切出横截面的操作是不可逆的。SEM具有高分辨率的优点,适用浮雕光栅光栅参数的测量。
1972年,第一台SEM分辨率为40 nm,现在常用热钨灯丝SEM分辨率达到3.0 nm,新一代的场发射SEM分辨率优于1.0 nm,而超高分辨率SEM分辨率高达0.5~0.4 nm。大部分SEM要高真空环境,并且有时样品需要进行镀膜处理。不过,最新的环境SEM可以做到真正环境条件工作,可在100%湿度条件下观察样品,生物样品和非导体样品不需要镀膜,可直接进行动态观察和分析。SEM能够得到完整的槽型信息,并且能够给出底切(Undercut)侧面细节,这是原子力显微镜所不能做到的,如图6所示。SEM设备的不断更新为光栅参数测量提供了强有力的技术支持。

图5 扫描电子显微镜示意图Fig.5 Diagrammatic sketch of SEM method

图6 SEM照片Fig.6 SEM figure
2.3 其他方法
除上述AFM测量法和SEM测量法外,直接测量法还包括微型探针法,它不仅能测量光栅槽型,而且可以测量表面粗糙度,基本原理如图7所示。触头的位置变化引起电感式位移传感器电感的变化,从而得到表示触头高程位置的电信号,此信号经过放大,由滤波器滤去高频率的幅值。然后,经功率放大,控制记录仪笔位移,获得由触头高程决定的笔的精确位置。英国 Taylor-Hobson公司生产这类粗糙度测量仪,为了方便光栅形貌测量,该仪器特制了直径只有0.1 μm的触头,在最高放大倍数时,其分辨率可达0.5 nm。与AFM和SEM一样,微型探针法也适用于浮雕光栅的测量。微型探针法的缺点是即使在不大的测量正压力下,较松的的铝膜也会产生损伤,这是接触式测量的通病。

图7 微型探针法原理图Fig.7 Simplified schematic of minitype probe method
3 间接测量法
3.1 激光衍射(LD)测量法
光的衍射是一种常见的现象,LD测量法就是利用光的衍射规律来测量光栅周期,它具有非接触、非破坏性等优点。图8为光栅自准直设置图。

图8 光栅自准直设置图Fig.8 Littrow mounting of grating
此时,入射光线与第m级衍射光线共线而反向,衍射公式为:

因此光栅周期为:

LD测量光栅的原理如图9所示。由激光器发出的激光经反射镜、分束器后投射到光栅上,激光将沿不同方向发生不同级次的衍射,通过角度调整台调整光栅倾斜角度α使得m级次(通常是1级)衍射光满足自准直设置。自准直的判断标准探测器接收到信号强度是极大。原理图中分束器起半透半反的作用,探测器只接收衍射光的被分束器反射部分,然后利用公式(2)即可计算光栅常数。

图9 激光衍射测量法原理图Fig.9 Simplified schematic of LD method
LD测量法原理和数据处理简单,测量结果和AFM测量法测量结果相吻合,并且LD测量法的不确定度更小。但LD测量法只能得到光栅周期参数,无法得到光栅的槽型和槽深等信息,仅适用于反射光栅的测量。另外,LD测量法需要标准的激光光源,并且可测光栅周期的范围受到激光波长的限制[4,5],因此寻找更短波长的标准激光光源是LD测量法提高测量精度的重要研究方向。
3.2 散射测量术
散射测量术测量光栅参数常用到的仪器是椭偏仪(Ellipsometer)或反射计(Reflectometer)。椭偏仪测量光栅参数称为椭偏测量术[3],图10为双旋转补偿型椭偏仪测光栅参数原理图。
用椭偏仪测得光栅样品的椭偏参数 Ψm和Δm,假设Eip和Eis表示入射光的两个电场分量,p代表平行于入射面,s代表垂直于入射面。采用光栅矢量衍射理论(如严格耦合波法和模式理论等)分析光栅可以得到0级衍射光(反射光)的两个电场分量Erp,Ers。因此,两个电场分量的反射率和它们与椭偏参数的关系由下式得到:

图10 椭偏法测光栅原理图Fig.10 Simplified schematic of ellipsometry

其中,Ñ为光栅层的复折射率,d代表光栅常数,h代表光栅槽形参数。式(6)为椭偏参数Ψm和Δm与光栅材料参数Ñ和光栅形貌参数d,h之间的关系式,由于式(6)是一超越方程组,因此无法得到光栅常数d和槽深h等参数的解析解,无法用优化算法[26](如模拟退火算法,遗传算法等)对椭偏参量反演得到光栅参数。
椭偏法也是一种非接触式测量,它不仅可以反演出光栅常数,槽形等形貌信息,而且可以反演得到折射率等光栅材料属性;椭偏法不仅适用于浮雕光栅的测量,也适用于体积位相全息光栅的测量;另外,由于对被测对象所处的环境条件要求不苛刻,椭偏法适合于现场测量,具备实时测量的潜力。椭偏法可以测量结构复杂光栅,图11为文献[15]椭偏法所得光栅形貌(9个形貌参数)与SEM结果的对比。椭偏法的缺点是反演比较繁琐,对矢量衍射理论和优化算法的选择以及计算机的性能要求比较严格,因此光栅矢量衍射理论以及优化算法的研究是提高椭偏法测量光栅速度和精度的重要研究方向。

图11 扫描电镜与椭偏法对比Fig.11 Comparison of results between SEM and ellipsometry
3.3 其他方法
除上述LD测量法和散射测量术外,间接测量法还包括透射光谱测量法、分光计测量法、衍射能量比测量法[21,22]、CCD测量法等。其中分光计测量法是利用光栅方程来计算光栅常数,它是大学物理实验最常用方法,适合于黑白透射光栅光栅常数的测量;透射光谱测量法和衍射能量比测量法与椭偏法相似,不同点在于椭偏法用到的是0级反射光反射系数,而透射光谱测量法用到的是光栅的透射系数,衍射能量比测量法则是用到不同级次衍射光衍射系数的比值,然后建立光栅参数与透射系数或者衍射系数比值之间的关系,最后通过优化算法数据反演得到光栅形貌参数,它们既可以用来测量浮雕光栅也可用来测量体积位相全息光栅,文献[21]是利用反射光谱能量比反演得到体积位相全息光栅材料的折射率以及光栅层厚度等参数;CCD测量法则是利用标量衍射理论计算衍射±1级光斑与主极大光斑能量比得到与光栅常数有关的信息,鉴于标量理论的局限性,该方法具有很大的局限性。CCD测量法目前只是进行了理论研究,未见实验验证。
4 结 论
本文综述了国内外现阶段应用的光栅参数测量技术,重点介绍了AFM测量法、SEM测量法、LD测量法和散射法的测量原理、应用范围和发展趋势。
AFM和SEM两种直接测量方法均可测得光栅的局部形貌信息,因此可用于检测光栅表面缺陷形貌。其中,AFM测量法不仅可以测量金属光栅,也可测量介质光栅,是对扫描隧道显微镜(STM)功能的扩展,既可以选择接触式测量模式,也可选择非接触式测量模式以及点拍式,对测量光栅造成极小或者没有任何损伤,而SEM在横截面测量模式下对测量光栅切出横截面的操作可产生不可逆的破坏,但是SEM可以测得陡直侧面以及底切侧面细节,这是对AFM测量法的很大改进。
LD测量法和散射测量术两种间接测量方法测量结果反映的是激光照射区域的平均结果,其测量结果更加精确,不确定度相比AFM和SEM更小,但是两者不能用于光栅局部参数测量。LD测量法数据处理简单,能得到光栅周期参数,由于测量中需要光栅旋转,该方法不适合现场测量。椭偏测量术可以得到光栅周期以外的其他形貌参数,另外,该方法适合于现场测量并具有实现实时在线测量的潜力,但是椭偏测量术测量光栅数据反演相对繁琐。
文献[4]和[5]比较表明,AFM测量法、SEM测量法和LD测量法测量光栅常数的结果吻合,LD测量法不确定度最小,AFM次之,SEM最大。
随着光栅制造技术的不断进步,光栅结构越来越复杂,刻线越来越密,这也对光栅参数测量精度要求越来越高,另外,光栅加工和检测同步性的需求使得实时在线测量是未来光栅技术的另外一个研究重点。总之,随着光栅参数测量技术不断创新发展,高精度仪器将不断问世。
[1]祝绍箕,邹海兴,包学诚.衍射光栅[M].北京:机械工业出版社,1986. ZHU SH J,ZOU H X,BAO X CH.Diffracted Grating[M].Beijing:China Machine Press,1986.(in Chinese)
[2]巴音贺希格,李燕,吴娜,等.紫外平面刻划光栅杂散光数值分析及测试[J].光学 精密工程,2009,17(8):1783-1789.Bayanheshig,LI Y,WU N,et al..Numerical analysis and measurement of stray light from UV ruled gratings[J].Opt.Precision Eng.,2009,17(8):1783-1789.(in Chinese)
[3]卢向东.椭偏法测量光栅参数的理论研究[D].成都:四川大学,2003.LU X D.Theoretical study of measuring grating parameters with ellipsmetry[D].Chengdu:Sichuan Uniυersity,2003.(in Chinese)
[4]PAN S P,CHEN CH J,CHANG L CH.1-D pitch measurement by laser diffractometer and Atomic Force Microscope[C].International Symposium on Precision Mechanical Measurements,Hefei,China,11-16 Aug.2002:5-059-5-063.
[5]YAO B CH,PAN SH P,CHEN CH J,et al..SEM 1-D grating measurement compare to AFM and laser diffractometer[C].International Symposium on Instrumentation Science and Technology,Hefei,China,11-16 Aug.2002:2-034-2-037.
[6]DONALD A CH,EGBERT B,DAVID L B,et al..Picometer-scale accuracy in pitch metrology by optical diffraction and atomic force microscopy[J].SPIE,2008,6922,69223J.
[7]MICHAEL R M,CHRISTOPHER J R,S SOHAIL H N,et al..Subwavelength photoresist grating metrology using scatterometry[J].SPIE,1995,2352:251-261.
[8]MELI F,THALMANN R,BLATTNER P.High precision pitch calibration of gratings using laser diffractometry[C].Proc.of the 1st Int.Conf.on Precision Engineering and Nanotechnology,Bremen,May 1999,2:252-255.
[9]EGBERT B,WINFRIED M,ALEXANDER D,et al..Multi-wavelength VIS/UV optical diffractometer for high-accuracy calibration of nano-scale pitch standards[J].Measurement Sci.and Technol.,2007,18:667-674.
[10]JENNIFER E D,BUHR E,DIENER A,et al..Report on an international comparison of one-dimensional(1D)grating pitch[J].Metrologia,2009,46:04001.
[11]倪重文,陈宪锋,沈小明,等.分光计测定光栅常数[J].大学物理实验,2008,22(2):50-53.NI ZH W,CHEN X F,SHEN X M,et al..Discussion on the experiment of diffracive grating constant with spectrometer[J].Physical Experiment College,2008,22(2):50-53.(in Chinese)
[12]PETRE C L,JOHN R M,ADRIAN S,et al..The characterization of grating using the optical scatteromter[J].Romanian J.Physics,2010,55(3-4):376-385.
[13]BABAR K M,STEPHEN A C,SOHAIL S,et al..Ellipsometric scatterometry for the metrology of sub-0.1 μm-linewidth structures[J].Appl.Opt.,1998,37(22):5112-5115.
[14]NI X,JAKATDAR N,BAO J,et al..Specular spectroscopic scatterometry in DUV lithography[J].SPIE,1999,3667:159-168.
[15]HSU-TING H,FRED L T.Erratum to‘Spectroscopic ellipsometry and reflectometry from gratings(Scatterometry)for critical dimension measurement and in situ,real-time process monitoring’[J].Thin Solid Films,2004,468:339-346.
[16]PETRE C L.Phase-modulation scatterometry[J].Appl.Opt.,2002,41(34):7187-7192.
[17]WEI SH M,LI L F.Measurement of photoresist grating profiles based on multiwavelength scatterometry and artificial neural network[J].Appl.Opt.,2008,47(13):2524-2532.
[18]ANTOS R,OHLIDAL I,MISTRIK J,et al..Spectroscopic ellipsometry on lamellar gratings[J].Appl.Surface Sci.,2005,244:225-229.
[19]张丽娟,傅克祥,李建龙,等.用透射光谱法测光栅参数的数值模拟[J].激光杂志,2005,26(3):42-44.ZHANG L J,FU K X,LI J L,et al..The numerical simulation of measuring grating parameters with the transmission spectrum method[J].Laser J.,2005,26(3):42-44.(in Chinese)
[20]张丽娟,傅克祥,麻建勇,等.透射光谱法测光栅参数的可行性[J].激光技术,2005,29(2):165-168.ZHANG L J,FU K X,MA J Y,et al..The feasibility of measuring grating parameters with the transmission spectrum method[J].Laser Technol.,2005,29(2):165-168.(in Chinese)
[21]李健龙,傅克祥,朱建华,等.用光栅正负一级能量比侧体积相位全息光栅参量[J].光子学报,2006,35(2):239-243.LI J L,FU K X,ZHU J H,et al..Determining the parameters of VPHG with the diffractive efficiencies ratio(+1/-1)[J].Acta Photonica Sinica,2006,35(2):239-243.(in Chinese)
[22]张丽娟,卢向东,欧伟英.对正负一级能量比测量光栅参量方法的改进[J].光学学报,2006,26(11):1605-1608.ZHANG L J,LU X D,OU W Y.Improvement on measuring grating parameters with diffraction orders of m=±1 efficiencies ratio[J].Acta Opt.Sinica,2006,26(11):1605-1608.(in Chinese)
[23]付赛,陈海清.一种基于CCD的实时测量光栅常数的方法[J].应用光学,2005,26(1):53-55.FU S,CHEN H Q.A new method based on CCD to measure the constant of grating[J].J.Appl.Opt.,2005,26(1):53-55.(in Chinese)
[24]李岩,花国梁.精密测量技术[M].北京:中国计量出版社,2001.LI Y,HUA G L.Precision Measurement Technology[M].Beijing:China Metrology Press,2001.(in Chinese)
[25]谭鑫,李文昊,巴音贺希格,等.紫外全息闪耀光栅的制作[J].光学精密工程,2010,18(7):1536-1542.TAN X,LI W H,Bayanheshig,et al..Fabrication of ultraviolet holographic blazed grating[J].Opt.Precision Eng.,2010,18(7):1536-1542.(in Chinese)
[26]金伟华,金春水,张立超,等.基于混合优化算法测定铝薄膜光学常数[J].光学 精密工程,2008,16(9):1582-1588.JIN W H,JIN C SH,ZHANG L CH,et al..Determination of optical constants for aluminum thin film based on combined optimal algorism[J].Opt.Precision Eng.,2008,16(9):1582-1588.(in Chinese)
Progress in grating parameter measurement technology
LIU Hong-xing1,2,ZHANG Wei1,GONG Yan1
(1.State Key Laboratory of Applied Optics,Changchun Institute of Optics,Fine Mechanics and Physics,Chinese Academy of Sciences,Changchun 130033,China;2.Graduate Uniυersity of Chinese Academy of Sciences,Beijing 100039,China)
Grating parameter measurement technology is a key evaluation criterion of grating fabrication.This paper introduces several kinds of grating measuring methods that have been relative mature in present.It focuses on the Atomic Force Microscopy(AFM)method,Scanning Electron Microscopy(SEM),Laser Diffraction(LD)method and scattering measuring method(ellipsometry),and describes their working principles,developing trends and their own advantages and disadvantages.It points out that the AFM and SEM methods can measure the local profile of a grating and can get its surface profile defect.The LD method and scattering method can reflect average results of a laser radiation region,in which the LD method can give the grating period parameters and the ellipsometry can offer the other parameters except the period parameters.Furthermore,the grating parameters gotten by these method are identical,and the LD method provides a minimum uncer-tainty,the AMF method comes second and the SEM is the last one.In the end,it discusses the developing directions of grating parameter measurement technologies.
grating;grating parameter measurement;Atomic Force Microscopy(AFM);Scanning Electron Microscopy(SEM);Laser Diffraction(LD);ellipsometer
O436.1
A
1674-2915(2011)02-0103-08
2011-01-13;
2011-03-14
国家863高技术研究发展计划资助项目(No.863-2-5-1-13B)
刘洪兴(1986—),男,山东聊城人,博士研究生,主要从事精密检测技术和辐射定标方面的研究。E-mail:lhxing_888@126.com

