980nm 应变量子阱激光器外延层工艺参数的优化设计
张 莹,宋爱民,王培界
(1.重庆邮电大学光电工程学院,重庆 400065;2.重庆教育学院图书馆,重庆 400067;3.重庆光电技术研究所,重庆 400060)
0 引言
半导体激光器具有很高的电光转换效率,它最重要的应用之一是作为固体激光增益介质的泵浦源[1]。目前,980 nm的半导体激光器在光通讯、军事和医疗等领域均得到了广泛的应用。
980 nm半导体激光器是掺铒光纤放大器的最理想泵浦源。由于掺饵光纤放大器具有全光纤特性,便于和光纤通讯系统连接,使其成为光放大器的主选器件。在医学方面,980 nm波长比800 nm和1 060 nm波长能量更集中,更容易被水分子吸收,对周围组织损伤小,还具有很好的凝固止血效果,因此,高功率980 nm半导体激光器可以被用作医疗上的激光手术刀[2]。高功率980 nm应变量子阱半导体激光器,具有阈值电流密度低、增益系数高、温度特性好等优点,更适于制作高功率和长寿命的激光器,并且其发射波长在 0.9 ~1.1 μm 范围内,填补了匹配的GaAs/AlGaAs和InGaAsP/InP材料的发射波长盲区。
对于量子阱激光器,量子阱的In组分、势阱宽度,以及波导层、包层中Al的组分对激光器的性能起着决定性的作用。本文通过理论计算和软件模拟确定了In,Al的组分和阱宽,分析了波导层和包层的结构,采用MOCVD外延技术生长了器件的材料,测试结果达到预期要求。
1 量子阱结构的优化设计
1.1 材料的确定
0.9~1.1 μm 波段对应的带隙比 GaAs的带隙小许多,在Ⅲ-Ⅴ族材料中只有InGaAs满足980 nm对应带隙的要求,但是,找不到与InGaAs的晶格常数相匹配的二元衬底材料,所以会有一定的晶格失配。当2种不同晶格常数的材料生长在一起时,只有当外延层厚度足够薄时,生长层的弹性形变才能承受晶格失配形成的应力,避免由于过大的应力引起缺陷或位错,从而维持器件的正常工作[3]。
对于InGaAs量子阱材料,垒层选用GaAs,其原因是:GaAs的晶格常数和阱的晶格常数相差不多,可以得到较小的失配率;GaAs的带隙宽度对于阱层材料比较适合,即导带带阶ΔEc大小合适,可以很好地限制阱内的电子。
1.2 应变与带隙的关系
300 K 时,无应变的 InxGa1-xAs带隙[4]为

(1)式中,x为InGaAs中In的组分。
InxGa1-xAs/GaAs结构的应变量子阱,外延晶格在平行结平面的方向,受到双轴压应变,但是,在垂直结平面的方向,受到单轴张应变。应力的作用破坏了外延层晶格的立方对称性,导致了能带结构的变化。
对于应变层InxGa1-xAs,重空穴带的漂移值为


导带边的漂移值为

(3)式中,ac为导带和夹带的静压力形变势。
有效的带隙为无应变的带隙宽度与应变导致的价带边、导带边的漂移之和,即


(4)式中,a为静压力形势变,a=ac-av。
InxGa1-xAs三元化合物的应变参数通过表1[5]中GaAs和InAs的应变值之间进行线形内插法来确定。

表1 应变参数Fig.1 Strain parameters
1.3 组分的确定
对于量子阱激光器,激射波长受到阱、垒材料和量子阱宽度的影响。跃迁能量主要由第1子带电子到重空穴的跃迁决定,在考虑压应变的情况下,导带第1子带到价带重空穴第1子带跃迁的光子能量表示为

(5)式中:Eg为InxGa1-xAs的禁带宽度;ΔEc-hh为压应变导致的c1-hh1漂移值;Ec1(Lz)为电子第1子带能级位置;Ehh1(Lz)为价带重空穴第1子带能级位置;Lz为量子阱宽。
光子能量和波长之间的转换关系为

(6)式中:λ(x,Lz)为激射波长;E(x,Lz)为跃迁能量。
根据贝尔研究所的Miller等[6]通过实验确定的InxGa1-xAs/GaAs异质结能带不连续比例为

(7)式中:ΔEc,ΔEv分别为2种材料的导带不连续值和价带不连续值;ΔEg为2种材料的带隙差值。
对于有限深势阱,当阱间电子波函数不发生重叠时,决定子带能级的本征值方程[7]为

(8)式中:mw*和mb*分别为载流子在阱中和势垒处的有效质量;U(i)为势阱深度(导带或价带的不连续值);Lz为量子阱宽;ħ为普朗克常数除以2π;Ei为载流子能量本征值,当i代表c1或hh1时,即为导带第1子带能级或价带重空穴第1子带能级相对位置。
将阱宽设为7 nm,联立(1),(4)—(8)式,可以得出In的组分x与发射波长的关系,如图1所示,随着In组分增大,波长会相应变长。发射波长为980 nm时,对应的In组分约为0.25左右。

图1 In的组分与发射波长的关系Fig.1 Relationship between In compositions and emission wavelength
另外,文献[8]给出的InxGa1-xAs/GaAs半导体激光器的量子阱层中,In组分与阈值电流密度的关系曲线如图2所示。综合图1和图2中In组分和发射波长、阈值电流的关系,In的组分定为0.2。

图2 In的组分与阈值电流密度的关系Fig.2 Relationship between In compositions and threshold current density
1.4 阱宽的确定
对于晶格失配的异质外延材料,外延层存在一个临界厚度hc。当小于临界厚度时,应变是弹性的,失配产生的应力不会导致失配位错的产生;当大于临界厚度时,应变则会驰豫,并产生失配位错。由Matthews的力学平衡模型计算,临界厚度的表达式[6]为


院子里还有一只大公鸡,这只大公鸡竟能像狗一样看家。有陌生人来的时候,它不会像狗一样大叫呼唤主人,而是直接用尖尖的嘴巴啄人。有一次,亲戚来家里做客,经过院子的时候,隐约感到身后有一道犀利的视线。他觉得很纳闷:这是谁在跟着我啊?回头一看,那只白色带着血红鸡冠的大公鸡扑扇着翅膀向他直面扑来,幸亏亲戚身手不凡,一脚踢过去,才免于被啄。姥爷发现后,立刻把鸡赶到了鸡窝里。我想,这要是个坏人,大公鸡说不定还真可以和他搏斗一番呢。
根据(9)式的计算,得到临界厚度与In组分的关系,如图3所示,增加In的组分使临界厚度减小,所以,InGaAs量子阱的厚度受到相应In组分对应临界厚度的限制,如果超过了临界厚度,则会导致失配位错的产生,进而使激光器的性能急剧下降。

图3 In的组分与临界厚度的关系Fig.3 Relationship between In compositions and critical thickness
对于量子阱材料InGaAs,由于重空穴的有效质量比较大,且导带势阱比价带势阱深,因此忽略空穴能级的量子化效应,将跃迁看作是电子从第1量子能级到价带顶,得到导带电子的第1量子态能量为

将 In 的组分设为 x=0.2,联立(1),(4)—(8),(10)式,得到阱宽和波长的关系如图4所示,随着阱宽的增大,发射波长会相应变长。综上,阱宽定为7 nm左右。

图 4 In0.2Ga0.8As 阱宽与波长的关系Fig.4 Relationship between well width of In0.2Ga0.8As and wavelength
2 波导层、包层的优化设计
2.1 波导层结构的设计
波导层的设计是为了实现对载流子的控制,通过减少载流子的泄露来提高量子效率,降低阈值电流。为了提高注入载流子效率、减小垂直发散角、减小串联电阻等特性,我们采用折射率渐变的波导层结构。
通过理论分析可知,额外电压主要是由有源区与波导层之间的能阶ΔEc产生的[9],增加波导层中的Al组分,可以增大有源区和波导层的能阶,减少载流子的泄漏,但是,过高的能阶会因为波导层中Al组分与有源区中Al组分的含量差增大而导致异质结晶格失配,从而形成更多的界面态,影响激光器的内量子效率。
2.2 包层结构的设计
包层的设计是为了有效地限制光场。通过理论分析可知,Al组分高的材料可以更好地限制光场,同时也具有较低的阈值电流密度和较大的发散角,与之对应,Al组分低的材料,由于较小的折射率差对光场限制较弱,光限制因子减小,有利于发散角的减小。但是,如果材料中的Al组分太低,会因为与有源区的带隙差别较小,造成载流子的泄露严重,从而使内量子效率下降,阈值电流密度增大。
限制层的厚度对半导体激光器的性能也有很大影响。太厚的限制层会增大激光器的热阻和串联电阻,使激光器的性能变差,太薄的限制层又会引起辐射损耗。所以,通过选择合适的包层厚度可以优化外延结构。
2.3 模拟及分析
利用Crosslight公司的专业软件SimuLastip对不同Al组分的材料结构进行模拟。
图5为波导层和包层中不同Al组分结构的能带结构。模拟结果显示,包层和波导层之间的能阶很小,且费米能级几乎没有弯曲。图5a中有源区层和波导层的能阶小,费米能级弯曲小。图5b中有源区层和波导层的能阶大,费米能级弯曲大。所以,额外电压主要是由有源区与波导层之间的能阶产生的,且Al组分的含量起着决定性作用。

图5 能带结构模拟图Fig.5 Structure diagrams of bands
图6为波导层和包层中不同Al组分结构的V-I特性。由图6可知,在相同的输入电流下,减小波导层和包层的Al组分,工作电压和开启电压均有不同程度的降低。所以,可以通过调节材料中Al组分的含量来降低激光器的额外电压,提高效率。
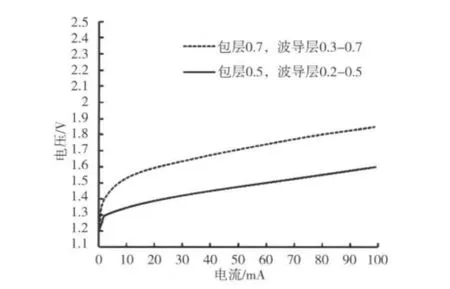
图6 不同包层、波导层Al组分激光器V-I特性模拟比较图Fig.6 Comparison between V-I characteristics of different Al compositions in cladding,waveguide layer
3 器件制作
采用MOCVD技术生长980 nm半导体激光器,器件结构如图7所示,在衬底GaAs上由下至上生长的材料分别为:300 nm GaAs缓冲层;1400 nm Al0.5Ga0.5As的N型下限制层;200 nm Al0.2-0.5Ga0.8-0.5As 渐变层;20 nm GaAs 垒层;7 nm In0.2Ga0.8As 量子阱层;20 nm GaAs 垒层;200 nm Al0.5-0.2Ga0.5-0.8As 渐变层;1 400 nm Al0.5Ga0.5As 的 P 型上限制层;200 nm的欧姆接触层GaAs。

图7 结构示意图及能级图Fig.7 Structure and energy chart
外延片制作完成后,通过以下工艺流程得到未镀膜的条形激光器:采用150 μm条宽的光刻版图,进行光刻工艺,完成波导区制作;采用等离子体增强化学气相沉积法(plasma enhanced chemical vapor deposition,PECVD)淀积SiO2介质膜,限定电流注入区的P面接触;通过2次光刻,完成电流注入区的制作;采用Cr/Au材料作为P-GaAs的欧姆接触;采用机械减薄,将衬底减薄至90 μm;采用Au-Ge-Ni/Au材料作为N-GaAs的欧姆接触,在H2气氛中合金,形成良好的欧姆接触;将制作好的晶片沿晶向(110)方向解理成腔长500 μm的细长条。
通过以上工艺流程,制作出的未镀膜条形激光器的I-V/P特性曲线如图8所示。输入单位电流时,对应的输出功率为407.6 mW,斜率效率达到了48%。外延材料激射波长的测试结果如图9所示,中心波长为981.2 nm,可见器件外延层优化设计后的特性良好,该计算方法和模拟方法可以作为应变量子阱激光器的理论设计依据。

图8 未镀膜器件的I-V/P特性曲线Fig.8 I-V/P curve of device without coating

图9 器件的激射光谱Fig.9 Lasing spectrum of device
4 结论
通过理论计算和软件模拟,优化了980 nm应变量子阱激光器的阱宽和量子阱材料的In组分。分析了Al组分对能阶、费米能级和电压的影响,通过降低Al组分的含量,降低工作电压,提高器件效率。在室温下,当工作电流为1 A时,阈值电流为150 mA,斜率效率为0.48 W/A(采用 150 μm ×500 μm,未镀膜器件),输出功率为400 mW。
[1]彭川,LE H Q,SARANGAN A M,et al.外耦合布拉格光栅5μm量子级联激光器[J].重庆邮电大学学报:自然科学版,2003,15(3):1-3.PENG Chuan,LE H Q,SARANGAN A M,et al.Externally Coupled Bragg Grating 5(m Quantum Cascade Lasers[J].Journal of Chongqing Universities of Posts and Telecommunications:Natural Science Edition,2003,15(3):1-3.
[2]张斯钰.高功率980 nm脊形量子阱半导体激光器的研究[D].长春:长春理工大学,2008.ZHANG Si-yu.The study of 980 nm high power ridge quantum well semiconductor lasers[D].Changchun:Changchun University of Technology,2008.
[3]冯昊,俞重远,刘玉敏.长波长QD-VCSELs中的应变补偿理论[J].北京邮电大学学报,2010,33(6):84-87.FENG Hao,YU Chong-yuan,LIU Yu-min,Analysis on Strain Compensation in Long-Wavelength QD-VCSELs[J].Journal of Beijing University of Posts and Telecommunications,2010,33(6):84-87.
[4]CHEN Gen-xiang,LI Wei,XU Cheng-lin,et al.Spectral Properties of Fabry-Pérot Laser Diodes and Conventional Semiconductor Optical Amplifiers[J].The Journal of China Universities of Posts and Telecommunications,2006,13(1):63-66.
[5]KOLBAS R M,ANDERSON N G,LAIDIG W D,et al.Strained-layer InGaAs-GaAs-AlGaAs photopumped and current injection lasers[J].IEEE J Quantum,1988,24(8):1605-1613
[6]江剑平.半导体激光器[M].北京:电子工业出版社,2000.JIANG Jian-ping.Semiconductor lasers[M].Beijing:E-lectronic Industry Press,2000.
[7]蔡伯荣,陈铮,刘旭.半导体激光器[M].北京:电子工业出版社,1995.CAI Bo-rong,CHEN Zheng,LIU Xu.Semiconductor lasers[M].Beijing:Electronic Industry Press,1995.
[8]WANG C A,GROVES S H.New materials for diode laser pumping of solid-state laser[J].IEEE J Quantum Electron,1992,28(4):942-951.
[9]田秀伟,陈宏泰,车相辉,等.高效率976 nm激光器材料[J].微纳电子技术,2010,47(1):29-32.TIAN Xiu-wei,CHEN Hong-tai,CHE Xiang-hui,et al.High-Efficiency Semiconductor Laser Material[J].Micronanoelectronic Technology,2010,47(1):29-32.

