聚乙二醇与嵌段聚合物L64在超填孔镀铜中的行为
肖宁,李宁,,谢金平,李树泉,范小玲,黎德育
(1.哈尔滨工业大学化工学院,黑龙江 哈尔滨 150001;2.广东省佛山市高力集团,广东 佛山 528247)
聚乙二醇与嵌段聚合物L64在超填孔镀铜中的行为
肖宁1,李宁1,*,谢金平2,李树泉2,范小玲2,黎德育1
(1.哈尔滨工业大学化工学院,黑龙江 哈尔滨 150001;2.广东省佛山市高力集团,广东 佛山 528247)
以聚乙二醇(PEG)和嵌段聚合物L64为主要研究对象,通过金相显微照片和循环伏安溶出法(CVS)研究了镀液中 Cl−浓度对填孔镀铜的影响。研究发现,PEG对铜离子沉积的抑制作用受强迫对流与Cl−浓度的影响,对流越强,PEG的抑制作用越强;在30 ~ 180 mg/L范围内,随着Cl−离子浓度的增加,填孔率呈先增大后减小的趋势,而且Cl−浓度越高,PEG的抑制作用越弱。L64对铜离子沉积的抑制作用不受对流强度及Cl−离子浓度的影响,在20 ~ 120 mg/L内,填孔率随着Cl−离子浓度的增加呈现缓慢下降的趋势。在其他条件相同的情况下,L64对铜离子沉积的抑制作用远大于PEG。在提高镀液填孔效果方面,L64比PEG有更优秀的表现。
盲孔;填充;电镀铜;循环伏安溶出;聚乙二醇;嵌段聚醚;氯离子;对流
1 前言
电镀填孔工艺是实现半导体高密度互联的有效手段,更是促进电子产品日趋小型化的秘密武器,因此,近年来电镀填孔工艺受到了广泛关注,发展十分迅速。在生产技术上,可溶性磷铜阳极逐渐被惰性阳极配合氧化铜粉末补加所取代,在垂直电镀技术不断更新完善的同时,水平电镀技术也得到长足发展,此外,脉冲技术应用于电镀填孔工艺也被提上日程;在填孔配方方面,各种添加剂组合被开发研究,并成功应用于实际生产。同时,人们对填孔机理以及配方中添加剂之间的相互作用进行了研究。在酸性镀铜填孔工艺中,生产设备是硬件,固然重要,但更重要的是作为软件的填孔配方。
在酸性镀铜填孔配方中,主要有加速剂、抑制剂和整平剂 3种添加剂,了解各种添加剂的作用机制以及添加剂之间的协同效应,将对电镀填孔的机理研究起到重要作用。同时,也为现场提供强有力的技术指导。国内外的学者们对电镀盲孔的机理进行了深入的研究,其中,曲率增强吸附机理(Curvature Enhanced Adsorbate Coverage)与对流控制吸附机理(Convection Dependent Adsorption)能更好地解释超填孔现象的发生[1-5]。此外,研究发现,加速剂SPS(聚二硫二丙烷磺酸钠)与抑制剂PEG(聚乙二醇)要在Cl−离子的协同作用下才能更好地发挥加速或抑制铜沉积的作用[6-11];吩嗪与酞菁染料以及含氮的阳离子表面活性剂对电镀盲孔有较好的整平作用[12-13]。目前,对电镀盲孔的研究更加倾向于新型添加剂的开发、待镀盲孔板的前处理工艺和提高镀液使用周期等方面[14-15]。而对组成镀液的基本组分──加速剂尤其是抑制剂的研究相对较少,见诸报道的基本都是PEG[16-20]。
本文以PEG与L64(一种嵌段聚醚,BASF生产)为主要研究对象,采用循环伏安溶出法(CVS)研究了镀液中Cl−离子的浓度对PEG与L64抑制铜沉积的影响。此外,以样品的金相显微照片为依据,对比分析了对流强度对PEG或L64抑制铜离子沉积、Cl−离子的浓度变化对以PEG或L64为抑制剂的镀液体系的填孔率的影响。
2 实验
2. 1 试剂
聚二硫二丙烷磺酸钠(SPS),江苏梦得电镀化学品有限公司;嵌段聚合物(Pluronic L64),德国巴斯夫;聚乙二醇(PEG6000)、稀盐酸(HCl)、五水硫酸铜(CuSO4·5H2O)、重铬酸钾(K2Cr2O7)、氯化钠(NaCl)和浓H2SO4(ρ = 1.84 g/mL),西陇化工股份有限公司;复合整平剂HIT-1,实验室自制。
2. 2 样品的制备
2. 2. 1 基材
选取表面盲孔(孔径150 μm,孔深75 μm)均匀有序分布的PCB板为待镀阴极板,尺寸为5 cm × 10 cm,化学沉铜层厚度为2 ~ 3 μm;采用磷含量为0.040% ~0.065%的磷铜板(广东多正化工科技有限公司生产)为阳极以及1.5 L的哈林槽为电镀槽。
2. 2. 2 电镀
电镀前,先将待镀板在质量分数为 10%的稀硫酸溶液中活化1 min,取出后用大量蒸馏水冲洗,冷风吹干后置于电镀液中浸泡5 min以使盲孔充分润湿,然后在1 A/dm2下施镀30 min,再在2 A/dm2下施镀90 min。电镀过程中,在阴极待镀板两侧下方持续鼓入空气进行搅拌。电镀完毕,断电,取出阴极盲孔板,用大量蒸馏水冲洗,冷风吹干后,置于干燥器中保存。
镀液组成为:CuSO4·5H2O 220 g/L,H2SO455 g/L,Cl−(以稀盐酸为 Cl−离子源)60 ~ 120 mg/L,SPS–PEG–HIT-1添加剂或 SPS–L64–HIT-1添加剂。其中HIT-1为混合整平剂,主要成分是健那绿(JGB);PEG的分子量为6 000;环氧乙烷(EO)–环氧丙烷(PO)嵌段聚醚L64的分子量为2 900,其中EO的质量分数占40%。
2. 3 表征方法
将试样裁剪后,封入水晶胶中并干燥固化,然后依次用180#、400#、1200#和2000#的砂纸打磨至露出盲孔的断面,再进行抛光处理。对切片进行微蚀处理后,用Leica的DFC290金相显微镜观察填孔效果,放大倍数为200倍和400倍。微蚀液组成为:K2Cr2O740 g/L,NaCl 40 g/L,浓H2SO4(ρ = 1.84 g/mL)80 mL/L。以填孔率评价填孔效果,填孔率越大,填孔效果越好。填孔率按下式计算[10]:

式中,a为盲孔深度(μm),b为填孔镀铜后盲孔内铜镀层的厚度(μm),c为填孔镀铜后盲孔板表面铜镀层的厚度(μm)。
采用循环伏安溶出法(CVS)研究 Cl−离子浓度对PEG与L64抑制铜离子沉积能力的影响。其中,旋转圆盘电极的转速为2 600 r/min,循环伏安曲线的扫描速率为 0.1 V/s,测试基础液 30 mL,由 220 g/L CuSO4·5H2O和55 g/L H2SO4组成,抑制剂和Cl−离子由测试系统自动补加。实验完成后,测试软件自动给出铜溶解峰的积分面积A,积分区间设定为0 ~ 0.5 V。最后,以Cl−的浓度为横坐标,以A/A0为纵坐标绘制曲线,其中A0为电解液中不含Cl−时铜溶解峰的积分面积。
3 结果与讨论
3. 1 以PEG作抑制剂时Cl–浓度对填孔镀铜的影响
图1是以SPS + PEG + HIT-1为添加剂的镀液体系中,Cl–质量浓度不同的情况下所得样品切片的金相显微照片。其中,图1a、c和e为放大100倍的照片,图1b、d和f为放大200倍的照片。由图1可以得出结论:第一,在以SPS + PEG + HIT-1为添加剂的镀液体系中,随着Cl−离子质量浓度的增加,填孔率先增加后减小,即镀液的填孔能力先增强后减弱;第二,随着Cl−离子质量浓度的增加,PCB板表面电镀铜层(简称“面铜”)的厚度逐渐增加,由最初的28 μm增加到后来的33 μm。台湾学者窦伟平教授根据研究指出,Cl−离子在填孔电镀中有3个作用:(1)Cl−离子能起到电子桥的作用,加速Cu2+得电子还原成Cu+的进程;(2)Cl−离子吸附在阴极铜板表面,起锚定抑制剂的作用(PEG–Cu+–Cl–),从而抑制铜离子的沉积;(3)Cl−离子能与加速剂协同提高铜离子的沉积速度。由超填孔的机理可知,抑制剂与加速剂在阴极待镀板表面有不同的浓度分布,一般抑制剂分子量较大,不容易扩散至盲孔底部,因此,它主要是抑制面铜的生长。而加速剂则能在盲孔底部聚集,与Cl−离子协同提高孔铜的沉积速度,从而实现超填孔。

图1 以SPS + PEG + HIT-1为添加剂的镀液体系中不同Cl-质量浓度下制备的样品的金相显微镜照片Figure 1 Metallographs of the samples prepared in a plating bath with SPS, PEG, and HIT-1 as additives in presence of Clat different mass concentrations
基于以上结论得知,在以SPS + PEG + HIT-1为添加剂的镀液体系中,当 Cl−离子含量较低时,大部分Cl−离子与PEG结合,形成PEG–Cu+–Cl−阻挡层,抑制面铜的生长,只有少量的Cl−离子在对流作用下扩散至盲孔底部,与SPS协同加速孔铜的沉积,因此,填孔效果较差,如图1b所示。造成这种结果的原因是在阴极板表面对流较强的地方,抑制剂的吸附作用较强,因此会有更多的Cl−被覆盖在抑制层PEG–Cu+–Cl−的下面,即面铜表面,从而使得盲孔中Cl−的浓度减少,孔铜沉积速度变慢。为了证明此结论的正确性,在以SPS + PEG + HIT-1为添加剂的镀液体系中做了有无搅拌的对比实验(Cl−离子浓度为60 mg/L),结果如图2a、2b所示。当停止向阴极表面进行鼓气时,即在无强制对流的情况下进行电镀填孔,填孔效果如图2b所示,比在强制对流下得到的填孔效果(见图2a)好。此外,对比图2a、2b可以发现,随着对流强度的减弱,面铜的厚度增加,由28 μm增大到31 μm,这与文献中报道的增强对流有利于抑制剂吸附的观点一致[1]。

图2 有无搅拌、Cl-质量浓度为60 mg/L时制备的样品的金相显微镜照片Figure 2 Metallographs of the samples obtained in a plating bath containing 60 mg/L of Cl- with and without air agitation
当镀液体系中的Cl−质量浓度增大到90 mg/L时,镀液的填孔效果明显变好,填孔率变大。这说明此时在盲孔底部有足够的 Cl−离子与 SPS协同加速铜离子的沉积。然而,并不是Cl−离子的浓度越大,填孔效果就越好。如图1e与f所示,当镀液中Cl−离子的质量浓度增大至120 mg/L时,镀液的填孔效果明显变差。原因是盲孔中过多的Cl−离子会与Cu+生成配合物而不再是CuCl晶体,从而减缓了孔铜的生长速度,导致填孔率变小[6]。
图3为上述电镀体系中铜溶解峰的积分面积比随Cl−离子浓度的变化曲线。由图 3可见,当 Cl−质量浓度由30 mg/L增加到180 mg/L时,随着Cl−离子质量浓度的不断增加,铜溶解峰的积分面积逐渐增大。这说明PEG对铜离子沉积的抑制作用在逐渐减小。由此可以得出结论:在以SPS + PEG + HIT-1为添加剂的镀液体系中,随着Cl−离子浓度的增加,铜离子的沉积速度变快,因此,面铜的厚度也随之增加,从而证明了由图1得出的第2条结论的正确性。

图3 以PEG作抑制剂时铜溶解峰的积分面积比随Cl-质量浓度的变化关系Figure 3 Variation of integral area ratio of copper stripping peaks with mass concentration of Cl- in plating bath containing PEG as inhibitor
3. 2 以L64作抑制剂时Cl–浓度对填孔镀铜的影响
基于以上PEG在填孔电镀中的各种行为,对比研究L64在填孔电镀中的表现。在以SPS + L64 + HIT-1为添加剂的镀液体系中,Cl−质量浓度分别为 30、60和90 mg/L时,样品切片的金相显微照片见图4,其中图4a、c和e为放大100倍的照片,图4b、d和f为放大200倍的照片。

图4 以SPS + L64 + HIT-1为添加剂的镀液体系中不同Cl-质量浓度制备的样品的金相显微镜照片Figure 4 Metallographs of the samples obtained in a plating bath with SPS, L64, and HIT-1 as additives in presence of Clat different mass concentrations
由图4可知,在以SPS + L64 + HIT-1为添加剂的镀液体系中,随着Cl−离子浓度的增加,填孔率逐渐减小,但减小的趋势非常缓慢,这与以SPS + PEG + HIT-1为添加剂的镀液体系形成了鲜明的对比。值得注意的是,在Cl−离子浓度较低(如30 mg/L)时,以SPS + L64 + HIT-1为添加剂的镀液体系便具有较强的填孔能力,且面铜厚度约为31 μm,与在以SPS + PEG + HIT-1为添加剂的镀液体系中Cl−质量浓度为90 mg/L时获得的面铜厚度相当。这说明以L64为抑制剂,只需较少的Cl−协助就能在阴极表面吸附形成阻挡层。这一结论可在图5中得到证明。
图5是以SPS + L64 + HIT-1为添加剂的镀液体系中,铜溶解峰的积分面积比随Cl−离子质量浓度的变化曲线。如图5所示,当镀液中Cl−质量浓度为20 mg/L时,A/A0就降低到0.1左右,与图3中A/A0的数值相比,可以证明L64在较少的Cl−离子浓度下就能在面铜表面发生吸附形成阻挡层,且阻挡层的抑制作用更强。由图5还可以发现,随着Cl−离子质量浓度的增加,A/A0的数值维持在0.1左右。这说明当Cl−质量浓度大于20 mg/L时,L64对铜离子沉积的抑制作用几乎不受Cl−离子浓度的影响。
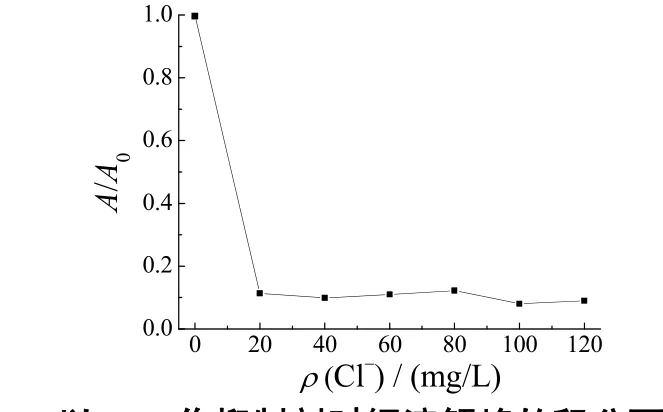
图5 以L64作抑制剂时铜溶解峰的积分面积比随Cl-离子质量浓度的变化关系Figure 5 Variation of integral area ratio of copper stripping peaks with mass concentration of Cl- in plating bath containing L64 as inhibitor
有文献报道[21],在大于临界胶束浓度时,L64在水溶液中以胶团的形式存在。其中,EO形成亲水的外壳,PO构成疏水的内核,由EO–PO构成的胶团对一些极性分子或离子有增溶作用,SPS就可以溶于胶团内与L64一起吸附在阴极铜板表面,抑制铜离子的沉积。因此,在以SPS + L64 + HIT-1为添加剂的镀液体系中,随着Cl–离子浓度的增加,面铜厚度几乎没有变化。
随着Cl−离子浓度的增加,填孔率略有下降,是由于EO–PO构成的胶团对氯离子有吸脱附作用,即当镀液中Cl−离子浓度较高时,Cl−离子能运动至胶团内部,与PO疏水内核相互作用而被包覆在EO–PO胶团内。而当镀液中 Cl−离子浓度较低时,Cl−离子能在扩散势能的作用下从胶团中溶出。换言之,EO–PO疏水胶团对 Cl−离子的吸脱附作用类似于海绵与水之间的相互作用。因此,以SPS + L64 + HIT-1为添加剂的镀液体系对Cl−离子浓度的变化不敏感。但Cl−离子的浓度并非可以无限地增大,因为当镀液中Cl−离子的质量浓度增大至90 mg/L时,盲孔的填孔率会发生较为明显的变化,说明此时有限的EO–PO胶团浓度对Cl−离子的吸附已经基本达到饱和,过剩的Cl−离子则与盲孔中的Cu+离子反应生成配合物,从而使盲孔的填孔率下降。
图6a、b分别为有无空气搅拌下、在以SPS + L64 + HIT-1为添加剂的镀液体系中,Cl−离子质量浓度为60 mg/L时制备的样品的金相显微镜照片。可见,在以SPS + L64 + HIT-1为添加剂的镀液体系中,对流强度的变化对盲孔填孔率的影响很小,面铜的厚度也几乎没有改变,说明L64对铜离子沉积的抑制作用不受对流的影响。

图6 以SPS + L64 + HIT-1为添加剂的镀液体系中Cl-质量浓度为60 mg/L时有无搅拌条件下制备的样品的金相显微镜照片Figure 6 Metallographs of the samples obtained in a plating bath containing SPS, L64, and HIT-1 as additives in presence of 60 mg/L Cl- with and without air agitation
4 结论
对比SPS + PEG + HIT-1和SPS + L64 + HIT-1两种添加剂组合在填孔电镀中的行为表现可知,PEG对铜离子沉积的抑制作用受对流强度与 Cl−离子浓度的影响。对流越强,PEG的抑制作用越强;一定范围内Cl−离子浓度越高,PEG的抑制作用越弱。而L64对铜离子沉积的抑制作用不受对流强度的影响,与Cl−离子浓度在一定范围内的变化也无关。在以SPS + PEG + HIT-1为添加剂的镀液体系中,随着Cl−离子浓度的增加,填孔率呈现先增大后减小的变化趋势;而在以SPS + L64 + HIT-1为添加剂的镀液体系中,填孔率呈现缓慢下降的趋势。此外,在其他条件相同的情况下,L64对铜离子沉积的抑制作用远大于 PEG。因此,在盲孔电镀中,L64在提高镀液的填孔效果方面比 PEG有更优秀的表现。
[1] DOW W P, HUANG H S, YEN M Y, et al. Influence of convectiondependent adsorption of additives on microvia filling by copper electroplating [J]. Journal of the Electrochemical Society, 2005, 152 (6): C425-C434.
[2] MOFFAT T P, WHEELER D, KIM S K, et al. Curvature enhanced adsorbate coverage mechanism for bottom-up superfilling and bump control in damascene processing [J]. Electrochimica Acta, 2007, 53 (1): 145-154.
[3] MOFFAT T P, WHEELER D, HUBER W H, et al. Superconformal electrodeposition of copper [J]. Electrochemical and Solid-State Letters, 2001, 4 (4): C26-C29.
[4] CAO Y, TAEPHAISITPHONGSE P, CHALUPA R, et al. Three-additive model of superfilling of copper [J]. Journal of the Electrochemical Society, 2001, 148 (7): C466-C472.
[5] WEST A C, MAYER S, REID J. A superfilling model that predicts bump formation [J]. Electrochemical and Solid-State Letters, 2001, 4 (7): C50-C53.
[6] DOW W P, HUANG H S. Roles of chloride ion in microvia filling by copper electrodeposition: I. Studies using SEM and optical microscope [J]. Journal of the Electrochemical Society, 2005, 152 (2): C67-C76.
[7] DOW W P, HUANG H S, YEN M Y, et al. Roles of chloride ion in microvia filling by copper electrodeposition: II. Studies using EPR and galvanostatic measurements [J]. Journal of the Electrochemical Society, 2005, 152 (2): C77-C88.
[8] DOW W P, YEN M Y, CHOU C W, et al. Practical monitoring of filling performance in a copper plating bath [J]. Electrochemical and Solid-State Letters, 2006, 9 (8): C134-C137.
[9] DOW W P, HUANG H S, LIN Z. Interactions between brightener and chloride ions on copper electroplating for laser-drilled via-hole filling [J]. Electrochemical and Solid-State Letters, 2003, 6 (9): C134-C136.
[10] DOW W P, YEN M Y, LIN W B, et al. Influence of molecular weight of polyethylene glycol on microvia filling by copper electroplating [J]. Journal of the Electrochemical Society, 2005, 152 (11): C769-C775.
[11] DOW W P, YEN M Y, LIAO S Z, et al. Filling mechanism in microvia metallization by copper electroplating [J]. Electrochimica Acta, 2008, 53 (28): 8228-8237.
[12] DOW W P, LI C C, SU Y C, et al. Microvia filling by copper electroplating using diazine black as a leveler [J]. Electrochimica Acta, 2009, 54 (24): 5894-5901.
[13] KIM S K, JOSELL D, MOFFAT T P. Electrodeposition of Cu in the PEI–PEG–Cl–SPS additive system [J]. Journal of the Electrochemical Society, 2006, 153 (9): C616-C622.
[14] VOLOV I, WEST A C. Interaction between SPS and MPS in the presence of ferrous and ferric ions [J]. Journal of the Electrochemical Society, 2011, 158 (7): D456-D461.
[15] VOLOV I, SAITO T, WEST A C. Investigation of copper plating and additive interactions in the presence of Fe3+/Fe2+redox couple [J]. Journal of the Electrochemical Society, 2011, 158 (6): D384-D389.
[16] DOW W P, YEN M Y, LIU C W, et al. Enhancement of filling performance of a copper plating formula at low chloride concentration [J]. Electrochimica Acta, 2008, 53 (10): 3610-3619.
[17] DOW W P, LI C C, LIN M W, et al. Copper fill of microvia using a thiol-modified Cu seed layer and various levelers [J]. Journal of the Electrochemical Society, 2009, 156 (8): D314-D320.
[18] JOSELL D, MOFFAT T P, WHEELER D. Superfilling when adsorbed accelerators are mobile [J]. Journal of the Electrochemical Society, 2007, 154 (4): D208-D214.
[19] KIM S K, JOSELL D, MOFFAT T P. Cationic surfactants for the control of overfill bumps in Cu superfilling [J]. Journal of the Electrochemical Society, 2006, 153 (12): C826-C833.
[20] TAEPHAISITPHONGSE P, CAO Y, WEST A C. Electrochemical and fill studies of a multicomponent additive package for copper deposition [J]. Journal of the Electrochemical Society, 2001, 148 (7): C492-C497.
[21] TABAKOVA N, POJARLIEFF I, MIRCHEVA V, et al. The role of micelles of multiblock copolymers of ethylene oxide and propylene oxide in ion transport during acid bright copper electrodeposition [J]. Macromolecular Symposia, 2004, 212 (1): 467-472.
Behavior of polyethylene glycol and block copolymer L64 in microvia filling by copper electroplating //
XIAO Ning, LI Ning*, XIE Jin-ping, LI Shu-quan, FAN Xiao-ling, LI De-yu
The influence of Cl−concentration in the bath on microvia filling by copper electroplating was studied by metallographic microscopy and cyclic voltammetric stripping (CVS) method with polyethylene glycol (PEG) and block copolymer L64 as main research objects. It was found that the inhibition effect of PEG on copper deposition is influenced by forced convection and Cl−concentration, and the stronger forced convection, the stronger inhibition effect of PEG. The filling rate in presence of PEG is increased initially and then decreased with the increasing of Cl−concentration from 30 to 180 mg/L, and the higher concentration of Cl−, the weaker inhibition effect of PEG. The inhibition effect of L64 is almost unaffected by forced convection and Cl−concentration. The filling rate in presence of L64 is slightly decreased with the increasing of Cl−concentration from 20 to 120 mg/L. Under the same conditions, L64 has a greater inhibition effect on copper deposition than PEG. L64 presents a better performance than PEG in aspect of improving the filling effect of plating bath.
blind via; filling; copper electroplating; cyclic voltammetric stripping; polyethylene glycol; block polyether; chloride ion; convection
Department of Applied Chemistry, Harbin Institute of Technology, Harbin 150001, China
TQ153.14
A
1004 – 227X (2012) 11 – 0015 – 05
2012–04–26
2012–06–01
肖宁(1984–),男,河北沧州人,在读博士研究生,主要研究方向为PCB盲孔镀铜。
李宁,教授,(E-mail) lininghit@263.net。
[ 编辑:韦凤仙 ]

