化学机械研磨抛光垫专利技术发展状况研究
唐路璐
(国家知识产权局专利局专利审查协作湖北中心,湖北 武汉 43007030070)
随着科学技术的迅猛发展,半导体产业的战略地位越来越重要,它已成为与国民经济、国防建设、人民生活和信息安全息息相关的基础性和战略性产业。化学机械抛光作为半导体零件的重要加工方式,其抛光效果的好坏,直接影响半导体零件的工作性能及使用寿命,因此,化学机械抛光技术的发展状况对半导体产业的影响力不言而喻。在CMP中抛光垫具有贮存抛光液并把它运送到工件的整个加工区域、维持抛光所需的机械和化学环境、传递材料去除所需的机械载荷等作用。抛光垫的力学性能如硬度、弹性模量等对抛光垫的变形产生重要影响[1-2]。抛光垫的表面组织特征如微孔形状、孔隙率、沟槽形状及分布等因素对抛光液在加工区域的流动及其分布等产生重要影响,从而影响抛光的质量和效率。
1 化学机械研磨抛光垫关键技术解析
抛光垫根据其软硬程度和表面绒毛结构可分为含绒毛少的硬质抛光垫和含毛绒较多的软质抛光垫。一般粗抛过程为提高抛光效率用硬质的抛光垫;精抛过程由于要求的材料去除量少,表面质量要求高,多用软质抛光垫[3]。抛光金属时采用多孔渗水性的抛光垫;抛光氧化物时采用较硬的抛光垫。
化学机械抛光的抛光垫根据材料表面微观结构可大致分为四类:①由聚酯纤维制成,例如专利(CN104625945A)中涉及的一种采用聚酯纤维制成的抛光垫;②由多孔性合成革组成,例如清华大学申请的专利(CN102601727A)中涉及一种以人造革为基垫材料的化学机械抛光垫;③由多孔聚氨酯组成,例如美国罗门哈斯电子材料CMP控股股份有限公司申请的专利(US20080253385A)介绍了一种以多孔聚氨酯为材料的多层化学机械抛光垫;④由无孔聚氨酯组成,如日本株式会社SKC申请的专利(JP2009501648A)涉及一种具有互穿网状结构、无孔无气泡的聚氨酯抛光垫。
抛光垫的物理机械性能很大程度上决定了其抛光质量和效率。对于不同硬度的抛光垫,硬度越高,抛光效果越好,能够达到要求的平整度,但抛光过程中可能引起晶片表面划伤,特别是当抛光压力较大时,易造成严重的表面损伤。弹性模量和剪切模量对抛光垫的工作性能也会产生重要影响。弹性模量高则抛光垫对所加载荷的承受能力强,剪切模量高则有利于抛光垫抵抗旋转力。
2 抛光垫技术发展趋势分析
化学机械抛光技术的提出始于1965年,随着该技术在工业上的应用范围不断扩大,以及对工件表面光洁度要求不断提高,抛光垫作为化学机械抛光技术的关键部件,也已受到业内人士的普遍关注,图1为抛光垫相关专利在世界范围的申请量分布情况。
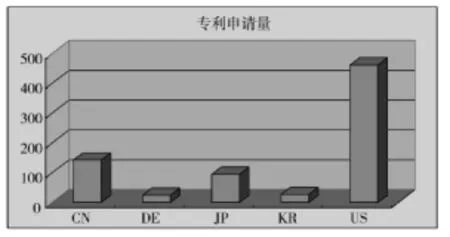
图1 抛光垫技术各国专利申请量分布
根据图1的统计结果分析可知,对于抛光垫的技术改进主要集中在美国、中国和日本,德国、韩国等国家的研发能力也在逐渐增强。
各国每年申请量变化趋势如图2。

图2 各国专利申请量随时间变化趋势
由图2可知,美国的抛光垫相关专利申请量在2006年达到顶峰,日本、德国、韩国均在2003-2006年左右专利申请达到最高峰,此后有渐渐回落的趋势,中国的申请量自2003年开始呈稳步增长态势,表明我国在化学机械抛光技术领域的研发力度逐渐增强。虽然中日韩在专利总量上与美国存在较大的差距,但近年来各国在该技术领域的差距正在不断缩小。从图中还反映出各国在近年来专利申请量均呈下降的趋势,这也反映出经过数十年的发展,化学机械抛光技术领域的相关研究日趋成熟,该领域的技术研究将会向新的方向推进。
2.1 化学机械抛光垫的多层化
随着半导体技术领域的逐渐发展,半导体器件正变得越来越复杂,具有较精细的特征以及较多的金属化层。这种趋势需要抛光耗材改善性能,以保持平整度并限制抛光缺陷,因此需要具有能与低缺陷制剂相关的物理性质很好地相关联的多层化学机械抛光垫层叠体,以增强其可修整性[4]。
基于此类技术需求,美国罗门哈斯电子材料CMP控股股份有限公司申请的专利(US2014357163A1)提供了一种具有柔软且可修整的抛光层的多层化学机械抛光垫层叠体,能够提供低缺陷抛光性能,并利于使用金刚石修整盘形成微织构,对半导体晶片进行抛光,并且不会对晶片表面造成破坏[5]。
2.2 化学机械抛光垫的窗口化
半导体器件的特征尺寸已逐渐向小型化方向发展,如果晶片表面出现过大的起伏,那么后续一系列的工艺对线宽的控制将会变得越来越困难。因此,在半导体工艺流程中,需要对化学机械平坦化过程进行监控。
为了实现化学机械抛光过程中的实时监测,上海中芯国际集成电路制造(上海)有限公司申请了一项发明(CN103978421A)涉及化学机械抛光终点侦测装置及方法,该装置可通过在抛光平台中安装一红外探测器,通过具有窗口的抛光垫来探测抛光时晶圆表面的温度变化。
3 结语
目前,CMP抛光垫的研究方向有很多,在对于抛光垫材料、物理机械性能、外形结构的技术改进日趋成熟的基础上,该领域的技术改进正朝着多功能、集成化方向发展。
[1]许雪峰,马冰迅,黄亦申.彭伟利用复合磨粒抛光液的硅片化学机械抛光[J].光学精密工程,2009,17(7):1587-1593.
[2]熊伟.化学机械抛光中抛光垫的作用研究[D].广州:广东工业大学,2006.
[3]余剑峰.新型化学机械抛光垫和抛光液的研究[D].广州:华南理工大学,2010.
[4]T.Du,V.Desai.Chemical mechanical planarization of copper∶pH effect[J].Journal of Materials Science Letters,2003(22)∶24-26.
[5]L.Borucki.Mathematical modeling of polish-rate decay in chemical-mechanical polishing[J].Journal of Engineering Mathematics,2002(2)∶41-46.

