基于多晶硅填充的TSV工艺制作
王文婧,何凯旋,王 鹏
(华东光电集成器件研究所,安徽 蚌埠 233042)
基于多晶硅填充的TSV工艺制作
王文婧*,何凯旋,王 鹏
(华东光电集成器件研究所,安徽 蚌埠 233042)
硅通孔(TSV)技术用于MEMS器件可实现器件结构的垂直互联,达到减小芯片面积、降低器件功耗等目的。对TSV结构的刻蚀和填充工艺进行了研究,通过优化ICP刻蚀工艺参数获得了端口、中部、底部尺寸平滑减小、深宽比大于20∶1的硅通孔;利用LPCVD技术实现了基于多晶硅的通孔无缝填充;经测试,填充后通孔绝缘电阻达10 GΩ以上,电绝缘性能良好。
MEMS;TSV;ICP刻蚀;LPCVD;无缝填充;绝缘特性
硅通孔(TSV)是用来实现垂直互联的一种结构,目前,TSV技术多用于以下两个方面:一是采用TSV技术实现集成电路芯片和芯片间的垂直互联,进而实现多层芯片的堆叠;二是利用TSV技术实现MEMS器件晶圆级封装中的垂直电互联引出。用于芯片堆叠封装的TSV结构如图1(a)所示,圆柱区域为TSV深孔,利用电镀工艺实现深孔结构填充,填充的金属作为电互联引线。由于引线距离短,可实现性能更好、密度更高、尺寸更小的三维封装[1-5];用于MEMS器件的TSV结构如图1(b)所示,通过在低阻硅片上刻蚀形成环状深槽,利用氧化与介质填充形成与体硅电隔离的低阻硅柱结构,低阻硅柱即为垂直互联引线。
此种形式的TSV不涉及金属,可与高温工艺相兼容,更适用于MEMS工艺的特殊要求。采用低阻硅TSV结构进行引线的垂直互联可有效减小MEMS芯片尺寸,提高MEMS器件抗过载能力。
TSV深槽制备常用的方法包括激光、深反应离子刻蚀、湿法腐蚀;TSV深槽填充方法包括电镀、化学气相淀积(CVD)等。史训清等人[6-8]利用脉冲激光能量在半导体元件上制作了TSV深槽结构,实现两个堆叠元件间的互联,但激光钻孔不适用于小孔径、高深宽比的通孔制作;Jiaotuo Ye等人[9]提出了一种采用(100)型硅晶片进行双面各向异性湿法刻蚀制作TSV深槽的方法,而腐蚀液的浓度会随着反映的进行不断变化,导致反应速率不易控制;陈颖慧等人[10]采用电感耦合等离子干法刻蚀获得TSV深槽,具有工艺可控、高深宽比的优点。
TSV深槽填充方面,用于集成电路的TSV深槽多采用电镀工艺进行填充,肖胜安[11]等人利用电镀技术实现了深宽比58∶1的无缝填充。然而由于MEMS工艺的特殊性,往往要求TSV结构可承受900 ℃以上的高温过程,此时不能使用金属TSV结构。利用CVD介质填充及低阻硅互联的TSV结构解决了高温工艺的兼容性问题,成为MEMS工艺中TSV结构的主要形式。
本文涉及的TSV为低阻硅柱互联结构,采用深反应离子刻蚀技术制作TSV深槽结构,通过优化刻蚀工艺参数,获得最佳刻蚀菜单;利用LPCVD沉积多晶硅实现TSV无缝填充。
1 TSV制作工艺流程及应用
1.1 TSV制作工艺流程
TSV制作工艺流程如图2所示。①在双抛低阻硅片上首次生长氧化层,如图2(a)所示;②利用光刻、ICP刻蚀工艺获得TSV深槽,如图2(b)所示;③重新生长氧化层作,如图2(c)所示;④采用LPCVD多晶硅填充TSV深槽,如图2(d)所示;⑤分别去除晶圆背面多晶硅和氧化层,如图2(e)所示;⑥减薄晶圆背面直至露出深槽结构,如图2(f)所示;⑦如图2(g)所示,分别去除硅片正面多晶硅和氧化层,直至露出键合面。
1.2 TSV应用
通常MEMS器件包含悬浮可动结构[12-13],如图3所示,带有TSV结构的衬底层与悬浮结构层通过硅硅直接键合形成MEMS可动结构,带有TSV结构的衬底层为可动结构实现机械支撑及互联引出。在后续晶圆级封装工艺中,可利用硅硅直接键合实现真空封装。由于硅硅直接键合是同种材料的键合,具有键合应力小、真空封装不需要吸气剂的优点,对提高MEMS器件的性能、降低MEMS工艺成本等方面有极大作用。此外,此种MEMS结构能够有效降低芯片尺寸,提高MEMS器件抗过载等环境适应能力。
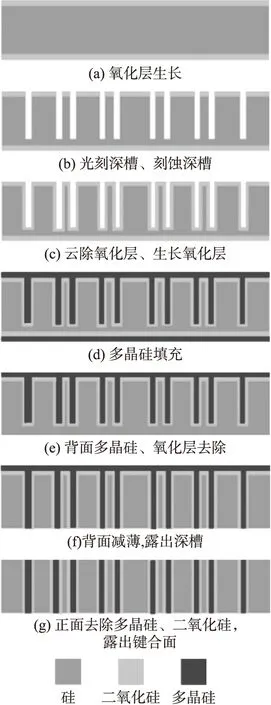
图2 TSV制作工艺流程
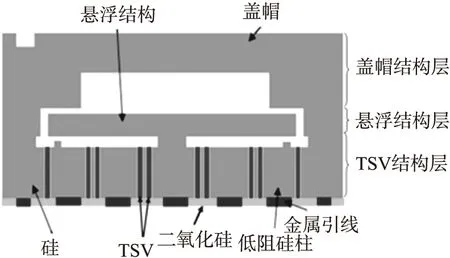
图3 TSV结构实现MEMS器件垂直引线
2 TSV刻蚀与填充实验
2.1 TSV深槽刻蚀实验
实验用硅片为P型<100>双抛硅片,电阻率为0.005 Ω·cm~0.025 Ω·cm,厚度为341 μm~352 μm;利用SPTS公司的LPX ASESR型刻蚀机实现深槽刻蚀,采用高频模式,线圈及极板射频频率均为13.56 MHz,线圈功率为600 W。试验中制作的TSV版图尺寸为6 μm,深槽刻蚀目标深度为200 μm,采用光刻胶和二氧化硅(厚度2 μm)作为深槽刻蚀掩膜。通过大量实验获得了四类深槽结构分别记为ⅰ、ⅱ、ⅲ、ⅳ,对应的刻蚀菜单分别是菜单Ⅰ、菜单Ⅱ、菜单Ⅲ、菜单Ⅳ,如表1、表2所示。

表1 菜单Ⅰ和菜单Ⅱ

表2 菜单Ⅲ和菜单Ⅳ
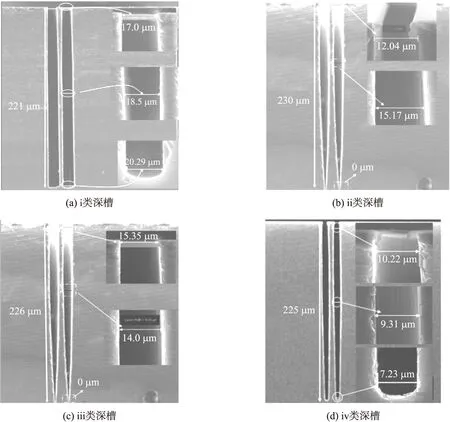
图4 4种深槽形貌
2.2 TSV深槽填充实验
利用SEMCO公司的F550型LPCVD设备对ⅰ、ⅱ、ⅲ、ⅳ四类刻蚀样片进行深槽填充,并利用SEM对深槽填充情况进行检查。
3 结果讨论
图4为刻蚀实验得出的四类深槽形貌。由于深槽目标深度为200 μm、深槽初始宽度为6 μm,深宽比大于设备能力(刻蚀深宽比20∶1),为了达到槽深要求,在循环单元刻蚀过程中设置钝化气体C4F8流量为0,其他参数设置详见菜单Ⅰ,对应获得ⅰ类深槽如图4(a)所示:深槽端口、中部、底部宽度分别为17.0 μm、18.5 μm、20.29 μm,槽深为221 μm。深槽从端口到底部尺寸依次增加,形貌呈现“上窄下宽”特征;减少循环单元刻蚀过程中刻蚀终点气体SF6流量,其他参数不变如菜单Ⅱ所示,得到图4(b)给出的ⅱ类深槽,图中结构端口、中部、底部宽度分别为12.04 μm、15.17 μm、0。深槽从端口到中部尺寸增加,中部到底部尺寸减小直至为0,形貌呈现“中宽两端窄”特征;减小菜单的刻蚀终点设置时间,其他参数不变见菜单Ⅲ,得出ⅲ类深槽如图4(c)所示,深槽端口、中部、底部宽度分别为15.35 μm、14.0 μm、0,即从端口到中部尺寸平滑减小,中部至底部尺寸减小直至为0,形貌呈现“上宽下尖”特征;菜单Ⅳ增加循环单元刻蚀过程中极板初始功率,其他参数不变,制作出ⅳ类深槽结构如图4(d)所示,深槽端口、中部、底部宽度分别为10.22 μm、9.31 μm、7.23 μm,深槽从端口到底部尺寸依次减小,形貌呈现“上宽下窄”特征。
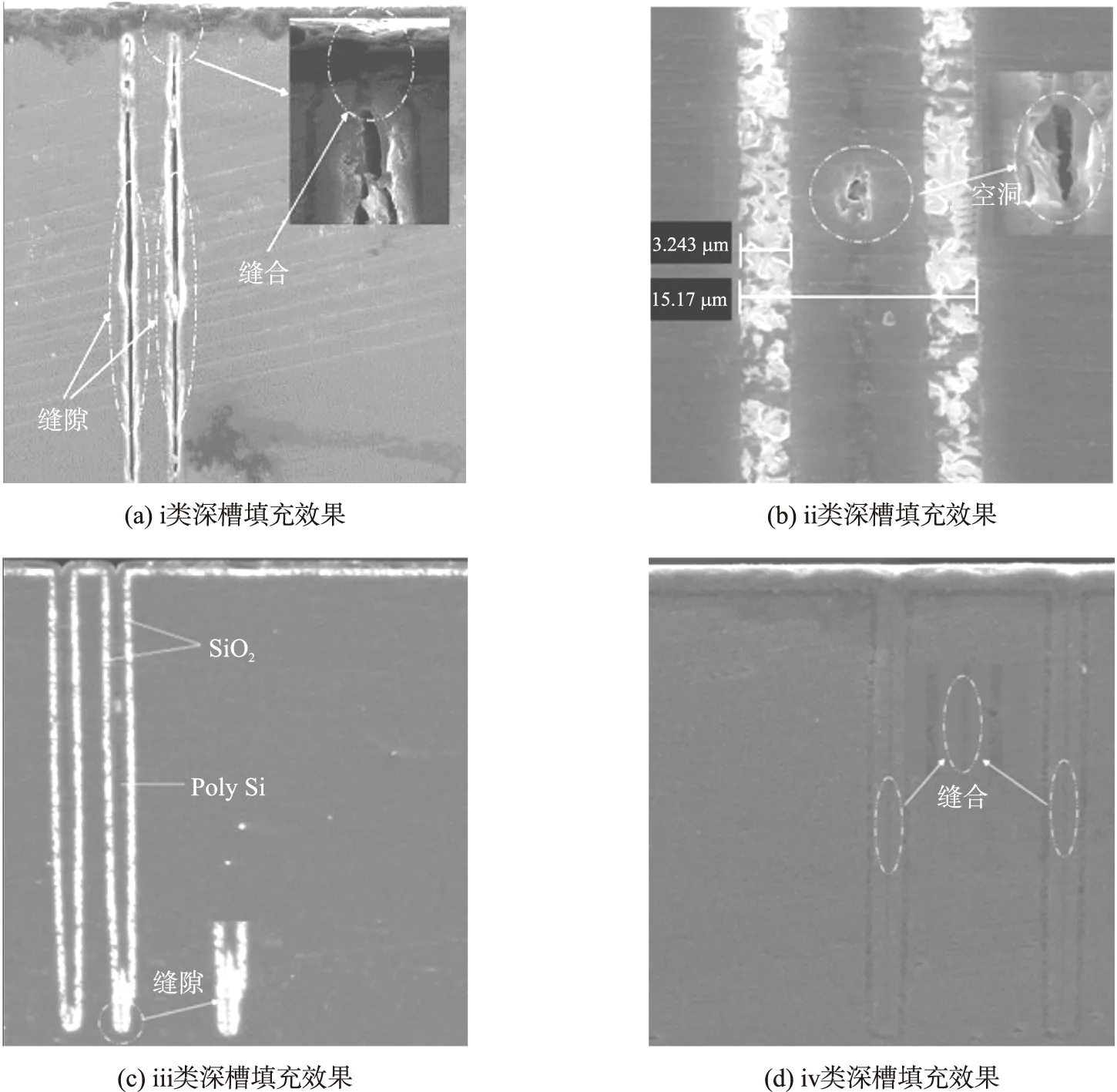
图5 4类深槽填充效果
针对图4中4种深槽结构,经过多次多晶硅填充实验,获得的填充效果分别如图5所示。ⅰ类深槽填充效果如图5(a)所示,深槽端口缝合、中部以下填充不完全。这是因为突然多晶硅在深槽端口处生长速率比深槽内部快,同时深槽端口尺寸较底部窄,无法实现深槽无缝填充;ⅱ类深槽填充效果如图5(b)所示,深槽端口缝合、底部填充完全,深槽中部出现空洞。这是由于多晶硅在深槽端口处生长速率比深槽内部快,同时深槽中部尺寸大于端口和底部尺寸,不能实现深槽无缝填充;ⅲ类深槽填充效果如图5(c)所示,实现了深槽的无缝填充。这是因为虽然进入深槽内部的沉积物量相比于端口处少,但是深槽中、下部的尺寸逐步减小,因而可以实现无缝填充。然而在制作隔离氧化层时不能保证底部充分氧化,存在漏电隐患;ⅳ类深槽填充效果如图5(d)所示,从图中深槽填充局部放大图可以看出深槽已实现致密无空洞填充,填充效果与ⅲ类深槽一致。不同的是,ⅳ类深槽底部有一定宽度,深槽底部可充分氧化,能够保证电绝缘要求。图5(d)中填充区域中间颜色较深部分为多晶硅逐渐缝合时留下的痕迹,可以通过沉积速率以及高温退火的方法改善;同时,快速退火也可以改善结构层内的应力状态。
对多晶硅填充后的TSV进行电学特性测试,即测量由TSV结构隔离的两部分体硅间电阻。测试结果表明,绝缘电阻均达10 GΩ量级以上,电绝缘性能优良。
4 结论
TSV技术用于三维封装可有效缩短互连线长度,减少信号传输延迟和损失,提高信号速度和带宽,降低功耗及减小封装体积等,是实现高性能、高可靠性MEMS器件的有效途径之一[14-16]。文中采用ICP刻蚀技术获得了深槽端口、中部、底部宽度分别为10.22 μm、9.31 μm、7.23 μm,深宽比为22∶1的深槽结构;采用LPCVD多晶硅技术实现了对该深槽结构的无缝填充;对填充后的TSV进行电绝缘特性测试,测试结果表明,其绝缘电阻可达10 GΩ量级以上,获得了与半导体工艺兼容性好的TSV结构。
[1] Cheng H C,Li R S,Lin S C,et al. Macroscopic Mechanical Constitutive Characterization of Through-Silicon-via-Based 3-D Integra-tion[J]. IEEE Transactions on Components,Packaging and Manufacturing Technology,2016,6(3):432-446.
[2] Yaghini P M,Eghbal A,Yazdi S S,et al. Capacitive and InductiveTSV-to-TSV Resilient Approaches for 3D ICs[J]. IEEE Transactions on Computers,2016,65(3):693-705.
[3] Yin X,Zhu Z,Yang Y,et al. Metal Proportion Optimization of Annular Through-Silicon via Considering Temperature and Keep-Out Zone[J]. IEEE Transactions on Components,Packaging and Manufacturing Technology,2015,5(8):1093-1099.
[4] Jin C,Li Y,Li R,et al. Built-in-Self-Test-Stacked 3-D Ring Oscillator Based on Through Silicon Vias[J]. IEEE Transactions on Components,Packaging and Manufacturing Technology,2015,5(2):217-224.
[5] 袁娇娇,吕植成,汪学方,等. 用于3D封装的带TSV的超薄芯片新型制作方法[J]. 微纳电子技术,2013(2):1-7.
[6] 史训清,马薇,谢斌,等. Pulsed Laser Bonding Method for Stacking Electric Elements Based on Silicon Throughhole[P]. 中国专利,101379892 B. 2014-09-24.
[7] 燕英强,吉勇,雪飞. 3D-TSV封装技术[J]. 电子与封装,2014,14(135):1-3.
[8] 余小飞. 紫外光激光加工盲孔的工艺研究[J]. 印制电路信息,2011(4):62-66.
[9] Ye Jiaotuo,Chen Xiao,Xu Gaowei,et al. Investigation of Wet-Etching- and Multiinterconnection-Based TSV and Application in 3-D Hetero-Integration[J]. IEEE Transactions on Components,Packaging and Manufacturing Technology,2014,4(10):1567-1573.
[10] 陈颖慧,张慧,施志贵,等. 圆片级封装中硅帽的设计和加工[J]. 微纳电子技术,2015(10):649-653.
[11] 肖胜安,程晓华,吴智勇,等. 一种金属填充硅通孔工艺的研究[J]. 固体电子学研究与进展,2012,32(2):180-183.
[12] 陈东红,安坤,燕乐,等. 基于八悬臂梁-中心质量块结构MEMS压电振动能量采集器[J]. 传感技术学报,2015,28(12):1770-1773.
[13] 何凯旋,黄斌,段宝明,等. MEMS悬浮结构深反应离子刻蚀保护方法对比研究[J]. 传感技术学报,2016,29(2):202-207.
[14] 祁飞,杨拥军,杨志,等. 基于MEMS技术的三维集成射频收发微系统[J]. 微纳电子技术,2016(3):1-5.
[15] Wang Z. 3-D Integration and Through-Silicon Vias in MEMS and Microsensors[J]. Journal of Microelectromechanical Systems,2015,24(5):1211-1244.
[16] 王宇哲,汪学方,徐明海,等. 应用于MEMS封装的TSV工艺研究[J]. 微纳电子技术,2012(1):1-6.
Fabrication of Through-Silicon-Vias Filled with Polysilicon
WANGWenjing*,HEKaixuan,WANGPeng
(East China Institute of Photo-Electron IC,Bengbu Anhui233042,China)
TSV(Through Silicon Via)for MEMS device can realize the vertical interconnection of device structures,then we can achieve the purpose of reducing the chip area and decreasing the power consumption of the device. we discussed the fabrication and filling processes of TSV. By optimizing the ICP etching processes,we get the TSV structure whose opening,middle and bottom size smoothly decreases,and the ratio of depth to width is greater than 20∶1;we use LPCVD(Low Pressure Chemical Vapor Deposition)technology to realize the seamless filling of TSV with polysilicon;After testing of the TSV structure for Insulation characteristics,the insulation resistance of the TSV is more than 10 GΩ,that is,the electrical insulation performance is excellent.
MEMS;TSV;ICP etching;LPCVD;seamless filled;Insulation characteristics

王文婧(1984-),女,工程师,2010年毕业于北京理工大学物理学专业,获硕士学位,现从事MEMS工艺技术研究。
2016-05-19 修改日期:2016-06-07
TP393
A
1004-1699(2017)01-0059-05
C:7230
10.3969/j.issn.1004-1699.2017.01.012

