塑封功率器件封装失效分析技术研究
张金彪,王 蓬
(广州海格通信集团股份有限公司,广东 广州 510663)
塑封功率器件封装失效分析技术研究
张金彪,王 蓬
(广州海格通信集团股份有限公司,广东 广州 510663)
功率器件是工业生产中一类重要的基础器件,其质量及可靠性水平深受广大学者关注。文章通过对功率器件封装形式、失效诱因及国内外专家学者对功率器件塑封封装失效的研究进展进行总结,希望能够为相关分析研究提供参照。
功率器件;封装失效;研究进展
功率半导体技术是现代电子技术的基础。功率半导体器件广泛地应用于电信、手机、家电、汽车等行业,是一种不可或缺的基础性产品。随着功率器件的大功率化、高频化、集成化发展,其内部结构及应用环境日渐复杂,工作中受到的应力逐渐增加。而良好的器件封装有助于保证器件的可靠性水平,因此本文对功率器件的封装失效原因、研究进展等进行分析,以期能够为相关人员提供参考。
1 功率器件的封装形式
功率器件的封装形式多种多样,但是因为塑料封装在成本、尺寸、重量等方面具有相当的优势,因此工业上功率器件多采用塑料封装。同时,因为塑料封装的可靠性近年来有了很大提升,在航天、军工等领域亦受到越来越多的关注,因此对功率器件塑料封装进行研究,提高其使用可靠性具有一定实际意义。常见功率器件封装形式如图1所示。
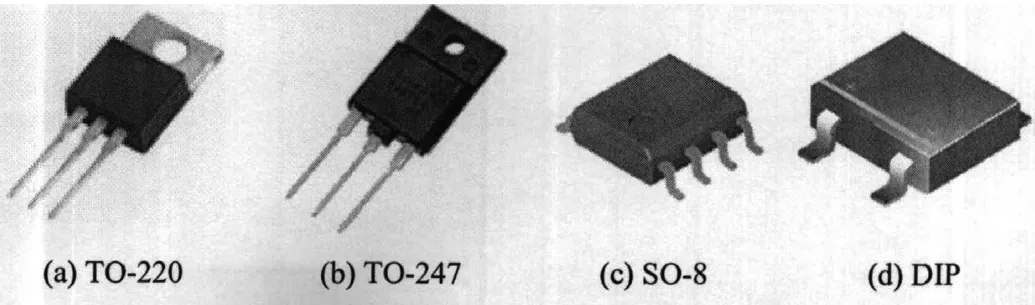
图1 常见功率器件封装形式
1.1 螺栓型、平板型封装
螺栓型及平板型封装作为传统的大功率半导体器件封装形式,多年以来一直沿用至今。螺栓型和平板型封装模式外壳和管芯的接触方式有所不同,平板型结构是通过压接方式实现的,可采用双面散热,而螺栓型是通过焊接或压接的方式将管芯和外壳进行连接。在这两种封装形式的发展中,平板型结构也可以通过双面散热进行,其封装多由金属和陶瓷组成。
1.2 功率模块
近年来,单个IGBT,双IGBT,IGBT三相桥等IGBT模块日渐普及。功率模块封装集成度高、形式多样,如模块内部可将保护、触发及控制电路与IGBT进行连接。对于功率较小的情况下,可以采用MOSFET模块。此外,多芯片模块是一个新的方向,功率模块封装材质可以是陶瓷、金属或塑料,视器件应用环境的可靠性要求而定。
1.3 塑封直列式封装
塑封直列式封装常见的封装形式有TO-220及TO-247等,如图1(a)(b)所示。此种封装形式已经能够实现大电流的传输,如IR公司采用的Super TO-247封装形式就是典型代表,最高允许电流可达210 A。同时,通过器件反面的散热铜板将器件散发的热量,传导至PCB板或者金属散热器,有效降低了器件内部的温升,保证器件具有良好的散热能力。
1.4 塑封表贴封装
此种封装形式是20世纪80年代以后发展起来的,能够实现器件的小型化,易于提高生产效率。一部分是将直列式封装改为表面贴装,典型代表是SMD-220;另一部分是沿用表贴集成电路的封装形式,最早多采用DIP封装形式,如IR公司至今仍采用该种封装,如图1(d)所示,但更为常见的封装形式为Mirco-8和SO-8,如图1(c)所示。通过借鉴集成电路封装形式,标贴塑封功率器件的引脚数逐渐增多,能够有效地提高器件散热能力。
1.5 高可靠封装
对于航天以及军工行业而言,因其对器件的可靠性要求较高,因此器件封装多采用金属封装。
2 功率器件塑料封装常见失效模式
2.1 早期失效
早期失效主要是由塑封工艺不完善以及工艺缺陷导致的,失效主要发生在芯片焊接、引线键合及注塑等工艺过程中。目前,随着塑封封装材料及工艺的不断发展,塑封器件的早期失效率已经得到本质上的提升,试验表明经1 000次温度循环试验,塑封与气密性封装器件的电性能参数相差无几,因此,当前在航天和军工领域,塑封器件均已经进行了一定的应用,如美国TIMED项目中采用了2 GB的塑封固体记录仪,我国神州4号飞船中采用塑封工艺的热电偶放大器AD594C等。但是,无法否认塑封封装受限于其材料特性,在使用过程中仍易受到潮湿及热应力影响导致失效,因此本文主要关注塑封器件的使用期失效。
2.2 使用期失效
塑封器件在使用过程中会经受各种环境及工作应力而导致失效,主要分为热应力失效及湿度应力失效。
2.2.1 热应力失效
热应力失效是由于组成器件的各材料间膨胀系数不同导致的失效;由于塑封功率器件内部的材料热膨胀系数存在一定的差异,在高温及温循条件下,封装内部容易形成应力集中,当应力达到一定程度时则会引起分层及开裂,从而导致失效。需要注意的是环氧树脂的玻璃化温度比较低,与功率器件的工作温度较为接近,因此,在该温度下,塑封封装的热膨胀系数和杨氏模量会产生较为明显的变化,从而导致器件工作状态的不稳定乃至失效,如封装分层等。这将加速湿气的渗透,进而导致芯片金属化层或钝化层的破损;在芯片散热不足时,会导致环氧树脂碳化,造成短路,此外,长期在热应力作用下,还将导致器件的焊球等疲劳失效。
2.2.2 湿度应力失效
湿度应力失效主要是湿气渗透到器件内部导致的失效,潮湿气体通过塑封器件的粘接界面或环氧树脂进入到器件内部,可以导致芯片表面或引线的腐蚀,从而导致功率器件电性能参数的退化及失效。同时,引线的腐蚀还将加剧粘接界面上环氧树脂的离解,使得湿气更加容易进入器件里面。此外,若塑封功率器件长期处于潮湿环境时,环氧树脂和芯片粘接材料吸收湿气会降低黏结强度,在器件PCBA过程中,器件温度迅速升至240 ℃左右,将会发生“爆米花”效应,造成引线、焊球移位、脱落甚至断裂,更有甚者会造成封装开裂及芯片损坏。
3 功率器件塑封封装失效试验及数学模型仿真研究
塑封功率器件应用范围广泛,而其封装的可靠性直接影响器件质量,因此功率器件塑封封装的失效研究成为当下国内外研究热点。相关领域学者在从多个角度对塑封封装的失效进行了研究,部分学者通过试验的方式展开分析,还有部分学者通过数学建模仿真的方式进行研究,本文从以上两个方面对国内外封装失效研究进展进行总结,以期对专业人员开展相关研究提供参考。
3.1 功率器件塑封封装失效的试验研究
试验研究的目的为通过观察塑封封装材料在环境应力下的变化及导致器件失效的过程,通过优化封装材料及工艺过程,从而提高器件可靠性,一般分为两方面。
3.1.1 环境条件对封装材料的影响
(1)湿度的影响,Li等通过对环氧树脂材料性能改进以及改进后材料的吸水性及应力变化等进行试验观察,得出了水分是导致塑封材料膨胀系数等参数变化的一种诱因,同时改进封装材料有助于提高器件的可靠性;(2)温度的影响,Boudefel等通过高温及温循试验等方式,验证环氧树脂的介电常数、膨胀系数、弹性模量等电学、力学性能参数受温度显著影响,改善器件封装过程及使用温度,有助于提高器件的可靠性;(3)温湿度综合影响:器件在使用过程中,实际上受到温度、湿度等多种应力影响,Sadeghinia等通过试验表明,在器件封装过程中温度及湿度应力发生耦合作用,显著影响其热力学性能。此外,随着功率器件的大功率化,芯片内部会产生较高热量,形成应力集中从而导致器件失效。而随着塑封功率器件更多地应用于航天、军工等领域,电场对其封装失效的影响逐渐显露,这将是一个新的研究方向。
3.1.2 塑封封装失效演变过程研究
通过对塑封封装在多应力作用下失效的渐变过程分析,有助于找出导致其失效的诱因,从而改善制程及材料特性。Zhang等在塑封成型材料上预留V缺口,分别通过施加温湿度应力及机械应力的方式,分析得出了环氧树脂在多应力耦合的作用下,其裂纹易扩展,封装失效过程加剧。Siow等对金属—聚合物界面的分层及界面断裂过程进行研究,发现温度加速了界面分层的产生及扩展,而界面处的微裂纹缺陷将导致粘接不良,有关金属—聚合物界面的研究尚需进一步发掘。
3.2 功率器件塑封封装失效的数学建模仿真研究
数学建模仿真研究能够从理论上快速辅助功率器件封装失效分析研究。为节约成本,Hsu采用了有限元模拟结合Weihull统计的方法,替代了加速寿命试验,对器件的平均失效率及加速因子进行了预计。Kim等利用LS-DYNA3D商业软件分析了改善功率器件抗冲击能力的材料,为改进相关设计提供参考。
对于环境应力对塑封材料失效的影响程度同样可以采用数学建模仿真进行研究。Chang等应用分子动力学模型对功率器件塑封封装吸湿性进行了探索,指出其是器件封装失效的重要因素之一。我国李志刚等采用空穴增长—湿热应力关系模型,发现功率器件封装材料存在缺陷时更易发生界面分层。而在温湿度共同作用下,封装材料内部易产生孔穴并导致分层。Xin等通过分子力学动力模型揭示了聚合物金属铜界面分层机理。Guo等建立微观力学模型,结合数值与增量计算,揭示了封装过程真空度、温度对界面分层及塑封材料形变的影响。
封装失效的建模仿真研究具有直观、快速的优点,但是其仿真结果受限于仿真人员的经验和理论水平,故在实际研究中需要结合试验研究同步开展。
4 结语
功率器件作为工业生产过程中重要的基础性产品,其塑封封装失效获得普遍关注。当前研究主要为通过试验及数学模拟仿真的方法,以高聚物封装材料作为分析对象,讨论其在环境应力作用下的失效机理。但是对多应力耦合作用下封装整体的失效机理及失效进程讨论较少,可以作为后续深入研究的方向。
[1]洪彬,胡菊,吕顺雅,等.功率器件封装失效分析及其研究进展[J].热固性树脂,2017(1):66-70.
[2]周军连,王蕴辉,唐云.塑封微电路在高可靠领域的应用、筛选与鉴定[J].电子器件,2007,(25):48-51.
[3]张鹏,陈亿裕.塑封器件失效机理及其快速评估技术研究[J].封装测试技术,2006(9):676-679.
[4]王晓珍,熊盛阳,张伟,等.军用塑封电路分层及可靠性方法研究[J].电子工艺技术,2016(11):316-319.
[5]ZHANG JP. Fatigue crack propagation behavior of underfill materials in microelectronic packaging[J].Materials Science and Engineering A,2001(1):194-200.
Research on failure analysis technology of plastic encapsulated power device package
Zhang Jinbiao, Wang Peng
(Guangzhou Haige Communication Group Co., Ltd., Guanghzou 510663, China)
The power devices are an important kind of basic device in industrial production, the quality and reliability level are paid close attention by the majority of scholars. This paper summarizes the research progress of the package form, encapsulated failure of power device and the experts and scholars at home and abroad on the failure of plastic encapsulated power device package, hoping to provide reference for the related analysis and research.
power devices; package failure; research progress
张金彪(1987— ),男,内蒙古赤峰,硕士;研究方向:可靠性设计,可靠性试验。

