磁控溅射氮化钽工艺的等离子体发射光谱分析
刘志宇++傅刚

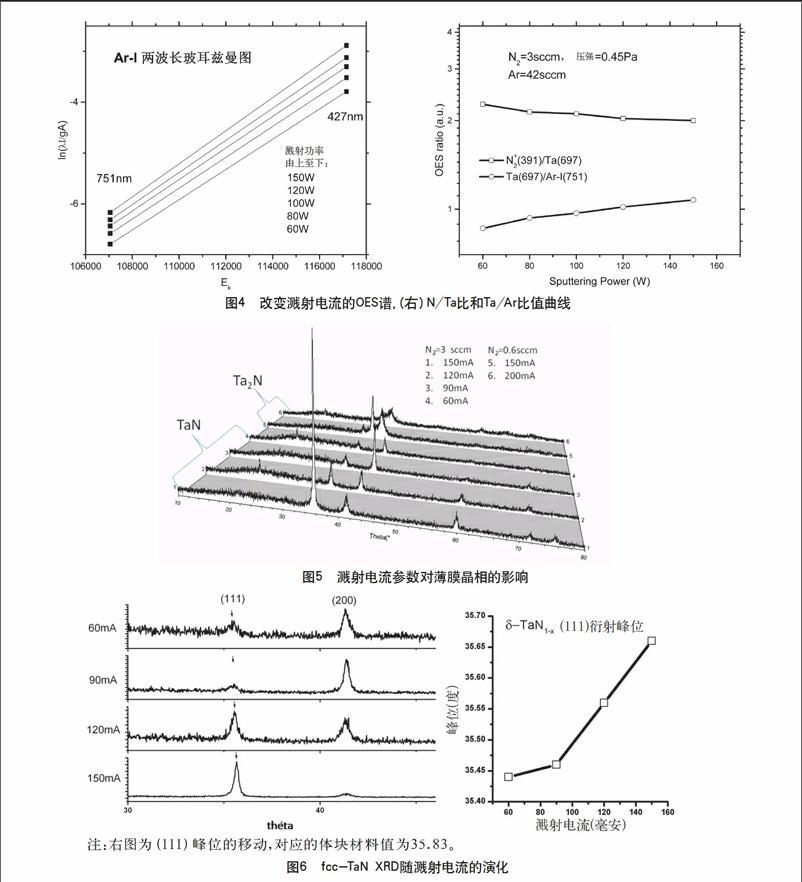

DOI:10.16660/j.cnki.1674-098X.2017.25.011
摘 要:本文讨论采用等离子发射光谱(Plasma OES)作为一种独立于具体溅射装置的仪器参数的工艺参量,并在微波薄膜电阻器的氮化钽溅射制备工艺中考察了这种方法的有效性。首先分析了OES中对应于活性氮成分N2+和Ta的谱线强度与传统溅射参数的关系,结果显示单调增加溅射功率会降低等离子体成分中活性氮成分的比例,从而将成膜参数向低氮和低TCR的窗口方向移动。从OES谱线中计算的两波长玻尔兹曼图定性地显示了等离子体激发温度与溅射功率的单调关系。其次,通过将OES谱线分析结果与晶体结构(XRD)、晶粒大小(AFM)和电阻温度系数TCR等物性测量相比较,证明Plasma OES是一种可靠的溅射工艺在线监测手段。
关键词:磁控溅射 等离子发射光谱 氮化钽
中图分类号:TB383 文献标识码:A 文章编号:1674-098X(2017)09(a)-0011-08
Abstract: The possibility and potential of utilizing the Plasma Optical Emission Spectroscopy (Plasma OES), as a Device-Independent characteristic, in the Magnetron-Sputtering deposition of Tantalum Nitride thin films has been studied. Firstly the OES was used to reveal the correlation between the density of active nitrogen species N2+ in the plasma and the traditional sputtering parameters. It was shown that increasing the sputtering power can lead to decrease in active nitrogen ratio, hence a shift of parameters to the more Ta-rich side of the growth window. The relation between input power and the temperature of the plasma was qualitatively determined. Then the structural, morphological and electrical properties of the samples were compared with the OES characteristics to prove its feasibility.
Key Words: Magnetron Sputtering; Plasma Optical Emission Spectroscopy; Tantalum Nitride
1 磁控濺射制备氮化钽(TaNx)薄膜的多相性及参数控制
利用氮-氩气氛反应磁控溅射的方法制备的氮化钽薄膜(TaNx)通常为多相共存的体系,其化学成分和晶体结构受多个工艺参数的影响,包括N2/Ar气体流量比,溅射功率,衬底温度[1-6],衬底预处理工艺和籽晶层的制备等[7,8]。由于TaNx体系在x取值从0增大到1的过程中发生了金属(bcc α-Ta或tetragonalβ-Ta)到绝缘体(例如Ta2N和各种立方及六角结构的TaN或TaN0.1等)的电学性质变化,因此在文献中被研究得最多的制备参数是氮-氩流量比。实际上对于特定的磁控溅射设备而言,由于溅射室的结构,靶材尺寸,所使用溅射电源等因素的影响,“氮-氩比参数”是不能独立于具体仪器来讨论的,也就是说采用同样的氮-氩流量比在不同的系统上(例如直流脉冲磁控溅射与射频磁控溅射)所获得的薄膜的化学成分和微观结构差异很大(参见[2,4,5,7]等所给出的参数空间相图)。
出于以上的考虑,在利用常规方法优化现有的溅射设备上的工艺参数的同时,我们也尝试寻找独立于具体仪器系统的工艺参量,以此来加深对TaNx溅射镀膜的物理机制的理解。在本文中我们具体描述使用独立组件搭建而成的“等离子体光学发射谱(OES)设备”在实时监测磁控溅射TaNx薄膜的过程中Ar-N-Ta等离子体成分和能量上的初步结果。
2 基于直流脉冲磁控溅射的氮化钽(TaNx)薄膜反应溅射和OES特性分析
2.1 镀膜设备和工艺准备
本工作的主要镀膜设备为一台JCP-350型磁控溅射镀膜机(北京泰科诺科技有限公司),该机配置两个永磁靶,可使用直径50mm的金属和陶瓷靶材(实际溅射中race track直径约为40mm)。基片台到靶面距离约为55mm,基片最高温度350℃左右。作为溅射气体的氩气和反应气体的流量由相互独立的质量流量控制器(MFC)调节。TaNx镀膜使用直流脉冲电源(频率40kHz),电源最大输出功率380W。在溅射真空室正前方与基片台等高处设有光学观察窗口(直径80mm),窗口材料采用高纯度石英,实际可用的透过波长范围下限为290nm。由独立组件构成的OES采集系统包括大口径凸透镜组、WGD-3型光栅光谱仪(天津港东,光栅1200线,采用光电倍增管)、可移动升降平台和计算机控制系统。光谱仪可以在波长扫描和定波长两种模式下工作,后者用于监控及稳定等离子体,校准光路和微调谱仪进、出口狭缝之用。在累计采集数据数小时后,光学窗口被镀膜覆盖部分开始影响数据的一致性,因此每次实验后石英窗口都需经化学方法清洗(EDTA水溶液)。具体装置如图1所示。endprint
实验中主要使用玻璃基底。玻璃的处理包括常规的去油步骤和24h以上酸洗。溅射使用2英寸高纯钽靶材(4N),溅射和反应气体采用高纯Ar和N2。
2.2 TaNx磁控溅射镀膜的光学发射谱分析:溅射功率和氮-氩比
等离子体光学发射谱(Plasma OES)作为一种非接触的诊断手段被广泛用于各种等离子体的参数测量,例如:样品成分分析[9,10]、等离子体分析[11,12]、金属表面低温等离子体氮化[13,14]、磁控溅射[15,16]的工艺控制等。在我们的实验中,光栅光谱仪被用于采集溅射镀膜各阶段的可见和紫外光发射,后者主要来源于等离子体中溅射和反应气体(Ar,N2)的分子和离子以及被溅射材料(Ta)原子的辐射退激发:
IX=kCexcnenX (1)
其中,IX为OES强度,nX为处于基态的X分子/离子在等离子体之中的密度,ne为电子密度,Cexc是X的激发速率参数,k为常数[11]。从式(1)可知OES信号与等离子体的成分和能量密度(等离子体的温度)直接相关。研究表明在TiN和TaNx溅射镀膜工艺中可以使用等离子体发射中相应谱线强度来近似估计该成分的离子密度[11-15]。因此,只要将谱线与元素原子发光标准谱线相比对[17],原则上可以利用OES定量地测定到达基片的各元素原子比例(此处主要为Ta/N比),从而实现对参数的实时监控和调整,以纠正薄膜成分的偏差。
图2显示了通过调整氮气/氩气比例所得到的一族典型的OES原始数据,将之与标准光谱数据库[12,13,14,17]相比对就得到可做半量化处理的谱线数据。
图3中总结了改变TaNx镀膜工艺中两个最典型工艺参数时的OES数据。在左图中,可以看到除N2离子在高功率情况下出现明显的饱和趋势之外,Ar-I,Ar-II和Ta的发射光谱与溅射电流成很好的线性关系。Ar-I在751nm附近的谱线已经非常接近该光栅光谱仪的探测极限(200~800nm),因此该波长对OES-电流线性关系的偏离尚有待重新确认。在右图中N2+离子在氮气流量为零处的非零值有可能来源于预溅射不彻底在靶面上遗留的氮化层,或者来自于阴极屏蔽罩上的吸附氮。
N2+在391nm辐射跃迁是被用于分析钢铁氮化工艺中等离子体所含活性氮浓度的最重要谱线之一[12,13,14],因此图3(左)中N2+的随参数演化趋势值得仔细分析。N2+辐射的饱和趋势可以用达到动态平衡的二能级系统的速率方程来简单理解。随着直流脉冲输入功率的提高,N2+391nm辐射跃迁所对应的上、下能级的占据几率差逐渐缩小,导致激发速率随溅射功率增加而升高的速度变慢直至停滞,此时如果在等离子体中N2+的密度不再增加,则处于上能级的原子/分子/离子密度也趋于饱和。这个结论的意义在于:在直流脉冲磁控溅射系统上,提高溅射功率除了可以增加沉积速度、改善成晶质量(高能带电离子对生长表面的轰击作用[9])之外,还会造成等离子体中活性氮的比例下降,从而降低薄膜中的氮元素含量,使生长向低电阻小TCR的参数区间移动。这是因为Ta的浓度在很宽的功率范围内随Ar离子浓度的升高而升高,靶面上被溅射出的Ta原子因为具有很高的动能会迅速离开,不会与周围的气态物质达到热平衡,因而不会出现饱和。需要指出的是,由于我们的系统上使用小尺寸靶材,靶材被溅射区域(race track)直径为40mm左右,因此出于保护永磁靶的考虑最高溅射功率一般不超过135W(对应于溅射电流180mA)。对左图中数据进行再次处理,还可以观察到(Ta/Ar)随功率升高,即溅射率S随等离子体能量密度的增加而提高。对“OES-溅射功率”的总结如图4(右)所示。
在图3的右图中,随着氮气在混合气体中百分比的增加,Ar和Ta的谱线强度都明显呈降低趋势,表明在N2=1.5sccm,即(N2/N2+Ar)=3.3%的条件下靶面已经发生氮化,所生成的TaNx表层具有比金属态钽更低的二次电子发射系数γ,等离子体能量密度随之降低[2,9]。在参考文献[2]中列出了使用探针法分析的反应溅射TaNx等离子体参量诊断结果,与我们的OES结果定性上一致。在实际操作中可以观察到溅射电流随1%量级比例的氮气的注入而明显降低,需调高电源输出才能保证溅射电流稳定。
图4(左)为Ar-I的两波长(751nm,427nm)波尔兹曼图。在假设等离子体趋于局部热平衡的前提下,从图中直线族的斜率可确定等离子体的离子温度[10-14],又称为激发温度(excitation temperature)。由于我们搭建的OES采集系统未经过全频域的校准,因此等离子体激发温度随功率增加而升高這一结论只能定性地从斜率的趋正倾向得出。在图4右图中N/Ta随功率下降为12%,Ta/Ar随功率增加24.4%,表明在保持其他参数不变的情况下单调增加溅射功率会使镀膜向“富钽”的方向移动,与图3的分析中结论一致。
3 磁控溅射TaNx多晶薄膜的结构和电阻温度特性
直流脉冲磁控溅射氮化钽(TaNx)多晶薄膜的晶体结构和电阻温度特性如下。
(1)溅射电流(功率)对氮化钽晶体结构的影响。
在目前已有的关于氮化钽溅射镀膜的文献之中,可以查到的往往只有氮-氩比和基底温度的参数相图。本文研究溅射功率对于薄膜晶相的影响,是因为从文献[8,12,13,14]和我们前期的OES测量结果(图3,图4),都可以得出有效氮-氩比,即处于激发态的N2分子和离子或原子氮的密度不仅仅由进入真空室的氮气流量决定的结论。因此所谓“氮-氩比参数”实际上隐含了氮气分子和离子被激发的效率,而后者直接受到等离子体平均能量密度,即离子温度(激发温度和电离温度,参见文献[10]中定义)的影响。从这个角度来说研究“氮-氩比参数”不能忽略溅射电流的影响。
图5是两个溅射电流系列(高氮和低氮)共6个样品的XRD图谱概况。endprint
对照标准衍射卡片可知通入3sccm氮气时(N2/N2+Ar=6.7%,高氮系列)在较宽的功率范围内可以得到单一晶相的薄膜。已有文献报道的生长窗口(例如[1,2,5])在这个氮气流量比参数之下,薄膜生长仍然以低电阻、低TCR的六方相Ta2N为主(PDF#26-0985)。与文献中报道的结果不同的是,在我们的磁控溅射仪上该参数下制备出的是fcc TaN (PDF#49-1283)。图5中有两个特点值得注意。除了使用150毫安溅射电流制备的薄膜之外,其它样品的XRD衍射峰都相当弱,并且展宽明显,这显示在这组参数下制备的氮化钽薄膜晶化质量不高,除了晶粒小,缺陷密度高(见下面分析)之外,还有相当比例以非晶态的形式存在于薄膜内。图5的另外一个特点是(200)和(111)两个晶面族的相对强度变化。在以最高功率(150mA,约112W)溅射时,所沉积的fcc TaN薄膜呈现出很强的(111)取向,成为类似于单晶膜的有序相。随着溅射功率的降低,来自(111)的信号迅速降低,而(200)信号上升,显示(200)取向的晶粒开始占薄膜内晶相部分的主导地位。(200)与(111)之比在90mA(68W)时达到最大。此后继续降低溅射功率导致成晶质量恶化。与此完全一致的多晶晶粒取向变化趋势也出现在氮-氩比参数生长相图中([1,2,5],见下文结果)。根据从光谱分析中得出的“氮氩比-溅射电流”关系(见图3,图4),图5中的fcc TaN在(111)与(200)晶相上的取向变化可以部分地用等离子体中的活性氮与氩离子的比例来解释。图3(左)和图4(右)中显示随溅射功率降低,等离子体中活性氮(N2+离子)的发射谱线与Ta和Ar-I的发射谱线之间的比例升高,表明等离子体种活性氮的比例升高,因此薄膜生长应该向生长参数空间中高氮-氩比(生成薄膜高氮-钽比)的方向移动。
图6列出了“高氮系列”的XRD图谱细节,在右图中总结了(111)峰位随溅射电流的移动。可以看到(111)的总趋势是随溅射电流减小强度上减弱,半高宽变大,峰位向低角度移动。Nie等[1]研究了Ta-N体系溅射薄膜随氮-氩比发生的同样变化,趋势和量级都与本文结果相符。考虑到氮化钽的这个面心立方相缺陷密度高,含氮量可以在相当宽的区间内取值而不会导致晶体不稳定,因此这种量级的晶格扩张(大约为1%)是正常的:随着溅射气体中氮分压的增加,晶格有扩大的趋势。在我们的溅射电流参数空间中观察到类似的变化,证明了OES分析结果的正确性。
图7是“高氮系列”的AFM(DFM模式)表面形貌分析。在图中可以看到晶粒大小随溅射电流变化。需要指出的是,由于调整溅射电流可以引起晶粒择优取向的改变,溅射功率对薄膜的物理性质(特别是表面粗糙度,晶粒大小等)的影响不再是单调的。
表1汇总了根据电阻测量,XRD和AFM图谱计算出的薄膜物理参数。AFM数据为原子力显微镜图片分析软件SPIWIN自动给出,XRD数据使用谢洛公式和布拉格公式计算得出,衍射峰FWHM采用了占优势的衍射峰的数值(即150mA和120mA从(111)的衍射数据得出,90mA和60mA从(200)得出)。由于在这组样品中晶相未发生根本变化,电阻率随功率增加而单调下降应该解释为薄膜内多晶晶粒尺寸变大和缺陷密度降低的结果。另外,始终存在的非晶相的比例随功率增加而迅速减小,也是电阻率降低的一个原因。
图5中的第二个溅射电流系列对应氮气流量为0.6 sccm,占总进气量的1.3%(“低氮系列”)。从XRD图谱观察,这一系列两个样品区别于“高氮系列”的特点主要有:
(1)薄膜的总XRD信号较弱,显示出有非晶相的TaNx或Ta存在。
(2)衍射峰移位和展宽远大于高氮样品,并呈现明显非对称峰形,说明低氮薄膜为多相(化学相和晶相)共存体系。
(3)主要晶相从高氮样品的fcc TaN演变为六方相的Ta2N。
在这个系列中溅射电流对薄膜晶相的作用可以从混合相成分的角度来分析。目前被引用最多的Ta-N反应溅射参数相图[1,2,5,6,7]都指出在从纯氩溅射开始增加N2入气量的条件下,薄膜生长大致按以下次序演化:α-/β-Ta,bcc TaN0.1和其他贫氮相,hexagonalγ-Ta2N,cubic δ-TaN1-X。这个生长参数图里的最后一个相对应于前面分析的高氮样品,在文献中对这个区域的起始点说法差异很大,最低氮-氩流量比从5%~15%都有报道。Ta-N体系在低氮区域如此丰富的生长相图带来的直接后果是在低氮条件下很难形成单一晶相,甚至单一化学相薄膜也是不可能的(除了纯金属Ta),而薄膜成分对等离子体含氮比例敏感。根据我们前面对OES数据和高氮样品晶粒取向的分析,在低氮样品中溅射电流应该能再现“经典生长相图”中氮-氩比的作用。图8中200mA溅射电流的样品在高角度上的衍射峰((102),(110),(103)和(112))顯示样品中Ta2N占据晶相的主要部分。在低角度上,对应(101)的信号向低角度方向呈现展宽。除了可能发生的(002)峰经过展宽与之重叠,更合理的解释是在2theta(35°,40°)这一区间内来自于β-Ta的衍射信号(峰位参见图9中的细状图)。因此这一样品可以视为主要是hexagonal Ta2N和β-Ta的两相混合。在当前的生长参数下β-Ta晶化质量很差(见下文分析),这就解释了200mA溅射样品的XRD信号微弱的原因。当溅射电流降低到150mA(图8上方谱线),衍射图谱显示薄膜晶相发生很大变化,其中Ta2N的(101)在强度上被2theta=36.1°的信号超过。150mA样品的谱线看似一个(002)取向占优势的Ta2N多晶样品。但是仔细分析对应Ta2N的3个主要衍射峰位之后,我们发现除较弱的(100)没有发生明显位移之外,(002)和(101)都有很大的向低角度平移,其中2theta=36.1°的衍射峰距离fcc TaN的(111)衍射峰(2theta=35.83°)非常近,而Ta2N的(002)为36.541°。因此降低溅射电流所得到的样品实际为hexagonal Ta2N与(111)取向的fcc TaN的混合相。endprint
从以上分析中,我们看到了低氮样品的溅射电流系列演化趋势与光谱数据相吻合。
低氮样品的电阻率已经接近100cm的量级,具体电特性见下文TCR测量结果。
(2)氮-氩流量比对氮化钽晶体结构的影响。
图9为氮-氩比参数系列XRD测量结果的概况。在这一组参数下未能在纯氩溅射的样品中观察到β-Ta的衍射峰。在图中标示的图例是根据溅射参数的推断。我们注意到生长这一系列样品所使用的基片温度(大约200℃)恰好处于文献中bcc α-Ta与tetragonal β-Ta两相生长窗口的中间附近[2]。Ta的这两个相的晶体结构和晶格常数都相差极大,而在生长窗口交叉部分从原理上说这两个相的自由能相近,因此在成核和岛状生长的过程中不会自发向层状生长过渡,导致晶粒非常小[18]。用于制作小TCR薄膜电阻器的Ta2N其生长参数空间较窄,意味著膜的质量对氮-氩比参数和与之相关的其他工艺条件较敏感,这个是保证镀膜质量可重复性要解决的问题。在图9中是和文献中基本一致的生长参数相图。在我们的系统中尚未在Ta-Ta2N和Ta2N-TaN这两个过渡区间发现其他相(例如Ta4N和六方的TaN)存在的证据。图10归纳了这一系列样品的XRD结果。在图10(左)中,(111)和(200)相对强度的变化与文献中描述基本一致。需要指出的是,氮气流量最大的两个样品(9sccm,15sccm)其(111)已经极度展宽,有可能已经开始出现其他的高氮相,例如Ta3N5等。
(3)溅射电流、氮气流量和衬底温度参数对TaNx电阻特性的影响。
当TaNx薄膜的沉积参数从x=0连续变化至x>1,所沉积薄膜也经历从金属到绝缘体的转变。磁控溅射的金属Ta薄膜是一种缺陷密度高的金属导体,视具体沉积工艺的不同其电阻率一般为100??cm以上[18]。其电阻温度系数(TCR)大于零,在高于德拜温度(Ta的D=258K)时电阻随温度线性上升,和其他金属一样其微观机理是载流子所受的声子散射。在生长相图另一端,富氮的TaNx(x>1)由于存在大量的Ta空位缺陷VTa从金属过渡到绝缘体,其TCR为正。
在文献中报道的优化氮化钽薄膜电阻特性(方块电阻R□和电阻温度系数TCR)的方法有多种。例如采用铜-钽共溅射然后退火形成纳米复合物,利用金属铜的正TCR与fcc-TaN的负TCR达到TCR=0的目的[19,20]。我们从导致TaNx薄膜TCR变化的微观机理出发,探索利用单一Ta-N层的方式来优化TCR的方法。
从金属-绝缘体相变(Mott相变)的角度来看,TCR=0实际上就是导体处于金属-绝缘体相变点(M-I Transition)附近的表现,因此低TCR的TaNx薄膜的电阻率值应该接近Mott的估计值,对于接近化学剂量的fcc-TaN此临界值大约为400~4000??cm[21-24],非常接近磁控溅射Ta薄膜的数值[18]。在我们的实验中,由于所采用的膜厚测量技术有较大误差[22],所以对四引线测量所得电阻率的数值仅可以精确到20%的范围(我们采用光刻之后腐蚀台阶的方法暴露出基片,然后使用AFM扫描样品轮廓,最后从表面形貌图读出镀膜的厚度。采用这种方法,薄膜容易在光刻过程中受到损伤,使测厚的精确度较差。将利用这种方法得出的测厚结果与文献中和光谱分析中得出的沉积速率相比较,后者随氮气分压增加的下降趋势并未在前者之中清晰体现出来,由此可估计出测厚误差的范围)。上面的临界电阻率范围相当于表1中样品的高功率极限值,略大于图5中N2=0.6的两个样品电阻率值。在本文中,电阻温度测量集中在N2/(Ar+N2)<11%,即在我们的标准溅射条件下(总流量=45sccm)最高通入5sccm氮气。
表2总结了改变3个常用参数所得到的TCR结果。其中TCR=(R120℃-R30℃)/R30℃×106。在低氮,高功率和高衬底温度的条件下,样品均接近或超过了100ppm/°C的实用化TCR指标。
在表2中,样品O-K-I-F为氮-氩比系列,O-P-Q为溅射功率系列,O-U-V(最后一个未测)为基片温度系列。从结果来看,值得注意的是基片温度系列。通过提高镀膜时的基底温度,可以提高表面吸附原子的迁移率,改善成晶质量,从而减少晶粒间界和晶格缺陷对载流子的散射。但是这种效果通常以相同的趋势反映在电阻率和TCR中,即电阻率降低,TCR绝对值减小(表中的氮-氩比系列和溅射功率系列)。在上表中样品U的电阻高于O和其他一系列样品,但是其电阻温度系数是所有均匀薄膜样品中最低的。即使考虑了测量膜厚产生的误差,U的电阻仍然没有跟随其TCR绝对值一起减小。在关于氮化钽样品退火处理的文献中[19,20],研究者将电阻和TCR绝对值增加的现象解释为通过加热释放出被俘获在晶界之间的过量氮,而后者可以在晶界内起到施主的作用。通过释放过量的氮原子,使样品远离金属-绝缘体相变条件,提高电阻的同时也使TCR绝对值增加。我们认为同样的过程也发生在高基底温度生长的样品中。TCR绝对值的降低应该是多种因素作用的结果。详细研究这个现象需要在更系统的样品上做测量和分析。
4 结语
我们使用在直流脉冲磁控溅射装置上的Plasma OES装置,成功地重复了已报道的TaNx生长窗口,并从光谱的角度解释了气体流量比与溅射功率参数之间的关联。由于自建测量系统在结构上的松散性,本文中描述的使用独立组件搭建Plasma OES采集系统的方式,在实际科研或生产中使用会遭遇可靠性和可重复性的问题。作为一种成熟可靠的在线实时监测手段,专门配置于磁控溅射系统的成套光谱采集系统将会使磁控溅射镀膜的参数控制更直观,更能反映镀膜中的实际物理和化学过程。
参考文献
[1] Nie H B,Xu S Y,Wang S J,et al.Structural and electrical properties of tantalum nitride thin films fabricated by using reactive radio-frequency magnetron sputtering[J].Applied Physics A,2001, 73(2):229-236.endprint
[2] Shin C S,Kim Y W,Gall D,et al.Phase composition and microstructure of polycrystalline and epitaxial TaNx layers grown on oxidized Si(001) and MgO(001) by reactive magnetron sputter deposition[J].Thin Solid Films,2002,402(1):172-182.
[3] 曾曉兰,冷永祥,黄楠.磁控反应溅射制备Ta-N薄膜的显微组织与畸变分析[J].西南交通大学学报,1998,33(3):263-268.
[4] 杨文茂,张琦,陶涛,等.非平衡磁控溅射沉积Ta-N薄膜的结构与电学性能研究[J].功能材料,2006,37(10):1593-1595.
[5] Riekkinen T,Molarius J,Laurila T,et al.Reactive sputter deposition and properties of Ta x N thin films[J].Microelectronic Engineering,2002, 64(1):289-297.
[6] Radhakrishnan K,Ing N G,Gopalakrishnan R. Reactive sputter deposition and characterization of tantalum nitride thin films[J].Materials Science & Engineering B,1999,57(3):224-227.
[7] Chen G S,Lee P Y,Chen S T.Phase formation behavior and diffusion barrier property of reactively sputtered tantalum-based thin films used in semiconductor metallization[J].Thin Solid Films,1999,353(12):264-273.
[8] Shen H,Ramanathan R.Fabrication of a low resistivity tantalum nitride thin film[J]. Microelectronic Engineering,2006,83(2):206-212.
[9] 许根慧,姜恩永,盛京,等.等离子体技术与应用[M].北京: 化学工业出版社,2006:128-149.
[10] Bogaerts A,Gijbels R.Fundamental aspects and applications of glow discharge spectrometric techniques[J].Spectrochimica Acta Part B Atomic Spectroscopy,1998,53(1):1-42.
[11] B.Ku akowska-Pawlak,W. yrnicki,K.Miernik, et al.Optical emission diagnostics of the linear magnetron sputtering discharge[J].Surface & Coatings Technology,1999,s116-119(99):1076-1082.
[12] Qayyum A,Zeb S,Naveed M A,et al.Optical emission spectroscopy of Ar-N2,mixture plasma[J].Journal of Quantitative Spectroscopy & Radiative Transfer,2007,107(3):361-371.
[13] Sharma M K,Saikia B K,Bujarbarua S.Optical emission spectroscopy of DC pulsed plasmas used for steel nitriding[J].Surface & Coatings Technology,2008,203(3):229-233.
[14] Yong M K,Kim J U,Han J G.Investigation on the pulsed DC plasma nitriding with optical emission spectroscopy[J].Surface & Coatings Technology, 2002,151(1):227-232.
[15] Aryasomayajula A,Valleti K,Aryasomayajula S,et al.Pulsed DC magnetron sputtered tantalum nitride hard coatings for tribological applications[J]. Surface & Coatings Technology,2006,201(7):4401-4405.
[16] Lu Y M,Weng R J,Hwang W S,et al.Study of phase transition and electrical resistivity of tantalum nitride films prepared by DC magnetron sputtering with OES detection system[J].Thin Solid Films,2001,398(1):356-360.endprint
[17] 除氮分子發射谱线参考[12,13,14]中提供的数据,光谱分析中使用的材料参数均来自于美国国家标准和技术局的原子谱线数据库[EB/OL].http://physics.nist.gov/PhysRefData/ASD/lines_form.html.
[18] Grosser M,Schmid U.The impact of sputter conditions on the microstructure and on the resistivity of tantalum thin films[J].Thin Solid Films,2009,517(16):4493-4496.
[19] Wang C M,Hsieh J H,Li C.Electrical and piezoresistive properties of TaN–Cu nanocomposite thin films[J].Thin Solid Films,2004,s469-470(469):455-459.
[20] Wang C M,Hsieh J H,Li C,et al.Effects of annealing on the microstructure and electrical properties of TaN-Cu nanocomposite thin films[J]. Surface & Coatings Technology,2005,193(1):173-177.
[21] Lal K,Ghosh P,Biswas D,et al.A low temperature study of electron transport properties of tantalum nitride thin films prepared by ion beam assisted deposition[J].Solid State Communications,2004, 131(7):479-484.
[22] Kim D K,Lee H,Kim D,et al.Electrical and mechanical properties of tantalum nitride thin films deposited by reactive sputtering[J].Journal of Crystal Growth,2005,283(3):404-408.
[23] Lovejoy M L,Patrizi G A,Roger D J,et al.Thin-film tantalum-nitride resistor technology for phosphide-based optoelectronics[J].Thin Solid Films,1996,s290-291(6):513-517.
[24] Freeman A J,Stampfl C,Yu L,et al.Mechanism and control of the metal to insulator transition in rocksalt tantalum nitride[A].APS Meeting.APS Meeting Abstracts[C].2002:121-121.endprint

