Pt/Au/n-InGaN肖特基接触的电流输运机理∗
徐峰 于国浩 邓旭光 李军帅 张丽 宋亮范亚明 张宝顺
1)(中国科学院苏州纳米技术与纳米仿生研究所,苏州 215123)2)(南京大学扬州光电研究院,扬州 225009)(2018年6月19日收到;2018年9月2日收到修改稿)
基于热电子发射和热电子场发射模式,利用I-V方法研究了Pt/Au/n-InGaN肖特基接触的势垒特性和电流输运机理,结果表明,在不同背景载流子浓度下,Pt/Au/n-InGaN肖特基势垒特性差异明显.研究发现,较低生长温度制备的InGaN中存在的高密度施主态氮空位(VN)缺陷导致背景载流子浓度增高,同时通过热电子发射模式拟合得到高背景载流子浓度的InGaN肖特基势垒高度和理想因子与热电子场发射模式下的结果差别很大,表明VN缺陷诱发了隧穿机理并降低了肖特基势垒高度,相应的隧穿电流显著增大了肖特基势垒总的输运电流,证实热电子发射和缺陷辅助的隧穿机理共同构成了肖特基势垒的电流输运机理.低背景载流子浓度的InGaN肖特基势垒在热电子发射和热电子场发射模式下拟合的结果接近一致,表明热电子发射是其主导的电流输运机理.
1 引 言
三元合金铟镓氮InxGa1−xN是直接带隙半导体材料,通过改变金属In的组分可使其带隙宽度在0.7—3.4 eV的范围内连续变化,从而覆盖了从近红外到紫外的光谱区域.InGaN材料已成为制造高亮度发光二极管、高效半导体激光器的理想选择,同时它在太阳电池和光电探测器等领域也有着非常广泛的应用前景[1−6].肖特基势垒器件在高速集成电路、微波技术等领域有着很好的应用前景,但InGaN材料的高质量制备问题却限制了其肖特基器件的发展和应用[7−10].利用金属有机物化学气相淀积方法制备高质量InGaN薄膜材料的主要困难在于:InGaN表面金属In分布不均匀[11],甚至会出现金属In分凝现象,同时InN饱和平衡压强高,分解温度较低,In原子比Ga原子更难溶入六方晶格,导致InGaN材料存在大量缺陷,载流子迁移率较低[12].基于InGaN材料的肖特基势垒的报道较少,Jang等[13]研究了不同退火温度对Pt/n-InGaN肖特基势垒特性的影响,Lin等[14]明确了氮化物表面氧化层的存在对肖特基势垒高度和电子输运机理的影响,Wang等[15]研究了不同衬底材料下的肖特基势垒电流输运机理,但上述结论所采用的肖特基势垒质量均不理想,同时材料中In组分均偏低,因此目前还没有关于In组分大于10%的n-InGaN肖特基势垒电流输运机理的研究报道.本文针对光伏器件设计并制备了大面积的InGaN肖特基接触,改变生长条件调控了In组分为30%的n-InGaN的载流子浓度,通过淀积Pt/Au电极研究了n-InGaN肖特基势垒特性,最后根据热电子发射(thermionic emission,TE)和热电子场发射(thermionic field emission,TFE)模式综合分析了Pt/Au/n-InGaN肖特基的电流输运机理.
2 实 验
采用金属有机物化学气相淀积方法生长实验所用的In0.3Ga0.7N薄膜.首先在蓝宝石C面衬底上低温生长30 nm的GaN缓冲层,继而生长2µm的高温非故意掺杂GaN层,最后在750,730,700◦C的不同反应温度下生长非故意掺杂InGaN薄膜样品,分别对应编号为A,B,C的肖特基势垒样品.制作金属接触之前,将各InGaN分别在丙酮、甲醇和乙醇中以等标准的表面清洗工艺超声清洗3 min;淀积肖特基接触之前,将各InGaN在浓度为10%盐酸溶液中浸泡15 s以去除样品表面的氧化层和可能存在的金属In积聚.金属接触采用电子束蒸发,欧姆电极所用金属为Ti/Al/Ni/Au(20/120/30/50 nm),淀积后在600◦C氮气氛围中快速退火15 s;肖特基接触采用Pt/Au(5/5 nm)金属,面积为2 mm×2 mm.InGaN材料的In组分通过X射线衍射(X-ray diffraction,XRD)方法确定,背景载流子浓度通过范德堡霍耳效应得到,肖特基接触I-V电学特性采用惠普半导体参数测试仪测试.
3 结果与讨论
首先对上述在不同生长温度下制备的InGaN薄膜样品进行了XRD测试(图1),扫描方式为ω-2θ.图1中除了最强的GaN衍射峰外,还能观察到各样品较强的InGaN(0002)晶面的衍射峰.以确定实验所采用的InxGa1−xN薄膜中的In组分.利用Vegard定律,根据InxGa1−xN(0002)衍射峰相对于GaN(0002)衍射峰的峰位移动计算了InxGa1−xN样品的组分[16],并假设在GaN上外延制备的In-GaN样品是完全弛豫的:

计算得到3个InxGa1−xN样品In组分均为x=0.3,并且In组分偏差小于0.01,因此忽略由于In组分不同导致的对其肖特基势垒特性的影响.进一步测试得到样品A,B和C的(0002)面摇摆曲线半峰宽(full-width half-maximum FWHM)分别为324,639和728 arcsec.通常,对于六方结构的III族氮化物材料,可利用下式估算薄膜中的螺位错密度[17]:

其中Dscrew为螺位错密度,β为FWHM,Burgers矢量长度b=0.5185 nm. 根据测得的(0002)面摇摆曲线FWHM计算得到样品A,B和C的In0.3Ga0.7N螺位错密度分别为2.09×108,8.12×108和1.05×109cm−3.

图1 InGaN薄膜(0002)ω-2θ XRD谱Fig.1.XRD ω-2θ scans of the(0002)InGaN of samples A–C.
对各In0.3Ga0.7N样品表面形貌进行了原子力显微镜(atomic force microscope,AFM)测量(图2),扫描范围为5µm×5µm.可以发现:750◦C生长的In0.3Ga0.7N样品A薄膜表面较为平整,属于二维台阶流模式生长,表面粗糙度(RMS)为0.85 nm,而730,700◦C的样品B,C薄膜趋向于三维模式生长,表面均具有较大的晶粒起伏并且存在高密度V型位错缺陷坑(V-pits),表面粗糙度RMS分别为4.31,6.62 nm,较低生长温度导致的低表面吸附原子迁移率使薄膜缺陷形态受动力学控制[18].InGaN材料表面V-pits的产生主要是由于失配应变使In原子向螺位错周围聚集形成金属In团簇,In团簇作为异面活性剂使(11¯20)晶面的表面能低于(0001)面,从而促使了V-pits的形成[19,20].综合XRD和AFM的测试结果可知,较低生长温度导致的高密度螺位错缺陷对InGaN材料的晶体质量和表面形貌均具有较为显著的影响.
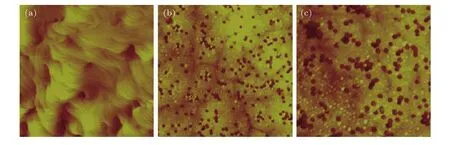
图2 In0.3Ga0.7N样品(a)A,(b)B,(c)C的AFM照片Fig.2.AFM surface morphology images of In0.3Ga0.7N(a)A,(b)B,(c)C.
室温下通过Hall测试研究了In0.3Ga0.7N薄膜的电学性质,测得样品A,B,C的InGaN载流子浓度分别是8.7×1016,5.7×1018和1.9×1019cm−3(图3).从图3可以看出,700◦C生长的InGaN样品背景载流子浓度比750◦C的增加了两个数量级,Lee等[21]的报道中也发现了类似现象,这主要是因为作为氮源的NH3在相对低温下分解效率较低,导致反应气氛中具有反应活性的N浓度不足,出现In:N化学配比大于1的现象,从而形成高密度的施主态氮空位(VN)缺陷,显著增加了InGaN的背景载流子浓度;同时,与VN缺陷相关的高密度螺位错会在InGaN中进一步作为导电路径,极大地降低了InGaN的电阻率[22].另一方面,较高的生长温度能够压制VN缺陷的形成[23],抑制了InGaN的背景载流子浓度.

图3 InGaN样品载流子浓度随生长温度的变化Fig.3.Variation of n-InGaN carrier concentration as a function of growth temperature.
通过TE和TFE模式进一步拟合分析了各In-GaN肖特基势垒的电流输运机理.TE模式仅考虑TE机理,TFE模式则包含了TE和隧穿机理.通常,当InGaN材料缺陷密度大于一定值(Ndefect>1019cm−3)时,需考虑肖特基势垒界面隧穿机理的作用[12],隧穿机理极大地影响了肖特基接触的势垒特性[24].
在TE和TFE模式下对各InGaN样品肖特基势垒I-V实验数据进行拟合,得到了肖特基势垒高度和理想因子(n)随载流子浓度的变化.图4是根据TE和TFE模式对I-V数据的拟合曲线,拟合结果和Jang等[13]的研究数据列于表1中.TE和TFE模式的电流-电压特性表达式分别为[22]

其中,I,V分别为肖特基势垒正向电流和正向偏压;肖特基势垒面积S=2×10−2cm−2;n-In0.3Ga0.7N薄膜样品有效理查逊常数A∗∗=4qk2m∗/h3=21 A·cm−2·K−2;k是玻尔兹曼常数;q是电荷量;ϕB是有效势垒高度;E0是隧穿系数;理想因子Nc是导带态密度.
通常,隧穿机理的形成与氧、VN缺陷相关的表面态以及界面氧化层有关[14],它会降低肖特基势垒高度并增大理想因子[24].在TE模式下,拟合得到样品A肖特基接触的势垒高度和理想因子分别是1.04 eV和1.10,非常接近于TFE模式拟合的结果(1.15 eV和1.05).肖特基势垒理想因子的正常范围在1.0—1.3[13],上述拟合结果表明样品A肖特基势垒输运电流中的隧穿成分极少,VN相关表面态对势垒电流输运机理的影响可忽略.因此,利用低背景载流子浓度InGaN材料制备的肖特基接触中,TE是其主导的载流子输运机理.同时实验结果也验证了预先的有机溶液清洗和化学处理能够有效去除界面氧化层.在图4(a)中,当正向电压V超过0.22 V时,I-V特性逐渐偏离了原来的线形关系,这种偏离是由于异质结构和欧姆接触的串联电阻造成的.
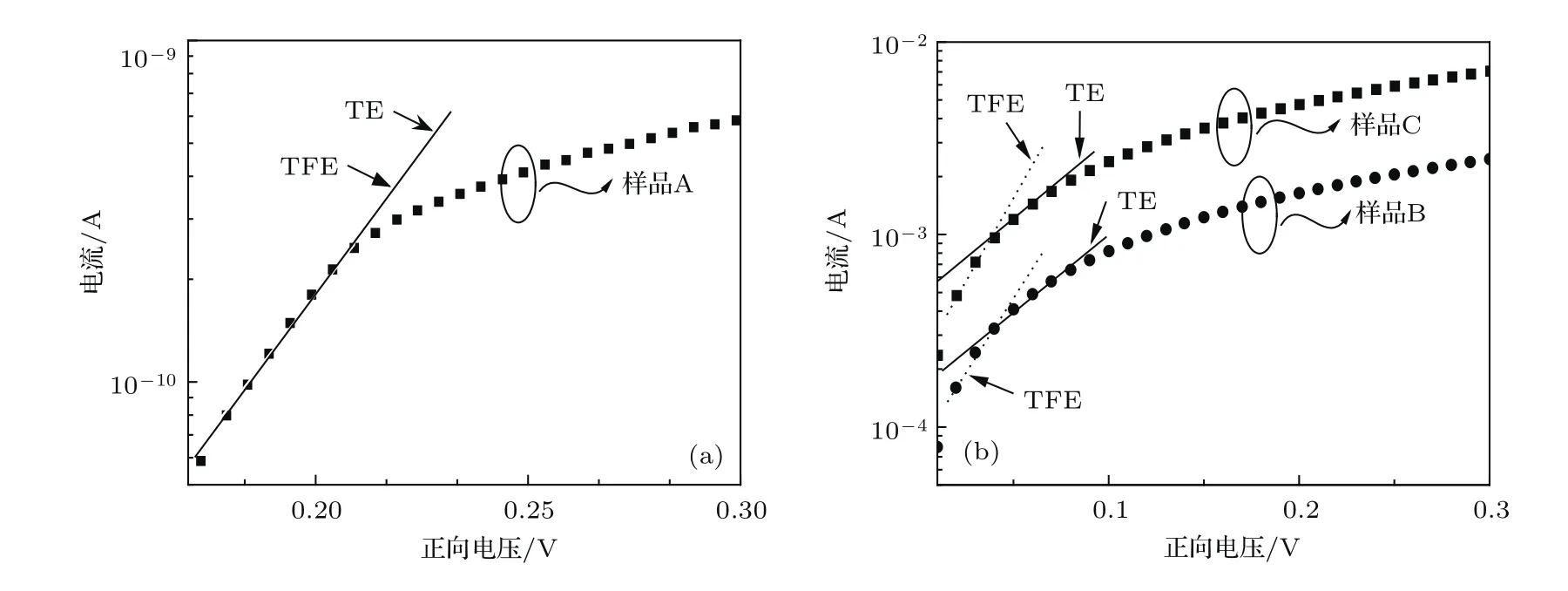
图4 InGaN肖特基势垒I-V拟合图 (a)样品A;(b)样品B和CFig.4.Forward I-V characteristics of Schottky barrier:(a)sample A;(b)sample B and C.

表1 TE和TFE模式下Pt/Au/n-InGaN肖特基势垒特性Table 1.Summary of characteristics of Schottky contact on n-InGaN obtained using TE and TFE models.
相比于样品A,利用高背景载流子浓度InGaN材料制备的肖特基接触样品B和C在TE和TFE两种模式下的势垒高度值均出现了明显减小,同时它们的理想因子拟合值均远超过1,表明InGaN样品高密度VN缺陷导致其肖特基势垒性能发生了衰减,肖特基接触中存在VN缺陷辅助的隧穿机理[25].如表1数据所示,隧穿机理使TFE模式下的势垒有效高度远大于TE模式下的拟合值,并且TFE模式下的qE0/kT值均接近1,更证实了肖特基势垒输运电流中存在隧穿电流成分[26].因此,VN缺陷辅助的隧穿机理和TE综合构成了高背景载流子浓度InGaN肖特基势垒的电流输运机理.
在表1中,各InGaN肖特基势垒高度随背景载流子浓度的增加而减小,并且在图4中可观察到样品B和C的总输运电流明显大于样品A,这是由于高密度VN缺陷提高了背景载流子浓度,增加的载流子通过隧穿机理穿越势垒,形成隧穿电流增加了总输运电流.Hashizume等[27]研究认为非故意的表面施主缺陷会降低势垒,从而增加通过势垒的漏电流.另外,通过与Jang等[13]的低In组分In0.1Ga0.9N的工作对比发现,InGaN材料中In组分越高,随生长温度降低,VN缺陷增加得越快,隧穿效应会进一步增强,因此高In组分InGaN肖特基势垒隧穿效应更为明显.
如图5所示,在−4 V偏压下,肖特基接触样品B和C的暗电流大小比样品A的暗电流大5个量级,这主要归因于InGaN高密度VN缺陷导致的势垒高度降低.通常暗电流的大小对肖特基势垒高度非常敏感,因此,InGaN表面缺陷密度的控制对Pt/Au/InGaN肖特基势垒的性能提升以及高质量肖特基光电子和光伏器件的制备至为重要.

图5 Pt/Au/InGaN肖特基接触的反向I-V特性Fig.5.Reverse I-V characteristics of Pt/Au/InGaN Schottky contacts.
4 结 论
本文对n-In0.3Ga0.7N薄膜上的Pt/Au肖特基势垒进行了I-V测试,利用TE和TFE模式研究了Pt/Au/n-In0.3Ga0.7N肖特基势垒在不同背景载流子浓度下的电流输运机理,研究发现,利用低背景载流子浓度InGaN材料制备的肖特基接触中,未出现由于VN缺陷导致的隧穿电流,TE是其主导的电流输运机理;较低温度下生长的InGaN薄膜的载流子浓度由于高密度施主态VN缺陷而呈现指数增加,在利用高背景载流子浓度InGaN材料制备的肖特基接触中,高密度VN缺陷恶化肖特基接触的势垒特性,导致肖特基势垒有效高度降低,使TE和缺陷辅助的隧穿机理共同构成了肖特基势垒的电流输运机理,隧穿电流的存在显著增加了通过肖特基势垒的总输运电流.

