二氧化硅膜厚标准样片的研制与评价∗
赵 琳 梁法国 韩志国 李锁印 付少辉
(中国电子科技集团公司第十三研究所 石家庄 050051)
1 引言
随着纳米科技与超精密加工技术的快速发展,相关器件和结构的尺寸越来越小,测量精度的要求也越来越高[1],从而对微纳米尺寸测量提出了更高的要求。薄膜厚度是半导体器件制作中的主要参数,膜厚测量仪、椭偏仪等是测量薄膜厚度的专用仪器,其准确度的保证是该参数准确测量的前提[2]。目前,国内外都使用膜厚标准样片对膜厚测量仪等进行校准[3~4]。膜厚标准样片是具有膜厚量值的标准物质,是实现微纳尺寸从国家计量标准部门的标准器件传递到实际生产、制造中的重要传递介质[2]。
微电子行业中可以用于制作薄膜的材料种类很多,而使用膜厚测量仪测量不同材料的厚度时需选定不同测量模型进行膜厚量值的准确测量。因此为了保证该类仪器测量结果的准确性,需要研制适用于校准该类仪器的膜厚标准样片。当前半导体器件制作过程中二氧化硅(SiO2)薄膜的应用最为广泛。目前,国内方面,在该类样片的研制方面未见报导,只有西安应用光学研究所提供用于校准膜厚测量仪的SiO2/Si膜厚标准样片[5],但是样片属于外购,并且样片的范围不能满足微电子行业的需求。标准样片的质量直接影响量值传递过程的准确性,本文研制了膜厚量值为10nm~1000nm一系列的样片,以10nm、1000nm为例,对膜厚样片的量值、均匀性、稳定性等质量参数进行了评价,并与VLSI膜厚标准样片进行了比较。
2 二氧化硅膜厚样片的研制方法
微电子行业中制作二氧化硅膜的方法有很多,如热氧化、电化学、磁控溅射和等离子化学气相淀积法(PECVD)等[6]。在这些方法中,使用最为广泛的方法是热氧化和等离子化学气相淀积。热氧化法是硅器件制造中最重要的方法,是现代硅集成电路工艺中的关键工艺,可以提供最低界面陷阱密度的高质量氧化层。而PECVD的特点是:1)沉积温度低,对多晶硅中少子寿命影响小,并且生产时能耗低;2)沉积速率较快,生产效率高;3)工艺重复性好,薄膜厚度均匀;4)薄膜缺陷密度较低。考虑到标准样片对膜层的均匀性、致密性及稳定性要求较高,本文选择热氧化和PECVD两种方法分别生长二氧化硅薄膜,对制作的二氧化硅薄膜分别进行考核,最终确定更为合适的研制方法。
2.1 热氧化工艺制备二氧化硅膜
热氧化法包括干氧、水氧和湿氧三种方法[7],其中干氧氧化是通过氧分子与硅直接反应生成二氧化硅,干氧生长的氧化膜表面干燥、结构致密,但氧化速率极慢,这是由于氧气在二氧化硅中扩散系数通常小于水在二氧化硅中的扩散系数,适用于较薄的氧化层的生长。而水汽氧化是通过高温下水汽与硅反应生成二氧化硅,对高纯水加热产生高纯水蒸气,水汽进入氧化炉与硅片反应生成二氧化硅膜。水汽氧化速率较快,但膜层不致密,质量很差,特别是对杂质扩散的掩蔽作用较差。湿氧氧化中既有干氧氧化,又有水汽氧化。湿氧氧化中,用携带水蒸气的氧气代替干氧。氧化剂是氧气和水的混合物,湿氧氧化相当于干氧氧化和水汽氧化的综合,其速率也介于两者之间。具体的氧化速率取决于氧气的流量、水汽的含量。氧气流量越大,水温越高,则水汽含量越大,氧化膜的生长速率和质量越接近于水汽氧化的情况。反之,就越接近于干氧氧化。
表1给出了以上三种热氧化方法的比较。

表1 三种热氧化方法比较
比较以上三种热氧化方法可知水汽氧化制作的二氧化硅膜的质量很差,干氧氧化制作的膜的质量最好,而研制的标准样片质量是第一位的,因此采用干氧氧化法制作二氧化硅膜厚样片。
2.2 等离子化学气相淀积法(PECVD)制备二氧化硅膜
等离子化学气相淀积法(PECVD)制备二氧化硅膜的技术是利用SiH4和N2O在较低温度环境下实现SiO2薄膜的沉积[8~9],具体的化学反应如下:

这种方法的特点是可以在非硅材料上沉积二氧化硅膜,并且可以沉积较厚的二氧化硅层,沉积的厚度与沉积时间成正比,沉积温度较低,且生长速率快,可准确控制沉积速率,生成的薄膜结构致密,对于不宜作高温处理而又需要在表面生长二氧化硅的器件也适用[10]。缺点是真空度低,从而使薄膜中的杂质含量较高,薄膜硬度低,沉积速率过快而导致薄膜内柱状晶严重,并存在空洞等。
3 二氧化硅膜厚样片的制备
3.1 膜厚标准样片的图形设计
本文结合当前微电子行业对硅上二氧化硅膜厚样片的需求设计了适用于校准膜厚测量仪的样片。硅上二氧化硅膜厚样片的尺寸拟设计为10nm、20nm、50nm、100nm、200nm、500nm、1000nm。并对膜厚样片进行了图形设计:由于制作的膜厚样片区域较大,为了保证使用膜厚标准样片校准膜厚测量仪结果的准确,样片定标时应规定好定标区域。因此,在研制的膜厚样片上设计了特殊图形,标记出膜厚标准样片的定标位置,如图1所示,其中定标有效区域的直径为20mm。

图1 膜厚样片的定标区域图形
3.2 膜厚标准样片的制作
决定膜厚标准样片质量的关键在于二氧化硅膜层的制作工艺,本文中分别选用热氧化和PECVD两种工艺制作了二氧化硅薄膜,制作工艺流程图如图2所示。

图2 二氧化硅膜厚标准样片的制作工艺流程
使用热氧化工艺制备二氧化硅薄膜时,首先采用电子清洗剂和去离子水分别对硅片进行清洗,甩干后进行热氧化,热氧化过程是在氧化炉中进行的,设定氧化温度,通入氧化气体,并依据氧化硅的厚度设定氧化时间,氧化完成后取出样片进行涂胶、曝光、显影、刻蚀、去胶一系列的工艺后得到一个与设计图形相一致的二氧化硅膜厚样片。而使用PECVD工艺制备二氧化硅薄膜的过程中,淀积过程发生在淀积炉中,通入SiH4和N2O气体,优化气体流量,设定反应环境条件,制备出相应厚度的二氧化硅层,最后进行光刻和刻蚀工艺。图3中给出了制作的二氧化硅膜厚样片的实物图。
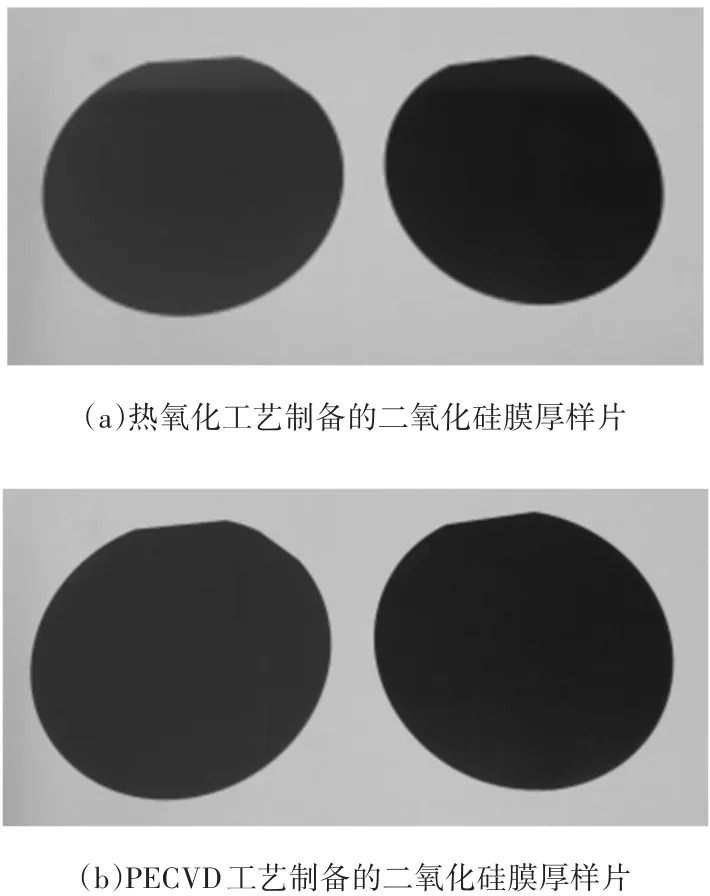
图3 分别使用两种工艺制作的尺寸为10nm和1000nm的二氧化硅膜厚样片实物图
4 二氧化硅膜厚样片的质量考核
通过查阅文献及对膜厚类测量仪器的研究,了解到膜厚标准样片作为一种标准物质,其考核的基本要求:1)制作的样片的膜层厚度与设计的标称厚度一致,偏差尽量小;2)样片的区域均匀性好,在膜厚样片的测量区域内,不同位置测得的膜层厚度一致性好;3)稳定性好,在长期使用中样片的膜层厚度值保持不变[11]。
使用Woollam公司型号为M2000-XF的椭偏仪作为膜厚标准样片膜厚量值及质量考核的测量仪器[12~14]。以标称厚度10nm和1000nm的膜厚样片为例分别对两种加工工艺制作的膜厚样片的质量参数进行考核,考核参数为膜厚量值、均匀性和稳定性[15]。同时,使用相同仪器、相同测量方法对美国VLSI公司的相同标称高度的膜厚标准样片的膜厚量值和均匀性进行评价,考核结果与本文制作样片的考核结果相比较。
4.1 膜厚量值
对研制的标称厚度为10nm和1000nm的膜厚标准样片中心区域进行测量,重复测量6次,以6次测量结果的平均值作为该样片的膜厚量值,以标准偏差计算该样片的测量重复性。测量结果如表2所示。

表2 膜厚样片量值、重复性测量结果
由表2中数据可知,使用热氧化工艺加工的膜厚样片的测量结果分别为10.63nm和1005.13nm,使用PECVD工艺制作的膜厚样片的测量结果分别为10.56nm和994.76nm,两种工艺制作的膜厚样片的膜厚量值与设计的膜厚量值基本一致。
4.2 膜厚样片的均匀性
对研制的膜厚标准样片中心区域的五个位置进行测量(如图4所示),以五个位置测量结果的最大差值作为该样片的均匀性结果。VLSI标准样片同样按照相同测量方法、测量位置对样片的均匀性进行分析,测量结果如表3所示。

图4 膜厚样片考核参数的位置示意图
由表3中数据可知,热氧化工艺制作的膜厚样片的均匀性分别为0.06nm和0.31nm,PECVD工艺制作的膜厚样片的均匀性分别为0.53nm和1.34nm,而VLSI公司生产的相同尺寸的样片的均匀性为0.20nm和0.38nm。分析以上数据热氧化工艺制作的膜厚样片的均匀性优于PECVD工艺制作的样片的均匀性,并与VLSI生产的膜厚样片的均匀性基本一致。
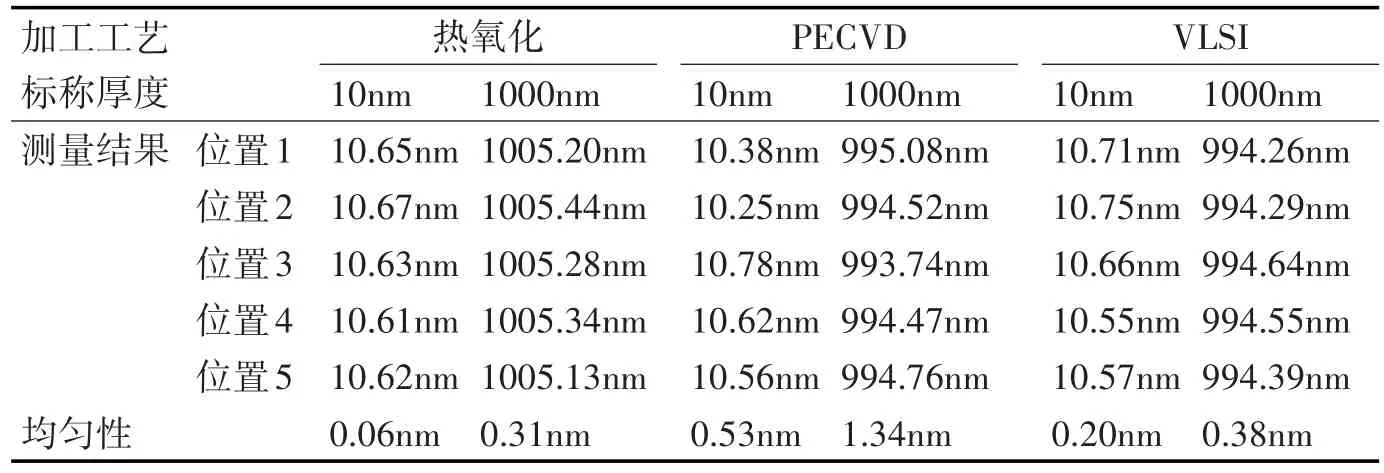
表3 膜厚样片的均匀性测量结果
4.3 膜厚样片的稳定性
膜厚标准样片的稳定性是通过使用光谱型椭偏仪对膜厚样片中心区域的5个位置每隔1个月测量一次,5个位置测量结果的平均值作为一次稳定性测量数据,通过分析平均值的变化来确定膜厚标准样片的稳定性。对热氧化工艺和PECVD工艺研制的样片稳定性进行考核,每个月测量一次,共监测12个月,10nm和1000nm样片的测量结果分别如图5、图6所示。

图5 10nm膜厚样片的稳定性测量结果

图6 1000nm膜厚样片的稳定性测量结果
由图中曲线可知,采用热氧化工艺制作的膜厚样片在12个月内稳定性的最大变化量:10nm的稳定性变化量为0.14nm,1000nm的稳定性变化量为0.8nm;采用PECVD工艺制作的膜厚样片:10nm的稳定性变化量为0.60nm,1000nm的稳定性变化量为1.6nm;热氧化工艺制作的膜厚样片的性能在12个月内没有显著变化,膜厚样片的量值稳定,优于PECVD工艺制作的样片的稳定性。
5 结语
本文设计制作了用于膜厚测量仪校准的膜厚标准样片。介绍了二氧化硅膜厚样片的主要加工工艺,并设计了样片的图形结构及其制作过程,分析了作为标准物质的基本要求,使用Woollam公司的椭偏仪对样片的膜厚量值、均匀性、稳定性进行了考核,并使用相同仪器、相同方法对美国VLSI公司的相同标称尺寸的膜厚样片的均匀性进行测量。实验结果表明,使用热氧化工艺和PECVD工艺制备的膜厚样片量值与设计值均基本一致,但是热氧化工艺制备的样片的均匀性与美国VLSI公司的片测量结果一致,稳定性较好,优于PECVD工艺制备的膜厚样片。本文使用热氧化工艺制备的二氧化硅膜厚样片满足了作为标准物质的基本要求,可以作为标准物质使用和推广。

