直流磁控溅射生长(002)择优取向A lN薄膜及其光致发光
吕 伟,刘 俊,赵鹏宇,李健亮,李思达,沈龙海
(沈阳理工大学理学院,辽宁沈阳 110159)
1 引 言
氮化铝(AlN)属于Ⅲ族氮化物半导体材料,具有最宽的直接带隙结构(禁带宽度为6.2 eV)[1]、较高的热导率(320 W/(m·K))和击穿场强(10 kV/m)[2]、良好的化学稳定性[3]以及较高的声表面波(SAW)传输速度等优异的特性。AlN这些优异的物理化学性能使得AlN薄膜有着广阔的应用前景,例如:AlN薄膜可以作为缓冲层,外延生长高质量的GaN或SiC薄膜[4];AlN薄膜是GHz级(SAW)和体声波(BAW)器件的优选材料[5];AlN薄膜是良好的发光材料和稀土掺杂发光基体材料[6]。
AlN薄膜的生长方法有化学气相沉积(MOCVD)[7]、磁控溅射(PVD)[8]以及脉冲激光沉积(PLD)[9]等。其中,磁控溅射具有设备简单、实验参数易于控制以及可以在低温下成膜等优点[10-11],被广泛应用于半导体薄膜的制备。磁控溅射的工艺参数与薄膜结构的关系备受研究者关注。Imran等研究了直流溅射功率对AlN薄膜择优取向的影响[12],随着直流溅射功率的增大有利于AlN薄膜(002)择优取向的生长;Taurino等研究了溅射总气压对AlN薄膜择优取向转变的影响[13],溅射总气压越小,越有利于AlN薄膜沿c轴择优取向生长,随着溅射总气压的增大,薄膜取向从(002)向(100)转变;Zang等研究了衬底温度对AlN薄膜结构和性能的影响[8],溅射过程中衬底温度对薄膜晶体质量有重大影响,温度越高越有利于结晶质量的提高。在AlN晶体的生长过程中由于气体纯度、衬底表面杂质及本底真空等因素的影响一定会引入杂质和缺陷,形成与缺陷能级相关的复合缺陷能级发光。目前,AlN通常被作为深紫外发光器件和稀土掺杂半导体发光材料的优选材料,但是关于AlN晶体缺陷能级的发光机制却没有统一的定论,存在很多争议,因此,研究AlN薄膜缺陷发光机制对其在发光器件上的应用具有重要意义。
目前,氮气含量对直流反应磁控溅射制备AlN薄膜微观结构的影响的研究还很少,由于制备方法不同,AlN晶体缺陷能级发光也呈现出多样性和复杂性的特征。本文采用直流反应磁控溅射在玻璃衬底上生长了AlN薄膜,研究了氮气含量对AlN薄膜的晶体结构取向以及表面形貌的影响,并测量了不同条件下生长的AlN薄膜在405 nm激光激发下的PL光谱,讨论了AlN薄膜的光致发光机制。
2 实 验
本文采用直流反应磁控溅射的方法在玻璃衬底上生长了AlN薄膜,靶材是直径 50 mm厚4 mm的高纯铝靶(99.999%);工作气体为高纯氩气,纯度99.999%;反应气体为高纯氮气,纯度为99.999%;衬底为玻璃。实验制备前,先把基片放在酒精中超声波清洗15 min,并在30 Pa的氩气氛围下辉光清洗10 min。溅射前对靶材预溅射10 min,去除表面氧化层。
生长参数如表1所示。其中氮气含量是通过质量流量计来调节的,保持气体总流量90 mL/min的条件下,分别改变氮气流量和氩气流量,并通过下列公式计算氮气含量:

其中,F(N2)和F(Ar)分别为N2和Ar气体流量,单位为mL/min。

表1 AlN薄膜生长参数Tab.1 Deposited parameters of AlN film
3 结果与讨论
3.1 AlN薄膜XRD分析
图1为不同氮气含量下沉积的AlN薄膜的XRD谱。从图1可以看出,在不同的氮气含量下制备得到的AlN薄膜均出现了(002)和(103)衍射峰,其中(002)衍射峰强度远远大于(103)衍射峰强度,即制备得到的AlN薄膜具有良好的c轴择优取向。衍射峰的半高宽(FWHM)是衡量薄膜结晶质量的标志之一,通常情况下,XRD谱中最强衍射峰的FWHM越小,薄膜结晶质量越好[14]。从图1中可以明显看出氮气含量为66.7%时,FWHM最小,薄膜结晶质量最好,通过 origin数据分析软件进行高斯多峰拟合得到FWHM为0.28°。不同氮气含量下AlN薄膜的平均晶粒尺寸可以根据谢乐公式计算得到:

其中,D⊥为沿 c轴(002)晶向的晶粒大小,λ=0.154 056 nm,B 为 FWHM 的值[15],θ为(002)峰的XRD衍射角,计算结果如表2所示。从表2中可以看出,氮气含量为66.7%时晶粒尺寸最大。

图1 不同氮气含量下生长的AlN薄膜的 XRD谱。(a)φ(N2)=66.7%;(b)φ(N2)=75%;(c)φ(N2)=80%。Fig.1 XRD spectra of AlN films deposited under various nitrogen concentrations.(a) φ(N2)=66.7%.(b)φ(N2)=75%.(c)φ(N2)=80%.

表2 不同氮气含量下生长的AlN薄膜的(002)峰结构参数Tab.2 (002)peak structure parameters of AlN films deposited under various nitrogen concentrations
在不同氮气含量下都生长出了具有(002)择优取向的AlN薄膜,根据余志明等的研究[16]表明,氮气含量在50% ~80%范围内有利于(002)择优取向的生长,本文的实验条件与此相符,这表明氮气含量在这一范围内的变化对薄膜择优取向没有明显作用,但对薄膜的结晶度有明显作用。造成这一现象的可能原因是:在氮气含量为66.7%时,Ar+具有较高的溅射产额并且溅射出来的Al原子具有较高的能量,到达衬底表面时有较大的表面迁移能,生长出成核密度高、晶粒尺寸较大以及结晶质量较好的AlN薄膜;当氮气含量为75%时,溅射气体中的Ar+含量降低,导致被溅射出来Al原子能量降低,同时也导致了到达衬底表面的Al原子数量减少。Al原子到达衬底表面时,表面迁移能较小,且由于N含量的升高抑制Al原子表面扩散,缩短了Al原子的扩散距离,降低了Al原子的重排能力,最终导致晶粒尺寸的减小和结晶度下降;当氮气含量为80%时,Ar+含量进一步降低,N原子含量进一步升高,Al原子到达衬底表面很快与N原子凝结成核,抑制Al原子表面扩散和重排,导致Al原子不断沿着垂直于衬底表面的方向堆积,促进了薄膜(002)取向的生长,改善了薄膜的结晶性能。
3.2 AlN薄膜表面形貌分析
图2是不同氮气含量下的AlN薄膜的扫描电镜(SEM)图。从图2中可以看出,不同氮气含量下,薄膜表面形貌均呈现小颗粒密堆积排列,无明显大颗粒存在,颗粒尺寸大概在20 nm左右。当氮气含量为66.7%时,薄膜表面颗粒堆积比较均匀,无明显的起伏现象。当氮气含量为75%时,薄膜表面出现一些形状大小不一的小岛,颗粒堆积的均匀程度明显下降。当氮气含量进一步升高时,薄膜表面呈现形状大小接近的小岛,薄膜表面形貌均匀程度得到改善。

图2 不同氮气含量下生长的AlN薄膜SEM图。(a)φ(N2)=66.7%;(b)φ(N2)=75%;(c)φ(N2)=80%。Fig.2 SEM images of AlN film deposited under various nitrogen concentrations.(a) φ(N2)=66.7%.(b) φ(N2)=75%.(c)φ(N2)=80%.
造成以上结果可能的原因是:在氮气含量为66.7%时,Ar+含量较大,溅射出来的Al原子能量较高,附着在衬底表面时依旧有足够的能量迁移和重排,从而薄膜表面比较均匀;当氮气含量为75%时,被溅射出来的Al原子能量降低没有足够的能量去迁移和重排,导致薄膜表面堆积不均匀,呈现出大小不一的小岛状;当氮气流量进一步增大时,被溅射出来的Al原子能量进一步减小且受到N原子含量的抑制,在衬底表面不断堆积,使薄膜表面呈现出堆积状的小岛。
3.3 光致发光(PL)光谱测试
图3为不同氮气含量条件下生长的AlN薄膜的光致发光光谱。由图3可知,不同氮气含量条件下生长的AlN薄膜在550 nm处均有较强的发光峰,在大约590,620,650 nm处也有较弱的缺陷能级发光峰,如图3虚线所示,随着氮气含量增高,缺陷发光峰越来越明显。为了更好地确定在大约590,620,650 nm处缺陷能级发光峰的位置,对氮气含量为80%的PL光谱进行高斯拟合,拟合结果如图4虚线所示。从图中可以清楚地看出,这3处发光峰分别位于589,614,654 nm处。

图3 波长为405 nm的激光激发的不同氮气含量下的AlN薄膜的光致发光光谱。(a)φ(N2)=66.7%;(b)φ(N2)=75%;(c)φ(N2)=80%。Fig.3 PL emission spectra of AlN films with different nitrogen concentrations excited by laser at 405 nm wavelength.(a) φ(N2)=66.7%.(b) φ(N2)=75%.(c)φ(N2)=80%.
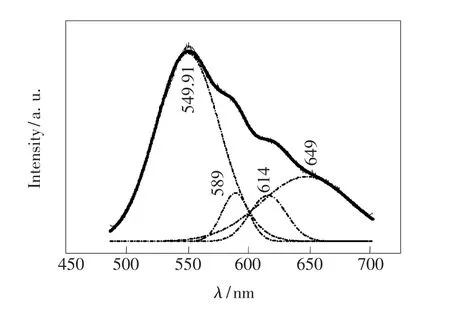
图4 波长为405 nm的激光激发的氮气含量为80%的AlN薄膜的PL发光光谱Fig.4 PL emission spectra of AlN film with nitrogen concentration of80%excited by laser at405 nm wavelength
AlN的本征禁带宽度6.2 eV,所以AlN薄膜产生的这几个发光峰都是由禁带中缺陷能级之间以及缺陷能级与价带和导带之间的跃迁辐射产生的。在磁控溅射生长AlN的过程中,不可避免地会产生缺陷和引入杂质,例如氮空位(VN)、铝空位(VAl)以及氧原子占据N的位置(ON)等。根据Chichibu[17]和 Sedhain[18]等研究者的研究结果表明,VAl形成的缺陷能级位于价带顶1.6~2.78 eV的范围内。因此550 nm(2.25 eV)的发光峰可归因于VAl产生的缺陷能级向价带顶的跃迁。在589 nm(2.11 eV)、614 nm(2.02 eV)以及654 nm(1.90 eV)处的发光峰可分别归因于ON-ON缺陷对[19]向 VAl-2ON[20]产生的复合缺陷能级的跃迁、导带向与氧有关的杂质能级(IO)间的跃迁[21]以及VAl-ON深能级上的电子跃迁到价带[22],由此构建的AlN薄膜缺陷能级发光机制如图5所示。

图5 AlN薄膜禁带中的发光机制Fig.5 Luminescencemechanism of AlN films in the forbidden band
由于所有的AlN薄膜都是在氮气含量大于1的条件下生长得到的,所以会产生大量的VAl缺陷能级,即在PL光谱中,所有AlN薄膜在550 nm处都有较强的发光峰。随着氮气含量的增加,溅射出来的粒子能量较弱,对衬底表面的轰击作用减弱,衬底表面有更多的氧杂质含量残留,从而导致AlN薄膜氧杂质含量增加。当氮气含量达到80% 时,溅射出来的粒子能量最弱,氧杂质含量达到最大,因此在589,614,654 nm处与氧有关的缺陷能级之间的发光峰更加明显。
4 结 论
采用直流反应磁控溅射法在不同氮气含量条件下生长了沿(002)择优取向的AlN薄膜,薄膜表面均呈小颗粒密堆积排列,颗粒尺寸在20 nm左右。随着氮气含量增加,薄膜表面颗粒从均匀堆积向小岛状堆积转变。当氮气含量为66.7%时,可以得到结晶质量相对较好和晶粒尺寸相对较大的AlN薄膜。不同氮气含量条件下生长的AlN薄膜在550 nm左右都有较强的发光峰,并且随着氮气含量的增大,在589,614,654 nm处的缺陷发光峰越来越明显。

