氮化硅膜层对TFT白点色度均匀性的影响及其改善
操彬彬,叶成枝,安 晖,马 力,刘广东,吕艳明,彭俊林,杨增乾,栗芳芳,陆相晚,黄正峰,刘增利,廖伟经,李恒滨
(合肥鑫晟光电科技有限公司,安徽 合肥 230001)
1 引 言
随着人们对显示屏画质的要求不断提高,对显示屏的色度均匀性的要求也越来越高,通常显示屏的色度均匀性采用测量白点色度均匀性(White Color Uniformity,WCU)的方法来监控,因此WCU成为TFT-LCD产品一项新的光学检测项目。之所以选择白点,是因为白点是RGB色空间的靶心,它的色坐标会影响显示屏绝大部分颜色的表现,RGB三原色的三刺激值共同决定白点色度坐标[1],故白点色度均匀性可以间接反应其他色彩色度均匀性。目前WCU检测设备主要利用CCD光电转换器拍摄显示屏白画面,再经视频卡采集,把图像的RGB三基色值存入计算机,经过计算机软件处理,最终输出白点色度偏差Δu′v′值,当Δu′v′超出规格则会判为不良品[2-3]。
目前针对TFT-LCD产品WCU改善研究中,除了背光色块、偏光片、盒厚、配向膜、彩膜等常规研究对象外,理论上TFT光学水平也会对白点色度坐标产生影响,但是现有文献极少涉及。TFT光学透过率主要是受开口区的膜层结构影响,如栅极绝缘层、钝化绝缘层、透明导电膜(ITO)等等,本文重点研究了SiNx的绝缘膜层(包含GI,PVX1和PVX2)对WCU的影响,依据1931 CIE-XYZ表色系和1976 CIE均等色度表色系[4-7],将TFT基板开口区透过率数据拟合得到白点色度坐标,通过测量TFT 阵列基板内大量均匀分布点位SiNx膜厚(SiNxTHK),建立其余u′、v′和Δu′v′的匹配关系,分析总结各层SiNx对TFT WCU的影响并制定相应的改善措施以期优化TFT WCU的整体水平。
2 实验设计
本次实验样品制备基于合肥鑫晟光电G8.5 TFT-LCD生产线进行某款HADS有机膜笔记本(NB)产品,其TFT像素区膜层结构示意图如图1所示。为匹配各层SiNxTHK和TFT WCU的关系,二者需采用相同的坐标点位分别进行测试,测试点位图见图2,即单个面板分别测试12点的SiNx膜厚和TFT WCU,整个TFT基板80片面板共计960个测试点,为进一步提升WCU测试的准确性,面板内四周的点位均选择在近乎于AA区的最边缘。
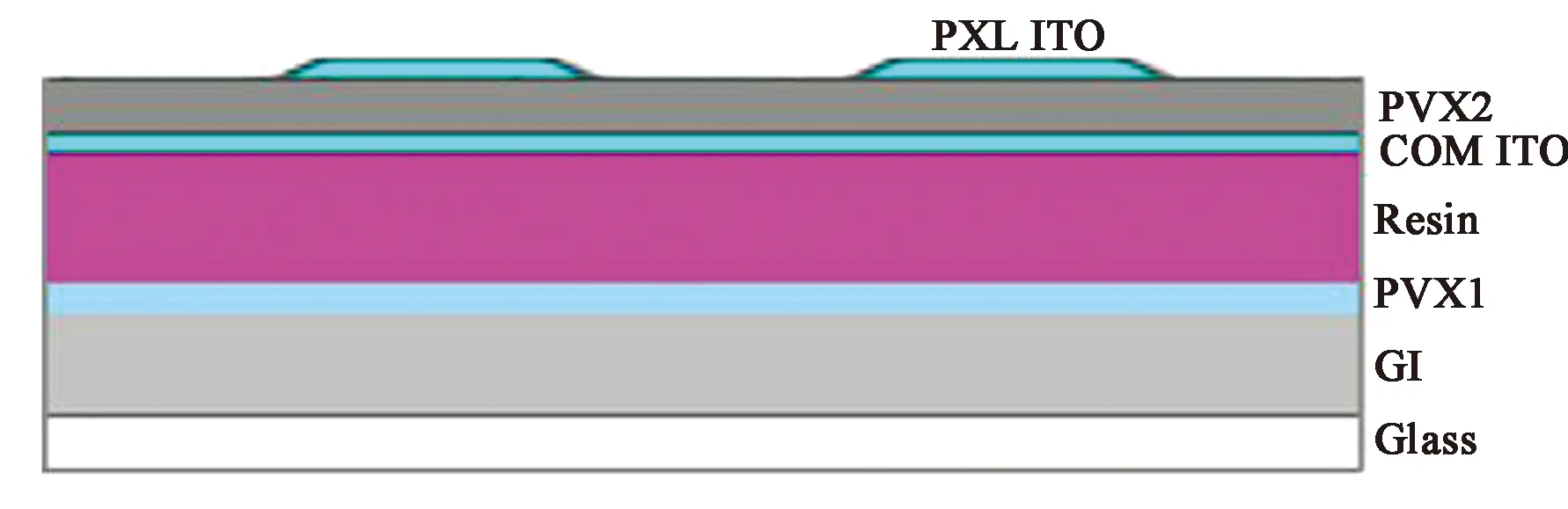
图1 TFT像素区膜层结构示意图Fig.1 Schematic diagram of TFT film structure in pixel area

图2 测试点位分布图Fig.2 Distribution map of test points
2.1 TFT WCU的测量及其计算
完成全部TFT工艺的基板使用Otsuka LCF-8000型MCPD设备测试像素区各点位的全波段透过率光谱,测试点位均聚焦于像素ITO条状电极正上方。为排除对盒工艺、彩膜RGB、偏光片以及背光色块波动等对白点色度的影响,将最理想状态下背光色块光通量、CF RGB光谱带入模拟,根据公式(1)(2)计算出LCD 面板白点色度坐标u′、v′值;单个TFT 面板内测试若干个点位白点色度坐标,根据公式(3)计算任意两点之间的白点坐标色度偏差Δu′v′(i,j),以差异最大两点的Δu′v′(i,j)表征TFT的WCU,即Δu′v′=Max{Δu′v′(i,j)}。
u′=4X/(X+ 15Y+ 3Z),
(1)
v′=9Y/(X+ 15Y+ 3Z),
(2)
(3)
2.2 SiNx各层膜厚的测量
采用K-Mac膜厚测量设备分别测试栅极绝缘层(GI),第一绝缘层(PVX1)和第二绝缘层(PVX2)层的960点膜厚:GI膜厚在源漏(SD)层工艺完成后测试像素区的剩余厚度即可,测试结果为GI层剩余厚度(GI remain THK),而考虑后续膜层堆叠对膜厚测试的影响,PVX1和PVX2的膜厚测试样品为白玻璃上PECVD沉积的单膜,测试结果分别简称为PVX1 THK和PVX2 THK。为保证测试的准确性,膜厚测试的样品成膜条件、所用的设备和腔室均与2.1章节所述的基板逐层保持一致。
3 实验结果及讨论
3.1 SiNx膜厚对u′的影响
图3为u′与各层SiNxTHK的散点分布图,从大体趋势上看,u′与PVX1 THK无明显的分布关联性,与PVX2 THK和GI剩余厚度有一定的线性关系,而在图3(a)中还看到,u′随着GI剩余厚度的增加分布变的愈加发散,尤其是在>350 nm的区间。由此可见,GI,PVX1和PVX2虽然同为SiNx材质,但THK-u′的趋势上看,三者还是存在很大的区别的。
为确保TFT特性的需求,各层SiNx沉积的条件和需要的规格存在很大的差异[8],表1列举了GI,PVX1和PVX2成膜参数和物理参数(ε介电常数,n折射率,T透过率)的对比,其中GI由高速沉积的和低速沉积两部分膜层组成(以下分别简称为GH和GL)。结合数据可看到PVX1的膜厚最薄、n值最大,但其趋势性最不明显,区间内各THK下u′分布的上限和下限差异不大;而n值较小的GI和PVX2两层对应的SiNxTHK和u′可见一定的线性关系,其中PVX2 THK趋势性最为明显,而GI剩余厚度的趋势性弱于PVX2 THK的主要原因推测是GH和GL存在一定的光学差异:在TFT SD层制作过程中,通常GI剩余厚度集中在320~370 nm区间,而沉积的GH厚度为350 nm,即当GI剩余厚度大于350 nm时,此时的GI剩余厚度很可能是GH和GL的复合膜。由于GH和GL的光学特性本身就存在差异,因此二者在不同厚度组合的下整体光学差异更为明显和不可控[9-10],这也能解释为何GI剩余厚度越大,u′分布越发散,并且在350 nm后愈发明显。
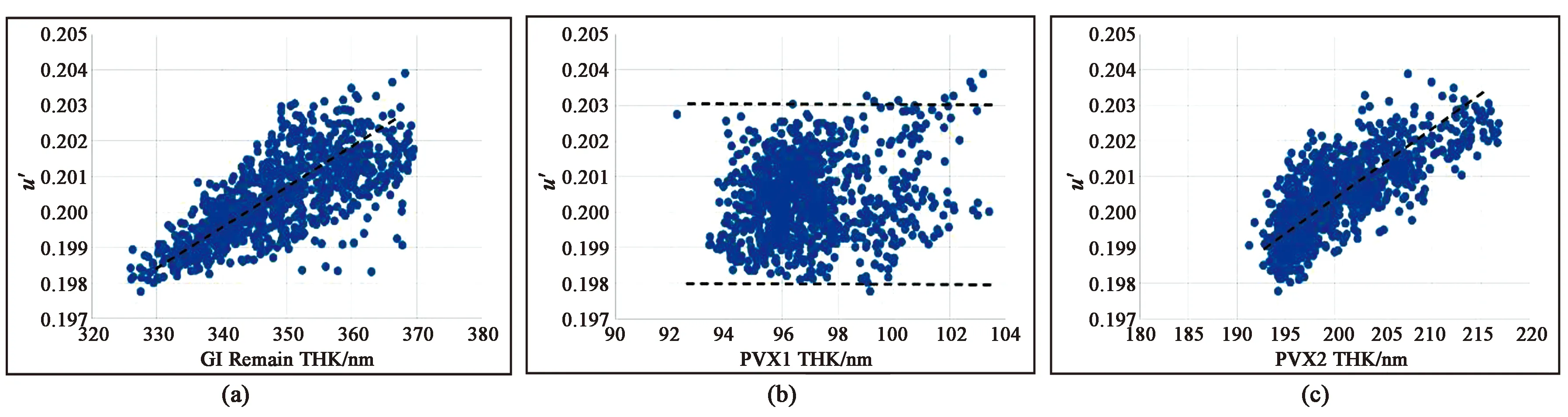
图3 u′与各层SiNx THK的散点图。(a)GI剩余厚度;(b)PVX1 THK;(c)PVX2 THK。Fig.3 Scatter diagram of u′ and SiNx THK of each layer.(a)GI remain THK;(b)PVX1 THK;(c)PVX2 THK.
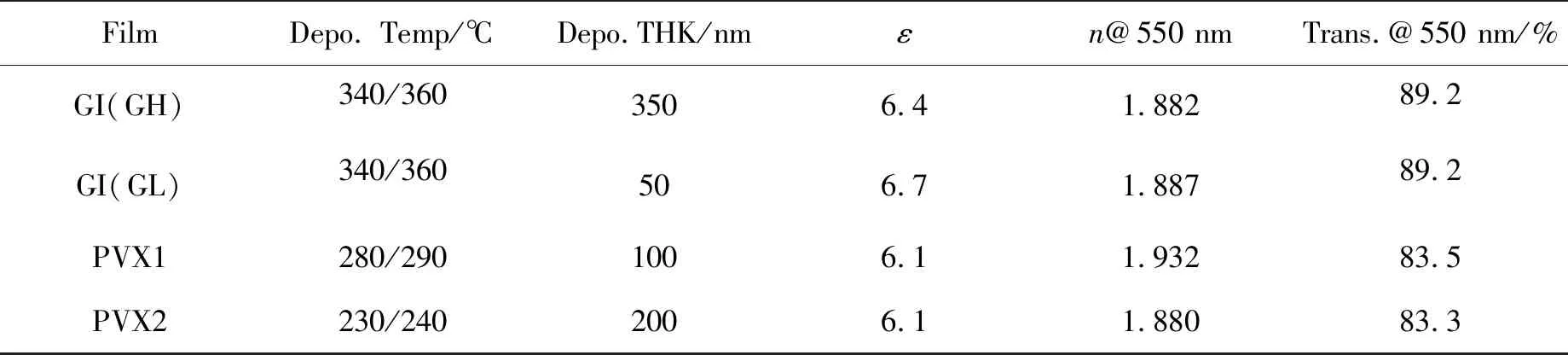
表1 不同SiNx成膜参数和物理参数的对比Tab.1 Comparison of each SiNx layer with deposition parameter and physical parameter
3.2 SiNx膜厚对v′的影响
图4为v′与各层SiNxTHK的散点分布图,从图中的分布趋势看,v′与各层SiNxTHK未见有较强的相关性,各个SiNxTHK下,v′分布的上下限都没有太大的变化,因此我们认为v′与SiNxTHK没有太大的关联性,针对膜层对TFT WCU影响可能更多的是集中在u′参数上。
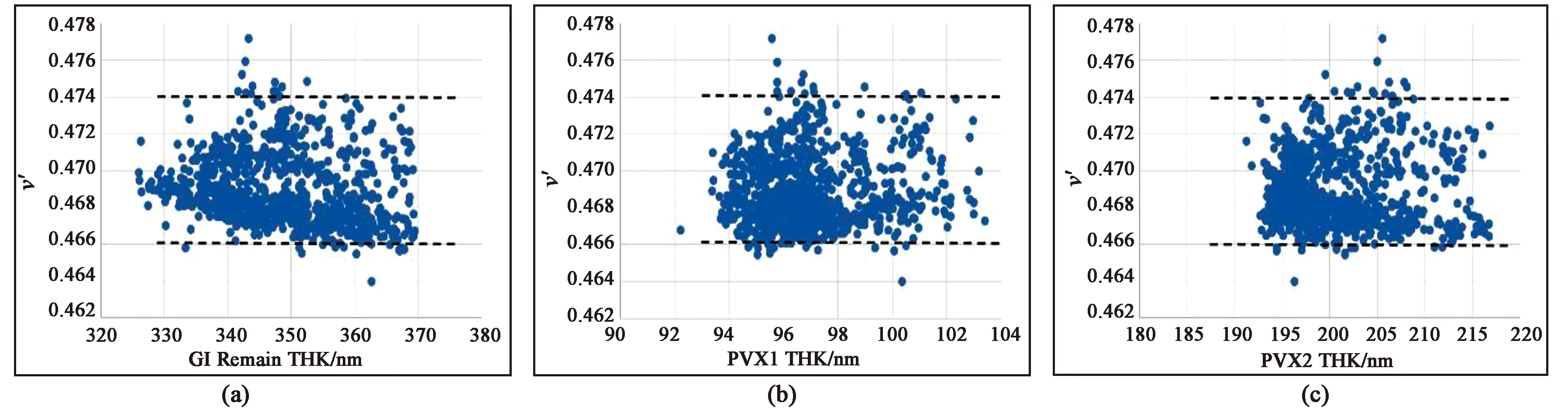
图4 v′与各层SiNx THK的散点图。(a)GI剩余THK;(b)PVX1 THK;(c)PVX2 THK。Fig.4 Scatter diagram of v′ and SiNx THK of each layer.(a)GI remain THK;(b)PVX1 THK;(c)PVX2 THK.
3.3 面内SiNx膜厚差异对Δu′v′的影响
单个面板内12个点位的THK[max]与THK[min]的差值为各层的ΔTHK,从中可以得到Δu′v′(即TFT WCU)与各层SiNxΔTHK的散点分布图,如图5可以看出,PVX2 ΔTHK与Δu′v′的线性趋势最为明显,其对TFT WCU的影响表现的最为直接,即面内PVX2 ΔTHK越小,相应的TFT WCU的结果越佳。从u′和v′与SiNxTHK的趋势看,GI剩余厚度和PVX2 THK二者都是相似的,但从ΔTHK与Δu′v′的关系看,二者差异较大,推测还是由于GI剩余厚度大于350 nm时可能存在GL层造成的,即考虑到基板内均一性的工艺波动,对应350 nm左右的GI剩余厚度下,既有可能是GH的单膜,也有可能是各组厚度组合的GH和GL复合膜,光学特性差异大,最终造成Δu′v′的离散和不可控,而PVX2一直是单层膜结构,特定厚度下光学特性稳定,整体上看呈现出较好的ΔTHK- Δu′v′线性关系。PVX1同样为单层膜结构,但其整体厚度只有100 nm,且最大ΔTHK不到6 nm,面内厚度均一性明显优于GI和PVX2,因此PVX1THK层对WCU的影响相对最不明显,u′、v′和Δu′v′均无明显的趋势性。

图5 Δu′v′与各层SiNx ΔTHK的散点图。(a)GI剩余ΔTHK;(b)PVX1 ΔTHK (c)PVX2 ΔTHK。Fig.5 Scatter diagram of Δu′v′ and SiNx ΔTHK of each layer.(a)GI remain ΔTHK;(b)PVX1 ΔTHK;(c)PVX2 ΔTHK.
3.4 TFT WCU的改善
综合前文所述,PVX1 THK与u′,v′和Δu′v′关系均不明显;对于GI剩余厚度,若其过厚,由于GH和GL膜层间的差异会导致u′和Δu′v′的离散。PVX2 THK与u′的线性关系明显,且面板内PVX2 ΔTHK越小,相应的Δu′v′的数值就越低。因此,对于GI层改善的方案为增加干法刻蚀的刻蚀量,降低整体GI剩余厚度,以避免像素区GL层的存在,即增加有源层刻蚀和N+层刻蚀的干法刻蚀时间使得GI层多被刻蚀约25 nm,最终的GI剩余厚度的最大值小于350 nm,中心值在325 nm的水平;对于PVX2层,需要尽量减少面板内厚度的差异,相应的改善方案膜厚降低,即在满足设计需求的前提下(如充电率,Cst等),根据PVX2成膜速率折算并降低PECVD的沉积时间,使得厚度中心值由200 nm降低至150 nm。
图6为改善前后基板内80片面板的TFT WCU分布图,为取得更佳的效果,我们的改善措施综合了前述的两项改善方案,从中可以看出,通过同时降低GI剩余厚度和PVX2 THK的中心值分别至325 nm和150 nm,TFT WCU整体均值可降低约0.000 7,基板内各面板的分布更加均匀,最大值由改善前的0.007 0降至改善后的0.005 2,从而满足了最大值≤0.005 5的管控规格,改善效果明显。

图6 改善前后TFT WCU数值对比Fig.6 TFT WCU value comparison of before and after improvement
4 结 论
通过分别测试相同点位下SiNxTHK与TFT WCU的数值,分析了u′,v′和Δu′v′分别与GI剩余厚度,PVX1 THK和PVX2 THK的匹配关系,明确了TFT WCU与各层SiNxTHK的关联性为PVX2 THK>GI乘余厚度>PVX1 THK。对于TFT WCU的优化方案,一方面可根据3.3章节中的PVX2 ΔTHK与Δu′v′线性关系,降低PVX2整体膜厚,Δu′v′也相应降低;另一方面可根据3.1章节中的GI剩余厚度与u′散点图,增加SD HT工艺的过刻量,避免GL层的残留造成的GI膜层光学特性的波动。通过组合上述两个改善方案,使得基板内80 面板的最大值降到了≤0.005 5的规格范围内,成功优化了TFT WCU的整体水平,进一步提升了产品品质。

