磁控共溅射法制备ZrRu薄膜及其电学性能研究
孟 瑜,沈 欢,宋忠孝,畅庚榕
(1.西安文理学院 陕西省表面工程与再制造重点实验室,西安 710065;2.西安交通大学 金属材料强度国家重点实验室,西安 710049)
0 引言
由于具有较低的电阻率和较好的抗电迁移能力,Cu已经成为集成电路的首选互连材料。然而,Cu和Si在200℃下容易互相扩散而导致器件性能恶化,通常在Cu与Si之间加入扩散阻挡层来抑制二者的互扩散[1-3]。目前对阻挡层材料的研究仍以过渡族金属及其化合物为主,如Ta、Ti、Mo、W和Ru等[4-8]。理想的阻挡层材料应具有较低的电阻率,良好的热稳定性和化学稳定性,与Cu互连工艺有较好的兼容性,可以通过常规薄膜方法制备,如物理气相沉积、化学气相沉积、原子层沉积等[9-10]。
本课题组研究了Ru膜中掺杂少量Zr元素的RuZr阻挡层的化学特性、结构特性及扩散阻挡性能,结果表明:随Zr元素含量增加,RuZr合金阻挡层由晶体结构向非晶结构转化,可在600℃以下有效阻挡Cu原子扩散,明显改善了Ru的扩散阻挡层效果[11]。但Ru基合金阻挡层成本高、耐高温性差的特性将会阻碍其推广应用[12-13],因此,低Ru含量的Zr基合金膜的特性亟待研究。本文采用磁控共溅射技术在Zr薄膜中掺入不同含量的Ru原子,系统研究ZrRu薄膜的化学特性、微观结构及电学性能。
1 实验方法
利用JGP560V型高真空磁控溅射设备在p型Si(100)基底上沉积ZrRu薄膜。沉积前,对靶材及硅片进行清洁处理,用丙酮和无水乙醇分别超声10 min后,用去离子水清洗并烘干备用。溅射室本底压力为4.0×10-4Pa,薄膜沉积时工作气压为0.4 Pa,Ar流量为40 mL/min。固定Zr靶功率为80 W(采用直流溅射),调节Ru靶溅射功率为30 W、35 W、40 W和45 W(采用射频溅射),溅射时间均为30 min。
利用X射线光电子能谱仪(XPS,Thermo-Scientific K-Alpha)分析ZrRu薄膜的化学组成及键合状态,采用Al的Kα射线作为激发源,样品分析区域为400µm直径的点圆,采用Ar离子对样品表面刻蚀60 s以去除表面污染物,Ar离子能量和入射角分别为2 keV和45°;采用掠入射X射线衍射仪(GIXRD,XRD-7000,岛津)表征薄膜的物相结构,2θ扫描范围为30~80°,步长 0.02°,扫描速度为 8°/min;利用场发射扫描电子显微镜(SEM,Nova NanoSEM 450)观察薄膜的截面和表面形貌,利用图像标尺测量薄膜截面厚度,并根据截面厚度与沉积时间计算薄膜的沉积速率;采用数字式四点探针测试仪(FPP,RTS-9)测定薄膜的方块电阻(简称方阻),每个样品测试5次,最后取平均值。根据薄膜的截面厚度与方阻计算薄膜电阻率ρ=Rsd(Rs为方阻,d为薄膜厚度)。
2 结果与讨论
2.1 薄膜的沉积速率及化学成分
如图1所示,ZrRu薄膜的沉积速率随Ru溅射功率的增加而增加。当Ru溅射功率为30 W时,薄膜沉积速率为7.74 nm·min-1;当Ru溅射功率为45 W时,薄膜沉积速率为17.99 nm·min-1。薄膜的沉积速率与靶材的溅射产额有关,Ru靶与Zr靶的溅射产额比为1.7∶1[14],由于在沉积过程中保持Zr溅射功率不变,随Ru溅射功率的增加更多的Ru原子被Ar离子溅射出来,提高了沉积速率[15]。当Ru溅射功率升高到35 W以上时,被溅射出来的Ru原子携带更高的能量,这些高能原子会轰击掉部分沉积的薄膜,导致沉积速率增加缓慢。

图1 不同Ru溅射功率沉积的ZrRu薄膜的沉积速率曲线Fig.1 Deposition rate of the ZrRu films at different Ru sputtering power
采用SEM附带的EDS能谱仪对ZrRu薄膜的成分进行分析,不同ZrRu薄膜中Ru原子百分比如图2所示。当Ru溅射功率为30 W、35 W、40 W和45 W时,薄膜的Ru原子含量百分比分别为6.24%、7.64%、8.32%和9.89%,随Ru溅射功率增加呈上升趋势。XPS分析薄膜中Zr 3d和Ru 3d的结合峰位表明,两种元素在合金膜中分别以Zr-Zr和Ru-Ru键形式存在。

图2 不同Ru溅射功率沉积的ZrRu薄膜中Ru原子百分比曲线Fig.2 Atomic content of Ru atoms in ZrRu films with different Ru sputtering power
2.2 薄膜的物相结构
图3示出了用不同Ru溅射功率沉积的ZrRu薄膜的XRD谱图。随Ru溅射功率的升高,掺杂含量增加,合金膜由非晶结构逐渐向纳米晶结构转变。当Ru溅射功率为30 W和35 W时,薄膜呈现非晶或微晶结构;当Ru溅射功率为40 W时,出现晶化特征,但是衍射峰强度较弱;当Ru溅射功率为45 W时,薄膜呈现多晶结构。图中 2θ=38.46°、44.04°、58.37°和69.51°分别对应 Ru的(100)、(101)、(102)和(110)四个衍射峰,且以(101)为择优取向峰。该结果与前期研究中高Ru含量的ZrRu的物相结构变化呈对应关系[11],即随Zr含量的增加薄膜晶体结构发生从多晶→纳米晶→非晶的转变,表明通过调整Ru、Zr元素含量可以实现ZrRu阻挡层微观结构的调控。

图3 不同Ru溅射功率下ZrRu薄膜的XRD谱图Fig.3 XRD patterns of ZrRu films with different Ru sputtering power
2.3 薄膜的微观形貌
图4为用不同Ru溅射功率沉积的ZrRu薄膜的截面SEM形貌图。从图中可以看出,合金膜表面连续平整,与基底结合良好。当Ru溅射功率为30 W、35 W、40 W和45 W时,薄膜厚度分别为232 nm、437 nm、508 nm和540 nm,即薄膜厚度随Ru溅射功率的升高呈增加趋势。薄膜呈现均匀分布的柱状结构,根据Takeuchi的三个经验法则[15-16],从靶材溅射出来的原子或原子团在基底上沉积时容易发生聚集,以岛状结构堆积生长,形成柱状结构形貌。结合XRD结果可知,只有当Ru溅射功率为45 W时,薄膜为纳米柱状晶结构。
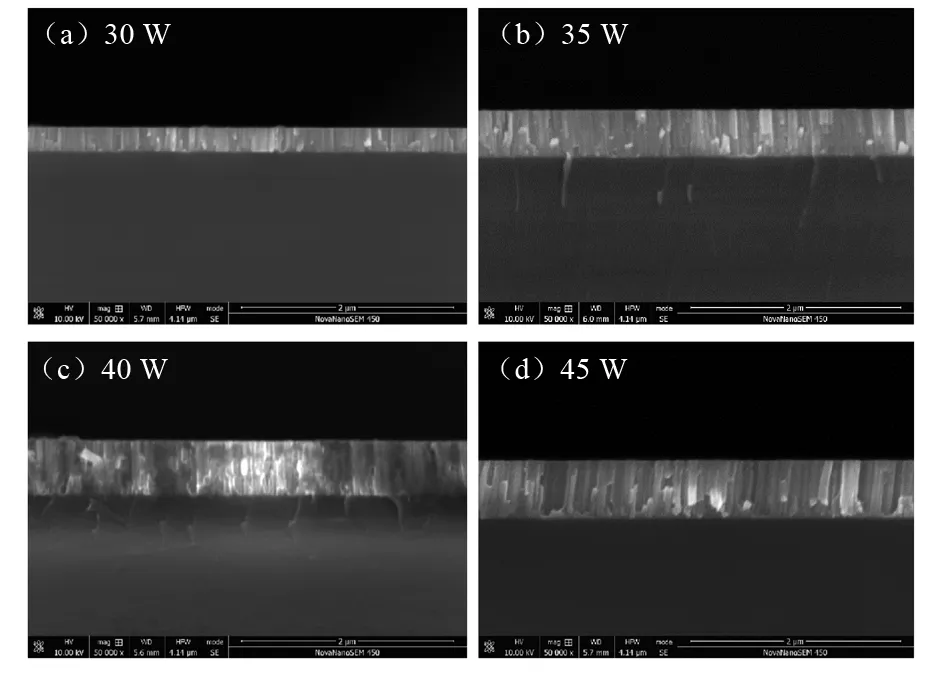
图4 不同Ru溅射功率沉积的ZrRu薄膜的截面形貌图Fig.4 Cross section morphology of ZrRu films deposited at different Ru sputtering power
图5为ZrRu薄膜的表面形貌图。可以看出,用不同Ru溅射功率沉积的薄膜表面均呈现颗粒状,且随溅射功率增加,表面颗粒尺寸和致密性增加,这是由于溅射功率增加会使沉积速率升高,薄膜临界核半径与临界形核自由能均随之降低,从而导致高的形核速率和致密的薄膜组织。
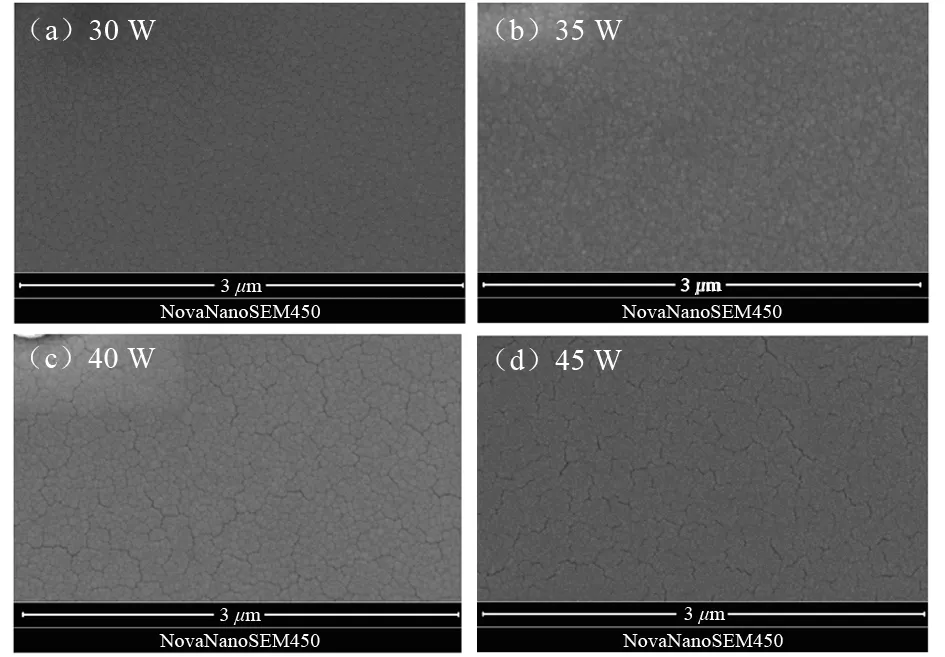
图5 不同Ru溅射功率沉积的ZrRu薄膜的表面形貌图Fig.5 Surface morphology of ZrRu films deposited at different Ru sputtering power
2.4 薄膜的电学性能
图6为ZrRu薄膜的电阻率随Ru溅射功率增加的变化曲线。由图可知,随Ru溅射功率增加,薄膜的电阻率由30 W时的192.2µΩ·cm降低为45 W时的53.5µΩ·cm,这是由于一方面合金膜中电阻率较低的Ru元素含量逐渐增加;另一方面,结合SEM图可知,Ru含量较高的薄膜晶粒尺寸较大,降低了晶界对电子的散射作用,从而降低薄膜电阻率[17]。薄膜整体电阻率较低,还与薄膜表面粗糙度有关,薄膜表面散射对薄膜导电性有一定的影响,薄膜电阻率随表面状态发生变化[18]。
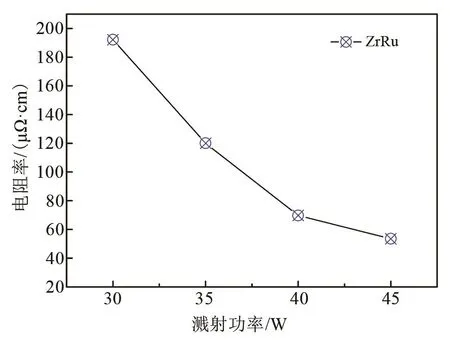
图6 ZrRu薄膜的电阻率随Ru溅射功率的变化曲线Fig.6 Resistivity of ZrRu films as a function of Ru sputtering power
3 结论
采用磁控共溅射技术在单面抛光p型Si(100)基底上制备了不同元素含量的ZrRu薄膜,系统研究了ZrRu扩散阻挡层的化学键合状态、物相结构、微观形貌和电学性能的变化规律。结论为:(1)随Ru溅射功率的增加,ZrRu薄膜的沉积速率增加,Ru原子百分比增加,薄膜中Ru、Zr均以金属单质形式存在,ZrRu合金膜由非晶结构向多晶结构转变,主要为Ru的纳米晶,且以(101)为择优取向;(2)沉积的合金膜表面平整连续,与基底界面结合良好,薄膜结构致密,由均匀分布的纳米晶组成;(3)薄膜的电阻率介于53.5~192.2µΩ·cm之间,且随Ru靶溅射功率的增加呈现递减的趋势,表明了ZrRu薄膜具有良好的电学性能。

