铝酸锌(ZnAl2O4)基导热陶瓷材料的研究
陈仕军
(潮州三环(集团)股份有限公司,广东 潮州 521000)
铝酸锌的化学名称为ZnAl2O4,在铝酸锌陶瓷中一种纯相呈现白色陶瓷是新型的陶瓷材料,为进入新世纪后才得以研究发展的,在性能和晶体方面与其相像的是一种MgAl2O4陶瓷,其颜色也呈现白色,被称作镁铝尖晶石,基于构成2种陶瓷材料的共同晶体是尖晶石,我们对这种天然矿物的利用历史已经很久,是宝石生产的原材料之一。而构成尖晶石的物质为MgAl2O4,是硬度极大的矿物,可达到8以上的莫氏硬度,基于杂质因素特征而表现诸多颜色。以往,很少有研究者全面系统地研究过以ZnAl2O4类型的尖晶石结构陶瓷材料,直到最近几年,研究者才发现了这种材料的优势,不仅导热和介电性能极佳,还具备一定的机械强度,有望成为陶瓷导热基板材料家族中的新宠。
1 铝酸锌陶瓷的研究状况
最早报道ZnAl2O4和MgAl2O4这2种尖晶石结构铝酸盐材料的时间是2004年,而这2种介电陶瓷材料研究最早的国家是印度。2004年Surendran等人发表了ZnAl2O4的研究信息,相继在2005年MgAl2O4的研究信息也发表,该研究对这2种材料的介电性能进行了介绍。针对降低ZnAl2O4陶瓷温度的研究,Qinl等人在2019年尝试运用LMZBS(Li2OMgO-ZnO-B2O3-SiO2)玻璃做实验,显示当LMZBS玻璃的总质量中达到2/3掺杂量时,能够把ZnAl2O4-LMZBS的复合材料烧结温度下降到920℃,而此刻,这2种材料的复合体已经转化为Mg2b2O5和Li2ZnSiO4,Q×f作为材料的品质因数恶化值也达到34100GHz。实验显示,玻璃对 ZnAl2O4的烧结效果较差,不仅掺杂量大,更大幅度降低其品质[1]。
2 ZnAl2O4基陶瓷基板的优势
电子封装基板的制造材料陶瓷基板等,可以支撑和绝缘电路和元器件,之所以陶瓷材料材料应用广泛,它具有以下性能优势:1)良好的绝缘性能。因为非金属晶体的属性,陶瓷材料的电阻率很低,不用另外的绝缘处理,因为生产基板容易而成本低。2)优良的高频特征,因为陶瓷材料介电常数较小,也因为非常低的损耗角正切值形成了高品质因数,所以表现很低的信号延迟促进了信号传输速度的提升。同时,非常小的介电损耗会减少高频率作业产生的热量,所以更适合应用在5G、宇宙航天通信等高频行业。3)热膨胀系数的优势,在不断变化的工作温度下,相匹配的热膨胀系数可以有效保护芯片稳定地与其他电子元件的连接,不会发生脱焊,减轻了电子系统被热应力影响的程度。4)高热导率的优势,陶瓷材料的热导率远远超过传统的((C11H12O3)n)塑料基板,可达0.4 W/(m·K)的差异幅度,特别是一些立方晶系的陶瓷材料理论上的热导率能够超过金属。
3 ZnAl2O4基板与其他材质基板在不同工况下散热能力研究
ZnAl2O4基陶瓷材料一种具有良好导热与介电性能的电子封装基板材料。该文将构件试验用的基板物理模型,将该类型的铝酸锌材料与业界普遍使用的2种电子封装基板材料共同使用作为模型基板,在此基础上利用模拟试验比较不同操作环境下不同导热率基板材料的散热效果,进行ZnAl2O4基陶瓷材料性能的验证。
3.1 基板的三维模型
基于该文是以基板材料的热导率为主要研究课题核心,并非是以优化基板结构设计为重点,所以,有必要简化基板结构的设计,更有助于仿真计算。模型的尺寸见表1。

表1 基板物理模型部件规格
3.2 计算等效热导率
在以上的物理模型中芯片的形式为没有封装的裸芯片状态,因此必须等同芯片本身热导率和芯片材料的热导率,芯片材料热导率为Si,大约是155W/(m·K)[2],在该模型仿真中,采用的铝酸锌陶瓷材料的热导率大约18.97 W/(m·K),同时还采用了另外2种材料进行仿真对比试验,其中环氧树脂的热导率为0.31W/(m·K),低温共烧陶瓷材料热导率大约为3.3W/(m·K)。考虑到基板结构特点,基板的热导率不能是以上3种材料的热导率,而是要计算3种材料采用的实际基板结构,然后得出基板的等效热导率。计算公式如公式(1)所示。

式中:λ1为铜的热导率;λ2代表基板基材的热导率;v1为铜层厚度与整体基板厚度的比例,也就是0.053。
表2是电子系统各部分的热导率情况。

表2 基板各结构等效热导率
3.3 设计散热模型
通常情况下有3种传热模式,即热辐射、热传导和热对流。该文的试验需要在仿真模型中应用这3种传热模式。
其中热传导散热可以在基板内部进行,散热的范围可以是芯片与散热基板之间、基板内部和芯片内部;芯片和基本与空气间的热交换是通过热辐射完成的,传热方式主要是一种热交换,表现在空气与基板和芯片之间的热交换,在50 ℃以上就必须引起重视[3]。基于设定26℃的室温,所以可以不去考虑空气热辐射基板的情况。但要关注基板传热给空气的状况,可以设定为0.72的辐射率。实现热对流的途径是空气在基板表面流动,基于温存在一定的温差基板热量会被空气带走。不一样的对流速度产生的效果也不同。
4 仿真模拟与结果分析
4.1 导入模型和设定参数
试验的模型通过SolidWorks设计完成后,在ANSYS有限元分析软件中将建好的模型导入,设计理想边界条件,然后设定芯片发热功率和基板各部分材料热导率,再进行基板附近环境变量的设定,包括风速、温度等,随后进行迭代计算,模拟一百次迭代[4],迭代的目的是通过在计算开始时加入势能热输入量和多种形式的传热速率等瞬态量,物理量输出相对稳定,模拟过程由开始的热不稳定到最后的热平衡,这也意味瞬态到稳态热分析的过程。
4.2 分析模拟结果
该文模拟的2种信息状态为芯片热功率的设定和环境风速,一般情况下芯片正常工作不能高于86℃,突破这个极限就会显著增加各种故障发生的概率。
4.2.1 室内芯片小功耗模拟
针对该状态,芯片热功率可以设定为1 W,环境风速为0 m/s,详细数据如图1所示。
从图1中可以看出,在低功耗,在无风介入的散热状态下,自然散热也就是无风的条件下,环氧树脂基板的芯片已经临近86 ℃的限值,工作可以勉强进行,而LTCC与ZnAl2O4基陶瓷基板都可以在室内小功率芯片的条件下轻松作业。而且分析基板各部分温差,使用材料的热导率越高基板各部件间的温差就越不明显,可以有效避免基板热力变形现象的产生。相反,环氧树脂基板各部分已经接近80℃的最大温差,长此已久就会发生一些热应力故障。
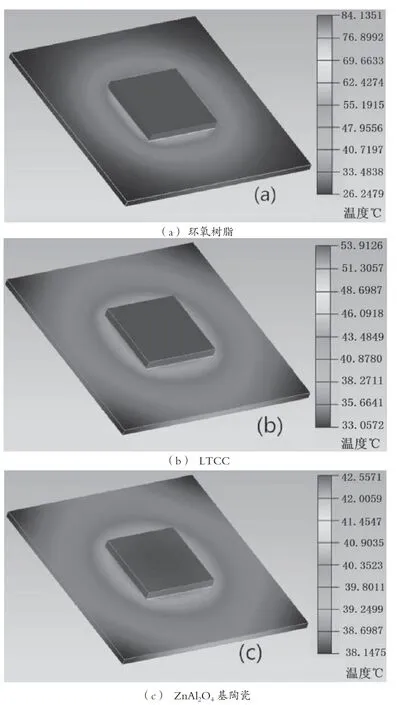
图1 不同材料的基板在芯片热功耗1 W
4.2.2 室内芯片中功耗模拟
针对这种情况,可以设定芯片功耗为4.3 W,环境风速设置为0 m/s,在室内采用中功耗进行工作,低温共烧陶瓷和环氧树脂芯片的温度明显突破了工作温度的极限,而ZnAl2O4基陶瓷基板芯片的温度却一直在正常的工作温度内,足以显示其散热性能良好。而且随着不断增大的功率,也会逐渐将不同热导率材料的芯片的温差拉大[5]。中、低热导率基板各部分的温差也随拉伸距离的增大而增大。不难看出,不具备辅助散热的中等热功耗芯片在在室内使用的难度很大。因为该状态下,中等热功耗芯片没有辅助的情况下散热有很大难度。因为该状态下,部分热量由缓慢的热空气上升发出,并通过芯片表面与基板和空气之间的温差散发热量。在自然对流(无风)的情况下,周围区域的温度低于芯片上表面附近的空气温度,所以大量热量会向芯片表面附近的空气转移,向外扩散不畅。基板上的芯片温度变得非常高,因为正上方空气的缓慢对流将热量带走。针对这种情况,在接下来的一组实验中,工作人员对在室外通风环境下的工作状况进行模拟,这样的条件更接近芯片在室外的应用环境。
4.2.3 室外芯片中功耗模拟
针对该状态,可以将芯片的热功耗设定为4.2 W,设定环境风速为3.6 m/s,该风速等同于外界23级风的速度。详细数据见图2所示。

图2 材料不同的基板特定热功耗和风速下的温度状况
从图2可以看出,在外界通风的情况下利用中功耗,终于将环氧树脂基板上的芯片的温度降低到极限以下,同时显著下降的还有LTCC基板芯片温度,而ZnAl2O4基陶瓷基板芯片温度已经降到39℃以下。由此可见,在风的作用下,基板上的温度难以对称分布,并且显示温度在风来向时低,在去向时偏高,这种情况可以根据空气的热流分布规律进行解释。在强制对流(通风)条件下,芯片上方空气的温差小于无风时的温差,因为流动空气会将沿芯片周围方向的热量带走。通过试验不难看出,基板和芯片附近的空气呈现较低的温度,而进入芯片的空气温度较高,因为先前流动中交换的热量被它携带着,这也是基板温度不均匀的关键所在。从实验可以看出,芯片和基板周围的风的空气温度较低,进入芯片的空气更高,因为基本周围的的定向气流,芯片表面和基板的热量可以被空气去除,所以,如果是强制流动的工作环境,芯片的工作会很稳定,这也是利用冷却风扇对CPU等芯片进行冷却的原理。为了测试高导热基板材料的热容量极限,继续增加芯片的热能消耗,在恒风速条件下进行下一组对比实验。
4.2.4 室外芯片高功率模拟
在该状态下,可以将芯片的热功率设定为15.8W,风速环境设定为3.6m/s,在室外通风条件下的高功耗工作,没有突破极限工作温度的基板芯片温度是ZnAl2O4基陶瓷,而LTCC和环氧树脂基板上芯片都突破了极限的工作温度,不同热导率的基板芯片的温差大于中等功耗芯片的温差。每个基板不同部分之间的温差也在增加,即使在通风换热缓解的高热导率板上,温度也高达69 ℃。
5 结论
该文对拥有极佳热导率陶瓷材料、业界广泛使用的中热导材料LTCC以及热导率较低的环氧树脂进行针对基板散热情况的模拟试验设计,对比模拟试验了不同环境风速与不同芯片热功耗的场景,结果显示,该文重点介绍的新型铝酸锌导热材料可以切实满足不同环境和芯片热功率不一样状态下的需求。在高功耗以及外界超强的对流散热下,该材料具有优势,因此新研发的 ZnAl2O4基导热陶瓷材料应用前景非常广阔。

