AlGaN/GaN 高电子迁移率晶体管的栅极电容模型*
刘乃漳 姚若河† 耿魁伟2)
1) (华南理工大学微电子学院,广州 510640)
2) (中新国际联合研究院,广州 510700)
AlGaN/GaN 高电子迁移率晶体管的栅极电容由本征电容和边缘电容组成.边缘电容分为外部边缘电容和内部边缘电容,内部边缘电容相比外部边缘电容对器件的开关转换特性更为敏感.本文基于内部边缘电容的形成机理,推导了内部边缘电容Cifs/d 模型,进一步的分析表明,其与器件的栅极偏置强相关;基于Ward-Dutton 电荷分配原则推导了相应的本征电容模型,最后结合外部边缘电容得到了完整的栅极电容模型.由于边缘电容是由器件结构产生的寄生电容,仿真结果表明,若不考虑边缘电容的影响,栅源电容的误差可达80%以上,而栅漏电容的误差可达65%以上.因此,在高频开关应用领域,边缘电容对栅极电容的影响不可忽略.
1 引言
AlGaN/GaN 高电子迁移率晶体管(high electron mobility transistor,HEMT)是现代微波电路的重要器件[1-6],随着器件和电路系统仿真技术的不断进步,应用领域不断往高频深入,人们对AlGaN/GaN HEMT 器件模型的要求越来越高.AlGaN/GaN HEMT 的电容模型对准确预测处于微波与毫米波的数字/模拟高速芯片有重要的作用[7].
Ward 和Dutton[8]基于电路各节点的电荷守恒原理,提出了一种金属-氧化物-半导体系的本征电容建模方法,该方法也可应用于HEMT 器件电容的建模.Yigletu 等[9]基于Ward-Dutton 电荷分配原则对AlGaN/GaN HEMT 本征电容进行了建模,得到的本征电容模型精度较高,但是该电容模型没有考虑边缘电容的影响.之后Li 和Rakheja[10]指出栅极电荷里除本征电荷外,其寄生部分电荷占有一定的比例,而且该寄生电荷受外加偏置的影响.Jia 等[11]把边缘电容考虑到栅极电容中,指出栅极电容包含了本征电容和边缘电容两部分,然而该模型中的内部边缘电容值是通过测量得到的,而边缘电容的测量受诸多不确定性因素的影响,并且基于该建模方法无法得到一个包含边缘电容的统一栅极电容模型.目前尚未见到完整的的栅极电容物理模型文献,边缘电容在栅极电容中的影响作用和不同偏置条件下栅极电容的变化情况需进一步明确.
本文在基于保角映射法推导出外部边缘电容Cofd模型的基础上[12],进一步推导出内部边缘电容Cifs/d模型,通过引入过渡函数(Tf)来表征Cif在器件开启后逐渐转换为Cgc的过程,然后基于Ward-Dutton 电荷分配原则建立了本征电容模型,最后结合本征电容和边缘电容模型推导出完整的栅极电容模型.
2 栅极电容模型
图1 是AlGaN/GaN HEMT 栅极电容处于开启状态或者关断状态下的电容示意图.图中的电容可以分为本征电容Cgs/d、外部边缘电容Cofs/d、内部边缘电容Cifs/d以及栅极和沟道之间形成的电容Cgc.当器件处于关断(OFF)状态时,如图1(a)所示,施加的栅极偏压小于阈值电压,在栅极下方形成一定长度的耗尽区,并且受栅极两边表面态的影响,沟道耗尽层向两边拓宽[13],该耗尽层把沟道分隔为源端沟道和漏端沟道,每一端都由1 个本征电容和2 个边缘电容构成,这3 个电容的总和就是源(漏)端在关断状态下的总电容值.随着Vg偏压逐渐上升,栅极两边的类施主表面态释放电子[14,15],由该“虚栅”作用产生的耗尽层消失.同时,由于栅压提高,异质结势阱加深进而逐渐积累电子,栅极下方的耗尽层也在变窄.在耗尽层收窄的情况下,二维电子气(two-dimensional electron gas,2DEG)沟道不断往中间靠拢,直至源漏两端的2DEG 沟道完全闭合,这时内部边缘电容完全消失,转换为栅极—2DEG 沟道电容Cgc,如图1(b)所示.因此,对于内部边缘电容来说,器件从关态到开态过程中是一个逐渐变化的过程.
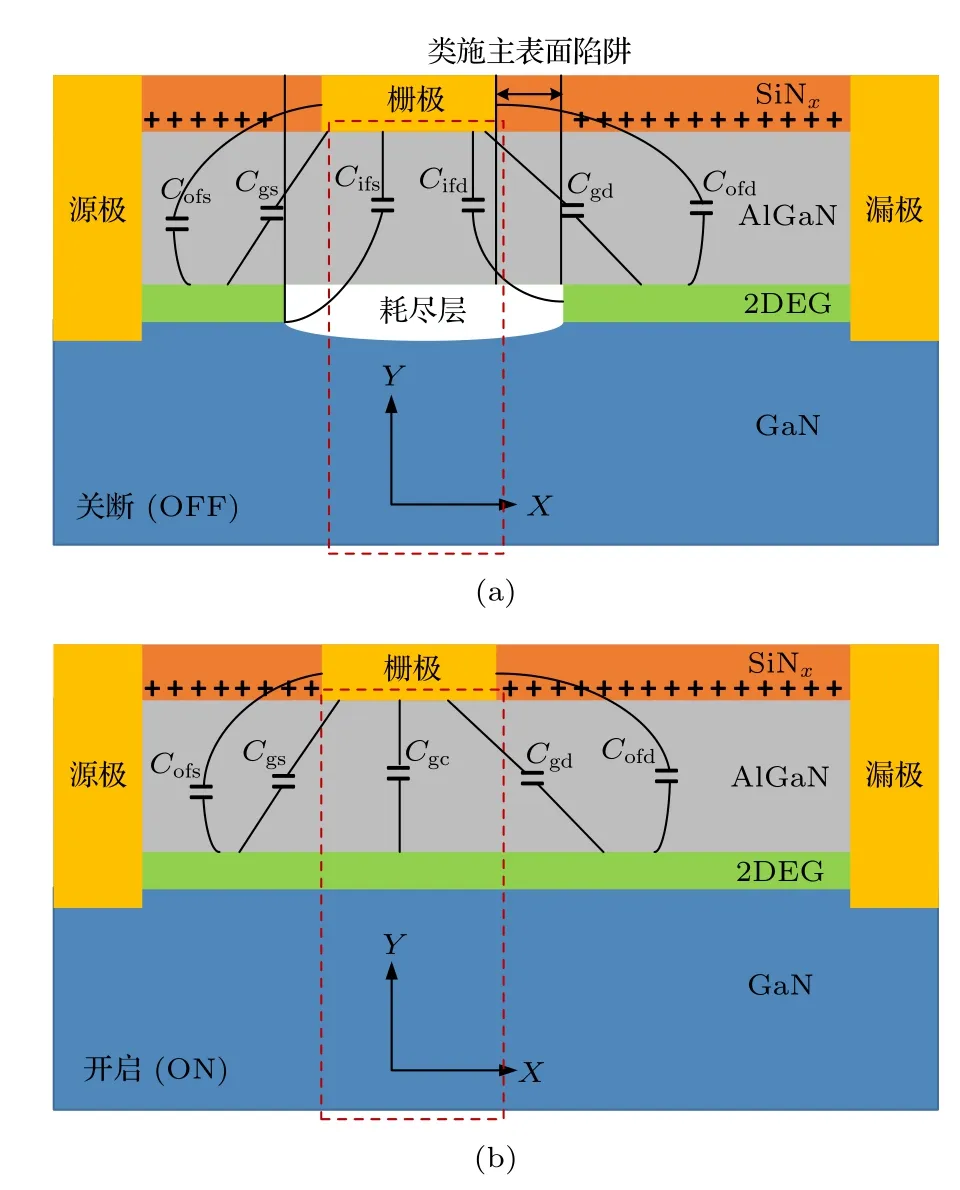
图1 不同工作状态下AlGaN/GaN HEMT 栅极电容的示意图 (a)处于关断状态;(b)处于开启状态Fig.1.Schematic of AlGaN/GaN HEMT gate capacitances in different states:(a) In the OFF-state;(b) in the ON-state.
栅极电容是本征电容和2DEG 相关边缘电容的总和,可分为栅源电容和栅漏电容,对应的表达式如下[16]:

因此,为了求得栅源或栅漏电容需要获取对应的本征电容和边缘电容.
2.1 本征电容模型
(1)式和(2)式中本征电容Cgs/d可以通过电荷分配原则确定,基于电荷分配的本征电容计算公式为[17,18]

式中,W是栅极宽度;L是栅极长度;q是电子电荷;f(n)和g(n)是计算栅极电荷Qg时换元得到的函数,均是关于2DEG 浓度的函数,具体表达式为

其中,d是AlGaN 势垒层厚度,vth是热电压,γ0是由实验数据得到的拟合参数,ε代表介电常数.(6)式和(7)式关于沟道电势的微分表达式为

其中,nx代表了势阱内源端或者漏端的2DEG 浓度.源端2DEG 浓度ns关于栅极偏压的表达式为[19]

求解漏端2DEG 浓度nD,只需将(11)式中的栅压变量Vg0替换成等效的栅漏电压Vgd0,再利用同样的ns模型求出来的就是漏端2DEG 浓度nD的模型,Vgd0的表达式为


式中,Vd,eff表示考虑沟道长度调制效应后的漏端等效电压,其经验公式为

式中,k是拟合参数;Vsat是饱和电压,具体表达式为[9]

其中vsat是电子饱和速度.结合推导出的nD表达式代入到(3)式中就能求出Cgd.
2.2 边缘电容模型
图2 是漏端沟道边缘电容电场的示意图,图中Lg指的是栅极长度,TAlGaN是势垒层厚度,Te是二维电子气层厚度,内部边缘电容和外部边缘电容的形成原理一样,内部边缘电容是由栅极底部水平壁到2DEG 垂直侧壁之间等效电场构成的等效电容,建模方法可以利用保角映射法.在2DEG沟道向栅极靠近过程中,椭圆电场线围成的面积逐渐缩小,意味着内部边缘电容在2DEG沟道不断靠近栅极过程中是逐渐变小的,最终在沟道完全闭合后转换为Cgc.

图2 靠近漏端处边缘电容示意图Fig.2.Schematic of fringing capacitances near the drain.
图3 是漏端内部边缘电容Cifs/d电场的示意图,图中Te表示2DEG 厚度,Ldep_d表示源/漏表面态宽度.由图3 可见源端和漏端的电场分布是一样的,它们都是以1/2 的栅极底部水平壁和2DEG垂直壁为边,内椭圆长边都是AlGaN 势垒层厚度,唯一区别是栅极两边的类施主表面态长度不同,因此在对源端或者漏端内部边缘进行建模时可以用同一种方法,区别只是改变表面态长度变量Ldep_s和Ldep_d.将外部边缘电容表达式[6]进行修改后得到内部边缘电容表达式为
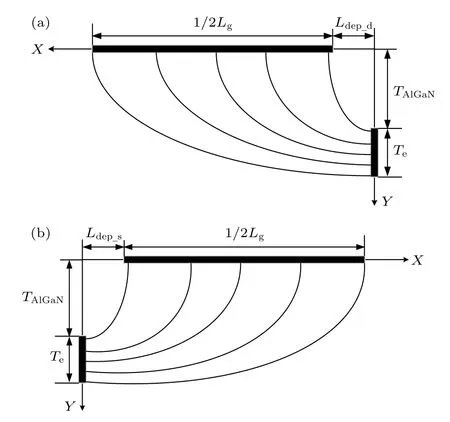
图3 Cifs/d 椭圆电场示意图 (a) Cifd;(b) CifsFig.3.Schematic of Cifs/d elliptical electric field:(a) Cifd;(b) Cofd .

式中εAlGaN代表AlGaN 介电常数.共焦电场与实际电场仍然存在误差,如图4 所示.

图4 Cifs/d 椭圆电场共焦后存在的误差Fig.4.Errors after Cifs/d elliptical electric field confocal.
以2DEG 厚度Te为参考边,修正函数如下:

式中ζ是拟合参数.将(16)式作为修正函数添加在Te前就可得到源/漏端内部边缘电容的核心表达式为

正如前面所讨论的,内部边缘电容在器件从关断到开启中是逐渐减小,最后转换为沟-栅电容Cgc的过程,因此对内部边缘电容表达式(17)还需要添加一个函数用来表征Cifs/d从关态到开启的变化过程,过渡函数如下:

式中,δ1,δ2,β2是拟合参数.将Tf表达式(18)式与(17)式结合可以得到内部边缘电容最终表达式为

基于保角映射法推导的外部边缘电容Cofd为[20]

式中,τ,a,b,c为拟合参数;εx是介于钝化层SiNx与AlGaN 势垒层之间的等效介电常数;W表示器件宽度.
当漏源电压Vds达到饱和电压Vdsat后漏端发生沟道长度调制效应,Ld会因为沟道长度调制效应而变小[21],假设沟道长度变化量为ΔL,漏端实际沟道长度Lcd如下:

式中,Vdsat是漏端饱和电压,利用(14)式将ns替换成nD求出;Vdse是漏端的等效电压;m是拟合参数;Esat代表饱和电场.
基于得到的Cofd表达式,只需要将Cofd核心表达式中的Lcd换成Ls,Ldep_d换成Ldep_s后就可推导出Cofs的核心表达式:

3 模型仿真与分析
为了验证栅极电容模型Cgs_total和Cgd_total,采用表1 的器件参数进行仿真验证.

表1 器件模型的参数值Table 1.Parameter of the device model.
3.1 栅源电容特性
源端电容由三部分组成:栅源本征电容Cgs、源端外部边缘电容Cofs和源端内部边缘电容Cifs.对Cifs和Cofs的表达式(19)和(24)进行仿真,将栅极电压Vg扫描范围设置在—6 V 到0 V,漏源电压Vds设置为3 V,阈值电压为—4.98 V,得到边缘电容随Vg的变化情况如图5 所示.可以发现,源端边缘电容(Cofs+Cifs)在器件开启前就已经出现了衰减,这主要是由源端内部边缘电容Cifs引起的:当器件处于亚阈值区(Vg<Voff)时,Cifs在器件处于完全关断状态下取得最大值,随着器件从关断状态逐步到开启状态的变化过程中,源端沟道向中部靠拢,Ls随着Vg升高逐渐减小,由于Ls是椭圆电场的参考边之一,当Ls减小后,椭圆电场围成的面积减小,由保角映射法最终得到的Cifs也因此减小,(Cofs+Cifs)从一开始的0.258 pF/mm 到开启状态的0.17 pF/mm.Vg再继续升高使器件开启后,沟道几乎闭合,此时Cifs转换为栅-沟电容Cgc,Cifs趋于稳定值,而Cofs不随栅压变化,因此Vg继续增高也不会使源端边缘电容(Cofs+Cifs)发生变化.

图5 源端边缘电容(Cifs+Cofs)与Vg 的关系图Fig.5.Relation between source fringing capacitance (Cifs +Cofs) and Vg .
得到源端边缘电容随Vg的变化情况后可进一步对总源端栅极电容进行分析.对考虑边缘电容的Cgs_total表达式(1)和不考虑边缘电容的Cgs表达式(3)分别进行仿真,栅极偏置也设置在—6 V到0 V 的范围内,阈值电压和漏源偏置分别设置为—4.98 V 和3 V,仿真结果见图6.图中蓝色虚线是栅源本征电容Cgs随Vg的变化情况,当考虑到边缘电容后,总栅源电容Cgs_total的变化情况如蓝色实线所示,观察两条曲线可以发现,两者随Vg变化的趋势有少许差别:在考虑边缘电容后,Cgs_total整体要比Cgs大.并且,Cgs_total在亚阈值区会有1 个轻微的衰减过程,器件开启之后,Cgs_total会逐渐偏离Cgs直至两者都处于稳定状态,这种差异主要是由边缘电容造成的.如前面所述,Cifs在亚阈值区工作状态下,会因为其随Vg的提高逐渐转换为Cgc而减小,包含边缘电容的Cgs_total在亚阈值区会因为Cifs的转换现象而出现衰减.当Vg>Voff后,边缘电容基本趋于固定值,这时Cgs_total与Cgs的差值基本保持不变.
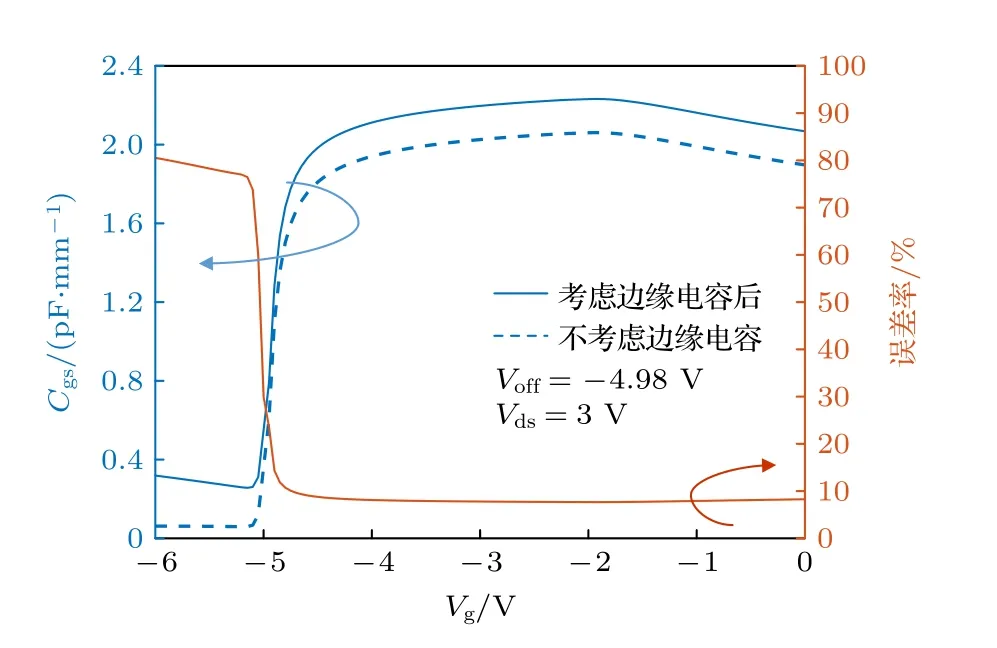
图6 Cgs 总电容与Vg 的关系图Fig.6.Relation between total capacitance of Cgs and Vg .
为了更加直观地表示边缘电容对栅源电容的影响,计算出未考虑边缘电容的情况下与考虑了边缘电容之间的误差,其结果如图6 红线所示:器件开启状态下,误差率为9%,即边缘电容占总电容的9%左右.但是在关断状态下,边缘电容占到了总电容的80%,而且器件开启与关断前后,误差的变化速率很快,这说明了边缘电容对器件开关特性影响尤为明显,是建模时不可忽略的一部分.
3.2 栅漏电容特性
漏端电容由三部分组成:栅漏本征电容Cgd、漏端外部边缘电容Cofd和漏端内部边缘电容Cifd.对Cofd和Cifd的表达式(20)和(19)进行仿真,将漏源电压Vds扫描范围设置在0.5 V 到4 V,栅极电压Vg设置为—4 V,阈值电压为—4.98 V,得到漏端边缘电容(Cofd+Cifd)随Vds的变化情况如图7 所示.可见,相对于(Cofs+Cifs)与Vg的关系,(Cofd+Cifd)受Vds的影响十分微小,这主要是因为内部边缘电容Cifs/d与Vds无关,在各边缘电容中,只有漏端外部边缘电容Cofd因沟道长度调制效应受Vds的影响[10],但是影响效果随Vds的变化相对Vg对Cifs/d的影响来说要小得多,因此(Cofs+Cifs)这两个边缘电容随Vds的变化可忽略.

图7 漏端边缘电容(Cifd+Cofd)与Vds 的关系图Fig.7.Relation between drain fringing capacitance (Cifd +Cofd) and Vds .
对考虑了边缘电容的Cgd_total电容表达式(2)和Cgd电容表达式(3)进行仿真,结果如图8所示.图中虚线为Cgd,实线为Cgd_total,可以看出考虑了边缘电容后的Cgd_total相对于Cgd来说整体向上平移,这是由(Cofs+Cifs)造成的.
还计算了未考虑边缘电容的情况下与考虑了边缘电容之间的误差,其结果如图8 红线所示.观察图中红线发现,Cgd_total随着Vds从0.5 V 到4 V变化过程中,误差从10%左右升到65%以上,而且误差在Cgd斜率减小的地方变化尤为明显.造成这种现象的原因是:根据Ward-Dutton 电荷分配原则,本征电容Cgd的直观表达式是,它表示的是漏源电压Vds对栅极电荷Qg的控制能力,当Vds足够大引起沟道长度调制效应后,耗尽层把沟道和漏端隔开,直至漏端完全失去对沟道的控制,而栅极电荷与沟道电荷存在电荷守恒的关系,这时候漏端已经无法通过改变沟道电荷来影响栅极电荷,意味着漏端失去了栅极电荷的控制,因此Cgd随着Vds的提高逐渐减小最后趋于零.然而前面对漏端边缘电容的分析发现Vds对(Cofd+Cifd)影响有限,相对于Cgd与Vds的变化可忽略,(Cofd+Cifd)可以近似当作常数.综上,Cgd逐渐减小的过程中,(Cofd+Cifd)保持不变,当器件处于饱和区时,漏端电容部分占主导地位的已从Cgd转变为(Cofd+Cifd).

图8 Cgd 总电容与Vds 的关系图Fig.8.Relationship between total capacitance of Cgd and Vds .
4 结论
AlGaN/GaN HEMT 器件总的栅极电容包含了两部分:本征电容Cgs/d和与2DEG 相关的边缘电容Cifs/d和Cofs/d.本文基于保角映射法推导出内部边缘电容Cifs/d模型和源端外部边缘电容Cofs/d模型,最后得到源/漏端的总栅极电容表达式,经过仿真分析发现:内部边缘电容Cifs/d与器件的栅极偏置强相关,与漏源偏置无关,而外部边缘电容Cofs/d受偏压影响要小得多.考虑边缘电容后,栅源电容整体要比未考虑边缘电容时大,边缘电容是由器件结构产生的寄生电容,所以即使器件处于关断状态,边缘电容仍然存在,这时不考虑边缘电容误差达到了80%,器件开启后误差率减小到9%;对于栅漏电容,Vds较低条件下边缘电容只占总电容的9%左右,当器件处于饱和状态时,Cgd≈0,这时若不考虑边缘电容其误差则高达65%以上.所以,对AlGaN/GaN HEMT 器件电容建模时,其边缘电容是不可以忽略的一部分,特别是应用于高频开关领域.

