印制电路板用高端电子铜箔及其技术新发展(上)
祝大同
(中电材协覆铜板材料分会,陕西 咸阳 712099)
1 引言
电子铜箔产品按其性能水平划分,可分为一般常规型与高端型两大类。高端型铜箔,具有应用条件要求苛刻或特殊,制造水平高端的特点,应用在高端印制电路板(PCB)制造领域,所制PCB多在高端的电子产品或终端产品中应用。
高端型铜箔主要品种包括:高频高速电子电路用极低轮廓铜箔;IC封装基板及高端HDI(高密互连)板用极薄铜箔;高端挠性PCB的专用铜箔(含:电解铜箔、压延铜箔等);大电流、大功率基板用厚铜箔(箔厚≥105 μm);锂电池用极薄/高抗力性铜箔;特殊功能铜箔(如埋容、埋阻电路用铜箔)等。当前及未来,在全球电子铜箔业界的技术进步、新品开发、满足新型电子产品配套的电子铜箔主要是以上所列的六大类高端电子铜箔[1][2]。
一个新时代的技术发展,需要一代新的材料作为支撑。近年,5G通信技术、人工智能应用技术、物联网及互联网技术得到广泛应用与发展。驱动了PCB制造技术,正朝着高速高频化、高耐热化、高导热化、高密度布线化、模块化等方向快速发展。作为高端PCB主要使用的导电材料——高端铜箔,也随着应用市场的扩展、升级,它在品种个性化、细分上有所变化;在性能上也在不断地提升,朝着高端化方向发展[3]。
在上述所列的六大类高端电子铜箔,是当前的高端PCB市场需求热点,以及技术水平快速发展的品种。更主要集中在高频高速电子电路用极低轮廓铜箔和IC封装基板及高端HDI 板用极薄铜箔这两大类产品方面。本文主要重点讨论这两大类高端铜箔的市场对细分品种、产品性能需求,以及技术开发新进展。
2 极低轮廓电解铜箔的市场与实现关键性能的提高
2.1 电子电路用低轮廓电解铜箔的三大类别八个品种
业界中,目前把电子电路用低轮廓电解铜箔按照表面粗糙度(Rz)的大小划分为三大类别、八个品种。三大类别是VLP型铜箔(超低轮廓铜箔)、RTF型铜箔(低轮廓反转铜箔),以及HVLP型铜箔(极低轮廓铜箔)。八个品种是较低轮廓铜箔与在低轮廓反转铜箔品种中三个世代的RTF品种,以及在极低轮廓铜箔品种中现已发展到四个世代的HVLP品种。详见表1[3]所示。

表1 低轮廓电解铜箔品种及Rz等级(各类的世代产品)表
2.2 五大应用领域对低轮廓电解铜箔关键性能需求重点的差异性
从整个低轮廓度铜箔市场需求来讲,随着低轮廓及极低轮廓电解铜箔的应用市场,以及各市场领域对极低轮廓电解铜箔性能要求侧重面的差异,这类高端铜箔的性能向着客制化、个性化方向发展。针对五大应用领域,低轮廓度铜箔在性能项目及其技术指标上,都有所差异化。这五大应用领域分别如下。
(1)刚性射频/微波电路用低轮廓电解铜箔;主要应用于高档的射频-微波电路基板,如毫米波车载雷达用基板等。
(2)高速数字电路用低轮廓电解铜箔,它的市场绝大多数定位在频率一般在厘米波(3 GHz~30 GHz)电路基板范围,应用终端是高中端服务器、数据中心等。
(3)挠性PCB用低轮廓电解铜箔。挠性PCB用的这类,还要求铜箔具有高的抗拉强度,较高的延伸率及薄型化。蚀刻后基膜优异透明性,也是此铜箔市场的重要需求项目。
(4)高频高速模块基板用低轮廓电解铜箔,它除了有低轮廓度要求,还需要有铜箔的高抗拉强度性、高热稳定性、高弹性模量、高剥离强度要求。
(5)大电流厚铜PCB用低轮廓电解铜箔,厚铜PCB的微细线路制造技术也要求所采用的超厚铜箔也兼备低轮廓度特性。例如,三井金属RTF型低轮廓厚铜箔:MLS-G(Ⅱ型),Rz=2.5 μm(产品典型值)。
高频高速刚性PCB用HVLP型的四个世代的极低轮廓电解铜箔,其中HVLP2型、HVLP3型极低轮廓电解铜箔,更是当前市场需求HVLP类型中的“重中之重”热门品种。它们的应用市场,是甚低损耗(Very Low Loss)、超低损耗(Ultra LowLoss)等级的覆铜板以及对应的多层板制造中应用。即对信号完整性(SI)有更高要求的射频-微波基板,高速数字信号基板,以及高频特性的模块基板。
HVLP2型、HVLP3型极低轮廓电解铜箔关键性能,主要为两大项目,即极低且均匀一致的表面低粗糙度,以及高稳定的铜箔剥离强度。由于铜箔表面近似平滑状极低粗糙度,还要兼顾高剥离强度性,这给研究者带来技术上极大挑战。
2.3 对解决极低轮廓电解铜箔最低粗糙度与更高剥离强度难题的讨论
回顾近十年来全球电解铜箔业界的HVLP类型极低轮廓电解铜箔研发历程,处在同时解决“极低的铜箔表面轮廓度+高的铜箔剥离强度”难题中。因此,近年来,追求低轮廓电解铜箔(包括了低轮廓压延铜箔)最低的粗度与最高的剥离强度,这是各铜箔厂家开发高频基板用电子铜箔的重要课题。如何解决此方面难题?笔者对综合台湾铜箔专家对此方面的深入讨论文献[4]的研读后,作了要点的整理归纳。
2.3.1 从“弹性定理”得到了解决难题的技术思路
从图1中的弹性定理,可从理论上更深入了解影响铜箔剥离强度的主要因素。

图1 影响剥离强度的主要因素关系的弹性定理图
中国台湾铜箔专家在该文献[4]中,对图1所示弹性定理中涉及的六个影响铜箔剥离强度,作了如下的讨论。
从弹性定理(Elastic theory)可知,影响剥离强度的主要因素:变形树脂的厚度(Yo,Thickness of the deformed resin)、树脂的抗拉强度(σN,Tensile strength of the resin)、铜箔总厚度(δ,Foil thickness)、铜的杨氏模量(E,The ratio of the copper modulus)、树脂的杨氏模量(Y,The ratio of the resin modulus)等。由图1中公式可知,提高杨氏模量(E)、铜箔厚度(δ)、变形树脂厚度(y),剥离强度就会得到提高。铜的杨氏模量(E)是由原箔微结构所控制的。假设铜箔总厚度(δ)是固定的,那么调整生箔(原箔)厚度和小瘤尺寸。生箔厚度占总的铜箔厚度之比的改变,会使有效厚度(原箔厚度)得以改变。改动小瘤的大小、改动阻隔层和硅烷抗氧化层,就可以起到增加变形树脂厚度的效果,达到提高剥离强度的目的。并且没有增加铜箔表面粗糙度。
以上的专家这段阐述,笔者得到两点启发,具体如下。
(1)提高整个铜箔层,即包括瘤化层与生箔(原箔)的杨氏模量,对铜箔的剥离强度有利,而铜箔表面的瘤化粒子的尺寸越小(瘤化粒子低,铜箔表面轮廓度低),铜箔就越有提高杨氏模量的可能。
(2)树脂在铜箔表面上“占据”的空间越大,越变形树脂厚度就越大。变形树脂厚度的增加,会带来剥离强度提高的效果。这就给通过改善铜箔表面的偶联剂处理层,来提高铜箔剥离强度,找到了其中一个理论依据。
2.3.2 提出了解决此难题的四方面切入点
(1)从光面(S面)上,改变生箔(原箔)的表面实现生成小瘤入手。即改善成核密度、根瘤大小、数量和形状,从而可提高瘤化处理后整体铜箔表面粗糙度低、剥离强度高的问题。
(2)研究铜表面构形对影响电性能的特性。即建立模型,由粗糙度与铜瘤堆叠来推算电性能的特性。
(3)采用铜箔表面涂覆底胶,以提高剥离强度。文章中提及了三井金属铜箔株式会社出台的运用底胶的新品(NP-VSP)例。
(4)采用铜箔制造中的纳米锚工艺手段,以提高剥离强度。注意这里提及的纳米锚(nano anchor)称谓瘤化粒子“锚”的概念,是否就是这位台湾铜箔专家在文中提及的制造生箔中其表面(指在电解机阴极辊表面相接触的箔表面)所产生的“根瘤” 与“纳米锚”指的是同一产物。
2.4 提高极低轮廓电解铜箔关键性能四方面工艺技术路线的研究进展
近年业界在同时解决“极低的铜箔表面轮廓度+高的铜箔剥离强度”难题中,笔者主要归纳为可采取的四方面工艺技术路线。这四方面工艺技术路线,近年不断取得技术与应用的新进展、新成果。
2.4.1 在铜箔层压面再进行薄层涂敷底胶(胶层厚度在10 μm)[1]
2000年底,卢森堡电路铜箔公司在业界中率先在此方面作了研发,并发表了这项工作的研发成果,但并未有产业产品的问世。直到20世纪10年代中期,三井金属铜箔公司研发出采用涂底胶的平滑铜箔(NP-VSP)产品,做过“新品”宣传。
Rogers公司于2018年3月首次公布的“CU4000 LoPro®铜箔”,它可作为一种高频电路基板用铜箔商品。它为多层结构的设计者提供的片状铜箔选择,这种铜箔与RO4000产品一同使用时,还具有优良的外层铜箔结合力(引自罗杰斯此产品说明书)。CU4000 LoPro铜箔为反转型电解铜箔(RTF),属IPC-4562标准中的3级型(高温延伸铜箔)。在它的光面(S面)作了表面处理后,又涂敷了厚度约8.89 μm(0.35 mil)的薄胶层。
2018年,三井金属铜箔公司也推出新品——FSP-501极薄、超低轮廓带载体型电解铜箔。它的铜箔厚度为1.5 μm~3.0 μm,Rz为1.4 μm,铜箔层压面敷有薄胶层,起到提高超低轮廓铜箔剥离强度的作用。它与FR-4基材的铜箔剥离强度可达到1.2 kg/cm[1]。当Rogers公司、三井金属铜箔公司的涂敷底胶型产业化问世三年后,笔者注意到:我国一家通信设备大厂对铜箔表面进行涂敷底胶薄层处理的工艺路线研制的极低轮廓铜箔(见图2所示)电气性能的保证提出了异议。这篇报告提出:由于趋肤效应的影响,我们关注铜箔的粗糙度,同时也关注铜箔与基材结合力。覆胶铜箔虽然有助于增加剥离强度,但对电气性能损失极大[5]。

图2 涂敷底胶薄层处理的极低轮廓铜箔剖面
2.4.2 在铜箔表面处理面上采取形成纳米锚的亚微米瘤化处理
20世纪10年代中期,三井金属铜箔公司研发出形成纳米锚(nano anchor)工艺手段,它在极低轮廓铜箔的剥离强度提高方面,起到良好效果。当时在高频高速基板中得到小批量的应用[1][4]。
日本福田金属箔粉工业株式会社在2019年间推出的CF-T4X-SV极低粗糙度铜箔,是一种刚性PCB及FPC均可兼用的HVLP3等级的高频高速电路用铜箔[6]。此产品牌号中的“SV”代表该产品采用了独创的形成毛箔的SV工艺技术,使得毛箔两面都具有超低粗糙度(即中国国内对锂电箔产品俗称的“两面光”)。牌号中的“T4X”代表该产品采用了独创的微细粗化处理技术。它具有超低粗糙度,即CF-T4X-SV的有Rz:1.4 μm(6 μm箔)、1.1 μm(9 μm/12 μm箔)、1.0 μm(9 μm箔)。因粗化面处理后形成了瘤化粒子形态非常特别——“细而长”,使得它的表面既粗糙度超低,比表面积大,又带来了“高锚栓”效果,这样就带来了较高的铜箔剥离强度性(剥离强度:9 μm箔:0.55 kN/m;18 μm箔:0.80 kN/m)。这种形成“细而长”的超微细表面形状的“T4X”后处理技术,它还克服了应用加工中产生“落粉”的问题,即它的微细瘤化粒子具有高固着性[7]。它所显示的高水平研发成果,是与开发成功的“两面光”毛箔SV工艺技术,密切相关的。近年有项集中了多家低轮廓铜箔产品进行插损测试对比研究,其所得结果表明:福田金属运用了SV工艺技术制造的其他牌号的低轮廓铜箔品种,也是在高频条件下插损测试结果表现较佳,且在13 GHz~20 GHz插损值之差表现最佳[8]。福田金属的开发成果就是从毛箔实现生成小瘤入手,即改善成核密度、根瘤大小、数量和形状的成功案例[4]。
在推进微细瘤化工艺处理技术进展方面,近年除了三井金属、福田金属外,还有古河电工株式会社、南亚胶塑股份有限公司、金居技术股份有限公司(Co-Tech)等铜箔企业,在近年取得的极低轮廓铜箔研制成果中。海外的一份对台、日三家同一低轮廓度档次铜箔的对比试验报告的结果表明:Rz都在≤2.5 μm的RTF电解铜箔,由于它在表面瘤化处理的晶粒构型及形貌差异,造成了堆叠及分布状态、晶粒分布的均匀程度、非压合面粗糙度等方面的差异,而这种差异会引起它制成的基板材料的插损值大小的差异。有研究发现[9],区分、表征表面瘤化处理的晶粒构型及形貌差异的手段,可采用测试表面的Rq(均方根粗糙度,检测铜箔Rq一般采用Line Roughness ISO 4287)。这项研究表明:尽管同一低轮廓度铜箔的Rz值较为接近,但它的Rq却相差较大,造成在不同频率下测试的插入损耗值出现差异如图3所示。

图3 三种同一Rz档次RTF铜箔在Rq、插损的对比
在2021年底召开的我国覆铜板技术交流会上,来自一家国内著名的终端产品大型企业的报告,向与会代表展示了某海外企业推出的瘤化粒子构形特殊的极低轮廓电解铜箔新品(铜箔表面及剖面见图4所示)[10]。它是采用亚微米粒子瘤化及无瘤化镀层形成技术,解决了“极低的铜箔表面轮廓度+高的铜箔剥离强度”的难题。而从报告中给出的微观表面及剖面瘤化粒子构形观察,表现出瘤化粒子“细而长”的有利于提高剥离强度的构形鲜明特点,其剖面粒子的H:439.2 nm;V:167.5 nm。
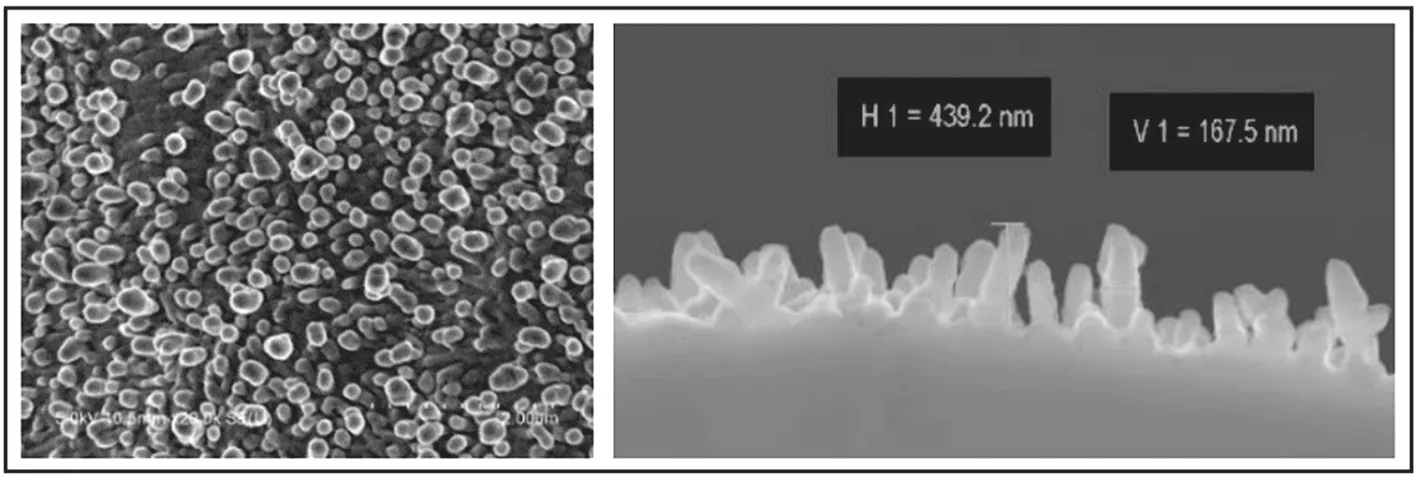
图4 极低轮廓度铜箔表面及剖面瘤化粒子构形图
2.4.3 在铜箔处理面表面进行化学处理
松下株式会社在2018年1月向业界推出针对毫米波雷达、5G基站等天线市场的无卤化超低传送损失覆铜板R-5515。松下在2019年12月召开的研讨会上,做了题为“应对高速-高频的低介电特性基板材料的最新发展”的报告[11][12]。报告中提出:应对所开发的这个高频天线基板材料(R-5515)性能确保的需求,松下采用的三个重要原材料应用技术的推进与支撑。其中,包括自行开发出超低轮廓铜箔压合面的表面处理新技术(称为“CuTAP”),从而获得高频下导体方面的低传输损失,并兼顾良好的铜箔剥离强度性。实施这项新技术,使得铜箔表面上纳米级晶粒构成微小凹凸状,扩大了比表面,使得树脂与铜箔的黏接强度得到提高。进而保护膜的加入,基板的耐热性也得到提高,并且确保了在250 ℃下铜箔光滑面的抗氧化性的良好。日本产业技术综合研究所(简称“产综研”)先进涂层技术研究中心,2019年3月公布了通过紫外光在铜箔表面形成化学交联的聚合物涂层新成果[13]。该技术是利用紫外光反应的表面化学修饰技术将构成铜箔积层基板的聚酯膜表面氧气官能基化,通过热压与铜箔相接,得到表面化高强度的接合强度,可以接合不同种类的基板材料。
2.4.4 在铜箔与树脂的界面间运用偶联技术、偶联剂复配技术
近年,国内外铜箔企业在解决兼顾良好的极低轮廓性、铜箔剥离强度性方面,通过偶联剂及偶联剂复配技术进行对铜箔表面的处理,取得不少的研究成果。在近期发表的来自大型终端产品企业的报告中[10],论及解决“极低的铜箔表面轮廓度+高的铜箔剥离强度”难题时,对 “亚微米瘤化及无瘤化镀层技术”和“低粗糙度界面偶联技术、偶联剂复配”,这 两个工艺技术路线的成果的应用前景,加以更多的肯定。该报告人在另一份报告中[14],通过实验数据说明了铜箔与基材树脂之间的界面,经过偶联剂改性后它们与树脂耐热结合力,比未做偶联剂改性的基材有所提高(见图5所示)。这也说明,采用偶联剂处理工艺路线,是对提高极低轮廓铜箔的剥离强度,可以发挥辅助提高的效果。

图5 铜箔经偶联剂改性后与树脂耐热结合力对比图
2.5 PCB业界对未来几年提高低轮廓铜箔性能水平的需求
未来几年,从PCB业界对提高低轮廓铜箔性能水平的需求,我们以下例可有所了解与展望。
2021年7月,中国台湾的工业研究院/产科国际研究所与中国台湾电路板协会(TPCA),编制出台了“2021中国台湾PCB高阶技术盘点调查报告”。此报告中详尽提出了,四大应用领域未来对高阶PCB用低轮廓铜箔性能水平的需求[15][16]。
该报告中四大类应用领域分别为:(1)高性能计算(HPC:High Performance Computing)设备群,含计算中心、AI运算、服务器、应用处理器、高阶笔记本电脑等;(2)超5G的终端应用产品(简称B5G-Edge,B5G的终端应用),含智能手机、汽车电子、AR(增强现实)/VR(虚拟现实)、穿戴式装置等等;(3)超5G的基础设施(简称B5G-Infrastructure,B5G的基础设施),含B5G的基地台、地面基站、网络设备等;(4)大功率装置(简称High Power,高功率设施),含车用电源系统、充电站等装置。此调查报告公布显示,这四类高阶PCB终端市场应用领域未来对高频高速基板用电解铜箔的性能需求的预测情况,见表2[15][16]所示。
表2中:HPC:高效能运算;B5G-Edge:B5G之终端应用;B5G-Infrastructure:B5G的基础设施;High Power:高功率设施。根据2021中国台湾PCB高阶技术盘点调查报告内容整理。
笔者对表2所示的中国台湾高阶PCB用电解铜箔的技术发展蓝图内容,领会其要点如下。

表2 未来五年铜箔技术发展蓝图表
(1)提高高频高速电路用低轮廓度铜箔品种的性能,提到了中国台湾PCB全行业对所用铜箔性能提高的“首位”需求。为了实现高阶PCB产品的高频高速与信号完整性的产品需求,四个高阶终端领域中的各类高阶PCB产品,未来都对电解铜箔表面粗糙度(Rz)有更为严格的要求。到2025年铜箔的Rz≤1.5 μm已成为普遍的需求,此Rz档次的低轮廓度铜箔品种(即HVLP2、HVLP3等),未来几年将成为高阶HLC(高多层PCB)、HDI、FPC的应用主流低轮廓度铜箔品种。
(2)各类高阶PCB应用高频高速性树脂基材与低轮廓铜箔,当前与未来还遇到确保与提高铜箔剥离强度的问题。表2中反映了:不同PCB产品结构的品种,对铜箔剥离强度指标需求趋势有截然的不同:四大高阶应用领域中的HLC板,是势于剥离强度越来越高的趋向(例如:B5GInfrastructure中的HLC对采用的剥离强度,2021年为0.5 N/mm,2023年为0.6 N/mm,2025年要达到0.8 N/mm)。而HDI板,则是对剥离强度要求趋于“走低”(例如:HPC、B5G-Infrastructure中HDI对采用的铜箔剥离强度,2021年为0.8 N/mm,2023年为0.7 N/mm,2025年要达到0.6 N/mm)。
笔者认为:这种对剥离强度的各应用领域存在的不同需求趋势上的差异,是与HLC、HDI类基板对铜箔的其他性能要求的侧重点有关。同时,有的终端产品在PCB设计中,还要考虑低成本性制造的因素。
(未完待续)

