重离子在SiC,GaN,Ga2O3宽禁带半导体材料及器件中的辐照效应研究
闫晓宇,胡培培,艾文思,翟鹏飞, 赵培雄,李宗臻,刘 杰†
(1. 中国科学院 近代物理研究所,兰州 730000;2. 中国科学院大学 核科学与技术学院,北京 100049)
自20世纪四五十年代晶体管发明以来,半导体行业遵循摩尔定律飞速发展[1]。以Si为代表的第一代半导体材料,广泛应用于电力电子系统中,如电机驱动、谐振变换器和整流器等[2]。受限于Si材料的物理性能,Si半导体器件无法满足电力电子行业发展对半导体在高压、高频、高温和高功率密度应用中的需求。于是,以SiC,GaN,Ga2O3为代表的第3代宽禁带半导体材料逐渐兴起并快速发展,如,SiC材料具有较高的击穿电场强度等物理性能,被应用于高功率器件[3]。
Si,4H-SiC,GaN,β-Ga2O3材料的带隙Eg、电子迁移率μn、电子饱和速度vsat、击穿电场强度Ec、介电常数εr、热导率λ和Baliga优值BFOM等参数如表1所列。由表1可知,4H-SiC,GaN,β-Ga2O3材料的多种参数均优于Si,特别是SiC和GaN材料还具有较高的热导率[3]。由BFOM可知,4H-SiC,GaN,β-Ga2O3可提升金属-氧化物-半导体场效应晶体管(metal-oxide-semiconductor field-effect transistor, MOSFET)器件的高功率特性[3-4]。SiC功率器件有望在航天器电源系统中用于动力控制单元、电推系统、电力驱动和高压静态开关等系统中[5]。早在1998年,美国空军就提出并逐步实现了SiC器件在多电飞行器中的应用[6]。GaN器件在空间可用作射频器件和微波高功率放大器等[7-8]。同样,Ga2O3器件在航天器电源和驱动负载中有应用潜力。
然而,半导体器件在空间应用中将面临高能粒子辐射环境[9-10],可能产生单粒子效应等空间辐射效应。针对复杂的空间辐射环境,宽禁带半导体器件的辐照效应机理和加固技术等是空间应用所面临的挑战[11],还存在空间辐射效应地面模拟等效性和评价机制合理性等诸多问题[12-13]。如,重离子辐照功率器件会造成器件电学性能退化甚至烧毁等。本文重点介绍了重离子辐照SiC,GaN,Ga2O3材料和器件引起的材料损伤及器件电学性能退化与失效。
1 SiC材料和器件重离子辐照效应研究
1824年,Berzelius[14]首次发现SiC材料,但受限于制造工艺,SiC难以广泛生产和应用;直到1955年, Lely等提出了生长高品质SiC单晶的方法[15];1991年,美国CREE公司发布全球首个商用SiC晶圆。至此,SiC材料及应用开始快速发展[16]。SiC晶体根据Si-C双键堆垛次序的不同,有200多种同质异型体,目前制作器件最常用的是4H-SiC,6H-SiC,3C-SiC等晶体结构[17]。其中,4H-SiC的禁带宽度最大,Ec和μn高,适于制造耐高压高温的功率半导体器件[18]。研究表明,SiC材料具有优异的抗辐照性能[19-20],但与材料迥然不同,当SiC器件工作在高电压状态下时,重离子辐照极易引发单粒子效应,产生单粒子烧毁和栅穿等硬错误,成为SiC器件空间应用的瓶颈。
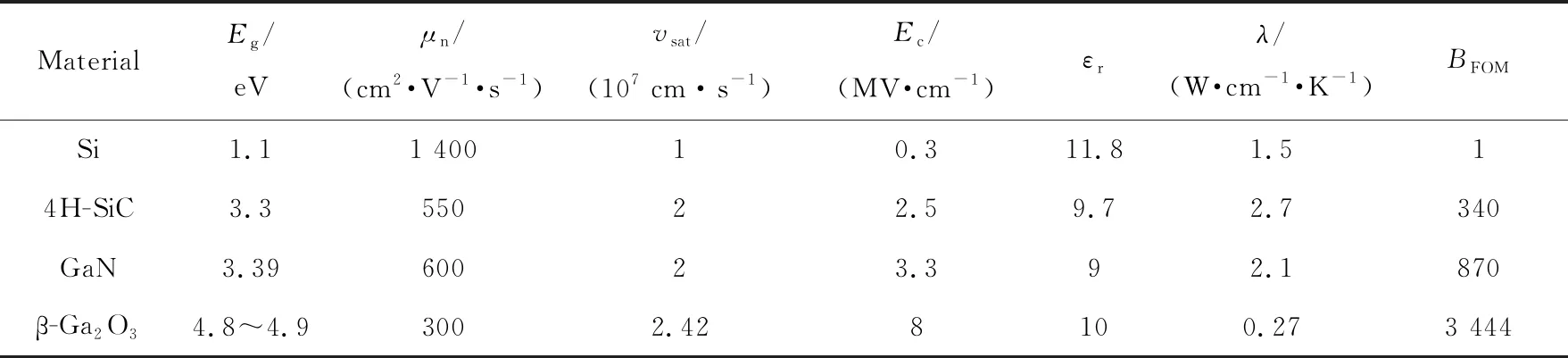
表1 几种半导体材料的物理参数[3]Tab.1 Parameters of several semiconductor materials[3]
1.1 SiC材料重离子辐照效应研究
重离子入射材料后沉积能量会造成材料原子电离、激发或移位。低能重离子入射材料主要以核能损Sn的形式产生位移损伤,其中,需满足离子传递给靶原子的能量大于离位阈能值Ed,Si材料的Ed为11~21 eV[21];而SiC材料中Si原子的Ed最小为35 eV,C原子的Ed最小为21 eV[19]。实验研究表明,室温下,低能重离子辐照SiC形成非晶化的临界注量约为1014~1015cm-2[22-24],且SiC材料具有低中子吸收截面、高耐腐蚀性及低热膨胀系数等特性,是反应堆常用的结构材料之一[25-27]。
快重离子与材料相互作用中电子能损Se占主导,重离子与靶原子核外电子发生非弹性碰撞,造成电离和激发。当快重离子入射材料时,通常沿路径会在半径r为几纳米的柱形区域内形成潜径迹。根据重离子与材料相互作用形成缺陷及潜径迹的非弹性热峰模型(inelastic thermal spike model, i-TS model),潜径迹的形成及特性不仅与入射离子种类和能量有关,而且与靶材料的热扩散系数、热传导系数、比热、电子密度、德拜温度和电导率等有关[28]。实验研究表明,Si和SiC材料中潜径迹的形成均具有较高的电子能损阈值。当Se为29 keV·nm-1的重离子入射Si材料时,Si材料内部只产生点缺陷[29];SiC材料内产生潜径迹的Se阈值大于34 keV·nm-1[20]。实验中,使用2.7 GeV U离子辐照SiC材料也未发现潜径迹[30]。本文利用非弹性热峰模型计算潜径迹形成的阈值,当1.5 GeV U离子辐照SiC材料时,不同半径条件下,能量沉积的分布如图1所示。由图1可见,SiC材料内形成潜径迹的Se阈值约为37 keV·nm-1。但至今为止,人们还没有直接观测到单个重离子在SiC材料中形成的潜径迹,可见,SiC材料具有较好的抗辐照损伤性能。
1.2 SiC器件重离子辐照效应研究
SiC器件主要有肖特基二极管和MOSFET等。诸多研究表明,SiC器件具有较好的抗电离总剂量效应和位移损伤效应能力[31-35]。2004年,Scheick等[36]首次通过实验发现,质子和重离子辐照施加偏置电压的SiC肖特基二极管时,出现了烧毁现象;之后,研究人员开始关注SiC功率器件由重离子辐照引发的单粒子硬错误。研究主要围绕SiC肖特基二极管和MOSFET器件,通过重离子辐照实验和TCAD模拟计算等手段,研究不同重离子辐照下SiC器件单粒子效应及加固措施。本节给出了重离子辐照SiC肖特基二极管和MOSFET器件的响应特性和机理。
1.2.1 SiC肖特基二极管重离子辐照效应
实验发现,SiC肖特基二极管的重离子辐照响应特性与器件参数设定和重离子辐照参数等有关。器件偏压Vb和入射离子线性能量转移(linear energy transfer, LET)值是决定器件响应的2个主要因素。当重离子辐照SiC肖特基二极管时,随着反向偏压的增加,器件发生电荷异常收集,漏电退化,直至单粒子烧毁(single event burnout, SEB),如图2所示[37]。器件发生SEB的阈值电压可能低于额定电压的50%。
快重离子入射会在器件内部沉积能量,沿路径产生的电子-空穴对在器件电场及载流子浓度的作用下发生漂移和扩散而被收集。图3为不同偏压下Xe离子辐照SiC肖特基二极管漏电流Ir随离子注量Φ的变化关系[37]。
由图3可见,当相同离子作用在漏电损伤响应区域时,器件表现为偏压越高损伤越严重,且偏压相同时,漏电流随离子注量增大而增大[37-38]。重离子微束辐照SiC肖特基二极管时,发现器件漏电流随入射离子注量呈线性增长趋势[39]。随着偏压和LET值的进一步增大,器件会发生破坏性损伤,即SEB,表现为反向阻断能力的丧失。图4为不同重离子辐照不同偏压SiC肖特基二极管时,发生SEB时的电流随时间的变化关系[40]。离子入射角度对器件漏电退化的影响研究表明,相同偏压及重离子辐照下,重离子正入射时,器件退化最严重[41]。
利用兰州重离子加速器(Heavy Ion Research Facility in Lanzhou, HIRFL)提供的单核能量为13.5 MeV的Ta离子,开展了不同规格SiC肖特基二极管的重离子辐照实验。实验结果表明:LET值相同时,偏压越高,器件漏电损伤越严重。650 V/20 A规格的SiC肖特基二极管辐照实验发现,当Ta离子能量为1 602 MeV,LET(SiC)值为82.8 MeV·cm2·mg-1,反向偏压设置为300 V,注量累积到4.5×105cm-2时,器件发生SEB,光学显微镜观测到器件表面有明显直径大于100 μm的熔坑,如图5所示。
针对SiC肖特基二极管重离子辐照漏电退化和SEB的机理,人们通常从局域热效应的角度进行分析[37, 42-43]。Kuboyama等[37]认为重离子沉积能量并与器件内高电场共同作用造成热效应,使器件内材料晶格温度升高产生损伤,重离子入射器件时,由电场引起的峰值功率为[37]
(1)

目前,SiC肖特基二极管重离子辐照下的响应特性和影响因素的研究结果基本一致,用热效应机理可解释器件漏电退化或烧毁,但缺乏重离子入射器件内部更为精细的作用过程研究及对器件抗辐照可靠性的精确评估机制。
1.2.2 SiC MOSFET重离子辐照效应
对于重离子辐照下的器件响应,与肖特基二极管相比,SiC MOSFET也会出现漏电退化和SEB等效应;但由于栅的存在,重离子辐照时,SiC MOSFET还会出现单粒子栅穿(single event gate rupture, SEGR)。SiC MOSFET的重离子辐照响应特性,与器件在线参数设定、重离子辐照参数及器件工艺等相关。目前SiC MOSFET器件重离子辐照在线测试大多使用N沟道MOSFET,测试中器件一般处于关态,同样辐照参数下,随着漏源电压VDS变化,器件在线和辐照后会出现的响应如图7所示[45]。
与Si基MOSFET相比,重离子入射SiC MOSFET器件同样存在栅极潜径迹(latent tracks)的形成与激活效应[46-48],如图8所示。由图8(a)可见,辐照后栅极电应力测试(post irradiation gate stress, PIGS)下器件栅极特性失效[47];由图8(b)可见,相应偏压下,随辐照注量增大,当重离子再次作用在辐照引起的局域潜径迹损伤位置时,栅极漏电流IGSS和漏极漏电流IDSS发生同步跳变[47]。
IGSS,IDSS随电压和辐照注量的变化关系如图9所示。由图9可见,随着VDS的增大,SiC MOSFET重离子辐照下可在线观测到IGSS,IDSS增大,即器件发生了漏电退化,表现IGSS=IDSS或IGSS 实验研究表明,重离子辐照下SiC MOSFET发生SEB的阈值电压可能低于额定电压的50%[50]。通过改变入射离子的LET值观测器件发生SEB的阈值电压,1 200 V SiC MOSFET发生SEB的阈值电压随入射离子LET值的变化关系,如图11所示。由图11可见,重离子LET值小于20 MeV·cm2·mg-1时,器件阈值电压对LET变化敏感;重离子LET值大于20 MeV·cm2·mg-1时,器件的阈值电压趋于稳定。重离子入射器件不同位置,器件发生SEB的敏感性不同,正入射时,源-体区最为敏感[50];SiC材料的结构和晶面对MOSFET器件SEB的敏感性也有影响,利用TCAD模拟发现,与6H-SiC相比,4H-SiC材料更有优势;(0001)晶圆器件抗SEB能力更强[51-52]。 针对一款国产商用900 V/36 A增强型SiC MOSFET开展重离子辐照实验,用Ta离子辐照处于关态的器件,设定VGS为0,施加漏源偏压VDS并在线监测器件电流,发现:LET值相同时,偏压越大,器件漏电损伤越严重;离子入射角度对器件漏电损伤特性有影响,正入射时,器件漏电损伤最严重,这与SiC肖特基二极管结果一致。当Ta离子能量为1 602 MeV,LET(SiC)值为82.8 MeV·cm2·mg-1,VDS为400 V,辐照注量累积到1×105cm-2时,器件发生SEB,光学显微镜可观察到表面的熔坑,如图12所示。 SiC MOSFET器件发生SEB机理是目前研究的热点,部分研究人员延用Si MOSFET寄生双极性晶体管(bipolar junction transistor,BJT)激活诱发SEB进行解释。在此机制的基础上,Witulski等[50]研究重离子入射位置对寄生BJT开启的影响发现,当入射位置距离灵敏区域较远时,需增大重离子的LET值以确保沉积足够的电荷开启寄生BJT;Peng等[53]根据重离子辐照实验和TCAD模拟发现,SiC MOSFET发生SEB过程中,寄生BJT的开启会减小器件发生SEB的阈值电压;Zhou等[54]对比了Si和SiC MOSFET的SEB安全工作区(safe operation areas, SOAs)特性,根据不同LET值时器件发生烧毁的阈值电压,得出Si MOSFET SEB的安全工作区为110 V,而SiC MOSFET SEB的安全工作区仅为15 V。然而,Ball等[55]开展了1 200 V SiC MOSFET和二极管重离子辐照实验,给出了SiC MOSFET和二极管发生SEB和漏电退化的阈值电压随LET值的变化关系,如图13所示。由图13可见,2种器件漏电退化和SEB的阈值电压随LET值有相同的变化趋势,故分析2种器件辐照响应的机制相同,由此提出了离子诱导的高局域能量脉冲机制,并分析同样条件下高规格器件产生更小功率密度,使降额使用提高器件的可靠性变得可行[56]。 目前,针对SiC MOSFET的重离子辐照效应研究,以实验现象为主,而对失效的机理还缺乏统一的解释,重离子辐照造成材料层面上的损伤对器件失效的影响还有待进一步研究。 GaN是典型的宽禁带半导体材料,发展初期,由于没有合适的单晶衬底,晶格失配导致位错密度较高、N型材料本底浓度高及难以实现P型掺杂等诸多问题,GaN材料发展非常缓慢。直到20世纪80年代初,日本日亚化学工业公司(Nichia)的中村修二克服了材料制备2大工艺难题,实现了高质量GaN薄膜的生长及GaN P型掺杂的调控,解决了单晶材料制备的困难,GaN器件的发展开始进入黄金时期。在室温及正常大气压下,纤锌矿型结构是GaN最常见的结构,也是热力学稳态结构。纤锌矿GaN属于六角密堆积结构,不具有中心对称性,没有外应力作用时,正负电荷中心不重合,沿着晶体极轴c轴方向会产生自发极化效应。GaN三元化合物通过改变组分配比可连续改变工作波长和带隙宽度,是异质结器件的首选材料。GaN电子器件主要以异质结高迁移率晶体管(high electron mobility transistor, HEMT)为主,在AlGaN/GaN异质结界面形成的2维电子气(two-dimensional electron gas, 2DEG)具有很高的电子迁移率和极高的载流子浓度,是制备高频大功率电子器件的首选材料。此外,GaN HEMT结构可在SiC和金刚石等高热导率衬底上生长,具有极好的散热特性。因此,GaN HEMT被公认为是目前最理想的微波功率器件[57]。 GaN材料禁带宽度大,热导率高,击穿电场强度大,具有较好的抗辐照性能。前期研究发现:GaN材料经重离子辐照后,低注量下表现出退火效应;当累积注量达到1×1011cm-2时,GaN材料会产生显著的结构损伤,通过拉曼(Raman)光谱分析发现晶体中产生的缺陷团簇引起了晶格畸变,导致拉曼谱特征峰蓝移;当累积注量更高时,重离子辐照会直接导致GaN晶体材料非晶化,拉曼光谱测试及透射电子显微镜(TEM)直接观测的结果均验证了这一结论[58]。 GaN器件辐照损伤的研究分别提出了热声子效应[59]、逆压电效应[60]及热载流子效应[61],这些理论模型都不能完美地解释辐照损伤的确切机制。为解决这一难题,研究人员利用电子、质子、中子和重离子等多种粒子开展了GaN基HEMT器件辐照效应的研究工作[62-65]。Hazdra等[66]研究电子辐照效应过程中发现,小注量4.5 MeV电子辐照时,GaN基晶体管没有明显变化;当电子注量较高时,引入大量的点缺陷,导致器件内部电子浓度及迁移率下降,晶体管性能退化。2 MeV质子辐照AlGaN/GaN HEMT器件研究结果表明,异质结界面处产生的缺陷作为有效的散射中心引起2维电子气迁移率减小,降低了器件饱和漏电流[67]。γ射线辐照实验研究发现,AlGaN/GaN HEMT器件具有较好的抗辐照性能,但在高注量γ射线辐照下也会引入陷阱电荷,影响器件的电学和光学特性[68]。中子辐照效应研究发现,热中子辐照GaN二极管产生点缺陷导致器件反向偏置电流显著增大[69]。这些工作在总剂量效应研究方面取得了丰硕的成果,为GaN基器件辐照效应的深入研究奠定了基础。重离子辐照实验发现,辐照引入缺陷,引起异质结界面陷阱电荷浓度增大、导致器件性能退化、饱和漏电流减小及阈值电压正向漂移等退化现象[70]。与Si及SiC衬底相比,GaN自支撑器件表现出更好的抗辐照性能[71]。 低能粒子与GaN基器件相互作用的过程中核能损起主导作用[72-73],位移损伤是导致器件电学性能退化的主要因素。对中高能重离子而言,强电子激发效应引起的材料结构损伤是导致器件性能退化的关键因素。Sasaki等[74]利用超高压电子显微镜观察到18 MeV Ni离子辐照后器件中有应力产生,图14为AlGaN/GaN HEMT器件超高压电子显微镜图。辐照后电学性能没有明显变化,说明AlGaN/GaN HEMT器件表现出很好的抗辐照性能。Islama等[75]开展了2.8 MeV Au离子辐照AlGaN/GaN HEMT器件实验,研究发现,界面陷阱电荷的引入导致器件击穿电压降低。利用TEM分析了辐照引起器件材料的微观结构损伤,图15为HEMT器件透射电镜图。由图15可见,辐照后观察到界面缺陷聚集现象及辐照应力引起的位错。 综上所述,器件电学性能的退化与材料辐照损伤密切相关,已发表的研究成果主要聚焦于辐照引起的器件电学性能的退化,对器件结构损伤的研究涉及较少。本文基于GaN材料重离子辐照效应的研究基础,从器件材料结构损伤的角度分析了重离子辐照引起AlGaN/GaN HEMT器件电学性能退化的本质因素,详细分析了重离子辐照AlGaN/GaN HEMT器件在材料内部产生的潜径迹的形貌和结构,获得了器件电学性能退化与器件材料结构损伤之间的本质联系。 不同能量的Bi离子及Xe离子辐照AlGaN/GaN HEMT器件后的电学测试结果表明:Xe离子辐照后HEMT器件阈值电压正向漂移,饱和漏电流减小;Bi离子辐照后饱和漏电流急剧下降,在高注量下出现关态漏电现象。对2种离子辐照后的器件进行剖面微观结构分析,Xe离子辐照后器件整个栅区域及异质结区域并未发现潜径迹形成;Bi离子辐照AlGaN/GaN HEMT器件纵截面TEM图如图16所示。由图16可见,有穿越整个栅区域及异质结区域的重离子径迹。 由图16(a)可见,有黑色线条分布,如虚线框标记的b和c区域即为离子入射后形成的潜径迹,在非晶SiN层中也有潜径迹形成。图16(b)虚线框中标记位于异质结界面区域径迹直径大约5.8 nm,随着离子入射深度的增大,径迹直径逐渐减小。由图16(c)可见,距离器件表面500 nm深度观察到径迹直径大约为4.3 nm,且径迹晶格条纹模糊,有非晶相形成。由图16(d)可见,漏区域形成了潜径迹。在距离器件表面500 nm处观察径迹的显微结构,高倍下观察漏区域潜径迹呈现准连续的形貌,如图16(e)所示。潜径迹是缺陷和缺陷团簇的聚集区域,潜径迹的形成导致晶格结构不完整,引入电子陷阱和缺陷,使载流子输运沟道中散射中心数目增大,散射概率增加,最终导致有效载流子浓度降低,栅压控制能力减弱,阈值电压漂移。由于异质结厚度较小,沟道内引入杂质较少,沟道外引入深能级缺陷会通过载流子去除效应和隧穿效应引起异质结势垒高度降低,势垒层中掺杂浓度增大,导致2维电子气面密度降低,迁移率减小。因此,快重离子辐照引起的材料结构损伤是导致器件电学性能退化甚至失效的主要因素[76]。 Ga2O3存在5种不同的晶型[77-84],其中,α-Ga2O3具有与蓝宝石相同的刚玉型晶体结构,可利用特殊的化学气相沉积工艺在蓝宝石衬底上制备出无应力的α-Ga2O3薄膜。日本Flosfia公司已利用α-Ga2O3薄膜制备出二极管和晶体管,部分器件已实现量产。单斜晶系的β-Ga2O3是Ga2O35种晶型结构中最稳定的。在一定条件下,其他4种Ga2O3晶型结构都可以转化为β-Ga2O3。β-Ga2O3可采用与单晶Si相似的高温熔体技术直接生长,以较低成本大批量生产单晶晶圆[85]。结合β-Ga2O3晶体的优异物化性质及低成本等优势,β-Ga2O3被认为是最具发展潜力的晶相,也是目前国内外研究最广泛的晶相。随着β-Ga2O3单晶生长及制备工艺的成熟,以β-Ga2O3空间应用为背景的辐照效应研究也逐步展开。 早在1974年,针对β-Ga2O3单晶材料,利用注量为4×1017cm-2的快中子辐照烧结β-Ga2O3,发现β-Ga2O3电导率下降,如图17所示。 推测辐照在材料中产生的空位类型缺陷作为电子的俘获中心,从而引起材料电导率下降[86]。能量为几百keV的P,Ar,Sn离子辐照β-Ga2O3单晶,利用卢瑟福沟道背散射方法(Rutherford backscattering spectrometry in channeling mode,RBS/C)给出结构损伤信息[87],发现700 keV Sn离子辐照剂量达到0.6 dpa(dpa为给定注量下,每个原子的平均移位次数)时,损伤峰处无序度达到饱和值0.9,而单晶4H-SiC在4 MeV Xe离子辐照下的非晶临界剂量为0.4 dpa[88]。表明,β-Ga2O3抗低能重离子辐照能力可能要优于4H-SiC。 通过TEM直接证实快重离子辐照在β-Ga2O3中产生圆柱形非晶结构的潜径迹[89],如图18所示。同时,利用非弹性热峰模型,预测β-Ga2O3中产生潜径迹的Se阈值约为17 keV·nm-1,明显低于GaN和SiC等产生潜径迹的Se阈值,表明相同快重离子辐照后,β-Ga2O3单晶更容易产生潜径迹这种永久性结构损伤。利用946 MeV Au离子辐照多晶β-Ga2O3样品,并通过X射线衍射(X-ray diffraction, XRD)光谱分析发现,辐照产生的非晶潜径迹还导致β-Ga2O3出现各向异性的肿胀[90]。利用120 MeV Ag离子辐照多晶β-Ga2O3薄膜,当辐照注量为1×1011~5×1012cm-2时,通过XRD光谱、拉曼光谱及RBS/C光谱研究,发现Ag离子辐照不仅使β-Ga2O3薄膜平均晶粒尺寸逐渐减小,还使薄膜呈现乏氧状态[91]。 由于β-Ga2O3材料P型掺杂困难,目前主要开展N型掺杂的β-Ga2O3的肖特基势垒二极管(Schottky barrier diode, SBD)和MOSFET器件辐照效应研究。利用10 MeV质子、1.5 MeV电子和10 MeV α离子辐照β-Ga2O3肖特基整流器,观测到辐照引入的陷阱态造成整流器反向击穿电压、载流子去除率及开关比等电学参数退化[92-94]。利用10 MeV质子辐照通过机械剥离制得的薄层β-Ga2O3FETs器件发现,当注量为2×1015cm-2时,器件场效应迁移率下降73%,阈值电压正向漂移,器件开关比变化不大[95]。 能量为2 096 MeV,注量ΦTa为5×107~1×109cm-2的Ta离子辐照时,β-Ga2O3SBD参数的变化情况如图19所示[96]。 由图19可见:辐照后器件正向导通及反向阻断能力下降,注量增加至5×109cm-2时,器件损坏;快重离子在β-Ga2O3SBD中造成了明显的载流子去除效应;通过比较β-Ga2O3,SiC,GaN等器件,发现快重离子辐照后,β-Ga2O3器件载流子去除率最高,器件性能退化最严重。 宽禁带半导体材料的功率器件独具优势,但对重离子辐照效应的敏感性是制约宽禁带半导体器件在空间应用的瓶颈问题。研究表明:SiC材料对重离子辐照不敏感,但SiC器件在高压工作条件下易发生重离子单粒子效应,如单粒子漏电退化、单粒子烧毁和单粒子栅穿等;随着器件结构和工艺尺寸的不断发展,仍需开展不同离子参数和器件电学特性的重离子辐照实验及理论模拟,明确重离子入射高压器件后内部电场及载流子浓度等演化过程,建立材料损伤与器件电学特性变化的关系,从而认识效应机理;GaN材料对低能重离子表现出较好的抗辐照特性,而对快重离子,易产生潜径迹等结构损伤,直接影响器件电学特性,在加电状态下,重离子辐照与器件内高强度电场共同作用的影响还需进一步研究;快重离子辐照后,Ga2O3材料易产生潜径迹等结构损伤,造成器件电学性能退化,限制了其在辐射环境下的应用。2 GaN材料和器件重离子辐照效应研究
2.1 GaN材料重离子辐照效应研究
2.2 GaN器件重离子辐照效应研究
3 Ga2O3材料和器件重离子辐照效应研究
3.1 β-Ga2O3材料重离子辐照效应研究
3.2 β-Ga2O3器件重离子辐照效应研究
4 总结

