背散射方法测薄膜厚度和杂质分布
徐 川,付恩刚,楼建玲
(北京大学 物理学院 核物理与核技术国家重点实验室,北京 100871)
20世纪初,卢瑟福通过分析α粒子散射实验提出了原子的核式结构模型. 1967年,美国探索者V号利用背散射方法对月球表面土壤元素成分进行了分析. 这是根据卢瑟福提出的原理解决非核领域问题的首个公开发表的实际应用例子[1]. 几十年来该方法已发展成十分成熟的离子束分析(Ion beam analysis,IBA)技术. 这种技术具有方法简便可靠,不需要依赖标准样品就能得到定量的分析结果,不必破坏样品宏观结构就能获得样品深度分布信息等优点. 因此IBA被广泛应用于离子注入工艺研究,对半导体材料、金属材料、超导材料、反应堆器壁材料以及各种薄膜材料的成分分析,对原子的扩散和外延层性质的研究,对新材料、新器件的研制等起到了推动作用.
目前,国际上IBA研究领域朝着高精度和集成化方向发展. 通过将背散射分析、核反应分析、粒子诱发X射线分析等IBA技术结合起来,可实现综合离子束分析[2]. 这种协同分析的优点是可以弥补单一IBA分析能力的不足,获得更加全面的样品成分信息. 北京大学基于4.5 MV 静电加速器,设计并搭建了高精度综合IBA系统,可实现背散射与核反应的协同分析[3]. 四川大学基于核天体物理实验中对实验靶的检验需要,发展了用于大面积样品背散射分析的实验装置,可实现对样品任意测量位置的自动定位、自动测量以及大量实验谱的批量数据处理分析[4].
由于背散射分析方法简便易行,国内很多具备小型加速器的高校都建有背散射分析束流终端,除了进行科研用途之外,还能够开展针对本科生及研究生的实验教学[5-7]. 学生通过背散射分析实验可以更好地了解其基本原理,掌握该分析方法也能为学生将来从事相关科学研究、工业测量奠定基础. 本文主要介绍背散射实验的基本原理及具体应用[1,8-10],利用IBA软件SIMNRA对实验能谱进行解谱分析[11].
1 实验原理
当1束载能粒子入射到靶上时,大部分粒子沿入射方向穿透靶,并与靶原子中的电子发生碰撞损失能量;只有极少部分粒子与靶原子核发生大角度库仑散射,偏离原来的入射方向,如图1所示. 入射粒子与靶原子核之间的大角度库仑散射称为卢瑟福背散射(Rutherford backscattering spectrometry,RBS). 当入射粒子能量较高时,由于出现核势散射的贡献,散射截面将偏离卢瑟福截面,发生非卢瑟福散射. 利用探测器对这些背散射粒子进行测量分析,能获得有关靶原子的质量、含量和深度分布等信息. 入射粒子与靶原子碰撞的运动学因子K、散射截面σ和能量损失因子[S]是背散射分析中的3个主要参量.
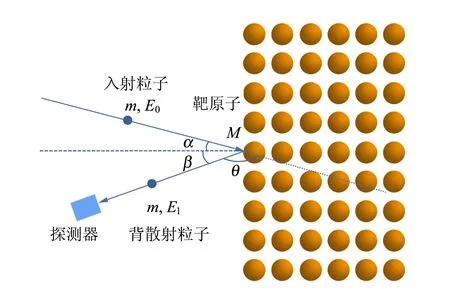
图1 背散射示意图
1.1 运动学因子K
根据入射粒子与靶原子碰撞时的能量和动量守恒,可以求得散射后粒子的能量E1. 入射粒子与靶原子碰撞后和碰撞前的能量之比K称为运动学因子,即
(1)
K与入射粒子质量数m、靶原子质量数M和散射角θ有关. 对于一定质量的入射粒子,若散射角θ一定,则K由靶原子质量数M决定. 通过测量散射粒子的能量,可以确定K值,从而能够对靶原子的质量进行分析. 区分不同质量的能力称为质量分辨本领. 通过提高入射粒子的能量和采用重的入射粒子以及在180°附近测量都可以提高质量分辨本领. 在背散射分析时,有可能发生从样品表面某一元素散射的粒子能量与样品内部其他元素(原子量大)散射的粒子能量相等的情况,此时可采用改变入射粒子的能量进行区分.
1.2 散射截面σ
入射带电粒子与靶原子核之间的弹性散射截面,一般是库仑散射截面和核散射截面两部分贡献之和. 常用的背散射分析都是卢瑟福背散射,研究的是入射粒子与靶原子核之间的库仑排斥作用下的弹性散射过程,其微分截面就是著名的卢瑟福散射截面. 当入射粒子的质量数m远小于靶原子的质量数M,以及背散射角较大时,利用e2=1.44×1013MeV·cm,卢瑟福散射截面可近似为
(2)
其中,Z1和Z2分别为入射粒子和靶原子的原子序数,入射粒子能量E量级为MeV,σ量级为10-24cm2/sr. 由式(2)可知,σ反比于E2,入射粒子能量越高,散射概率越低;Z2越大,σ越大,所以粒子背散射对轻基体中的重杂质分析较为灵敏. 在确定的实验条件下,散射产额取决于被分析元素的浓度,因此通过能谱分析,可定量分析元素的浓度及分布. 卢瑟福散射截面适用于粒子电荷态保持不变,没有靶原子的电子屏蔽以及不发生核散射的情况. 当入射粒子能量很高时,核散射贡献增强,大大超过卢瑟福散射截面. 利用非卢瑟福散射可以分析低原子序数的杂质原子.
1.3 能量损失因子[S]


图2 入射粒子在单元素样品上背散射示意图
(3)
在x深度,能量为E(x)的粒子与靶原子发生背散射后,其能量为KE(x). 这些背散射粒子穿出样品时,同样有能量损失. 在θ方向穿出样品表面时的能量为
(4)
因此,探测器所测到的从样品表面发生背散射的粒子能量KE0和从x深度发生背散射的粒子能量E1(x)之间的差为
(5)

(6)

ΔE=[ε]Nx,
(7)

2 实验设备与测试过程
2.1 实验设备
实验设备主要有:1.7 MV串列静电加速器;实验束线终端(包含束流管道、狭缝、真空靶室、阀门、真空机械泵、分子泵)、转角仪系统(可以进行三维转动及一维平动操作)、钝化离子注入平面硅探测器(Canberra PD 50-12-100AM)、高压插件(ORTEC 710)、前置放大器(ORTEC 142A)、主放大器(ORTEC 572A)、多道分析器(ORTEC TRUMP-PCI-2K 或 ASPEC 927)、束流积分器(ORTEC 439)、计数器(ORTEC 771)和微机(装有能谱获取软件MAESTRO).
图3所示为背散射实验装置的示意图. 靶盘引出线串接+300 V电池后再接入束流积分器,加正高压的目的是为了抑制二次电子. 束流积分器与计数器可测量入射粒子的电荷量,并通过计数器反馈给多道分析器GATE信号,可以控制多道分析器是否有输出. 探测器信号通过前放和主放后接入多道分析器,多道分析器的输出信号送入微机,最后通过MAESTRO软件来获取背散射能谱.

图3 背散射实验装置示意图
2.2 样品准备
背散射分析对样品制备方法无特殊要求. 常见样品是通过磁控溅射镀膜或离子注入技术制备,部分高校已开展了相关研究性实验课程[12-14]. 样品尺寸一般为边长5~10 mm,厚1 mm左右,用导电胶粘在圆形靶盘上,如图4所示. 为了便于调束,需要在靶盘上粘贴一小块石英片. 此外,为了对探测系统进行能量刻度,还需要几种不同的单元素厚样品或者含有O,Si,Au等表面杂质的C靶样品作为标样. 靶盘固定在转角仪上,样品位置通过距离靶盘中心的长度及角度来标记.

图4 实验靶盘
2.3 实验条件
在背散射分析时应选择合适的实验条件,主要包括入射束、能量、实验的几何安排、探测系统的能量分辨率要求等. 一般选用2~3 MeV的He离子来做背散射分析,入射方向一般是垂直样品表面入射,散射角一般取160°~170°.
2.4 实验测试过程
串列加速器产生的粒子束,经过分析磁铁进入背散射束线管道,再经过2个准直狭缝,打到靶盘上. 先调整转角仪使离子束打在石英片中心,作为基准位置,束斑尺寸不超过2 mm×2 mm. 再将标样和待测样品依次转到束斑所在位置,获取能谱. 能谱获取时应使目标元素峰的计数足够高,谱形明显,一般样品的测试时间在10 min左右. 对于单晶样品,测随机谱时可能会受到沟道的影响,需要微调样品角度.
3 SIMNRA软件介绍
实验测得的能谱可利用SIMNRA软件进行解谱,如图5所示. 该软件由马克斯·普朗克等离子体物理研究所开发,是目前国际上应用最广泛的解谱软件,可模拟离子束分析中的背向或前向散射能谱,广泛应用于背散射能谱分析、核反应分析及弹性反冲探测分析等. 利用该软件可在实验前模拟能谱的信息,有助于选择合适的实验条件.

图5 SIMNRA软件界面
对于常规的背散射测试,计算能谱时大部分软件使用默认参量值(或推荐值),各参量的具体含义可参考SIMNRA用户手册[15]. 通过Setup→Experiment [图6(a)]设置的参量主要包括入射束种类、能量、探测器位置及分辨率、能量刻度系数、粒子数×立体角等. 粒子数×立体角可以通过直接测量的参量来确定,利用软件中的Calculate→Particles*sr功能可以快速算出粒子数×立体角. 然而精确测量粒子数与立体角比较困难,也可以通过模拟衬底部分的能谱得到粒子数×立体角,但对于常见的镀膜样品,随着膜厚增加,衬底部分逐渐向低能处移动,甚至可能测不到衬底. 上述2种方法相结合可以更好地确定粒子数×立体角. 如果入射束的流强较大,则多道分析器采集数据时死时间的占比会较大,将对测量结果的准确分析带来影响,在Setup→Experiment: More options→Live Time and Pile-up中可设置实际时间和活时间的时长,修正后可降低由死时间引起的误差.

(a)实验参量设置界面 (b)计算参量设置界面 图6 SIMNRA软件中的主要参量设置界面
随入射深度增大,多次散射概率增加,将对能谱低能部分产生明显影响. 通过在Setup→Calculation→Parameter[图6(b)]中选中Multiple scattering及Dual scattering选项,将会考虑多次小角度散射引起的歧离以及2次大角度散射事件,会使低能部分的计算结果与实验谱更好地符合[15]. 电子阻止本领数据的选择会对模拟谱的形状产生较大影响,默认选项为Ziegler/Biersack,即Ziegler,Biersack和Littmark提出的电子阻止本领,与SRIM 1997采用的数据一致[15]. 此外,SRIM选项能够调用本机SRIM 2003或更高版本软件中的阻止本领数据[16]. 对于大部分弹靶组合,ZB+KKK选项与Ziegler/Biersack选项采用的阻止本领数据相同. 这2个选项的区别是当H,D,T,3He以及4He作为入射粒子打在C或Si靶上时,ZB+KKK选项采用的阻止本领为KKKNS参量,其精度可达2%[15,17-18].
通过Target→Target可对样品靶设置多层结构,每层参量包括厚度、元素个数、种类及各元素的原子数占比等. 其中,厚度采用薄膜厚度单位(1015atoms/cm2),根据质量密度(g/cm3)可换算为长度单位(nm). 利用软件中的Calculate→Density能够查看各元素的质量密度、原子密度及厚度的单位换算,例如Si元素,其质量密度为2.322 g/cm3, 原子密度为4.979×1022atoms/cm3,1015atoms/cm2对应厚度为0.200 85 nm. 此外,对于特殊样品还可以设置每层的粗糙度,从而提高薄膜界面谱形的计算效果. 综合每层元素的参量可得到深度分布信息.
在Reactions中可选择反应截面(包括操作者添加的截面数据),在计算能谱时软件会自动选择,一般选择默认参量. 最后,通过Calculate→Calculate spectrum计算出当前条件下的能谱.
4 背散射分析应用实例
选用2种典型的样品进行背散射实验. 样品1为薄膜样品,样品2为经过离子注入后的Si样品,相当于在Si中进行了掺杂.
4.1 薄膜样品的成分与厚度测量
样品1结构为AuxGe1-x/Pd/Ni,即在Si衬底上镀3层薄膜,每层厚度约5 nm,为得到薄膜的详细信息,将2 MeV的4He+作为入射束进行背散射实验. 实验时流强约为3 nA,入射粒子总电荷量为1.3 μC,探测器立体角约为8.889 msr,可知粒子数×立体角约为7.21×1010. 本次测试中角度设置为α=0°,β=20°,θ=160°,探测器分辨率为21 keV. 由于实验流强较弱,死时间占比在1%以下. 电子阻止本领数据由SRIM2013软件模块计算得到. 计算能谱如图7所示.

图7 Si衬底上AuxGe1-x/Pd/Ni薄膜的背散射实验SIMNRA计算谱
从图7中可以看出,模拟谱与实验数据基本重合. 尤其在选中Dual scattering时,由于包括了2次大角度散射事件,因此在低能区域的模拟效果更好.
根据模拟参量可知,粒子数×立体角为7.05×1010,比直接测量值7.21×1010约小2%. 样品参量如表1所示,厚度相对不确定度为5%,主要来自阻止本领和峰面积计数的统计误差等[19]. 由表1数据可知薄膜成分为Au0.92Ge0.08/Pd/Ni.

表1 SIMNRA计算结果
对于多层薄膜,如果每层厚度都非常薄(几nm或十几nm),且有元素相同或相近,则入射束垂直入射往往不能很好地分辨这些元素峰. 图8(a)所示为Au/Ti/Au薄膜的SIMNRA模拟能谱,厚度分别设定为6.8 nm,15.8 nm和6.8 nm,衬底为Si.

(a) 垂直入射与掠角入射时的模拟能谱
SIMNRA软件计算垂直入射(α=0°,β=20°,θ=160°)与掠角入射(α=75°,β=55°,θ=160°)2种条件时的能谱.4He+能量2 MeV,探测器能量分辨率设为21 keV,入射粒子数相同. 在入射束垂直入射(α=0°)时,2层Au薄膜的峰叠加在一起,无法区分. 对于这种情况,可以采用掠角入射提高深度分辨率,能得到较好的实验结果. 在设计实验时可以利用SIMNRA软件包里的ResolNRA程序对深度分辨率进行计算. 如图8(b)所示,深度分辨率从约16.4 nm(垂直入射)减小到约4.4 nm(α=80°时). 可见入射角度越大,深度分辨率越好. 对于上述Au/Ti/Au薄膜样品,在入射角α=75°时,2层Au薄膜的峰已经明显分开,因此可以得到各层结构的精确信息.
4.2 注入样品的杂质分析
背散射分析技术也可以对离子注入后的样品进行表征. 样品2为经过3 MeV的Au2+注入后的Si样品,期望的注入剂量为4×1015cm-2,为避免沟道效应,束流与样品法线偏离约7°[20]. 离子沿入射方向在靶中所穿过的平均距离称为投影射程(或平均射程),用Rp表示. 如果注入离子的射程分布是高斯分布,则该高斯分布的标准偏差就是射程岐离,用ΔRp表示. 利用SRIM2013软件直接计算得到Rp=682.6 nm,ΔRp=125.0 nm. 由于射程较深,如果背散射分析时的入射束仍采用2 MeV的4He+,则Au的能谱会与Si的能谱发生重叠,不利于数据分析. 因此,实验时采用了能量为3 MeV的4He2+作为入射束,这样可以使Au的能谱与Si衬底能谱分开,避免重叠.4He2+流强约10 nA,死时间小于1%,入射4He2+总电荷量为8.5 μC. 对于此类样品,教科书中常采用250 keV的As+注入Si中,由于射程较浅,采用表面能量近似法对背散射能谱进行分析得到了注入剂量和射程[1,8]. 对于3 MeV的Au2+,在Si中射程比较深,如果采用表面能量近似法计算则结果误差较大. 图9所示为背散射能谱,箭头标出了Au在Si样品表面时背散射的能量KAuE0. Au峰的半高全宽RFWHM为190 keV,其中心能量位置相对于KAuE0的能量位移ΔE=363.5 keV. 根据Rp=ΔE/(NSi[ε]) 和ΔRp=RFWHM/(2.355[ε]NSi) 即可计算出3 MeV的Au2+在Si中的投影射程和射程岐离,其中NSi为Si的原子密度.
利用SIMNRA软件对注入样品的背散射能谱进行解谱分析,可得到精确的结果. 样品可设置为多层,从表面开始第一层是由Si元素构成,之后若干层是由Si元素与Au元素构成,其中Si的原子数占比在99%以上,最后一层由足够厚的Si元素构成. 因为样品中Si占绝大部分,所以电子阻止本领数据可采用KKKNS参量,其精度可达2%. 计算能谱如图9所示,实验谱与模拟谱符合很好.
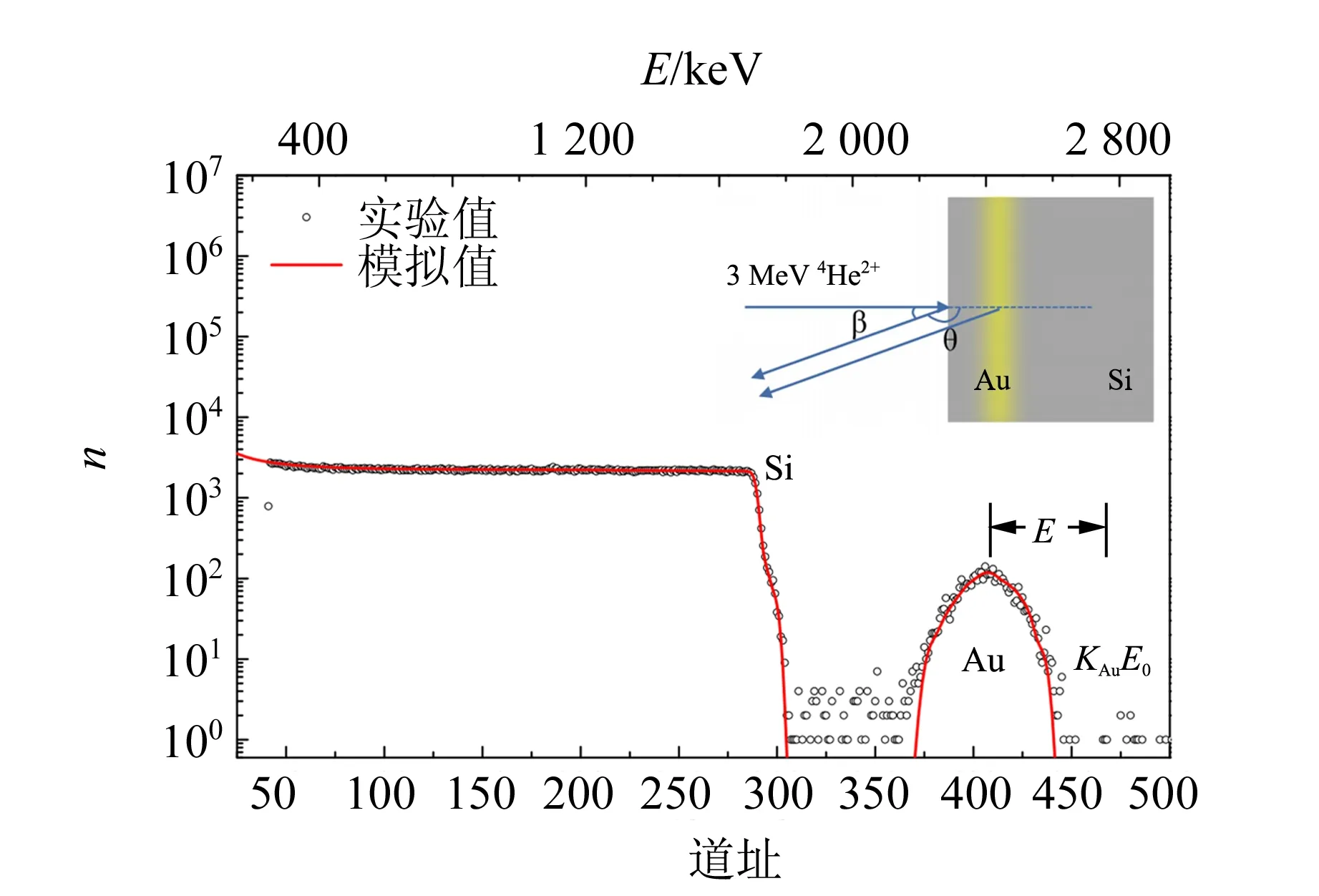
图9 Si中注入Au杂质样品的背散射能谱
将各层Au元素的含量加起来即为Au2+的注入剂量,可在Target→Show→Target summary中查看. 由此得到Au2+注入剂量为(3.95±0.11)×1015cm-2,误差主要来自Au峰的统计误差(~1.6%)、散射角偏差(~1.22%)以及阻止本领(~2%). 此外,在Target→Edit→Copy depth profile中可将各元素的深度分布信息提取出来. 如图10所示为Au在Si中的深度分布情况.

图10 Au的深度分布
通过高斯拟合可以得到3 MeV Au2+在Si中的Rp=924.2 nm,在忽略探测器的能量分辨率和能量歧离等因素后,可得ΔRp=207.2 nm. 该投影射程比SRIM直接计算结果(682.6 nm)大很多,这是因为在计算过程中Au等重离子在低Z靶中的电子阻止本领被高估[21].
在利用SRIM计算Au2+注入Si中时,将Si的密度减小27%时可以得到与实验一致的射程结果[22]. 对于3 MeV的Au2+注入,当Si的密度为1.7 g/cm3时,SRIM计算得到Rp=933.0 nm,ΔRp=171.3 nm,与背散射分析结果基本一致. 若采用表面能量近似和平均能量近似法进行计算,则分别得到Rp=962.3 nm,ΔRp=213.6 nm与Rp=928.8 nm,ΔRp=206.1 nm. 可见平均能量近似法的结果更好.
5 结束语
背散射分析技术广泛应用于材料的表征,主要适用于分析轻基底上的重元素,方法简便易行,分析结果可靠. 本文分别对薄膜样品的成分及厚度和离子注入样品的杂质浓度及深度分布做了实验测量,利用SIMNRA软件对背散射能谱进行了解谱分析,模拟结果与实验数据符合很好. 背散射分析适合作为学生实验开展,针对不同待测样品需要选择合适的实验条件,有助于学生深入掌握背散射分析的原理. 通过本实验的训练可以提高学生在科研实践中解决实际问题的能力.

