苯基修饰含氮整平剂对高厚径比盲孔镀铜的影响
何晓桐 ,谭伟,陈泳,华子如,罗勇葳,潘文龙,
(1.广东工业大学轻工化工学院,广东 广州 510006; 2.广东省科学院测试分析研究所(中国广州分析测试中心), 广东省化学测量与应急检测技术重点实验室,广东 广州 510070)
印刷电路板(PCB)是大部分电子产品的核心器件。随着5G时代的到来,要求通信拥有更高速、更大容量、更小延时的特点[1],对PCB基板的厚度、表面形貌、阻抗等各方面性能也提出了更严格的要求[2-3]。盲孔电镀填孔是实现多层板高密度互连的重要技术之一[4],选择高性能电镀添加剂能有效提高镀液的深镀能力,实现“超填充”或“自下而上填充”[5-8],从而得到性能好和成本低的PCB产品。
电镀添加剂包含整平剂、光亮剂和抑制剂[9-11]。抑制剂大多为大分子聚醚类物质[12-14],例如聚乙二醇(PEG)。光亮剂多数为含磺酸基团的化合物[15-16],聚二硫二丙烷磺酸钠(SPS)是常用光亮剂之一。整平剂一般是含有S、N、O等杂原子的环状物质,早期应用较多的整平剂是健那绿(JGB)[17]。这3种添加剂在电镀过程中协同作用方能达到填孔整平效果[18],其中整平剂对盲孔铜沉积的影响最大[5,19]。
近年来,季铵盐型整平剂是电镀添加剂的研究热点之一,季铵盐型整平剂中的氮原子带正电荷,基于阴、阳离子对效应,季铵盐型整平剂会吸附在阴极的高电流密度区,抑制铜离子在高电流密度区的析出,使孔内铜离子的析出速率大于孔外铜离子的析出速率,从而达到填平效果[20-23]。Hai等[24]研究发现,咪唑与1,4-丁二醇二缩水甘油醚(BDGE)反应得到的聚合物整平剂既能发挥类似于聚醚的抑制作用,又具备季铵盐的整平 作用,具有良好的超填充能力。Zheng等[25]以1-乙烯基咪唑和BDGE为原料合成了一种聚合物整平剂VIBDGE,它与SPS和PEG既存在竞争吸附,又能够协同作用,镀液中同时含有这3种添加剂时对通孔电镀的均镀能力高达90%。Lai等[17]结合计算机模拟和盲孔电镀实验,对比了健那绿和咪唑环氧氯丙烷聚合物(IMEP)的整平效果,发现在高电流密度下IMEP的整平效果更好。
本文分别以咪唑、4-苯基咪唑、2-苯基咪唑和苯并咪唑为原料,与1,4-丁二醇二缩水甘油醚和仲胺反应合成季铵盐整平剂,对比了4种季铵盐整平剂对盲孔填充效果的影响,为开发高厚径比整平剂提供一定的理论基础。图1示出了4种咪唑类化合物的分子结构。
1 实验
1.1 主要试剂与仪器
1,4-丁二醇二缩水甘油醚(99%)、咪唑(99%)、2-苯基咪唑(98%)、苯并咪唑(98%):上海麦克林生化科技有限公司;4-苯基咪唑(≥98%):广州翁江化学试剂有限公司。
集热式恒温加热磁力搅拌器:巩义市予华仪器有限责任公司;AVANCE-300超导脉冲傅里叶变换核磁共振谱仪(NMR):德国Bruker;MAGNA-IR 760傅里叶变换红外光谱仪(FTIR):美国Nicolet;CHI760E型电化学工作站:上海辰华仪器有限公司。
1.2 整平剂合成与表征
将一定量咪唑、2-苯基咪唑、苯并咪唑或4-苯基咪唑与BDGE、仲胺化合物及去离子水加入带温度计的三颈烧瓶中,搅拌升温至90 ℃保温8 h,合成路线如图2所示。反应结束后溶液呈琥珀色,加入硫酸调节pH至3 ~ 4,分别得到咪唑季铵盐化合物(IABDGE)、2-苯基咪唑季铵盐化合物(TPIABDGE)、4-苯基咪唑季铵盐化合物(FPIABDGE)和苯并咪唑季铵盐化合物(BIABDGE)。

图2 咪唑及其衍生物与仲胺化合物和BDGE的反应式 Figure 2 Reaction equation of imidazole or its derivatives with secondary amine and BDGE
采用核磁共振谱仪对产物进行核磁共振分析,并使用Topspin软件分析数据。另外采用傅里叶变换红外光谱仪分析产物的结构,波数范围为400 ~ 4 000 cm-1,扫描32次,并用OMNIC软件分析数据。
1.3 盲孔电镀工艺
采用6.3 cm × 20 cm的盲孔测试板为基材,盲孔孔径100 ~ 120 μm,孔深70 ~ 80 μm,孔内预先通过化学沉铜和闪镀得到厚度为4 ~ 6 μm的铜层。
电镀前先对测试板进行如下处理:酸性除油1 min →水洗1 min →微蚀(采用硫酸-过硫酸钠体系)1 min→水洗2 min →酸洗(采用质量分数为3% ~ 5%的硫酸)1 min。
电镀铜采用含磷铜板作为阳极,在温度25 ℃和电流密度1.6 A/dm2的条件下电镀45 min或30 min。基础镀液是含CuSO4·5H2O 220 g/L、硫酸60 g/L和Cl-60 mg/L的水溶液。添加剂包括3 mg/L SPS、600 mg/L PEG-1300和15 mg/L整平剂。电镀结束后如图3所示根据式(1)计算填孔率(η),以评价添加剂的填孔能力。其中,A为外表面铜镀层厚度,B为孔内铜镀层厚度,C为电镀铜层外表面到孔内铜镀层表面的高度。
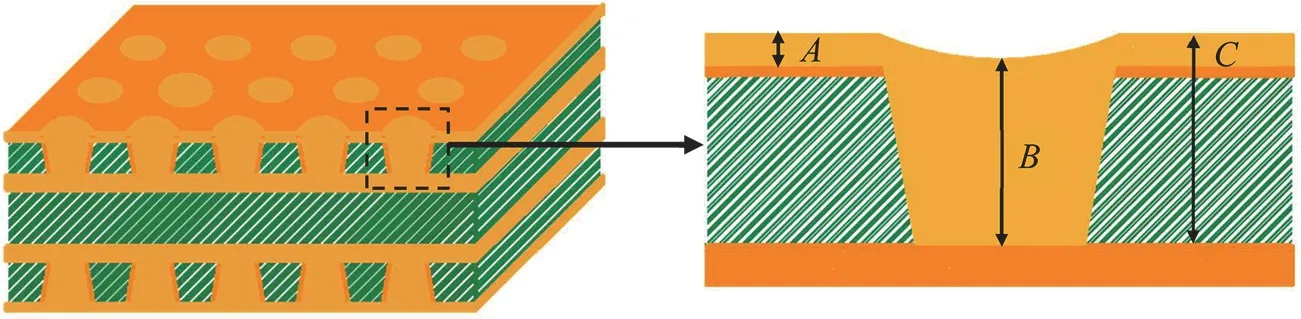
图3 电镀铜填充盲孔效果示意图 Figure 3 Sketch showing the via filling effectiveness by copper electroplating

1.4 电化学分析
采用CHI760E型电化学工作站和三电极体系进行电化学分析,以评估整平剂在盲孔电镀中对铜电沉积行为的影响及其抑制铜析出的能力。采用直径为3 mm的旋转圆盘金电极(Au-RDE)作为工作电极,汞-硫酸亚汞电极(MSE)作为参比电极,铂片作为辅助电极。
循环伏安(CV)分析的电位范围为-0.7 ~ 0.6 V,线性扫描伏安(LSV)分析的电位范围为-0.4 ~ -0.8 V。电化学阻抗谱(EIS)在电位0.65 V下测量,频率从100 kHz至100 Hz。CV、LSV和EIS都在含添加剂的镀液中测得,旋转圆盘金电极的转速都为1 000 r/min。
计时电位测试前在旋转圆盘金电极表面电镀2 ~ 3 μm厚的铜,使金电极转换成铜电极。然后以基础镀液为电解液,分别在1 000 r/min的高转速和100 r/min的低转速下进行计时电位测试,以模拟铜在盲孔口和盲孔底的沉积行为,在测试开始的500、1 000和2 000 s时分别加入PEG、SPS和整平剂。通过对比采用不同整平剂时的电位差来评价各自的填孔能力。
2 结果与讨论
2.1 产物结构表征
不同原料和产物的核磁氢谱如图4所示。从中可知,BDGE在δ为2.65 × 10-6和2.85 × 10-6处的环氧键的共振消失,并且咪唑环上氢的峰型和化学位移在反应后发生了变化,可以推断反应已经完成。

图4 IABDGE、TPIABDGE、FPIABDGE和BIABDGE的1H-NMR谱 Figure 4 1H-NMR spectra of IABDGE, TPIABDGE, FPIABDGE, and BIABDGE
从图5可知,反应产物的红外谱图并没有显示原料中环氧键的吸收峰(位于波数1 248 ~ 1 252 cm-1和904 ~ 910 cm-1),出现了大量羟基吸收峰(对应波数为3 050 ~ 3 700 cm-1),说明BDGE的环氧键全部被打开而形成大量羟基。
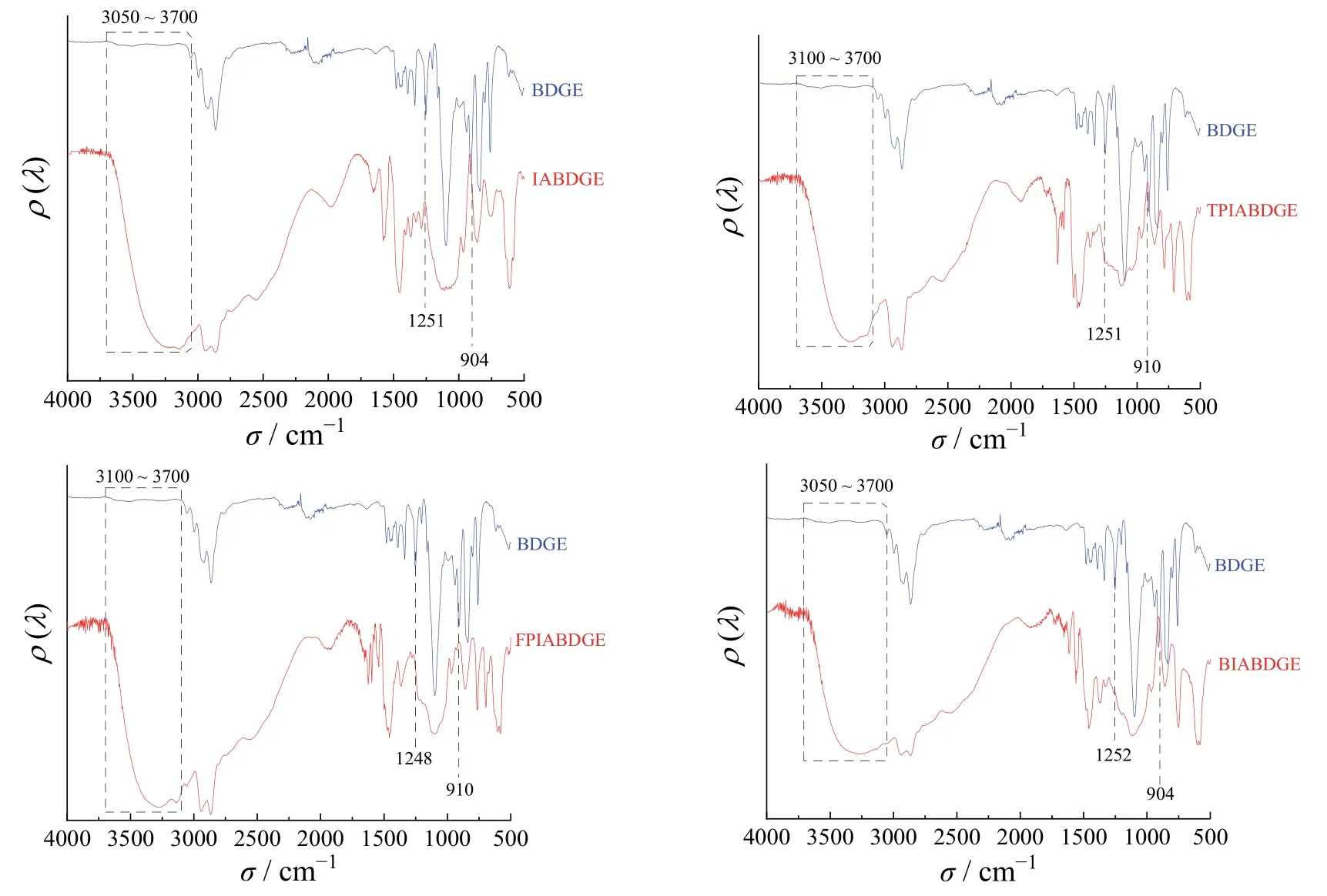
图5 BDGE、IABDGE、TPIABDGE、FPIABDGE和BIABDGE的红外光谱 Figure 5 FTIR spectra of BDGE, IABDGE, TPIABDGE, FPIABDGE, and BIABDGE
2.2 铜电沉积过程的电化学分析
2.2.1 循环伏安分析
从图6可知,在电位正向扫描过程中,以BIABDGE作为整平剂时CV曲线的阳极溶出峰面积最小,滞后效应最低;以IABDGE作为整平剂时CV曲线的阳极溶出峰面积最大,滞后效应最强。这说明BIABDGE对孔外铜沉积的抑制作用最强,IABDGE对孔外铜沉积的抑制作用最弱。从图6还可以发现BIABDGE做整平剂时铜的沉积电位最负。
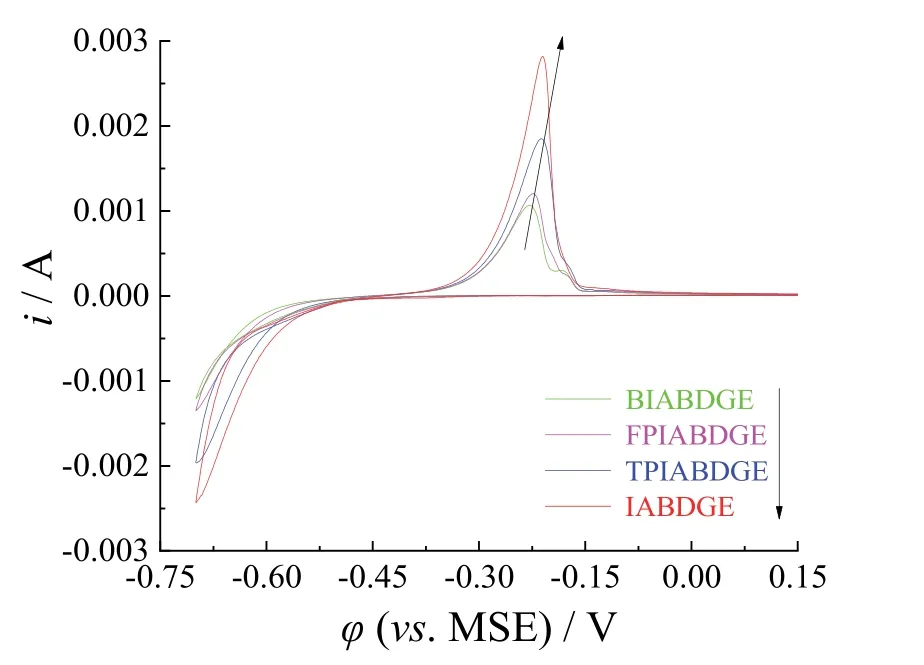
图6 采用不同物质作为整平剂时铜电沉积的循环伏安曲线 Figure 6 Cyclic voltammetries for electrodeposition of copper with different levelers
2.2.2 线性扫描伏安分析
从图7可知,采用BIABDGE、FPIABDGE、TPIABDGE和IABDGE作为整平剂时,铜的沉积电位分别为-0.647 8、-0.623 7、-0.613 2和0.434 9 V。铜沉积电位越负,表示阴极极化作用越强。上述结果表明采用BIABDGE作为整平剂时阴极极化作用最强,对表面铜析出的抑制作用最强,最终使孔外铜离子的还原速率小于孔内铜离子的还原速率。这与CV的分析结果一致。

图7 采用不同物质作为整平剂时铜电沉积的线性扫描伏安曲线 Figure 7 Linear sweep voltammograms for electrodeposition of copper with different levelers
2.2.3 电化学阻抗谱分析
实际上,Cu2+还原沉积包含Cu2+还原为Cu+以及Cu+还原为Cu两步。图8是采用不同整平剂时铜电沉积的电化学阻抗谱图,表1是采用图8d对Nyquist图的拟合分析结果。其中Rs为溶液电阻,R1为Cu2+还原成Cu+的电荷转移电阻,C1为双层电容。

图8 采用不同物质作为整平剂时铜电沉积的Nyquist曲线(a)、Bode相图(b、c)及其等效电路(d) Figure 8 Nyquist plots (a), Bode phase plots (b, c), and corresponding equivalent circuit (d) for electrodeposition of copper with different levelers

表1 EIS谱图的拟合参数 Table 1 Fitted parameters of EIS spectra
在Nyquist图中,BIABDGE做整平剂时的容抗弧直径最大,IABDGE做整平剂时的容抗弧直径最小。由Bode图可知,BIABDGE做整平剂时在高频区具有最大的相位角,在低频区具有最大的lg|Z|,而IABDGE做整平剂时都是最小的。从表1可知,采用不同物质作为整平剂时铜电沉积的Rs和C1都接近,但各自的R1差异较大。Cu2+还原为Cu+是决定整个过程还原速率的关键步骤,因此R1越大表示铜离子还原速率越低。BIABDGE做整平剂时的R1最大,对铜沉积的抑制效果最好。
2.2.4 计时电位分析
从图9和表2可知,加入PEG时,阴极电位显著降低,但Δη1< 0,孔口和孔底铜层厚度没有差异。进一步加入SPS时,阴极电位增大,Δη2> 0,意味着孔口和孔底铜层厚度开始出现差异。最后加入整平剂时阴极电位降低,Δη3> 0,除了IABDGE外,其他3种整平剂的Δη3都比相应的Δη2大,说明孔口和孔底铜层的厚度差异加大,最终达到平整的效果。BIABDGE作为整平剂时的Δη3最大,IABDGE作为整平剂时的Δη3最小,也就是说BIABDGE作为整平剂时对盲孔的整平填充效果最佳,表面铜厚最小。这与上述3种电化学分析结果一致。

图9 在不同转速下不同整平剂镀液中铜电沉积的计时电位曲线 Figure 9 Chronopotentiometric curves for electrodeposition of copper with different levelers at different rotational speeds

表2 采用不同整平剂时的阴极电位差 Table 2 Cathode potential differences when adding different levelers to the bath
2.3 不同整平剂用于盲孔电镀时的填平效果
从图10可知,在盲孔电镀铜45 min的情况下,采用含苯环物质作为整平剂时自下而上的填孔能力都较好,表面铜厚在16 μm左右,其中BIABDGE的填孔率最高,达到98.91%。而采用无苯环的IABDGE作为整平剂时,盲孔的填孔率最低,只有85.14%。为了更好地比较不同整平剂的填孔能力,把电镀时间缩短到30 min,IABDGE的填孔率依然是4种整平剂中最小的,BIABDGE和FPIABDGE的填孔率接近,BIABDGE依旧略胜一筹,高达73.77%。这说明4种整平剂中BIABDGE的整平效果最好,IABDGE的整平能力最弱,验证了上述电化学分析的结果。
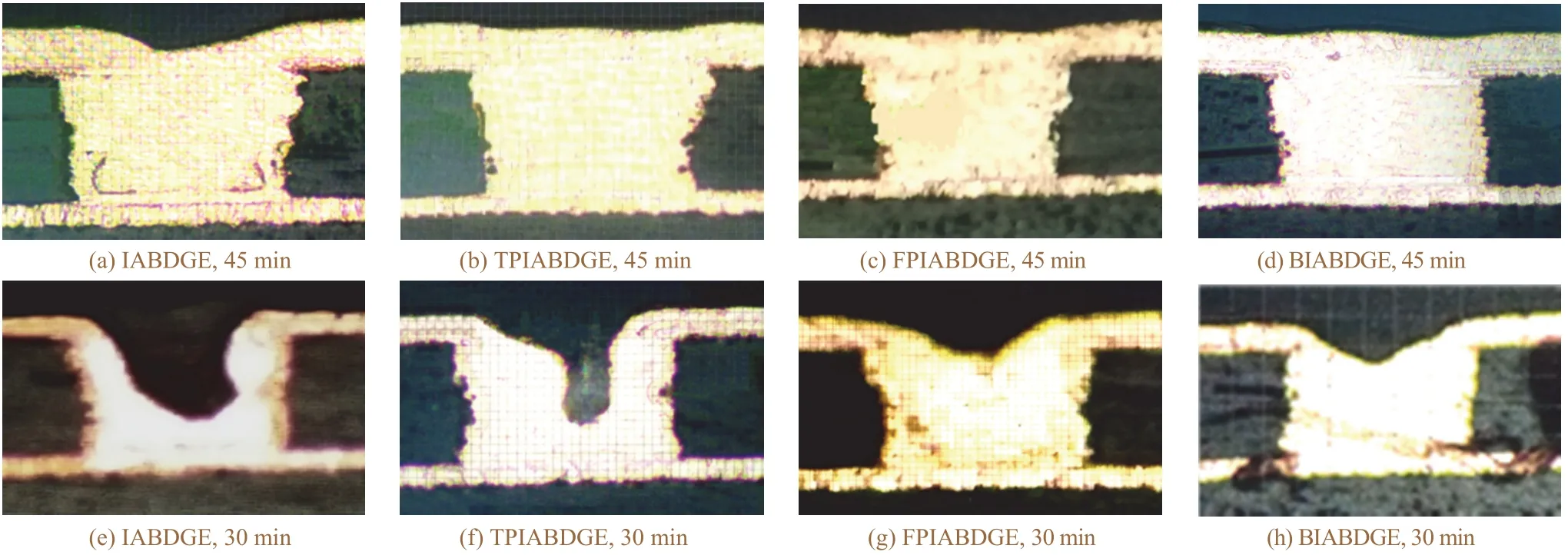
图10 采用不同物质作为整平剂时电镀盲孔的截面金相照片 Figure 10 Cross-sectional metallagraphs of blind vias after copper electroplating with different levelers
在电镀过程中,测试板表面的电流密度比盲孔底高,季铵盐整平剂中的氮原子带正电,可以通过静电作用吸附在测试板表面。咪唑环是五元环六电子结构,苯环是六元环六电子结构,苯环取代基对于咪唑环而言是个吸电子基团。因此,没有取代基的咪唑季铵盐所带正电荷比带苯基的咪唑季铵盐少,电镀过程中对测试板表面的静电吸附也就较弱。苯并咪唑具有稳定的平面结构,其中的咪唑环和苯环共平面,形成一个高度共轭π体系,使得苯并咪唑型季铵盐中平行吸附在铜表面的面积相比于其他苯基咪唑更大。因此,在研究的4种整平剂中,苯并咪唑季铵盐具有最优异的综合整平性能。
3 结论
研究了4种季铵盐整平剂对盲孔电镀铜的影响,以苯并咪唑季铵盐化合物(BIABDGE)的整平能力为最佳,其对盲孔的填充率最高,达到98.91%。

