磁控溅射参数对氧化钨薄膜结晶性的影响
陆文琪, 高可心
(大连理工大学 物理学院,辽宁 大连 116024)
在过去几十年中,由于过渡金属氧化物在自然界中储量丰富,被人们用于各种技术应用研究.其中,氧化钨被广泛应用于气体传感器、电致变色器件、紫外光电探测器(PD)、工业废水处理[1-4]等各种技术领域.
氧化钨因其多重氧化态、着色效率高、稳定性好,是目前研究最多的无机电致变色材料之一.研究表明,氧化钨薄膜的电致变色性能与其结构密切相关,包括几何形状、晶粒尺寸、结晶度等.人们普遍认为,晶体氧化钨薄膜具有显著的循环稳定性,但光调制范围较低;而无定形态下则表现出相反的特征——较大的光调制范围但循环稳定性较差,另外氧化钨非晶态比结晶态[5-8]具有更高的着色效率和更快的转换时间.有报导证明,非晶态的氧化钨和结晶态的氧化钨具有协同效应,以及双相层膜表面粗糙,表现出优异的电致变色性能[9].然而,由于非晶态氧化钨的结构无序和多孔,因此存在如锂离子积累和原子键断裂等与离子多次传输和弯曲柔性有关的结构稳定性的固有问题.
另一方面,氧化钨在化学、机械传感器、选择性催化、电化学工业和环境工程等各方面的应用引起了人们的广泛关注.三氧化钨(WO3)是一种直接带隙较宽 (3.2eV)的n型半导体,具有非常高的化学稳定性和较高的电导率,其晶格具有承受大量氧空位的能力,以及抗高温的能力.研究表明,结晶态的WO3在阳极氧化过程中具有较高的抗溶解化学稳定性[10],可作为一种前景良好的废水处理电极材料.同时,WO3薄膜所具有的光活性的晶体结构使其适合于紫外线(UV)光电探测器(PD)的应用[11-13].此外,WO3薄膜对硫化氢、NOx、三甲胺等有机物等气体具有良好的功能活性,可用于集成传感器,在环境和工业污染监测中获得应用.实际上,WO3纳米晶薄膜已被确定为制备NO2、H2、CO等还原气体的最佳气体传感器之一[11,14-17].
上述氧化钨的各种应用中,氧化钨的结晶状态对其各种特性表现出了显著的影响.因此,研究制备参数对氧化钨薄膜结晶性的影响非常重要.尽管通常通过控制衬底温度能够很容易地获得结晶或非晶状态的氧化钨薄膜,但加热的方法在量产化应用中会带来设备、工艺复杂化,效率降低和成本升高的问题,且在某些应用中(如有机柔性衬底镀膜)难以采用,因此探究低温下氧化钨薄膜的结晶性调控仍然具有重要的实际意义.
在调控沉积薄膜的结晶性方面,Thornton[18]和Messier[19]揭示了除生长温度外沉积粒子能量的重要影响.实际上,Zhang[20]等人利用磁控溅射制备氧化钨薄膜时发现,在80 W的较低功率下制备的氧化钨薄膜为非晶态,而在120 W的较高功率下制备的氧化钨薄膜则具有了一定程度的结晶性.我们理解这是不同功率下沉积粒子能量不同所产生的差异.
本文论述我们利用射频反应磁控溅射制备氧化钨薄膜中,生长温度、溅射功率、气压及氧流量对薄膜结晶性的影响,结果显示,不仅是生长温度和溅射功率,气压和氧流量对氧化钨薄膜的结晶性也有影响.我们的研究结果可以对调控射频反应磁控溅射制备氧化钨薄膜的结晶性提供参考.
1 实验设计
氧化钨薄膜沉积实验在大连理工大学三束材料改性教育部重点实验室自行研制的等离子体增强非平衡磁控溅射系统上进行[21].实验选择单晶 Si(100)作为衬底,依次经丙酮、乙醇和去离子水各10分钟的超声波清洗,以及干燥氮气吹干后置于真空室中;采用直径68.5mm、纯度为99.99%的金属钨作为溅射靶材;靶与衬底的距离固定为6cm.实验过程中首先将真空室的本底真空抽至4.0× 10-3Pa,然后同时通入高纯的氩气和氧气(纯度均为99.99%),并在靶上施加射频(13.56MHz)功率产生放电进行溅射沉积,实验参数如表1所示.

表1 氧化钨薄膜制备实验参数
2 实验结果与讨论
2.1 衬底温度对氧化钨薄膜结晶性的影响
图1是不同衬底温度下沉积的氧化钨薄膜的x射线衍射(XRD)谱.沉积时采用的射频功率为200W、Ar和O2的流量比为30∶50、总气压为1.5Pa.从图1可以看出,较高温度下(400、265)沉积的氧化钨薄膜呈现出(001)择优取向的结晶态,而当温度低于200时沉积的薄膜则为非晶结构.

图1 不同温度下沉积的氧化钨薄膜的XRD谱图2 不同靶功率沉积的氧化钨薄膜的XRD谱
氧化钨薄膜表现出的这种结晶性随衬底温度变化的规律与Thornton提出的结构区域模型(Structure Zone Model)[18]给出的结果是一致的.实际上,Thornton[18]指出薄膜的结晶性受温度与气压的共同影响,其原因是随着气压降低,被溅射下来的靶材粒子在向衬底输运过程中因碰撞而损失的能量减小,从而使沉积能量增大,产生与提高衬底温度同样的效果.根据这个原理,可以期待通过降低气压(减小输运过程中的能量损失)和提高溅射功率(提高溅射粒子的初始能量)在较低衬底温度下获得结晶态的氧化钨薄膜.
2.2 沉积气压和靶功率对氧化钨薄膜结晶性的影响
图2给出了室温条件下采用不同靶功率沉积的氧化钨薄膜的XRD谱,沉积气压为0.5Pa,Ar和O2的流量比为30∶30.从图2可以看出,在0.5Pa的低气压下,不同靶功率溅射沉积的氧化钨薄膜均显示出WO3晶体的(111)和(212)面衍射峰,证明膜层中存在结晶态的氧化钨.对比(111)和(212)面衍射峰强度,可知结晶具有(111)的择优取向,这与高衬底温度下生长的氧化钨薄膜不同(后者为(001)的择优取向,图1).此外,(111)峰显示出随靶功率增大而变强的规律,意味着较高的靶功率有利于薄膜中结晶态氧化钨的形成.
然而,当沉积气压升高到1Pa时,则不能得到(111)择优取向的结构,如图3所示.图3为1Pa沉积气压下两个不同靶功率沉积的氧化钨薄膜的XRD谱, Ar和O2的流量比为30∶30.由图可见,200W靶功率溅射沉积的氧化钨薄膜为非晶态,而300W靶功率溅射沉积的氧化钨薄膜中只显示有一个很小的(212)面衍射峰,显示出沉积气压对于溅射沉积氧化钨薄膜结晶状态的重要影响.
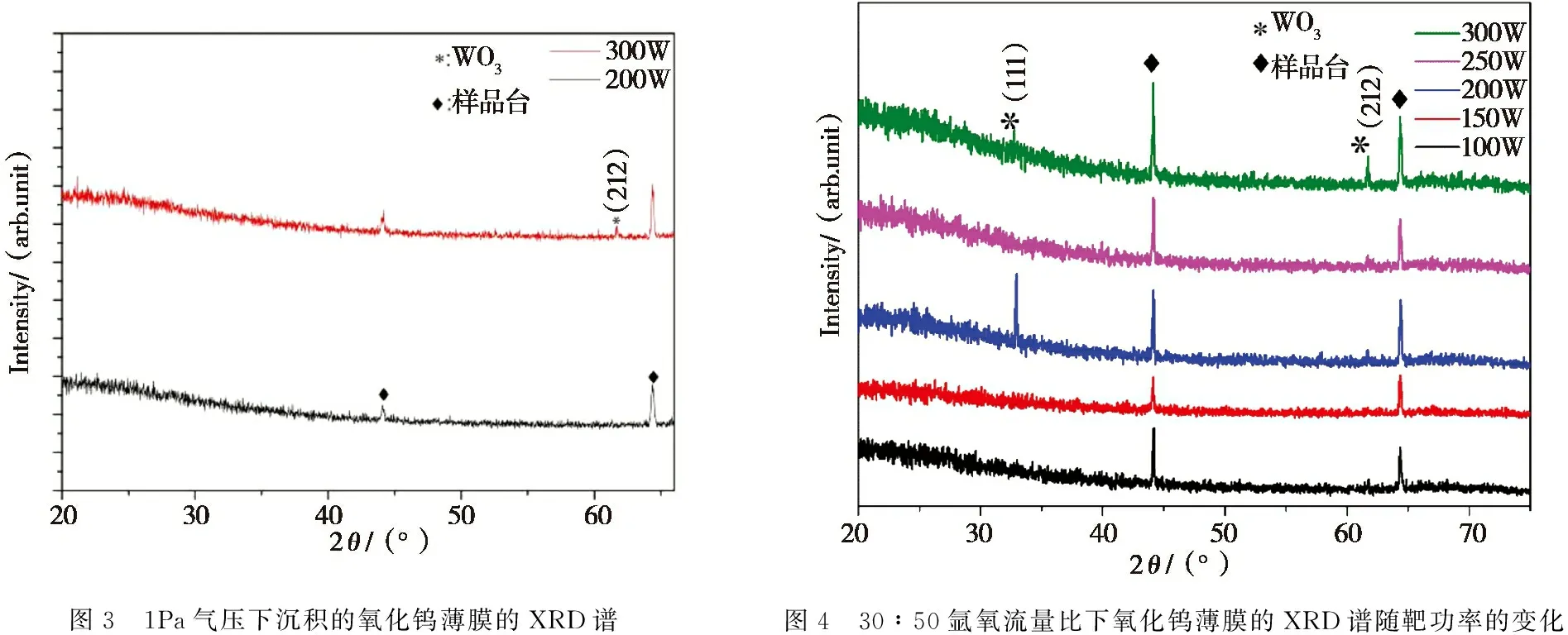
图3 1Pa气压下沉积的氧化钨薄膜的XRD谱图4 30∶50氩氧流量比下氧化钨薄膜的XRD谱随靶功率的变化
室温下沉积薄膜时,由于表面吸附原子迁移率低,往往不易形成结晶态.在这种情况下,如果存在载能粒子对薄膜表面的轰击作用,使表面吸附原子的迁移率提高,则有利于薄膜结晶态的形成[18,19].载能粒子可以来自于靶表面被溅射出的原子和/或被基片表面偏压加速的等离子体中的离子.其中前者要求气压足够低以使被溅射出的靶材原子能够接近无碰撞地输运至薄膜表面.对于我们实验中采用的0.5Pa和1Pa气压,以氩原子直径(0.376nm)估算的平均自由程分别是1.32cm和0.66cm,只有靶基距的约1/5到1/10.因此,溅射出的靶材原子应该不是影响薄膜结晶性的主要因素.另一方面,Messier等发现,基片的悬浮电位对于溅射沉积SiC薄膜结构有显著影响[19].根据Messier等的结果,当气压由1Pa降至0.5Pa时,基片悬浮电位会增大数倍.因此,在我们的实验中,高悬浮电位加速离子对薄膜的轰击是促进结晶态形成的主要因素.
2.3 氩氧流量比对氧化钨薄膜结晶性的影响
图4给出了0.5Pa、30∶50氩氧流量比时不同靶功率沉积的氧化钨薄膜的XRD谱.意外的是,只有靶功率为200 W时出现了(111)衍射峰,显示膜层中存在(111)择优取向的结晶态氧化钨,而较高或较低功率下都没有产生这个结构.这与图2的结果(30∶30氩氧流量比)差别明显,显示出过量的氧对氧化钨薄膜结晶性的显著影响.Messier等提出表面反应存在化学作用对吸附原子迁移率的影响[19].图4的结果可能是这种化学作用影响吸附原子迁移率的表现,其机理有待于后续进一步的研究阐明.
3 结论
我们利用射频磁控溅射制备了氧化钨薄膜,并对实验参数对薄膜结晶性的影响进行了研究.结果发现,升高衬底温度至265以上或室温下降低沉积气压至0.5Pa都可以获得含有结晶态的氧化钨薄膜,但前者为(001)择优取向,后者为(111)择优取向,而室温下当沉积气压在1Pa以上时则不能得到择优生长的氧化钨薄膜.此外,我们还发现氩氧流量比对薄膜的结晶性也有影响.这些结果可以为调控射频磁控溅射制备氧化钨薄膜的结晶性提供参考.

