Ni(W)Si/Si肖特基势垒二极管电学特性研究
王 胜,黄 伟,张树丹,许居衍
(中国电子科技集团公司第58研究所,江苏 无锡 214035)
1 前言
难熔金属硅化物作为接触和局部互连材料有很多优点,例如接触电阻低、薄层电阻小、无电迁徙现象、能够实现自对准结构和承受高温热处理等,因而在深亚微米集成电路中硅化物技术被广泛应用。NiSi由于具有薄层电阻小、应力小、易形成浅结等优点,却没有Ti硅化物的“桥连”现象和线宽效应,也没有CoSi2形成时耗硅多、应力大、漏电大的缺点,因而NiSi能够适应集成电路特征尺寸不断缩小的趋势,成为深亚微米集成电路中最有前景的硅化物之一。然而NiSi存在一个亟待解决的问题,即热稳定性差[1],大于650℃RTP退火后的NiSi薄膜开始结团,750℃就能生成高阻的NiSi2,这将增大薄膜电阻率,并引起器件的漏电流增大。目前在Ni中掺入金属如Pt、Pd[2]等方法来提高NiSi的热稳定性,能够起到不同程度的作用。本文首次提出在Ni中掺入W的方法来提高NiSi的热稳定性,取得了良好效果。
2 实验
在掺As,浓度为1×1019cm-3,晶向<111>,n型硅衬底上生长一层厚为9μm ~10μm掺磷的外延层,外延层浓度5×1015cm-3。常规清洗后将其放入S-Gun磁控反应溅射室内,在本底真空度达到5.2×10-5Pa时,再通入Ar气后,分别溅射15nm Ni/2nm W/15nm Ni夹层结构。随后进行第一次快速热退火(RTA),温度为600℃,时间40s,反应生成Ni(W)Si薄膜。用H2SO4和H2O2煮2min,去除未反应的Ni、W。最后在600℃~950℃范围内对样品进行40s的第二次快速热退火。用四探针法测量Ni/W/Si硅化物薄膜的薄层电阻,采用卢瑟福背散射(RBS)法分析金属W在其中的原子百分含量及其硅化物的厚度,并借助Raman光谱分析方法研究Ni/W硅化物薄膜的相转变。使用HP4156半导体参数测试仪测量肖特基二极管的正反向特性。
3 结果和讨论
3.1 Ni(W)Si薄膜的薄层电阻
用四探针法测量经不同温度快速热退火后的Ni(W)Si薄膜的薄层电阻,结果如图1所示。

由图1可以看出,CapTi/Ni/Si结构经600℃~700℃快速热退火后,该硅化物的薄层电阻为3.0 Ω/□~3.2Ω/□。当快速热退火温度升高到750℃时,薄膜电阻就增大到4.5 Ω/□,这个实验结果已被张慧等人报道[6]。而由夹层结构得到的Ni(W)Si薄膜经受600℃~800℃快速热退火后,薄层电阻比上述NiSi的方块电阻要低,低阻值约为2 Ω/□,此时硅片表面光亮,硅化物颗粒细密而且颗粒分布均匀;而当退火温度上升到850℃时,虽然这时硅片表面仍然光亮,但硅化物表面开始粗糙不平而且硅化物颗粒明显增大并出现结团的迹象,表明NiSi2开始形成。上述实验结果表明掺W的镍硅化物薄膜的热稳定性有了很大的改善,其薄层电阻由低阻转变为高阻的温度提高到800℃以上。
3.2 Ni(W)Si薄膜的卢瑟福背散射(RBS)分析
为了较为准确地了解究竟有多少W参加了硅化反应,采用RBS确定在Ni(W)Si薄膜中W金属的原子含量以及该硅化物厚度。其中15nm Ni/2nm W/15nm Ni/Si在800℃快速热退火后的样品被用来进行RBS分析。图2给出了RBS的实验结果:W在金属中的原子含量为7.3%。Ni(W)Si硅化物厚度约为80nm。

3.3 Ni(W)Si薄膜的Raman 光谱分析
用Raman光谱分析快速热退火后NiSi和Ni(W)Si薄膜中的物相组成。测试的样品是30nm Ni /Si分别经过650℃、750℃、800℃快速热退火后的薄膜,和15nm Ni/2nm W/15nm Ni/Si分别经历650℃、800℃、850℃快速热退火后的样品。然后对它们形成的硅化物样品进行Raman光谱分析测试。Raman光谱分析是在Renishaw1000谱线上进行的,使用的激光的波长是633nm。样品的Raman光谱如图3所示。
对于NiSi样品,图3(a)的拉曼光谱的实验结果表明,对于650℃、750℃快速热退火后的镍硅化物薄膜样品,在215cm-1和195cm-1左右位置附近都能够观测到有很强的Raman 光谱峰,其中215cm-1处是NiSi的峰[3,4]。而在800℃形成的样品中,在215cm-1和195cm-1位置附近并没有出现NiSi的峰,相反在290cm-1、380cm-1位置上已经能够明显地看到有两个很强的高阻NiSi2峰,而这个现象在650℃的样品中并没有发生,说明硅化物已经完全转化成高阻NiSi2。对于Ni(W)Si样品而言,图3(b)的拉曼测试结果表明,经650℃和800℃快速热退火后的镍硅化物薄膜样品,仍然在215cm-1和195cm-1位置发现NiSi的存在,而且峰的强度很大;而850℃快速热退火后的Ni(W)Si薄膜,在上述两位置并没有观测到NiSi这两个峰,相反在232 cm-1、297 cm-1、320 cm-1、402cm-1左右出现了高阻NiSi2峰。由此可见,650℃和800℃退火生成的Ni(W)Si硅化物只有NiSi,而没有NiSi2峰的存在,在850℃退火生成的硅化物成分中,却已能探测到在该薄膜中存在着高阻NiSi2。所以Raman光谱实验也证明了掺W能够延缓NiSi2的形成,将形成NiSi2的温度提高到了800℃以上。

3.4 Ni(W)Si/Si肖特基势垒二极管电学特性
镍硅化物薄膜的热稳定性除了要考察薄层电阻的特性以外,它与硅接触的电学特性在器件和电路的制造中也是非常重要的一个方面。采用的硅片材料为:n+型衬底,n型外延,外延层厚度9μm ~10μm,杂质浓度5×1015cm-3,晶向<111>。器件面积为210μm×210μm,结构为保护环结构肖特基势垒二极管。分别溅射夹层金属15nm Ni/ 1.5nm W /15nm Ni,在600℃进行60s第一次快速热退火,反应生成Ni(W)Si并形成肖特基结。随后用选择腐蚀液去除未反应的Ni、W。然后使其分别在650℃、700℃、750℃、800℃四个温度下进行第二次快速热退火,退火时间40s。为考察Ni(W)Si/Si肖特基二极管的电学特性,使用HP4156B半导体参数分析仪进行了正向和反向I-V特性的测试。
图4比较了650℃、700℃、750℃、800℃四个温度下形成的Ni(W)Si/Si肖特基二极管的I-V正向特性。
由图4可以求得Ni(W)Si/Si肖特基势垒二极管的理想因子和势垒高度,结果如表1所示。
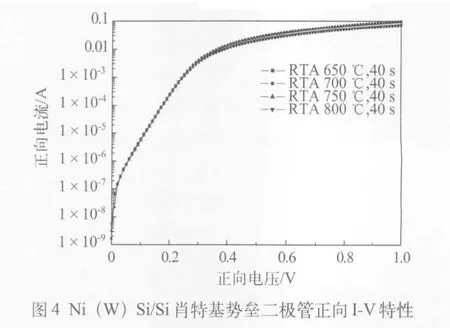
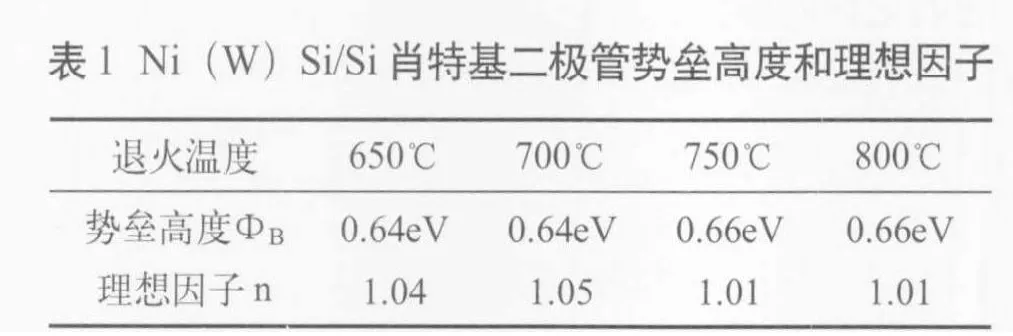
可以看出,经650℃~800℃等不同温度快速热退火的器件势垒高度基本稳定在0.65 eV左右;理想因子在1.00~1.04之间。
图5为Ni(W)Si/Si肖特基势垒二极管经过650℃~800℃快速热退火后的反向I-V特性。
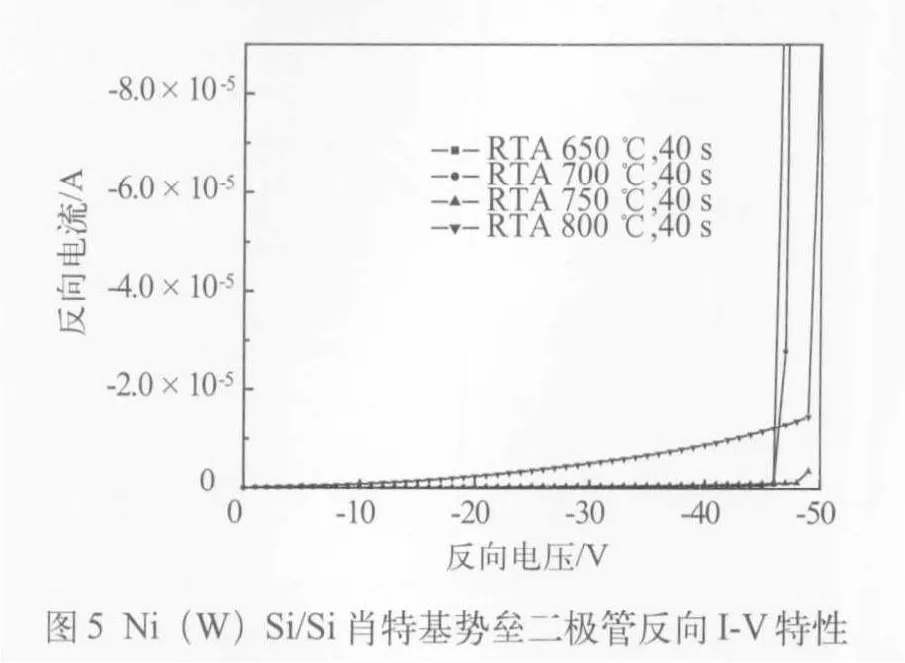
由图5可知,器件经过650℃、700℃、750℃退火后,击穿很硬,击穿电压在45V~49V左右,在击穿点漏电流的量级在1μA左右;器件经过800℃退火后反向击穿特性仍然很好,只是漏电流比700℃、750℃退火的器件稍微大一点,在击穿点漏电流的量级在30μA左右,击穿电压在49V左右,击穿也很硬。而没有掺入W的NiSi形成的NiSi/Si肖特基结能够经受的最高退火温度为650℃,超过这个温度则肖特基结的反向特性很差,漏电非常大,几乎没有结的特性。因此,在金属Ni中掺入一定量的W,对于所形成的镍硅化物的热稳定性以及Ni(W)Si/Si肖特基结的电学特性都有很大的改善作用。
4 结论
首次提出在NiSi薄膜中掺W能够使Ni(W)Si薄膜的热稳定性提高。在600℃~800℃温度范围内快速热退火后薄层电阻低,约为2 Ω/□。Raman光谱分析结果均表明,Ni/W/Ni/Si薄膜经600℃~800℃快速热退火后,形成的Ni(W)Si硅化物中只有NiSi相而不存在NiSi2物相。因此掺7.3%的W能够有效延缓NiSi2的形成,使镍硅化物的薄层电阻由低阻转变为高阻的温度提高到800℃以上,比没有掺W的镍硅化物的转变温度的上限提高了100℃。Ni(W)Si/Si肖特基势垒二极管能够经受650℃~800℃不同温度的快速热退火,肖特基接触特性良好,肖特基势垒高度为0.65eV,理想因子接近于1。因而Ni(W)Si薄膜是一种性能良好的接触和局部互连材料。
[1]E G.Colgan, J P Gambino,B Cunningham. Nickel silicide thermal stability on polycrystalline and single crystalline silicon [J]. Material Chemistry and Physics, 1996.
[2]D Mangelinck, J Y Dai, J S Pan, et al. Enhancement of thermal stability of NiSi film on(100)Si and(111)Si by Pt addition [J]. APPLIED PHYSICS LETTERS, 1999.
[3]P S Lee, K L Pey, D Mangelinck, et al. New Salicidation Technology With Ni(Pt)Alloy for MOSFETs [J]. IEEE ELECTRON DEVICES LETTERS, 2001.
[4]P S Lee, K L Pey, D Mangelinck, et al. Improved NiSi Salicide Process Using Presilicide N2+ Implant for MOSFETs [J].IEEE ELECTRON DEVICES LETTERS, 2000.

