Al2O3薄膜的发光性能及其结构研究
储汉奇,李合琴,聂竹华,都 智,朱景超
(合肥工业大学 材料科学与工程学院,安徽 合肥 230009)
1 引言
Al2O3薄膜具有强度高、耐磨、抗蚀等优异的特性,已经广泛的应用于机械领域,而Al2O3薄膜作为一种宽带隙发光材料,是实现全色平板显示较理想的基质材料,目前其研究方向主要集中在两方面:一是Al2O3薄膜的光致发光光谱(PL)机理研究,通过调整制备过程中的工艺参数获得高质量的紫外发光和高纯度、高亮度的蓝光发射;二是研究掺杂离子对Al2O3薄膜发光性能的影响[1]。到目前为止,关于Al2O3薄膜的发光光源和发光机理仍缺少有力的佐证。Yamamoto等[2]在草酸溶液中用阳极氧化法制得Al2O3薄膜,观察到位于470 nm左右的发射峰,解释为草酸根离子在阳极氧化过程中进入薄膜并充当了发光基团。Du等[3]用纯铝箔分别在草酸和硫酸溶液中制备薄膜,发现草酸中得到的薄膜光致发光强度优于硫酸中制备的薄膜,而且他们还用电子共振顺磁测量数据证明了在薄膜中有F+心(一个氧空位带一个电子)的存在,认为是由氧化铝薄膜中的单离子氧空位充当的发光基团。Xu[4]采用电化学阳极氧化技术在草酸根溶液中制备Al2O3薄膜,得到350~550 nm范围内的蓝色发光,他们认为这个宽的发光带源于单离子氧空位(F+心)和草酸根发光中心共同作用的结果。Al2O3薄膜的制备方法很多,除了上面提到的阳极氧化法,还有溶胶-凝胶法[5](Sol-Gel),等离子化学气相沉积等[6],各种制备技术有其优点,但也存在一定的缺陷。作者采用的直流反应磁控溅射法具有高速、低温的特点而被广泛应用,可制备内应力小且结构致密的Al2O3薄膜[7]。作者通过前期的实验发现氧氩比例对氧化铝薄膜的光致发光性能影响较大,因此将重点探讨氧氩比例对氧化铝薄膜发光性能的影响,以找到最佳的工艺参数,改善其发光性能,结合Al2O3薄膜的发光机理,探索其作为超薄发光器件在未来电子技术中的应用。
2 实验
实验采用直流反应磁控溅射法,溅射靶材为Φ60.0 mm×5.7 mm的高纯Al靶,纯度为99.99%,衬底为单晶硅片,并在实验前置于丙酮、乙醇及去离子水中分别超声清洗15 min后用热风吹干放入溅射室中。当本底真空度优于9.0×10-5Pa时,向溅射腔通入高纯氩气(99.998%),并预溅射20~30 min后再通入纯氧(99.995%),待靶面电流和电压充分稳定后再转开样品挡板进行正式室温溅射。通入的气体流量由D08-3B/ZM型气体质量流量计精确控制,溅射总气压为0.5 Pa,溅射功率为60 W,溅射时间为0.5 h,样品托在溅射过程中转动以提高成膜的均匀性。其他的实验工艺参数见表1所列。
利用FL-4500荧光分光光度计,对薄膜进行室温荧光光谱测试,激发源为氙(Xe)灯,激发波长为370 nm。利用D/Max-γB型X-ray衍射仪(CuKα1,λ=0.15 406 nm)对样品的晶体结构、结晶性能进行分析。

表1 Al2O3薄膜的制备工艺
3 结果分析
3.1 光谱分析
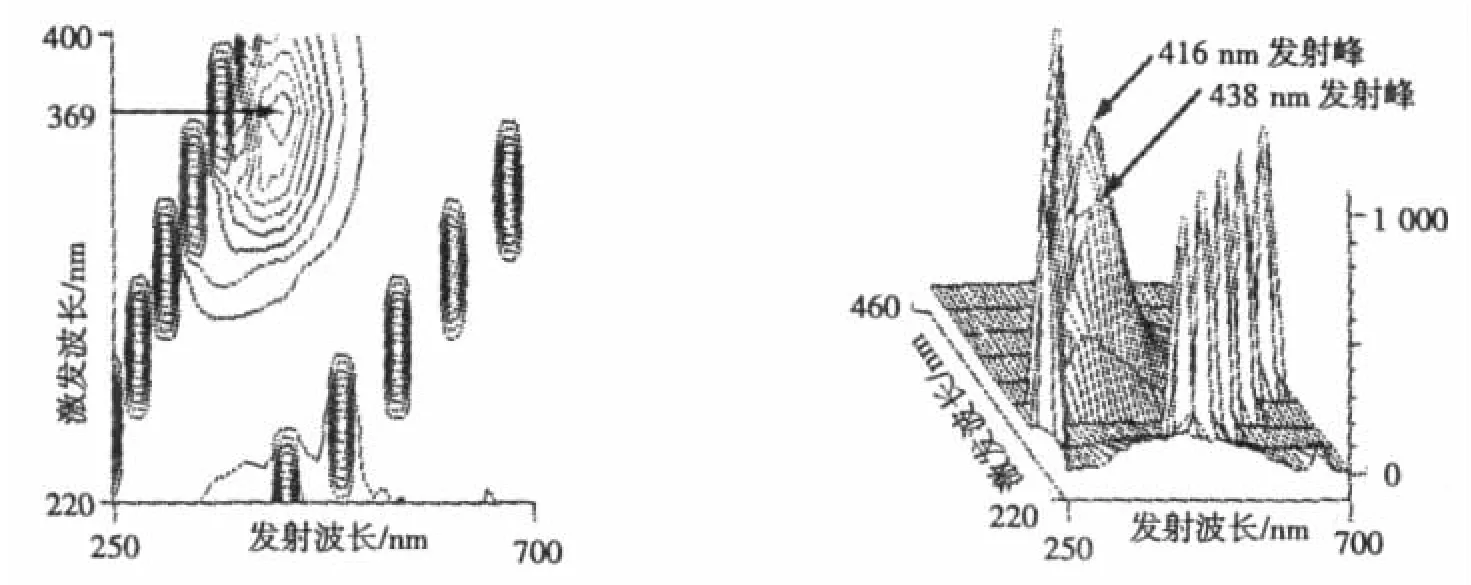
图1 Al2O3薄膜的三维荧光光谱图
首先用F-4500型荧光分光光度计对C样品进行扫描,以得到最佳的激发波长,结果如图1所示。从图1的左图可以看出Al2O3薄膜在369 nm附近有一个最佳的激发波长,在图1的右图则显示在400~450 nm范围有一个较强的发光带。结合实验设备的具体情况以370 nm作为激发波长,对不同氧氩比例的Al2O3薄膜进行测试,得到的结果如图2所示。
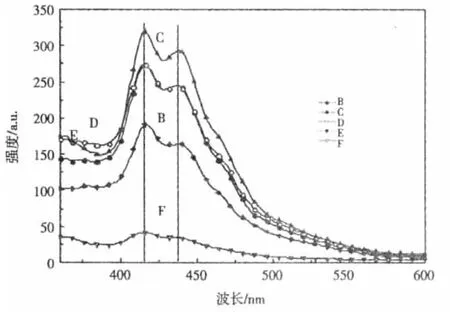
图2 不同氧氩比例下的荧光光谱图
在荧光光谱实验中,A样品的氧氩比为0.5:20,衬底上能有很厚一层银灰色薄膜,经检测主要成分为铝,含少量氧化铝,未测出有发光峰;G样品的氧氩比为3.0:20,其衬底上基本观察不到颜色变化,薄膜相当薄,也未测出发光峰。分析其原因在于制备薄膜过程中,随氧分压的增大,存在一个阈值[8],当氧分压小于阈值时,铝靶的溅射速率远大于氧化速率,为金属铝溅射区,因此,氧氩比为0.5:20时,溅射所得主要为铝膜含少量氧化铝,当氧分压大于阈值时为氧化铝溅射区,且随氧分压的突然上升,这时沉积速率有一突变,由于表面被氧化,结果铝的溅射速率急剧下降,出现靶中毒现象,因此氧氩比为3.0:20时溅射所得的薄膜相当薄,也就观察不到明显的发光峰。
当氧氩比例从0.8:20上升至2.5:20,膜的颜色从紫色向蓝绿色、黄绿色演变,从图2中可以看到在416 nm和438 nm处出现了2个发光峰,在不同的氧氩比例下,峰的位置基本不变,强度先上升后下降。当氧氩比为0.8:20时,峰的强度分别为191和164;随着氧氩比增加到1.0:20时,强度也上升至319和293。但当氧氩比增至1.5:20时,强度变为275和245,开始出现下降,氧氩比为2.0:20时,强度为273和245,基本维持不变;当氧氩比为2.5:20时,强度急剧下降到42和35,此时发光峰很微弱了。由于作者采用的是直流反应磁控溅射法,故氧化铝的发光源排除了Yamamoto等[2]提出的草酸根发光基团,我们就有充分的理由认为应该是F色心(俘获了电子的负离子空位)作为发光中心而引起的发光。Al2O3薄膜产生的色心包括F心(1个氧空位带2个电子)、F+心(1个氧空位带1个电子)、F2+心(2个氧空位带3个电子)、F22+心(2个氧空位带2个电子)和F2心(2个氧空位带4个电子)[9]。
图3即为不同电荷态Al2O3的能级图[10],可以看到,416 nm(3.0 eV)附近的发光峰是由F心所引起的,438 nm(2.75 eV)附近的发光峰是由F2+2引起的。决定峰的强度在于氧空位的浓度[11],而影响氧空位浓度的因素主要有2个:一个是沉积过程中,随氧气流量的改变,造成铝氧比例的失调,引起氧空位浓度变化。另一个是用磁控溅射法在硅衬底上生长薄膜,由于薄膜与衬底之间的应力失配,以及较快的生长速率,薄膜中存在较多的Al间隙原子和氧空位[12],氧氩比例对薄膜生长速率的影响已有人总结过[13],随氧氩比例的上升,沉积速率下降,且在氧氩比例为2.0:20时沉积速率会有一个突变。由上述2种因素共同作用,导致在氧氩比例从0.8:20上升至2.5:20过程中,发光峰的强度呈现出先增大,然后逐渐下降的趋势,且在氧氩比例为1.0:20时强度达到最高。

3.2 结构分析

图4 氧氩比为1.0:20时未退火及不同温度退火的XRD图谱
图4是氧氩比例为1.0:20的样品未退火以及分别在400、600、900、1 100、1 200℃氩气退火所得的XRD图谱。从图中可以看出,未退火时在69.14°处出现了衍射峰,强度为755,400℃退火在33.08°和69.26°处出现2个衬底单晶硅片衍射峰,强度分别为120和156 351,随着退火温度升高,这两处的衍射峰一直存在,且强度也在增大。同时经过400℃退火,在61.8°处开始出现了γ-Al2O3(122)晶面的衍射峰,强度为35,伴随着退火温度升高,此峰始终存在且强度也在逐渐增大,经过1 100℃和1 200℃退火,则在33.5°、43.5°、44.52°、57.84°等处出现了一系列的α-Al2O3衍射峰,尤其经1 100℃退火,在68.80°处出现了α-Al2O3(300)晶面的衍射峰,强度达到12 970,当退火温度达到1 200℃,此峰移至68.94°,强度为13 054。这说明,低温时氧化铝处于无定形态,在400℃以上退火时开始结晶,且随着退火温度的升高,氧化铝的结晶性能越好。
4 结论
(1)实验采用直流反应磁控溅射法成功在单晶硅衬底上制备了Al2O3薄膜,且发现随着氧氩比例的增大,溅射存在一个阈值,低于阈值为金属铝溅射区,大于阈值为Al2O3溅射区,沉积速率随氧氩比例的上升而下降。
(2)通过光致发光光谱分析发现,Al2O3薄膜的发光是由氧空位充当的色心引起的,且随氧氩比例的增加,Al2O3薄膜的氧空位浓度随之变化,薄膜的光致发光峰位基本不变,强度先增大后减小,氧氩比例为1.0:20时强度达到最高。
(3)通过结构分析发现室温沉积的Al2O3薄膜为非晶态,400℃退火开始有结晶出现,且退火温度越高,结晶性能越好。
[1]廖国进,巴德纯,闻立时,等.Al2O3薄膜在发光方面的研究进展[J].材料导报,2006,5:26~29.
[2]YAMAMOTO Y,BABA N,TAJIMA S.Coloured materials and photoluminescence centers in anodic film on aluminium[J].Natur,1981,289(12):572~574.
[3]DU Y,CAI WL,MO C M,et a1.Preparation and photoluminescence ofalumina membranes with ordered pore arrays[J].Appl Phys Lett,1999,74(20):2951~2953.
[4]XUWL,ZHENGMJ,WU S,et al.Effects ofhigh-temperature annealingon structural and optical properties ofhighlyordered porous membranes[J].Appl Phys Lett,2004,85:4364~4366.
[5]王喜娜,敬承斌,赵修建.溶胶-凝胶法制备致密α-Al2O3涂层的研究[J].材料科学与工艺,2005,13(1):1~3.
[6]雷明凯,袁力江,张仲麟.等离子体增强磁控溅射沉积Al2O3薄膜研究[J].无机材料学报,2002,17(4):886~890.
[7]刘永杰,刘忆,董闯,等.Al2O3薄膜的应用和制备[J].真空与低温,2002,8(4):236~239.
[8]廖国进,巴德纯,闻立时,等.中频反应磁控溅射沉积Al2O3薄膜中迟滞回线的研究[J].真空,2007,44(3)32~35.
[9]宋玉峰,朱智勇,孙友梅,等.高能铁离子辐射单晶氧化铝产生的色心研究[J].核技术,2007,2:114~118.
[10]宋银,谢二庆,张崇宏,等.Xe23+离子辐照Al2O3的光谱特性[J].原子能科学技术,2008,9:354~357.
[11]王卿璞,马洪磊,张兴华,等.溅射法制备的ZnO薄膜的光发射[J].山东大学学报,2004,39(2):62~65.
[12]陈汉鸿,吕建国,叶志镇,等.反应磁控溅射ZnO薄膜的高温退火研究[J].真空科学与技术,2002,22(6):467~469.
[13]祁俊路,李合琴.射频磁控反应溅射制备Al2O3薄膜的工艺研究[J].真空与低温,2006,12(2):75~78.

