CdZnTe(211)B衬底对MBE外延碲镉汞材料的影响分析
吴亮亮,侯晓敏,王 丛,王经纬,刘 铭,周立庆
(华北光电技术研究所,北京100015)
1 引言
碲镉汞(HgCdTe,MCT)材料因其组分可调、直接带隙和高量子效率等特点,可实现短波、中波和长波三个“大气透明窗口”红外波段的高性能探测,所以在夜视和引擎探测等军事领域及温度和热探测等民用领域具有重要应用价值[1]。
目前,HgCdTe材料常用的生长方法是外延生长,特别是分子束外延(molecular beam epitaxy,MBE),因其在低温下(185℃左右)生长并且对多层异质结生长可实现精确在线控制,所以MBE方法是生长高性能双色及高温工作HgCdTe的首选外延方法。
对于外延生长,其衬底的性能在很大程度上决定了HgCdTe外延材料的质量[2]。碲锌镉(CdZnTe,CZT)材料和HgCdTe材料具有相同的闪锌矿晶体结构,通过调整Zn 组分(Cd1-xZnxTe中x ≈ 0.04),两者之间能在晶格上实现完全匹配,实现准同质外延;其禁带宽度大于红外波段的光子能量,对红外光完全透明,可实现背入射,为混合集成创造条件;它与HgCdTe材料化学相容、热膨胀系数相近,使得由CZT衬底上外延生长HgCdTe材料制备的红外探测器的抗热循环能力强[3]。
正是由于CZT的上述优点,使得CZT材料在HgCdTe材料外延生长研究伊始就被选为衬底材料,至今仍是制备高性能HgCdTe红外焦平面阵列(infrared focal plane arrays,IR FPAs)探测器不可或缺的衬底材料,特别是对于中长波双色、雪崩型、高温工作型和甚长波等新一代HgCdTe红外焦平面阵列[4]。
本文主要分析了CdZnTe(211)B衬底的Zn组分及均匀性、缺陷(包括穿透位错、孪晶及晶界和碲沉淀)以及表面状态(包括粗糙度和化学组成)等性能参数对分子束外延碲镉汞材料的影响,并且提出了对CdZnTe(211)B衬底进行筛分时各性能参数的评价方法和指标。
2 CZT(211)B衬底制备流程
通过分析CdZnTe(211)B衬底的制备流程,可以更好地了解衬底各项性能参数由哪些制备步骤决定。如图1所示为 CdZnTe(211)B衬底的制备流程。
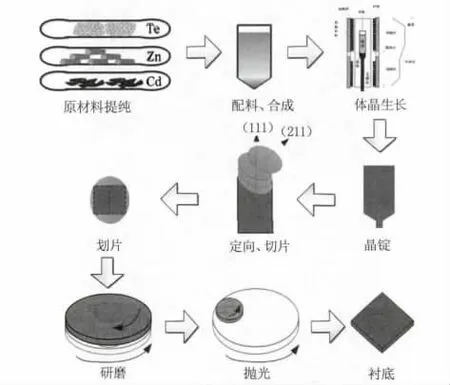
图1 CdZnTe(211)B衬底的制备流程
如图1所示,CdZnTe(211)B衬底的制备流程主要包括原材料提纯、配料、合成、体晶生长、晶锭的定向与切片、划片、研磨、抛光等过程。其中CZT晶体的生长过程(包括原材料提纯、配料、合成及体晶生长)决定了衬底Zn组分及均匀性、缺陷(包括位错、晶界、碲沉淀)等性能参数;而衬底的切磨抛工艺过程决定了衬底的表面状态(包括粗糙度和化学组成)等性能参数。
3 CZT(211)B衬底性能参数分析
3.1 Zn组分及均匀性
所谓Zn组分是指Cd1-xZnxTe晶体中ZnTe所占的摩尔分数,也即是x值,它决定了CZT衬底材料的晶格常数。对于外延生长过程,衬底与外延材料之间晶格匹配是生长高质量外延材料的关键因素。对于中波HgCdTe外延材料,与其晶格匹配的CZT衬底材料的Zn组分x约为0.04。所谓Zn组分的均匀性(Uniformity)是指Zn组分在衬底表面的横向分布。如果HgCdTe外延过程能在晶格匹配的准同质外延的条件下进行,将大大减小因晶格失配而形成的穿透位错和 Cross-hatch等缺陷[5-6],大幅提高外延层质量。
由于CZT材料存在组分分凝现象,其分凝系数约为1.35,使得垂直布里奇曼法生长的CZT晶锭从头部到底部存在组分梯度;同时CZT晶锭的(211)面与(111)面存在19.47°的夹角,所以需要倾斜切割,这将造成衬底面内组分分布不均匀;同时在晶锭横向由于存在温度不均匀等因素,使得横向组分本身不均匀,但相对于纵向的组分不均匀性,其横向组分不均匀较小。
表征Zn组分及其均匀性常用高分辨X射线衍射技术和光致发光(photoluminescence,PL)光谱进行面扫描。CZT晶体表面如果径向方向(中心至边缘4%)存在±1%的组分波动,将引起HgCdTe外延层0.2%的组分波动,同时由于晶格匹配问题导致面内穿透位错密度的变化,使得在长波或者甚长波FPAs出现大的响应率波动[6],所以希望Zn组分面分布均匀,其变化范围在±1%以内,也即x值为0.04 ±0.004。
3.2 缺陷
3.2.1 位错
这里所指的位错是指穿透位错,由于CZT衬底表面的穿透位错容易延伸进入HgCdTe外延材料,形成HgCdTe外延材料中的位错,它会降低少子寿命、增加噪声和暗电流,最终影响焦平面器件的响应率均匀性及盲元率。位错可通过透射电镜和腐蚀的方法被观察到,但是透射电镜(transmission electron microscope,TEM)因成本太高和视场太小,无法作为常规的检测手段。化学腐蚀法是最简单实用的方法,它通过腐蚀衬底表面,形成腐蚀坑,习惯上腐蚀坑对应穿透位错,将腐蚀坑密度(etch pit density,EPD)作为穿透位错的表征参数。实际上腐蚀坑密度对应的缺陷还与材料中的沉淀物或微沉淀物有关[4]。
高质量的CZT衬底材料的EPD为5×104cm-2左右,最好的可低至103cm-2量级。虽然EPD可直观显示这类缺陷,但是它是一种破坏性的测试方法。日本Nippo公司研究发现衬底的EPD与衬底的X射线衍射(XRD)峰的半高宽(full width at half maximum,FWHM)有很强的对应关系,X射线衍射峰的展宽主要由位错决定[7],所以可以用FWHM的大小间接表征位错密度多少,而且它是一种非破坏性的测试方法。市场上能够购买到的CZT衬底的XRD面扫描的FWHM一般低于15 arcsec。
3.2.2 晶界
晶界是指两个晶向不同的晶粒之间的界面。小角晶界是指由周期性竖直排列的刃形位错,或者由两组周期性排列的交叉的螺形位错组成的晶界;由小角晶界构成的晶粒也称孪晶,所以小角晶界也可称为孪晶界。大角晶界的两侧原子没有共格关系,一般也就是两个晶粒之间的晶面[4]。晶界是其他缺陷赖以存在的基础,如碲沉淀沿晶界分布,位错腐蚀坑排列成行是小角晶界,晶界引起的沟道效应和漏电流影响器件的性能[8]。晶体生长过程中生长界面的形状及温度波动都可能导致晶界的产生。
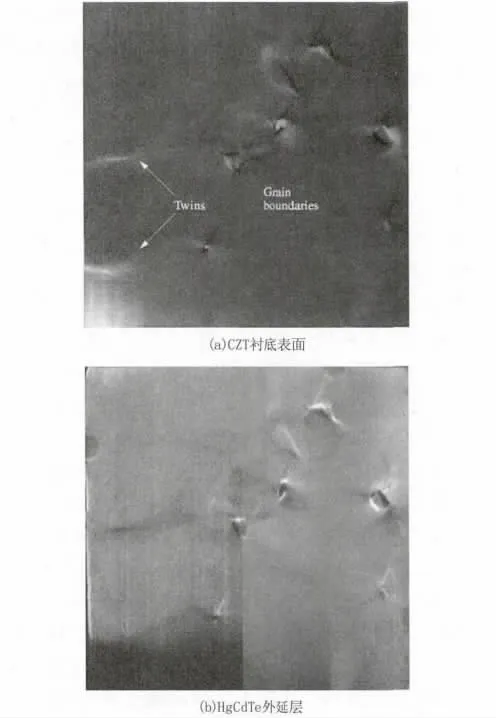
图2 CZT衬底表面的晶界对HgCdTe外延层中缺陷的影响[5,6]
CZT衬底表面的孪晶界等晶界将直接从衬底表面延伸至HgCdTe外延层中,如图2所示为CZT衬底表面的晶界对HgCdTe外延层中缺陷的影响[5,6]。X射线形貌像(X-ray topography,XRT)反应晶格完整性的均匀性,因为晶界两边是两个晶向不同的晶粒,所以XRT可以观察晶界。因为晶界严重影响HgCdTe外延材料的质量,所以衬底中应不存在孪晶和晶界,对应的XRT照片应为灰度均匀的图像。
3.2.3 碲沉淀
碲沉淀是CZT材料中常见的一种体缺陷。当偏离化学计量比的CZT晶体从高温快速降温时,会出现过饱和析出。碲沉淀会在后续磨抛光工艺中会形成表面空洞(void)等缺陷,而这类缺陷将严重影响HgCdTe外延层的结晶质量;裸露在衬底表面及亚表面的沉淀物缺陷将会延伸到碲镉汞外延材料中,形成尺寸较大,且能直接观察到的表面缺陷,它是碲镉汞外延材料表面缺陷的主要来源[4];同时碲沉淀过多会降低其红外透过率。所以应该尽量降低碲沉淀的尺寸和数量,通过降温工艺的改进可降低甚至消除碲沉淀,如图3所示为不同退火工艺后CZT材料中碲沉淀的红外透射显微镜图[9]。
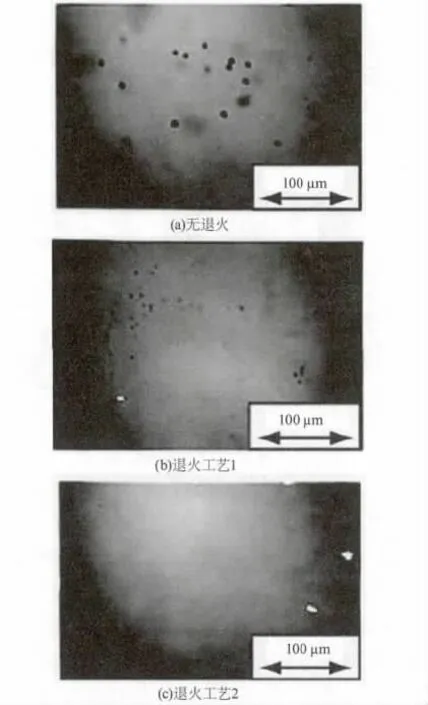
图3 不同退火工艺后CZT材料中碲沉淀的红外透射显微镜图[9]
表征碲沉淀最直接的方法是红外透射显微镜(Infrared transmission microscopy,IRTM)观察,如图3所示。红外透射显微镜可直接检测不同深度碲沉淀的大小和尺寸。一般而言碲沉淀的数量在103~105cm-3,尺寸大小不一,最好的衬底可以做到如图3(c)所示接近无碲沉淀。由于碲沉淀过多会降低其红外透过率,所以红外透过率测量是表征碲沉淀的一种间接方法。正常情况下,性能良好的CZT衬底的红外透过率为63%左右,截止边陡峭。同时载流子浓度也会影响红外透过率,如果载流子浓度过大,其红外透过率曲线在长波长(小波数)位置会出现截止吸收,而且载流子浓度过大其红外吸收越大[7]。
3.3 表面状态
3.3.1 粗糙度
表面粗糙度用规定面积内材料表面与基准面(各表面点到基准面距离的算术平均值为零)之间距离的标准均方差(root mean square,RMS)来度量,是衡量材料微区高低起伏的参数。衬底抛光工艺或者后续的湿化学处理工艺都会决定表面的粗糙度。粗糙度可以通过原子力显微镜(atomic force microscopy,AFM)和白光干涉表面轮廓仪(surface profiler)来表征,其中AFM对微区进行精确形貌测量,而表面轮廓仪不但可以对微区测量,还能对整片衬底进行测量。椭偏仪(spectroscopic ellipsometry,SE)是一种可以在线(In-situ)测量表面粗糙度的方法[5]。反射式高能电子衍射(reflection high energy electron diffraction,RHEED)也可用来间接表征表面粗糙度,可通过不同的衍射图样反映表面粗糙度的大小,如图4所示[6]。
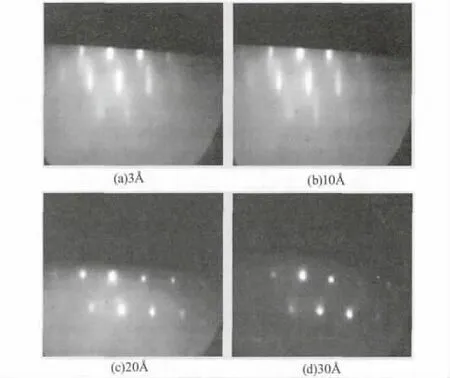
图4 CZT衬底的RHEED衍射图样与表面粗糙度(通过SE测量)的关系[6]
衬底表面粗糙度越小,RHEED衍射图样越呈长条纹状,反之,粗糙度越大越呈三维圆点状。
HgCdTe外延层的表面粗糙度与CZT衬底的表面粗糙度有很强的对应关系,前者粗糙度大于等于后者粗糙度。而如果HgCdTe外延层的表面粗糙度较高,将会影响后续的器件工艺成败。当CZT衬底的表面粗糙度达到10 nm时,将会在外延生长过程中阻碍原子在表面的迁移,从而导致三维生长和差的晶体质量;当达到中等粗糙度(>1 nm)时,外延生长的初始阶段将为三维生长,外延层表面粗糙度增加。而且,在粗糙的 CZT衬底表面生长的HgCdTe外延层表面将形成高密度的针状缺陷(Needle defect),但是通过生长CdTe缓冲层可降低甚至消除针状缺陷[5-6]。
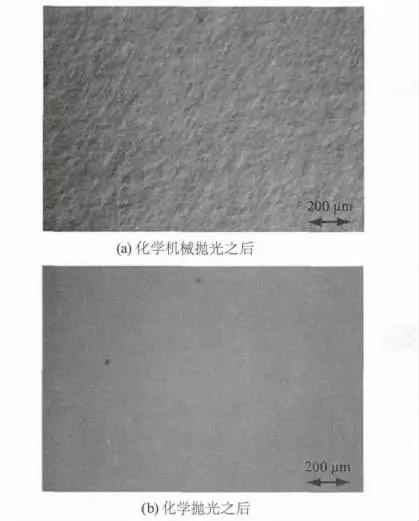
图5 CZT衬底表面的Nomarski显微照片[7]
值得一提的是日本Nippo公司研制了一种独特的腐蚀液,使得经过该腐蚀液化学抛光之后衬底表面光滑,如图5所示为CZT衬底表面的Nomarski显微照片。有的研究小组使用碘基腐蚀液,也可获得良好抛光效果[9-10]。
综上所述,要获得高质量的HgCdTe外延层,CZT 衬底表面粗糙度应小于 1 nm[11-12]。
3.3.2 化学组成
CZT衬底晶片通常会存在表面损伤层及1.5 ML 左右的表面沾污(氧、碳、氯等)[13],通常在进入MBE生长腔室之前需要进行湿化学处理,但是通常使用的0.5%的溴甲醇腐蚀液会使衬底表面形成非晶态的富碲层和碳残留,需要在衬底进入MBE生长腔室之后加热衬底至300~340℃进行高温去除富碲层、氧及碳沾污[6]。即使通过湿化学和高温退火过程,衬底表面依然会残留大约0.25 ML的碳以及过量Te或者Zn[13]。如果非晶态的富碲层未能完全去除干净,将导致HgCdTe材料外延过程为三维生长以及形成微孪晶(Microtwinning),如果衬底表面还存在碳残留,将会降低HgCdTe外延层的电学性能。即使是利用等离子体清洗处理衬底表面,虽然能够获得无沾污和粗糙度为0.4 nm的表面,其外延的HgCdTe的质量也并未出现明显的提升(比通常的湿化学 + 高温退火处理工艺)[13,14]。
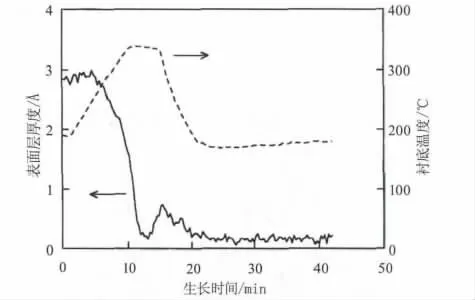
图6 CdZnTe衬底脱氧过程中表面层厚度变化的测量结果[15]
衬底表面化学组成的表征方法有X射线光电子能谱(X-ray photoelectron spectroscopy,XPS)和俄歇电子能谱(auger electron spectroscopy,AES)。XPS也称为化学分析电子谱(electron spectroscopy for chemical analysis,ESCA),可用于检测材料表面层的结构和成分,经常用来测定表面氧化层的结构和成分,它不但可以测量表面层化学组成,而且可分析其化学态。而AES只能测量化学组成,但其空间分辨率比 XPS(10 μm以上)大,可达15 nm。主要测量表面中C、O、Te、Cd等的含量。如果将XPS等设备与分子束外延设备组合,可检测高温脱氧之后衬底表面化学组成。希望高温脱氧过程之后能完全去除富碲层及沾污,氧化物层厚度尽量小(0.25 ML以下)。利用SE可在线测量高温脱氧过程中氧化层的厚度[4,15-16],如图6所示为CdZnTe衬底脱氧过程中表面层厚度变化的SE 测量结果[15]。
虽然可以在衬底制备完成之后立即清洗和真空密封包装,但是衬底表面依然存在沾污和氧化问题,无法实现即开即用(Epi-ready),所以通常在衬底进入MBE生长腔室之前会对其进行湿化学处理,也即是清洗和抛光性质的腐蚀,其腐蚀液与化学抛光过程中的腐蚀液相同,以达到去除表面损伤层、沾污和氧化层的目的。但是常用的溴甲醇腐蚀液会使得衬底表面形成非晶态的富碲层和碳残留,所以衬底表面状态还应关注湿化学处理之后表面粗糙度和表面化学组成等性能参数。
4 结论
本文主要分析了衬底各性能参数对其上分子束外延HgCdTe材料性能的影响,以及衬底各性能参数的表征方法及评价指标。
Zn组分及均匀性将影响与HgCdTe外延材料的晶格匹配及均匀性,将严重影响HgCdTe外延材料的结晶质量,所以Zn组分及均匀性应控制在0.04±0.004以内;缺陷(包括位错、晶界和碲沉淀)很可能在外延过程中延伸进入HgCdTe外延层中,增加HgCdTe外延材料的缺陷密度,所以缺陷应控制在一定范围以内,包括位错腐蚀坑密度应控制在104cm-2量级以及FWHM ≤15 arcsec,碲沉淀及表面缺陷等体缺陷应尽量减少甚至消除,晶界不应存在。
衬底表面粗糙度过高将导致外延生长模式成为三维生长,缺陷增多,降低外延层质量,同时影响后续倒装互联工艺,所以CZT衬底表面粗糙度应控制在1 nm以内;衬底表面氧化层及各种沾污的存在将影响外延生长模式,降低外延层材料质量,应完全去除表面C和富碲层等,尽量减少氧化层厚度。
总之,CZT衬底材料和表面质量将影响HgCdTe外延材料的质量,同时还可能影响后续器件工艺的成败,不但要控制衬底各性能参数在预设范围之内,还应控制不同衬底间各性能参数的波动幅度,因为稳定的衬底性能将有利于提高分子束外延HgCdTe材料质量的一致性,乃至FPAs性能的一致性。
[1] Gong Feng,Zhou Liqing,et al.Research on growth and properties of CdZnTe single crystal[J].Laser & Infrared,2004,34(5):362-363.(in Chinese)巩锋,周立庆,等.优质碲锌镉单晶的生长及性能测试[J].激光与红外,2004,34(5):362-363.
[2] Triboulet,R Tromson-Carli.A Substrate issues for the growth of mercury cadmium telluride[J].Journal of Electronic Materials,1993,22(8):827-834.
[3] Zhou Liqing.The status and development of substrates for HgCdTe epilayer[J].Laser & Infrared,2005,35(11):808-811.(in Chinese)周立庆.碲镉汞外延用衬底材料的现状与发展.激光与红外,2005,35(11):808-811.
[4] Yang Jianrong.Physics and technology of HgCdTe materials[M].Beijing:National Defense Industry Press,2012.(in Chinese)杨建荣.碲镉汞材料物理与技术[M].北京:国防工业出版社,2012.
[5] Capper P,Garland J.Mercury cadmium telluride growth,properties and applications[M].John Wiley & Sons,Ltd,2011,Chapter 4.
[6] Dhanaraj G.Springer handbook of crystal growth[M].Berlin:Springer-Verlag,2010.
[7] Capper P,Garland J.Mercury cadmium telluride growth,properties and applications[M].NewYork:John Wiley &Sons,Inc.2011.
[8] Liu Keyue,Wang Jinyi,et al.Preparation of CdZnTe substrate used in HgCdTe epitaxy[J].Semiconductor Technolog,2000,25(2):38-42.(in Chinese)刘克岳,王金义,等.HgCdTe外延用的CdZnTe衬底研制.半导体技术,2000,25(2):38-42.
[9] Ivanits’ka V G,Moravec P,et al.Chemical polishing of CdTe and CdZnTe in Iodine-methanol etching solutions[J].Journal of Electronic Materials,2006,40(8):1802-1808.
[10] Ivanits’ka V G,Moravec P,et al.Chemical etching of CdTe in aqueous solutions of H2O2-HI-citric acid[J].JournalofElectronic Materials,2007,36(8):1021-1024.
[11] Moravec P,Hoschl P,et al.Chemical polishing of CdZnTe substrates fabricated from crystals grown by the verticalgradient freezing method[J].Journal of Electronic Materials,2006,35(6):1206-1213.
[12] Singh R,Velicu S,et al.Molecular beam epitaxy growth of high-quality HgCdTe LWIR layers on polished and repolished CdZnTe substrates[J].Journal of Electronic Materials,2005,34(6):885-890.
[13] Johnson J N,Almeida L A,et al.Use of electron cyclotron resonance plasmas to prepare CdZnTe(211)B substrates for HgCdTe molecular beam epitaxy[J].Journal of Electronic Materials,1999,28(6):817-820.
[14] Johnson J N,Almeida L A,et al.Electron cyclotron resonance plasma preparation of CdZnTe(211)B surfaces for HgCdTe molecular beam epitaxy[J].Journal of Electronic Materials,1998,27(6):657-660.
[15] Benson J D,Cornfeld A B,et al.Eilipsometric analysis of CdZnTe preparation for HgCdTe MBE growth[J].Journal of Crystal Growth,1997,175/176:659-664.
[16]Henini M,Razeghi M.Handbook of Infrared Detection Technologies[M].Oxford:Elsevier,2002.

