楔形瓣状结构对正向注入型Si-LED发光特性的影响
崔 猛, 谢 生, 毛陆虹, 郭维廉, 张世林, 武 雷, 谢 荣
(天津大学 电子信息工程学院, 天津 300072)
楔形瓣状结构对正向注入型Si-LED发光特性的影响
崔 猛, 谢 生*, 毛陆虹, 郭维廉, 张世林, 武 雷, 谢 荣
(天津大学 电子信息工程学院, 天津 300072)
基于标准CMOS工艺的p+源/漏区和n阱,设计了两种楔形瓣状结构的正向注入型硅基发光二极管(Si-LED),采用UMC 0.18 μm 1P6M CMOS工艺设计制备。测试结果表明,正向注入型p+/n-well二极管的发射波长位于近红外波段,峰值波长在1 130 nm附近,且工作电压小于2 V,与标准CMOS电路兼容。其中,八瓣结构的Si-LED (TS2)在200 mA时的发光功率可达1 200 nW,且未出现饱和,而注入电流为40 mA时的最大功率转换效率达5.8×10-6,约为四瓣结构器件(TS1)的2倍。所研制的Si-LED具有工作电压低、转换效率高等优点,有望在光互连领域得到应用。
硅基发光二极管; 正向注入; 楔形结构; 标准CMOS工艺
1 引 言
随着集成电路的特征尺寸降低到90 nm以下,传统硅基芯片的信号延迟、串扰和功耗等问题变得越来越突出。因此,以成熟的硅基微电子平台为基础,将光子作为集成电路中信息传输的载体,在同一芯片上集成电路和光路的光互连系统成为研究热点[1-2]。然而,硅为间接带隙半导体,其辐射复合发光效率极低[3]。因此,如何基于标准CMOS工艺,研制低工作电压、高转换效率的硅基发光器件是解决硅基光互连的关键因素。
目前,基于标准CMOS工艺的硅基发光器件多采用反向击穿发光机制。Snyman等[4]最早采用MOS器件的源/漏接触区,设计了pn+结发光二极管(LED),并利用注入少子在耗尽区内的齐纳击穿发射光子。随后又基于注入雪崩效应,设计出高效的楔形Si-LED[5-6],将电光转换效率提高了一个数量级。杨广华等[7]利用n阱和p型衬底构建了条形叉指状的Si-LED。董赞等[8]利用重掺杂的源/漏区在n阱内制备出锯齿结构的Si-LED阵列。然而,这些发光器件都需要反向偏置在5 V以上,难以与标准CMOS电路的电源电压兼容。此外,受反向注入电流的限制,基于反向击穿机制Si-LED的发光功率仅为数纳瓦,难以真正实用化。
为了解决上述问题,Lee Hsiu-Chih等[9-10]提出一种正向注入发光的Si-LED器件,将发光功率提高到100 nW以上,而工作电压仅为1.2 V。本课题组在以前研究的基础上,研制出多种正向注入的楔形Si-LED单元[11-12]和器件阵列,将发光功率提高到微瓦量级。为了研究楔形结构对器件发光特性的影响,本文利用标准CMOS工艺设计了四瓣(TS1)和八瓣(TS2)两种结构的Si-LED器件。测试结果表明,楔形八瓣结构(TS2)具有更高的发光功率和光电转换效率。
2 实 验
基于UMC 0.18 μm 1P6M CMOS工艺图层,我们利用MOSFET的p+源/漏区和n阱,构建了如图1(a)所示的p+/n-well发光二极管。当正向注入载流子到达结区附近时,通过声子辅助或杂质能级辅助辐射复合发光。为了比较瓣状结构对发光性能的影响,我们设计了四瓣和八瓣两种结构的发光器件,且两种器件的阱区面积均为44 μm×44 μm。为了提高注入电流密度,增加电子-空穴复合几率,我们基于Snyman等[6]提出的楔形结构,设计了如图1(b)所示的四瓣测试结构TS1。其中,左右镜像对称的p+掺杂区与n阱形成p+n结发光二极管,而上下对称的n+掺杂区作为n阱接触,p+区和n+区的间距为4 μm,楔形尖端的夹角为90°。
为了增大发光区面积和楔形尖端电流密度,我们还设计了如图1(c)所示的八瓣测试结构TS2。相比于器件TS1,TS2的发光区面积近似增大了1.6倍。由于楔形尖端的电荷密度随表面曲率的增大而增大,所以TS2中的45°楔形尖端比90°尖端具有更大的曲率变化,有利于提高发光功率和光电转换效率。
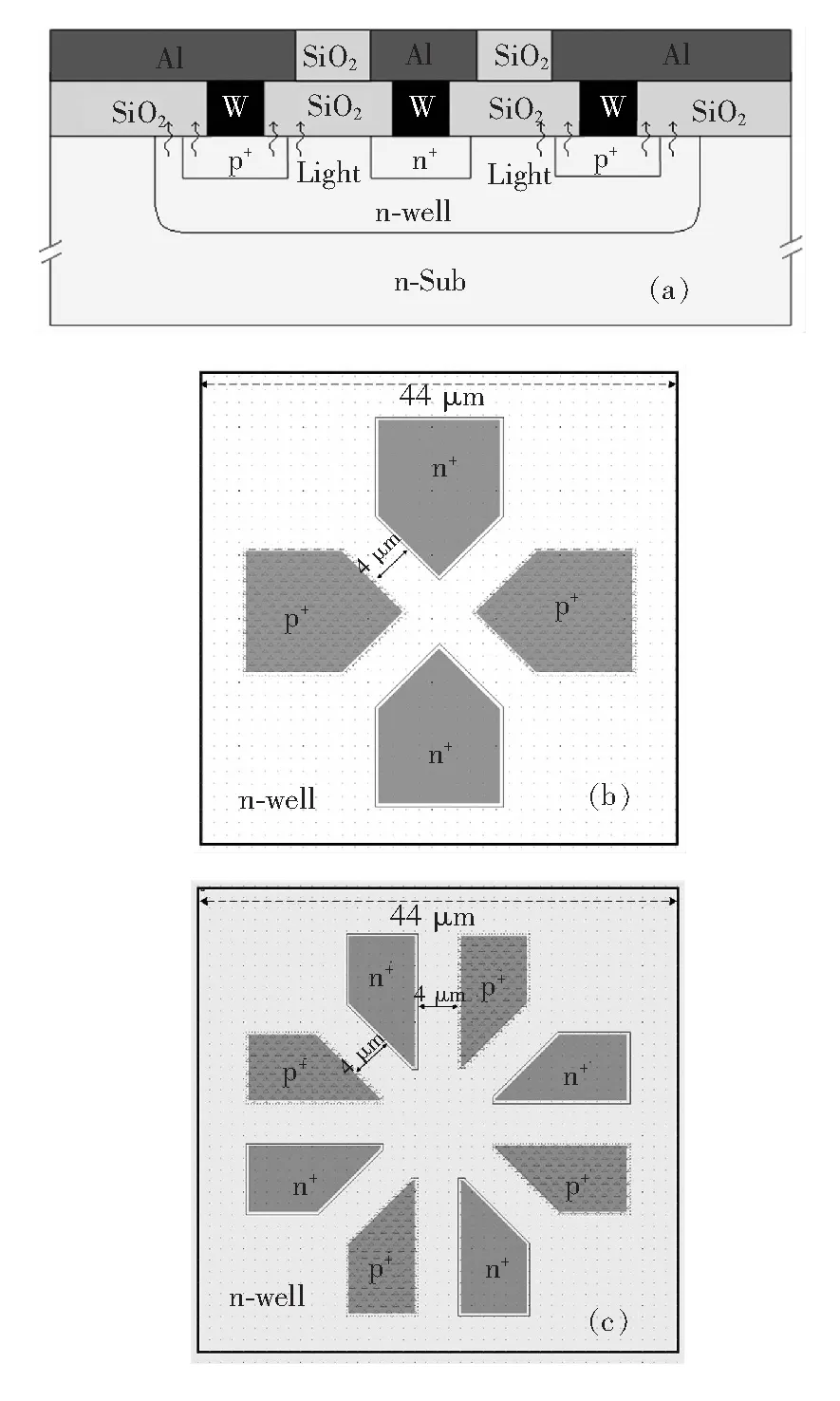
图1 (a) p+/n-well发光二极管的结构示意图;(b) 传统楔形Si-LED (TS1)的示意图;(c) 八瓣楔形Si-LED (TS2)的示意图
Fig.1 (a) Structure diagram of p+/n-well LED. (b) Schematic of Si-LED with conventional wedged configuration (TS1). (c) Schematic of Si-LED with eight-petal configuration (TS2).
在完成前道制备工艺后,利用金属互连工艺中的Metal 1和Metal 2分别将p+区和n+区电连接在一起,形成发光器件的正、负电极。为了降低上层金属对发射光子的吸收和反射,发光区域上方未布置任何金属层。图2给出了MITUTOYO FS-70显微镜拍摄的实际器件的显微照片。

图2 器件TS1 (a)和TS2 (b)的显微照片
Fig.2 Micrograph of Si-LEDs with four-petal (a) and eight-petal configuration (b)
3 结果与讨论
3.1 电学特性
Si-LED的电学特性采用Keithley 4200-SCS测试。由于器件TS1和TS2的二极管结构相同,所以二者的电学特性也相同。图3给出了p+/n-well二极管的典型I-V特性曲线,其中的插图给出了对数坐标表示的器件TS1和TS2的正向电流-电压关系。由图可见,正向导通电压约为0.9 V,反向击穿电压在8 V@1 mA附近。结果表明,器件TS2并未因大的表面曲率而过早击穿。由于n-well掺杂浓度通常比p型衬底高一个数量级,所以反向击穿电压略低于n+/p-sub二极管[11]。
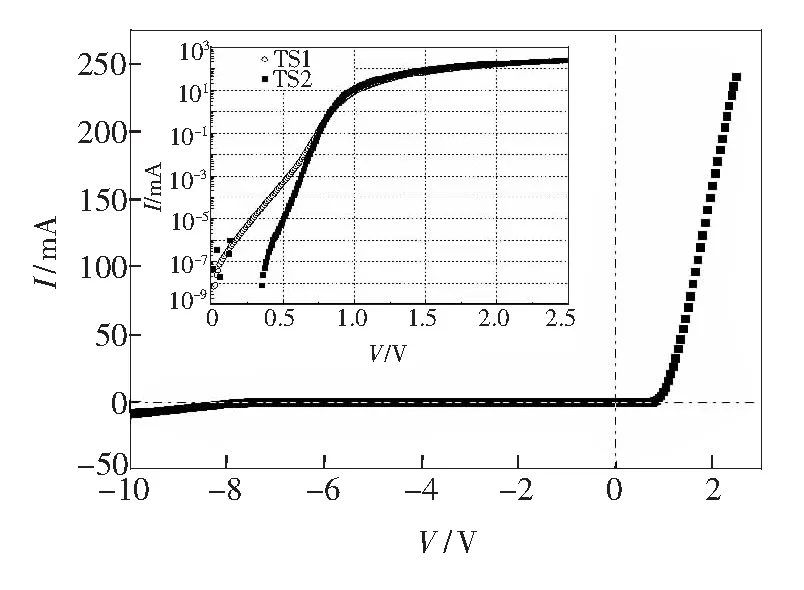
图3 p+/n-well二极管的典型I-V特性曲线
3.2 光学特性
Si-LED的发射光谱利用Horiba LabRAM HR800微区PL谱测试系统测量,采用Thorlabs PM100D光功率计和S132C Ge探测器记录器件在不同注入电流时的光功率。其中,Ge探测器的接收孔径尺寸为Φ9.5 mm,接收波长设定为光谱响应的峰值波长,即1 130 nm。
图4所示为正向注入电流为40 mA时,两种器件在室温下的发射光谱。与反向击穿发射可见光不同[4-8],正向注入型Si-LED的发光波长位于近红外波段,且发射谱较宽,峰值波长在1 130 nm附近。另外,1 030 nm附近存在一个小肩峰。这与已报道的正向注入型Si-LED的发光谱完全一致[9-12]。与1 130 nm发光峰相对应的光子能量(E=1.1 eV)略小于Si的带隙能,其发光机制可能与声子参与的带间跃迁[5,8]、硼离子在带边形成浅能级缺陷[13]或者Si/SiO2界面陷阱[9]引入的辐射复合有关。而1 030 nm附近的肩峰则可能是声子参与的带间跃迁引起的。
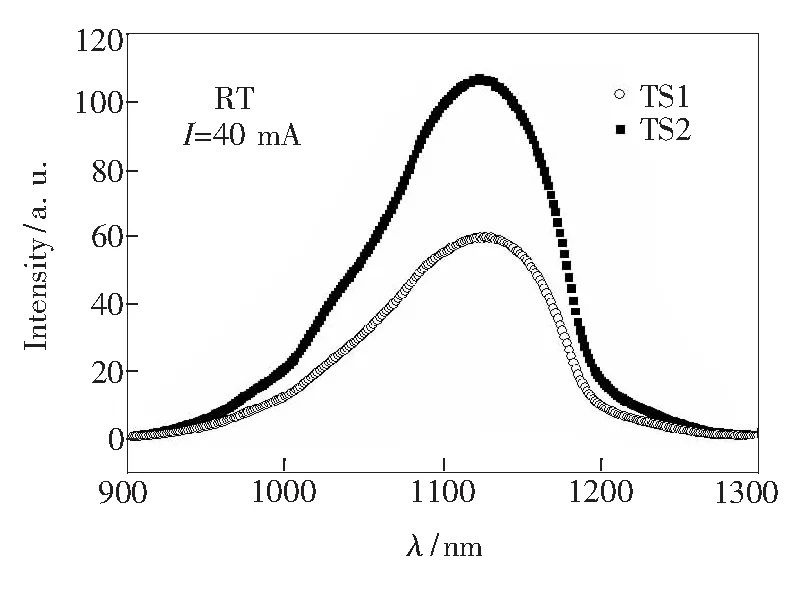
图4 正向注入时器件的发射光谱
为了有效分析器件TS1和TS2中p+/n-well结的发光性能,应将两种结构在相同正向注入电流密度下的发光强度和发光效率进行对比。定义正向注入电流密度为正向注入电流与p+区电极面积之比。由于器件TS1和TS2的p+区电极面积均为144 μm2,因此以注入电流和以注入电流密度为基准是等价的。本文采用相同正向注入电流下TS1和TS2的发光强度和发光效率的对比进行分析。
器件TS1和TS2的发光功率与注入电流的关系曲线如图5所示。当注入电流较小时,两种器件的发光功率均随注入电流的增加而近似线性增长。当注入电流超过100 mA后,光功率与注入电流的关系偏离线性。当注入电流为200 mA时,器件TS1和TS2的发光功率分别为900 nW和1 200 nW,且未达到饱和。当发光功率从100 nW增加到1 000 nW时,器件TS1的正偏电压增量约为1.1 V,而TS2的仅为0.7 V。由此可见,器件TS2不仅工作电压低,而且具有更高的转换效率。
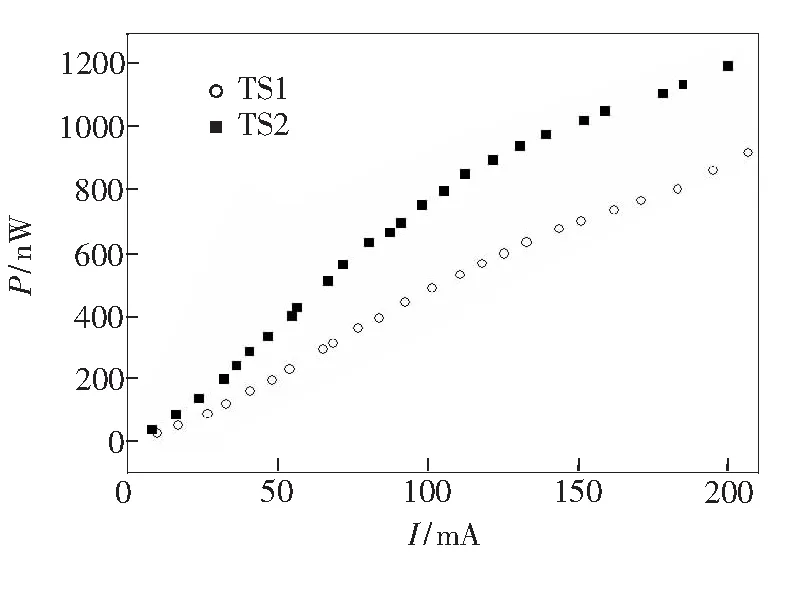
图5 不同器件结构的光功率特性
为了更准确地描述器件的发光性能,本文采用功率转换效率ηp表征器件的发光效率。其中,ηp定义为输出光功率与输入电功率之比。图6所示为功率转换效率ηp与注入电流的关系曲线。由图可见,两种器件的转换效率具有相同的变化趋势。器件TS1在100 mA以下的功率转换效率约为3×10-6,随着注入电流的进一步增大,转换效率单调下降。器件TS2的效率转折点出现在50 mA附近,最大转换效率达5.8×10-6,高于目前报道的功率转换效率[9,11-12]。超过转折电流后的效率下降可能与结温有关。大注入电流引入更多的热耗散,从而使结温升高,发光效率降低,这与温度对发光效率的影响是一致的[13]。
参考B+注入型Si-LED的发光机理[14-15],我们认为红外发光区在p+/n-well结区附近。由于器件TS2设计为八瓣结构,其发光区域约为TS1器件的1.6倍,若假设单位长度的发光功率相同,则TS2的发光功率必定高于TS1。由于器件TS2采用45°楔形尖端,比TS1具有更大的曲率变化,表面电荷密度随表面曲率的增大而增大,导致电场强度增强[12],因而更有利于提高发光强度。结合图6,可以看到在40~50 mA电流区域,器件TS1和TS2发光效率相差1.9倍左右,而200 mA电流时的发光效率比约为1.5,这说明两种结构发光性能的差异并不是由发光面积决定的。另外,文献[9]采用大面积的环形正向注入,但其发光功率和转换效率不及本文结果。因此,我们更倾向于是楔形尖端提高了转换效率,具体原因仍在进一步研究中。
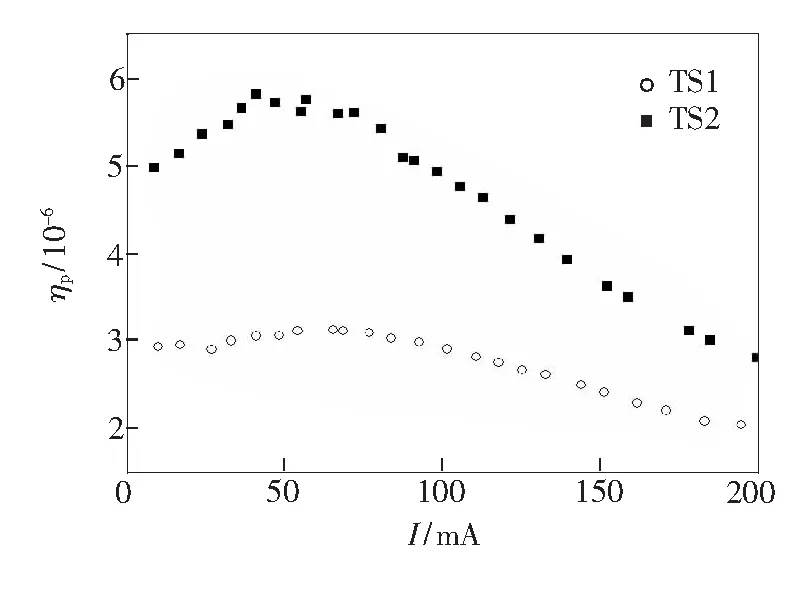
图6 功率转换效率曲线
Fig.6 Power transfer efficiencyvs. current for TS1 and TS2
为了比较本文设计器件的性能,我们总结了近年来基于标准CMOS工艺制备的正向注入型Si-LED的实验结果,如表1所示。由表可见,本文研制的八瓣楔形Si-LED (TS2)在工作电压、功率转换效率ηp及外量子效率ηexe等方面均具有良好的性能。

表1 正向注入型Si-LED的性能比较
* Numbers approximated from plots and/or adjusted by given area.
4 结 论
基于UMC 0.18 μm 1P6M CMOS工艺,成功制备出四瓣结构和八瓣结构的Si-LED。测试结果表明,两种器件均可在2 V以下正常工作,其发射光谱位于近红外波段,峰值波长在1 130 nm附近。在相同的测试条件下,八瓣结构的发光二极管(TS2)具有更高的发光功率和功率转换效率,最大转换效率达5.8×10-6,明显优于四瓣结构器件(TS1)及目前报道的实验结果。由于本文设计的器件TS2可在1.8 V或更低的电压下工作,与标准CMOS电路的电源电压兼容,且发光效率更高,所以有望在光互连领域获得广泛应用。
[1] Rumley S, Nikolova D, Hendry R,etal. Silicon photonics for exascale systems [J].J.LightwaveTechnol., 2015, 33(3):547-562.
[2] Vlasov Y A. Silicon CMOS-integrated nano-photonics for computer and data communications beyond 100 G [J].IEEECommun.Mag., 2012, 50(2):s67-s72.
[3] Chen J D, Zhang T. Fabrication and photoluminescence mechanism of iron-passivated porous silicon [J].Chin.J.Lumin.(发光学报), 2014, 35(2):184-189 (in Chinese).
[4] Snyman L W, Plessis M, Seevinck E,etal. An efficient low voltage, high frequency silicon CMOS light emitting device and electro-optical interface [J].IEEEElectron.Dev.Lett., 1999, 20(12):614-617.
[5] Snyman L W, Plessis M, Bellotti E. Photonic transitions (1.4-2.8 eV) in silicon p+np+injection-avalanche CMOS LEDs as function of depletion layer profiling and defect engineering [J].IEEEJ.Quant.Electron., 2010, 46(6):906-919.
[6] Snyman L W, Plessis M, Aharoni H. Injection-avalanche-based n+pn silicon complementary metal-oxide-semiconductor light-emitting device (450-750 nm) with 2-order-of-magnitude increase in light emission intensity [J].Jpn.J.Appl.Phys., 2007, 46(4B):2474-2480.
[7] Yang G H, Mao L H, Huang C H,etal. Design and analysis of a forked n-well and p-sub junction Si LED based on standard CMOS technology [J].Chin.J.Lumin.(发光学报), 2010, 31(1):369-372 (in Chinese).
[8] Dong Z, Wang W, Huang B J,etal. Low threshold voltage light-emitting diode in silicon-based standard CMOS technology [J].Chin.Opt.Lett., 2011, 9(8):082301-1-5.
[9] Lee H C, Lee S C, Lin Y P,etal. Interface-trap-assisted emission in Si complementary metal-oxide-semiconductor light-emitting devices [J].Jpn.J.Appl.Phys., 2005, 44(6A):3867-3871.
[10] Lee H C, Liu C K. Si-based current-density-enhanced light emission and low-operating-voltage light-emitting/receiving designs [J].Solid-StateElectron., 2005, 49(7):1172-1178.
[11] Han L, Zhang S L, Guo W L,etal. Design and fabrication of three-terminal carrier-injection-type Si-LED with standard CMOS technology [J].Chin.J.Lumin.(发光学报), 2012, 33(4):444-448 (in Chinese).
[12] Xie R, Mao L H, Guo W L,etal. High optical power density forward-biased silicon LEDs in standard CMOS process [J].IEEEPhoton.Technol.Lett., 2015, 27(2):121-124.
[13] Ng W L, Lourenco M A,Gwilliam R M,etal. An efficient room-temperature silicon-based light-emitting diode [J].Nature, 2001, 410(6825):192-194.
[14] Sun J M, Dekorsy T, Skorupa W,etal. Below-band-gap electroluminescence related to doping spikes in boron-implanted silicon pn diodes [J].Phys.Rev. B, 2004, 70(15):1-11.
[15] Sun J M, Helm M, Skorupa W,etal. Highly efficient silicon light emitting diodes produced by doping engineering [J].Front.Optoelectron., 2012, 5(1):7-12.
Effect of Wedged Petaloid Configuration on Luminescence Characteristics of Si-LED Fabricated in Standard CMOS Process
CUI Meng, XIE Sheng*, MAO Lu-hong, GUO Wei-lian, ZHANG Shi-lin, WU Lei, XIE Rong
(SchoolofElectronicandInformationEngineering,TianjinUniversity,Tianjin300072,China)
Based on p+source/drain region and n-well of standard CMOS technology, two forward-injection-type Si-LEDs with different petaloid configuration were designed and fabricated by UMC 0.18 μm 1P6M CMOS process. The measurement results indicate that the emission spectra of both Si-LEDs locate at near-IR region with peak wavelength around 1 130 nm, and the devices can operate properly below 2 V. When the device TS2 with eight-petal configuration is forward-biased at 200 mA, its optical power increases to 1 200 nW without saturation, and the maximum power conversion efficiency reaches up to 5.8×10-6at the current of 40 mA, which is almost double that of the device TS1 with four-petal. Due to the features of low operating voltage and high conversion efficiency, the device TS2 is highly attractive for future optoelectronic applications.
Si-based light emitting diode; forward-injection; wedge configuration; standard CMOS technology

崔猛(1988-),男,河北唐山人,硕士研究生,2012年于河北工业大学获得学士学位,主要从事硅基发光器件和集成电路方面的研究。
E-mail: cuimeng0211@126.com

谢生(1978-),男,河北赤城人,副教授,2006年于厦门大学获得博士学位,主要从事半导体器件与集成电路设计方面的研究。
E-mail: xie_sheng06@tju.edu.cn
*CorrespondingAuthor,E-mail:xie_sheng06@tju.edu.cn
1000-7032(2015)05-0552-05
2015-02-11;
2015-03-24
国家自然科学基金(61036002,61474081)资助项目
TN383
A
10.3788/fgxb20153605.0552

