电离总剂量效应对浮栅型Flash存储器擦写耐久与数据保持特性的影响研究
刘 岐,沈鸣杰,董 艺
(上海复旦微电子集团股份有限公司,上海 200433)
0 引言
Flash存储器是一种用于数据或程序存储的通用集成电路产品,主要有浮栅型和电荷俘获型2种,浮栅型因具有优异的可靠性,被广泛应用于消费电子、工业和航空航天等领域;电荷俘获型因其高温特性略差,大多应用于消费电子领域。
Flash存储器的可靠性有2项基本指标:擦写耐久和数据保持。擦写耐久是指存储器在满足功能和电参数指标前提下的数据可重写能力,通常用擦写循环次数表征,对于Flash存储器,该值通常为104~105;数据保持是指存储器经时间推移仍然可以保持数据的能力,通常用数据保持时间表征,对于Flash存储器,该值通常为55 ℃下数据保持10年。若应用在航空航天领域,则对存储器还有抗辐射的相关要求。在空间环境中,Flash存储器会受到空间辐射的影响,主要可分为单粒子效应、电离总剂量效应和位移损伤3种类型。其中,单粒子效应是高能粒子引起的一些瞬时效应,主要对CMOS电路有影响,部分单粒子效应对双极型和光电电路也有影响;电离总剂量效应[1]会使原子或分子电离产生大量的电子-空穴对,对双极型和CMOS电路都有影响;位移损伤[2]会使原子或离子的位置发生移动,在半导体内形成缺陷,对双极型和光电电路有影响,对CMOS电路(包括Flash存储器)无影响。本文主要研究电离总剂量效应的影响。
对浮栅型Flash存储器的总剂量效应、擦写耐久和数据保持特性各自的机理以及它们之间的相互影响已有较多研究,但仍存在局限,如:基于商用Flash产品的研究[3],受外围MOSFET器件抗辐射性能所限,试验的总剂量较低,未超过50 krad(Si);也有的研究[4]总剂量较高,但评估的偏置条件不够全面,未评估动态偏置条件的影响。本文研究了较高总剂量以及含动态偏置在内的多种偏置条件下的总剂量效应对浮栅型Flash存储器擦写耐久和数据保持特性的影响。
1 研究对象
本文的研究对象是浮栅型Flash存储器[5-7]。存储单元是Flash存储器的核心器件,决定了其可靠性。浮栅器件采用浮栅(FG)存储电荷,器件结构如图1所示,根据浮栅中存储电荷量的不同来表示不同的存储数据,一个单元可以存储1 bit(SLC)、2 bit(MLC)甚至 3 bit(TLC)数据。对于可靠性要求较高的应用,一般采用SLC方式,即一个单元存储1 bit数据,其阈值电压有擦除态和编程态2个状态。

图1 浮栅器件结构示意(非按比例绘制)Fig.1 The structure of floating gate device (not in scale)
Flash存储器的基本操作包括编程、擦除和读。编程操作采用沟道热电子注入(NOR型Flash)或FN隧穿效应(NAND型Flash)向浮栅注入电子,使阈值电压升高;擦除操作采用FN隧穿效应将浮栅中的电子擦除,使阈值电压降低;读操作在控制栅(CG)上施加一个电压(称为读电压),该电压介于编程态和擦除态阈值电压之间,根据读出电流大小区分存储单元是处于擦除态(一般用数据“1”表示)还是编程态(一般用数据“0”表示)。由于多个存储单元浮栅存储的电荷量不可能完全相同,阈值电压会呈现一个分布(如图2所示),其分布范围的宽窄由编程和擦除操作算法决定,不同工艺、不同算法下的阈值分布会有所不同。阈值电压靠近读电压(例如5 V)的单元,经过擦写耐久和数据保持等可靠性试验后,更容易出错,这部分单元的数量及其阈值决定了可靠性考核试验的结果,因此本文仅对这部分单元的阈值电压(介于4~7 V之间)分布进行阈值扫描,对可靠性无影响的、阈值电压离读电压较远(<4 V或>7 V)的单元不进行阈值扫描测试。

图2 Flash 存储单元阈值电压分布示例Fig.2 Threshold voltage distribution of flash memory cell
2 试验方案
采用复旦微电子公司 65 nm工艺、32 Mbit NOR型Flash产品进行总剂量效应、擦写循环和数据保持试验。具体试验方案如下:
1)辐射总剂量(TID)效应试验[8]条件:辐射源60Co,剂量率 50 rad(Si)/s,总剂量 150 krad(Si)——这是未来Flash产品的设计目标值。辐射试验偏置条件包括静态待机、动态读和动态擦写3种。静态待机偏置(TID_SDB)——样片上电,输入管脚接电源,输出管脚浮空;动态读偏置(TID_RD)——以1 MHz频率进行连续、循环的读操作;动态擦写偏置(TID_WR)——对样片的一半空间进行连续、循环的扇区擦除和页编程操作(另一半空间不做操作),整个总剂量效应试验过程中进行约50次擦写循环。受辐射试验平台通信速度所限,进行 1 次擦写循环耗时 1 min,150 krad(Si)总剂量效应试验时间为50 min,故整个总剂量效应试验中可进行50次擦写循环操作。
2)数据图形:以扇区为单位,前8个扇区数据图形依次为 00h、FFh、CKBD、ICKBD、55h、AAh、ICKBD、CKBD,后面扇区依次循环,每个样片每种图形至少4 Mbit存储单元(其中CKBD和ICKBD图形各有8 Mbit),所有样片在试验前初始化成相同的数据图形。
3)擦写循环(NVCE)试验[9]条件:为了缩短试验时间,选取部分空间按该产品擦写耐久指标最大次数(104次)、其余空间按擦写耐久指标的10%(103次)进行擦写循环试验,每次写入相同的数据图形。
4)数据保持试验条件:分别在高温(HT)和常温(LT)条件下进行,高温试验温度为150 ℃,最长测试至340 h(若Ea取1.1 eV,按阿伦纽斯公式可等效为55 ℃下数据保持240年);常温最长测试至500 h。整个数据保持试验过程中,数据不刷新。
5)数据刷新(ReWR):按数据图形要求,全空间重新写入一次数据。
6)试验顺序:先进行总剂量效应试验,再进行擦写循环试验,最后进行数据保持试验。针对不同的研究目的,某些分组会跳过某项或某些项试验。例如为了评估总剂量效应对擦写耐久的影响,会有2个分组,一组先进行总剂量效应试验,再进行擦写循环试验;另一组跳过总剂量效应试验,只进行擦写循环试验,比较2组样片的试验结果以判断总剂量效应对擦写耐久的影响。本文假设总剂量效应、擦写循环和数据保持试验的先后顺序对试验结论无影响,未对其他试验顺序进行评估。
7)样片数量:每个试验分组包括3个样片,样片的试验条件完全相同。由于有些试验有多个试验条件,则某些分组的前置试验可能多于3个样片,比如做过擦写循环试验的样片,需要分2组分别进行高温和常温数据保持试验,则进行擦写循环试验需要6个样片。
8)电测试:所有试验前、总剂量效应试验后、擦写循环试验后和数据保持试验后进行电测试,包括功能测试、电参数测试及存储单元阈值扫描,阈值电压扫描范围4~7 V。
3 总剂量效应试验
总剂量效应试验后的阈值电压测试,编程态单元采用6 V、擦除态单元采用4.5 V的加严条件读出,统计失效单元数目。失效判据为编程态单元阈值低于6 V或擦除态单元阈值高于4.5 V。试验结果如图3所示,图中数据为每组样片的平均值,为了比较不同图形的影响,失效单元数目换算为每2 Mbit存储单元有多少个单元失效。具体数据处理方法为:一个样片有4 Mbit空间存储00h图形,这一空间有 4 Mbit个“0”和 0 个“1”,而若存储 55h(或 AAh、CKBD、ICKBD)图形,则有 2 Mbit个“0”和 2 Mbit个“1”。数据处理时,将 00h图形的编程态失效单元数目除以2,即换算成每2 Mbit平均有多少个失效单元,而55h(或AAh、CKBD、ICKBD)图形不需处理,编程态和擦除态分别统计。这一结果也可理解为比特失效率。

图3 总剂量效应试验结果Fig.3 TID testing result
试验表明,总剂量效应试验中不同图形失效单元数目不同,棋盘格图形(CKBD和ICKBD)失效数目最大,其他图形(00h、FFh、55h、AAh)相近。其原因是电离辐射会在氧化层中产生大量的电子-空穴对,电子和空穴会在电场作用下运动,其结果是浮栅中存储的电荷会有一部分被中和掉,导致存储电荷变少。因棋盘格图形相邻单元存储电荷的极性相反,浮栅间电场强度最大,从而导致阈值电压变化幅度最大,失效单元数最多。可见,棋盘格图形是总剂量效应试验的最易感图形。
在总剂量效应试验中,偏置条件也会影响阈值变化,且对擦除态和编程态的影响不同。与动态读偏置(TID_RD,图3中虚线)相比,静态偏置(TID_SBD,图3中实线)的擦除态阈值变化较大,而编程态阈值变化幅度较小。2种状态的阈值的变化方向不同主要是因为浮栅中存储电荷的极性不同,读电压为正电压,编程态和擦除态单元浮栅中电荷受正电压的影响不同所致。因擦除态阈值变化幅度更大,而数据读错是由阈值变化最大的单元决定,即由擦除态决定,所以,静态偏置是总剂量效应试验的最严格偏置条件。
4 擦写循环试验
由于Flash存储器的编程和擦除算法均有校验操作,经校验操作后编程态和擦除态阈值会分布在一个固定的区间,无法通过阈值分布的变化来分析试验的影响,所以本文通过擦除和编程时间来分析总剂量效应对擦写耐久特性的影响。
擦写循环试验测试结果如图4所示,无论是否经过总剂量效应试验,一个扇区的总编程时间几乎不变;而一个扇区的擦除时间与初始值(Init)相比,经过单独的总剂量(TID)和擦写循环(NVCE)试验样片的擦除时间略微增加,经过总剂量和擦写循环叠加试验样片的擦除时间增加幅度最大(约10%)。其原因是NOR Flash编程采用CHEI机理[6],热电子注入区域在浮栅器件漏端附近,总剂量效应产生的正电荷和界面态分布在整个隧穿氧化层中,对局部较小区域的热电子注入效率影响较小,又因为隧穿氧化层厚度较薄,总剂量效应的影响本来就小,所以,总剂量效应对编程时间无影响;而擦除操作是在浮栅下面的整个隧穿氧化层区域发生隧穿,总剂量效应在隧穿氧化层里产生的正电荷会影响电子隧穿,使擦除时间变长。按擦除时间变化幅度升序排列为:150 krad(Si)总剂量效应试验,104次擦写循环,总剂量与擦写循环叠加试验。叠加试验的影响最大,但总体变化幅度较小,影响有限。

图4 总剂量/擦写循环试验编程时间与擦除时间测试结果Fig.4 Testing results of programming time and erasing time after TID/NVCE
5 数据保持试验
数据保持试验分别在高温和常温条件下进行。
5.1 高温数据保持试验(HTDR)
1)总剂量效应试验后数据不刷新
总剂量效应试验后直接进行高温烘培试验,不刷新数据,评估其对高温数据保持特性的影响。试验结果如图5所示,静态待机偏置(TID_SDB+HTDR)和动态读偏置(TID_RD+HTDR)对阈值电压变化的影响差别很小,可以忽略。经过总剂量效应试验的样片(TID_SDB+HTDR与TID_RD+HTDR),与未进行总剂量效应试验的样片(HTDR)相比,阈值电压变化幅度显著增大,这主要是因为引入额外的辐射致电荷泄漏效应所致。

图5 高温数据保持试验结果(数据不刷新)Fig.5 Testing result of HTDR (without data refreshing)
2)总剂量效应试验后数据刷新
高温数据保持试验前刷新数据,以消除前置试验对浮栅存储电荷的影响,考察除了辐射致电荷泄漏效应以外的其他影响。试验结果如图6所示,总剂量效应试验的不同偏置(TID_SDB+ReWR+HTDR、TID_RD+ReWR+HTDR、TID_WR+ReWR+HTDR)对阈值电压变化的影响几乎无差异;擦写循环(TID_SDB+NVCE+ReWR+HTDR)和总剂量效应试验会使阈值变化幅度稍微变大,且仅对较高阈值的编程态单元有一些影响,对其他阈值电压的单元无影响,即消除了辐射致电荷泄漏效应的影响之后,总剂量效应对高温数据保持的影响很小,可以忽略。
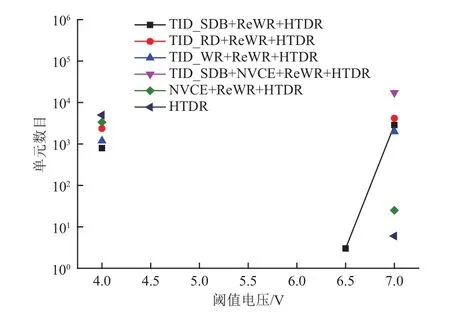
图6 高温数据保持试验结果(数据刷新)Fig.6 Testing result of HTDR (with data refreshing)
综上所述,总剂量效应对高温数据保持特性的影响主要表现在辐射致电荷泄漏,若辐射后刷新数据,则总剂量效应对高温数据保持特性的影响可以忽略。
5.2 常温数据保持试验(LTDR)
由图7可以看到,总剂量效应对常温数据保持的影响与对高温数据保持的类似:若总剂量效应试验后不刷新数据(TID_LTDR),其阈值电压变化幅度最大,主要是因为引入额外的辐射致电荷泄漏效应所致;若总剂量效应试验后刷新数据,即消除辐射致电荷泄漏效应之后,则辐射对常温数据保持的影响很小,几乎可以忽略。
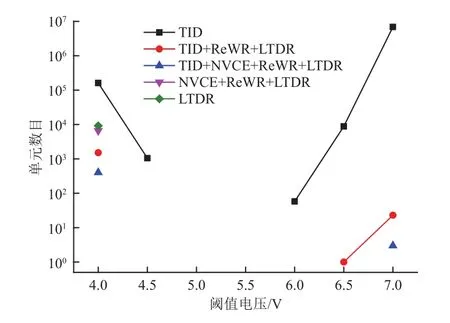
图7 常温数据保持试验结果Fig.7 Testing result of LTDR
6 讨论
浮栅器件阈值主要由2个因素决定:器件本征阈值和浮栅存储电荷量。浮栅器件的本征阈值是指浮栅处于电中性时器件的阈值。下面从这2个方面分别讨论总剂量效应、擦写循环以及数据保持试验对浮栅器件阈值电压的影响。
1)总剂量效应试验
与对NMOS器件阈值的影响[10]类似:一定剂量的辐射会在栅氧化层中产生电子-空穴对,电子迁移率较高,较容易在电场作用下漂移出栅氧化层,空穴会驻留在氧化层中,即辐射后氧化层俘获正电荷,使阈值电压降低;同时,辐射还会在栅氧化层和硅界面处产生界面态,界面态带负电[11],对NMOS阈值的影响与氧化层正电荷相反,使阈值电压升高。一般而言,氧化层俘获的正电荷更多,占主导作用,故总体上辐射会使NMOS阈值降低[12],即使浮栅器件的本征阈值降低。辐射致阈值电压漂移量与氧化层厚度tox呈幂律关系,n一般在1~3之间,具体由工艺条件和偏压条件决定。当氧化层厚度小于10 nm时,辐射引起的阈值漂移很小,甚至可以忽略[13]。
2)擦写循环试验
NOR型Flash编程时会在漏端(Drain)注入热电子,在界面处产生界面态,同时有些电子会被氧化层中的陷阱俘获[14],形成氧化层中的负电荷,这些负电荷主要分布在漏端附近;擦除操作的隧穿效应发生在浮栅下方的整个氧化层区域,因而栅氧化层俘获的电子会分布在整个栅氧化层区域;由于阳极空穴注入效应的存在,氧化层俘获电子的同时,也会有空穴注入到栅氧化层中而被俘获。由于栅氧化层是绝缘体,电子和空穴不会立即复合,二者会同时存在,经过擦写循环试验的浮栅器件如图8所示,栅氧化层中同时存在正电荷和负电荷,界面处存在界面态,由于编程效应发生在漏端附近,电荷和界面态密度在漏端附近略高。出于操作电压和数据保持特性的折中考虑,浮栅型Flash的隧穿氧化层厚度一般为6~8 nm,理论上,总剂量效应对阈值电压的影响很小。本文试验也证实,与104次擦写循环试验相比,150 krad(Si)总剂量效应试验后器件特性的退化幅度更小。总剂量效应与擦写循环叠加试验后,器件特性的退化幅度最大,扇区擦除时间增加约10%,但总体变化幅度较小,影响有限。
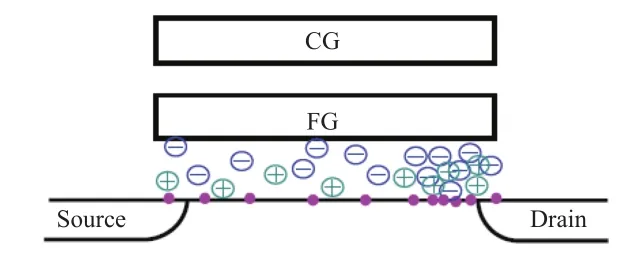
图8 NOR 型 Flash 擦写特性退化机理示意Fig.8 NVCE degrading mechanism of the NOR Flash
3)数据保持试验
数据保持试验后浮栅器件的本征阈值变化较小,数据保持失效主要由浮栅存储电荷量的变化量决定,造成浮栅存储电荷量变化的机理主要有2种:氧化层俘获电荷脱阱(detrapping)和应力致漏电(SILC)[15]。总剂量效应对浮栅存储电荷的影响表现为辐射导致浮栅存储的部分电荷泄漏,此效应也被称为辐射致漏电(RILC)效应,与应力致漏电(SILC)效应类似[16]。辐射后不刷新数据的数据保持试验,由于受到RILC效应影响或辐射引入的弱编程影响[17],使浮栅中存储的电荷发生变化,从而导致阈值电压有较大幅度变化;而辐射试验后刷新数据,亦即消除RILC的影响之后,再进行数据保持试验,则阈值变化很小,这可以证实总剂量效应引入的氧化物电荷和界面态很少,对电荷脱阱和SILC效应的影响有限,亦即总剂量效应对器件高温和常温数据保持特性的影响也较小。
7 结论及建议
本文通过总剂量效应、擦写循环和数据保持试验及其叠加试验,对电离总剂量效应对浮栅型Flash可靠性的影响进行了研究。结果表明:总剂量效应对擦写特性的影响较小,可忽略;对数据保持的影响主要体现在辐射会导致浮栅中的部分电荷泄漏,若总剂量效应试验后刷新数据,即可消除该影响。总剂量效应试验还发现,与动态读和动态擦写偏置相比,静态待机偏置下擦除态阈值电压的变化幅度更大,是总剂量效应试验的最严格偏置条件;棋盘格图形在几种常见数据图形中阈值电压变化幅度最大,是最易感图形。因而总剂量效应试验偏置选用静态待机偏置,数据图形选用棋盘格图形,会使试验筛选条件更为严格。
本文研究对象是浮栅型Flash存储器,试验样品为SLC浮栅型NOR Flash产品。基于相同的器件结构、工作原理和失效机理,本文的研究结论同样适用于MLC和TLC浮栅型NOR Flash产品。对于浮栅型NAND Flash,由于其与试验样片的器件结构相同,只是编程原理不同,而总剂量效应、擦写耐久和数据保持的失效机理相同,所以本研究结论也同样适用于浮栅型NAND Flash。对于电荷俘获型Flash,由于其器件结构、工作原理和失效机理均与试验样片的不同,本研究结论可能不适用,需另行研究。
在可靠性考核方面建议:因总剂量效应试验对擦写特性和数据保持特性的影响可忽略,总剂量效应试验可与擦写循环和数据保持试验分别进行。
在系统级应用方面建议:为了将辐射致电荷泄漏和应力致电荷泄漏效应的影响降到最低,Flash存储器可每间隔一段时间(如1年)刷新一次数据,以进一步提升系统的可靠性,降低出现故障的概率。
致谢
感谢廖少武、郝香池同志对NOR型Flash电路工作原理方面的支持,感谢王寅、康鑫、张慕威、刘剑海、赵明浩等同志在可靠性试验与测试方面的辛勤工作,以及刘佩同志在测试数据处理方面的工作。

