芯片尺寸级CSP封装自动植球技术的研究
刘劲松,郭 俭,王 鹤
LIU Jin-song1 , GUO Jian2 , WANG He2
(1.上海理工大学,上海 200093;2.上海微松工业自动化有限公司,上海 201114)
0 引言
CSP是狭窄间距的BGA,日本富士通1992年提出,于2000年开始兴起,是高端IC封装技术的主流和发展方向[1]。
植球工艺制造芯片凸点以及实施植球工艺的植球技术是CSP芯片封装过程中的关键技术,植球机是实施植球工艺制造凸点的设备,是CSP等先进封装技术最核心的半导体高端封装设备之一。通常,引进一套国外的全自动植球机设备需要大约60多万美元,价格极其昂贵。因此,开展全自动植球技术的研究非常必要和迫切[2]。
国内,夏链、郭建强等[3~5]研究了针对基板植球的BGA植球技术和视觉检测技术,给出了设计方案和技术路线,但没有进一步探究植球技术的工业应用及其具体实现问题。本文则阐述了针对基板植球和针对晶圆植球的两种CSP植球方法,并以真空吸引法基板植球为例,探究了其具体工业应用。
1 CSP封装流程
CSP封装(Chip Size Package/Chip Scale Package)按日本电子机械工业会EIAJ的定义为:与晶片(Die)大小相同,或稍微大一些的封装总称;封装形式为现有封装形式(如BGA等)的衍生和升级[6]。
CSP的封装流程大致分为三个阶段:晶圆级工艺阶段、晶片级工艺阶段和塑封成型工艺阶段[7],其封装流程如图1所示。在塑封成型工艺阶段,植球是把锡球植放到芯片PAD点上,锡球是芯片与外部电路相连接的纽带,即I/O通道。植球质量从某种意义上来说代表了芯片封装质量。由于植球设备对自动化程度和制造加工精度等要求较高,导致国内依赖进口设备和依靠人手动植球的现状依旧普遍。
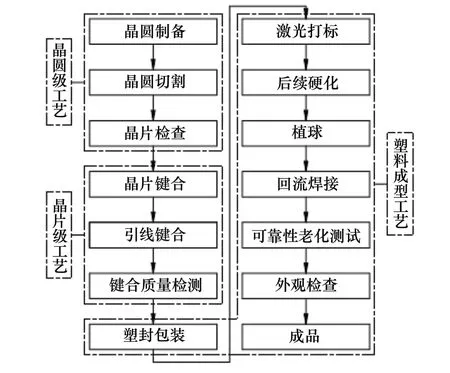
图1 CSP封装流程图
2 CSP植球技术
植球使锡球与基板相连接,植球质量将直接影响到器件性能与可靠性[8],属于半导体IC封装后道工序,是芯片尺寸级CSP封装塑封成型工艺中的关键步骤之一。锡球吸拾和植放是植球工艺中的核心步骤,主要植球方法有两种:真空吸引法和丝网印刷法。下面介绍这两种植球方法,并以真空吸引法为例,讨论其在植球机设备上的具体应用。
2.1 植球方法与植球原理
基板植球机大多采用真空吸引法,晶圆植球机大多采用丝网印刷法。由于晶圆的平整度较好,可以制作与晶圆图案花形相一致的网板,扫球机构的刮刀在网板上蛇形运动,将锡球扫入网板筛孔中,植入到晶圆上,如图2所示。丝网印刷法使用的是微米级的薄板,晶圆和刮刀与网板的接触会造成网板的弹性变形,需要对这种变形加以控制以保证植球精度[9]。塑封好的基板可能翘曲,平整度不如晶圆,采用丝网印刷法植球效果不够理想。
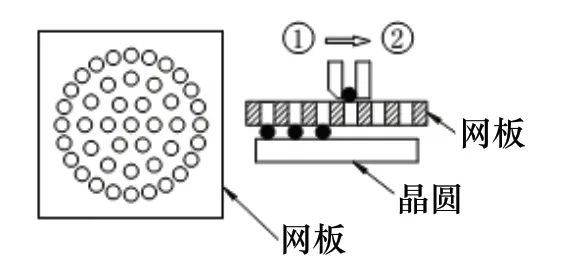
图2 丝网印刷法植球原理示意图
真空吸引法植球按供球方式不同,可以分为振盘式真空吸引法植球方式和预埋入式真空吸引法植球方式,如图3、图4所示。振盘式供球方法是在锡球料盒的底部安装一振动盘或料盒与振动盘一体式,开启振动源,调整至合适的电压和频率,可以把料盒底部的锡球振至群体跳跃状,锡球与料盒底部腾空一段距离;关闭振动盘,锡球由于自身重力重新落回料盒底部。
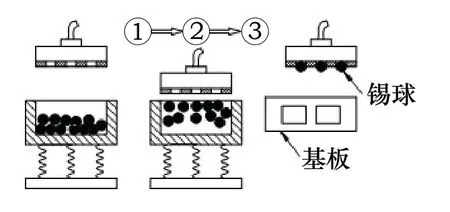
图3 振盘式真空吸引法植球原理示意图
预埋入式则采用制作与基板图案花形相一致的治具,治具上有若干整列小孔,孔的大小与所需植球的锡球球径大小相对应。一般,锡球球径大于0.5mm,锡球料盒布置在治具上方,料盒按水平方向往复运动,使锡球自动落入治具小孔或者治具接有真空设备,开启真空,将小球吸入小孔内。当锡球球径较小时,料盒采用水平方式往复运动,卡球现象严重,锡球容易被刮入到料盒与治具的间隙中。此时,料盒采用翻转方式往复运动,借助惯性和一定倾斜角度使锡球不被刮入间隙中,卡球的现象得以消除。
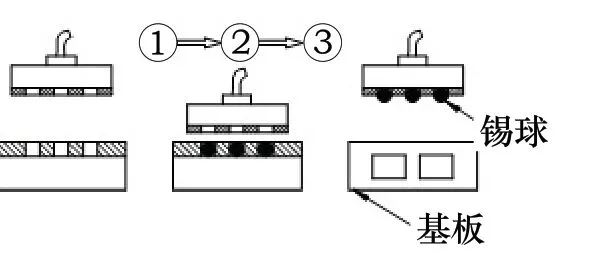
图4 预埋入式真空吸引法植球原理示意图
无论是预埋入式还是振盘式真空吸引法植球,都采用真空方式来吸拾锡球,然后植放到基板上。图3和图4所示是真空吸引法植球的一般过程,从左往右,共三个步骤:锡球供给,锡球真空吸拾,锡球植放。
2.2 真空吸引法的实施与应用
基板有多种尺寸规格[10],植球后的每一块基板可以切割成若干个芯片,每个芯片有若干个I/O引脚,如图5所示。
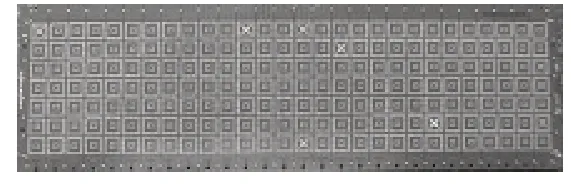
图5 一种240mm×74mm尺寸规格基板实物图
设某种基板可以切割成m个芯片,每个芯片有n个I/O引脚,所需单次植球数为Qs,则:

所需植放的锡球球径为d,锡球密度为ρ,锡球自身重力为Gb,所需植球区域长a宽b,所需真空发生器的真空度为Pv,安全系数取Sf,重力加速度为g,则:

安全系数与吸拾方式(水平或垂直)有关,对于水平吸拾方式的安全系数一般取4[11]。
根据吸拾供球治具上全部锡球所需的真空度Pv预选最大真空度比Pv略大的真空发生器,再对真空发生器的极限吸入流量进行验算,便可确定所需使用的真空发生器类型,此步骤可参照各公司(如SMC等)真空产品的选型手册,这里不再赘述。
真空吸拾锡球后,植放至已涂抹了助焊剂Flux的基板上。在植放时,由于基板有些许翘曲,需给基板一定的压力,这由植球机构来完成,如图6所示。若基板翘曲严重,在植球之前还需专门的机构压平基板。
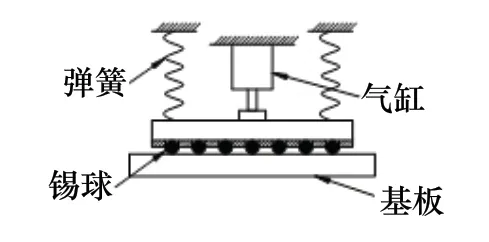
图6 锡球植放示意图
设气缸缸径为D,供给气缸使用的压缩空气的压强为P0,气缸理论输出力为Fc,则:

锡球未植放前,弹簧刚度为K,拉伸伸长量为Δ1x,单个弹簧拉力为Fsi,使用弹簧的个数为Q,植球治具和植球机构自重为W,则:

锡球植放时,弹簧伸长量为Δx2,单个弹簧拉力为对基板的压力为Fp,则:

调整气缸压强P0值,可以改变弹簧伸长量Δx1,进而可以对锡球植放时实施于基板上的压力Fp进行控制和调整,以满足不同球径锡球与不同基板所需的压力要求。
3 真空吸引法基板植球实验
本次植球实验,使用自主研制的植球机MBA-2000,如图7所示。实验对象是PCB基板,主要材质为BT树脂。基板尺寸为270mm×80mm×0.8mm,所需植球区域长250mm宽67mm。使用国产锡球,主要材质Sn63Pb37,球径0.25mm。

图7 MBA-2000基板植球机
3.1 植球过程
基板共80个芯片,5行16列布置,每行间距16mm,每列间距15mm。每个芯片78个I/O,单次植球数Qs为6240个。
使用SMC ZR120S2-K15MZ-EC大型真空发生器和CQSXB20-10D薄型气缸,缸径D为20mm,两个MISUMI AUT12-45拉伸弹簧,弹簧刚度K为11.18N/mm。设定气缸压强P0为0.1MPa,植球压力Fp为61.152N。
植球机构在供球处开启真空,吸拾锡球,于基板上方沿Z向下降,使治具上的锡球与基板接触,微微翘曲的基板在压力Fp的作用下变得平整,使锡球可以与基板上全部PAD点相接触。破真空,植放锡球。植球机构Z向升起,植球完成,如图8所示。
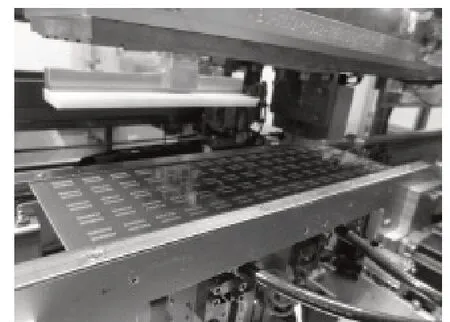
图8 真空吸引法植球实物图
3.2 植球结果
植球完成后,可以借助三次元测量仪观察植球效果,根据观测结果,再对机构进行调整或电气PLC软件上进行位置补偿,以获得较理想的植球效果。图10所示基板上方两块芯片没有点上胶(矩形区域),锡球植放时由于气流作用把锡球吹得散乱了。图9是调整了印刷机构,保证基板上每个芯片的PAD点都点上胶,最终的植球效果比较理想。

图9 植球效果较好

图10 植球有缺陷

图11 三次元测量仪观察植球效果
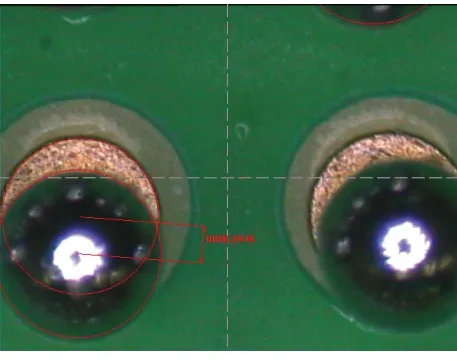
图12 锡球偏移量测量
如图11、图12所示,使用三次元测量仪测出锡球最大偏移量为0.0946mm。由于焊点之间的张力产生良好的自对中效果,锡球偏移量在其球径的50%以内回流焊时可以拉正[12]。当然,可以经过反复多次植球实验,确定合适的植球工艺参数,MBA-2000植球效果还可以进一步地提高。
4 结束语
植球技术是芯片尺寸级CSP封装塑封成型工艺过程中的关键技术之一。丝网印刷法适用于晶圆植球,真空吸引法适用于基板植球。通过植球机MBA-2000植球实验,表明真空吸引法在基板上植球效果良好。从长远角度来看,植球技术的研究和植球机设备的研制,将提升我国在半导体封装测试领域的竞争力,有助于巩固和扩大我国IC产品在国际半导体市场的占有率,使我国封装测试产业能更好地发展下去。
[1]刘劲松,郭俭.BGA/CSP封装技术的研究[J].哈尔滨工业大学学报,2003,35(5):602-604.
[2]赵志明,乔海灵.芯片凸点植球技术[J].电子工业专用设备,2009,38(12):17-19.
[3]郭建强,韩江,夏链,余道洋.BGA全自动植球机视觉检测技术及应用[J].制造业自动化,2006,06:33-35,46.
[4]王晶,夏链,戴文明,韩江.BGA植球机三维计算机辅助模块化设计[J].现代制造工程,2006,03:43-45.
[5]夏链,韩江,方兴,等.球栅阵列(BGA)自动植球机的研制[J].仪器仪表学报,2006,02:155-158,164.
[6]萩本英二.陈连春,译.CSP技术(第1版)[M].台湾:建兴出版社,1998.
[7]王志越,易辉,高尚通.先进封装关键工艺设备面临的机遇与挑战[J].电子工业专用设备,2012,41(4):1-6.
[8]李丙旺,吴慧,向圆,等.BGA 植球工艺技术[J].电子与封装,2013,06:1-6,37.
[9]刘劲松,郭俭.3D芯片封装晶圆植球装备关键技术研究[J].中国电子科学研究院学报,2013,8(6):573-577.
[10]王鹤,郭俭,石洋.圆带传动在植球机基板传送系统的应用与研究[J].机械传动,2014,38(7):171-173,178.
[11]SMC(中国)有限公司.现代实用气动技术[M].3版.北京:机械工业出版社,2008.
[12]罗伟承,刘大全.BGA/CSP和倒装焊芯片面积阵列封装技术[J].中国集成电路,2009,02:49-55.

