工艺气体比例对微波MOCVD沉积氧化铝膜性能影响
张 健,巴德纯,赵崇凌,杜广煜,刘 坤
(东北大学 机械及自动化学院,沈阳 110004)
工艺气体比例对微波MOCVD沉积氧化铝膜性能影响
张健,巴德纯,赵崇凌,杜广煜,刘坤
(东北大学 机械及自动化学院,沈阳 110004)
AlO薄膜作为高效太阳能电池中P层钝化薄膜引起了光伏龙头企业的关注。本文利用自主研发的线性微波等离子增强化学气相沉积系统(LMW-MOCVD)在单晶硅基体上用不同N2O和TMA特气比例制备氧化铝膜层样品,并通过SEM、SE800椭偏仪对薄膜的成分、表面形貌、厚度、沉积速度、折射率测试分析。实验结果表明,随着N2O比例增大,薄膜中O/Al原子比例有上升趋势;膜层沉积速度显著降低;膜层折射率开始趋于稳定而后迅速降低。所以,工艺气体比例对LMW-MOCVD沉积氧化铝膜的性能有明显影响。
线性微波源;氧化铝薄膜;工艺气体比例;折射率;沉积速度
0 引 言
AlO薄膜具有可以钝化硅片表面,弥补硅片表面悬挂键,起到增加少子寿命的作用,最重要的是氧化铝膜层内部有负阴离子团,该阴离子位于AlO和硅交界处,可以在P型硅表面形成阴性场效应,增强PN结的内建电场,增大开路电压和短路电流,最终实现提高晶硅电池效率。因此,近年来AlO薄膜的制备也引起了很多国内外专家的关注,如应用溶胶凝胶技术制备出硬质氧化铝膜,高介质性能氧化铝膜[1-5],同样近年来的ALD技术也实现了氧化铝膜层的制备,且薄膜的致密性能、介电性能、钝化性能都有显著的提高[6-11]。但溶胶凝胶制备出的薄膜不适用于晶硅电池行业要求,同时ALD法制备薄膜的沉积速度过慢,无法实现真正的大范围普及。
因此,本文研究LMW-MOCVD技术制备高质量、高沉积速度的AlO薄膜,在保持其它沉积参数不变的条件下研究了不同特气比例对AlO薄膜成分、表面形貌、折射率、沉积速度的影响
1 实 验
采用强碱抛光后的单晶硅片作为基体材料。将基体用体积5%浓度的HF浸泡2min,再用无水乙醇和丙酮溶液将基体超声波清洗10min,最后用去离子水冲洗2次后基体烘干。开起沈阳科仪自主研发的LMW-MOCVD-SD30系统(该系统由装载、预热、沉积、冷却、卸载5部分组成,其功能分别是快速加热、稳定加热、微波离化反应特气、冷却样片、取样片),将样片放入预热腔体中,350 ℃加热基体,而后真空环境传递到反应腔体,反应腔的本底真空为1.0×10-1Pa,通入定量反应气体N2O和TMA,而后通过变频真空泵调节反应腔压力到20Pa,加载微波电源功率2 200W、占空比9/11,腔体内出现淡粉色的辉光放电,由于该设备的微波源是线性源,所以要求样片匀速通过微波源上方,同时在样片运动过程中生长了AlO薄,最后样片通过冷却卸载腔被取出。单次生长时间是1.5min。表1是AlO薄膜生长工艺参数表

表1 AlO薄膜制备参数
图1是微波沉积设备的示意图。同时采用SEM对薄膜进行了成分和表面状态分析;用SE800椭偏仪进行了薄膜厚度和折射率测量。
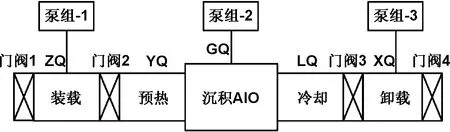
图1 LMW-MOCVD系统简图
2 结果与讨论
2.1工艺特气比例对薄膜成分及表面形貌影响
表2为EDS测试AlO薄膜样片得到的组成元素比例。可以看出随着N2O∶TMA比值增大,O元素在AlO薄膜中的含量开始时迅速升高,当达到11∶1后,O元素含量逐渐趋于稳定,且O元素含量最大,薄膜成分是AlO1.6。这是因为当N2O∶TMA比值较小时,反应气氛中N2O处于紧缺气体,TMA过剩,这时适当增加N2O∶TMA比值就相当于增加了参与反应的N2O量,所以AlO薄膜中O元素含量增大。但是当N2O∶TMA比值达到11∶1时,反应气氛中N2O相对TMA过剩,继续增大N2O∶TMA比值,对AlO薄膜中O元素含量贡献不大。
表2不同特气比例生长的AlO薄膜中元素百分比
Table2ElementpercentofAlOfilmwithrationchangesbetweenN2OandTMA

SpecimenCompositionofAlOfilmRatioofelement1AlOXAl∶O=1∶0.82AlOXAl∶O=1∶1.23AlOXAl∶O=1∶1.44AlOXAl∶O=1∶1.65AlOXAl∶O=1∶1.6
为了研究AlO薄膜的表面状态,本文对样片进行了SEM扫描。由于样品为陶瓷薄膜,所以在做SEM扫描时在表面进行了喷金处理,为了更好地显示AlO薄膜的表面状态,本文对AlO编号(5)样品进行了SEM面扫描。图2是SEM观测的样片表面状态图,其中图2(a)扫描的是碱抛光硅基片、图2(b)扫描的是沉积AlO薄膜后基片表面、图2(c)扫描的是AlO薄膜中O原子的分布状态、图2(d)扫描的是AlO薄膜中Al原子的分布状态。可见,碱抛光的硅基片沉积AlO薄膜后,样品表面形貌基本没有改变,AlO薄膜均匀的覆盖到了硅片表面;图2(c)和(d)可见,生长的AlO薄膜中O元素和Al元素也可以均匀的分布到整张样片,这种均匀分布是制备高性能AlO薄膜的前提。
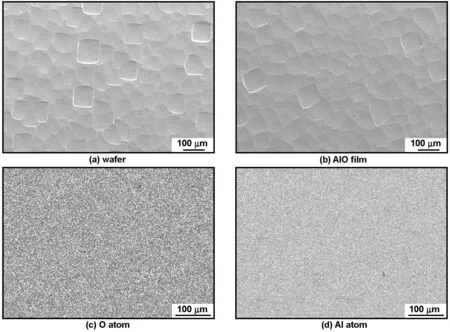
图2AlO薄膜SEM图片
Fig2PictureofiswaferwithSEM,PictureofisAlOfilmwithSEM,PictureofisOelementdistributioninAlOfilm,PictureofisAlelementdistributioninAlOfilm
2.2 工艺特气比例对薄膜沉积速度的影响
本文通过SE800椭偏仪检测了不同工艺特气比例参数下生长的AlO膜层厚度。图3表示样品的测试分布点,图4表示各个测试点的AlO膜层厚度值。可以看出,这5张样片制备出的AlO膜层都出现了测试中心点(1)较薄,而样片四周较厚现象,这是因为在样片沉积过程中,由于系统结构的影响,样片中间位置的温度要高于样片周边的温度造成的。其它测试点2、3、4、5的厚度也不一致,但厚度差不超过±3%,在PECVD沉积薄膜技术中属于正常数值差。图4中还可以明显看出N2O与TMA流量比例由小变大后,膜层厚度起初微弱的增厚,而后迅速下降。因为开始时N2O流量相对TMA过小,N2O处于稀缺气体,TMA相对过量,所以适当增加N2O流量可以使TMA充分反应,起到提高反应速度的目的。当N2O流量继续增加时,TMA已经充分反应了,还继续增大N2O流量,相当于增大了非反应气体的浓度,从而阻碍了膜层生长。图5可以清晰得看出膜层生长速度,当N2O流量达到900mL/min时,AlO的生长速度最快,生长速度为2.05nm/s。上述数据和讨论说明,只有合适的N2O和TMA比例,才能达到最快沉积速度。

图3 膜层厚度测试分布点

图4N2O与TMA流量比例变化时AlO薄膜厚度曲线
Fig4CurvesoffilmthicknesswithrationchangesbetweenN2OandTMA
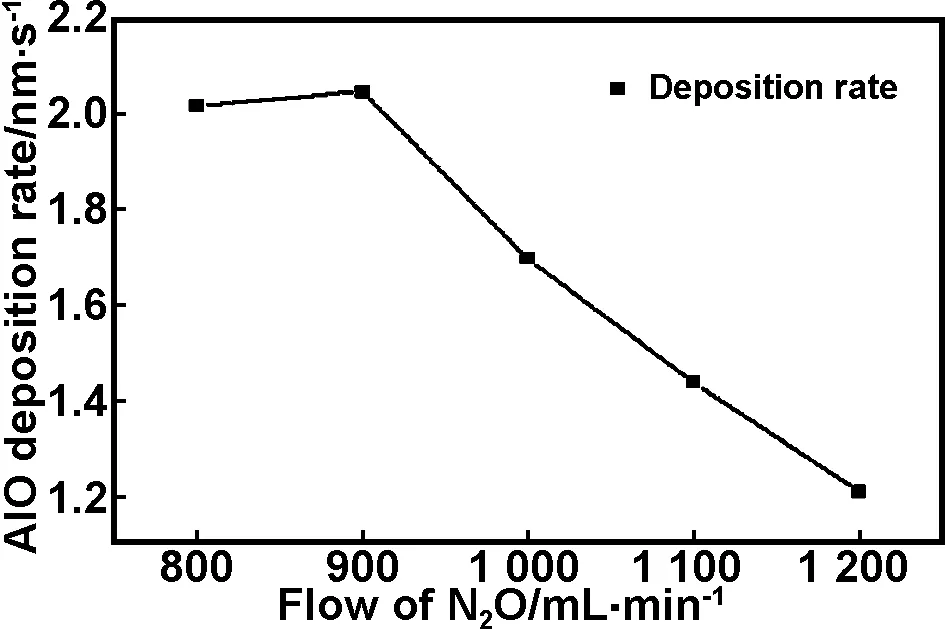
图5N2O与TMA流量比例变化时AlO膜沉积速度曲线
Fig5CurveofdepositionratewithrationchangesbetweenN2OandTMA
2.3工艺特气比例对膜层折射率的影响
AlO膜作为晶硅太阳电池背钝化薄膜和双面吸光电池正面薄,其折射率都是影响其性能的重要参数。本文通过SE800椭偏仪进行了折射率测试,如图6所示。图中表明反应特气(N2O∶TMA)比例,对制备的AlO折射率有明显的影响,当比值较小时,膜层的折射率偏高,基本在1.75~1.78之间浮动;随着比例的增大,膜层折射率有明显变小的趋势,但一般不会低于1.64。这是因为当N2O比值小时,TMA相对过量,这时生长的AlO薄膜成分显富Al状态,薄膜较致密,折射率较高;而当N2O比值增大时,生长的AlO薄膜成分显富O状态,富O时薄膜中O-O键很可能以氧分子的形式脱离薄膜,使AlO薄膜致密性下降,折射率降低。

图6 AlO膜折射率随N2O比例变化曲线
Fig6RefractivityofAlOfilmonproportionchangingofN2O
3 结 论
(1)通过LMW-PECVD在硅片上用不同特气比例条件下沉积了AlO薄膜,膜层中O/Al元素百分比随着N2O∶TMA比例增加迅速升高而后趋于稳定,当N2O∶TMA比例高于11∶1时,薄膜成分为Al2O3。微波制备的AlO薄膜,样片表面形貌基本没有改变,且Al和O元素分布均匀。
(2)通过LMW-PECVD在硅片上用不同特气比例条件下沉积了AlO薄膜,膜层生长速度随着N2O∶TMA比例增大开始略有升高后迅速下降,当比例达到9∶1时生长速度最大,数值为2.05nm/sec。该沉积速度远大于ALD沉积速度,更加适用于大规模生产。
(3)通过LMW-PECVD在硅片上用不同特气比例条件下沉积的AlO薄膜,膜层折射率随着N2O∶TMA比例增加而减小,一般在1.6~1.8之间浮动。且当N2O∶TMA比例高于11∶1时,薄膜的折射率最接近1.6,有助于合成质量更好的氧化铝薄膜,这与EDS的测试结果一直。
(4)本文使用自主研发的LMW-MOCVD系统,制备了高质量、高沉积速度的AlO薄膜,为背钝化高效晶硅电池和双面吸光电池的研发制备提供一道高效工序。
[1]HuangXin,SunYali.Studyofaluminacoatingformedbysolgelmethod[J].ChemicalEngineer,2008,(11):07-09.
黄新,孙亚丽.用溶胶-凝胶法形成氧化铝硬质涂层的研究[J]. 化学工程师,2008,(11):07-09.
[2]LuoLaima,YuJia.Solgelmethod,thesurfaceof45steelcoatingsandpropertiesofAlOceramics[J].JournalofMaterialsandHeatTreatment,2009,30(4):138-141.
罗来马,俞佳.溶胶-凝胶法45钢表面制备AlO陶瓷涂层及性能[J].材料热处理学报,2009,30(4):138-141.
[3]HouCunyang.Studyonthesynthesisandpropertiesofaluminamembranecoatedactivatedcarboncarriersystem[D].Hangzhou:ZhejiangUniversity,2011.
侯春阳,氧化铝膜包覆活性炭载体的制备及其性能研究[D].杭州:浙江大学,2011.
[4]HuiskenF,KohuB,PaillardV.Synthesisofrutileandanatasefilmswithhighsurfaceareasinaqueoussolutionscontainingurea[J].ApplPhysLett,1999,(74):2316-2318.
[5]BulenteYoldas.Hydrolysisofaluminumalkoxidesandbayeriteconversion[J].JApplChemBiotechnol, 1973,(23):803-809.
[6]RichterA,Hennecks,BenickJ,etal.FiringstableAlO/SiNlayerstackpassivationforthefrontsideboronemitterfon-typesiliconsolarcells[C]//NewYork: 25thEuropeanPhotovoltaicSolarEnergyConference,2010.
[7]AslanMM,WebterNA,ByardCL,etal.Low-lossopticalwaveguidesforthenearultra-violetandvisiblespectralregionswithAlOthinfilmsfromatomiclayerdeposition[J].ThinsolidFilms, 2010,518(17):4935-4940.
[8]HsuW,ChenJY,ChengT,etal.SurfacepassivationofCuSe2usinggatomiclayerdepositedAlO[J].AppliedPhysicsLetters, 2012,100(2):508-508.
[9]SchmidtJ,MerkleA,BrendelR,etal.Surfacepassivationofhigh-efficiencysiliconsolarcellsbyatomic-layer-depositedAlO[J].ProgressinPhotovoltaics, 2008,16(6):461-466.
[10]Solarphotovoltaicindustry"twelfthfiveyearplan"[J].SolarPhotovoltaic,2012,(06):12-17.
太阳能光伏产业“十二五”发展规划[J].太阳能,2012,(06):12-17.
[11]ChenJie,LiJun.TheelectricalpropertiesofALDaluminadielectricthinfilmanditsapplicationinsiliconcapacitor[J].ElectronicsandPackaging,2013,(09):31-34.
陈杰,李俊.ALD氧化铝薄膜介电性能及其在硅电容器的应用[J].电子与封装,2013,(09):31-34.
Influenecofprocessgasratioonthepropertiesofaluminafilmdepositedbymicrowavemocvdthchnology
ZHANGJian,BADechun,ZHAOChongling,DUGuangyu,LIUKun
(SchoolofMachinery&Automation,NortheasternUniversity,Shenyang140330,China)
AlO,asSurfacepassivationfilmtoPtypesiliconinhighefficiencysolarcells,causedconcernbyleadingcompany.AlOthinfilmweredepositedontomonocrystallinesiliconusingself-developedLMW-PECVDtechnologywithdifferenceprocessgasproportionbetweenN2OandTMA.CompositionandsurfacemorphologyofthefilmswereinvestigatedbySEM.SE800spectroscopicellipsometerwasemployedtomeasurethicknessandrefractivityofthefilms.Theresultshowsthat,withtheincreasingofN2Oratio,elementratioofO/Alinfilmisontherise;depositionrateofAlOfilmremarkablydecrease;refractivityofthefilmbegantoleveloffandthendecreasedrapidly.So,ProcessgasproportionplaysanimportantroleinAlOfilms.
slinearmicrowavepower;aluminafilm;processgasratio;refractiveindex;depositionrate
1001-9731(2016)05-05227-04
教育部博士点基金资助项目(20120042110031)
2015-02-11
2015-10-09 通讯作者:张健,E-mail:zhangjian811029@163.com
张健(1981-),男,沈阳人,在读博士,师承巴德纯教授,从事功能薄膜开发及利用研究。
O484;TB43
A
10.3969/j.issn.1001-9731.2016.05.043

