P型栅增强型GaN功率开关器件的中子辐照效应
张得玺,陈 伟,罗尹虹,刘 岩,郭晓强
(西北核技术研究所,西安710024)
增强型器件也称为常关器件,是电力电子系统中功率开关器件的首选。实现氮化镓高电子迁移率晶体管(GaN HEMT)增强型的方法很多,其中P型栅(也称PN结栅)方法最早由Hu等人提出[1]。该方法实现增强型的原理是:PN结栅自建电势场耗尽栅下二维电子气(2DEG),使沟道在不加正栅压时关闭。国内外对常规AlGaN/GaN HEMT器件在γ射线、电子、质子和中子等辐照环境下的特性退化开展了较多的研究[2-6],而针对增强型AlGaN/GaN HEMT器件的辐照效应研究相对较少。在对P型栅增强型器件的辐照效应研究中,Fiore等人认为,为了实现正阈值电压,P型栅增强型AlGaN/GaN HEMT器件额外引入的层结构很可能影响器件的抗辐射性能[7]。Abbate等人的实验结果表明,在辐照至γ总吸收剂量为10.8kGy(Si)时,P型栅增强型器件的总剂量效应和重离子辐照下发生的单粒子效应均不明显,但器件对能量为3MeV、注量为4×1014cm-2的低能质子辐照比较敏感,辐照后栅电流增大1个量级,阈值电压负向漂移1V,跨导减小30%[8]。因此,位移损伤可能是导致P型栅增强型GaN HEMT器件性能退化的主要因素。为了进一步了解P型栅增强型GaN HEMT器件对位移损伤效应的敏感性,本文选用塑料封装的P型栅增强型商用GaN功率开关器件(下文简称GaN功率晶体管)在反应堆中子环境下开展实验,研究了该器件对中子辐照的敏感性和位移损伤对其电特性的影响,重点探讨了为实现器件增强型引入的P型层结构对其抗辐射性能的影响。
1 实验样品与测试方法
1.1 样品器件及其工作原理
样品为日本松下公司的GaN功率晶体管,又称栅注入晶体管(gate injection transistor,GIT),如图1所示。它是一种基于GaN/AlGaN异质结的增强型功率开关器件,其单管工艺流程横截面如图2所示。P-AlGaN/i-AlGaN/GaN异质结生长在Si衬底上,异质结和衬底中间生长了缓冲层,缓冲层包括多层GaN/AlN层和AlGaN/AlN成核层。缓冲层中的每一层都有效释放了晶格匹配和热匹配在GaN中产生的应力。氮化物外延层的总厚度为4.7um。本征AlGaN层的Al原子分数为15%,厚度为25nm。通过对P型AlGaN进行选择光刻形成P型栅,其厚度为100nm,Al原子分数为15%。经仿真模拟测算,该器件P型栅的掺杂浓度大于1.0×1018cm-3。器件在使用硼离子注入法进行隔离后,在源漏栅极分别使用Ti、Al和Pd形成电极,钝化层则使用等离子增强化学气相沉积法(PECVD)淀积厚度为400nm的SiN,最后采用电镀Au实现互联。P型AlGaN栅长为2um,栅漏间距为7.5um[9]。

图1 GaN功率晶体管Fig.1GaN power transistors
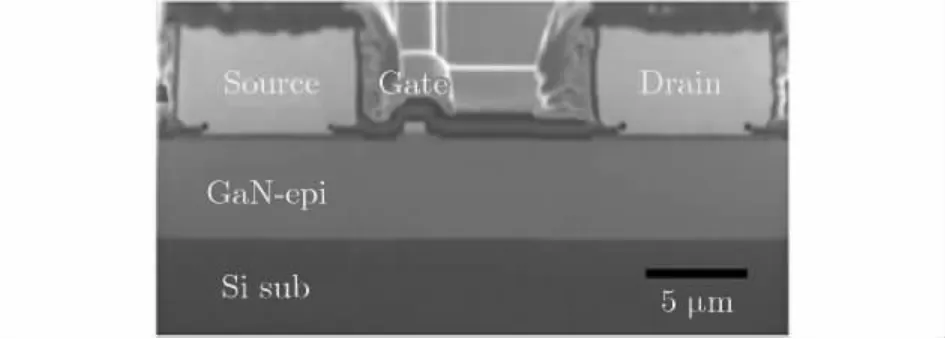
图2 GaN功率晶体管单管工艺截面图Fig.2Cross section of GaN power transistor
器件的工作原理如图3所示。一方面,势垒层形成具有内建电压VF的PN结,由于P型掺杂具有提高能带的作用,在栅压Vgs为0V时使栅下沟道电子耗尽,实现了增强型特性;另一方面,当0<Vgs<VF时,器件以场效应管原理工作,当Vgs>VF时,将使空穴从P型AlGaN注入沟道,而沟道电子向栅的注入被AlGaN/GaN界面势垒抑制。注入的空穴将从源极吸引等量的电子以保持沟道的电中性,这些电子在漏极电压的作用下不断以高迁移率到达漏极,而由于空穴迁移率比电子迁移率低2个量级,注入的空穴基本上位于栅下沟道区域。在保持较小的栅电流时,这种电导调制作用能够明显增加漏电流。和一般增强型器件的电流驱动能力相比,由于电导调制效应的介入,这种器件实现了较高的电流驱动能力[10]。

图3 GaN功率晶体管工作原理示意图Fig.3Schematic of the working mechanism of GaN power transistor
1.2 实验条件
利用西安脉冲反应堆1MeV等效中子进行辐照实验,中子注量率为3.18×1010cm-2·s-1,中子注量为 1.5×1015cm-2,累计 γ总吸收剂量约200krad(Si)。如前文所述,由于器件对电离辐照不敏感,因此在本实验中不考虑γ总剂量效应。为避免辐照时电应力对器件特性产生影响,辐照时未加偏置电压。
1.3 电参数测量
器件初始静态参数和辐照后静态参数测量均在型号为TESEC 3620TT的功率器件静态参数测试仪器上进行。该仪器测试的最高电压和最大电流分别为1 200V和200A,电压与电流的测试精度分别为1mV和3pA;阻抗测试范围为1mΩ~999.9MΩ。该仪器可用于功率器件击穿电压、阈值电压、导通电阻、栅极电流、漏极漏电流、跨导、脉冲电流以及源漏二极管正向压降等参数的测量。本文主要测量了与辐照效应相关的击穿电压、栅极电流和漏电流等参数。
2 实验结果与分析
对3只样品器件在反应堆中子环境下同时进行辐照,中子注量为1.5×1015cm-2。测试结果表明,3只样品的辐照结果基本一致,对其中1只样品的测试结果进行了分析。
图4为GaN功率晶体管中子辐照前后的转移曲线对比图。其中,Ids为漏电流,漏极电压Vds为5V。

图4 中子辐照前后GaN器件的转移曲线对比Fig.4Transfer characteristics of GaN power transistor before and after neutron irradiation
通过对实验数据和图4分析可知,辐照后转移曲线的斜率略有减小,阈值电压基本没有发生变化。电流较辐照前开始降低,降低量随着栅压增加先增大后减小,Vgs约为2.5V时,漏电流明显降低。转移曲线斜率变小的主要原因是中子辐照导致沟道电子迁移率减小。从辐照前后的转移曲线对比可以看出,阈值电压几乎没有发生漂移。
图5为辐照前后样品器件的输出特性曲线。可以看出,经中子注量为1.5×1015cm-2辐照后,Vgs>1.75V时,输出曲线同辐照前相比有所下降,表明饱和漏电流有所减小;Vgs=2V时,输出曲线平均下降约3.13%,饱和漏电流减小约0.5A;Vgs=2.25V时,输出曲线平均下降5%,饱和电流下降约0.8A。从实验数据可知,辐照后在阈值栅压附近漏电流变化较小,在栅压Vgs为1.6V附近,漏电流变大,但增量非常小;器件膝点电压附近漏电流变化最明显,最大降低量约达10%,漏电流的减小量接近1A。

图5 中子辐照前后GaN功率晶体管的输出特性曲线Fig.5Output characteristics of GaN power transistor before and after neutron irradiation
图6 为辐照前后器件关态漏电流Ids-off的对比图。在进行辐照时器件三端均悬空,测量参数期间Vgs始终保持0V不变,使器件处于关断状态。

图6 中子辐照前后器件关态漏电流对比g.6Off-state drain current vs.drain voltage for GaN power transistor before and after neutron irradiation
可以看出,经过中子注量为1.5×1015cm-2辐照后,在Vds<200V的区间,同辐照前相比,器件Ids-off明显增加,最大增幅达50%,增加0.3uA。
图7给出了GaN功率晶体管静态反向栅漏电流Igs在中子辐照前后的对比情况。可以看出,中子辐照后Igs没有发生变化,因此,Igs不属于中子辐照敏感参数。对于常规肖特基栅HEMT而言,中子辐照引起的缺陷会辅助电子隧穿,从而会导致正向和反向栅泄漏电流的增加。而P型栅结构的增强型器件,栅极由PN结构成,对陷阱辅助隧穿效应不敏感。因此,P型栅增强型HEMT器件的反向栅特性对中子辐照具有一定的免疫能力。由样品器件工作机理可知,正向栅泄漏电流比绝缘栅或其他栅结构HEMT的大,中子辐照对正向栅泄漏电流的影响有待进一步研究。

图7 辐照前后GaN功率晶体管静态反向栅电流对比Fig.7Off-state gate currents vs.gate voltage for GaN power transistor before and after neutron irradiation
3 GaN功率晶体管辐照损伤退化机理分析与讨论
GaN器件经中子辐照,在位移损伤作用下,不但感生出常见的空位缺陷,而且产生间隙原子和反位缺陷,间隙原子和反位缺陷在工艺过程中很难形成。中子辐照在GaN材料中产生的各类缺陷与材料中的原生杂质、人为掺杂杂质以及位错缺陷等发生复合,形成络合物,尤其会产生大的缺陷群落,各种类型的缺陷和各种形式的络合物在禁带中形成不等的缺陷能级,能量分布范围较大,可以从距离较近的能级到接近禁带中部。这些辐射感生缺陷在材料中可以是电子/空穴陷阱,通过俘获载流子起到减小载流子寿命和去除载流子的作用;还可以成为附加的散射中心,引起沟道迁移率的降低;对于肖特基栅,还有可能通过增加隧穿效应对器件的栅特性产生影响[9]。对于GaN HEMT器件,形成的缺陷还会影响AlGaN材料的极化特性,最终改变HEMT器件的极化电荷密度。
GaN样品器件输出特性曲线和关态漏电流在辐照前后发生明显变化表明,辐照导致样品器件性能出现退化。下面对器件的辐照退化机制进行讨论。
对HEMT器件,漏电流Ids近似为

式中,q为电子电荷;W 为栅宽;v(x)为电子漂移速度,与沟道电场和迁移率相关,迁移率为位移损伤敏感参数(辐照在沟道内形成的各类缺陷,能够使沟道中电子迁移率降低);ns(x)为薄层载流子浓度,即2DEG浓度,也与辐照相关。
辐照对2DEG浓度ns(x)的影响分为两种情况:
1)当Vgs<VF时,ns(x)为

其中,ε(x)为AlGaN层介电常数;x为AlGaN材料AlGaN层形成的自建电势;ΔEC(x)为异质结导带不连续能级差;Nd为AlGaN层掺杂浓度;NA为P型AlGaN栅掺杂浓度;d为AlGaN层厚度;ΔEF为量子势阱导带底部与费米能级之差;σ(x)为极化电荷密度。其中,最有可能受中子辐照影响的参数包括受NA影响的VF和σ(x)。辐照在器件各层引起的深能级陷阱通过俘获载流子对器件性能产生影响,载流子去除效应导致P型AlGaN层受主掺杂浓度NA的降低(AlGaN势垒层为未经过人为掺杂的弱N型,因此载流子去除效应对掺杂浓度Nd的影响可忽略),最终影响自建电势的变化。另外,辐照在势垒层形成晶格失序对极化效应产生影响,在势垒层形成的位移缺陷会导致极化电荷密度σ(x)的变化(压电效应对位移缺陷不敏感)。VF和σ(x)在辐照后发生改变都会导致ns(x)发生变化,最终影响漏电流改变。
2)当Vgs>VF时,ns(x)为

式(3)中,后一项表示注入沟道的空穴浓度。由器件的工作原理可知,基于电中性原理,栅注入空穴浓度与沟道层内参与导电的电子浓度的增量相等。经中子辐照后,除了VF和σ(x)发生改变之外,当栅压足够高,以至于器件出现空穴注入时,注入空穴浓度也会发生变化,最终会间接导致器件漏电流发生改变。
器件阈值电压可表示为

由式(4)可知,引起阈值电压漂移的因素有:1)载流子去除效应引起的P型栅有效掺杂浓度NA的降低会导致阈值电压发生负向漂移;2)辐照在势垒层形成晶格失序引起的极化电荷密度σ(x)的降低会导致阈值电压发生正向漂移。图4实验结果显示,阈值电压没有发生明显的漂移,有可能因为载流子去除效应导致的阈值电压负向漂移与势垒层位移缺陷导致极化电荷密度降低引起的阈值电压正向漂移之间发生了补偿。
器件关态漏电流Ids-off同样可由式(1)表示,Vgs=0V时,则

从式(1)和式(5)可看出,中子辐照下,可能影响关态漏电流的主要参数包括与沟道迁移率相关的v(x)、P型栅掺杂浓度NA以及极化电荷密度σ(x)。
漏电流的变化主要与3个参数相关,分别是与P型栅掺杂浓度相关的自建电势VF、与沟道迁移率相关的漂移速度v(x)以及极化电荷密度σ(x)。GaN功率晶体管样品器件经中子辐照后,产生载流子去除效应,会导致器件P型栅有效掺杂浓度的降低。由式(1)至式(3)可知,P型栅浓度降低会进一步导致漏电流增加。在沟道区域形成的缺陷会导致电子迁移率降低,从而影响电子漂移速度,最终导致漏电流减小。辐照在器件势垒层形成位移缺陷或晶格无序区域,会导致极化电荷密度降低,从而导致漏电流减小。从图5可以看出,当Vgs<1.7V时,漏电流随栅压增大略有增加,说明在栅压接近器件阈值电压附近时,中子辐照引起的载流子去除效应使P型栅的有效掺杂浓度NA减小,因此,低栅压情况下,漏电流较小,中子辐照引起的载流子去除效应占主导。当Vgs>1.7V时,漏电流较大,经中子辐照后,漏电流明显减小,表明位移缺陷对迁移率和极化电荷密度的影响占主导。
由器件的工作原理可知,器件的增强特性是通过P型栅耗尽栅下沟道电子实现的,因此,中子辐照产生的载流子去除效应对P型栅有效掺杂浓度的影响必然会导致沟道电子浓度发生变化。电子漂移速度v(x)和极化电荷密度σ(x)的减小会导致器件关态漏电流Ids-off减小,而P型栅有效掺杂浓度NA的降低会导致Ids-off增加。在器件处于关闭状态、漏电流非常小的情况下,中子辐照产生的缺陷造成v(x)发生变化,但对Ids-off的影响非常小。因此,线性区Ids-off的增大主要是由载流子去除效应引起的P型栅有效掺杂浓度降低造成的。图6中,当Vds>200V时,Ids-off受中子辐照后产生不规则变化,这是否受到其他机制的影响,目前尚无定论。
4 结论
对P型栅增强型GaN功率晶体管在反应堆1MeV等效中子环境下进行了辐照实验,中子注量为1.5×1015cm-2,研究了 GaN 功率晶体管对中子辐照的敏感性。结果显示,在中子辐照后,样品器件的转移曲线斜率减小;器件饱和区漏电流明显降低,最大降幅可达2A;器件的关态漏电流在辐照后明显增大;栅极反向泄漏电流在辐照后没有发生变化。分析表明,转移曲线斜率减小的原因是中子辐照导致器件沟道迁移率降低;饱和漏电流减小的主要原因是中子辐照引起沟道迁移率的降低和2DEG的退化;辐照前后器件的关态漏电流发生变化的主要原因是载流子去除效应导致P型栅有效掺杂浓度降低,从而弱化了P型栅对沟道电子的耗尽,这正是中子辐照引起P型栅退化的重要例证。器件栅极反向泄漏电流辐照前后没有发生变化,可能因为PN结栅对中子辐照引起的陷阱辅助隧穿效应不敏感。
研究表明,P型栅增强型GaN功率开关器件在大注量中子辐照下,最敏感的结构是为了实现增强型而额外增加的重掺杂P型栅,P型栅退化产生的最大影响是器件关态漏电流增加,最大增幅达50%,而器件反向栅泄漏电流对中子辐照具有一定的免疫力,中子辐照对器件正向栅泄漏电流的影响有待进一步研究。器件沟道迁移率、极化电荷密度等参数受中子辐照的影响与其他常规GaN HEMT器件中子位移损伤效应没有明显差异。下一步工作可开展该类器件的质子辐照效应研究。

