圆片级封装全硅梳齿电容式MEMS加速度计设计
牛昊彬,孙国良,王帅民,张方媛
(中国航空工业集团公司西安飞行自动控制研究所,西安 710076)
MEMS 加速度计具有体积小、成本低、功耗小、稳定性好等优点,广泛应用于军事、医疗、汽车和工业控制领域的加速度、振动、冲击和倾角等测试[1],是小型化惯性测量单元的核心组件。MEMS 加速度计按照检测原理的不同有电容式、压阻式、谐振式、光学类、隧道电流式等[2],其中电容检测由于具有良好的灵敏度、温度特性和动态特性,被中高端MEMS加速度计广泛采用。
电容式MEMS 加速度计通常采用面外运动的平板电容结构或者面内运动的梳齿电容结构[2-4]。相比梳齿电容结构的MEMS 加速度计,平板电容结构的MEMS 加速度计通常采用较大的敏感质量,机械灵敏度较高,有利于获得高精度。然而,随着深反应离子刻蚀(Deep Reactive Ion Etching,DRIE)技术和电路水平的提升,这种优势正在减弱。如今,梳齿结构的电容式MEMS 加速度计由于具备更优的过载能力和设计灵活性,正逐渐成为中高端MEMS 加速度计结构设计的另一种选择[4]。
本文给出了一种高精度梳齿电容式MEMS加速度计的结构设计、工艺实现和性能测试,其特点为采用了圆片级封装的全硅工艺方案,整表具备良好的封装形态和性能,适合小型化惯性测量单元集成。
1 结构设计
本文中加速度计的结构设计方案如图1所示,其由锚点、U型弹性梁、固定梳齿、可动梳齿和“日”字型的质量框组成,可动梳齿与“日”字型质量框共同构成加速度计的敏感质量。当受到水平向的外部加速度时,敏感质量将在水平方向移动,与左右对称布置的固定梳齿形成差分电容。
加速计为典型的二阶系统,系统方程为
其中,m为敏感质量,x为敏感质量的位移,b为结构粘性阻尼系数,k为弹性梁刚度,a为外部加速度。
式(1)可等效为

常值加速度输入稳定后,式(2)可简化为

可见,敏感质量和弹性梁刚度决定了加速度计的灵敏度,而选择相对较小的梳齿间隙则有利于提高单位输入下的差分电容变化量,从而有利于提高加速度计的电容灵敏度和信噪比。在闭环工作模式下,反馈电压产生的静电力对惯性力的平衡能力决定了加速度计的量程,其由基础电容、梳齿间隙、敏感质量和反馈电压等共同决定。基于上述考虑和实际工艺能力约束,本文加速度计结构的主要参数设计如表1。结构有限元仿真结果显示该加速度计一阶谐振频率为1918.46Hz,工作模态如图2。

表1 主设计参数Tab.1 Maindesignparameters

图2 加速度计一阶模态Fig.2 The first modeof theaccelerometer
噪声水平是衡量加速度计性能潜力的重要指标,本文中加速度计采用常压封装,其理论机械噪声水平

式(4)中KB为玻尔兹曼常数,T为绝对温度。
2 工艺实现
本文加速度计采用三层全硅工艺方案,其剖面示意图如图3,由上层盖板、中间结构层和下层电极引出层组成。其中,电极引出层的硅通孔有两种类型,一种用以敏感质量和固定梳齿的锚点电信号引出(图3左孔),另一种用以电极层、盖板和结构层外圈密封结构的接地(图3右孔)。

图3 剖面示意图Fig.3 Structural cross-section diagram of the accelerometer
本文中加速度计采用圆片级硅-硅键合封装,该工艺对圆片表面质量要求较高,在流片过程中有必要对硅片表面进行保护,避免损伤或污染。基于此,本文加速度计的工艺流程设计如图4。

图4 工艺流程Fig.4 Process flow of theaccel erometer
首先制作用以芯片封装的盖板和用以电信号引出的电极引出层。
选用100晶向p型硅片,采用热氧工艺在硅片表面氧化一层厚度约8000Å 的SiO2;采用该SiO2层作为湿法腐蚀的掩膜,利用KOH 溶液在其中一面腐蚀出一个深度约20μm 的空腔,此即盖板。将盖板表面剩余的SiO2漂洗干净备用。
另取一氧化片,以SiO2层为掩膜,采用DRIE 工艺刻蚀出深度约80μm的盲孔和间隙;将圆片去胶、清洗并沉积一层厚度约800Å 的Si3N4;以该Si3N4膜层为掩膜,从圆片的另一面采用KOH 溶液湿法腐蚀锥形孔直至与干法刻蚀的盲孔贯穿,形成导通孔;去除剩余的Si3N4和SiO2膜层,然后采用热氧工艺在圆片及导通孔表面制备一层厚度约2μm的SiO2绝缘层,此即电极引出层圆片。
将电极引出层圆片与一50-1-300μm 的SOI片的结构层硅-硅键合,然后采用干法刻蚀去除SOI片的支撑层,再将埋层的SiO2漂洗干净,完成圆片减薄;将减薄后的圆片清洗、光刻、干法刻蚀,完成加速度计敏感结构制作。将刻蚀完成的圆片去胶、清洗,并与准备好的盖板圆片硅-硅键合,完成加速度计芯片的圆片级封装;最后采用反应离子刻蚀将接地孔中的SiO2刻蚀干净,蒸镀Al完成引线电极制作。

图5 V191101号圆片芯片测试结果Fig.5 Chiptest results of wafer 5V191101
流片完成的圆片先进行芯片筛选,测试合格后方可与电路一起封装成整表。本文加速度计芯片筛选采用质量块可动性测试方法[5]。图5是一典型圆片的芯片测试结果统计,圆片上共有308只加速度计芯片,其中合格芯片198只,合格率约68%。图6为划片后加速度计芯片实物,尺寸约4×4×0.85mm3。

图6 加速度计芯片实物Fig.6 The accelerometer chips
3 性能测试
本文加速度计电极引出层为硅材料,其与结构层间的SiO2绝缘层厚度约2μm,锚点、电极引线与电极引出层间存在较大的寄生电容,其简化模型如图7,其中C1和C2为有效电容,Cm-g为敏感质量锚点及其电极引线与电极引线层间的寄生电容,Cp1和Cp2为固定梳齿及其引线与电极引线层间的寄生电容。为了消除寄生电容的影响,芯片使用时须将电极G 接地。
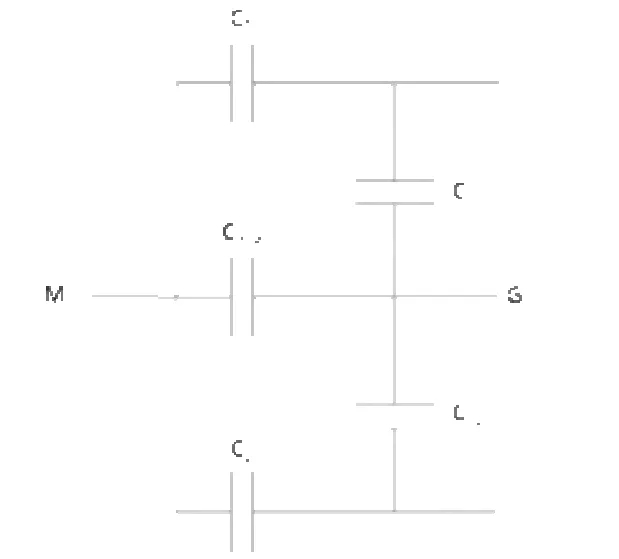
图7 寄生电容模型Fig.7 Parasitic capacitance model
为了对本文加速计的性能进行评估,随机抽取8只合格加速度计芯片与模拟ASIC电路低应力陶瓷管壳封装(如图8),封装尺寸为12.7×12.7×3.25mm3。
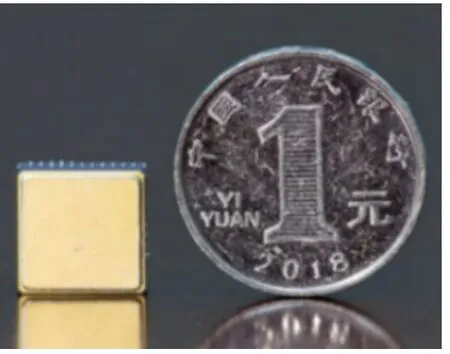
图8 加速度计陶瓷管壳封装Fig.8 The accelerometer packaged in cera micshell
使用加速度计测试系统对该8 只加速度计的零偏、标度因数等技术和性能指标进行测试。
1)常温条件下,采用四点法测试加速度计的零偏和标度因数。
测试结果如表2,8 只加速度计的零偏均小于200 mg,标度因数约80 mV/g,量程大于±50g。

表2 零偏和标度因数Tab.2 Zero deviation and scale factor of the accelerometers
2)常温条件下,测试加速度计的0g输出稳定性。
测试时间为1 h,8 只加速度计的0g输出稳定性均小于100 μg(1σ)。图9为1#加速度计上电1 h 的输出曲线。

图9 1#加速度计0 g 稳定性Fig.9 Stability of No.1 accelerometer at 0 g
3)常温条件下,测试加速度计的零偏和标度因数稳定性。
一次通电条件下,连续测试7 次四点法,计算每次四点法加速度计的零偏和标度因数,取7 次测试结果的标准差,得8 只加速度计的零偏和标度因数稳定性如表3。该8 只加速度计的零偏稳定性均优于100 μg(1σ),标度因数稳定性均小于30 ppm。
4)常温条件下,测试加速度计的零偏和标度因数重复性。
常温保温1 h,采用四点法测试得到加速度计的零偏和标度因数,然后断开加速度计电源,1 h 后重新上电,进行第2 次四点法测试,如此重复测试7 次。求得7 次测试零偏和标度因数的标准差,得8 只加速度计的零偏和标度因数重复性,结果如表4。该8 只加速度计的零偏重复性均优于100 μg(1σ),标度因数重复性均小于30 ppm。

表3 零偏和标度因数稳定性Tab.3 Zero deviation and scale factor stability

表4 零偏和标度因数重复性Tab.4 Zero deviation and scale factor repeatability of the accelerometer
5)温度滞环测试。
将加速度计置于 0g位置,测试加速度计在-40 °C~+70 °C 升降温过程中的输出,8 只加速度计的零偏全温漂移均小于20 mg。典型的温度滞环曲线如图10所示,该加速度计的零偏全温变化约为18 mg,最大滞环小于1 mg。

图10 温度滞环曲线Fig.10 Temperature hysteresis curve of the accelerometer
4 结 论
本文介绍了一种圆片级封装的全硅梳齿电容式MEMS 加速度计的设计、制造和测试。小批量测试结果显示该加速度计标度因数约80 mV/g,0g输出稳定性优于100 μg(1σ),短期零偏稳定性和重复性均优于100 μg(1σ),-40 °C~+70 °C 范围内的零偏漂移小于20 mg。该加速度计形态优异,性能良好,能够满足小型化惯性测量单元的集成需求,具备较广的应用潜力。

