原子力显微镜探针表征烷烃及正烷类有机化合物的研究
(吉林大学 物理学院,长春 130012)
1 引言
原子力显微镜(AFM)[1]是一种具有原子级高分辨的仪器,可以在空气或液体环境下对样品的物理性质进行探测,也被用来直接进行纳米操纵[2]。AFM被广泛应用于半导体、纳米功能材料、生物、化工、食品、医药研究等相关学科的研究领域中,成为纳米科学研究的基本工具。原子力显微镜通过监测样品和悬臂探针上探针针尖之间的相互作用来表征小到原子尺寸样品表面的特征。通过在探针针尖和样品之间提供相对扫描移动,可获得样品的特定区域上的表面特征数据,并可产生样品的对应图谱。在操作中使探针针尖非常靠近待检查的样品的表面或与所述表面相接触,并且悬臂响应探针针尖与样品的相互作用通过光杠杆系统的偏转由检测器测量。探针被固定在高分辨率三轴扫描器在样品表面上方进行扫描。同时测量样品的形貌、弹性或一些其它表面性质。
AFM可设计成以包括接触模式和振动模式[3]的两种模式操作。在接触模式操作中,显微镜通常使探针针尖在样品表面扫描,通过保持探针针尖在样品表面上的力大体恒定来获得样品形貌。AFM还可以采用轻敲模式操作,探针针尖通常以接近探针悬臂的共振频率振动,利用响应于探针针尖-样品的相互作用而产生的反馈信号使此振动的振幅和相位在扫描期间保持恒定。如接触模式中的那样,这些反馈信号然后被收集、存储并用作表征样品特征的数据。无论具体操作模式如何,AFM都能够通过使用压电晶体扫描器、光杠杆偏转检测器和采用半导体蚀刻技术加工的非常小的悬臂而在空气、液体或真空中的多种多样的绝缘或导电面上获得小到原子级的分辨率。因为它们的分辨率和多功能性,AFM在许多不同领域中是特别重要的测量装置。典型AFM探针包括:具有自基部延伸的固定端部的悬臂;以及附连于悬臂自由端的探针针尖。
像任何测量工具一样,探针针尖的尖锐度很大程度上决定了原子力显微镜的分辨率,测量精度也受到探针弹性系数的影响[4]。目前大规模使用的AFM探针都是基于单晶硅材料。本研究考察了形成尖锐度高、一致性好的探针针尖的具体工艺实现,并对其进行了表征测量。
2 工艺流程
由于干法刻蚀硅无法保证形成针头的尖锐度和一致性,利用单晶硅不同晶向在特定溶液中刻蚀速度不同的特点,湿法刻蚀成为获得高质量探针针尖的广泛选择[5]。其中,利用高掺杂硅做为阻挡层的电化学刻蚀法和利用绝缘体上的硅SOI晶圆片都被采用过,但由于价格昂贵及工艺复杂而没有得到大规模应用。

图1 工艺流程图A.双面抛光单晶硅片上生长二氧化硅和低应力氮化硅;B.在硅片背面光刻并RIE刻蚀氮化硅;C. BOE刻蚀二氧化硅,KOH各向异性刻蚀单晶硅,并在一定深度停止刻蚀;D.在已刻蚀的硅片上生长低应力氮化硅作为悬臂层;E. 在硅片正面光刻,RIE刻蚀氮化硅形成刻蚀探针针尖的掩膜;F. 去除光刻胶,BOE刻蚀二氧化硅,KOH各向异性刻蚀单晶硅形成针尖,氧化炉氧化硅针尖以使针尖更尖锐;G. 厚胶光刻工艺定义悬臂形状,在硅片背面蒸镀铝层作为支撑层,RIE刻蚀氮化硅;H. 去除光刻胶,去除硅片背面的铝层,BOE去除针尖上的二氧化硅氧化层,清洗吹干,在硅片背面蒸镀钛金,悬臂背面的钛金层作为光斑的反射层。
工艺流程如图1所示。在双面抛光的单晶硅片上通过氧化生长二氧化硅,再生长低应力氮化硅作为湿法刻蚀单晶硅的阻挡层。在晶圆片的背面涂覆光刻胶,利用硅片的平边<110>晶向作为对准标记用掩膜光刻,反应离子刻蚀RIE氮化硅。缓冲氧化物刻蚀液BOE刻蚀二氧化硅。氢氧化钾KOH各向异性刻蚀单晶硅,刻蚀过程中取出硅片测量刻蚀厚度,在达到一定刻蚀深度时停止KOH刻蚀,去离子水清洗,烘干。放回低压化学气相沉积LPCVD炉中生长低应力氮化硅作为探针悬臂的材料层。在硅片的正面光刻,RIE刻蚀氮化硅以形成探针刻蚀掩膜。去除光刻胶,BOE刻蚀二氧化硅,KOH各向异性刻蚀单晶硅形成针尖。使用厚胶光刻工艺,在覆盖探针的同时定义悬臂图形,RIE刻蚀氮化硅前在硅片及悬臂氮化硅层背面蒸镀一层铝作为RIE刻蚀的支撑层。
去除光刻胶,BOE去除覆盖在针尖上的二氧化硅,同时去除铝层。最后,蒸镀金层作为光斑的反射层,在蒸镀金前蒸镀一层钛作为金和氮化硅之间的粘结层。整个探针加工完毕,使用时用镊子夹住探针的基座掰断连接探针和晶圆片框架的连接端即可。
3 工艺实现
研究中使用新欧科技的4英寸n掺杂(100)双面抛光单晶硅片300 μm厚度, 200 nm的二氧化硅通过湿法氧化生长在硅片表面,然后再用LPCVD生长200 nm的低应力氮化硅,这层氮化硅将作为湿法刻蚀硅的掩膜,而二氧化硅层作为中间过度层。
然后,在晶圆片上涂覆光刻胶Shipley S1813, 涂覆旋转速率4000 r/min,时长1 min, 1150C烤盘烘烤1 min,冷却。使用Karl Suss公司的MA6接触式光刻机进行光刻,以晶圆的平边<110>晶向作为校准线与背面图案光罩上的对准标记进行光刻对准,以保障后续刻蚀硅晶向的准确性,曝光时间7 sec,使用MF-321显影液漂洗1 min, DI水清洗,氮气吹干。在显微镜下检查光刻图案的完整性。使用AST公司Cirie-200等离子刻蚀RIE机刻蚀氮化硅,并穿透入二氧化硅层约50 nm。使用H2SO4及H2O2混合液去除光刻胶,DI水清洗,氮气吹干。6∶1 BOE刻蚀二氧化硅3 min,DI水清洗。将硅片平放浸入装有KOH的玻璃皿中,玻璃皿通过水浴槽来保持恒温60oC,水浴槽放置在磁力搅拌器上,带动玻璃皿底部放置的磁力搅拌棒对KOH溶液进行缓慢搅拌,以保障化学反应的均匀、连续进行。30%化学纯氢氧化钾KOH被用来作为湿法刻蚀试剂,单晶硅(100)晶面在溶液中的刻蚀速率约0.25 μm/min。在刻蚀过程中,硅片被不断取出,清洗并测量,再刻蚀,清洗并测量,直到刻蚀深度达到290 μm,KLA-Tencor AlphaStep台阶仪被用来测量刻蚀深度。刻蚀完成的晶圆局部显微镜照片如图2所示,显示了两个完整单元的探针器件,图中白色区域为刻蚀深度达到290 μm的区域,探针基底尺寸为1.5 mm × 3.5 mm 。将刻蚀过的晶圆片重新放入LPCVD炉内生长500 nm厚度低应力氮化硅。

图2 背面刻蚀图案
在晶圆片的未被刻蚀面上涂覆光刻胶Shipley S1813,使用针尖光罩进行光刻,参数与前述光刻相同。在显微镜下检查光刻图案的完整性。使用RIE刻蚀氮化硅,并穿透入二氧化硅层约50 nm。使用H2SO4及H2O2混合液去除光刻胶,DI水清洗,氮气吹干。6∶1 BOE刻蚀二氧化硅3 min,DI水清洗。将硅片平放浸入装有30% KOH的玻璃皿中,玻璃皿通过水浴槽来保持恒温60℃。
在刻蚀过程中,硅片被不断取出,清洗并测量,再刻蚀,清洗并测量,直到针尖掩膜图案脱落,探针针尖刻蚀成型,针尖刻蚀过程的扫描电镜图如图3所示,其中浅颜色的图案是作为刻蚀掩膜的低应力氮化硅膜,中心位置的深色区域是尚未刻蚀完成的单晶硅。刻蚀图案尺寸的选择保障了在形成探针针尖的同时,硅晶圆片上剩余的10 μm单晶硅也被完全刻蚀干净,探针针尖完全由500 nm的低应力氮化硅支撑并与硅晶圆连接成为一个整体。探针刻蚀完成的晶圆形貌如图4所示,透明褶皱区域是悬空的低应力氮化硅薄膜,对应的是图2中从晶圆背面刻蚀到290 μm的区域,在背面刻蚀掩膜的设计上,尽量缩小了悬空氮化硅薄膜的面积,以保障薄膜在整个工艺加工中的完整性。

图3 探针针尖刻蚀过程图
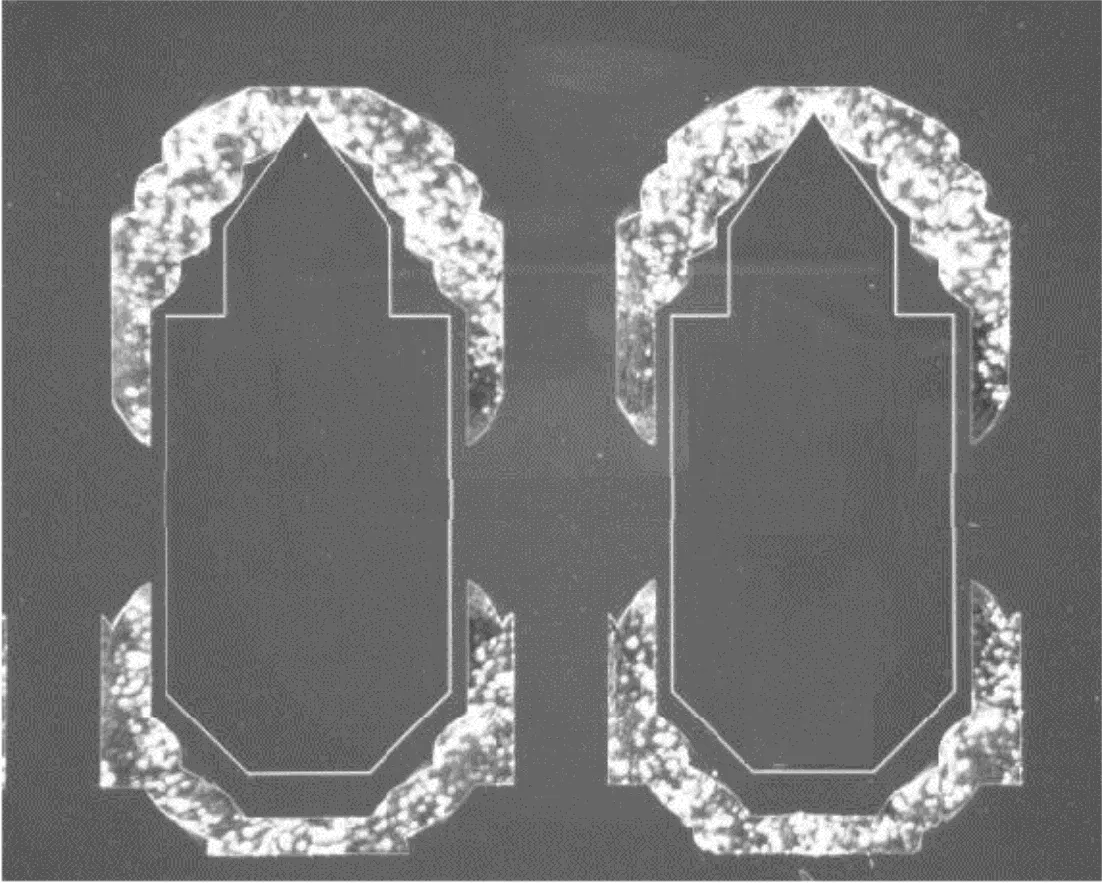
图4 探针针尖刻蚀完成后晶圆局部图
完全中心对称形状的探针掩膜图案在湿法刻蚀单晶硅从而形成尖锐的探针针尖过程中对晶圆的晶向错位极其敏感,且晶圆本身加工中晶向的偏差以及光刻中具体工艺操作引起的对准偏差,都使得这类掩膜图案不适合在用来生成尖锐探针针尖。虽然晶圆本身的晶向偏差可以通过在晶圆上先刻蚀V型槽来准确定义晶向,但这对光刻工艺的对准偏差没有帮助,实验中没有考虑增加这一步骤,而是通过使用高品质的硅晶圆来降低相关偏差引起的实验结果的准确性。类似风筝形状的非中心对称四边形掩膜图案对晶圆晶向及光刻对准偏差影响不很敏感,从非对称的两侧由不同角度刻蚀使探针针尖最终的形貌更趋于一致,且尖锐度给出了最适合工艺加工的探针针尖形态,并可实现纳米级别的探针针尖尖锐度。500 nm的二氧化硅通过湿法氧化生长在硅片表面,即覆盖针尖,在接下来工艺过程中保护针尖,并使针尖更尖锐[6]。
接着实验采用厚胶光刻工艺来定义氮化硅悬臂形状,此时晶圆片部分位置仅有500nm厚的氮化硅,操作过程中要小心,在晶圆正面涂覆光刻胶Shipley SPR220, 涂覆旋转速率2000 r/min,时长1 min, 1150C烤盘烘烤3 min,冷却。接触式光刻曝光时间20 sec,使用MF-321显影液漂洗6 min, DI水清洗,氮气吹干。
使用Ulvac公司的ei-5公司金属蒸镀机,在晶圆背面蒸镀100 nm铝作为后续氮化硅干法刻蚀的支撑层。使用RIE刻蚀氮化硅。氧气等离子刻蚀去除光刻胶。MF-321显影液去除晶圆片背面的铝层。BOE去除针尖上的二氧化硅层,清洗吹干。使用金属蒸镀机在硅片背面蒸镀5 nm钛和50 nm金,钛作为金和氮化硅之间的粘合层,悬臂背面的钛金层在AFM使用中起到对光斑的反射作用。完成的硅针尖在氮化硅悬臂上的扫描电镜图如图5所示。

图5 探针悬臂图
4 表征测量
由于针尖部位的尖锐度接近扫描电镜的分辨率,实验采用已知长度特性的纳米材料来间接表征探针。表征中使用唯易科公司的Multimode AFM,对探针进行性能测试。
扫描面积200 nm × 200 nm,扫描频率1 Hz。测试材料为自组装生长的三十六烷烃,其链间距约为4 nm,利用探针可以清晰的分辨出来层距,如图6、图7所示,即证明探针针尖的曲率半径ROC小于2 nm。
保持扫描面积不变,进一步加大扫描频率至22 Hz,可以看到在保障分辨率的同时,探针已经基本满足视频扫描需求[7]。
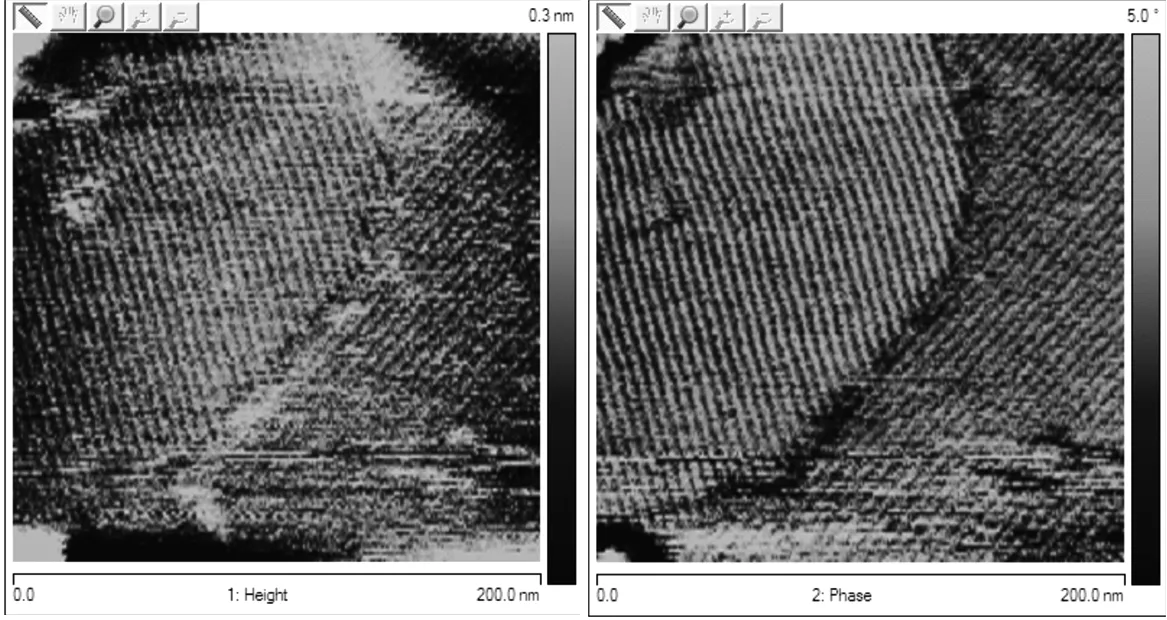
图6 三十六烷烃AFM扫描图片

图7 三十六烷烃AFM扫描图片
对正六十烷样品进行测试,扫描面积400 nm × 400 nm,扫描频率40 Hz,如图8所示。

图8 正六十烷AFM扫描图片
通过在晶圆上下左右、中心,选取5个探针器件的进行表征测量,均得到类似的结果,证明了工艺的片上一致性。
本研究工艺实现了硅针尖集成氮化硅悬臂的AFM探针,通过对三十六烷烃和正六十烷的表征测量,证明了针尖的纳米尺度尖锐度。在保持扫描精度的同时达到视频扫描标准。

