低气压感性耦合等离子体源模拟研究进展*
张钰如 高飞 王友年
(大连理工大学物理学院, 三束材料改性教育部重点实验室, 大连 116024)
感性耦合等离子体源具有放电气压低、等离子体密度高、装置结构简单等优点, 因此常被用于材料刻蚀及表面处理工艺中.为了深入了解感性耦合等离子体的特性及其与表面的相互作用, 数值模拟成为了目前人们普遍采用的研究手段之一.针对具体问题, 可以选择不同的模拟方法, 如整体模型、流体力学模型、流体力学/蒙特卡罗碰撞混合模型、偏压鞘层模型、粒子模拟/蒙特卡罗碰撞混合模型等.其中, 整体模型计算效率最高, 常被用于模拟复杂的反应性气体放电.但整体模型无法给出各物理量的空间分布, 因此二维及三维的流体力学模型, 也得到了人们的广泛关注.在低气压等极端的放电条件下, 由于电子能量分布函数显著偏离麦氏分布, 则需要耦合蒙特卡罗碰撞模型, 来精确地描述等离子体内部的动理学行为.此外, 通过耦合偏压鞘层模型, 还可以自洽地模拟鞘层的瞬时振荡行为对等离子体特性的影响.对于等离子体中的非局域及非热平衡现象, 则需要采用基于第一性原理的粒子模拟方法来描述.最后对目前感性耦合放电中的前沿问题进行了展望.
1 引 言
早在1884 年, Hittorf[1]通过激发缠绕在真空管外侧的线圈, 首次观察到感性放电, 即“无电极的环形放电”.随着人们对感性放电认识的不断加深, 感性放电得到了进一步发展.目前, 等离子体材料处理工艺中普遍采用的感性耦合等离子体(inductively coupled plasma, ICP)源, 具有如下两种结构: 当驱动线圈处在一个平面内, 被置于放电腔室上方时, 称为平面线圈ICP 或盘香形线圈ICP; 当驱动线圈缠绕在介质管的外侧时, 称为柱状线圈ICP[2].
在感性耦合放电过程中, 当在线圈中通入环向电流后, 会在整个放电装置内部激发出交变的磁场.根据法拉第电磁感应定律, 交变的磁场又会感应出环向电场.在该电场的作用下, 放电腔室内部的电子被加速, 通过电离碰撞等过程产生等离子体, 这一放电模式被称为感性模式(或H 模式).如果线圈中通入的电流较低时, 线圈两端存在较高的电压降, 此时的放电主要由容性耦合产生的静电场来维持, 这一放电模式被称为容性模式(或E 模式).与H 模式相比, 当放电处于E 模式时, 电子密度较低, 鞘层较厚, 实验中观测到的发光强度较弱.由于在感性耦合放电中存在两种放电模式, 当往返调节通入线圈的电流或功率时, 会观察到模式转换[3−6], 甚至回滞现象[7−10].
在感性耦合放电中, 尤其是当放电处于H 模式时, 大量的电子在感性电场的作用下做环向运动, 增加了与背景气体碰撞的概率.因此, 即使在较低的气压下, ICP 源仍具有较高的等离子体密度.与传统的容性耦合等离子体(capacitively coupled plasma, CCP)源相比, ICP 源的密度要高1—2 个量级.此外, 在ICP 放电中, 功率是通过介质窗或器壁耦合给等离子体, 即在反应腔室内部并不需要高压电极, 这显著地降低了鞘层电势降,并有效地抑制了由于高能离子轰击而引起的污染及介电损伤.在CCP 源的发展历程中, 为了实现对离子能量和离子通量的独立控制, 人们采用双频源来驱动放电.而在ICP 源中, 同样可以通过在放置衬底的电极上施加一个容性耦合的射频偏压源,来实现这种独立调控[11−14].
正是由于ICP 源具有上述优点, 因此得到了人们越来越广泛的关注[15,16].但在实际的等离子体材料表面处理工艺中, 放电腔室内部类似于一个“黑匣子”, 即人们对放电过程知之甚少, 只能通过材料表面的处理结果来推测所产生的等离子体的特性参数.的确, 等离子体放电过程是极其复杂的.首先, 在实际的工艺过程中, 普遍采用反应性气体(如O2, CF4, Cl2, HBr 等)或更为复杂的混合气体放电.在反应腔室内部, 除了大量的电子和各种正离子外, 还可能存在多种多样的负离子、处于激发态的粒子及中性基团等.各种粒子的不同属性, 使得反应腔室内部存在复杂的物理化学过程.除了放电气体的组分外, 等离子体的状态还受到多种其他外界参数的影响, 如气体的流速、气压, 电源的频率、功率, 腔室的几何尺寸和材料属性等.此外, 在ICP 源内部, 各物理量的变化存在多个空间尺度和多个时间尺度, 如图1 所示.例如, 反应腔室的尺寸在cm 到m 的量级, 而电极表面的鞘层厚度为µm 到mm 的量级, 刻蚀槽的线宽则在nm 量级.在时间尺度方面, 电磁场变化的特征时间为ns 量级, 等离子体输运的特征时间为µs 量级, 而表面化学反应的特征时间为s 量级.
面对如此复杂的等离子体源, 如果无法对其内部的放电过程进行深入了解, 将在很大程度上限制对材料刻蚀及表面处理机制的理解.目前, 人们普遍采用的研究方法有实验诊断和数值模拟.在实验诊断方面, 通常是在ICP 源上搭载不同的诊断系统, 如探针、光谱、质谱仪等, 以实现对等离子体各状态参数的实时监测.与实验诊断相比, 仿真模拟具有成本低、输出参数全面等优点.因此, 仿真模拟可以作为一种经济、高效的手段, 用来预测工艺结果、优化工艺过程, 并为ICP 源的进一步发展提供科学依据.
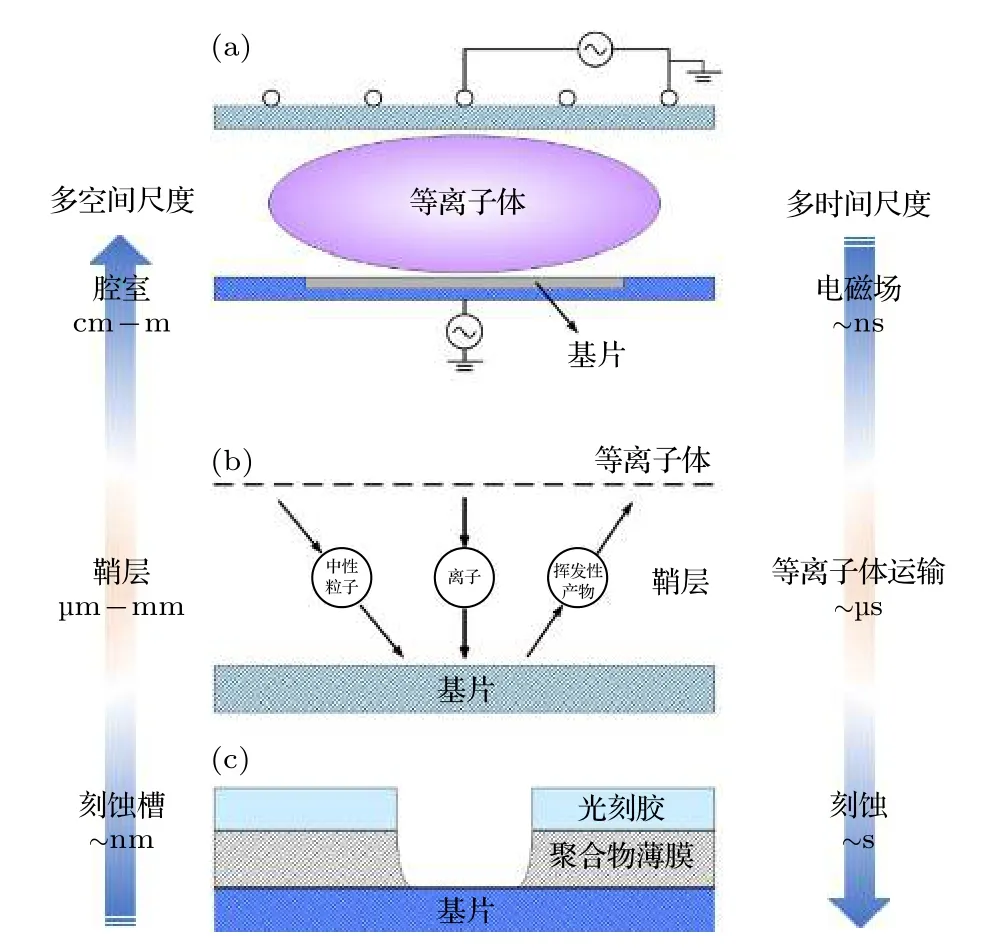
图1 多时间尺度和多空间尺度变化示意图Fig.1.Schematic diagram of multi-scale variations.
目前, 在ICP 源的模拟研究方面, 采用的模型主要有整体模型、流体力学模型、流体/蒙特卡罗碰撞混合模型、偏压鞘层模型和粒子模拟.本文将详细介绍这五种模型, 以及近年来所取得的研究进展, 并对ICP 源的下一步发展进行展望.
2 整体模型
2.1 理论模型
整体模型, 又称零维模型, 即在模型中不考虑各种物理量的空间维度.正是由于该模型忽略了等离子体的空间变化, 因此计算效率较高, 常被用于定性地分析等离子体状态随外界放电参数的演化规律, 尤其适用于复杂的混合气体放电.
在整体模型中, 通过联立求解各种粒子的粒子数平衡方程及能量平衡方程, 来确定各种粒子的数密度和电子温度[17−20].其中, 第j类粒子的粒子数平衡方程为
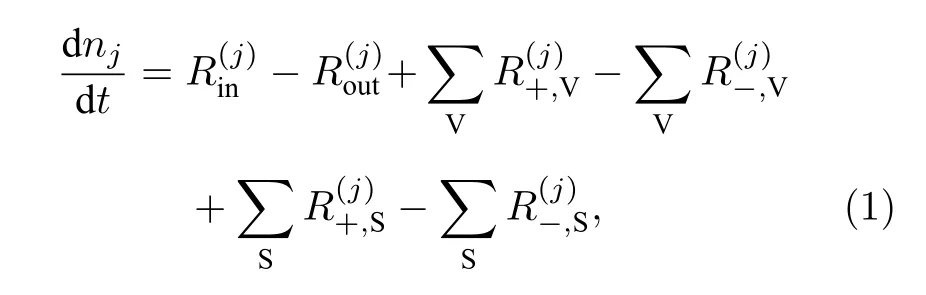
其中nj为第j类粒子的密度.可以认为当放电达到稳态后, 第j类粒子的产生和损失相等.粒子的产生途径包括气体的泵入体区的化学反应和表面反应; 而粒子的损失途径包括气体的泵出体区的化学反应和器壁表面的碰撞过程气体的泵入源项为

其中Qin为气体的流速,V为反应腔室的体积.由于在实际的放电过程中, 只会泵入原料气体, 因此泵入源项只出现在原料气体的粒子数守恒方程中.
气体的泵出会导致粒子的损失

其中Pout为出口处的气压.由于负离子在鞘层电场的约束下, 只存在于放电腔室的中心处, 因此由于气体泵出而引起的损失只会影响中性粒子和正离子的密度.在模拟中, 通过调节Pout, 使得腔室内部的气压保持恒定.
以二体反应为例, 由于体区的碰撞而引起的第j类粒子的产生项和损失项分别为

其中,kV为体区碰撞反应的速率系数;n1,n2和n3分别为反应物的数密度.例如, 当发生电离反应e+A→2e+A+时, 电子e 及离子A+的产生项以及中性粒子A 的损失项为kiznenA.其中kiz为该电离反应的速率系数,ne和nA分别为电子e 和中性粒子A 的密度.当发生吸附反应 e +B→B−时, 负离子B–的产生项以及电子e 和中性粒子B 的损失项为kattnenB.其中katt为该吸附反应的速率系数,ne和nB分别为电子e 和中性粒子B 的密度.
第j类粒子在器壁表面的损失, 可以表示为

由于负离子被限制在放电腔室的中心处, 不会到达器壁表面而损失, 因此假设表面损失项仅会出现在中性粒子和正离子的粒子数守恒方程中.此外, 根据表面反应的具体产物, 需要在相应的粒子数守恒方程中添加表面反应的产生项例如,当发生表面反应 A++wall→A 时, 中性粒子A 的产生项以及离子A+的损失项为其中为该表面反应的速率系数,nA+为离子A+的密度.
对于中性粒子和正离子来说, 器壁表面的损失系数有所不同, 因此下面分开讨论.如果第j类粒子为中性粒子(下文中标记为n), 则损失系数为

其中,Λn是中性粒子的扩散长度, 在圆柱形腔室中, 其表达式为

Dn是中性粒子的扩散系数, 其表达式为

γn是中性粒子在器壁上的复合系数,是中性粒子的平均热速度,Tn,mn和λn分别是中性粒子的温度、质量和平均自由程;e是单位电荷;A是反应腔室的表面积,L和R分别是腔室的高度和半径.
对于正离子(下文中标记为i)而言, 其在器壁表面的损失系数为

其中uB,i是玻姆速度, 即正离子进入鞘层的最小速度.对于电正性等离子体来说, 玻姆速度的表达式为

在电负性气体放电中, 需要对玻姆速度进行修正

其中,mi是正离子的质量,αs是鞘层边界处的负离子密度与电子密度之比,γ−=Te/T−是电子温度Te与负离子温度T−的比值.
Aeff,i是正离子在器壁表面的有效损失面积

其中hL,i和hR,i分别是轴向和径向边界处的密度与中心处的密度之比.在电正性气体放电中

式中的第三项代表高气压条件下扩散过程对密度分布的影响.λi是正离子的平均自由程, J1(χ01) 是一阶贝塞尔函数,χ01≈2.405 是零阶贝塞尔函数的第一个零点.Da,i是正离子的双极扩散系数

其中Di是正离子的扩散系数,γ+=Te/T+是电子温度Te与正离子温度T+的比值.
在电负性气体放电中, 同样需要做修正.对于中等电负性的情况, 等离子体由一个电负性的核心区和一个电正性的边界区组成, 且核心区的负离子密度分布近似呈抛物线形状.需要注意的是: 在该电正性的边界区域内, 并非净电荷呈电正性, 而是此处的等离子体具有“电正性”的特点, 即等离子体由电子和正离子组成, 负离子密度近似为零.在此放电条件下, 边界处与中心处的密度比值为

其中,η=2T+/(T++T−) ,α0是放电中心处的电负度, 即放电中心处的负离子密度与电子密度之比.当有负离子存在时, 正离子的双极扩散系数修正为

随着电负性的提高, 电正性的边界区域会逐渐消失.当电负性进一步提高时, 负离子不再处于玻尔兹曼平衡态, 即电负性核心区的离子密度分布变得平坦(此现象一般出现在气压较高的情况下).此时, 边界处与中心处的密度比值可进一步表示为

当所有离子的密度确定后, 电子密度由准中性条件给出

其中qi为第i类正离子或负离子所带电荷量.
对于功率平衡方程, 可以认为当放电达到稳态后, 等离子体的吸收功率与损耗功率相等, 即

其中,Pabs表示电子从电源中吸收的能量.在ICP放电中, 如果在下电极上施加一个射频偏压电源,则该项表示线圈功率与偏压电源功率之和.PV表示电子在体区和中性粒子发生弹性及非弹性碰撞而引起的功率损失.当放电中存在多种中性粒子时, 该项需要对所有的中性粒子所引起的功率损失进行求和, 即

其中,n(l)和m(l)分别是第l类中性粒子的密度和质量;me是电子质量;和分别表示电子与第l类中性粒子发生弹性碰撞、电离碰撞及其他类型的非弹性碰撞的速率系数;分别表示电子与第l类中性粒子发生相应碰撞的阈值能.
方程(24)中的PW表示带电粒子流到器壁上引起的功率损失


其中Vs表示鞘层电势, 通过器壁处的通量平衡条件来获得.
2.2 研究进展
如前文所述, 整体模型常被用于研究复杂混合气体放电中的等离子体特性, 如Ar/H2[21], Ar/N2[22],Ar/Cl2[19,23], Ar/Cl2/N2[24], SF6/Ar[25], SF6/Ar/O2[26]等.Kimura 和Kasugai 假设电子服从麦克斯韦分布, 采用整体模型研究了Ar/H2[21]和Ar/N2[22]混合气体放电中气体组分对等离子体特性的影响, 并将模拟结果与实验测量结果进行了对比.如图2 所示, 在Ar/H2放电中, 随着H2含量的增加,离子密度显著增加, 并在H2含量高于20%时达到饱和; 由于Ar+-H2电荷交换碰撞反应的增强, Ar+离子密度显著下降.在Ar/N2放电中, 随着Ar 含量的增加, Ar+离子密度显著增加, 而当Ar 含量不超过80%时, N+和离子密度几乎不随气体组分而改变.
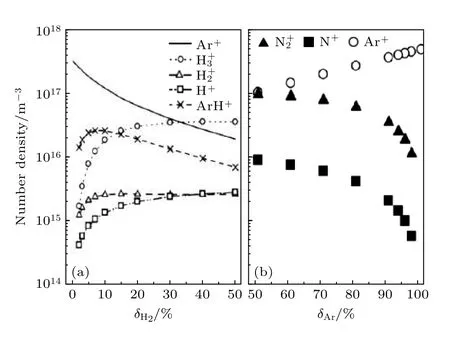
图2 (a)气压为20 mTorr (1 mTorr ≈ 0.133 Pa)时Ar/H2放电[21]和(b)气压为30 mTorr 时Ar/N2 放电[22]中的正离子密度Fig.2.Positive ion densities calculated in (a) Ar/H2 discharges at 20 mTorr and (b) Ar/N2 discharges at 30 mTorr.Reprinted from Ref.[21, 22], with the permission of AIP Publishing.
基于Cl2的等离子体常用于刻蚀工艺, 如多晶硅的刻蚀等.Thorsteinsson 和Gudmundsson[19,23]采用整体模型, 针对Ar/Cl2混合气体, 详细研究了连续波放电和脉冲调制射频放电中的等离子体特性, 并讨论了各种粒子的产生和损失过程.研究结果表明: 在连续波放电中, 随着Ar 含量的增加,Cl2分子的解离率增加, 电负性呈比例下降; 当Ar含量不超过70%时, Cl+离子的密度随Ar 含量的增加而增加.当射频源被脉冲调制时, 在脉冲周期的后辉光阶段, 电子密度和正离子密度迅速下降,而负离子密度则维持在较高水平.此外, 由于在实际工艺中, 粒子通量直接影响刻蚀的选择性及各向异性, 他们还讨论了时间平均的Cl 原子通量与正离子通量之比随Ar 含量等参数的变化趋势.Chanson等[24]在Ar/Cl2混合气体中加入N2, 并系统研究了N2含量对各种粒子密度的影响.研究结果表明:随着N2含量的增加, 电子密度有所降低, 电子温度有所升高; 电负性的变化主要依赖于气压.
SF6作为原料气体, 常被用于刻蚀硅及二氧化硅等材料.Yang 等[25]采用整体模型, 系统研究了SF6/Ar 混合气体中, 不同的线圈功率和气体比率下F 原子的产生和损失过程.图3 给出了当Ar 含量为30%时, 不同气压下F 原子的产生和损失速率.结果表明: F2的分解反应是F 原子最主要的产生渠道, 且该反应的速率随着气压的增加, 先增加后下降; F 原子在器壁表面生成F2, 是最主要的损失机制, 且该反应的速率也随着气压先增加后下降.

图3 SF6/Ar 放电中, 当Ar 含量为30%时, F 原子的(a)产生和(b)损失速率[25]Fig.3.Relative (a) creation and (b) loss reaction rates of F atoms, as a function of pressure, for Ar fraction of 30% in the SF6/Ar plasma.Reprinted with permission from Ref.[25].Copyright [2016], American Vacuum Society.
通过在混合气体中加入O2, 产生的O 原子可以增强侧壁表面的钝化过程, 从而降低横向刻蚀速率.Pateau 等[26]研究了SF6/O2/Ar 混合气体放电中, O2含量的影响.研究结果表明: 在几十mTorr(1 mTorr ≈ 0.133 Pa)的气压范围内, 当O2含量从0 增加至40%时, 尽管SF6的含量有所降低,F 原子的密度却有所增加.这主要是由于: 一方面,SF6的分解率随O2含量而增加; 另一方面, O 原子密度的增加会增强其与含F 类自由基的碰撞, 提高F 原子的产生率.此外, O(3p)是最主要的氧原子, 其密度随O2的含量而增加, 并在40% O2含量时达到最大值.
此外, 整体模型还常被用于研究某些特定的物理化学过程对等离子体特性的影响.例如, Annusova 等[27]在模型中考虑了41 个O2的振动激发态, 系统研究了低气压感性放电中的振动激发过程.研究结果表明: 模拟得到的O2(X,v= 4—18)密度与实验测量结果符合得较好; 除了负离子和臭氧分子外, 振动激发过程对其他粒子的密度影响较小.Le Dain 等[28]采用整体模型, 研究发现在C4F8放电中, 随着线圈功率的增加, 等离子体从电负性跳变为电正性.这是由于当功率较高时, C4F8在电子的碰撞作用下会分解成较轻的分子, 如CF2, CF 等.这些分子与电子发生碰撞电离, 生成大量电子, 因此等离子体的电负性显著下降.
3 流体力学模型
3.1 理论模型
在整体模型中, 通常假设等离子体是均匀分布的, 因此计算效率较高.但是, 采用整体模型无法得到各物理量的空间分布信息, 因此不能够完全满足感性耦合等离子体源的研究需求.
流体力学模型的基本思想是: 将等离子体看成一种流体, 通过一系列的流体力学方程, 来描述等离子体中各种粒子(如电子、离子、分子、自由基和激发态粒子等)的行为.在模拟过程中, 人们感兴趣的是等离子体的一些宏观行为, 如粒子的密度、平均速度和能量密度等.这些宏观物理量的空间分布, 可以通过求解只含有位置坐标和时间变量的宏观守恒方程, 即玻尔兹曼的各阶矩方程来获得.
首先, 将玻尔兹曼方程在速度空间上积分, 即可得到连续性方程.电子、离子和中性粒子的连续性方程如下所示:

其中ne,ni和nn分别表示电子、离子和中性粒子的密度,Γe为电子通量,ui和un分别为离子和中性粒子的速度.以二体反应为例,为电子的源项, 角标a表示产生电子的碰撞反应, 如电离反应、解吸附反应等; 角标b表示损失电子的碰撞反应, 如吸附反应、复合反应等;ka和kb表示碰撞反应的速率系数,n1,n2和n3表示反应物的密度.同理, 离子的源项为中性粒子的源项为
将玻尔兹曼方程两端乘以v后, 对速度积分,即可得到动量守恒方程.对于电子来说, 由于其质量很小, 通常可以忽略加速度项及惯性项.因此,电子的运动可以采用漂移扩散近似来描述:

其中,νen为电子与中性粒子的弹性碰撞频率,me和Te分别为电子的质量和温度,kB为玻尔兹曼常数,e为单位电荷,Es为电子所受的静电场力.
对于离子和中性粒子的输运过程, 则采用完整的动量方程来描述:

其中,mi和mn为离子和中性粒子的质量,∇pi和∇pn为离子和中性粒子的压力梯度项,Zi为离子所带电荷数.πn为中性粒子的黏滞压力张量

其中η为黏滞系数.当放电气压较低时, 通常不考虑等离子体与背景气体的黏滞输运过程, 即此项可以忽略.Mi和Mn分别表示由于离子与中性粒子碰撞而引起的动量转移, 表达式分别为


其中νin为离子与中性粒子发生弹性碰撞的频率.

其中qe为能流密度, 其表达式为

在方程(39)中,We表示电子由于碰撞过程而引起的能量损失, 表达式为

其中,εj表示电子在碰撞反应j中的能量交换,kj表示该反应的速率系数.当εj为正时, 表示电子通过碰撞过程损失能量, 如电离反应、激发反应等;当εj为负时, 表示电子通过碰撞过程获得能量, 如超弹性碰撞反应、退激发反应等.Pind为感应电场沉积功率

其中Jθ和Eθ分别为等离子体电流和感应电场的角向分量.在感性放电中, 如果考虑E 模式状态, 则还需要将等离子体电流和感性电场的径向分量和轴向分量的贡献包含进来.
离子和中性粒子的能量守恒方程分别为

其中,Cv,i和Cv,n分别是离子和中性粒子的热容,Ti和Tn分别是离子和中性粒子的温度,qi和qn分别是离子和中性粒子的能流密度,Ei和En分别是离子和中性粒子由于碰撞而损失的能量, 具体形式可参考文献[29, 30].对于低气压放电, 由于离子和中性粒子的温度远小于电子温度, 因此可以采用“冷流体”近似, 即认为离子及中性粒子的温度与室温相同, 从而避免求解能量守恒方程.
在放电过程中, 由于电荷分离而产生的静电场, 通过求解泊松方程获得

其中φ为静电势,ε0为真空中的介电常数.
由线圈中变化的电流引起的电磁场则通过麦克斯韦方程组来描述

其中E为感应电场;B为感应磁场;µ0为真空中的磁导率;J为等离子体电流, 表达式为

对于上述麦克斯韦方程组, 可以采用时域有限差分进行数值求解, 并将计算得到的感应电场和等离子体电流代入方程(42), 求解沉积功率Pind.
此外, 在单频放电中, 还可以对电磁场及等离子体电流做谐波近似, 即假设等离子体中的电磁场及等离子体电流随时间的变化是简谐的

其中,ω为电源的圆频率.在此假设下, 麦克斯韦方程组可以转化为

将(51)式两边取旋度, 将(52)式代入, 并利用广义欧姆定律J=σpE, 整理可得

其中c为真空中的光速;σp为电导率, 表达式为


通过求解方程(53), 即可获得电场各分量的空间分布, 及周期平均的感应电场沉积功率

需要注意的是, 上面介绍的方程, 是流体模型中包含的最基本的物理过程.当研究特定的物理问题时, 需要根据具体的放电条件对流体模型进行修正.
3.2 研究进展
Kudryavtsev 和Serditov[31]采用流体模型, 研究了双腔室ICP 源中的非局域现象.其中, 射频功率施加在源区, 通过电子的热传导过程传输到扩散腔室.研究结果表明: 在不同的气压下, 电子密度的空间分布有很大不同, 如图4 所示.当气压为50 mTorr 时, 放电处于局域状态, 即电子密度的最大值局域在源区.这是由于当气压较高时, 热传导过程的特征长度小于扩散过程的特征长度, 即电子主要在源区吸收能量并引起电离.当气压为5 mTorr 时, 热传导过程的特征长度有所增加.由于热量的快速传递, 电子温度在整个放电腔室内部的分布都比较均匀, 即源区和扩散区的电离过程相当.此外, 由于源区尺寸较小, 由扩散过程引起的粒子损失较多, 因此密度最大值出现在扩散腔室内部.

图4 当气压分别为(a) 50 mTorr 和(b) 5 mTorr 时, 双腔室ICP 中的电子密度分布[31]Fig.4.Two dimensional distribution of the electron density in the considered two-chamber ICP source for 50 mTorr(a) and 5 mTorr (b).Reprinted from Ref.[31], with the permission of AIP Publishing.
Sun 等[32]针对大面积平面线圈ICP 放电过程, 研究了双频双线圈参数对等离子体均匀性的影响.其中, 内侧五匝线圈, 频率在2.26—6.78 MHz范围内可调, 外侧两匝线圈, 频率固定为13.56 MHz.首先, 双频线圈的电流固定为10 A, 研究发现随着内侧线圈频率的降低, 内侧线圈附近的角向电场逐渐减弱, 而外侧线圈附近的角向电场基本不变.这使得电子密度的最大值从放电中心处逐渐向径向边缘处转移.当内侧线圈频率为3.39 MHz 时, 等离子体密度的径向均匀性最好, 如图5 所示.当固定内侧线圈频率为2.26 MHz 时, 随着内侧线圈电流从6 A 增加至18 A, 内侧线圈附近的角向电场显著增强, 放电中心处的等离子体密度有所提高.等离子体密度的径向分布从边缘高过度为中心高,径向均匀性在14 A 时达到最佳.
为了进一步优化大面积放电中等离子体的径向均匀性和角向均匀性, Brcka[33]提出了两种新型的多线圈驱动的ICP 放电装置, 如图6 所示.其中, 图6(a)为分布式多线圈ICP (distributed multiple ICP, DM-ICP), 即四个独立线圈均匀地分布在介质窗上方.图6(b)为集成式多线圈ICP (integrated multicoil ICP, IMC-ICP), 即四个线圈叠加放置在介质窗上方.在放电过程中, 每个线圈的电流、频率、相位等, 均会影响腔室内部的等离子体特性.例如在DM-ICP 放电中, 当四个线圈同相位时, 由于相邻位置的两个线圈内的电流方向相反, 感应磁场互相抵消, 放电过程受到抑制, 因此等离子体密度较低.而当相邻的线圈反相位时, 相邻线圈内的电流方向相同, 即等离子体的产生过程得到增强.
Zheng 等[34]也提出了一种新型的ICP 源装置, 即螺线管形线圈垂直放置于真空腔室内部, 线圈的接地端置于介质窗上方, 如图7 所示.与传统的平面线圈ICP 源相比, 该方法可以有效地降低等离子体与线圈之间的容性耦合.例如, 在平面线圈ICP 放电中, 随着吸收功率从0.1 W 增加至15 W, 介质窗下方的直流鞘层电势降的最大值从40 V 增加至100 V.这一幅值超过了介电材料的溅射能量阈值, 因此会引起介质窗的介电损伤, 并造成等离子体的严重污染.而在螺线管线圈放电中, 由于线圈的接地端置于介质窗上方, 即使当吸收功率为15 W 时, 介质窗下方的直流鞘层电势降的最大值仅为18 V.正是由于在螺线管线圈放电中, 介质窗上的电势降被有效抑制, 离子轰击到介质窗和腔室器壁上引起的能量损失显著下降.因此, 在相同的吸收功率下, 螺线管线圈ICP 源可以产生更高密度的等离子体.

图5 不同低频频率下的离子密度分布 (a) 6.78 MHz; (b) 4.52 MHz; (c) 3.39 MHz; (d) 2.26 MHz[32]Fig.5.Distributions of the ion density at different LFs: (a) 6.78 MHz; (b) 4.52 MHz; (c) 3.39 MHz; (d) 2.26 MHz.Reprinted from Ref.[32], with the permission of AIP Publishing.

图6 (a)分布式多线圈ICP; (b)集成式多线圈ICP[33]Fig.6.(a) DM-ICP and (b) IMC-ICP source configurations.Reprinted with permission from Ref.[33].Copyright (2016) The Japan Society of Applied Physics.

图7 螺线管线圈示意图[34]Fig.7.Schematic diagram of the solenoid coil.Reprinted from Ref.[34], with the permission of AIP Publishing.
Jeong 等[35]采用二维流体力学模型, 研究了在脉冲调制的带有偏压源的感性放电中电子密度和电子温度随时间的演化.其中, 线圈源始终采用脉冲调制, 偏压源状态可选关闭、连续波或同步脉冲调制.研究结果表明: 偏压源的状态对体区的等离子体参数和下极板表面的离子角度分布均有影响.Agarwal 等[36]采用三维流体力学模型, 研究了非轴对称的感性放电过程.其中, 放电由四匝分段线圈联合驱动, 角向分块的法拉第屏蔽被镶嵌在介质窗上方.研究结果表明: 线圈接地端的位置(如置于介质窗上方或法拉第屏蔽上方), 会显著影响放电腔室内部的电场分布, 进而改变等离子体密度的均匀性.
此外, 流体力学模拟还可以用来辅助解释实验现象.例如, Zhang 等[37]在实验上观察到在O2放电中, 当气压为10 mTorr 时, 基片表面的悬浮电势呈凸形分布; 当气压增加为100 mTorr 时, 悬浮电势呈凹形分布.由于在Ar 放电中, 并未观察到悬浮电势随气压的变化, 因此推测在O2放电中,悬浮电势的分布变化是由负离子引起的.模拟结果表明: 在O2放电中, 当气压较低时, 负离子被双极场限制在放电中心处; 随着气压的升高, 等离子体电负性增强, 双极扩散过程受到抑制, 正负离子密度的峰值均出现在线圈附近.正是由于离子的扩散过程受到抑制, 放电中心处的正离子通量有所降低, 因此高气压下悬浮电势呈凹形分布.
4 流体力学/蒙特卡罗碰撞混合模型
4.1 理论模型
在流体力学模型中, 通常假设电子服从麦克斯韦分布.然而在实际的放电过程中, 尤其是当放电气压较低且电场较强时, 电子能量分布函数显著偏离麦氏分布, 即此时流体力学模型无法精确地描述等离子体内部的动理学行为.为了克服流体力学模型的上述缺陷, 流体/蒙特卡罗碰撞(Monte Carlo collision, MCC)混合模型, 受到了人们越来越广泛的关注.所谓的混合模型, 即采用电子MCC 模块, 描述电子与中性粒子的碰撞过程.通过统计碰撞后所有粒子的动理学信息, 自恰地求解电子能量分布函数, 以及相应的反应速率系数.随后, 将相关结果输入到流体力学模块中, 进一步计算等离子体密度、电场等参量的时空分布.而后, 电场分布又被反馈到MCC 模块中, 用于推动粒子.两个模块互相迭代, 直至收敛.
在MCC 模块中, 通常采用伪碰撞技术来处理电子与中性粒子之间的碰撞过程[38].对于能量为εi的电子, 与密度为ng的中性粒子发生第j种碰撞的频率为
其中σi,j为第j种碰撞在能量为εi时对应的碰撞截面.假设在模型中, 考虑的碰撞类型共有Ntype种,则能量为εi的电子的总碰撞频率为

最大碰撞频率为

随后, 对于能量为εi的电子, 产生一个随机数R(0 ≤R≤1), 并由此判断即将发生的碰撞类型

如果电子发生伪碰撞, 则它的能量和速度均不会改变.如果电子发生弹性碰撞, 则根据动量守恒定律和能量守恒定律, 碰撞后电子的速度可由相关公式确定[39,40].如果电子发生激发碰撞或电离碰撞, 还需要考虑碰撞过程中电子损失的能量, 以及电离过程中新产生电子的能量分配.
此外, 电子在电磁场的作用下, 运动轨迹会发生改变, 因此可依据牛顿方程对电子的位置和速度进行更新.为了提高程序的运算效率, 还可以采用不等时间步长等方法[41,42].
当MCC 模块运行一定周期后, 通过统计一个周期内不同时刻的所有电子的速度和位置信息, 可以得到时空分辨的电子能量分布函数f(ε,r,t).第j类碰撞反应的系数kj(r,t) 可通过对相应的碰撞截面σj(ε) 积分获得

随后, 该反应系数被输入到流体力学模块中, 用于求解连续性方程中的源项.
4.2 研究进展
Kushner 教授是混合模拟领域的领军人物,其团队开发的HPEM (hybrid plasma equipment model)包含多个模块, 可用于模拟等离子体放电中的多种物理过程.在等离子体处理工艺中, 电子能量分布函数(electron energy distribution function, EEDF)至关重要, 直接决定了电子碰撞反应的源项, 以及晶圆表面各种活性粒子的通量.因此,Logue 和Kushner[43]采用HPEM 模型, 系统研究了在Ar/N2脉冲调制射频感性耦合等离子体中,外界放电参数对EEDF 的调控.研究结果表明: 在脉冲周期的不同时刻, EEDF 呈现出不同的分布,但脉冲占空比不会对周期平均的EEDF 及电子碰撞反应源项产生显著影响, 如图8 所示.此外, 气压对EEDF 的调控十分显著: 随着气压的增加, 电子能量弛豫距离缩短, 电子密度增加, 电磁波的趋肤深度减小, 这使得趋肤层外部EEDF 的高能尾显著下降, 且不同轴向位置处的EEDF 差异变得明显.

图8 气压为50 mTorr 时, 不同轴向位置处周期平均的EEDF[43]Fig.8.Pulse averaged f (ε) at different heights at 50 mTorr.Reprinted from Ref.[43], with the permission of AIP Publishing.
Tinck 和Bogaerts[44]采用HPEM 模型, 研究了复杂混合气体CF4/CHF3/H2/Cl2/O2/HBr 中的化学反应过程.在他们的模型中, 包含了30 种带电粒子、35 种中性粒子, 以及约600 个反应.通过改变每种气体的占比, 详细研究了等离子体特性随气体组分的变化.研究结果表明: 随着CF4含量的增加, F 原子密度增加, O 原子密度下降, 这使得刻蚀速率有所增加.随着H2含量的增加, H+,和离子密度显著增加.但由于这些离子质量较轻、溅射产额较低, 因此整体而言, 溅射过程被抑制.随着Cl2含量的增加, Cl 原子密度显著增加.尽管F 原子活性更高, 但由于Cl 原子通量比F 原子高几个量级, Cl 原子成为最主要的刻蚀粒子.随着HBr含量的增加, Cl 原子和F 原子的含量均有所降低, 这使得化学刻蚀过程有所减弱.同时,由于HBr+和Br+离子密度的增加, 溅射速率有所上升.
最近, Qu 等[45]采用HPEM 模型研究了脉冲调制射频Ar/Cl2感性放电中的等离子体特性.在后辉光阶段, 脉冲不彻底关闭, 即此时采用较低功率维持放电.采用这种高低功率交替放电的好处是, 避免后辉光阶段过低的密度引起的不稳定性,并缩短下一脉冲周期的起辉时间.研究结果表明: 当放电从低功率向高功率转换时, 趋肤层内(高度为11 cm 处)的电子温度会出现一个峰值;而当放电从高功率向低功率转换时, 趋肤层内的电子温度会出现一个谷值.随着高低功率转换所对应的上升沿和下降沿时间的延长, 电子温度这一峰值和谷值会逐渐消失.此外, 随着低功率幅值的增加,电子温度这一峰值和谷值也会逐渐减弱.
在刻蚀过程中, 除了离子和自由基外, 光子也起着至关重要的作用, 例如光子会增强刻蚀过程中的协同反应、对low-k材料造成损伤等.基于此,Tian 和Kushner[46]采用HPEM 模型, 研究了在Ar/Cl2混合气体中等离子体特性及真空紫外光子随放电参数的改变.研究结果表明: 随着气压从10 mTorr 增加为100 mTorr, 体平均的电子密度下降, Cl–密度先上升后趋于饱和; Cl+密度显著下降,密度显著上升, 成为最主要的正离子; 由Ar(1s4)和Ar(1s2)辐射的光子密度有所下降, 而由Cl(3p44s)辐射的光子密度显著增加; 轰击到基片表面的光子通量逐渐超过总的离子通量.此外,材料表面Cl 原子的复合系数以及混合气体中Cl2的含量, 均对光子通量有着显著影响.
此外, Zhao 和Wang[47]采用自己开发的二维混合模型, 研究了Ar 感性放电中亚稳态原子对模式跳变及回滞过程的影响.研究结果表明: 亚稳态原子的存在会提高等离子体密度, 但并不会影响密度随功率的变化趋势.此外, 亚稳态原子对E 模式和H 模式下的EEDF 影响不大, 由此推测亚稳态可能不是回滞发生的决定性因素.
Xu 等[48]在此模型的基础上, 耦合等效回路模型, 研究了外部因素(如匹配网络)对H2放电中回滞现象的影响.在等效回路模型中, 各电路元件的值由电子密度、电子温度、碰撞频率以及空间电磁场等参数计算求得.研究结果表明: 当气压为20 mTorr 时, 通过往返调节串联电容, 等离子体各状态参量, 如密度、温度等, 均发生明显的跳变, 但没有观察到回滞现象.而当气压升高至100 mTorr时, 通过往返调节串联电容, 发现了明显的回滞环,如图9 所示.
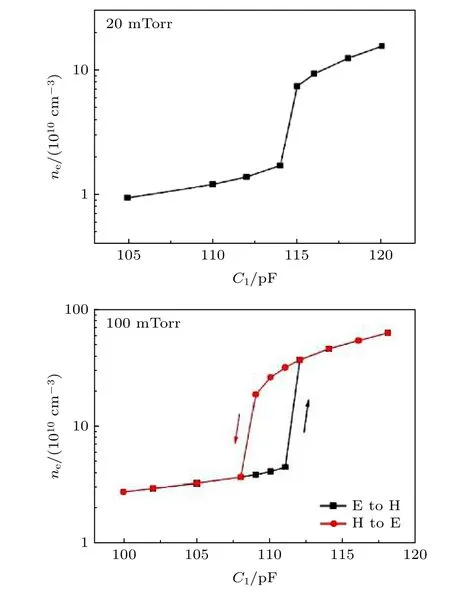
图9 不同气压下, 电子密度随串联电容的演化[48]Fig.9.Electron density ne versus the matching capacitance C 1.Reprinted with permission from Ref.[48].
5 偏压鞘层模型
5.1 理论模型
尽管在ICP 源中, 放电主要靠感性电场维持,在某些放电条件下, 例如当在基片台上施加一个射频偏压源时, 鞘层特性也会对放电过程产生显著影响.因此, 需要采用独立的偏压鞘层模型, 来精确地描述鞘层的瞬时振荡行为[49].
由于鞘层的厚度远小于极板半径, 可以近似采用一维的鞘层模型.在鞘层中, 正离子的密度n+和速度u+采用连续性方程来描述

其中,e为单位电荷,Z+为正离子所带电荷数,m+为正离子的质量,p+为正离子的压力,M+为正离子与中性粒子碰撞而引起的动量转移.V为鞘层内的电势, 通过求解泊松方程来获得

其中,ε0为真空中的介电常数,Z+和Z−分别为正离子和负离子所带电荷数.负离子密度n−和电子密度ne满足玻尔兹曼分布

其中,n−0,ne0和Vp分别为等离子体和鞘层交界处的负离子密度、电子密度和等离子体电势,T−和Te分别为负离子温度和电子温度,kB为玻尔兹曼常数.
如果在极板上施加一个电流偏压源, 则根据电流平衡方程, 有

其中,I0和ω分别是偏压源的电流幅值及圆频率,Ii和Ie分别代表离子流和电子流.Id为位移电流,表达式为

式中Cs为鞘层等效电容, 表达式为

其中A为极板面积,ds为鞘层厚度.通过求解上述电流平衡方程, 可以得到极板表面的瞬时电势Ve.
需要注意的是, 上述偏压鞘层模型需要与相应的等离子体模型进行耦合, 来描述带有偏压源的感性放电过程.此外, 该偏压鞘层模型还可以与离子MCC 模型进行耦合, 用于模拟轰击到基片表面的离子能量角度分布.首先, 将偏压鞘层模型中计算得到的鞘层内的电场等参数传递给离子MCC 模型.然后, 在离子MCC 模型中, 离子经历碰撞, 并且在电场的作用下, 其运动轨迹会发生改变.最后,通过统计到达基片表面的离子信息, 获得离子的能量角度分布.
5.2 研究进展
Zhang 等[50]将偏压鞘层模型与二维流体力学模型耦合, 系统研究了带有偏压源的感性放电过程, 重点关注了在不同的线圈电流下, 偏压源对等离子体特性的影响.研究结果表明: 当线圈电流较低时, 等离子体密度随着偏压幅值的增加而增加;而当线圈电流较高时, 等离子体密度随着偏压幅值呈现先下降后上升的趋势.此外, 通过电离率的时空分布也可以清楚地观察到放电模式随偏压幅值的改变.图10 给出了当线圈电流为11 A, 频率为13.56 MHz, 偏压源频率为2 MHz 时, 不同偏压幅值下电离率的时空分布.研究结果表明: 当偏压幅值为60 V 时, 环向电流激发的感性电场对放电起主导作用, 因此电离率的峰值出现在介质窗下方;随着偏压幅值的增加, 偏压源的影响变得重要, 电离率的时空分布受到显著影响, 即电离率的峰值出现在下极板附近偏压鞘层扩张的相位.
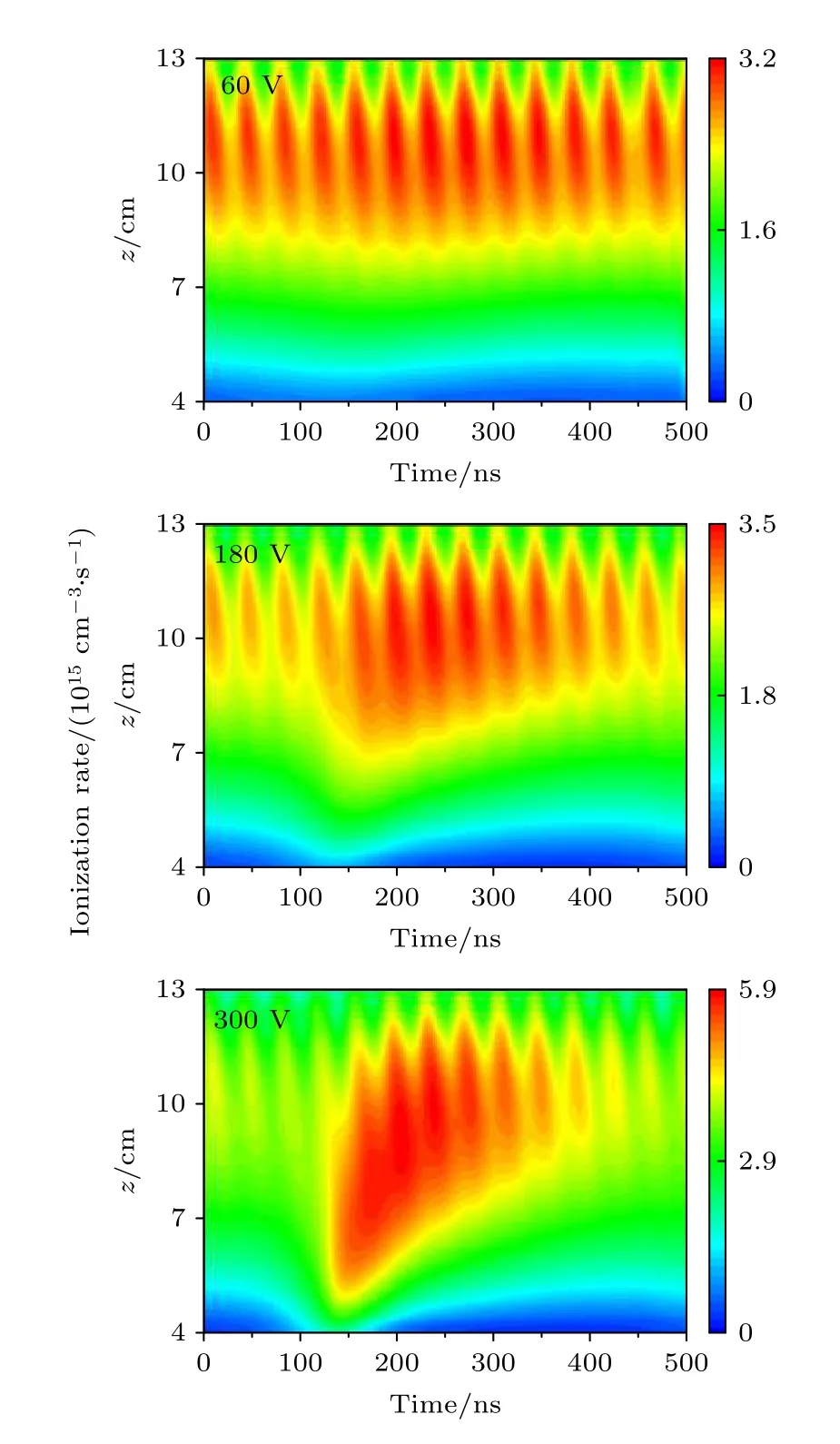
图10 不同偏压幅值下, r = 7 cm 处电离率的时空分布[50]Fig.10.Spatiotemporal distributions of the ionization rate at r = 7 cm at different bias voltages.Reprinted with permission from Ref.[50].Copyright [2015], American Vacuum Society.
Wen 等[51]将偏压鞘层模型与整体模型和离子MCC 模型耦合, 研究了不同放电条件下的离子能量角度分布, 并与实验诊断结果进行了比较.研究结果表明: 当偏压源的频率由0.6 MHz 增加为13.56 MHz 时, 高能峰和低能峰之间的能量间隔减小, 如图11 所示.这是因为当偏压源的频率较低时, 离子的渡越时间小于射频周期, 即离子能量受到离子进入鞘层时的相位的影响.当偏压源的频率较高时, 随着偏压的增加, 离子能量分布由单峰变成双峰, 且双峰的间隔变宽.这是由于随着偏压的增加, 鞘层电压降增加, 离子渡越鞘层的时间变短.

图11 不同偏压频率及幅值下的离子能量角度分布[51]Fig.11.IEADFs versus RF bias frequencies and amplitudes.Reprinted from Ref.[51], with the permission of IOP Publishing.
6 粒子模拟/蒙特卡罗碰撞混合模型
6.1 理论模型
上文中介绍的模型, 均是建立在一定的假设之上.如果要对等离子体放电过程进行更为精确的模拟, 尤其是描述其中的非局域、非热平衡现象, 则需要采用粒子模拟/蒙特卡罗碰撞(particle-incell/Monte Carlo collision, PIC/MCC)混合模型.PIC/MCC 模型是基于第一性原理的动理学方法, 并且不存在数值耗散问题, 因此模拟结果较为可靠.
在PIC/MCC 模型中, 通常假设中性粒子的分布是均匀的, 而带电粒子的特性则通过追踪大量的宏粒子来获得[52,53].其中, 每个宏粒子可以代表103—109个真实粒子, 荷质比与真实粒子相同.为了减少离散粒子的数值噪声, 通常要求每个空间网格内的宏粒子数目要远大于1.在模拟过程中, 首先需要根据每个宏粒子的坐标, 将其信息分配到临近的格点上, 以获得放电腔室内部的电荷及电流分布.例如, 格点 (xi,yj) 处的电荷密度为

其中,qp表示位于 (xp,yp) 处的宏粒子所带电荷量,S(xp,yp,xi,yj)表示权重函数.需要注意的是, 该权重函数的形式不是唯一的, 但需要满足归一化条件.以二维直角坐标系为例, 假设宏粒子的坐标位于xi 在获得放电腔室内部的电荷及电流密度分布后, 通过求解麦克斯韦方程组, 可以得到每个格点处的电场E(xi,yj) 及磁场B(xi,yj).然后采用相同的权重函数, 将格点处的电磁场再次分配到宏粒子所在位置.随后, 宏粒子在电磁场的作用下运动 其中m和q表示粒子的质量和所带电荷量,v和x表示粒子的速度和位置. 为了处理带电粒子与中性粒子之间的碰撞过程, 还需要将上述PIC 模型与MCC 模型耦合[38,54].与第4 节介绍的模型相比, 本节采用的MCC 模型中, 还需要考虑离子与中性粒子的碰撞过程.其中,离子与中性粒子之间的弹性碰撞和电荷交换碰撞,可以采用硬球模型来描述[39].在分子气体及电负性气体放电中, 由于涉及到的碰撞过程更为复杂,需要根据具体的反应类型选择不同的处理方式. 需要注意的是, 为了提高程序的稳定性, PIC/MCC 模型需要采用非常小的时间步长和空间网格, 这使得该方法十分耗时.此外, PIC/MCC 模型通常只能采用规则网格, 即只能模拟简单的放电腔室结构, 这在一定程度上限制了PIC/MCC 模型的应用. 由于ICP 源中的等离子体密度比CCP 源高1—2 个量级, 为了保证模拟结果的精确性, PIC/MCC 模型中的宏粒子数目也需要按比例增加, 这使得计算效率进一步下降.因此, 针对ICP 源的PIC/MCC 模拟研究工作十分有限. Takao 等[55,56]采用二维的PIC/MCC 模型,研究了微型ICP 源的特性及放电过程中的容性耦合效应.在他们的研究中, 腔室的半径和高度均在mm 量级, 线圈频率高于100 MHz, 吸收功率仅为几瓦甚至几十毫瓦.研究结果表明: 在此放电条件下, 鞘层厚度约占腔室高度的10%, 说明在微型ICP 源的模拟过程中, 鞘层不应该被忽略.此外,尽管采用的放电气压较高, 为500 mTorr, 但整个腔室内部的电子能量均偏离麦克斯韦分布.此外,当模型中只包含感性耦合效应时, 功率沉积主要是由电子的角向运动引起的; 而当模型中包含容性耦合效应时, 功率沉积主要是由电子的轴向运动引起的; 随着频率的降低和功率的提高, 容性耦合效应有所增强. 此外, Mattei 等[57]提出了一种隐式的电磁PIC/MCC 模型, 用来研究感性耦合Linac4 负氢离子源的特性.研究结果表明: 当Linac4 负氢离子源运行约0.15 µs 后, 放电模式发生转化, 电子密度的空间分布也发生显著改变[58].此外, H+及离子与中性粒子的碰撞过程, 并不会对放电模式的转化产生影响, 但会影响H 模式下的等离子体特性[59]. 目前, 芯片刻蚀工艺的发展趋势是芯片尺寸越来越大、刻蚀线宽越来越窄, 这也对材料刻蚀工艺提出了更高要求, 如更好的均匀性、更高的各向异性、更高的刻蚀率及选择性等.为了实现上述目标,就需要不断对感性耦合等离子体特性进行调控.例如, 通过在下极板施加独立的偏压源, 并调控偏压源的波形等, 以实现对轰击到基片表面的离子能量和离子通量的独立控制; 通过采用脉冲调制, 改变脉冲频率、占空比等参数, 对后辉光阶段的等离子体特性进行调控, 以实现对刻蚀剖面的优化; 通过采用双频甚至多频源驱动放电, 并改变电源的频率、相位及电流幅值比, 以实现对等离子体均匀性的调控等.此外, 放电过程中的模式跳变等现象,会引起放电的不稳定性, 进而影响刻蚀过程, 因此需要采用一定的方法来抑制.如通过增加法拉第屏蔽、改变介质窗形状、施加轴向磁场、改变线圈形状等, 来降低放电过程中的容性耦合效应.总之,感性耦合等离子体源的数值模拟研究具有深远意义, 相关研究结果可以用来优化工艺过程, 并为ICP 源的进一步发展提供科学依据.

6.2 研究进展
7 结 论

