离轴照明强度不对称性对投影曝光光刻系统成像影响分析
陈德良 王玉清 李世雄 余宏
(贵州师范学院 贵州省贵阳市 550018)
迄今为止,集成电路(IC)的发展一直遵循Intel 公司创始人之一Gordon E.Moore 预言的规律:当价格不变时,集成电路上可容纳的晶体管数目,约每隔18 个月便会增加一倍,性能也将提升一倍[1-2],这个规律就是IC 界著名的摩尔定律。目前13.5nm 光刻系统只有少数企业使用,193nm 光刻系统仍是国内制造集成电路的主流光刻设备。157nm 光刻系统因成本和透镜材料问题而不能被实际应用,下一代光刻系统,如极紫外光刻、离子束光刻和纳米压印技术仍在不断改进,因此国内企业目前只能不断改进193nm 光刻设备和曝光工艺希望将此技术延伸到7nm 节点。将193nm 光刻技术延伸至7nm 节点可以说是相当大的挑战,对曝光工艺要求势必更加苛刻,因此提升193nm 光刻系统曝光工艺就变得越来越重要。曝光工艺是集成电路加工的关键步骤。曝光工艺的主要作用是将掩膜板上的图形精确复制到硅片上,为下一步刻蚀或离子注入做准备。光刻工艺的提升离不开光刻工艺模拟,光刻模拟可为工艺提升提供参考依据,可以减少实验用的时间和节省实验的成本[3-7]。光刻成像模拟是光刻工艺模拟的重要组成部分,是后续光刻工艺模拟的关键,因此建立精确光刻成像仿真模型非常重要。
离轴照明技术[9]是光刻技术常用的照明技术,离轴照明可以改善光刻分辨率、增大焦深、提高光刻成像的对比度[8-10]。但是离轴照明结构如果不对称,包括强度不对称和几何结构不对称,如果强度中心和几何中心偏离了主轴势必对光刻产生影响。因此,本文利用自建的一种光刻成像模型,再利用波前处理技术引入离焦像差,用以研究光刻照明光源不对称性对光刻成像的影响。利用此模型,分析了照明光源强度不对称性在离焦和未离焦的情况下对193nm 深紫外投影曝光光刻系统100nm特征尺寸的成像影响。分析结果表明,掩膜处光场照明强度均匀时,离焦对成像的影响很小,光场照明强度不均匀时,离焦对成像的影响非常大。分析结果可为投影曝光光刻工艺优化提供参考。
1 光刻部分相干成像模型
光刻成像仿真模型,是由一个照明系统和一个双远心部分相干成像系统组成[11-12]。如图1所示,在照明系统前焦面处为一等效光源,等效光源面处每一点相当于点光源,发出的光经照明系统扩束准直后均匀照射到掩膜处,再经投影系统最后成像到硅片面处,等效光源所有点光源照射掩膜在硅片面成像的强度形成非相干叠加,即为光刻的部分相干成像,这种模型类似于广泛的阿贝成像。

图1:光刻部分相干成像模型
模型的理论部分已在文献[13]中进行了详细的推导论证,这里仅写出硅片面最后的成像公式,即为:
公式(1)中,r(x0,y0)为等效光源分布函数,Umask(x1,y1)为掩膜复振幅透过率函数,P(fx,fy)为光瞳函数,FT表示傅里叶变换,FT-1表示逆傅里叶变换。以上函数具体表达式请参看文献[13]。
为了模拟离焦对部分相干成像的影响,本文采用了波前处理技术,在光瞳面引入离焦的影响。离焦实际上可认为是一种像差,如图2所示,理想的投影系统在光瞳处产生的球面波(半径较小者),设该平面波的汇聚点所在平面为理想焦平面,硅片面应该与焦平面重合。然而实际中硅片面与焦平面存在一定的距离,设为z',那么此时可理解为球面波汇聚在离焦后的硅片面上,从图中可以看出,实际波前与理想光前存在光程差(OPD:optical path difference),这个光程差可用离焦量z'和位置描述,位置可用光的传播方向θ表示,由于离焦量远远小于光波传播的距离,OPD 可近似写为:

图2:离焦与光瞳波前的关系
OPD 实际上对光瞳函数进行了调制,光刻系统引入离焦像差后,光瞳函数可写为:
引入像差后的部分相干成像公式,可由式(1)和式(3)推出为:
2 二极照明下硅片面部分相干成像离焦影响仿真参数设置
利用上面光刻部分相干成像模型,我们就可研究二极照明强度不平衡在离焦和未离焦的情况下,对光刻部分相干成像的影响。所用掩膜和二极照明如图3所示,掩膜特征尺寸为100nm 等间距结构,二极照明极张角为30 度,内相干因子为0.55,外相干因子为0.85。
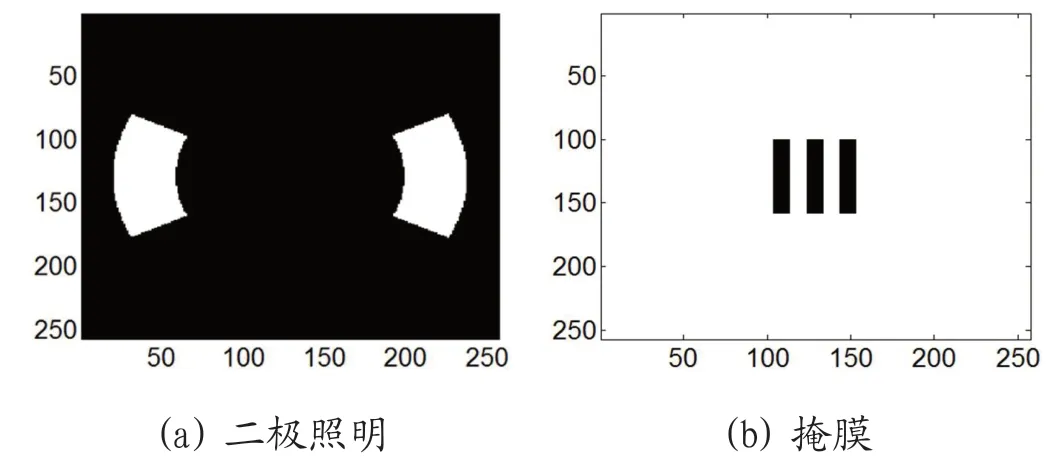
图3:二极照明结构与掩膜特征尺寸
模拟光源选用193nm 紫外光刻光源,为了计算迅速方便且不失一般性,仿真中每个像素点代表10nm 大小,采样点选取为257×257,详细参数如表1所示。

表1:光刻仿真主要参数设置
二极照明对称时,左极和右极相对强度设置为1;二极照明不对称时,左极和右极相对强度分别为1 和3。本文分别在这两种情况下,研究了掩膜光刻部分相干成像随不同离焦的变化。
3 仿真结果及分析
基于表1 参数,结合光刻部分相干仿真理论,仿真得到了在二极照明对称和不对称情况下,不同离焦量下掩膜图形部分相干成像强度分布。为获得部分相干成像图形的中心,首先我们将部分相干成像强度分布图灰度化,然后在相同阈值条件下对灰度化后的图像进行二值处理,最后求得图像中心。
如图4所示为二极不对称照明条件下,部分相干成像强度图和图像处理后的二值图,a、b、c 分别是离焦量为0nm、-500nm 和500nm 时的部分相干成像强度图,a1、b1、c1 为其对应的二值化后的二值分布图。从图4中可以看出,离焦为-500nm 和500nm 时,掩膜成像的图形结构相对于未离焦时都有了较大偏移。

图4:二极照明强度不对称时掩膜的部分相干成像强度图及二值化后图
如图5所示为二极对称照明条件下,部分相干成像强度图和图像处理后的二值图,d、e、f 分别是离焦量为0nm、-500nm 和500nm 时的部分相干成像强度图,d1、e1、f1 为其对应的二值化后的二值分布图。从图5中可以看出,在二极强度对称照明条件下,离焦为-500nm和500nm 时,掩膜成像的图形结构相对于未离焦时基本没有偏移。

图5:二极照明强度对称时掩膜的部分相干成像强度图及二值化后图
从图4 和图5 中还可以看出,不管是在二极对称照明或者二极不对称照明情况下,离焦-500nm 和500nm时,掩膜图形成像的分辨率大大降低,掩膜特征尺寸变宽,可见离焦对部分相干成像的分辨率影响较大。
通过图像处理方法,得到了两种照明情况下,不同离焦量对应部分相干成像图形结构的中心位置。图6、图7 分别是不对称照明和对称照明情况下,不同离焦量部分相干成像时对应图形中心坐标值。从图6 和图7 中可以看出,在没有离焦的情况下,不管是对称照明还是不对称照明,都不会使掩膜成像的图形结构偏移。但是在离焦的情况下,如果是不对称照明,掩膜成像的图形结构就会发生较大偏移;而对于对称照明,离焦情况下,图形结构仍没有偏移。从图6、图7 中还可以看出,不对称照明情况下,对应图形中心坐标x 值并没有随离焦变化发生明显改变,而y 值却随离焦发生了很大改变。因此可以得到,x 方向的不对称照明,离焦时可以引起掩膜图形在y 方向偏移,x 方向不发生偏移;反之,y方向的不对称照明离焦时可以引起掩膜图形在x 方向偏移,y 方向不发生偏移。

图6:照明强度不对称时成像图形中心位置

图7:照明强度对称时成像图形中心位置
4 结论
从以上分析可以看出,当硅片面发生离焦时,离轴照明强度不对称对光刻系统的影响较大,离轴照明强度对称对光刻系统的影响较小,可以忽略;当硅片面不发生离焦时,离轴照明强度对称和不对称,都不会对光刻系统成像造成影响。通过模拟,可以事先了解离轴照明对光刻系统成像的影响,数据可以为实际光刻提供参考。在实际的光刻中,很难做到光刻照明强度绝对对称,因此控制硅片面的离焦量非常重要。

