基于矩阵积分法优化光刻部分相干成像模型
彭清维,陈德良
(1.贵州师范学院,贵州贵阳 550018;2.贵州大学,贵州贵阳 550025)
基于矩阵积分法优化光刻部分相干成像模型
彭清维1,2,陈德良1*
(1.贵州师范学院,贵州贵阳 550018;2.贵州大学,贵州贵阳 550025)
基于矩阵积分法实现了Matlab对光刻部分相干二维成像的模拟,验证了Matlab编写的部分相干程序的可行性,加入了离焦对光刻分辨率的影响。通过建立部分相干光光刻仿真模型,并在二极照明方式下,对离焦对光刻成像的影响进行了模拟计算。结果表明,矩阵积分法降低了程序运算所用时间,微小的离焦对光刻部分相干成像影响巨大,必须考虑离焦对光刻分辨率造成的影响。
光刻工艺;矩阵积分法;离焦
引言
光刻模拟开始于1970年代早期,当时,Rick Dill在 IBM的 Yorktown Heights Research Center用数学公式描述了光刻工艺的一些基本步骤[1]。Dill首先建立一个最简单的模型。在一维情况下给定一个硅片上未曝光的光刻胶模型,然后研究曝光时随着在光刻胶中曝光深度变化光强的分布。Dill首先把光刻过程分解成为一系列待计算的子过程,首先计算光刻胶里的光强(驻波的计算),然后计算光刻胶曝光后产生的化学生成物的浓度,然后考虑该化合物对显影率的影响,最后是显影率对时间的积分来预测显影后光刻胶的厚度。注意到重氮盐正性光刻胶在曝光后被漂白,这是由于这种光刻胶吸收光能以后发生了化学变化。Dill利用这个对光吸收上的化学变化来描述曝光的动力学过程,把光刻胶涂在硅片上面,Dill测量了和曝光剂量函数相关的光刻胶透射系数[3-4]。测量结果和他的一阶动力学曝光模型得到的结果非常吻合。Dill模型有三个参数A、B和C,分别表示可被漂白常数、不可被漂白常数和吸收常数[5-6]。
在Dill之后,Andy Neureuther团队在1979年开发出了光刻模拟程序SAMPLE[2]。SAMPLE给光刻模型增加了很多前沿性的技术,如在成像计算方面改进为部分相干光成像,在显影率计算里增加了表面抑制函数,在光刻胶显影的时候用String算法替代了元胞算法。但更重要的是,SAMPLE能够被光刻界广泛使用,光刻研究者第一次能够利用模型来帮助他们理解并且提高他们的光刻工艺了。几十年来,UC Berkeley的SAMPLE研究小组为光刻研究做出了重要的努力,他们用光刻模拟作为研究工具为光刻的进步做出了大量的贡献:第一次建议曝光后烘烤光刻胶,很早就提出了移相掩膜技术等一些分辨率增强技术,设计了象差灵敏度监测器等。毫无疑问,最重要的贡献还是SAMPLE本身。
除了Andy Neureuther,很多人在Dill之后做了很多理论的改进工作,这使光刻仿真更加精确。最为显著的是Chris A.Mack在Dill和Andy Neureuther等人的基础上开发出了现今最流行的也是最专业化的商业光刻软件PROLITH(正性光刻胶光刻模型:the Positive Resist Optical Lithography model)[7-10]。PROLITH的诞生可以说在半导体光刻工艺的仿真改进方面做出了非常大的贡献。
但是SAMPLE和PROLITH软件的部分相干成像模块可设置参数比较少,像杂散光参数设置比较简单不能更精确模拟杂散光对光刻成像的影响。因此,本项目考虑基于matlab软件编写光刻部分相干成像程序,开放的程序更方便加入部分相干成像各影响因素。但是部分相干成像模型最后计算硅片面上的强度分布时是一个四重积分,在程序中是一个四重循环,Matlab计算循环很慢,矩阵计算很快。因此,本文将利用积分法将等效光源的两层循环变成矩阵运算,然后将非相干叠加的两层循环采用matlab并行算法,这样,当模拟采样点很大时将大大减少计算时间,实现用Matlab仿真光刻的部分相干成像。
1 部分相干光光刻成像模型
1.1 部分相干光光刻成像理论模型的构建
部分相干光光刻仿真模型主要取决于两种科学领域,其一是用来建立空间成像的光学领域模型,其二是用来建立在光刻胶中成潜在影像的化学领域模型。以下是建立光刻二极照明模式下的成像模型。

图1 光刻空间成像的光学模型
图1是光刻空间成像的光学模型示意图,现在大多数都用的此光刻仿真软件模型[7-9],实际的光刻光源和聚光系统被一个具有辐照分布函数为r(x0,y0)的等效光源[8]取代,掩模被认为是一个数字透过率函数,可以写为:

这里,(x1,y1)表示掩模面坐标。根据Hopkins等人[11-13]论文中对部分相干成像的讨论,如果点光源被假设为在系统光轴上,例如: (x0,y0)=(0,0)。当光透过掩模发生衍射后,掩模的谱函数可以用夫琅禾费衍射描述,

这里,fx和fy表示空间频率,定义为:

ε(fx,fy)表示掩模的傅里叶变换形式,(x',y')表示光阑处空间坐标,λ为光源的波长。对于一般形式的源点,其位置不在光轴上,即(x0,y0)≠(0,0),可以做这样的近似,光学系统具有移位不变性,这样掩模被一般形式源点照射后,其波谱可以写为:

由一般源点的照射,在硅片面的空间成像形式可描述为:

这里,P(fx,fy)表示光学系统的光阑函数,NA表示数值孔径,FT-1表示逆傅里叶变换。根据定义,既然等效光源等效于自发光光源,那么硅片面的总的光照分布可以对整个等效光源面积分得到,其形式可写为:

这里,r(x0,y0)表示二极等效光源。式(7)的原理和广泛的阿贝成像理论相似,物体在部分相干照明下的成像,可以用许多垂直和倾斜照射物体平面照明光波的相干成像过程的组合来解释。既然我们关心的是成像的辐照度,不用部分相干成像理论一样可以确定。为了计算方便,整个等效光源被分解为许多发光的点源,这些点源各有独立的相干成像过程,点源与点源之间不相干,那么硅片面成像的净辐照度即为这些点源相干成像辐照度的总和。
1.2 部分相干光光刻成像模型的实现
如何得到光阑面频移后的频谱与之后对整个等效光源范围积分是部分相干光光刻成像模型的关键。

图2 正入射照明和倾斜入射照明对掩模频谱衍射花样的影响
如图2(a)是平面波正入射时的情形,它是由等效光源面轴上点光源照明时频谱分布,掩模上相位处相等,即将这种情况下掩模上的复振幅分布定为1。如图2(b)是平面波斜入射时的情形,它是由等效光源面的轴外一点光源照明时的频谱分布,这时掩模上的相位处就不相等了,即将这种情况下的复振幅分布不能再定为1,频谱也发生了平移。
由于平面波入射时有一定的角度,即这时掩模上平面波传播的复振幅分布可以用方向正弦表示如下:

其中,tgθxz=,(x'0,y'0)为等效光源面以轴心为原点的实际坐标。
那么掩模面的复振幅透过率函数可写为:

那么光阑面平移后的频谱就可以写为:

其中,x0=表示相干因子坐标系;同时,也把fx和fy规范化为FT表示傅里叶变换。把式(10)代入式(7)可得:

2 基于积分法转换优化光刻部分相干成像算法
第二部分建立了光刻的部分相干成像模型,但是要利用Matlab实现光刻部分相干成像模拟是比较困难的。从本文第二部分掩膜上复振幅分布公式来看,如果在计算硅片面部分相干光强光强分布时复振幅分布也用循环来实现,那么整个计算硅片面部分相干成像光强分布的循环就需要四层,如果采样点数多,Matlab计算循环将会特别慢。并且从计算部分相干成像硅片面光强分布积分公式看,积分函数包含了傅里叶变换及逆傅里叶变换,这就更加增加了计算的时间,造成了本文第二部分光刻部分相干成像难于利用 Matlab实现。
Matlab软件在进行矩阵运算方面进行了优化,矩阵运算速度特别快,因此我们考虑将计算等效光源面上一个点光源在掩膜面的复振幅分布的循环算法转换成利用矩阵进行运算,这种方法我们将其命名为矩阵积分法。
2.1 利用矩阵积分法优化掩膜面复振幅分布算法
假设光刻部分相干成像模拟程序的采样点为M×M(M为奇数,在使用本方法优化时M最好取为奇数,如果不是奇数,掩膜面的矩阵坐标离散可能会出现除不尽的小数,造成离散坐标误差。光刻的部分相干成像系统实际上是一个双远心系统,如果硅片面成像不出现离焦,这种误差对成像没有影响;如果硅片面成像有离焦,这种误差将会造成成像微小偏移),我们定义两个矩阵都是M 列M行,一个为S,一个为ST(S的转置):

等效光源上每个点源在掩膜上的复振幅分布可写为:

式(13)中,ψ为等效光源上某个点源在掩膜上的复振幅分布,ψ为一个与S同维的矩阵。这样掩膜上复振幅透过率可写为:

式(14)中,T也为一个与S同维的矩阵。由式(13)(14),光刻硅片面部分相干成像的强度分布公式可改写为:

这样,我们就将计算光刻部分相干成像需要的四层循环,通过矩阵积分法转换成了两层循环。
2.2 对优化后的部分相干成像算法进行模拟验证
为了验证光刻部分相干成像理论,我们仿真了193 nm光刻环形照明(内相干因子为0.55,外相干因子为0.85)下,特征尺寸为100 nm的掩膜图形部分相干成像,仿真具体参数如表1所示。仿真所用电脑主要配置为:i5四核cpu 3470,内存4G。我们在没有改进算法情况下进行了仿真,程序运行了48小时没有出结果,最后放弃了运算;我们用矩阵计分法改进算法(未进行并行)后,程序运行了1131秒后得到结果;我们用矩阵计分法改进算法结合matlab并行算法改进后,程序运行了414秒得到结果。可见,矩阵分析法大大缩短了仿真时间,再结合matlab自身的并行算法更将运算时间缩短了近两倍。
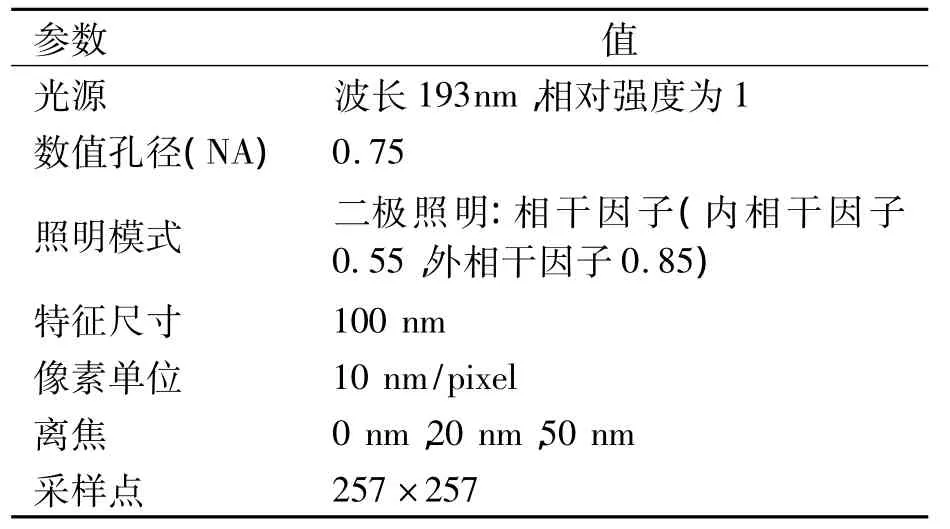
表1 光刻模拟参数设置

图3 100 nm线宽掩模和对应照明模式

图4 点光源照明和二极照明时掩模的频谱强度分布对比
图3为仿真掩模和选取的照明模式(二极照明)。图4(a)所示为光阑处掩模点光源入射时频谱强度分布,图4(b)所示为二极照明光源照明掩模频谱强度的非相干叠加图样。从图4中我们可以看出二极照明展宽了频谱,部分基频被移出光阑,部分高频被移进光阑,因此光阑处可以得到更多掩模的高频信息,从而提高了成像的分辨力。

图5 离焦对部分相干成像的影响
我们基于优化的程序,添加了离焦模块,分析了离焦对部分相干成像的影响。图5是不同离焦时对部分相干成像的影响,从图5(a)、图5(b)及图5(c)可以看出,随着离焦的增大,特征尺寸的线宽变大,线宽的分辨率降低。仿真表明,离焦对部分相干成像的影响是很大的,我们在实际的光刻中,要注意找准硅片面的对焦面,以免离焦对光刻分辨率产生大的影响。
结论
通过矩阵积分法实现了Matlab对光刻部分相干成像的模拟,验证了编写的部分相干程序的可行性,同时我们加入了离焦因素对光刻分辨率的影响。从仿真分析可以得到,微小的离焦对光刻部分相干成像影响是巨大的,因此在实际光刻中必须考虑离焦的影响,设计有效的焦面对准方法,避免离焦对光刻分辨率造成大的影响。下一步,将考虑对程序进一步完善,实现对光刻成像中各种像差(象散、场曲、球差、畸变、慧差等)的影响分析,同时进步提高程序仿真的精度,实现亚像素成像分析。
[1]Chris A.Mack.Thirty years of lithography simulation[J].SPIE,2004,5754:1-12.
[2]W.G.Oldham,S.N.Nandgaonkar,A.R.Neureuther and M.O.Toole.A general simulator for VLSI lithography and etching processes:Part I.Application to projection Lithography[J].IEEE Trans.Electron Devices,1979,26 (4):717-722.
[3]F.H.Dill.Optical lithography[J].IEEE Trans.Electron Devices,1975,22(7):440-444.
[4]F.H.Dill,W.P.Hornberger,P.S.Hauge,and J.M.Shaw.Characterization of positive photoresist[J].IEEE Trans.Electron Devices,1975,22(7):445-452.
[5]K.L.Konnerth and F.H.Dill.In.Situ measurement of dielectric thickness during etching or developing processes[J].IEEE Trans.Electron Devices,1975,22(7):452-456.
[6]F.H.Dill,A.R.Neureuther,J.A.Tuttle,and E.J.Walker.Modeling projection printing of positive photoresists [J].IEEE Trans.Electron Devices,1975,22(7): 456-464.
[7]C.A.Mack.PROLITH:A Comprehensive Optical Lithography Model[J].SPIE,1985,538:207-220.
[8]C.A.Mack.Algorithm for optimizing stepper performance through image Manipulation[J].SPIE,1990,1264:71-82.
[9]C.A.Mack and J.E.Connors.Fundamental differences between positive and negative tone imaging[J].SPIE,1992,1674:328-338.
[10]C.A.Mack.Lithographic optimization using photoresist contrast[J].Microelectronics Manufacturing Technology,1991,14(1):36-42.
[11]H.H.Horpkins.Applications of coherence theory in microscopy and interferometry[J].Journal of the Optical Society of America,1957,47(6):508-526.
[12]H.H.Horpkins.On the diffraction theory of optical images[J].Proc.R.Soc.Lond.A,1953 217:408-432.
[13]Eric C.Kintner.Method for the calculation of partially coherent imagery[J].Appl.Opt.,1978,17(17): 2747-2753.
[责任编辑:庄 鹏]
Optimizing photolithography partial coherent image model based on integral matrix method
PENG Qing-wei1,2,CHEN De-liang1*
(1.Guizhou Education University,Guiyang,Guizhou,550018;2.Guizhou University,Guiyang,Guizhou,550025)
By using the integral matrix method,the Matlab simulation to photolithography partial coherent imaging has been achieved;the feasibility of partly coherent image program written has been confirmed;the defocus effects to photolithography have been considered as well.Using partial coherent image program,the defocus effects to photolithography have been simulated with the condition of defocus.The simulation results indicate that the integral matrix method can reduce the simulation time.Moreover,small defocus has significant influences on partly coherent image,thus defocus error must be considered when carryingon photolithography.
Photolithographic process;Matrix integral method;Defocus
O439
A
1674-7798(2016)09-0049-05
10.13391/j.cnki.issn.1674-7798.2016.09.010
2016-08-02
贵州省教育厅自然科学基金招标项目(黔教合KY字【2012】051号);贵州省科技厅自然科学基金项目(黔科合J字【2013】2253号、黔科合SY字【2014】3084号);贵州师范学院校级学生科研项目(2014DXS114)。
彭清维(1992-),女,贵州师范学院物理学专业2015届本科生,研究方向:光刻技术。
*通讯作者:陈德良(1980-),男,贵州师范学院副教授,研究方向:光电子技术、光刻技术。

