具有不同Al组分的非极性a面p型AlGaN外延层的生长及特性研究
张 雄,范艾杰,崔一平
(东南大学电子科学与工程学院,先进光子学中心,江苏南京210096)
AlGaN基紫外发光二极管(UV-LED)由于其结构紧凑、使用寿命长和节能环保等诸多优势,在水和空气净化、杀菌消毒、光疗、植物生长照明和印刷油墨固化等领域具有重要的应用价值,尤其是2020年初,新型冠状病毒(COVID-19)在全球范围内大肆传播,基于UV-LED的消毒技术被普遍认为是一种可快速消灭COVID-19的有效方法。UV-LED消毒市场呈爆发式增长趋势,已在全球多个国家被广泛使用。目前大多数商用的AlGaN基UV-LED均是在极性(0001)c面蓝宝石衬底上外延生长制备的,然而其外量子效率(EQE)仍然处在个位数的百分比范围内,电光转换效率十分低下。究其原因主要是以极性AlGaN材料制备的UV-LED沿着c方向有较强的自发极化和压电极化导致的内建电场,该电场使得c面AlGaN基量子阱的能带结构倾斜,电子和空穴波函数在空间上发生分离,从而导致UV-LED辐射复合或内量子效率(IQE)降低,即所谓的量子限制斯塔克效应(QCSE)[1-3]。
虽然非极性(112ˉ0)a面AlGaN材料由于消除了沿外延生长方向的QCSE,因而采用非极性a面AlGaN材料被认为是制备高发光效率UV-LED的有效途径[4-6],但目前获得高导电性能的非极性(112ˉ0)a面p型AlGaN材料仍然是制备高亮度和高发光效率非极性AlGaN基UV-LED所面临的一大挑战。其主要原因可以归结为以下三个因素:首先,随着p型AlGaN中Al组分的增加,受主杂质Mg在AlGaN材料的激活能呈指数增加,造成p型AlGaN材料的电导率随着Al组分的增加而急剧下降[7-8];其次,相比极性(0001)c面AlGaN材料,非极性(112ˉ0)a面AlGaN材料存在更高密度的螺旋位错和堆垛层错,导致非极性(112ˉ0)a面AlGaN材料的晶体质量往往相较极性(0001)c面AlGaN材料差很多,且非极性(112ˉ0)a面AlGaN材料中高密度的堆垛层错被认为不仅会影响量子阱的发光效率,也会影响载流子在量子阱中的输运特性[9-12];最后,由于非极性(112ˉ0)a面AlGaN材料与r面蓝宝石衬底之间存在较大的晶格失配,并且Al或Ga吸附原子沿着非极性(112ˉ0)a面内各个方向的外延生长速率存在强烈的各向异性,造成非极性(112ˉ0)a面AlGaN材料的表面形貌通常非常粗糙,还会产生沿着AlGaN材料表面某些特定晶向的条纹和凹形位错坑[13]。此外,由于在p-AlGaN材料的外延生长过程中通常使用高Ⅴ/Ⅲ比生长条件来抑制氮空位等缺陷的产生,以降低p-AlGaN材料的自补偿效应,提高p-AlGaN材料的空穴浓度,但是高Ⅴ/Ⅲ比生长条件往往会造成p-AlGaN材料的表面形貌发生进一步劣化。
本课题组研发了一种以金属有机源的流量脉冲供给(PMFS)为特征的创新型金属有机物化学气相沉积(MOCVD)外延生长技术,在半极性(11ˉ02)r面蓝宝石衬底上成功地外延生长了一系列具有不同Al组分的非极性(112ˉ0)a面p型AlGaN外延层样品,并对所获得的样品进行了各种表征研究。结果表明,利用PMFS的MOCVD外延生长技术生长的非极性(112ˉ0)a面p型AlGaN外延层样品的电学和结构性能均获得了显著的提高,证明了本课题组研发的技术能在非极性Mg掺杂的p-AlGaN外延层的外延生长过程中起到关键性的作用。
1 实验过程
本研究中所有非极性(112ˉ0)a面Mg掺杂的p-AlGaN外延层样品均是在直径为2英寸的半极性r面(11ˉ02)蓝宝石衬底上,采用低压(40 Torr)MOCVD技术外延生长而成。在整个外延生长过程中,选取三甲基铝(TMAl)、三甲基镓(TMGa)、二茂镁(Cp2Mg)和氨气(NH3)分别作为生长非极性(112ˉ0)a面p-AlGaN外延层样品所需的Al、Ga、Mg和N的前驱体,同时采用氢气(H2)作为生长非极性(112ˉ0)a面p-AlGaN外延层样品的载气[17]。非极性(112ˉ0)a面p-AlGaN外延层的MOCVD生长过程如下:首先,将r面(11ˉ02)蓝宝石衬底加热至1 060℃,并在H2氛围中进行热处理,以除去蓝宝石衬底表面的污染物;然后,在相同温度下,对蓝宝石衬底进行5分钟的氮化处理;之后,将r面(102)蓝宝石衬底加热至1 160℃,在其上直接外延生长200 nm厚的非极性(112ˉ0)a面高温AlN(HT-AlN)缓冲层;接着,将生长温度降至1 080℃,在HT-AlN缓冲层上外延生长非故意掺杂非极性(112ˉ0)a面Al组分渐变的AlxGa1-xN缓冲层(x从0.7逐渐减小到0);随后在Al组分渐变AlxGa1-xN缓冲层上分别外延生长Al组分从0至0.41的非极性(112ˉ0)a面Mg-δ掺杂p-AlyGa1-yN外延层;最后在p-AlyGa1-yN外延层上生长厚度约为10 nm的非极性(112ˉ0)a面p型GaN帽层。整个非极性(112ˉ0)a面Mg-δ掺杂p-AlyGa1-yN外延层样品的结构如图1所示。
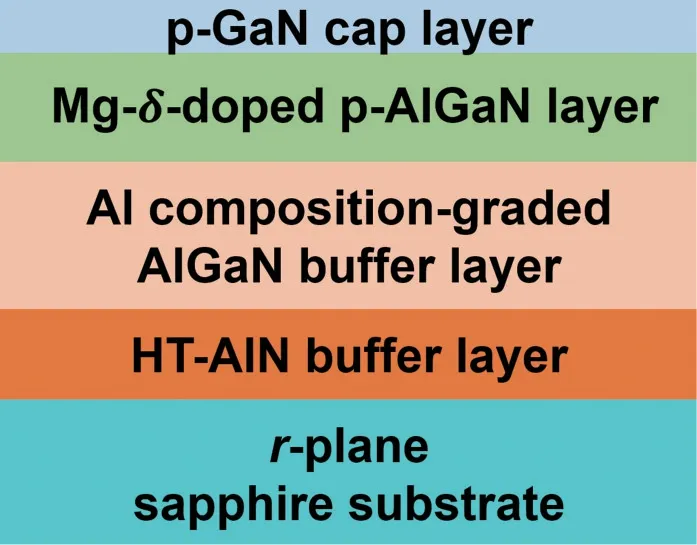
图1 非极性(112ˉ0)a面Mg-δ掺杂的p-AlGaN外延层样品的结构示意图
在外延生长非极性(112ˉ0)a面Mg-δ掺杂的p-AlyGa1-yN外延层时,我们采用了常规的Mg-δ掺杂技术,所获得的样品分别命名为样品P1、P2、P3。图2(a)描述了采用Mg-δ掺杂技术生长p-AlyGa1-yN外延层样品P1~P3时的金属有机物源和氨气的供应图。从该图可看出,Mg-δ掺杂p-AlyGa1-yN的外延生长过程为:首先,将TMAl、TMGa和NH3同时通入反应室90 s,外延生长厚度大约为22 nm的非极性(112ˉ0)a面AlGaN层;然后,仅将NH3和H2的混合气流通入反应室,吹扫10 s;最后,将Cp2Mg和NH3的混合气流通入反应室进行Mg的掺杂。上述3个步骤构成1次Mg-δ掺杂的子循环。将上述Mg-δ掺杂子循环重复10次,从而完成整个Mg-δ掺杂p-AlyGa1-yN层的MOCVD外延生长。另外,在外延生长样品P1~P3的Mg-δ掺杂p-AlyGa1-yN层时,除了TMAl的流量大小分别为0、5.8和8.7μmol/min之外,其余外延生长条件均相同。由此可以看出,样品P1其实就是非极性a面Mg-δ掺杂的p-GaN外延层样品,因而在本研究中我们将其作为参考样品。为了提高具有高Al组分的非极性(112ˉ0)a面p-AlyGa1-yN外延层的晶体质量,改善其结构和电学特性,本课题组研发了一种以金属有机物源的流量脉冲供给(PMFS)为特征的MOCVD外延生长技术,并利用新开发的PMFS的MOCVD外延生长技术获得了Al组分高达41%的非极性(112ˉ0)a面p-AlGaN外延层样品P4。图2(b)为采用以PMFS为特征的MOCVD技术生长的Mg-δ掺杂p-AlyGa1-yN外延层样品P4在生长时的金属有机物源和氨气的供应图。与前述常规的Mg-δ掺杂技术的类似之处是同样需要重复10个子循环,且在每个子循环中首先外延生长厚度大约为22 nm的非极性(112ˉ0)a面AlGaN层;不同之处是在外延生长AlGaN层时,一方面保持NH3持续通入反应室,另一方面将TMAl和TMGa分别交替通入反应室3 s和9 s。子循环的吹扫和Mg掺杂步骤则与前述Mg-δ掺杂技术相同。在完成所有的Mg-δ掺杂p-AlyGa1-yN样品的外延生长过程后,均在800℃的氮气氛围中对全部样品进行快速热退火,从而断裂Mg-H键,激活p-AlyGa1-yN外延层中的Mg受主杂质。
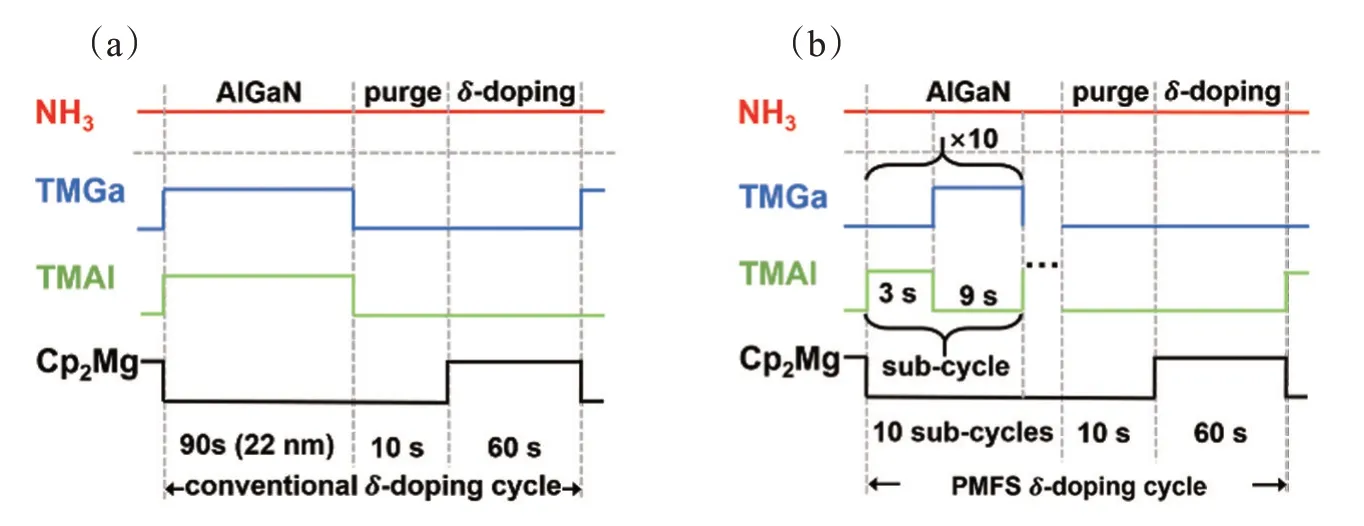
图2 采用常规(a)和PMFS(b)Mg-δ掺杂技术生长p-Aly Ga1-y N外延层时的金属有机物源和氨气的供应图
本研究采用高分辨率X射线衍射(HR-XRD)表征所有的非极性(112ˉ0)a面p型AlGaN外延层样品的晶体质量和结构特性,用原子力显微镜(AFM)揭示非极性(112ˉ0)a面p型AlGaN外延层样品的表面形貌。采用In电极作为欧姆接触电极,根据Van der Pauw法在室温下利用霍尔效应测试仪评估所生长的非极性(112ˉ0)a面p型AlGaN外延层样品的电学性能。
2 结果与讨论
图3(a~d)为样品P1~P4的HR-XRD的2θ-ω扫描曲线。如图3(a)所示,在样品P1的2θ-ω扫描曲线中,位于57.65°和59.35°的两个峰为非极性(112ˉ0)a面的p-GaN外延层和HT-AlN缓冲层的XRD衍射峰[18-19]。在图3(a)中,非极性(112ˉ0)a面p-GaN外延层的XRD衍射峰的右侧“肩位”处有明显的不对称展宽的XRD衍射峰。我们认为这种现象是由非极性(112ˉ0)a面Al组分渐变的AlxGa1-xN缓冲层的XRD多个衍射峰叠加所引起。此外,从图3(b)~3(d)可知,样品P2~P4均拥有3个清晰的XRD衍射峰。例如在图3(b)中,2θ位于57.65°、58.12°和59.35°的3个XRD衍射峰分别源自非极性(112ˉ0)a面GaN缓冲层、非极性(112ˉ0)a面p-AlyGa1-yN外延层和非极性(112ˉ0)a面HT-AlN缓冲层的衍射。根据XRD衍射峰位,计算样品P2中的p-AlyGa1-yN外延层的Al组分y为27%。类似地,根据图3(c)和3(d)所示的p-AlyGa1-yN外延层的XRD衍射峰位,可估算样品P3和P4中的p-AlyGa1-yN外延层的Al组分y分别为37%和41%。

图3 非极性(112ˉ0)a面p-AlGaN样品P1~P4的XRD 2θ-ω扫描曲线
为了评估具有不同Al组分的非极性(112ˉ0)a面p-AlyGa1-yN外延层样品的晶体质量,我们分别在phi=0°([0001]方向)和phi=90°([1010]方向)的方位角上测量了样品P1~P4的X射线摇摆曲线(XRCs),测试数据如表1所示。从表1可知,样品P1~P4的非极性(112ˉ0)a面p-AlyGa1-yN外延层所对应的衍射峰的XRC半高宽(FWHM)值沿[0001]方向分别为1 188、1 282、1 540和1 294 arcsec,而沿[1010]方向则分别为1 719、1 962、3 347和1 548 arcsec。从XRC的FWHM测量值可以发现,采用常规的Mg-δ掺杂技术外延生长的样品P1~P3,沿[0001]和[1010]方向测量的XRC的FWHM值均随Al组分的增加而显著增大。具体而言,沿[0001]和[1010]方向测得的XRC的FWHM值分别从样品P1(Al组分为0)的1 188和1 719 arcsec增加到样品P3(Al组分为37%)的1 540和3 347 arcsec。这一结果表明,采用常规的Mg-δ掺杂技术外延生长的p-AlyGa1-yN外延层晶体质量随着Al组分的增加而显著变差。产生这种现象的原因是,随着p-AlyGa1-yN外延层Al组分的增加,p-AlyGa1-yN外延层与下方Al组分渐变的AlxGa1-xN缓冲层的最上层(即GaN层)的晶格失配亦将逐渐增大,而晶格失配的增大会造成p-AlyGa1-yN外延层中位错密度的增加。从XRC的FWHM测量值可知,采用常规的Mg-δ掺杂技术外延生长的样品P1~P3沿[0001]方向测得的XRC的FWHM值均明显小于沿[1010]方向测得的XRC的FWHM值,且随着p-AlyGa1-yN外延层Al组分的增加,沿[0001]方向和沿[1010]方向测得的XRC的FWHM值之间的差异也越来越大,表明外延生长的非极性(112ˉ0)a面p-AlyGa1-yN外延层的晶体质量与Al组分呈密切相关的各向异性,且沿[1010]方向比沿[0001]方向具有更大的晶格畸变[20-21],而这种畸变在采用常规的Mg-δ掺杂技术外延生长的p-AlyGa1-yN外延层中,随着Al组分增加而加剧。从表1中还得知,采用PMFS技术生长的Mg-δ掺杂的p-AlyGa1-yN外延样品P4,其沿[0001]和[1010]方向测得的XRC的FWHM值分别为1 294和1 548 arcsec,且沿[0001]和[1010]两方向XRC的FWHM值之间的差距,明显小于采用常规的Mg-δ掺杂技术外延生长的样品P1~P3。这一事实表明,样品P4晶体质量的各向异性比样品P1~P3明显减弱。特别值得注意的是,尽管样品P4中的p-AlyGa1-yN外延层的Al组分高于样品P3,其沿[0001]和[1010]方向测得的XRC的FWHM值相比样品P3均大为减小。这一结果充分说明了采用以PMFS为特征的Mg-δ掺杂技术外延生长p-AlyGa1-yN外延层可以显著提升晶体质量。我们认为这是由于采用PMFS的Mg-δ掺杂技术可有效提升Al吸附原子在外延生长时的迁移长度,较易进入到能量更低的晶格结点中,从而降低p-AlyGa1-yN外延层的缺陷密度。

表1 非极性a面(112ˉ0)p-AlGaN外延层样品P1~P4的FWHM值以及空穴浓度、空穴迁移率和电阻率
为了详细探究非极性(112ˉ0)a面p-AlyGa1-yN外延层样品P1~P4的表面形貌,我们采用轻敲模式,分别在探测面积为5×5μm2和2×2μm2的区域内,对样品P1~P4进行AFM测试。如图4(a)所示,在样品P1的表面上沿c方向上分布着明显的起伏状结构,这正是非极性(112ˉ0)a面GaN外延材料的典型表面形貌特征。这种起伏状的表面形貌是由于在非极性(112ˉ0)a面内Ga原子在表面沿[0001]和[1010]方向的扩散长度不同所导致[20]。此外,在样品P1表面没有发现明显的“金字塔状”表面缺陷,且经过测算,其表面粗糙度的均方根值(RMS)为0.8 nm,这表明样品P1具有极为光滑的表面形貌。然而,随着p-AlyGa1-yN中Al组分的增加,样品P2的RMS值高达11.3 nm,表明样品P2的表面形貌相比样品P1要粗糙得多,而且在样品P2表面上沿[0001]方向还出现许多“金字塔状”表面缺陷,如图4(b)所示。样品P2表面形貌显著恶化的物理原因应该是:在较薄的p-GaN层下方的非极性p-AlGaN外延层中,Al和Ga原子的扩散长度在面内具有强烈的各向异性。事实上,Al原子在表面的扩散长度远小于Ga原子在表面的扩散长度[13]。随着p-AlyGa1-yN中Al组分从样品P2的27%进一步增加到样品P3的37%,可以观察到采用常规Mg-δ掺杂技术外延生长的样品P3表面形貌发生了进一步恶化,如图4(c)所示。样品P3表面粗糙度的RMS值为32.1 nm,并且其表面的“金字塔状”表面缺陷密度相比样品P2也明显增大。与此结果形成鲜明对比的是,即使样品P4的p-AlyGa1-yN外延层中Al组分高于样品P3,其表面形貌却极为光滑,不仅RMS值大幅下降至1.3 nm,而且在样品P4的表面几乎观察不到“金字塔状”表面缺陷,如图4(d)所示。选取图4(d)所示样品P4的表面较光滑的虚线区域(探测面积为2×2μm2)进行AFM表面形貌测试,结果如图4(e)所示:在样品P4表面较为平坦的区域,其表面粗糙度RMS值仅为0.5 nm,甚至小于样品P1的RMS值。AFM测量结果表明,即使非极性(112ˉ0)a面p-AlyGa1-yN外延层中的Al组分超过40%,样品P4的表面形貌也仍非常平坦光滑。究其原因是由于在采用新研发的、以PMFS为特征的Mg-δ掺杂技术进行MOCVD外延生长的过程中,将TMGa和TMAl交替注入到MOCVD反应室中,可以给原子尤其是Al原子提供额外的时间,以迁移到晶格的合适位置。换言之,通过交替供应Ga和Al源可有效地增加Ga和Al原子的表面迁移长度[22],因而能够有效应对p-AlyGa1-yN外延层在MOCVD生长过程中Ga和Al原子在晶体表面迁移长度不足的挑战。
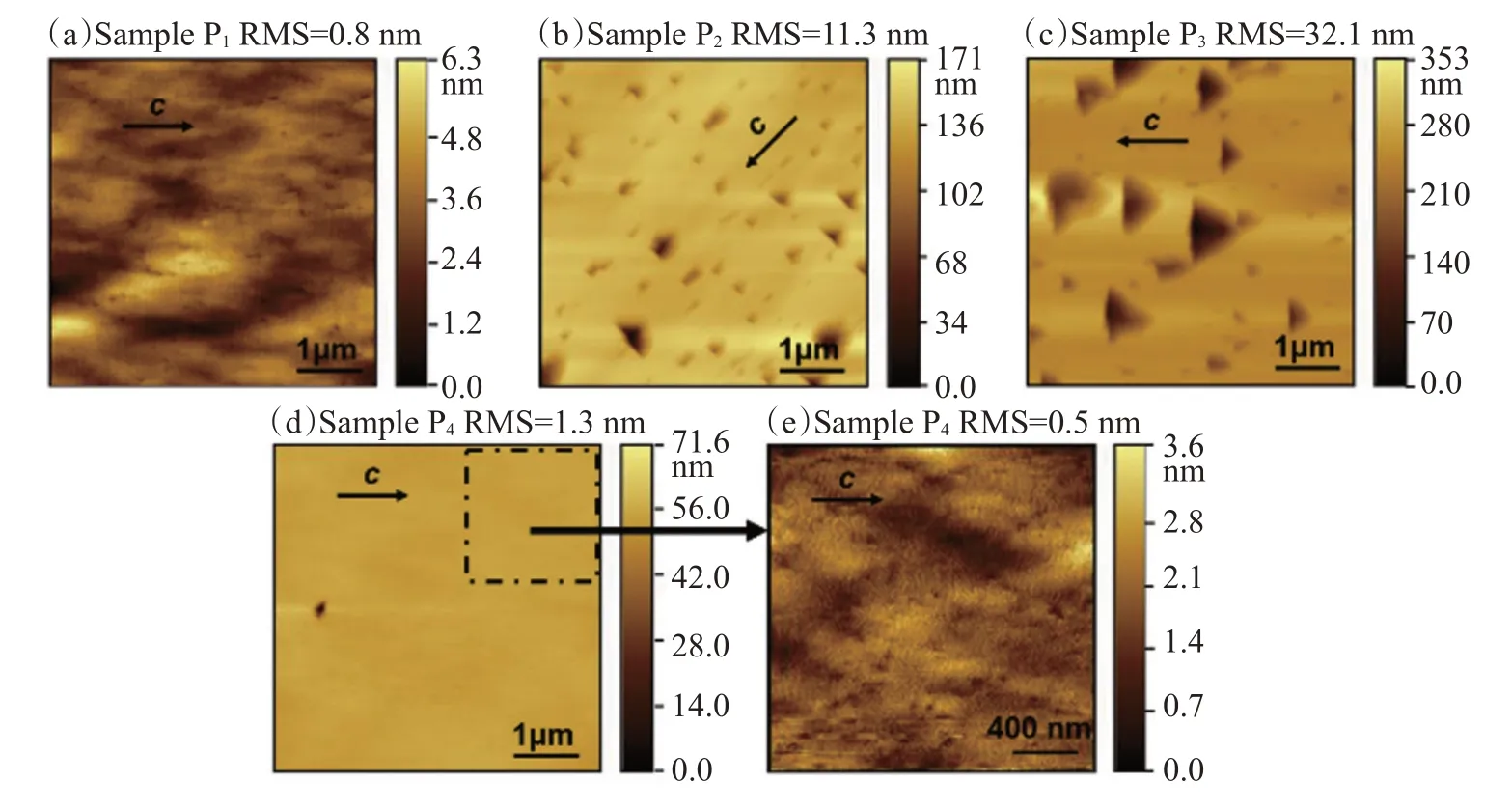
图4 非极性(112ˉ0)a面p-AlGaN样品P1~P4的2D-AFM表面形貌图像
此外,在室温下利用霍尔效应测试系统表征了样品P1~P4的空穴浓度、空穴迁移率和电阻率等电学性质参数,如表1所示。与非极性(112ˉ0)a面p-GaN外延层参考样品P1相比,采用常规的Mg-δ掺杂技术外延生长的p-AlyGa1-yN外延层样品P2和P3的电学性质与p-AlyGa1-yN外延层的Al组分y具有非常强烈的依赖关系。测试结果显示:相比样品P1,随着样品P2的Al组分增加至27%,其空穴浓度和空穴迁移率分别从8.1×1017cm-3和12.6 cm2/V∙s显著降低至2.4×1017cm-3和5.5 cm2/V∙s,电阻率则从0.9Ω·cm大幅增加至6.4Ω∙cm。当样品P3的p-AlyGa1-yN外延层中Al组分增加至37%时,由于电阻率过高(几乎为高电阻值样品),故无法测得样品P3准确的空穴浓度和空穴迁移率等电学性能参数。这一测试结果表明,对于采用常规的Mg-δ掺杂技术外延生长的p-AlyGa1-yN外延层样品P1~P3,其电学性质随着Al组分的增加而显著下降。我们认为主要原因在于:一方面,通常Mg受主在p-AlyGa1-yN外延层的激活能随着Al组分的增加呈指数型增加,而激活能的增加势必造成空穴浓度的急剧下降;另一方面,从前述的XRC测试结果也可以看到,随着Al组分增加,样品P1~P3的晶体质量呈单调下降趋势。需要强调的是,虽然样品P2和P3相比样品P1的电学性能显著下降,但是由于非极性(112ˉ0)a面p-AlGaN的外延生长难度很大,因此迄今除本文外,尚无关于Al组分超过20%的非极性(112ˉ0)a面p-AlGaN外延层电学性质的相关报道。
另外,虽然样品P4的p-AlGaN外延层Al组分进一步增加并超过了样品P3,但由于采用了新研发的、以PMFS为特征的Mg-δ掺杂技术进行外延生长,样品P4却显示出更为良好的导电性质,其在室温下测得的空穴浓度为7.0×1016cm-3,空穴迁移率为7.4 cm2/(V∙s),电阻率为23.3Ω∙cm,如上页表1所示。采用以PMFS为特征的Mg-δ掺杂技术外延生长的p-AlyGa1-yN外延层电学性能的提高,可以归因于以PMFS技术生长的样品P4在晶体质量和表面形貌上的显著改善。这一事实意味着,新研发的、以PMFS为特征的Mg-δ掺杂技术,除了能提升p-AlyGa1-yN外延层的晶体质量和表面形貌之外,还可以有效改善非极性(112ˉ0)a面p-AlGaN外延层的电学特性。
3 结论
本研究利用改良的MOCVD技术,成功地在半极性r面蓝宝石衬底上,外延生长了具有高电导率和高Al组分Mg-δ掺杂的非极性a面p-AlGaN外延层样品。研究结果表明,由于在MOCVD生长过程中采用了新研发的、以PMFS为特征的Mg-δ掺杂技术,具有较高Al组分的非极性p-AlGaN外延层的晶体质量、表面形貌和电学性能均得到显著改善。尤其是Al组分高达41%的p-Al0.41Ga0.59N外延层样品P4,其在室温下测得的空穴浓度、空穴迁移率和电阻率仍分别达到7.0×1016cm-3、7.4 cm2/(V·s)、23.3Ω·cm的较高水平。这些测试结果也有力说明:采用本课题组新研发的、以PMFS为特征的Mg-δ掺杂技术外延生长的p-AlGaN外延层具有良好的晶体质量、表面形貌和导电特性,可在后续制备高发光效率的非极性a面AlGaN基紫外发光二极管的过程中起到关键性的作用。

