磁控溅射与电弧离子镀制备TiN薄膜的比较
李 鹏,黄美东,佟莉娜,张琳琳,王丽格,李晓娜
(1.天津师范大学 物理与电子信息学院,天津 300387;
2.大连理工大学 三束重点实验室,辽宁 大连 116024)
磁控溅射与电弧离子镀制备TiN薄膜的比较
李 鹏1,黄美东1,佟莉娜1,张琳琳1,王丽格1,李晓娜2
(1.天津师范大学 物理与电子信息学院,天津 300387;
2.大连理工大学 三束重点实验室,辽宁 大连 116024)
分别采用磁控溅射和电弧离子镀在抛光后的W18Cr4V高速钢基体表面沉积TiN膜层,利用纳米力学系统、扫描电子显微镜(SEM)和X射线衍射仪(XRD)对薄膜进行测试,比较了两种方法所制备的薄膜的异同.结果表明:磁控溅射所制备的薄膜表面平整,但沉积速率和硬度均低于电弧离子镀制备的薄膜.
TiN;磁控溅射;电弧离子镀
20世纪60年代后期,在金属切削刀具表面真空沉积TiN薄膜取得成功后,硬质薄膜不仅成倍提高了刀具的切削寿命,而且允许切削速度大幅度增加,同时获得很好的加工精度和效率,在机械加工行业获得了广泛的应用.在沉积薄膜的各种方法中,电弧离子镀由于具有离子能量高、离化率高、膜层致密和附着力强等优点,已取代了其他各种类型的离子镀,成为当前TiN镀层工业主要的生产工艺,制备所得的TiN硬质膜广泛应用于材料表面装饰和各种工具的表面强化[1-6].然而,电弧离子镀制备的薄膜容易含有弧光放电过程所产生的显微喷溅颗粒,不仅影响表面的粗糙度,而且破坏膜的连续性[7].此外,普通电弧离子镀是以直流负偏压为工艺基础的镀膜技术,由于电弧等离子体具有很高的离化率,因此偏压对基体的温度具有明显的影响,这也限制了电弧离子镀的应用范围.与电弧离子镀相比,磁控溅射是一种“低温”溅射沉积技术,沉积过程中,电子对基体的轰击能量小,容易实现薄膜的低温沉积,使基体不产生回火软化,避免了基体与所沉积的薄膜之间存在较大的硬度差,也不存在表面显微喷溅颗粒污染的问题,但磁控溅射的沉积速率比较低,不适合大规模的工业生产,绕镀性明显不如电弧离子镀.
TiN薄膜属于第Ⅳ族过渡金属氮化物,具有NaCl面心立方晶体结构类型.它的结构由金属键和共价键混合而成,由于具有高硬度和低摩擦系数等优良的综合力学性能,被广泛用于模具和刀具等的耐磨改性层,是目前工业研究和应用最为广泛的薄膜材料之一[8].本研究以TiN薄膜为研究对象,在国产SA-6T型离子镀膜机上分别采用磁控溅射法和电弧离子镀技术沉积TiN,分析了两种方法制备的TiN薄膜在沉积速率、表面形貌、微结构和力学性能等方面的差异.
1 实验方法
高速钢体的样品规格为:15mm×10mm×10mm,基体试样分别用320号、400号、800号、1200号和1500号砂纸逐次打磨,然后在抛光机上抛光,直至基体试样表面呈现镜面,将抛光后的基体试样固定在真空沉积室的试样架上.沉积TiN薄膜采用立式结构的国产SA-6T型离子镀膜机,该镀膜机既可以从事6弧离子镀膜,也可以进行2靶直流磁控溅射镀膜.镀膜前将样品浸入酒精溶液中超声清洗20min,再用丙酮溶液浸泡,最后用吹风机烘干.涂层处理工艺为抽真空至3×10-3Pa,在基体上施加-1 000V的高偏压,开启电弧靶对基体表面进行离子溅射清洗3min,使其进一步净化.然后在不同偏压下,充入N2,开启电弧靶或磁控靶电源,进行反应镀膜,最后降温出炉[9].1-7号样品是通过电弧离子镀制备的,其中,1-4号样品是在保持N2流量不变的情况下,在不同偏压下制备的;5-7号样品是在偏压相同、N2流量不同的情况下制备的;8-9号样品为采用磁控溅射方法制备的TiN薄膜.详细实验参数见表1.
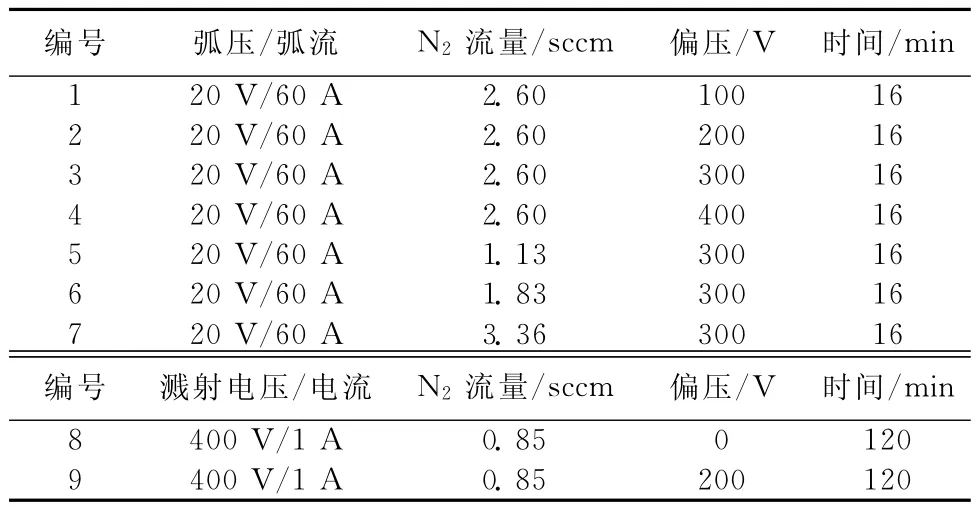
表1 实验工艺参数Table 1 Experimental details
采用美国Ambios公司的表面轮廓仪(XP-2)对薄膜的厚度进行测量,用XP型纳米压痕仪测试薄膜的硬度和弹性模量,薄膜的表面形貌用SHIMADZUSSX-550型扫描电子显微镜观察,利用X射线衍射仪(XRD,D/MAX2500)对样品进行物相和晶体结构分析.
2 结果与讨论
2.1 沉积速率
考虑到磁控溅射镀膜的沉积速率通常远小于电弧离子镀,为了得到厚度基本相当的薄膜样品,在制备样品时大大延长了磁控溅射的镀膜时间.如表1所示,所有电弧离子镀镀膜时间均仅为16min,而溅射镀膜时间为120min.采用表面轮廓仪(XP-2),对样品厚度测量3次,取平均值以减小测量误差.根据测量得到的薄膜厚度和相应的沉积薄膜所用时间,通过计算得到不同方法沉积薄膜的沉积速率.其中,磁控溅射TiN薄膜的沉积速率约为4~5nm/min,电弧离子镀的沉积速率约为40~80nm/min,后者的沉积速率远远快于前者,样品厚度测试结果见表2.

表2 不同样品的薄膜厚度Table 2 Thickness of different samples
2.2 薄膜的表面形貌
图1是偏压分别为0V和200V时,磁控溅射TiN薄膜在3 000倍放大倍数下通过SEM观察到的薄膜样品的表面形貌.从图1可以看到,不同偏压下磁控溅射方法沉积的TiN膜层成膜质量良好,表面平整、致密,偏压对薄膜形貌的影响较小.

图1 不同偏压下磁控溅射TiN的表面形貌Figure 1 Surface topography of TiN films by magnetron sputtering under different biases
图2是电弧离子镀TiN薄膜的表面形貌,图中许多白亮色的大颗粒是由靶材在电弧高温蒸发作用下产生的熔滴引起的[10-11],尺寸很不均匀.沉积过程中,自钛离子轰击清洗样品开始就有颗粒到达样品表面,较小的随着镀膜过程的进行而被埋入膜层内,较大的只有部分埋入,较晚到达的则直接附着在膜表面[12].这些熔滴引起的颗粒不但影响膜表面光泽,还会降低薄膜性能,从而影响TiN薄膜的表面质量[13],在一定程度上限制了电弧离子镀膜技术在制备精细膜和功能膜等方面的进一步开发与应用.
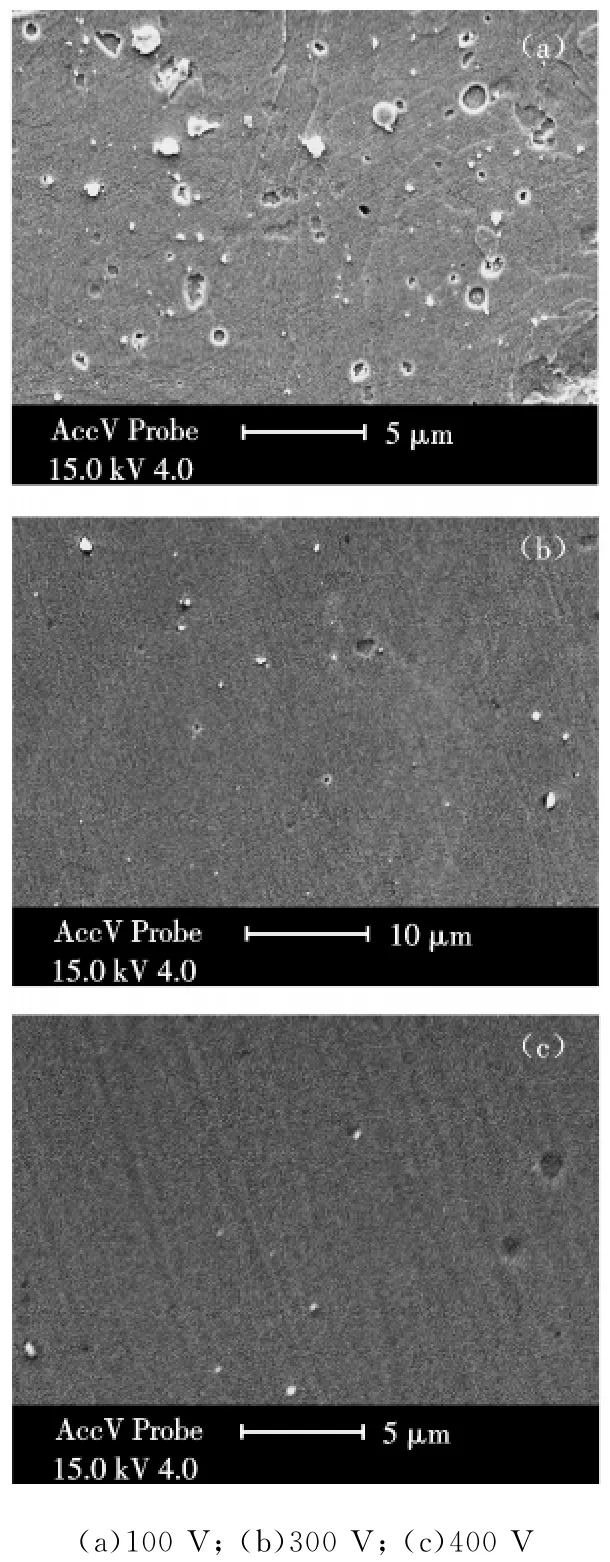
图2 不同偏压下电弧离子镀TiN的表面形貌Figure 2 Surface topography of thin films by arc ion plating at different biases
从图2还可以看出,基体所加偏压越高,表面形貌中大颗粒的尺寸越小,数量越少.大颗粒在沉积过程中将穿过等离子空间,相对于等离子空间中的电子、离子和中性原子来说,大颗粒具有非常大的尺寸和质量,电子和离子会随机地与它们发生碰撞.由于电子的热速度远大于离子的热速度,单位时间内到达大颗粒表面的电子数要远大于离子的个数,所以大颗粒在等离子体中是带负电的[14-17].带负电荷的大颗粒到达薄膜表面前要穿过一定厚度的鞘层,鞘层厚度与偏压大小有关,一般为几十μm至几mm之间.由Debye屏蔽效应可知,等离子体与基体间的电位降集中于鞘层处,实质上鞘层在基体与等离子体之间起到一种屏蔽作用,基体偏压只影响鞘层的分布和性质,对等离子体的中性区域基本没有影响,所以带负电的大颗粒进入鞘层区域后才受到偏压电场的影响.大颗粒在进入等离子体鞘层边缘时具有一定的初始动能,镀膜过程中,在基体上施加负偏压时,基体表面处存在一负电场,电场方向由等离子体指向基体表面,等离体与基体间的电势降主要集中于鞘层内且呈非线性变化.进入鞘层内的大颗粒会受到基体排斥力,当偏压较小时,基体对大颗粒的排斥力较小,大颗粒克服排斥力所需作的功较小,对于大部分大颗粒粒子来说,所需的功小于初始动能,这些大颗粒依旧会沉积到薄膜表面.随着施加负偏压的增大,电场强度逐渐增大,排斥力也逐渐增大,部分大颗粒的初始动能不足以弥补克服电场所需的功而使大颗粒无法到达基体,沉积到薄膜表面的大颗粒减少,表面形貌得到一定程度的净化.所以,较高偏压下制备的薄膜表面的大颗粒比在较低偏压下制备的要少且小,较高的偏压可以在一定程度上改善薄膜的表面形貌.不过,太高的偏压会使基体温度升高,可能导致薄膜综合性能变差.图2中有一些微坑,它们主要是由那些初始动能与电场排斥功基本相等时,以很弱的力附着在表面的大颗粒在离子轰击或电场力的作用下从表面脱附而形成的[18].
2.3 XRD衍射结果分析
图3和图4分别是两种方法制备的薄膜的XRD图谱.

图3 磁控溅射TiN薄膜的XRD图Figure 3 XRD spetra of TiN films by magnetron sputtering

图4 电弧离子镀TiN薄膜的XRD图谱Figure 4 XRD spectra of TiN films by arc ion plating
从图3中可以看出,磁控溅射制备的薄膜样品的XRD衍射结果在偏压为200V时可以观测到衍射峰TiN(111)和TiN(220),说明所得到的薄膜呈结晶态.不施加偏压时只能观测到微弱的TiN(220)峰,间接反映出偏压对沉积速率存在一定影响.偏压高时,离子所携带的能量高,沉积速率快;而偏压为0V时,薄膜的TiN(111)峰因厚度太小、衍射强度过低而无法观测到.
电弧离子镀制备的薄膜样品厚度较厚,因而XRD衍射结果中可以明显观察到来自薄膜的衍射峰,分析结果表明TiN薄膜具有面心立方(fcc)结构.结合前述薄膜厚度测试结果,基本可以解释图4(a)中TiN(111)峰强随N2流量的变化.随着流量增大,沉积气压增大,膜厚减小.当 N2流量达到3.36sccm时,衍射谱线上基本观察不到来自薄膜的衍射峰.从图4(b)中可以看出,来自TiN薄膜的3个晶面(111),(220)和(222)对应的衍射峰强度随偏压的变化而变化.为了考察偏压对TiN(111)与TiN(220)两个晶面择优取向情况的影响,引入择优取向因子F的定义[19]:
2.4 表面硬度和弹性模量
硬度是薄膜的一个重要的力学性能参数,对耐磨性具有重要的影响.用XP型纳米压痕硬度计测量了200V偏压下,分别由电弧离子镀和磁控溅射制备的TiN薄膜,即2号和9号样品的硬度.为了减少基体的影响,测量时探针划到薄膜厚度的1/10处.图5为两种方法获得的TiN薄膜进行硬度测试时的载荷-位移曲线.

图5 用纳米硬度计测量TiN薄膜的加载-卸载曲线Figure 5 Loading-unloading curves of TiN films by nano-indenter
加载过程中,试样首先发生弹性形变,随着载荷的增加,试样开始发生塑性形变,加载曲线呈非线性,当压头达至压痕最大深度时,载荷也加大到最大值;卸载曲线反映了被测物体的弹性恢复过程,当完全卸载后,仅弹性形变完全恢复,留下塑性形变压痕.由图5可以看出,电弧离子镀TiN薄膜加载的最大载荷为99mN,而磁控溅射TiN薄膜加载的最大载荷仅为79mN,由于硬度与最大载荷成正比,所以由电弧离子镀制备的薄膜的硬度比磁控溅射制备的高.
图6和图7分别是通过电弧离子镀方法在不同N2流量和不同偏压下制备的TiN薄膜的硬度值.

图6 不同N2流量下电弧离子镀TiN薄膜的硬度值Figure 6 Hardness of TiN films by arc ion plating at different N2flow

图7 不同偏压下电弧离子镀TiN薄膜的硬度值Figure 7 Hardness of TiN films by arc ion plating at different biases
从图6可以看出,TiN薄膜的硬度随N2流量的升高而增大,当N2流量达到2.60sccm时,硬度达到极大值;随着N2流量进一步增大,薄膜的硬度反而下降.硬度出现先增大后减小的趋势是由于N2流量的大小影响了Ti与N2的反应程度,流量过小时,反应不完全,薄膜硬度不高;流量过大时,膜层中的氮含量增多,也会降低薄膜的硬度.图7中,随基底负偏压的增加,薄膜硬度先增加后减小.负偏压的提高增强了轰击效果,导致薄膜的晶粒细化、致密度提高,从而硬度增大.但当偏压过高时,由于离子强烈的轰击,温度较高,冷却后薄膜的内应力增大,薄膜结构中可能出现一些微缺陷,导致硬度值下降.
图8是不同基底偏压下磁控溅射方法制备薄膜的硬度结果.对比图6、图7和图8可以看出,电弧离子镀制备的薄膜硬度为26.8~33.3GPa,而磁控溅射制备的薄膜硬度为15.7和16.4GPa,说明两种方法均提高了基底的硬度(高速钢的硬度为12.8GPa),但磁控溅射制备的薄膜的表面硬度低于电弧离子镀制备的薄膜.对于弹性模量,磁控溅射所制备的薄膜的弹性模量为208GPa和209GPa,远低于电弧离子镀的368~500GPa,这跟电弧离子镀离化率高,薄膜沉积时离子所携带的能量平均值高有关[20].高能离子在沉积过程中对先前生长的薄膜具有轰击作用,可以有效改善薄膜的微观组织结构,从而有效提高薄膜硬度.

图8 不同偏压下磁控溅射TiN薄膜的硬度曲线Figure 8 Hardness of TiN films by magnetron sputtering at different biases
3 结论
在国产SA-6T型离子镀膜机上分别采用磁控溅射和电弧离子镀方法制备TiN薄膜,实验结果表明:磁控溅射所制备的薄膜表面平整、致密,无明显的孔洞和电弧沉积时的大颗粒,但弹性模量和表面硬度均低于电弧离子镀所制备的薄膜,而且沉积速度较低;用电弧离子镀所制备TiN薄膜具有较快的沉积速率,虽然表面存在大颗粒污染,但薄膜硬度较用磁控溅射所制备的薄膜硬度有所提高;研究还发现,偏压对电弧镀TiN薄膜的择优取向有明显影响.
[1] Yousif A E,Nacy S M.The lubrication of conical journal bearings with bi-phase (liquid-solid)lubricants [J].Wear,1994,172(1):23-28.
[2] 白秀琴,李健.磁控溅射TiN薄膜低温沉积技术及其摩擦学性能研究[J].润滑与密封,2006(5):15-17,21.
[3] 武咏琴,李刘合,张彦华,等.TiN膜的制备和进展[J].新技术新工艺,2004(12):50-52.
[4] Randhawa H,Johnson P C.Technical note:a review of cathodic arc plasma deposition processes and their applications[J].Surf Coat Technol,1987,31(4):303-318.
[5] Akari K,Perry A J.Advances in cathodic arc technology using electrons extracted from the vacuum arc[J].Surf Coat Technol,1993,61(1/2/3):305-309.
[6] 闻立时,黄荣芳.离子镀硬质膜技术的最新进展和展望[J].真空,2000(1):1-11.
[7] 白秀琴,李健.低温磁控溅射与普通电弧离子镀TiN薄膜的摩擦学性能比较[J].中国表面工程,2006(1):13-15.
[8] 季鑫,宓一鸣,周细应.TiN薄膜制备方法、性能及其应用的研究进展[J].热加工工艺,2009(3):81-83.
[9] 孙伟,宫秀敏,叶卫平,等.电弧离子镀沉积温度对TiN涂层性能的影响[J].电加工与模具,2000(5):26-28.
[10] 胡敏,刘莹,赖珍荃,等.磁控溅射TiN薄膜的工艺及电学性能研究[J].功能材料,2009,40(2):222-225.
[11] 胡敏,刘莹,赖珍荃,等.磁控溅射制备TiN薄膜影响因素的研究[J].功能材料,2009,40(9):1465-1467.
[12] Tai C N,Koh E S,Akari K.Macroparticles on TiN films prepared by the arc Ion plating process[J].Surf Coat Technol,1990,43/44:324-335.
[13] 曾鹏,胡社军,谢光荣,等.脉冲偏压对真空电弧沉积TiN薄膜组织与性能的影响[J].材料热处理学报,2001,22(3):62-66.
[14] Selwyn G S,Singh J,Bennett R S.In-situ laser diagnostic studies of plasma-generated particulate contaminatioo[J].J Vac Sci Technol A,1989,7(4):2758-2765.
[15] Wu J J,Miller R J.Measurements of charge on submicron particles generated in a sputtering process[J].J Appl Phys,1990,67(2):1051-1054.
[16] Nowlin R N,Carlile R N.The electrostatic nature of contaminative particles in a semiconductor processing plasma[J].J Vac Sci Technol A,1991,9(5):2825-2833.
[17] Melzer A,Trottenbery T,Piel A.Expermental determination of the charge on dust particles forming Coulomb lattices[J].Phys Lett A,1994,191(3/4):301-308.
[18] 黄美东,林国强,董闯,等.偏压对电弧离子镀薄膜表面形貌的影响机理[J].金属学报,2003,5(39):510-515.
[19] 黄美东.脉冲偏压电弧离子镀低温沉积研究[D],大连:大连理工大学,2002.
[20] 黄美东,孙超,林国强,等.脉冲偏压电弧离子低温沉积TiN硬质薄膜的力学性能[J].金属学报,2003,5(39):516-520.
Comparison of TiN films prepared by magnetron sputtering and arc ion plating
LIPeng1,HUANGMeidong1,TONGLina1,ZHANGLinlin1,WANGLige1,LIXiaona2
(1.College of Physics and Electronic Information Science,Tianjin Normal University,Tianjin 300387,China;
2.Key Laboratory of Materials Modification by Laser,Ion and Electron Beams,Dalian University of Technology,Dalian 116024,Liaoning Province,China)
TiN films were deposited onto the well-polished W18Cr4Vby DC magnetron sputtering and arc ion plating,respectively.Both advantages and shortcomings of these two methods were discussed according to the microstructure and properties of the films measured by nano-indenter,SEM,as well as XRD.It was concluded that the films prepared by magnetron sputtering had cleaner surfaces but less deposition rate as well as lower hardness,when compared with those deposited by arc ion plating.
TiN;magnetron sputtering;arc ion plating
O484.4
A
1671-1114(2011)02-0032-06
2010-10-25
国家自然科学基金资助项目(61078059);天津师范大学学术创新推进计划资助项目(52X09038)
李 鹏(1985—),男,硕士研究生.
黄美东(1972—),男,副教授,主要从事表面改性及功能薄膜方面的研究.
(责任编校 纪翠荣)

