基于晶界离散分布的多晶硅薄膜晶体管直流模型*
严炳辉 李斌† 姚若河 吴为敬
(1.华南理工大学电子与信息学院,广东广州510640;2.华南理工大学材料科学与工程学院,广东广州510640)
多晶硅薄膜晶体管(TFT)在大规模有源矩阵显示器、大容量存储器等领域得到了广泛的应用[1-2].业界需要既能准确反映多晶硅TFT物理特性,又便于电路仿真的TFT电流解析模型.因此,多晶硅TFT模型研究已引起广泛的关注[3-6].
多晶硅TFT沟道中存在着晶粒与晶界势垒,增加了TFT伏安特性的复杂性及模型建模的困难.目前有两类多晶硅TFT 的解析模型[3-8]:(1)基于阈值电压的分区模型[3-5],该类模型可反映在栅电压的控制下晶界势垒对TFT的伏安特性的影响,但必须引用光滑函数连接各个分区,增加了模型参数和模型的复杂程度;(2)基于表面势的模型[6-8],该类模型可通过单一的电流方程表示各个工作区,简化了模型参数,但必须假定晶界陷阱均匀分布于整个沟道中,并忽略晶界势垒对载流子输运的影响,偏离了多晶硅TFT的物理特性,给器件仿真带来误差[9].此外,漏压会改变晶界势垒分布,从而影响沟道有效迁移率,而上述两类模型均忽略这一特点.
有鉴于此,文中根据基于表面势模型的建模思想,将多晶硅TFT沟道按晶粒个数分成若干个小TFT,以解决晶界势垒不利于沟道表面势求解的问题,并结合各小TFT电流相等的原理,建立多晶硅TFT的直流电流模型.该模型考虑了晶界势垒离散分布对TFT伏安特性的影响,可用单一解析方程来描述多晶硅TFT的亚阈值区、线性区和饱和区的漏电流.最后通过仿真验证模型的有效性.
1 模型建模
考虑晶界势垒的沟道表面势求解模型如图1所示.该模型假设其各晶粒大小相等,各晶粒间界与沟道垂直;晶粒串联排列在TFT沟道中,每个晶粒间界和两旁的半个晶粒组成的结合体为一个小TFT,也就是将晶界置于小TFT的沟道中间,将晶粒正中间作为其左边小TFT的漏端和右边小TFT的源端,如图1所示.根据上述模型,求出多晶硅TFT源、漏两端的表面势,结合沟道电流连续性原理来确定各小TFT源端和漏端的表面势函数,进而求出各晶界势垒高度和各个小TFT的沟道迁移率,最后求得多晶硅TFT的漏电流方程和沟道有效迁移率的表达式.
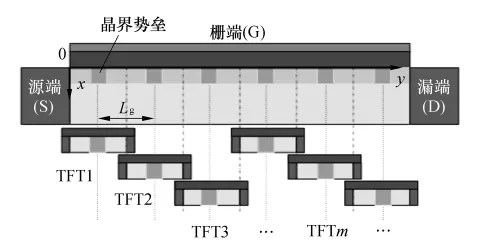
图1 多晶硅TFT分成若干小TFT的示意图Fig.1 Schematic diagram of small TFTs within poly-Si TFT
1.1 小TFT表面势ψs及自由电荷浓度Ui
对于本征多晶硅TFT,施加栅压Vgs后,沟道中晶粒内部产生感生电荷,同时表面势也发生变化,其一维泊松方程为

式中:ψ为沟道表面势;x为氧化层与晶粒中间的界面处,沿沟道深度方向的空间位置;Lg为晶粒大小;εSi为硅材料的介电常数;n为自由载流子密度(体密度)为硅的本征载流子浓度,V为沟道电势,φt为热电压,φt=kT/q,k为玻尔兹曼常数,T为温度,q为电子电量;NT为晶粒中间恰好出现自由载流子时,俘获电荷的晶界陷阱浓度.随着栅压继续增大,俘获电荷的晶界陷阱继续增加,但不影响晶粒中间处的表面势,仅影响晶界势垒高度.
利用高斯定理可得栅电压与表面势的关系表达式:

式中,表面势ψs为ψ在x=0处的值,Vfb为平带电压,Cox为单位面积上的栅电容.

沟道中表面势发生变化,同时产生感生电荷.根据电荷守恒定律,沟道感生电荷QC由自由电荷QI与被陷阱俘获的电荷QT组成,即

由式(2)-(4)得到QI与表面势的关系:

结合式(3)和(6)可求得漏、源两端的自由电荷浓度(面密度),但沟道内各个小TFT的自由电荷浓度(面密度)及表面势还需结合沟道电流方程求得.
为了方便计算,假设沟道各位置的迁移率相等,并忽略晶界势垒对沟道表面势的影响,则TFT沟道的电流方程为

式中,W为TFT沟道宽度,μ为迁移率,y为从源端到漏端的沟道坐标.
对式(7)求积分,可得漏电流:

式中,L为沟道长度,ψss和ψsd分别为多晶硅TFT源端和漏端的表面势.
由式(5)-(8)得到表面势与y的关系:

式(9)即是沟道表面势分布函数,结合式(6)可求得沟道自由电荷分布函数.然而,由于晶粒离散分布于沟道,因此,第m个小TFT漏端的电荷浓度和表面势应取y=mLg处的值,源端的电荷浓度和表面势应取y=(m-1)Lg处的值.根据自由电荷与晶界势垒的关系,可求解出第m个小TFT中的晶界势垒高度及迁移率.
1.2 晶界势垒高度与小TFT的迁移率
小TFT中晶界陷阱俘获载流子,使其两旁产生耗尽区,形成晶界势垒[10].晶界势垒会阻碍晶粒中自由载流子的输运,从而降低小TFT的迁移率.
晶粒内感生电荷的浓度比较低时,所有感生电荷会被晶界陷阱俘获,晶粒完全耗尽;当感生电荷的浓度增加到一定值时,继续增加感生电荷会减小耗尽区,晶粒部分耗尽,此时,晶界势垒达到最大值.此后晶界势垒会随感生电荷增加而降低,因此晶粒部分耗尽时,晶界势垒与自由电荷浓度的关系为[10]

式中,b=8CoxVB0εSit-1ch(qNst)-2,VB0为晶界势垒的最大值,Nst为俘获电荷的晶界陷阱浓度,tch为自由载流子厚度.对于本征多晶硅TFT,当栅极电压较低,即沟道晶粒的费米能级在本征费米能级附近时,晶界势垒可达到最大值.因为晶粒间界存在大量的带尾态,随着费米能级向带隙边缘移动,将有更多的晶界陷阱俘获电荷,所以 Nst远大于 NT.此外,根据Dimitriadis的实验结果[11],在实际的多晶硅TFT中,晶粒完全耗尽时,晶界势垒高度与最大值相近,其差别对电流的影响可以忽略,因此可用式(10)表示晶粒完全耗尽时的晶界势垒高度.
漏端电压的作用使得自由载流子在沟道各个小TFT中的分布不均匀,导致各晶界势垒高度分布不均匀,如图2所示.

图2 漏压作用下多晶硅TFT中晶界势垒分布图Fig.2 Distribution of grain-boundary barriers in poly-Si TFT under the drain bias
实际上,因为小TFT的沟道长度远小于多晶硅TFT,所以小TFT的源、漏两端载流子浓度相差极小,即 Ui(mLg)≈Ui((m -1)Lg).结合式(6)和(10),第m个小TFT的晶界势垒可表示为

由式(11)可知,从源端到漏端方向上晶界势垒逐渐增高,因此沟道中晶界势垒的平均高度也随之增高,文中定义为漏致晶界势垒不均匀分布效应.此效应是由于漏电压作用下沟道载流子浓度沿漏端方向逐渐降低,使得相应位置的晶界势垒升高而产生.与此相反,在多晶硅TFT沟道横向电场作用下,晶界两旁的耗尽区中,迎着电场方向一边的耗尽区宽度会减小,由此降低晶界势垒高度,即漏致势垒降低(DIGBL)效应[11].因此考虑 DIGBL效应后晶界势垒的表达式修正为

式中,VDIGBL为漏致晶
界势垒降低量[12],VDIGBL(mLg)=为修正参数,N为自由载流子浓度i(体密度),Ni(mLg)=CoxUi(mLg)(qtch)-1,E(mLg)为沟道横向电场.
由E=dψ/dy和式(9),即可求得第m个晶粒处的横向电场:

在多晶硅TFT中,晶粒迁移率主要由晶粒间界决定,根据Yang[4]的研究结果可知,沟道中第m个小TFT的迁移率可表示为

式中,μgb为小TFT的迁移率系数.
1.3 多晶硅TFT漏电流
考虑晶界势垒对迁移率的影响后,修正电流方程(7),得到第m个小TFT的电流方程为

由于流过各个小TFT的电流相等,即

由式(5)、(6)、(14)和(16)可得多晶硅TFT的电流方程为

式中:μeff为多晶硅TFT的有效迁移率,

N为多晶硅TFT沟道中小TFT的总数.式(17)和(18)是基于晶粒离散分布的多晶硅TFT直流电流模型.若晶界势垒高度为0,则式(17)可简化为基于表面势的SOI MOSFET电流模型.所以文中模型与通用的MOSFET模型有一致性,便于电路仿真.
2 模型验证和结果分析
为验证文中模型的有效性,将模型的仿真结果与文献[4]的实验数据进行比较.仿真所用的参数值见表1.不同宽长比的多晶硅TFT的输出特性如图3所示.从图3可见,模型仿真结果在较大的栅压范围内与实验数据吻合得较好.由于文中模型没有考虑kink效应[13],因此在高漏电压时实验数据比仿真结果稍大.在相等的漏电压和栅电压条件下,TFT2的漏电流仿真结果与实验数据之间的偏差比TFT1大.这是由于短沟的TFT2比TFT1具有更强的沟道电场,致使前者的kink效应更明显,其漏电流更大,因此造成上述差别.

表1 仿真中所用的参数Table 1 Parameters used in simulation
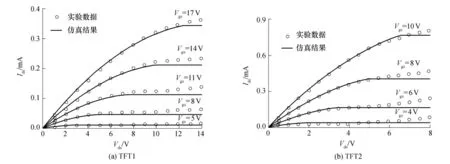
图3 两种不同晶体尺寸的多晶硅TFT输出特性的仿真结果与实验数据比较Fig.3 Comparison between simulated results and experimental data of output characteristics for poly-Si TFT with two different transistor sizes

图4 两种不同晶体尺寸的多晶硅TFT的有效迁移率与漏电压的关系Fig.4 Relationship between the effective mobility and the drain voltage for poly-Si TFT with two different transistor sizes
为进一步验证多晶硅TFT的有效迁移率与漏电压的关系.从文献[4]的输出特性数据中提取有效迁移率数据,并将其与文中模型(式(18))的仿真结果进行比较,结果如图4所示,二者具有较好的一致性.由图4可知,当TFT工作在线性区时,沟道有效迁移率受漏电压的影响表现为:漏致晶界势垒的不均匀分布效应明显超过漏致势垒的降低效应,因此有效迁移率随漏电压增加而降低;在较高栅压下,晶界势垒降低,有效迁移率受漏电压影响的程度减弱;相比TFT1,沟道较短的TFT2的有效迁移率受漏电压的影响更小,这是由于沟道较短,导致漏致晶界势垒的不均匀分布效应减弱,同时漏致晶界势垒的降低效应增强,两者共同作用使短沟道TFT的有效迁移率对漏电压的敏感度降低.由此可知,晶界势垒的存在使多晶硅TFT的有效迁移率受制于漏电压,进而影响TFT的伏安特性.当然,在实际的多晶硅TFT沟道中,晶粒大小不一、晶向各异、晶界的位置随机分布.文中为了方便描述多晶硅TFT的电学特性,借鉴现有模型[3-8]的建模方法,假设各晶粒大小相等、各晶界陷阱分布情况相同,因此造成实验数据和模型仿真结果之间的偏差(如图4所示).然而,文中还讨论了多晶硅TFT的有效迁移率与漏电压的关系,所提模型能较准确地解释有效迁移率随漏电压变化的趋势,模型仿真结果和实验数据之间的误差较小,平均误差在8%以内,在多晶硅TFT模型所容许的范围.
3 结语
文中考虑了多晶硅TFT中晶粒间界的离散分布,采用基于表面势模型的建模方法,建立了多晶硅
TFT的直流电流模型.该模型考虑了漏致晶界势垒的不均匀分布效应和降低效应,用单一的漏电流方程来描述多晶硅TFT的电流特性,能合理解释多晶硅TFT的有效迁移率随漏电压增大而降低的现象.
模型仿真结果与实验数据吻合得较好,从而验证了模型的有效性.
[1] Meng Z,Wong M.Active-matrix organic light-emitting diode display realized using metal-induced unilaterally crystallized polycrystalline silicon thin-film transistors [J].IEEE Transactions on Electron Devices,2002,49(6):991-996.
[2] Sato A,Momiyama Y,Nara Y,et al.A 0.5μm EEPROM cell using poly-Si TFT technology[J].IEEE Transactions on Electron Devices,1993,40(11):2126.
[3] Hatzopoulos A T,Tassis D H,Hastas N A,et al.On-state drain current modeling of large-grain poly-Si TFTs based on carrier transport through latitudinal and longitudinal grain boundaries[J].IEEE Transactions on Electron Devices,2005,52(8):1727-1733.
[4] Yang G Y,Hur S H,Han C H.A physical-based analytical turn-on model of polysilicon thin-film transistors for circuit simulation[J].IEEE Transactions on Electron Devices,1999,46(1):722-728.
[5] 姚若河,欧秀平.低掺杂多晶硅薄膜晶体管阈值电压的修正模型[J].华南理工大学学报:自然科学版,2010,38(1):14-17,43.Yao Ruo-he,Ou Xiu-ping.Modified model of threshold voltage for thin-film transistors with low-doped polysilicon[J].Journal of South China University of Technology:Natural Science Edition,2010,38(1):14-17,43.
[6] Chen R,Zheng X,Deng W,et al.A physics-based analytical solution to the surface potential of polysilicon thin film transistors using the Lambert W function [J].Solid State Electron,2007,51(6):975-981.
[7] Deng W,Zheng X,Chen R,et al.Subthreshold characteristics of polycrystalline silicon TFTs [J].Solid State Electron,2008,52(5):695-703.
[8] Bindra S,Haldar S,Gupt R S.Modeling of kink effect in polysilicon thin film transistor using charge sheet approach[J].Solid State Electron,2003,47(4):645-651.
[9] Wong M,Chow T,Wong C C,et al.A quasi two-dimensional conduction model for polycrystalline silicon thinfilm transistor based on discrete grains[J].IEEE Transactions on Electron Devices,2008,55(8):2148-2156.
[10] Serikawa T,Shirai S,Okamoto A,et al.A model of current-voltage characteristics in polycrystalline silicon thinfilm transistors[J].IEEE Transactions on Electron Devices,1987,34(2):1727-1733.
[11] Dimitriadis C A,Tassis D H.On the threshold voltage and channel conductance of polycrystalline silicon thinfilm transistors[J].Journal of Applied Physics,1996,79(8):4431-4437.
[12] Benzarti W,Plais F,Luca A D,et al.Compact analytical physical-based model of LTPS TFT for active matrix displays addressing circuits simulation and design [J].IEEE Transactions on Electron Devices,2004,51(3):345-350.
[13] 陈婷,李斌.多晶硅薄膜晶体管 kink效应的建模[J].微电子与计算机,2008,25(6):222-224.Chen Ting,Li Bin.Modeling of kink effect in polysilicon TFT [J].Microelectronics and Computer,2008,25(6):222-224.

