HfO/SiO高反射薄膜的应力控制技术研究
邱服民, 王 刚, 戴红玲, 蒲云体
(成都精密光学工程研究中心,成都 610041)
HfO/SiO高反射薄膜的应力控制技术研究
邱服民, 王刚, 戴红玲, 蒲云体
(成都精密光学工程研究中心,成都 610041)
摘要:物理气象沉积的薄膜通常都有应力。为了防止高反膜应力破坏基底的面型,采用数字波面干涉仪对电子束蒸发方法制备的薄膜的应力进行了测量,并讨论了影响光学介质薄膜应力的多种因素。使用了一种交替沉积HfO2和SiO2薄膜的技术路线,HfO2薄膜作为高折射率材料体现出张应力,SiO2薄膜作为低折射率材料体现出压应力。结果表明,在稳定了很多实验条件的情况下,通过调整镀膜时的充氧量和镀膜材料的蒸发速率实现了应力的平衡;高反射薄膜有比较高的损伤阈值。
关键词:薄膜;应力;氧分压;蒸发速率
E-mail:qiufuming121@sina.com
引言
几乎所有的薄膜都存在较大的应力,它对薄膜的牢固度、损伤阈值等很多重要的性能都有较大的影响。薄膜应力一般分为张应力和压应力,习惯上把张应力取正号,压应力取负号。在张应力作用下,薄膜本身有收缩的趋势,在压应力作用下,薄膜有向表面扩张的趋势,大多数金属膜以张应力的形式存在,多数介质膜是张应力,但也有一部分是压应力[1]。在高功率的激光系统中,要用到很多高损伤阈值的反射膜,分束膜以及偏振片,这些膜层的层数比较多,一般要用到高低两种镀膜材料,由于这两种镀膜材料的应力性质不同等复杂的原因,镀完膜的基片的反射波前经常发生很大的畸变,使被镀件无法按冷加工后的反射波前的指标来正常使用[2]。近年来,国内外的科学家对激光诱导薄膜损伤的机理进行了深入的研究[3],提出了包括雪崩电离、多光子吸收电离及杂质吸收等数学模型来解释观察到的实验现象,另外很多学者通过对薄膜应力的研究,了解薄膜的损伤机理,进而达到改善薄膜抗损伤性能的目的。尽管所有关于薄膜应力和激光诱导薄膜损伤的机理还没有统一的结论[4],但是同时满足薄膜应力平衡和薄膜具有高损伤阈值是所有高功率激光薄膜元件所追求的目标,而对运用在惯性约束核聚变系统的介质膜,HfO2/SiO2高阈值薄膜是研究中的重点。本文中的工作以HfO2/SiO2高阈值高反射薄膜为例来研究应力控制技术,一般来讲,电子束蒸发方式比离子束溅射方式在薄膜应力控制方面有优势,这个工作的目标是:用电子束蒸发方式镀膜后的高反膜的反射波前与镀膜前的基片的反射波前不能有明显的变化,同时薄膜有比较高的损伤阈值。
1影响薄膜应力的因素分析
薄膜的应力主要是由表面张力、热应力和内应力三部分组成。固体表面的表面张力大约为10-2N/cm2~10-3N/cm2,而一般情况下介质膜的应力的数量级是104N/cm2,所以尽管表面张力是一种应力,但大多数情况下对薄膜应力的贡献可以不计算。而热应力和内应力则非常复杂,它与薄膜应力的测试条件、薄膜元件的使用条件、镀膜时的温度、镀膜材料的蒸发速率、镀SiO2时的充氧量、膜层的厚度、镀膜前的基本真空度、镀膜后的退火处理都有很大关系[5]。
(1)影响薄膜应力的测试条件是温度和湿度,如果温度和湿度不稳定,薄膜应力变化很大。所以将镀膜前后的干涉仪所处的房间的温度控制在23℃附近,湿度在镀膜前后也基本保持一致。由于薄膜元件的应力在真空中使用和在大气中使用差别很大,一般来讲在大气中使用的薄膜放在真空中后薄膜的张应力增加,并且如果是在真空中使用,那么镀膜前基片的面型检测就应该在真空的状况中测量,所以作者都假设最后的使用条件是大气,故镀膜后的高反膜的反射波前与镀膜前的基片的反射波前都在大气中进行[6]。
(2)温度对薄膜的热应力有非常大的影响。因为热应力主要是由膜层与基板之间的热膨胀系数不同而引起的,可以这样讲,如果镀膜时的温度和测量时的基本温度一样的话,则薄膜的热应力很小,这就是所谓的冷镀方案。选择合适的镀膜温度可以调节热应力的大小。但是温度对内应力也有直接的影响,因为内应力主要取决于薄膜的微观结构缺陷等因素。而温度对薄膜的微观结构有直接的影响。不过现在有比较明确的观点是:对HfO2这样的介质膜,内应力随温度的升高而降低。从温度这一个参量的影响来看,薄膜的总应力的计算就非常复杂。
(3)镀膜材料的蒸发速率一般影响薄膜的内应力,现在的理论认为,薄膜中的再结晶及薄膜相变等薄膜的微观缺陷的改变都与蒸发速率有关。但是薄膜的内应力的大小与蒸发速率的关系现在从公开发表的数据来看也没有规律,可能和具体的介质膜的材料有关[7]。
(4)镀SiO2时增加充氧量被认为可以降低SiO2的内应力,一般认为SiO2的内应力表现为压应力[8]。
(5)膜层的厚度也直接影响薄膜的内应力,因为膜层的厚度与薄膜的再结晶的情况有密切的关系,而这种密切的关系和具体的介质膜的材料等因素有关,并不是简单的膜层的厚度越厚,薄膜的内应力越大。
(6)镀膜前的基本真空度也对薄膜的内应力有影响,因为真空中残余的进入薄膜,薄膜的晶体结构偏离了其块状材料。更为严重的是,镀膜前的基本真空度不同可能使薄膜的内应力由张应力变为压应力。
(7)镀膜后的退火处理很明显可以改变薄膜的微观缺陷,所以和薄膜的内应力有很大的关系,但是改变薄膜的微观缺陷不一定就是减小薄膜的内应力,也有可能增加薄膜的内应力。
除了这些因素外,双面补偿镀膜以及离子辅助等技术手段都可能对薄膜的应力产生影响[9]。
2HfO2/SiO2高反射薄膜的应力控制设计思想
一般来讲,薄膜的应力和很多因素有关,但是对HfO2/SiO2高反膜来讲,由于要达到很高的反射率,所以薄膜的层数不能少,对一种特定波长特定角度入射的薄膜,作者固定了膜系,也就是说固定了每一层薄膜的光学厚度,这样减少了实验的变量[10];对HfO2/SiO2高反射薄膜来说,不能用很低的温度来降低热应力,因为HfO2/SiO2高反射薄膜经常是用在高功率的激光系统中的,太低的温度使HfO2在缺氧的情况下吸收增加,使HfO2/SiO2高反射薄膜的阈值很低,而且膜层的牢固度也很不好,所以固定了镀膜时的温度250℃;镀膜前的基本真空度越高,对HfO2/SiO2高阈值膜的阈值越有利[11],固定了镀膜前的基本真空度比较高,即9×10-4Pa;镀膜后的退火处理也有比较大的技术风险,有时甚至发生再结晶而使薄膜直接“起皮”,作者没有用这个技术方案来实现薄膜的应力控制。
多层膜和单层膜在实现薄膜的应力控制方面有非常大的区别,单层膜在实现薄膜的应力控制方面要做的工作是尽量减少应力,而认为多层膜在实现薄膜的应力控制方面是实现两种镀膜材料的应力平衡,在HfO2/SiO2高反膜中,希望改变HfO2和SiO2的蒸发速率和镀膜时的充氧量来实现如下目标:SiO2的单层膜体现出压应力,HfO2的单层膜体现出张应力,而在膜系中张应力和压应力的大小基本一样。
3HfO2/SiO2反射薄膜的应力控制实验
作者所使用的镀膜设备是国产ZZS1100型镀膜机,该设备配备了双路双显的质量流量计,可以比较准确地控制镀膜时的充氧量。在蒸发HfO2的时候,为了比较准确地控制蒸发HfO2的速率,没有使用电子束扫描的功能,即在一层的镀制过程中,电子束打到镀膜材料上的位置不移动,依靠控制HfO2和SiO2的电子束的束流来实现对HfO2和SiO2的蒸发速率的控制。
基片尺寸大小是20mm×20mm×3mm,镀膜前后的通光口径为18mm×20mm,基底材料是石英玻璃,对于1053nm 45°高反膜,使用的膜系是G(HL)17H2LA,使用的工艺条件如下:充氧量是8×10-3Pa,蒸发HfO2的电子束的束流是200mA,蒸发SiO2的电子束的束流是55mA。实验结果如图1所示。图中wv代表以λ=632.8nm为基准的反射波前波长值,编号为1的石英玻璃镀膜前的反射波前峰谷值为0.054λ,镀膜后的反射波前峰谷值为0.409λ。
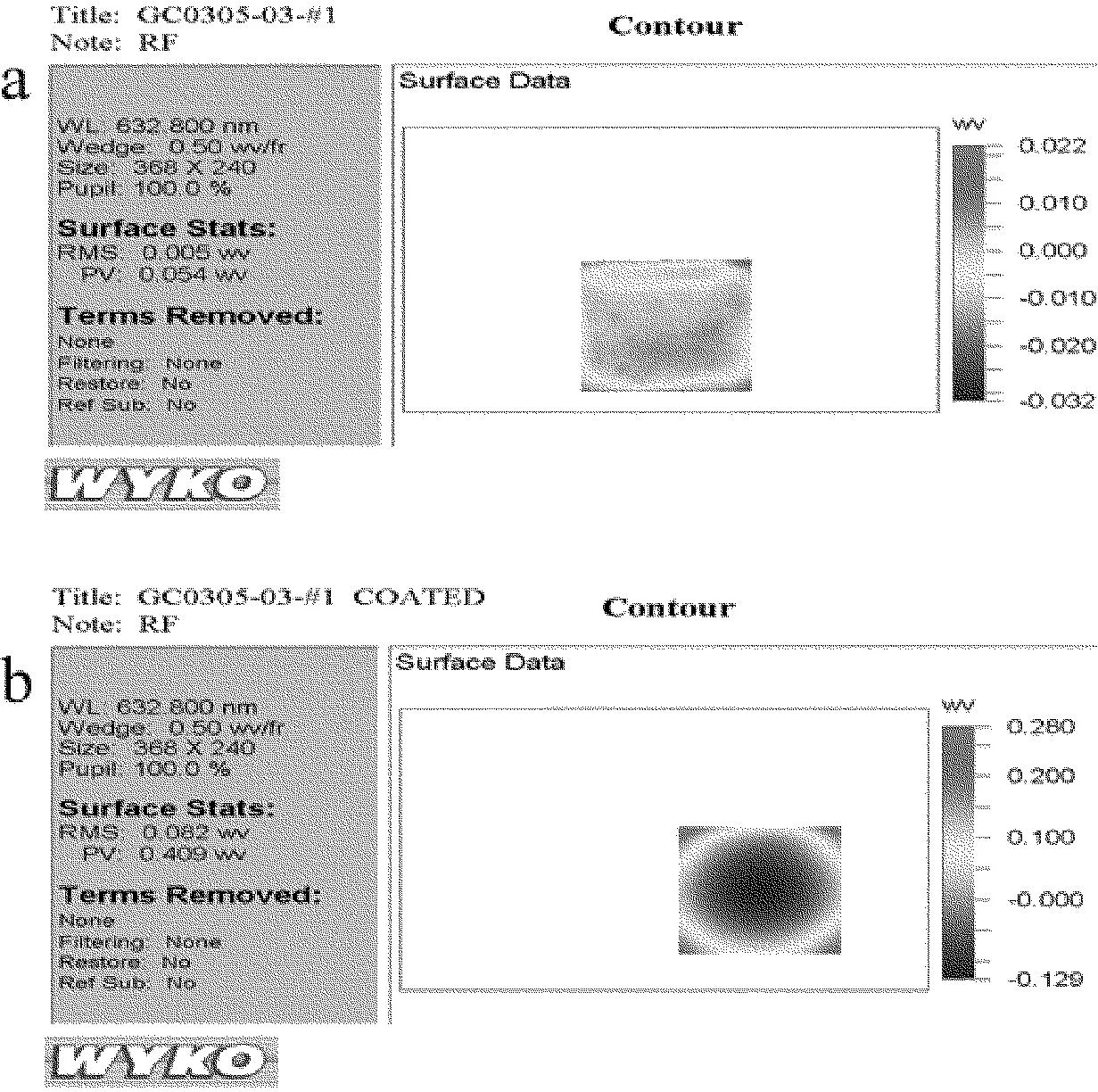
Fig.1 Reflective wavefront of fused glass(number 1)
使用的干涉仪的空腔精度好于0.1λ,图1的结果表明薄膜内的应力不平衡,具体体现在镀膜后膜层出现了明显的张应力。为了平衡总的膜层的应力,采取的办法是明显降低蒸发HfO2的电子束的束流和适当降低SiO2的蒸发速率,一般来说,对于真空蒸镀薄膜,由于蒸发源的热辐射等原因,往往使基片有高的温升,因而作动态应力测量时,热应力对总应力有比较大的贡献,因为蒸发速率降低,沉积粒子的能流密度减小,使得基板实际温度降低(尽管没有降低镀膜机的设定温度),这样薄膜与基片间的热膨胀系数不同而产生的热应力可以显著降低。另外明显降低蒸发HfO2的电子束束流有利于减少节瘤缺陷[12],节瘤缺陷被认为是纳秒级近红外薄膜损伤的诱因。HfO2/SiO2高反射薄膜的总应力还和充氧量密切相关,因为至少SiO2的应力和充氧量密切相关,而且和HfO2膜层的吸收也有直接的关系,也就是和整个膜系的阈值有直接关系。经过反复的实验,既要保持总应力平衡又要有一定的损伤阈值就是实验的目标。
重新实验时选定了下面的工艺条件作样品5:充氧量是1.2×10-2Pa,蒸发HfO2的电子束的束流是120mA,蒸发SiO2的电子束的束流是50mA。5号样品的损伤阈值超过18J/cm2(3ns,R-on-1方式,即激光能量按梯度增加打到样品测试点的测试方法)。
图2是5号样品石英玻璃镀膜前后的反射波前。表1中的数据表明,改变HfO2和SiO2的蒸发速率和镀膜时的充氧量可以实现镀膜后的高反膜的反射波前与镀膜前的基片的反射波前没有明显的变化。
高功率近红外应力平衡的高反膜的需求量很大,一套镀膜工艺必须有比较好的重复性,因为冷加工将基片加工到很高的反射波前和很低的粗糙度需要很高的成本和很长的工期,用这套工艺做了如下的重复性验证,表1是3块20mm×20mm×3mm的石英玻璃镀膜前后反射波前的重复性实验数据,表2是这3个样品的阈值数据。

Fig.2 Reflective wavefront of fused glass(number 5)

No.reflectivewavefrontbeforecoatingreflectivewavefrontaftercoating20.2720.23030.1410.14740.3060.314

Table 2 Damage threshold of three coated fused glasses
4结论
实验中主要对20mm×20mm×3mm的石英玻璃进行了1053nm,45°高反膜的薄膜应力实验,在固定其它实验条件的情况下,通过改变HfO2和SiO2的蒸发速率和镀膜时的充氧量来实现了镀膜后的反射波前与镀膜前的基片的反射波没有明显变化的目标,而且损伤阈值超过了14J/cm2(3ns,R-on-1方式),实验有比较好的重复性。需要指出的是,实现这种目标的工艺参量的选择应该有多种组合[13],作者所给出的工艺参量的选择也不一定是最优的。
20mm×20mm×3mm的石英玻璃的最大口径与厚度之比是9.42,作者还没有涉及最大口径与厚度之比,比如说是12∶1的问题。当这样的问题出来时,可能双面镀膜等补偿技术就要很好地研究[14]。
薄膜应力影响反射膜的反射波前是一个直接影响光学元件成品率的重要问题,由于薄膜应力的影响因素很多,不同的镀膜机,不同的夹具系统都会对控制薄膜应力的工艺带来影响,所以作者认为,建立每一台镀膜机的工艺数据库非常重要。
对高面型精度的大口径元件,除薄膜应力影响反射膜的反射波前外,均匀性也会对反射波前带来影响,而且小口径的工艺路线能否直接移值过去,需要大量的实验数据来证明。另外,激光阈处理技术经常用于提高大口径光学元件的阈值[15],对这种技术和膜层应力之间的关系所要做的工作还有很多。
本工作得到马平研究员和鄢定尧高级工程师的热情指导,在此特表感谢!
参考文献
[1]THORNTON J A,HOFFMAN D W.Stress-related effects in thin films.Thin Solid Films,1989,171(1):5-31.
[2]REICHER D W, McCORMACK S A.Production of thin film optical coatings with predetermined stress levels.Proceedings of the SPIE,2000,4091:104-110.
[3]GHANG Y H, JIN Ch Sh, LI Ch,etal. ArF excimer laser induced damage on high reflective fluoride film. Laser Technology,2014, 38(3):302-306 (in Chinese).
[4]FAN W X, WANG P Q, HAN J H,etal. Accumulation effect of film damage under repetitive laser pulses. Laser Technology,2014, 38(2):210-213 (in Chinese).
[5]D’HEURLE F M, HARPER J M E.Note on the origin of intrinsic stress in films deposited via evaporation and sputtering.Thin Solid Films,1989,171(1):81-92.
[6]POND B J, de BAR J I, CARNIGLIA C K,etal. Stress reduction in ion beam sputtered mixed oxide films. Applied Optics,1989,28(14):2800-2805.
[7]WINDISCHMANN H.Intrinsic stress in sputtered thin films.Journal of Vacuum Science,1991,A9(4):2431-2436.
[8]SHAO Sh Y.Study of the origin mechanism and controlling method of stress in thin films.Shanghai: Shanghai Institute of Optics and Fine Mechanics,2002:18-20 (in Chinese).
[9]MARTIN P J,NETTERFILED R P,SAINTY W G.Modification of the optical and structural properties of dielectric ZrO2films by ion-assisted deposition.Journal of Applied Physics,1984,55(1):235-241.
[10]QIN Y W. Film thickness measurement based on optical coherence tomography. Laser Technology, 2012, 36(5): 662-664(in Chinese).
[11]TOKAS R B, SAHOO N K, THAKUR S,etal. A comparative morphological study of electron beam co-deposited binary optical thin films of HfO2∶SiO2and ZrO2∶SiO2. Current Applied Physics,2007,8(5):589-602.
[12]REN H, ZENG Q, PANG Zh H,etal. Characteristics of Nd∶Y3Al5O12thin film prepared by electron beam evaporation deposition.Laser Technology,2012, 36(4): 450-452(in Chinese).
[13]SCHELL-SOROKIN A J, TROMP R M. Mechanical stresses in (sub) monolayer epitaxial films.Physical Review Letters,1990,64(9):1039-1042.
[14]WOLTERSDORF J,PIPPEL E.Substrate deformation and thin film growth.Thin Solid Films,1984,116(1/3):77-94.
[15]YU L F, YE Y T, WU J P. Defect detection and control of a laser conditioning system for large diameter optical film. Laser Technology,2012,36(2):188-190 (in Chinese).
Study on stress controlling technology of HfO2/SiO2high-refractive coating
QIUFumin,WANGGang,DAIHongling,PUYunti
(Chengdu Fine Optical Engineering Research Center, Chengdu 610041, China)
Abstract:Thin film deposited by physical vapor deposition usually has stress. In order to prevent high-refractive (HR) coating stress from destroying the surface of the substrate, the stress of the film prepared by electron beam evaporation was measured with a digital wavefront interferometer. The affecting factors of stress of optical dielectric coating were discussed. HfO2and SiO2were alternatively deposited on the substrate surface. As high refractive material, HfO2layers were in tensile stress. As lower refractive material, SiO2layers were in compressed stress. The results show that the stress is balanced by adjusting the oxygen pressure and the evaporation rate of coating material under stable experimental conditions. HfO2/SiO2HR coatings have high damage thresholds.
Key words:thin films; stress; partial pressure of oxygen; evaporation rate
收稿日期:2014-09-01;收到修改稿日期:2014-12-10
作者简介:邱服民(1970-),男,高级工程师,现主要从事高阈值薄膜的研究。
中图分类号:O484.2
文献标志码:A
doi:10.7510/jgjs.issn.1001-3806.2015.06.011
文章编号:1001-3806(2015)06-0785-04

