碳化硅粒径分布对单晶硅线切割的影响
杨春明
(中国电子科技集团公司第四十六研究所天津300220)
碳化硅粒径分布对单晶硅线切割的影响
杨春明
(中国电子科技集团公司第四十六研究所天津300220)
利用激光粒度仪和扫描电镜对切割前后碳化硅粒径的变化及切割后硅片的形貌进行表征,研究不同粒度分布的碳化硅磨料对线切割硅片表面损伤的影响。实验结果指出粒度分布不均引起的局部切割堵塞而导致的垂直于切割方向的左右侧滑振动,是导致表面损伤的主要原因,并且当碳化硅的粒度分布窄时,线切割硅片表面损伤层浅、表面粗糙度小。
磨料;碳化硅;粒径分布;线切割
随着光伏行业的发展,硅片的需求量越来越大,同时对硅片的直径、厚度和表面质量等有了更高的要求,而硅片多线切割在整个加工过程中起着至关重要的作用。多线切割机用来切割晶体、陶瓷等硬脆性材料是硅片的主要切割设备。当前,多线切割中广泛使用的线锯,仍然以游离磨料线锯为主。碳化硅微粉由于化学性质稳定、硬度高、耐磨性能好等优点,作为一种游离磨料广泛应用于多种硬脆材料的切片加工过程[1]。以碳化硅微粉作为主要切削介质的游离磨料线切割技术在太阳能级硅片的加工领域应用日益完善[2]。为了进一步提高硅片的成品率,碳化硅粒径分布对单晶硅线切割的影响研究逐步引起了人们的重视。
多线切割中使用的是切割液和碳化硅混合成游离态稳定悬浮剂——砂浆,其在切割过程中起主要作用。砂浆是被切割线的往复运动带到切割区域,碳化硅颗粒在切割线高速运动下,通过滚压、镶嵌、刮擦过程完成切割。对于硅片表面的损伤机理研究,中外学者侧重于切割线的振动、线的张力、液膜的厚度等方面,而没有涉及到磨粒的粒径分布影响。本文着重研究磨粒切割前后的粒径分布变化,结合不同粒径碳化硅切割实验硅片的表面损伤结果,提出单晶硅片切割对碳化硅磨粒的具体要求。

图1 线切割工艺过程及切割线够造示意图
1 多线切割工艺过程及切割原理
多线切割机的整个系统由供线轮、收线轮、供给张力滑轮、回收张力滑轮、供给载荷传感器滑轮、线速传感器滑轮、转向轮和工作导轮组成,切割过程在工作导轮上完成。切割线在工作导轮上缠绕相互平行的线网,切割线以一定的速度往复运动,游离态砂浆在硅棒的两侧均匀供给到线网上,并在线网上形成一层液膜。液膜的表面张力使砂浆裹覆在线网上,在线网的高速往复运动下,砂浆被带到切割区域,研磨颗粒碳化硅与硅棒表面高速磨削。碳化硅的硬度远大于硅棒,所以硅棒与线锯接触区被逐渐磨削掉,磨掉的硅屑和产生的热量被砂浆带走,保持切割的持续进行和工作区的稳定[3]。
2 实验部分
2.1实验设备及材料
实验主要设备为NTC多线切割机、LS-pop(8A)型激光粒度仪和CF一35扫描电镜(SEM)。实验材料为水溶性聚乙二醇(PEG)切削液和1 500#绿色碳化硅。为了考察碳化硅粒径分布对硅片切割质量的影响。选取如表1中所示的两种粒径分布不同的碳化硅磨料做切割实验。实验的切割参数为:切割线径为0.12 mm,单晶直径为76 mm,送线速度为11 m/s,切割速度为0.32 mm/min,切割线张力为25 N,砂浆配比为1∶1.19。
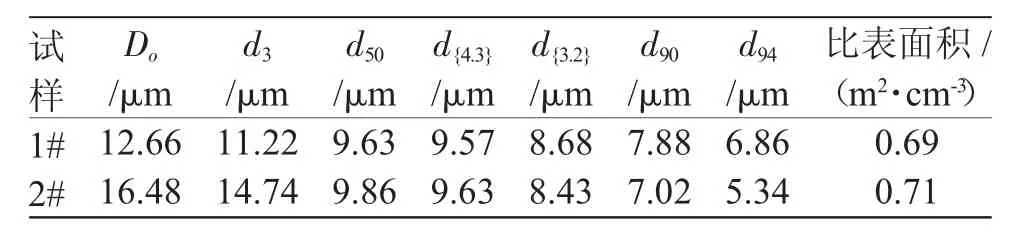
表1 碳化硅粒径分布表
2.2切割实验步骤
(1)分别采用1#、2#砂,按照表中砂浆配比配成切割液,在砂浆罐中搅拌12 h,使砂浆分布均匀;
(2)砂浆送至NTC多线切割机台切割硅棒,切割工艺参数按表2中设定,各切割5根硅棒;
(3)切割完毕,洗涤、检测硅片几何参数硅片厚度误差δ、弯曲度ε、翘曲度σ,并统计成品率。
(4)使用激光粒度仪分别检测切割前后两种粒度分布不同碳化硅磨料的粒度分布及累积分布。
(5)对比1#、2#砂切割出的不合格硅片,进行扫描电镜(SEM)观察。
3 结果分析
图2为切割前、后碳化硅砂浆的粒径分布。可以看出:1#碳化硅粒径分布较为集中,d50μm±2 μm区域累积了体积分数为91%的碳化硅颗粒,d0及d94和d50都较接近,整体砂浆中碳化硅颗粒大小比较均匀。2#碳化硅砂浆粒径分布较为分散,大颗粒和小颗粒所占体积分数达30%左右,粒径不均匀。从切割完毕检测的碳化硅粒径分布看:5~20 m区间为碳化硅颗粒粒径分布,0.2~2.5 m区间为断裂的碳化硅和切割过程中产生的硅粉颗粒的粒径分布,2#碳化硅颗粒中大于12 m区域的颗粒累积分数明显减小,0.2~1.5 m区域的颗粒累积体积分数高于1#碳化硅。1#、2#碳化硅切割后呈现非常相似的粒径分布状态,切割过程中2#碳化硅粒径变化较大。结合以上数据分析推测,2#碳化硅中大颗粒在切割过程中发生破碎,使其颗粒粒径分布在切割后变窄。
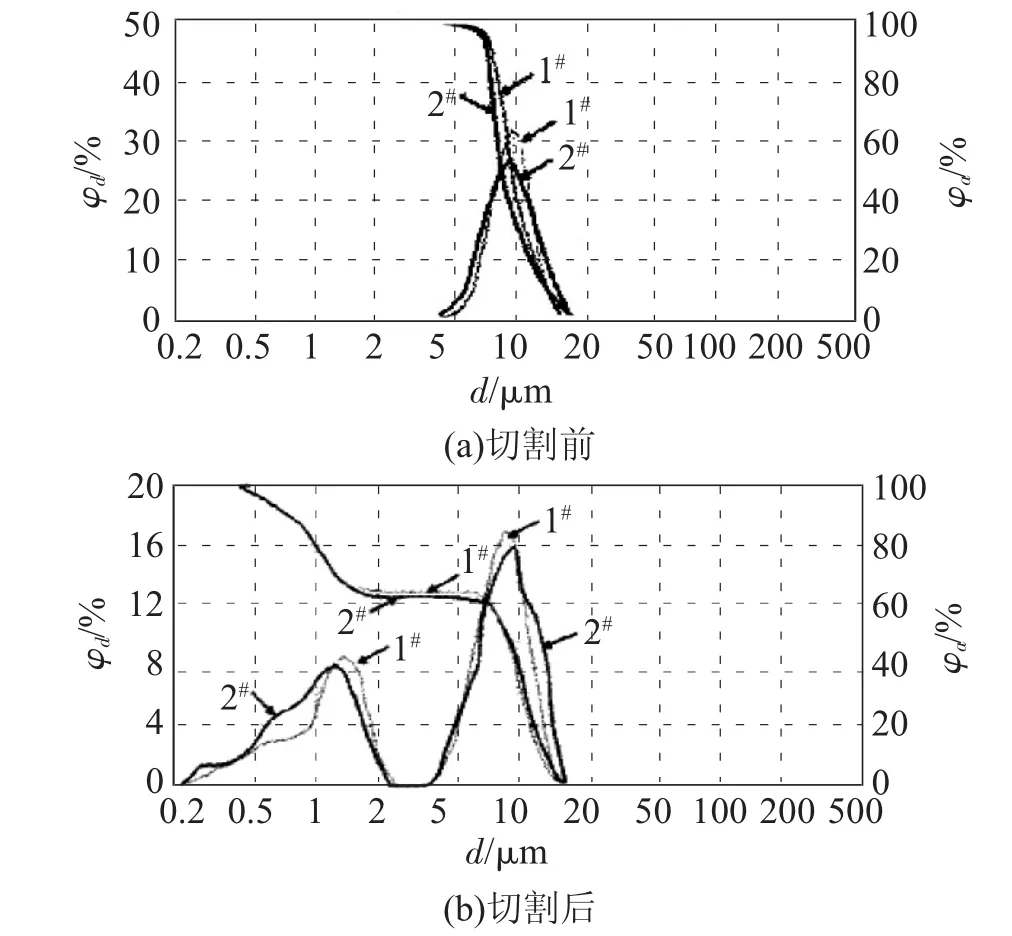
图2 切割前、后碳化硅的粒径分布
表2为l#、2#砂浆切割晶片的几何参数及成品率统计数据。可以看出:在其它切割参数相同,只改变砂浆粒径分布的条件下,晶片的几何参数和成品率都会发生变化,也就是说,在同等条件下,砂浆粒径分布越集中,颗粒大小越均匀,切割出晶片的几何参数越好,成品率越高。
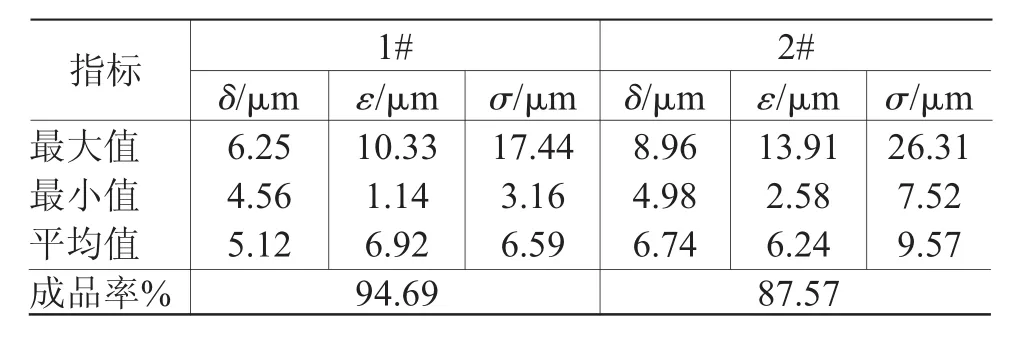
表2 切割硅片的几何参数及成品率
2#碳化硅磨料产生的次品硅片对比1#磨料主要现象是有大量重线痕和大的凹陷坑,由图3硅片表面SEM图像可看出。图4是硅片局部放大的SEM图像,可以看到大颗粒碳化硅在切割过程中发生断裂,碎屑残留镶嵌在硅片上.这在图4的重线痕处表现尤为突出。

图3 碳化硅磨料切割硅片表面损伤SEM图像

图4 SiC断裂嵌入硅片SEM图像
4 结论
通过切割实验前、后碳化硅粒径的变化及切割后硅片的形貌表征分析研究,得出如下结论:
(1)碳化硅粒径分布对单晶硅片线切割有较为重要的影响,粒径分布过宽,在切割过程中就会造成局部切割堵塞现象,硅片表面出现较重线痕。因此宜选择粒径分布集中的碳化硅颗粒来配制切割砂浆,完成切割过程。
(2)单晶硅片的切割过程中垂直于切割方向的左右侧滑振动是造成硅片表面损伤的另一个重要原因。减少切割线切割过程的振动,可有效降低碳化硅颗粒及切割线对硅材料造成的局部硬损伤,提高硅片的成品率。
[1]SCOTT J F.Multiferroic memories[J].Nat Mater,2007,(6):256.
[2]夏海良.半导体器件制造工艺[M].北京:电子T业出版社,1985.
[3]ZHENG H,WANG J,LOFLAND S E,et a1.Multiferroic BaTiO3-CoFe204 Nanostm~ures[J].Science,2004,303:661.
[4]孙守振,王林勇,奚西峰.碳化硅粒径分布对单晶硅线切割的影响[J].中国粉体技术,2011,17(1):52~54.
The Influence of SiC Particle Size Distribution on Monocrystalline Silicon Multi-wire Saw
YANG Chunming
(The 46thResearch Institute of CETC,Tianjin 300220,China)
This paper mainly uses laser particle analyzer and SEM to characterize the SiC size changes and wafer surface topography,which could research the effect of SiC size distribution on the wafer surface damage.The results show that the main reason of surface damage is inhomogeneity of size distribution,which leads to wire shake in the vertical direction.The surface damage and roughness would be small when the SiC size distribution is narrow.
Abrasive;SiC;Size distribution;Multi-wire saw.
TN305.1
A
1004-4507(2016)01-0024-03
2015-10-18

