高效在线测量加速实验中双极晶体管结温方法的研究∗
郭春生 丁嫣 姜舶洋 廖之恒 苏雅 冯士维
(北京工业大学信息学部电子科学与技术学院,北京 100124)
高效在线测量加速实验中双极晶体管结温方法的研究∗
郭春生†丁嫣 姜舶洋 廖之恒 苏雅 冯士维
(北京工业大学信息学部电子科学与技术学院,北京 100124)
(2017年2月23日收到;2017年8月20日收到修改稿)
针对晶体管在加速寿命实验和老炼实验等实际工程中结温的在线测控问题,本文基于大电流电学测温方法研究了型号为2N3055的双极大功率晶体管在恒定的集电极电压Vce和集电极电流Ice条件下发射结电压Vbe随着温度T变化的对应关系.研究结果表明,温度在40—140◦C范围内时,在集电极加载大功率电流电压的条件下,发射结电压随温度上升而线性减小,基极电流随温度变化不超过4%.通过理论推导恒定功率下发射结电压与温度的数学模型,证明了当基极电流数值随温度变化不超过4%时,Vbe-T关系曲线呈线性且理论上引起的温度误差不超过0.5◦C,以此为基础推导出一种新的在线测量加速实验中结温测试公式.最后利用Phase11进行对比验证实验,证明了该方法的正确性.
功率器件,结温,电学法,在线监控
1 引 言
随着半导体器件在军事、航天、工业等方面的广泛应用,对半导体器件的可靠性要求越来越高.在实际应用中,加速寿命实验和老炼实验是常用的预测器件寿命和检测器件优劣的实验方法,在国内外具有广泛的应用[1−3].现行实验过程中,结温通常利用线下测温法获得,即通过测量的恒定热阻计算得到加速实验中的结温.然而,该线下法测量结温会引入较大误差:1)热阻是温度的函数,材料热导率变化100◦C时引入的热阻变化达到20%[4];2)线下测温方法中器件与散热器之间的接触热阻并未考虑,而接触热阻通常是不可忽略的[5].并且,李霁红等[6]提出,由于器件生产工艺等因素的限制,实验过程中结温往往并不恒定.根据阿伦尼斯模型推断,温度每上升10◦C,器件寿命就下降约一半,所以结温的准确与否直接关乎预测结果的准确度.
为解决线下测温的问题,通常利用在线测温法.现行的在线测温法通常利用温度敏感参数与结温的对应关系[7],通过测量校温曲线的方式构建校温曲线库,从而做到对结温的在线测量[8−12].Baker等[13]对绝缘栅双极型晶体管器件利用峰值栅电流和温度的对应关系构建校温曲线,从而达到测量结温的目的.Munk-Nielsen等对金属氧化物半导体器件的峰值电流和温度的对应关系进行了研究,做出了相应的校温曲线以完成对结温的测量[14].国内有朱阳军等[15]利用校温曲线对双极晶体管的结温进行了在线测量的研究.
以上研究均对结温的在线测温问题做出了有益的探索,但是现有方法中均需要先测量得到校温曲线库,校温曲线库通常包括十几条校温曲线,一条校温曲线往往需要测量数个甚至十数个参考点才可以得到,并且需要利用软件进行拟合绘制,校温曲线的测量需要专门的设备,成本高且严重影响效率,不利于工程上的实际应用.针对加速实验和老炼实验等工程上的实际应用,为简化校温曲线的测量过程,避免复杂的数据处理及拟合绘制过程,本文以双极型晶体管为例,在电压Vce和电流Ice恒定的条件下对结电压Vbe随着温度T的变化关系进行了研究;分析发现以室温下Ibe的数值为参考点,当Ibe的数值随温度变化不超过4%时,理论上引起的温度误差不超过0.5◦C.在此理论基础上推导得到的Vbe-T的数学模型,证明Vbe-T曲线存在线性关系,并通过校温实验证明了线性关系的准确性.
由Vbe-T的数学模型提出了一个新的测试公式:在电压Vce和电流Ice恒定的条件下测量得到一个参考点的基础上,只需在线测量出结电压Vbe,代入公式即可快速计算出结温.该方法简化了复杂的数据处理过程和绘图制表步骤,一条校温曲线只需测量任意一参考点即可得到,提高了工程应用的效率,实现了对结温在线监控的目的.
2 实验及校温曲线
2.1 实验及所得数据图像
为了方便利于加速寿命实验和老炼实验等某些实际工程上的应用,本文基于电学测温方法测量并给出了集电极电压Vce和集电极电流Ice恒定时发射结电压Vbe和温度T的关系曲线.
将型号为2N3055的双极大功率晶体管放在温箱里,引脚外接半导体精密测试仪AgilentB 1500 A,分别设定温度为40,60,80,100,120,140◦C,待温度稳定后,可认为此时结温即为温箱设定温度.实验中晶体管采用共射极接法:集电极加20 V电压,发射极接地,基极分别加脉冲电流50µA— 13.15 mA,电流步长50µA,脉宽500µs,周期1 ms,以避免自升温对实验的影响.测量相同电流Ice条件下基极电流Ibe结果如表1所列,发射结电压Vbe如图1所示.
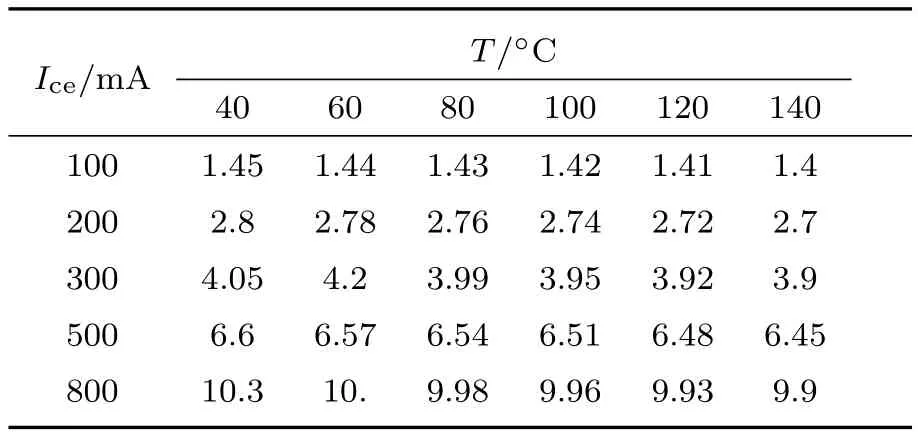
表1 基极电流Ibe数值与温度对应关系Table 1.Base current Ibevalue and temperature correspondence.

图1 (网刊彩色)Vce=20 V时拟合的校温曲线Fig.1.(color online)Vce=20 V,the fitting calibration curve.
从测量得到的实验数据可以发现:在晶体管的实际工作中,当电压Vce和电流Ice恒定时,基极电流Ibe会随着温度的变化而改变.
2.2 校温曲线的拟合曲线
对实验测量得到的数据进行线性拟合,得到Vce=20 V时不同电流Ice条件下对应的拟合校温曲线,见图1.拟合公式为Vbe=a+bT.
从图1中可以看出拟合曲线和试验点基本重叠,符合较好.以Ice=50 mA为例,拟合公式中的常数为:a=0.72861,b=−0.00204,不同的Ice对应的拟合公式中的常数见表2.

表2 不同的Ice对应的拟合常数Table 2.Di ff erent Icecorresponding fitting constants.
由拟合校温曲线和拟合公式可以得知:在电压Vce和电流Ice恒定条件下发射结电压Vbe和温度T呈良好的线性关系.
3 理论推导
由半导体器件物理[16]可知,以npn为例,集电极电压Vce会抽取(BE)结的电子扩散电流,而对BE结的空穴扩散电流没有影响.因此,Vce对输入特性曲线的影响在Vce>1 V后,基本不变,表现为当Vce>1 V时,输入特性曲线不变.即BE结仍可用PN结电流电压关系.由半导体物理中的PN知识可知[17]:由理想PN结(,其正)向电流IF和压降VF存在关系可推知,发射结压降Vbe和电流Ibe的关系

q为电子电荷,k为玻尔兹曼常数,T为绝对温度,IS为反向饱和电流中空穴电流,

C是与结面积和掺杂浓度有关的常数,r也为常数(r的数值取决于少数载流子迁移率对温度的关系).将(2)式代入(1)式两边取对数得,的影响.令Ibe为常数,当温度从T1变为T,发射结压降Vbe1变为Vbe时,

下面讨论非线性项

(3)式和(4)式联立得

理想线性温度相应Vbe应取如下形式:

将(7)式代入(6)式得


理想线性响应和实际响应相比较,理论偏差为

取r=3.4[18],T1=300 K,T=310 K,代入(9)式得∆=0.048 mV,相应Vbe的改变量约为20 mV,相比之下误差为0.2%.所以可以忽略非线性项的影响,(3)式可写为

将温度T1、电压Vbe1、电流Ibe1代入(10)式得出,将lnC代入(10)式得

即晶体管从温度T1对应的发射结电压Vbe1和基极电流Ibe1变化到温度为T对应的发射结电压Vbe和基极电流Ibe的关系表达式.(11)式存在一个非线性项根据文献中所述:结温每上升1◦C结电压Vbe就会下降2 mV,即结电压Vbe的偏差在毫伏量级以下时对结温预测的影响小于0.5◦C,可以忽略.所以,当此非线性项的数值大小在10−3数量级以下时,基本可以认为该项对结电压的数值影响不足以对结温的预测造成影响.即当时,该项可以忽略.以室温为参考点,取T=300 K,Ibe1为室温下基极电流大小,则当即以室温下基极电流数值为参考点,基极电流数值Ibe随温度变化不超过4%时,基极电流的变化的影响可以忽略不计.
从表1中可以看出:晶体管正常工作条件下基极电流Ibe随温度的变化在3%—4%;根据表1中基极电流的数据计算非线性项T大概在10−3—10−4数量级,相比结电压Vbe几百毫伏的数量级可以忽略不计,且不对校温曲线的精度造成影响.表3中列出了40◦C条件下和140◦C条件下该非线性项的大小,表4则列出了40◦C条件下和60◦C条件下该非线性项的大小.的数值都在10−3—10−4左右,可以忽略;即在晶体管的正常工作条件下,基极电流Ibe随温度的变化在4%以内,对电流Ice恒定条件下Vbe-T的线性关系没有影响.
由表3和表4的数值可以看出非线性项

表3 40◦C条件下和140◦C条件下非线性项的大小Table 3.The size of the nonlinear term at 40◦C and 140◦C.

表4 40◦C条件下和60◦C条件下非线性项的大小Table 4.The size of the nonlinear term at 40◦C and 60◦C.

4 结温在线测量的方法的提出及验证
对实验测量得到的校温曲线进行拟合,证明了线性关系的真实存在,通过理论推导得到了(12)式,并与实验数据对比证明了公式的准确性.该公式的提出简化了传统电学测温方法中复杂的测量工作和数据处理校准工作,极大地提高了工程效率.在实际应用过程中,只需要确定参考点,即给定已知参数Vbe1和T1,无需关注电流Ibe的情况而在线测量出结电压值Vbe即可迅速计算出该时刻的结温.与传统电学法测量结温时需测量校温曲线相比,该方法极大地减小了测量过程和测量时间,并避免了校温曲线的绘制和拟合过程.在加速寿命实验和老炼实验等实际工程中可以利用此方法对结温进行在线监控,确保结论的准确性,在半导体可靠性领域有广泛的应用.
用美国Phase11分别测量双极晶体管型号为2N3055的上表壳热阻对应的结温和2SD1047的下表壳热阻对应的结温,与用测试公式计算的结温进行了对比.型号2SD1047晶体管的校温曲线见图2,对比结果见表5和表6.

图2 (网刊彩色)型号2SD1047晶体管的校温曲线Fig.2.(color online)Model 2SD1047 transistor temperature calibration curve.

表5 晶体管型号2N3055的对比实验结果Table 5.Comparison of the transistor model 2N3055 experimental results.
从表中的数据可以清晰地看到:利用本方法所得到的结温值略大于Phase11的测量值,误差在0.7%以内,与真实情况相符.所以,通过对比实验可以证明本文提出的新方法可以准确快速地对晶体管的结温进行在线监控测量.

表6 晶体管型号2SD1047的实验结果对比Table 6.Comparison of the transistor model 2SD1047 experimental results.
5 结 论
在电压Vce恒定的条件下,通过对不同电流Ice条件下的校温曲线的研究发现:以室温下基极电流数值为参考点,当基极电流数值随温度变化不超过4%时,Vbe-T关系曲线具有良好线性关系,且理论上引起的温度误差在0.5◦C以内.对校温曲线进行线性拟合,发现实验数据和拟合曲线基本重叠,证实了线性关系的真实存在.基于理论公式推导,提出了(12)式:在电压Vce和电流Ice恒定的条件下,测量得到参考点的Vbe1和T1,实时测出Vbe,代入公式中就可实时计算出结温.通过对比实验证明了该方法的准确性和运用此方法计算结温的可行性.该方法的提出简化了传统电学测量方法中复杂的实验过程和制图步骤,极大地提高了效率,解决了在加速寿命实验和老炼实验等实际工程中对结温快速在线监控的问题,确保了实验数据的可靠度,在器件可靠性研究领域有广泛应用.
[1]Maset E,Sanchis Kilders E,Ejea J B,Ferreres A 2009IEEE Trans.Dev.Mater.Reliab.9 557
[2]Qi H C,Zhang X L,Xie X S 2013J.Semicond.34 064010
[3]Rong B H,Wang X Y,An Z F,Zhong L,Chen G Y,Zhang C S 2008Semicond.Technol.33 360(in Chinese)[荣宝辉,王晓燕,安振峰,仲琳,陈国鹰,张存善 2008半导体技术33 360]
[4]Guo C S,Li S W,Ren Y X,Gao L,Feng S W,Zhu H 2016Acta Phys.Sin.65 077201(in Chinese)[郭春生,李世伟,任云翔,高立,冯士维,朱慧 2016物理学报 65 077201]
[5]Li R,Guo C S,Feng S W,Shi L,Zhu H,Wang L 2015Chin.Phys.B24 076601
[6]Jia Y,Zeng C H,Liang W,Li D,Li J H 2016Semicond.Technol.31 35(in Chinese)[贾颖,曾晨晖,梁伟,李逗,李霁红2016半导体技术31 35]
[7]Avenas Y,Dupont L,Khatir Z 2012IEEE Trans.Power Electron.27 3081
[8]Yuan Y,Xiang D,Ning C 2016IEEE 8th International Power Electronics and Motion Control ConferenceHefei,China,May 22–25,2016 p3125
[9]Kuhn H,Mertens A 2009European Conference on Power Electronics and Applications IEEEBarcelona,September 8–10,2009 p1
[10]Wang L 2015M.S.Dissertation(Beijing:Beijing University of Technology)(in Chinese)[王琳 2015硕士学位论文(北京:北京工业大学)]
[11]Senturk O S,Munk-Nielsen S,Teodorescu R,Helle L,Rodriguez P 2011Energy Conversion Congress and Exposition IEEEPhoenix,Arizona,USA,September 17–22,2011 p568
[12]Xu Z,Wang F,Ning P 2012EnergyConversion Congress and Exposition.IEEERaleigh,North Carolina,USA,September 15–20,2012 p91
[13]Baker N,Munk-Nielsen S,Iannuzzo F,Liserre M 2015IEEE Trans.Power Electron.31 3784
[14]Baker N,Munk-Nielsen S,Iannuzzo F,Liserre M 2015Applied Power Electronics Conference and Exposition.IEEECharlotte,NC,USA,March 15–19,2015 p1270
[15]Zhu Y J,Miao Q H,Zhang X H,Yang L Y,Lu S J 2007J.Cemicond.28 980(in Chinese)[朱阳军,苗庆海,张兴华,Yang Lieyang,卢烁今2007半导体学报28 980]
[16]Sze S M,NG K K(translated by Geng L,Zhang R Z)2008Physics of Semiconductor Devices(Xi’an:Xi’an Jiaotong University Press)pp188–195(in Chinese)[施敏,伍国珏 著 (耿莉,张瑞智 译)2008半导体器件物理 (西安:西安交通大学出版社)第188—195页]
[17]Liu E K,Zhu B S,Luo J Set al.2010Semiconductor Physics(Beijing:National Defense Industry Press)p172(in Chinese)[刘恩科,朱秉生,罗晋生等2010半导体物理学(北京:国防工业出版社)第172页]
[18]Chen S Q 2000Phys.Exp.20 7(in Chinese)[陈水桥2000物理实验20 7]
PACS:47.80.Fg,85.30.Pq,85.30.–z,84.37.+qDOI:10.7498/aps.66.224703
*ProjectsupportedbytheBeijingMunicipalCommissionoftheEducationFoundationofChina(GrantNo.KM201510005008).
†Corresponding author.E-mail:guocs@bjut.edu.cn
High-efficiency on-line measurement of junction temperature based on bipolar transistors in accelerated experiment∗
Guo Chun-Sheng†Ding Yan Jiang Bo-Yang Liao Zhi-Heng Su Ya Feng Shi-Wei
(Deputy Dean,College of Electronic Science and Technology,Faculty of Information Technology,Beijing University of Technology,Beijing 100124,China)
23 February 2017;revised manuscript
20 August 2017)
Junction temperature is an important factor a ff ecting the reliabilities of semiconductor devices.Usually,the method of measuring the junction temperature is not tested on-line.However,due to the fact that neither contact thermal resistance nor thermal resistance varying with temperature is taken into account,there exists an error in the o ff-line measurement.A way to solve the problem of o ff-line measurement is to measure the junction temperature on-line.In this paper,we propose an electrical method of measuring the temperature rise of high-power bipolar transistor in the working condition.The measurement method is based on a good linear relationship between base-emitter voltage(Vbe)and temperature during the steady-state.Taking the model 2N3055 of bipolar high power transistor for example,in this paper we study the relationship between base-emitter voltage(Vbe)and temperature under the conditions of constant collector-emitter voltage(Vce)and collector-current(Ice).During the experiment,the device is placed in a thermostat.A voltage is applied to the device collector,a current is applied to the base,and the emitter is earthed.Before the device is measured,we set di ff erent temperatures and make sure that the equipment is in a steady state.In order to avoid the e ff ect of self-heating,the pulse current is used in the experiment.The pulse width and the period are 500µs and 1 ms,respectively.
The research result shows that the base-emitter voltage(Vbe)decreases linearly with temperature increasing and the base-emitter current is changed below 4%when the temperature is in a range of 40◦C–140◦C.In this paper we also deduce the mathematical expressions for base-emitter voltage(Vbe)and temperature under a steady state.It is proved that theVbe-temperatrue curve is linear and temperature error is less than 0.5◦C when the changes of base current value does not exceed 4%.Therefore,in this paper we deduce a new method of testing the junction temperature in the speeding up measurement experiment.By measuring any of the reference points on the calibration curve under certain experimental conditions,the junction temperature can be calculated quickly according to the proposed formula.
Finally,the phase 11 is used to verify the proposed method.We measure the thermal resistance upper the case for the junction of model 2N3055 and the thermal resistance under the case for the junction of model 2SD1047.The measurement results of phase11are compared with the junction temperature calculated using the test formula.The results show that the error of junction temperature between the two methods is less than 0.7%,which is corresponding with the needs of practical application.It proves the correctness and feasibility of the method.
power device,junction temperature,electrical method,on-line monitoring
10.7498/aps.66.224703
∗北京市教委基金(批准号:KM201510005008)资助的课题.
†通信作者.E-mail:guocs@bjut.edu.cn

