复合氮化铝压电薄膜研制及其应用
陈运祥,赵雪梅,郑泽渔,陶 毅,伍 平,田亚睿,张永川,许东辉
(中国电子科技集团公司第二十六研究所, 重庆 400060)
0 引言
复合氮化铝(AlN)压电薄膜不但具有AlN压电薄膜的特质,还具有较高声传播速率、较小声损耗、较大机电耦合系数及热膨胀系数与Si相近等特点。因此,其在声表面波(SAW)和声体波(BAW)器件制作和高频宽带通信等领域应用前景较广[1-5]。
由于复合AlN压电薄膜具有很高的BAW速度(11 300 m/s)和SAW速度(>7 500 m/s),因此,采用复合AlN压电薄膜制作高频BAW和SAW器件具有明显优势。
本文采用直流磁控溅射法制作了复合氮化铝压电薄膜,并描述了工艺参数及薄膜的结构参数测试结果。利用溅射制备的复合氮化铝压电薄膜制作了Ku及K波段声体波微波延迟线(BAWDL),以及AlN/Mo/AlN/纳米金刚石(NCD)/Si复合结构声表面滤波器(SAWF)样品,并给出了测试结果。
1 Si基AlN/Mo/AlN/纳米金刚石(NCD)
1.1 磁控溅射制备AlN压电膜及Mo膜
采用EndeavorAT型双S枪磁控溅射系统制作AlN压电薄膜。研制了NCD/Si基AlN(压电层)/Mo/AlN(种子层)结构的复合压电薄膜。其中,采用双S枪中频(40 kHz)磁控反应性溅射铝靶制作AlN薄膜;采用双S枪直流(DC)磁控溅射钼(Mo)靶制作出了Mo电极薄膜。各层薄膜生长条件如表1所示。

表1 薄膜生长条件
1.2 AlN及Mo薄膜择优取向
对制备的AlN(压电层)/Mo/AlN(种子层)/NCD/Si复合压电薄膜样品进行了X线衍射(XRD)分析,图1 为XRD衍射曲线。图2 为摇摆曲线。由图1可看出,AlN压电薄膜(002)面X线衍射峰峰值强度Imax=3 673 cps(每秒计数)(特征衍射角2θ=36.131 8°);其半峰宽FWHM=0.223 4°。Mo薄膜(110)面Imax=154 cps(2θ=40.726 1°);其FWHM=0.387 8°。由图2可看出, AlN压电薄膜(002)面摇摆曲线FWHM=2.7°;摇摆曲线Imax=3 727 cps(θ=17.679 7°);结果显示AlN薄膜 (002)面择优取向优良。
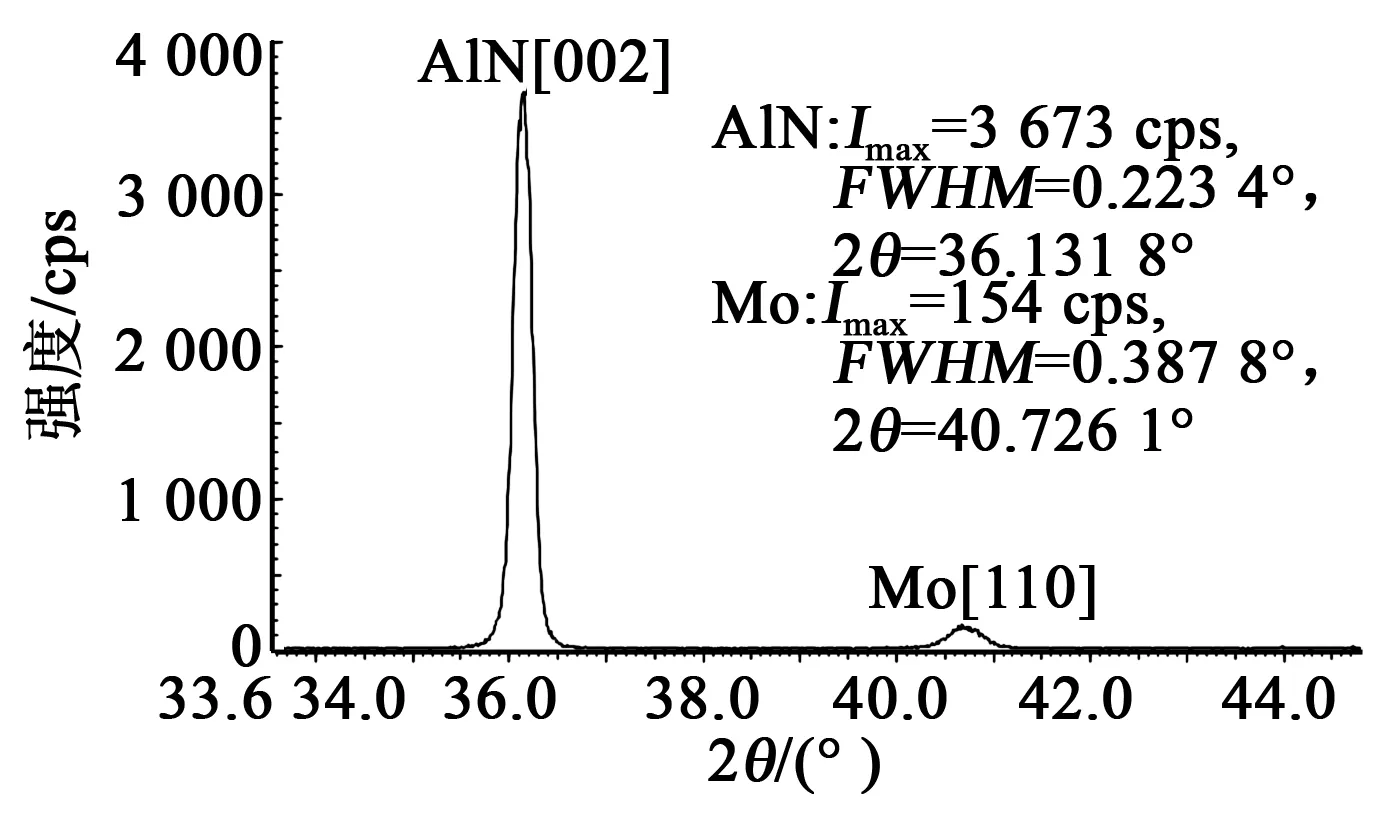
图1 AlN及Mo多晶薄膜XRD衍射曲线

图2 AlN薄膜XRD摇摆曲线
2 钇铝石榴石(YAG) 基Al/Cr/AlN/Au/Cr复合压电薄膜
2.1 Au/Cr及Al/Cr薄膜制作
采用脉冲直流磁控溅射Au、Cr、Al靶分别制作了Au/Cr底电极薄膜及Al/Cr顶电极薄膜。并采用XRD分析Au薄膜晶粒(111)面择优取向,结果为Imax=44 074 cps,2θ=38.956 0°,FWHM=0.351 1°。其摇摆曲线分析结果为Imax=2 172 cps;θ=19.439 5°,FWHM= 9.3°。
2.2 AlN压电薄膜制作
采用EndeavorAT型双S枪磁控溅射系统制作AlN压电薄膜。研制出了Au/Cr基AlN压电薄膜。用双S枪中频(40 kHz)磁控反应性溅射铝靶制作AlN薄膜,
AlN压电层薄膜生长方式为中频磁控反应性溅射,靶材采用铝靶(双S枪)(质量比99.999%),气体为氮气(N2)(质量比99.999%)、氩气(Ar)(质量比99.999 9%),溅射功率为5.7 kW,N2流量为21 cm3/min,Ar流量为7 cm3/min。
2.3 AlN压电薄膜晶粒择优取向
采用XRD对研制出的Au/Cr基AlN压电薄膜样品进行了XRD分析,获得了该样品XRD衍射曲线及其摇摆曲线如图3、4所示。由图3可知,AlN压电薄膜(002)面X线衍射峰Imax=736 cps(2θ=35.985 3°);其FWHM=0.260 8°。由图4可知,AlN压电薄膜(002)面摇摆曲线FWHM=3.6°;摇摆曲线Imax=741 cps(θ=18.345 2°)。这表明AlN薄膜(002)面择优取向优良。

图3 AlN薄膜XRD衍射曲线

图4 AlN薄膜XRD摇摆曲线
3 复合AlN压电薄膜的应用
3.1 AlN压电薄膜应用于NCD SAW器件
采用研制出的AlN压电薄膜应用于制作NCD SAW器件,其为Si基IDT/AlN/Mo/AlN/NCD结构。其中,IDT为铝叉指换能器。采用矢量网络分析仪测试出该结构SAW滤波器频率响应曲线,如图5所示。

图5 AlN/Mo/AlN/NCD/Si器件频率响应曲线

3.2 复合AlN压电薄膜应用于Ku及K波段BAWDL器件
采用Al/Cr/AlN/Au/Cr/YAG复合结构压电薄膜研制出了Ku波段及K波段BAWDL。采用矢量网络分析仪测试出该结构BAWDL频率响应及时域响应曲线,如图6~8所示。

图6 Ku波段BAWDL器件频率响应曲线

图7 K波段BAWDL器件频率响应曲线

图8 K波段BAWDL器件时域响应曲线
由图6可知,该器件中心频率为17.3 GHz,插入损耗为43.7 dB。由图7可知,该器件中心频率为23.5 GHz,插入损耗为54.6 dB,该复合压电薄膜材料的vp=9 300 m/s。
4 结束语
本文制作得到了高声速的复合AlN压电薄膜,在Mo/AlN/NCD/Si基上制作的AlN压电薄膜(002)面的XRD摇摆曲线半峰宽FWHM=2.7°;Au/Cr基上制作的AlN压电薄膜(002)面XRD摇摆曲线半峰宽FWHM=3.6°。本文方法制备的AlN压电薄膜所得Ku波段BAWDL器件插入损耗低至43.7 dB,K波段BAWDL器件插入损耗低至54.6 dB。

