溅射功率对MgZnO薄膜晶体管性能的影响
岳廷峰,高晓红,刘建文,付 钰,孟 冰
吉林建筑大学 电气与计算机学院,长春 130118
0 引言
近年来,ZnO基TFTs由于具有稳定性好、迁移率高、制备工艺较为简单且可低温制造的特点[1-2],因此其在高分辨率、大尺寸平板显示市场有较为广泛的应用.例如用于有源矩阵液晶显示器(AM-LCD)、射频识别标签、大面积传感器和计算机中[3].尤其是在透明显示方面,展现了卓越的应用前景.尽管如此,ZnO基TFT依然存在着不可忽视的问题.已经发现在基于ZnO的TFT中,器件特性包括场效应迁移率、开关比、亚阈值摆幅等电学性能均受到有源层中固有缺陷的影响.例如ZnO薄膜中会有较多的O空位、Zn间隙等本征缺陷,这些缺陷使得ZnO薄膜内部有着较高的载流子浓度以及过大的关态电流,致使器件开关比降低,从而导致器件失去了晶体管的意义,演变成栅压控制型的电阻器.因此,本文研究的目的是如何通过合理有效的方式降低ZnO有源层中的载流子浓度[4],从而获得高质量以及高性能的ZnO基TFT器件.
目前一般采用的是掺杂和合金两种方式实现这一目标,从而获得高性能且实用的薄膜晶体管[5-6].常见的掺杂元素包括Ga[7],In[8],Al[9],Mg[10]等等.但从绿色环保、低成本制备的理念考虑,Mg元素也是首选材料之一.并且依据文献调研,Mg元素的含量丰富,在地壳的含量排第8,易于获取,市场价格便宜,可以实现低成本、规模化生产.从离子半径来看,两者的离子半径的微小差异(Zn2+0.06 Å;Mg2+0.57 Å)使得掺杂不会造成明显的晶格畸变[11-12],可以避免因为晶格失配造成的高密度缺陷,有利于高质量的薄膜生长.
MgZnO薄膜材料常用的制备方法有原子层沉积法(ALD)[13]、金属有机化学气相沉积法(MOCVD)[14]、溶胶凝胶法[15]、脉冲激光沉积法(PLD)[16]以及磁控溅射法[17]等.在本次实验过程中,采用磁控溅射的方法,因为其具有操作较为方便、制膜技术成熟等优点.实验过程中将摸索Mg掺杂ZnO薄膜材料的生长条件,进一步优化工艺流程,制备出高性能、高稳定性的MgZnO-TFT.
1 实验
本次实验采用的是厚度为100 nm热氧化SiO2为栅介电层的p-Si衬底,通过射频磁控溅射法在SiO2栅介电层上生长MgZnO薄膜作为器件的沟道层,从而制备出底栅顶接触型的MgZnO-TFT,器件的结构如图 1 所示.具体工艺如下:先将硅片沿背面切割成尺寸约为1 cm×1 cm大小的形状,依次放入丙酮、无水乙醇、去离子水中超声清洗10 min左右,随后取出用氮气吹干.采用磁控溅射的方法沉积MgZnO薄膜,磁控设备使用的是Kurt J.Lesker公司的PVD 75型号,靶材采用的是纯度为99.99 %的高纯ZnO陶瓷靶及纯度为99.99 %的高纯金属Mg靶,磁控设备进行溅射之前,需将腔室真空度抽至5×10-5mTorr以下.将ZnO靶射频功率设置为100 W.一组实验是由ZnO靶单独溅射,另外3组实验是将Mg靶射频功率设置为3 W,7 W,10 W分别进行共溅射,沉积过程在室温下进行.沉积结束将片子取出进行湿法光刻,分为匀胶、前烘、曝光、显影、坚膜、刻蚀和去胶七个步骤.湿法光刻后用电子束蒸发设备镀50 nm厚的金属铝作为源漏电极.器件的沟道长为10 μm,宽为300 μm.对制备的器件采用Keysight B 1 500A型号的半导体参数仪测试其电学性能;采用英国牛津仪器集团的原子力显微镜(AFM)对薄膜的表面形貌进行探测;采用JEOL公司的JSM-7610 F型扫描电子显微镜(SEM)对薄膜的表面形貌进行研究.

图1 TFT器件的结构示意图Fig.1 Schematic diagram of TFT device
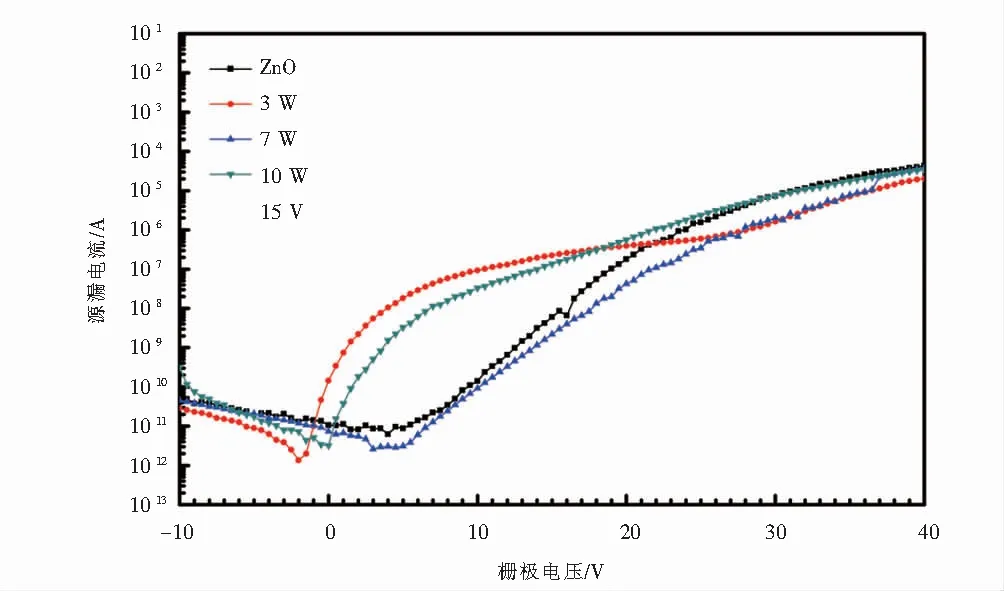
图2 不同掺杂量MgZnO TFTs转移特性曲线Fig.2 Transfer characteristics of MgZnO TFTswith different doping contents
2 结果与讨论
2.1 TFT器件性能分析
图2为不同掺杂量的MgZnO TFTs转移特性曲线.该转移特性曲线是在一定的源漏电压(VDS=15 V)下测得.随着VGS从-20 V增大到40 V,TFT逐渐经历从关态到开态的过程.实验结果表明,镁掺杂对TFTs的各项电参数均有影响.
由图2可知,在Mg靶材溅射功率为3 W时,MgZnO TFTs的各项电学参数总体达到最佳,电学性能的改善主要是由于在ZnO中掺入Mg离子降低了氧空位的密度和相应的电子陷阱.计算结果见表1.

表1 TFT的电学参数Table 1 Electrical performance of TFT
当溅射功率为3 W时电流开关比为Ion/Ioff=1.54×107, 电流开关比总体呈现先增高后降低的趋势.MgZnO TFTs的饱和场效应迁移率(1)式确定:

(1)
式中,W为沟道宽度;L沟道长度,μm;COX为单位面积栅极绝缘层的电容,mF/cm2;Vth为阈值电压,V;μsat为饱和场效应迁移率,cm2·V-1.
根据(1)式计算得到Mg靶功率为3 W时,MgZnO TFTs阈值电压为24 V,饱和场效应迁移率为1.98 cm2·V-1,饱和场效应迁移率也基本总体呈现先增高后降低的趋势,阈值电压总体变化不太明显.亚阈值摆幅SS是分析缺陷态密度的一个重要参数,SS由(2)式确定:

(2)
该公式表示的含义是当IDS增加一个数量级时VGS的增加量,SS数值越小,则越能说明绝缘层与沟道层界面态陷阱或沟道层中的缺陷态密度越小.通过计算得出,在Mg靶材功率为3 W时,MgZnO TFTs的亚阈值摆幅为1.1 V/decade.
综上所述,在Mg靶材功率为3 W时,MgZnO TFTs的各项电学参数得到改善,改善的主要原因是在有源层引入了更强的Mg-O键来抑制氧空位.界面缺陷态密度可以通过公式(3)确定:

(3)
式中,SS为亚阈值摆幅,V/decade;K玻尔兹曼常数,J/K;T绝对温度,K.当Mg靶溅射功率为3 W时,界面态密度最低,数值为3.82×1012cm-2·eV-1.
2.2 表面形貌分析
图3(a)~(d)为不同溅射功率的MgZnO薄膜的SEM照片.Mg溅射功率为3 W,7 W,10 W时在MgZnO结构中占的原子百分比(at.%)分别为1.54,3.50和4.67.

(a) 0 W

(b) 3 W

(c) 7 W

(d) 10 W
图4(a)~(d)为不同溅射功率功率的MgZnO薄膜的AFM图像.溅射功率为0 W,3 W,7 W,10 W的MgZnO薄膜的均方根粗糙度(RMS)分别为1.816 nm,1.168 nm,1.419 nm,1.482 nm,而ZnO的均方根粗糙度为1.816.与ZnO的均方根粗糙度相比较,MgZnO粗糙度降低较为明显.原因是一定量的Mg掺杂减少了薄膜的表面空隙数,改善了薄膜的表面粗糙度,使得薄膜质量变好.




图4 不同溅射功率MgZnO薄膜的AFM图像Fig.4 AFM images of MgZnO films with different sputtering powers
3 结论
本文在室温下通过射频磁控溅射技术,在100 nm厚的SiO2绝缘层硅衬底上制备了MgZnO薄膜及其晶体管.实验数据表明,Mg靶材溅射功率为3 W时,器件电学性对薄膜质量最好,原因是少量Mg掺杂降低了氧空位的密度和相应的电子陷阱,提升了电学性能以及Mg的掺杂,减少了表面空隙数,降低了薄膜表面粗糙度,改善了薄膜质量.

