氧氩比对Ta2O5栅介质薄膜晶体管电学性能的影响
王 超, 刘芙男, 杨 帆, 张含悦, 杨小天
(1. 吉林建筑大学 电气与计算机学院,吉林省建筑电气综合节能重点实验室,吉林 长春 130118;2. 吉林建筑大学 寒地建筑综合节能教育部重点实验室,吉林 长春 130118;3. 吉林师范大学,吉林 四平 136099)
1 引 言
进入21世纪以来,全球集成电路制造技术升级换代速度有加快的趋势,按照摩尔定律,随着集成度的提高,薄膜晶体管(Thin Film Transistor, TFT)特征尺寸按比例缩小,其结果就是晶体管沟道长度的减小和栅介质层的减薄[1]。SiO2作为TFT的栅介质材料,已经很接近可以保证SiO2完整带隙结构的最小厚度[2-3]。栅介质层过薄会导致多种问题,如电子因为隧穿效应穿越栅介质层使器件漏电流增大,器件可靠性降低,电路静态功耗增大,并影响器件的I-V特性和阈值电压[4-5]。解决方法之一是采用高介电常数(高k)的新型绝缘介质材料[6-9]。Ta2O5因具有比较大的介电常数、高的击穿电压、低的漏电流密度、以及比较容易和硅工艺相兼容的特点,被认为是二氧化硅的最好的替代品之一[10-13]。非晶态Ta2O5薄膜的相对介电常数约为20,远高于SiO2的相对介电常数(3.9),因而在相同厚度、相同电压的情况下,Ta2O5薄膜能够实现更高的等效氧化层厚度,从而降低漏电流密度[14]。在可见光波段范围内,Ta2O5具有较低的吸收率和较高的折射率,在波长550 nm处,折射率约为2.14,同时该材料还具有很宽的光谱透过范围,通常被广泛应用于各种光学器件[15]。随着微电子工业的发展,性能优良的Ta2O5薄膜必将在动态随机存储器和集成电路等方面得到越来越广泛的应用[16]。
本文使用射频磁控溅射方法在室温下制备了薄膜晶体管,分别以Ta2O5和SiO2薄膜作为栅介质层,以AZO(AlZnO,铝掺杂的氧化锌)为有源层,研究了Ta2O5在溅射过程中氧分压条件对TFT器件电学性能的影响,氧分压是影响TFT阈值电压、迁移率等性能的最重要因素之一。使用扫描电子显微镜和原子力显微镜对薄膜的形貌进行了表征,使用半导体参数测试仪测试器件的电学性能,分析了氧分压对Ta2O5薄膜作为栅介质的AZO-TFT性能的影响机理。
2 实 验
本实验采用美国Kurt J.Lesker磁控溅射设备沉积Ta2O5薄膜和AZO薄膜。溅射靶材分别采用的是高纯Ta2O5陶瓷靶(纯度为99.99%)、高纯ZnO陶瓷靶(纯度为99.99%)和Al靶(纯度为99.99%)。
(1)制备以Ta2O5为栅介质的底栅型TFT。以载玻片作为衬底,首先,清洗衬底,将载玻片依次浸入丙酮、乙醇和去离子水中,在超声条件下进行清洗,每步清洗10 min;然后,在清洗好的载玻片上蒸镀100 nm铝(Al)作为栅电极;在Al电极上采用磁控溅射法沉积Ta2O5薄膜作为栅介质,溅射功率为100 W,生长室压强1.067 Pa,衬底温度为室温,溅射时工作气体为氩气,反应气体为氧气。调控氧氩比分别为0∶100,5∶95,10∶90,20∶80,溅射时间为2 h;在该Ta2O5栅介质层上采用磁控溅射法沉积AZO有源层,其中,ZnO靶功率为100 W,Al靶功率为15 W,溅射压强1.067 Pa,衬底温度为室温,氧氩比为10∶90,溅射时间为15 min;对样品进行光刻,最后蒸镀50 nm Al为源漏电极,制备成TFT器件。器件结构如图1所示。
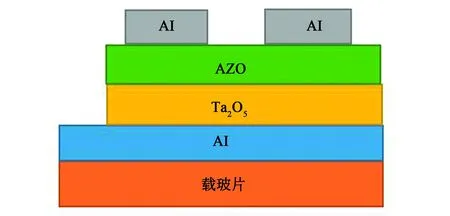
图1 Ta2O5栅介质薄膜晶体管结构Fig.1 Structure of Ta2O5 thin film transistor
(2)制备以SiO2为栅介质的底栅型TFT。以具有285 nm厚度热氧化SiO2绝缘层的p型硅片为衬底,首先,清洗衬底,将SiO2/p-Si先后浸入丙酮、乙醇和去离子水中,在超声条件下进行清洗,每步清洗10 min;然后,在清洗好的衬底上沉积AZO有源层,其中,ZnO靶功率为100 W,Al靶功率为15 W,溅射压强1.067 Pa,衬底温度为室温,氧氩比为10∶90,溅射时间为15 min;对样品进行光刻,最后蒸镀50 nm Al为源漏电极,制备成TFT器件。
采用日本JEOL公司的JSM-7610F型扫描电子显微镜(SEM)观察薄膜的表面形貌,采用英国Oxford公司的MFP-3D型原子力显微镜(AFM)观察薄膜的表面形貌和粗糙度,利用Keysight B1500A半导体参数测试仪测试TFT的电学性能。
3 结果与讨论
3.1 表面形貌分析
图2(a)~图2(d)为不同氧分压下沉积的Ta2O5薄膜的SEM照片,氧氩比分别为0∶100,5∶95,10∶90,20∶80。
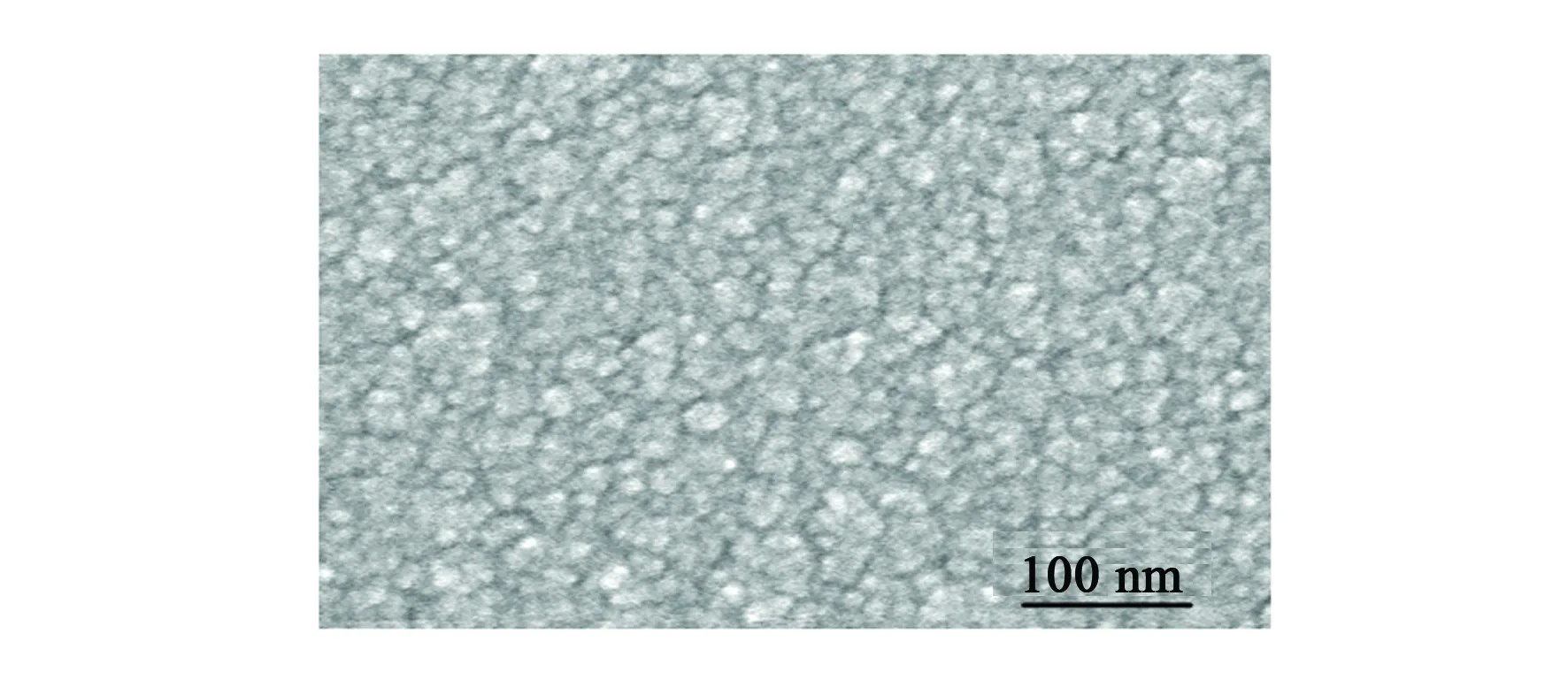
(a)O2∶Ar=0∶100
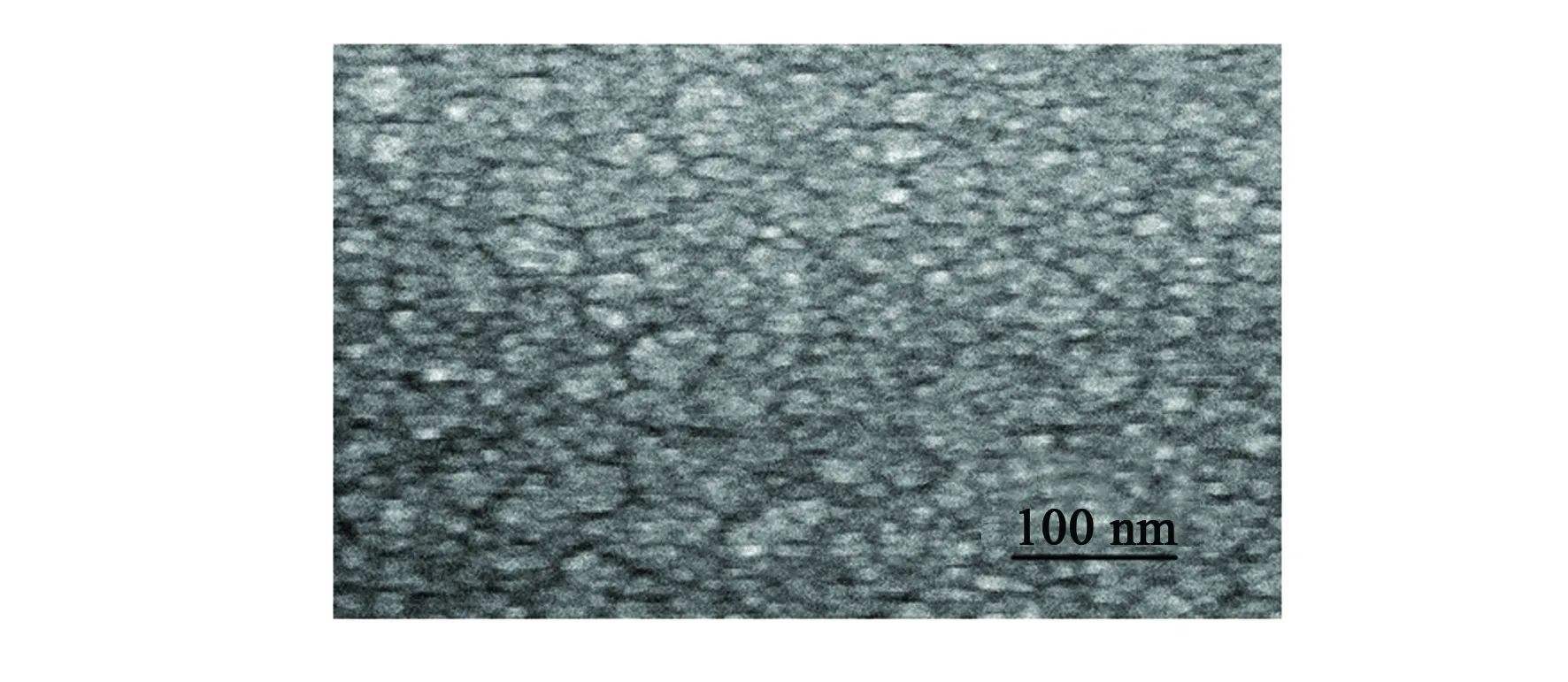
(b)O2∶Ar=5∶95
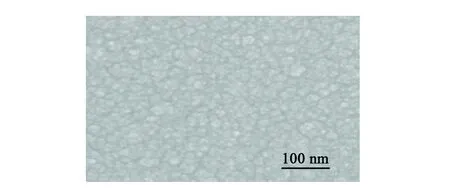
(c)O2∶Ar=10∶90
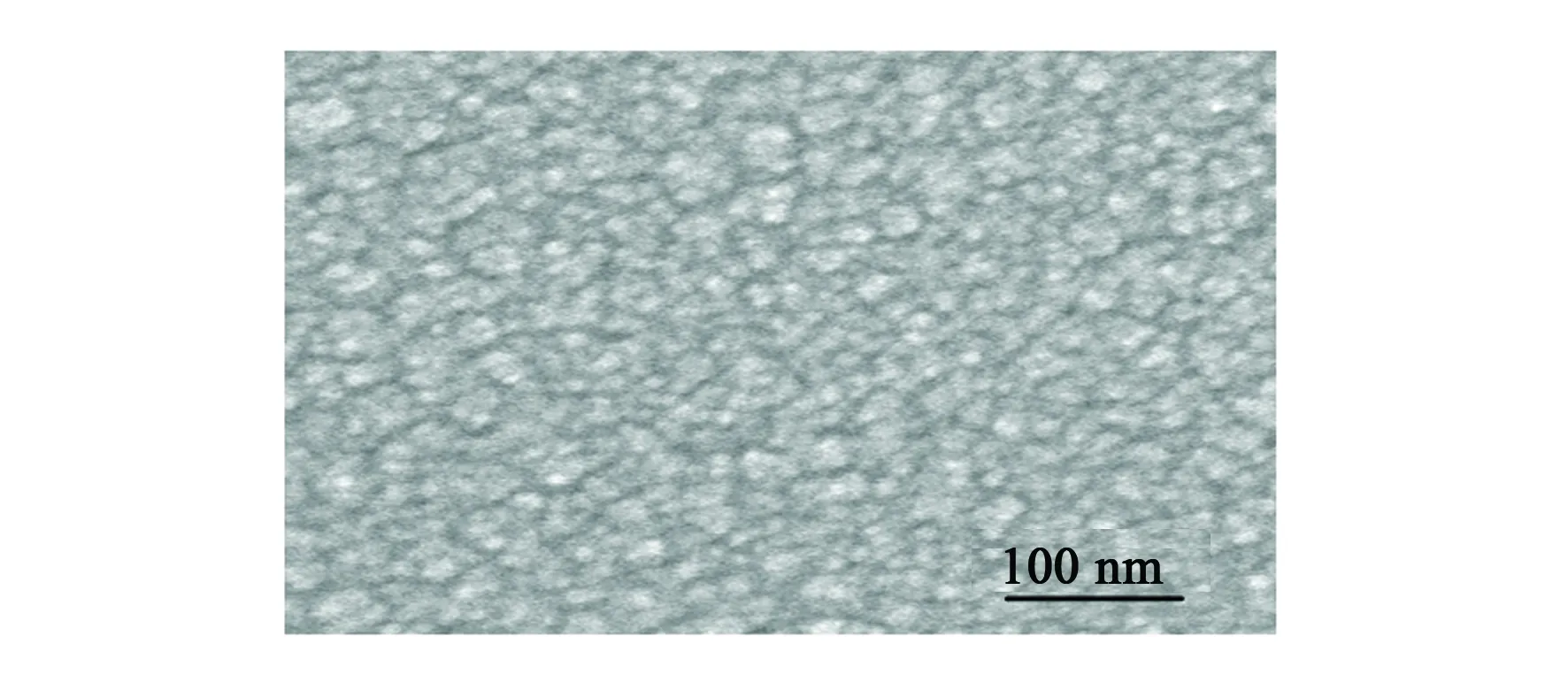
(d)O2∶Ar=20∶80图2 不同氧分压下生长的Ta2O5薄膜的SEM图Fig.2 SEM images of Ta2O5 films grown at different oxygen partial pressures
由图2可见,在纯氩气条件下(图2(a))生长的薄膜表面最粗糙,排列不致密,表面呈现颗粒状,缺陷较多,因此容易产生较大漏电流;加入氧气后,当氧气含量较少时(图2(b)),薄膜表面变化较小;氧氩比为10∶90时(图2(c))薄膜比较致密,表面平坦光滑,没有明显的空隙和缺陷;氧分压继续增大至20∶80时(图2(d)),薄膜表面相比较为粗糙,因为过高的氧气含量降低了沉积原子的动能,继而影响了沉积原子在衬底表面的迁移过程,影响了薄膜的质量。

(a)O2∶Ar=0∶100

(b)O2∶Ar=5∶95

(c)O2∶Ar=10∶90

(d)O2∶Ar=20∶80图3 不同氧分压下生长的Ta2O5薄膜的AFM图Fig.3 AFM patterns of Ta2O5 films grown at different oxygen partial pressures
图3(a)~图3(d)为不同氧分压下生长的Ta2O5薄膜的AFM图,Ta2O5薄膜表面粗糙度RMS分别为1.888,1.426,0.835,1.818 nm,半导体层与介电层的界面平整度会直接影响载流子的迁移率,高质量的平整界面有利于抑制界面处电荷陷阱的出现,并且对载流子的散射较少,利于载流子的迁移。纯氩气条件下(图3(a)),薄膜粗糙度较大,表面不够平整。随着氧分压的增加(图3(b)),薄膜粗糙度降低,氧氩比为10∶90时(图3(c)),薄膜粗糙度最小,说明氧气的通入减少了薄膜缺陷,使薄膜表面平整。氧分压继续增大(图3(d))会影响薄膜的生长,导致薄膜粗糙度增加。
3.2 TFT器件电学性能分析
图4所示为不同氧氩比条件下以Ta2O5薄膜为栅介质所制备AZO-TFT的转移特性曲线,源漏电压VDS为2 V,栅极电压VGS从-10 V变化到10 V。表1给出了不同栅介质的TFT电学性能参数,如表1所示,当氧氩比由0∶100改变为5∶95后,TFT电流开关比由1.92×102增至3.36×102,氧气的加入使得器件关态电流降低,氧氩比变为10∶90时,TFT电流开关比由3.36×102增至2×104,而在氧氩比调控至20∶80后,器件开关比由2×104降低至2.49×102。随着氧分压的增大,阈值电压先增大后降低,这可能是由于纯氩气生长条件下,Ta2O5薄膜的组分偏离化学计量比,存在氧空位,造成薄膜漏电流较大[17]。生长过程中氧气流量的增加,Ta2O5薄膜的化学计量比偏离较少,使薄膜中未补偿键饱和,大量的氧空位和缺陷随之减少,增加了薄膜的致密性,从而降低漏电流,氧氩比为10∶90条件下,Ta2O5薄膜能够达到最佳的绝缘性能。当氧分压继续增大,生长过程中氧气的增加已经无法弥补Ta2O5薄膜的缺陷,氧气的增加还会影响薄膜的沉积速率,导致开关比降低,阈值电压增大,亚阈值摆幅增大。
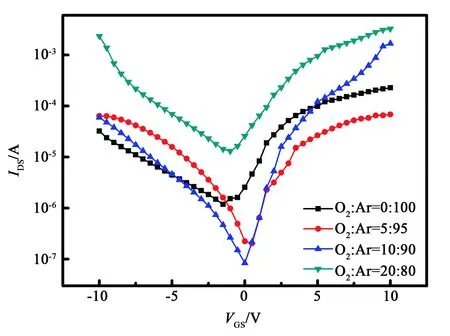
图4 不同氧氩比条件下Ta2O5作为栅介质的AZO-TFT的转移特性曲线Fig.4 Transfer characteristics of Ta2O5 gate dielectric AZO-TFT under different oxygen to argon ratios

表1 不同栅介质的AZO-TFT性能参数Tab.1 Performance parameters of AZO-TFT with different gate dielectrics
亚阈值摆幅的物理定义为漏电流增加一个数量级所对应的栅压[18],其公式如下:
(1)
当亚阈值摆幅很小时,器件只需要一个较小的栅极偏压改变就可以保证器件从截止区到达饱和区。由表1可知,随着氧氩比从0∶100增加到10∶90,薄膜陷阱态密度降低,器件亚阈值摆幅降低[19]。氧氩比继续增加到20∶80,器件亚阈值摆幅增大。相比SiO2栅介质层,采用Ta2O5作为栅介质层的TFT器件迁移率都有不同程度的提高。随着氧氩比从0∶100增加至10∶90,器件的迁移率从2.8 cm2/(V·s)增加到12.2 cm2/(V·s),开关比从1.92×102提升到2×104,继续通入氧气,迁移率增大,但关态电流增大,导致开关比降低。
图5所示为Ta2O5和SiO2作为栅介质的TFT的转移特性曲线。
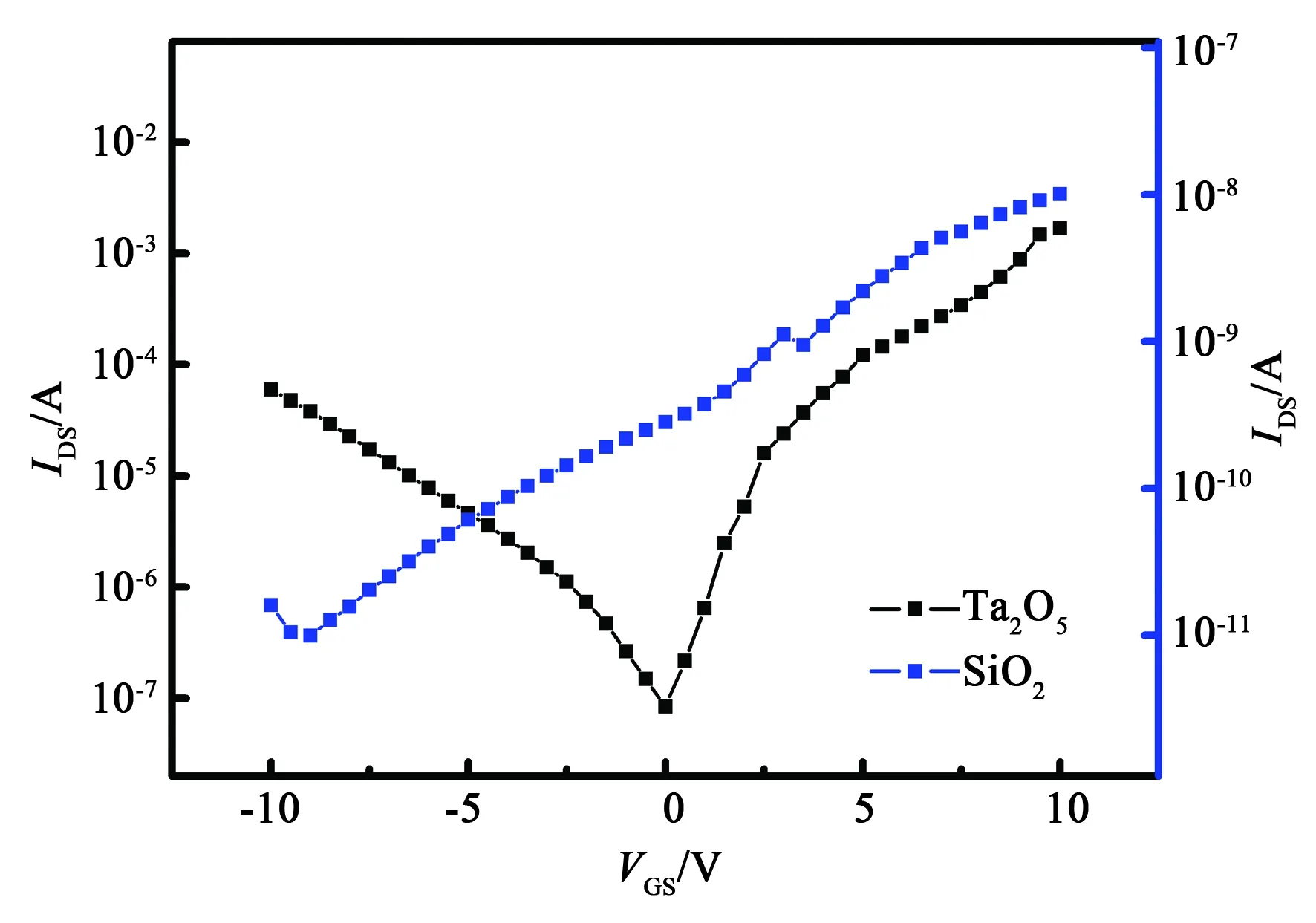
图5 Ta2O5和SiO2作为栅介质的AZO-TFT转移特性曲线Fig.5 Transfer characteristic curves of AZO-TFT with SiO2 and Ta2O5 as gate dielectric
图5中,Ta2O5的溅射氧氩比为10∶90,源漏电压VDS为2 V,栅极电压VGS从-10 V变化到10 V,与传统的SiO2材料相比,使用高k材料作为绝缘层的TFT器件同时具备较低的工作电压和较大的开态电流两个优点[20],传统的SiO2作为栅绝缘材料器件需要较高的工作电压,而Ta2O5薄膜可以降低器件的工作电压,从而降低器件功耗。由图5可知,SiO2作为栅介质的AZO-TFT阈值电压为0.8 V,亚阈值摆幅为5 V·dec-1,开关比为1.02×103,而Ta2O5作为栅介质的AZO-TFT阈值电压为0.5 V,亚阈值摆幅为1.5 V·dec-1,开关比为2×104,可见采用高k材料作为绝缘层后,器件阈值电压降低,亚阈值摆幅降低,开关比升高,器件性能有了较大提高。
4 结 论
本文采用磁控溅射方法,在载玻片上制备了Ta2O5作为栅介质的AZO-TFT,研究了不同氧氩比条件下Ta2O5薄膜对于TFT性能的影响,随着氧分压的增加,氧空位的减少,薄膜缺陷被改善,漏电流随之减小,能够达到更好的绝缘性能。实验发现,氧氩比为10∶90时TFT电学性能最优,采用高k材料作为绝缘层后,与传统SiO2绝缘层相比,TFT电学性能获得一定提升,电流开关比由1.02×103提升到2×104,亚阈值摆幅从5 V·dec-1降到1.5 V·dec-1,迁移率从1.6 cm2/(V·s)增加到12.2 cm2/(V·s)。

