基于两平晶三面互检的折射率均匀性测量方法
马致遥,郑东晖,陈磊,马骏
(南京理工大学 电子工程与光电技术学院,南京 210094)
0 引言
光学制造技术的发展对光学平晶的面形质量和折射率均匀性的要求越来越高,在动态干涉测量等领域都有应用[1-3]。对于常用的633 nm 红光波段,1 ppm(10-6)量级的不均匀性就能引起波面变化。美国的AI C等提出了采用光学干涉法,主要包括翻转法和透射法[4],来测量光学材料的均匀性。国内的郭培基等提出了光学平行平板样品不均匀性的绝对测量方法,进一步丰富了光学玻璃均匀性测量的方法[5-8]。张瑞应用同步移相干涉仪检测了平行平板的光学均匀性[9],白云波则完成了对1 m 级大口径钕玻璃的均匀性拼接测量[10]。MATOUŠEK O 通过傅里叶变换计算了折射率均匀性[11]。透射法可以消除样品面形及系统带来的误差,是目前定量测量光学均匀性精度最高的方法,也是在高精度测量玻璃光学均匀性时使用最广泛有效的方法。但是上述干涉测量方法除了干涉仪的参考平晶和被测样品外,还需要另外一块平晶作为反射平晶使用才能完成对被测样品折射率均匀性的检测,即至少需要三块平晶才能实现。
奇偶函数法和旋转平均法都是光学绝对检验中常用的方法。AI C 等首次提出了奇偶函数法,将波面分解为偶偶、偶奇、奇偶和奇奇四个部分分步求解[12]。XU Chen 提出了用两块光学板实现绝对检验的方法,他通过透射法预先对透射平晶的折射率均匀性进行检测和扣除,并通过两平晶的三个平面完成了绝对检验工作[13]。ZHAI Dede 提出了一种基于移位旋转的绝对测试算法。需要90°旋转和横向移位,便于大口径平面的实施[14-15]。ZHOU You 结合奇偶函数和N 位旋转平均的思想完成了对600 mm 平晶的绝对检验[16]。WANG Yuntao 通过奇偶函数法完成了对300 立式干涉仪的精度调校[17]。
本文结合了光学平晶绝对检验中两平晶绝对检验方法、奇偶函数算法和旋转平均算法的思想,提出了一种只需要使用参考平晶和反射平晶两块平晶就能够完成对参考平晶折射率均匀性质量评估的方法。该方法使用两块平晶的三个参考面以及多次旋转干涉测量,通过将折射率均匀性分成奇偶项求解再叠加的方式实现。利用Zernike 多项式进行了原理性的仿真,在100 mm Zygo 干涉仪上进行了实验,并通过透射法测量待测平晶的折射率均匀性。
1 两平晶三面测量折射率均匀性原理
提出的两平晶三面测量折射率均匀性的过程如图1 所示,其中A表示透射平晶的非工作面,B表示透射平晶的工作面,C表示反射平晶的工作面,n代表透射平晶(待测平晶)的玻璃材料折射率。

图1 两平晶折射率均匀性检测步骤Fig.1 Steps of two-flats refractive index uniformity test
首先,透过B面使非工作面A和C进行干涉,测量得到波面结果记录为M1。然后测量工作面B和C的波面结果记录为M2。接着让C绕z轴旋转,测量旋转45°、90°、180°位置的结果,并分别与工作面B产生干涉,测量得到波面结果记为M3、M4和M5。最后,将透射平晶沿y轴翻转180°,并将C转回到原位,直接测量非工作表面A和C,所得干涉测量波面结果记录为M6,即
式中,(x,y)表示规定的以测试面C为正方向坐标系,(-x,y)表示该面关于y轴发生了翻转,Cφ表示C面旋转了φ角度,δ(x,y)表示折射率均匀性引入的波面误差,n为材料折射率。
通过奇偶函数的分解方法,以偶奇(eo)项为例,利用测量结果M1、M2、M5、M6,将其中的eo 项分离出来,其中M5为B面与C面旋转180°后的测量结果,结果表示为
式中,下标eo 表示该波面的偶奇分量,根据式(2)可以求得δeo分量,表示为
同理,可以求得δ的奇偶分量δoe以及奇奇分量δoo,分别表示为
通过式(1)~(5)计算出折射率均匀性δ中的eo、oe 和oo 三个部分,还剩偶偶项δee没有求解,但是根据已有的测量结果,无法直接得到δee部分。因此采用继续分解的方案,将待求解的δee分量继续分解为δeee和δeeo两部分,这两个分量分别表示关于y=x呈正对称和负对称的两个部分,计算公式为
式中,[δee]'代表δee关于y=x翻转后的分量。
通过M2和M4的测量结果可计算eeo 分量,M4是B和C旋转90°的测量结果,先求得这两个测量结果的ee 分量,然后将这两个分量做差,可以表示为
式中,如果C在直角坐标系下表示为C(x,y),根据直角坐标系坐标变换,[C90°]表示为C(-y,x),根据ee 函数的性质,C(-y,x)和C(y,x)相等,C(y,x)就是C(x,y)关于y=x做翻转后的坐标,即[C]',所以
因此Ceeo可以表示为
在得到Ceeo分量后,转换得到δ中的eeo 分量部分,表示为
对于还没有求出的eee 项分量,继续分解为eeee 和eeeo 分量,和前面的类似,这两个分量分别是关于y=tan(22.5°)x呈正负对称的分量。类似地,可以通过旋转45°的测量结果将δeeeo表示为
此时已经求出了δ中除了eeee 分量外的其他分量,而δeeee是关于y=tan(22.5°)x呈正对称的分量,在Zernike 拟合当中,它可以被认为是8θ 分量,是部分高频分量。将这部分分量直接忽略的话,可以将折射率均匀性δ近似表示为
常用的Zernike 多项式36 项拟合只到5θ 项,而忽略的部分为高于8θ 的旋转对称分量,其中包含δf(ρ)部分,即旋转不变项分量。实际计算出的折射率均匀性中的误差项主要为离焦和球差部分。
2 仿真
为了验证所提方法的可行性,进行数值仿真。使用Zernike 多项式的前36 项构建平面A、B和C的原始表面误差和折射率均匀性误差波面,如图2 所示,其中Z1、Z2和Z3的系数为0,Z4~Z36的系数随机生成,其中A、B和C三个面的峰谷值(Peak-valley,PV)约为60 nm,折射率均匀性引入的波面误差在80 nm 左右,具体PV 和均方根值(Root-mean-square,RMS)参数如表1 所示。

表1 仿真原始波面PV 和RMS 值Table 1 PV and RMS values of original simulation wavefront

图2 原始仿真波面Fig.2 The original simulation wave
根据提出的方法恢复得到的折射率均匀性结果如图3(a)所示,其分布与仿真预设的折射率均匀性基本一致,两者相减得到的残差如图3(b)所示,残差图的形式符合预期,呈现旋转不变的特征。对应的PV 和RMS 值如表2 所示。理论的残差应该为实际的折射率均匀性引入波像差的eeee 部分。将这部分单独提取出来,如图3(c)所示。

表2 复原折射率均匀性的PV 和RMS 值Table 2 The PV and RMS values of recovered refractive index uniformity

图3 折射率均匀性波面复原结果及残差对比Fig.3 Recovered refractive index uniformity wavefront results and its residual comparison
从图3 中可以看出,所求出的折射率均匀性的残差和原始的折射率均匀性波面的eeee 项部分完全相同,符合理论预期。说明在Zernike36 项内,即中低频区域内,待测面的面形精度对恢复折射率均匀性没有影响。根据原理,残差为eeee 项部分,这部分分量每45°呈现正对称性质,因此是频率8θ分量,在实际测量中,面形信息中超过8θ的部分,会对恢复结果产生影响。但是这部分高频信息本身所占比重很低并且对整体面形以及波面参数的影响很小。
以材料折射率均匀性的标准来判断,假设平晶材料的厚度为10 mm,原始波面折射率均匀性为7.8 ppm,而复原波面的折射率均匀性为7.2 ppm,结果仅相差0.6 ppm,可以认为两者处于同一量级,说明该方法对评价折射率均匀性指标具有较好的效果。
3 实验与结果
3.1 100 mm 平晶实验
为了进一步验证该方法的准确性,在Zygo GPI 干涉仪上使用Φ100 mm 平晶进行实验,装置如图4 所示,6 次测量的波面如图5 所示。使用的透射平晶为石英材料,前后表面质量均优于,λ表示波长,且具有一定的楔角,不会产生自干涉的条纹。反射平晶的使用的是一块微晶平晶,表面质量同样优于。

图4 两平晶折射率均匀性检测装置Fig.4 Experimental setup for two flats refractive index uniformity test

图5 两平晶法测量透射平晶折射率均匀性波面Fig.5 Wavefront of refractive index uniformity of transmission flat by two flats method
在测量过程中,透射平晶在对点板上存在前后表面2 个光斑,反射平晶只有1 个光斑。透过平晶测量会引入折射率均匀性误差,条纹图及测量结果中能够看出比较明显的应力条纹,如图5 中的M1所示,可以直接判断出是否为透射测量。
采用传统三平晶透射法测量同一块透射平晶的折射率均匀性,与两平晶法进行比较,实验装置如图6所示。

图6 透射法测量折射率均匀性实验Fig.6 Experiment of transmission method for refractive index uniformity test
透射法测量折射率均匀性的步骤如图7 所示,总共需要进行4 次测量:1)测量参考面A和反射面D的空腔干涉结果;2)将待测折射率均匀性的测试平晶放到中间,测量穿过透射平晶后,参考面A和反射面D的干涉结果;3)测量参考面A和测试平晶前表面B的干涉结果;4)测量测量A和测试平晶后表面C的干涉结果。测量结果可以表示为

图7 透射法测量折射率均匀性步骤Fig.7 Steps for measure refractive index uniformity by transmission method
计算出折射率均匀性δ引入的波面差可以表示为
3.2 结果比较
通过两种方法计算出透射平晶的折射率均匀性结果如图8 所示,平晶厚度为15 mm,恢复结果的PV 和RMS 值如表3 所示。两种方法的测量结果在面形分布上相似,明显的应力条纹分布位置也能够显示出来。

表3 折射率均匀性复原结果的PV 和RMS 值Table 3 PV and RMS of the recovered refractive index uniformity

图8 折射率均匀性测量结果Fig.8 The result of refractive index uniformity
根据表3的结果,两种方法恢复的折射率均匀性结果PV 值相差3.02 nm,RMS 值相差1.27 nm。计算出通过两平晶法恢复的折射率均匀性为4.1 ppm,通过透射法测量的结果3.9 ppm,两者处于同一量级,仅相差0.2 ppm。因此,可以认为该方法能比较好地评价平晶的折射率均匀性质量,并且能够恢复出其中明显存在应力分布的位置。
4 误差分析
4.1 旋转角度误差
在实际测量过程中,由于旋转装置的机械误差,旋转过程中会产生角度误差。原始波面采用图2 的波面,每次的旋转角度为45°,在这个角度基础上每次增加0.1°的旋转角度误差,计算此时恢复波面的误差情况。这里忽略了固有的理论误差值,只考虑由于旋转角度误差造成的影响。
根据图9,当旋转角度误差小于0.5°时,残差的PV 值小于1 nm,当旋转角度误差小于1°时,残差的PV 值小于2.5 nm。所使用的旋转结构分度值为0.5°,实际由于旋转造成的误差能够小于1 nm,对恢复折射率均匀性的影响并不明显。

图9 旋转角度误差与残差关系Fig.9 Relationship between the rotation angle error and the residual error
4.2 对准偏差
在干涉测量过程中,干涉仪参考平面坐标被当作参考坐标。其他平面在对准以及旋转过程中都与参考坐标对准,但是实际上总会存在一定的偏差,影响测量结果。对准偏差和残差面之间的关系如图10 所示。对准偏差的计算方式与旋转角度误差类似,忽略固有的理论误差引入的影响,只考虑对准偏差造成的影响。
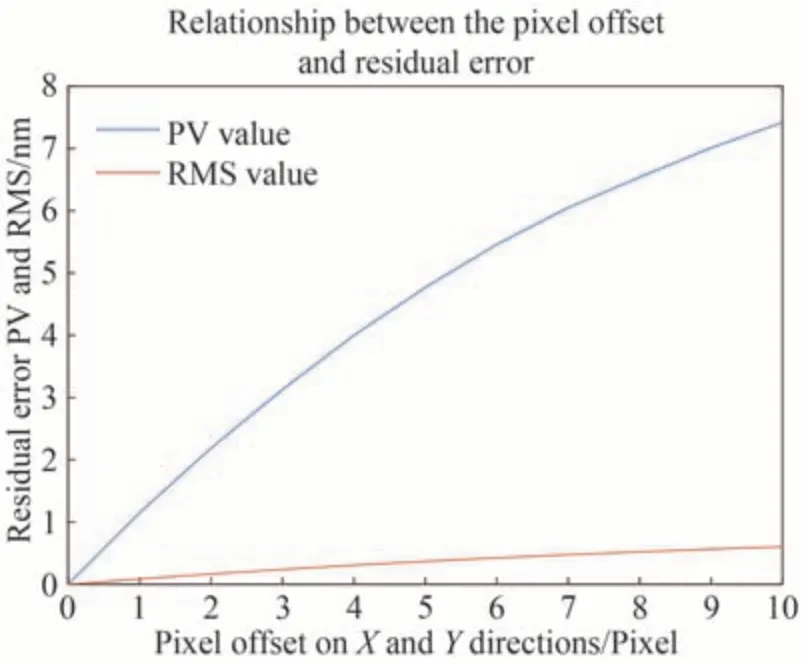
图10 对准偏差和残差关系曲线Fig.10 Relationship between the pixel offset and residual error
随着对准误差的增大,残差PV 值快速变大,RMS 值的增大则缓慢一些。如果偏差达到10 像素,残差的RMS 也能小于1 nm。换算成实际尺寸,在100 mm 的平晶中,保证对准偏差小于1 mm,恢复结果的RMS 值偏差能够小于1 nm。
5 结论
本文提出了一种基于两平晶三面互检的折射率均匀测量方法。在Φ100 mm Zygo GPI 干涉仪上对该方法进行了实验验证,并与传统三平晶透射法进行了比对,结果表明,两种方法测量得到的折射率均匀性结果分布一致,数值仅相差0.2 ppm,验证了所提方法的准确性与可靠性。该方法仅需两块平晶,可拓展应用至大口径光学平晶折射率均匀性的检测,降低检测成本。

