双向低触发电压横向晶闸管放电管研究
蒋 刚,邓旭聪,赵 明
(1.国网广安供电公司,广安 638000;2.四川大学电子信息学院,成都 610065)
0 引 言
晶闸管(SCR)由于其深回滞输出特性曲线、低导通电阻、高静电放电(ESD)泄流能力的特点,在ESD保护中得到越来越广泛的应用[1-2]。除了采用多个器件的组合方案来实现双向ESD保护之外,也可以用单向SCR的衍生器件来实现双向ESD保护,双向SCR器件内部是NPNPN结构[3]。为了对集成电路的输出端口形成有效保护,需要低触发电压的SCR放电管作为ESD保护器件[4]。对于低触发电压SCR放电管,在保证SCR放电管的开启速度不受影响的前提下,通过优化SCR放电管内部结构(如寄生晶体管基区结构、发射区结构、低电压触发结构等)的方法来降低SCR放电管的触发电压。
目前虽然关于ESD保护应用的SCR放电管设计及制备的文献报道较多,但是大多为分立垂直导通型结构,且触发电压较高(其触发电压一般在十几伏到几十伏之间),对于基于双极型集成电路工艺的横向低触发电压SCR放电管的报道较少。本文依据双向低触发电压横向SCR放电管电参数指标要求,利用利用Silvaco-TCAD半导体器件仿真软件对双向低触发电压横向SCR放电管结构参数进行仿真设计。探究了N-衬底区、寄生PNP晶体管P-集电区、寄生NPN晶体管P-基区、N+阴极区、N+触发区、寄生PNP晶体管P-集电区与寄生NPN晶体管P-基区间距、寄生NPN晶体管表面基区宽度对器件电学性能的影响。通过实际流片,研制出的样片的触发电压VS、触发电流IS、维持电流IH及触发电压、维持电流高低温变化率完全满足电参数指标要求。本文研究结果可为双向低触发电压横向SCR放电管的设计及制备提供一定的参考信息。
1 器件结构及物理模型
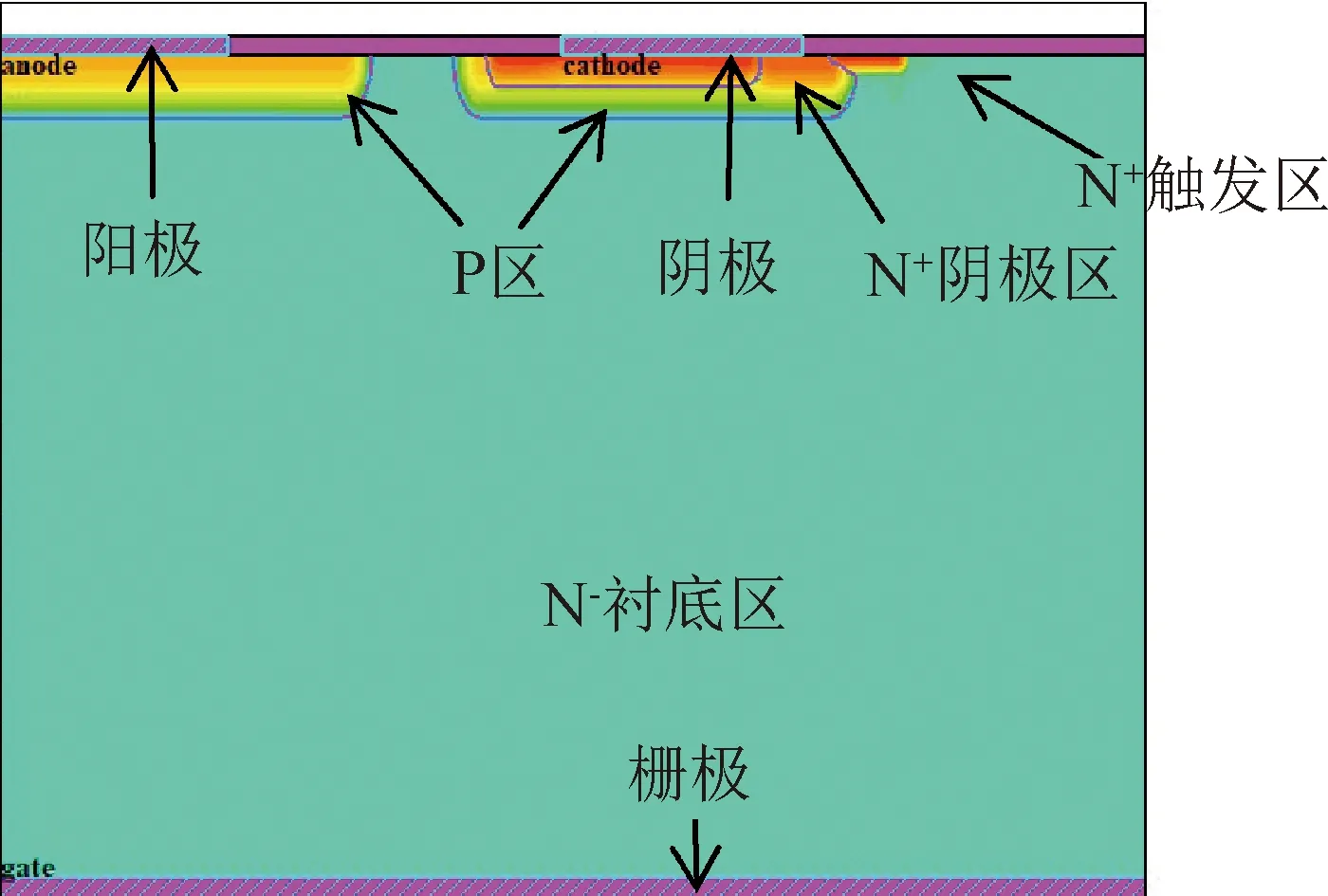
图1 双向低触发电压横向SCR放电管结构示意图Fig.1 Schematic diagram of transverse SCR discharge transistor with bidirectional low trigger voltage
双向低触发电压横向SCR放电管是一种对称的ESD保护器件,它没有阳极与阴极的差异,在两个方向的ESD保护性能是等同的。在结构参数设计及输出特性研究中,针对双向低触发电压横向SCR放电管的一路进行仿真研究。图1为双向低触发电压横向SCR放电管二维剖面结构(其中一路)。器件中P阳极区、N-衬底区、P区构成寄生PNP晶体管,N+阴极区、P区、N-衬底区构成寄生NPN晶体管,寄生PNP晶体管与寄生NPN晶体管相互耦合,形成PNPN晶闸管结构,器件底部为栅极。当寄生PNP晶体管与寄生NPN晶体管共基极短路电流放大倍数之和大于1(αPNP+αNPN>1)时,PNPN晶闸管结构触发开通[5]。
在25 ℃条件下,电参数要求为:(1)触发电压VS=6~10 V;(2)触发电流IS<500 μA;(3)维持电流IH<5 mA。高低温变化率要求:(1)触发电压VS低温变化率低于1%;(2)触发电压VS高温变化率低于1%;(3)维持电流IH低温变化率低于200%;(4)维持电流IH高温变化率低于50%。依据常温电参数要求,通过仿真设计确定器件的结构参数。仿真设计得到的器件结构参数如表1所示。其中,P阳极区与寄生NPN管P基区在同一工艺步骤经P型掺杂制备得到,N+阴极区与N+触发区在同一工艺步骤经N型掺杂制备得到。

表1 器件结构参数Table 1 Device structural parameters
在仿真前需要建立精确的物理参数模型,包括复合模型、迁移率模型等。复合模型考虑了SRH复合模型和俄歇(Auger)复合模型[6-7]。在仿真设计中考虑环境温度和结温变化对器件电学性能温度特性的影响,采用Klaassen迁移率模型[7-9]。同时在仿真设计中考虑器件内部电场对载流子迁移率的影响,采用解析的低电场迁移率(Analytic)模型和平行电场相关的负微分饱和速度效应迁移率(Fldmob)模型[7,10-11]。与电场有关的碰撞电离率采用Selberherr碰撞电离模型(Selb)[6-7]。当器件内存在足够高的电场,局部能带弯曲可能足以允许电子通过内部场发射从价带隧穿进入导带,因此,在导带和价带中分别产生额外的电子和空穴。由于所研究的双向低触发电压横向SCR放电管有低触发电压的要求,因此器件内需要设计并制备辅助触发结构,辅助触发结构为两侧重掺杂的PN结,因此在仿真触发特性的过程中,需要考虑重掺杂所致的带-带隧穿机制,在仿真中选择BBT.STD模型[6-7]。由于温度变化对载流子迁移率、禁带宽度等材料参数产生影响,将导致器件电学性能随温度变化发生漂移。因此,在双向低触发电压横向SCR放电管瞬态响应特性仿真过程中,为了精确模拟在瞬态脉冲电流下器件晶格温度的变化及分布,必须同时考虑载流子同晶格处于不同温度下的非热平衡效应与非局域效应耦合的半导体器件方程,在仿真过程中利用非等温能量平衡传输(Non-isothermal Energy Balance Model,NEB)模型来研究器件的瞬态特性[7]。另外还考虑了重掺杂引起的禁带变窄效应(Bgn)和能带简并效应(Fermi)[6-7]。
2 结果与讨论
图2为仿真得到的P区掺杂浓度和结深对双向低触发电压横向SCR放电管输出I-V特性的影响。由图2(a)可见:当P区结深dp-(结深为2.7 μm)一定时,随着P区表面浓度Np-的增大,转折电压和触发电压随之减小。触发电流和维持电流随之增大,且通态压降随之略有增大。根据低触发电压指标的要求,同时需要考虑降低干扰信号误触发的风险,应该适当提高P区掺杂浓度。由图2(b)可知,当P区表面浓度一定时(表面浓度为3.5×1018cm-3),随着P区结深的增大,转折电压和触发电压随之增大。触发电流和维持电流随之增大,且通态压降随之增大。根据低触发电压指标的要求,同时需要考虑降低干扰信号误触发的风险,应该适当减小P区结深。

图2 P区掺杂浓度和结深对双向低触发电压横向SCR放电管输出I-V特性的影响Fig.2 Influence of P region doping concentration and junction depth on the output I-V characteristics of transverse SCR discharge transistor with bidirectional low trigger voltage
图3为仿真得到的 P区掺杂浓度和结深对双向低触发电压横向SCR放电管抗瞬态电流烧毁能力的影响。施加脉冲电流进行瞬态响应仿真(用于衡量放电管抗瞬态电流烧毁的能力),脉冲峰值电流为2 A,脉冲上升时间和下降时间为10 ns,脉宽为80 ns(文中瞬态仿真的仿真条件相同)。当P区结深一定时,随着P区表面浓度的增大,器件峰值晶格温度随之增大,器件抗瞬态电流烧毁能力下降(见图3(a))。当P区表面浓度一定时,随着P区结深的增大,器件峰值晶格温度随之显著增大,器件抗瞬态电流烧毁能力下降(见图3(b))。为了提高放电管的抗瞬态电流的烧毁能力,应该适当降低P区的掺杂浓度和减小P区结深。其中降低P区掺杂浓度与降低触发电压、提高维持电流对P区掺杂浓度的要求相矛盾,因此对于P区掺杂浓度的选择应在满足电参数指标的前提下适当降低。P区结深对直流输出I-V特性和瞬态输出特性曲线的影响较显著。当P区结深为2 μm时,器件没有表现出回滞特性曲线(见图3(b)),不具有ESD保护能力。在脉冲峰值电流为2 A情况下,当P区结深为3.5 μm时,器件内部峰值晶格温度已达到1 000 K(见图3(b))。因此,允许的P区结深范围较窄。

图3 P区掺杂浓度和结深对双向低触发电压横向SCR放电管瞬态响应的影响Fig.3 Influence of P region doping concentration and junction depth on transient response of transverse SCR discharge transistor with bidirectional low trigger voltage
图4为仿真得到的N-衬底掺杂浓度Ns对双向低触发电压横向SCR放电管输出I-V特性和瞬态特性的影响。由图4(a)可知,N-衬底掺杂浓度不仅影响寄生NPN晶体管集电结偏压,同时也会影响寄生PNP晶体管的电流放大倍数。由于器件内部具有低压触发结构,因此器件的转折电压和触发电压由内部触发结构决定。从而使得不同衬底掺杂浓度情况下的触发电压和转折电压相差不大。随着衬底掺杂浓度的增大,器件触发电流和维持电流随之显著增大,维持电压也有所增大。根据低触发电压指标的要求,同时需要考虑降低干扰信号误触发的风险,应该适当提高衬底掺杂浓度。由图4(b)可知,随着衬底掺杂浓度的增大,器件峰值晶格温度随之先增大后减小,临界衬底掺杂浓度为2×1016cm-3。原因为:随着衬底掺杂浓度的增大,放电管开启时间延长,但瞬态触发电压(瞬态触发电压及开启时间与PN结电容有关,衬底掺杂浓度越高,触发电压越低,且空间电荷区展宽越小,结电容越大,开启速度越慢)降低,因此存在临界的衬底掺杂浓度。

图4 N-衬底掺杂浓度对双向低触发电压横向SCR放电管输出I-V特性和瞬态响应特性的影响Fig.4 Influence of N- substrate doping concentration on the output I-V characteristics and transient response characteristics of transverse SCR discharge transistor with bidirectional low trigger voltage
图5为仿真得到的寄生PNP晶体管P-集电区与寄生NPN晶体管P-基区间距(WN1)对双向低触发电压横向SCR放电管输出I-V特性和瞬态响应特性的影响。由图5(a)可知,WN1越大,寄生横向PNP晶体管基区宽度越宽,电流放大倍数越低,越难进入PNPN SCR正反馈模式,导致触发电压、触发电流、维持电压、维持电流增大。当WN1较小(5 μm)时,寄生PNP晶体管电流放大倍数较大,在器件内部低压触发区击穿前,器件已经开通,考虑降低干扰信号误触发的风险,选择的WN1宽度需要不小于7.5 μm。当WN1大于5 μm时,转折电压由内部低压触发区击穿电压决定,转折电压相差不大。由图5(b)可知,施加瞬态电流进行瞬态响应仿真时,随着WN1的增大,器件峰值晶格温度随之先增大后减小,当WN1=7.5 μm时器件的峰值温度最高,器件抗瞬态电流烧毁能力最低。因此,为了提高放电管的抗瞬态电流烧毁能力,应适当增大P区边缘横向距离WN1。

图5 P区间距对双向低触发电压横向SCR放电管输出I-V特性和瞬态响应特性的影响Fig.5 Influence of P region spacing on the output I-V characteristics and transient response characteristics of transverse SCR discharge transistor with bidirectional low trigger voltage
图6为仿真得到的N+阴极区与寄生NPN晶体管P基区边缘间距(WL)对双向低触发电压横向SCR放电管输出I-V特性和瞬态响应特性的影响。由图6(a)可知,N+阴极区与P基区边缘间距WL越大,N+阴极区边缘寄生NPN晶体管基区宽度越大,N+阴极区边缘开通程度越低,触发电压、触发电流、维持电压、维持电流越大。转折电压由内部触发区击穿电压决定,转折电压相差不大。由图6(b)可知,施加瞬态电流进行瞬态响应仿真,随着N+区与P基区结边缘间距WL的增大,器件峰值晶格温度随之先增大后减小。当WL=4 μm时器件的峰值晶格温度最高,器件抗瞬态电流烧毁能力最低。当WL较小时,器件过热点出现在P区柱面结表面处。随着WL增大,器件过热点转移至柱面结侧面边缘。当WL进一步增大时,器件过热点转移至柱面结与平面结的交界处。随着WL增大,器件进入SCR正反馈导通模式的触发时间增长。为了提高器件抗瞬态电流的烧毁能力,并提高放电管的开启速度,应该适当减小N+区与P区边缘间距WL。
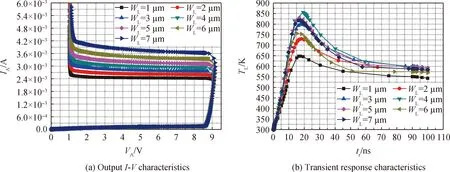
图6 N+阴极区与寄生NPN晶体管P基区边缘间距对双向低触发电压横向SCR放电管输出I-V特性和瞬态响应特性的影响Fig.6 Influence of the spacing between the N+ cathode region and the P base region edge of parasitic NPN transistor on the output I-V characteristics and transient response characteristics of transverse SCR discharge transistor with bidirectional low trigger voltage
图7为仿真得到的低压触发区N+掺杂浓度对双向低触发电压横向SCR放电管输出I-V特性和瞬态响应特性的影响。由图7(a)可知,随着低压触发结构N+区掺杂浓度的增大,触发电压、转折电压随之先减小后保持不变,维持电压和维持电流相差不大。器件触发开通后,进入晶闸管正反馈模式,内部触发结构PN结将不再有电流流过。器件的触发电压和转折由内部触发区击穿电压决定。器件的维持电压、维持电流由PNPN寄生晶闸管结构参数决定。由图7(b)可见:施加瞬态电流进行瞬态响应仿真,随着低压触发结构N+区掺杂浓度的增大,器件峰值晶格温度相差不大。

图7 低压触发区N+掺杂浓度对双向低触发电压横向SCR放电管输出I-V特性和瞬态响应特性的影响Fig.7 Influence of the N+ doping concentration in low voltage trigger region on I-V output characteristics and transient response characteristics of transverse SCR discharge transistor with bidirectional low trigger voltage
图8为根据上述优化设计得到的双向低触发电压横向SCR放电管光刻版图。共5次光刻,一次光刻为P区光刻,二次光刻为N+阴极区和N+低压触发区光刻(N+阴极区和N+低压触发区同步形成),三次光刻为接触孔光刻,四次光刻为金属电极光刻,五次光刻为钝化光刻。设计得到的芯片版图面积为630×630 μm2,两焊盘面积均为170×130 μm2。

图8 双向低触发电压横向SCR放电管版图Fig.8 Mask of transverse SCR discharge transistor with bidirectional low trigger voltage
依据仿真设计得到的结构参数,编制器件制造工艺流程。最终确定的双向低触发电压横向SCR放电管工艺流程包括:(1)衬底材料准备;(2)氧化;(3)P区光刻;(4)P区离子注入掺杂及退火;(5)淀积二氧化硅;(6)N+区光刻;(7)N+区离子注入掺杂及退火;(8)淀积二氧化硅;(9)接触孔光刻;(10)金属化电极制备。其中:N型衬底单晶电阻率为0.6~0.8 Ω·cm,总片厚为255~260 μm。为了降低硅表面缺陷态密度,热氧化前通30 min三氯乙烯。硼离子注入能量为60 keV,注入剂量为7.7×1014cm-2,推结时间300 min,推结温度1 100 ℃;磷离子注入能量为30 keV,注入剂量为8×1015cm-2,推结时间120 min,推结温度1 050 ℃。最终测得纵向结构参数:P区薄层电阻为99.6~102.5 Ω/□,P区结深为2.65~2.95 μm;N+阴极区薄层电阻为5.9~6.5 Ω/□。N+区结深为1.13~1.32 μm,与仿真设计值基本一致。
在双向低触发电压横向SCR放电管试制过程中,针对触发电压低温变化率偏大,不满足指标要求(其他参数满足指标要求)的情况进行技术攻关。从器件结构设计和制造工艺两方面,拟定了三种改善触发电压低温变化率偏大的技术方案,分别为:(1)调整N+阴极区结深(即调整寄生NPN晶体管基区宽度),其他结构参数不变;(2)调整版图中N+低压触发区与N+阴极区的间距,其他结构参数不变;(3)调整版图中N+低压触发区自身的宽度,其他结构参数不变。通过实验对比,在版图中增大N+低压触发区与N+阴极区的间距对改善触发电压低温变化率的效果较显著,并能控制其他参数(常温下触发电压、触发电流、维持电流等)实测值满足指标要求。当增大N+低压触发区与N+阴极区的间距,由12 μm增大到17 μm后,常温下触发电压增大约0.5 V,触发电压低温变化率较调整前降低约0.6%,触发电压高温变化率降低约0.2%,其他电参数变化不大。采用增大N+阴极区结深的方法虽然也可降低触发电压的低温变化率,但对常温下器件的触发特性产生较显著的影响(调整阴极区结深将影响寄生NPN晶体管共基极短路电流放大倍数,其对器件的触发特性影响较大),无法控制其他参数值满足指标要求。通过调整版图中N+低压触发区宽度的方法对于触发电压低压变化率改善效果不明显。经过关键工艺攻关,最终研制出的样片的触发电压VS、触发电流IS、维持电流IH、触发电压高低温变化率、维持电流高低温变化率均满足指标要求。
抽取10只样品管芯封装在A3-02E型管壳中,利用半导体分立器件测试系统(BC3193)进行常温电参数测试。为了采样准确,采用在线高低温测试系统(型号:S&A4220)测试器件触发电压、维持电流高低温变化率,温度范围为-50~125 ℃。触发电压VS、触发电流IS、维持电流IH、触发电压高低温变化率、维持电流高低温变化率测试结果如表2所示。图9为采用QT2晶体管特性图示仪测得的双向低触发电压横向SCR放电管击穿特性曲线。实测电参数均满足双向低触发电压横向SCR放电管指标要求,表明双向低触发电压横向SCR放电管结构参数设计及工艺参数设计较为合理。

表2 电参数测试结果Table 2 Electrical parameters test results

图9 实测双向低触发电压横向SCR放电管击穿特性曲线Fig.9 Measured breakdown characteristic curve of the transverse SCR discharge transistor with bidirectional low trigger voltage
3 结 论
本文利用Silvaco-TCAD半导体器件仿真软件对一款双向低触发电压横向SCR放电管的结构参数进行了仿真设计。从改善器件输出I-V特性和抗瞬态电流烧毁能力两方面考虑,给出了优化后的器件结构参数,包括:N-衬底区、寄生PNP晶体管P-集电区、寄生NPN晶体管P-基区、N+阴极区、N+触发区、寄生PNP晶体管P-集电区与寄生NPN晶体管P-基区间距、寄生NPN晶体管表面基区宽度。通过实际流片验证,仿真设计得到的结构参数及拟定的工艺条件较合理,制出的样片触发电压VS、触发电流IS、维持电流IH及触发电压、维持电流高低温变化率完全满足电参数指标要求。

